GaN基肖特基势垒二极管结构优化研究进展
2017-04-12吴月芳郭伟玲陈艳芳
吴月芳, 郭伟玲, 陈艳芳, 雷 亮
(北京工业大学 光电子技术省部共建教育部重点实验室, 北京 100124)
GaN基肖特基势垒二极管结构优化研究进展
吴月芳, 郭伟玲*, 陈艳芳, 雷 亮
(北京工业大学 光电子技术省部共建教育部重点实验室, 北京 100124)
作为宽禁带半导体器件,GaN基肖特基势垒二极管(SBD)有耐高压、耐高温、导通电阻小等优良特性,这使得它在电力电子等领域有广泛应用。本文首先综述了SBD发展要解决的问题;然后,介绍了GaN SBD结构、工作原理及结构优化研究进展;接下来,总结了AlGaN/GaN SBD结构、工作原理及结构优化研究进展,并着重从AlGaN/GaN SBD的外延片结构、肖特基电极结构以及边缘终端结构等角度,阐述了这些结构的优化对AlGaN/GaN SBD性能的影响;最后,对器件进一步的发展方向进行了展望。
肖特基势垒二极管(SBD); 外延片; 肖特基电极; 边缘终端; 结构优化
1 引 言
GaN作为第三代宽禁带半导体材料,以临界击穿电场强、热导率高和饱和电子漂移速度大等优异的材料性能在下一代半导体功率器件中有着广泛的应用[1-2]。GaN基器件具有开关频率高、击穿电压高、导通电阻低、热导率高等优点,可以应用在复杂的工作环境中,实现更高的系统效率[3]。GaN基肖特基势垒二极管(SBD)是一种重要的GaN基器件,它是多数载流子半导体器件,相比于PN结二极管,具有反向恢复时间短、开关损耗低的优点。GaN基SBD不仅有GaN SBD,还有体材料为异质结的AlGaN/GaN SBD。1983年,Klitzing[4]发现了AlGaN/GaN异质结构中的二维电子气(2DEG)的量子效应;1993年,Khan等[5]成功地在蓝宝石衬底上外延生长出AlGaN/GaN异质结。异质结构中的压电极化效应和自发极化效应[6]可以产生高浓度和高电子迁移率的(2DEG),因而一些AlGaN/GaN SBD、HEMT、MIS-HEMT等器件成为研究热点。
2 肖特基势垒二极管器件的发展需要解决的问题
肖特基二极管是通过金属与半导体之间形成金-半接触,分别形成肖特基阳极与欧姆阴极,实现器件的单向导电性。根据器件材料不同可分为Si基SBD、GaN基SBD以及SiC基SBD。肖特基势垒二极管与传统的PN结二极管不同,由多数载流子导电,所以它具有以下优良特性:高的工作频率和开关速度、大的饱和电流、低的正向压降等。图1[7]给出了不同材料器件的理论与实际性能参数。由图可以看出,GaN基器件的实际性能与理论值还有很大差距。本文重点总结了GaN基SBD结构的优化对于器件性能的影响。
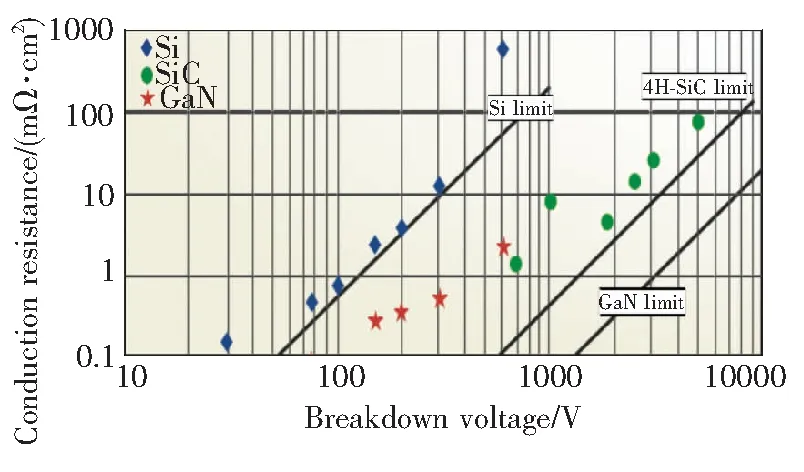
图1 基于不同材料的器件的实际参数值与理论极限值
Fig.1 Actual parameter values and theoretical limits of the devices based on different materials
2.1 边缘电场集中效应
现有的GaN基肖特基势垒二极管的击穿电压一般只能达到理论值的50%左右,要想使器件发挥更大的作用,就要致力于提高器件的击穿电压。除了材料本身的特性对器件击穿电压的影响,边缘电场集中效应[8]对器件的击穿电压也有很重要的影响。边缘电场集中效应是指器件在反向偏压时,耗尽层中的电场在水平方向的分布并不均匀,在越靠近电源边缘的位置,电力线的分布越密集,雪崩击穿就会在该处提早出现,降低了器件的耐压值。减弱边缘电场集中效应的方法有设置场板[9]、P+型保护环[10]以及悬浮金属环[11]等。
2.2 缺陷效应
由于目前的GaN基器件基本上是在异质衬底上生长的,所以GaN材料与衬底存在较大的晶格失配, GaN外延层的缺陷密度远高于Si和GaAs[12-13]。实验表明,GaN中的大部分缺陷为主要漏电通道。所以,高密度缺陷的存在使得外延片的质量变低,器件的泄露电流增大,器件的性能下降[14]。可以通过插入缓冲层、增加盖帽层、钝化等方法优化外延片的质量,降低外延片的缺陷密度,从而提高器件的性能。
2.3 衬底材料的选择
目前GaN基器件常用的衬底主要是蓝宝石和SiC。器件在应用过程中都需要很好的散热,蓝宝石衬底的热导率比较低,散热效果不好;SiC衬底的散热效果好,但是成本太高。因此,如何制作符合散热要求并且价格便宜的Si衬底或者是寻找新型符合要求的衬底材料成为需要继续研究的问题。
3 GaN SBD
3.1 器件结构与工作原理
传统的GaN SBD器件结构一般为垂直结构,如图2所示。器件结构由下到上依次是:欧姆接触阴极、n+GaN层、n-GaN层以及肖特基接触阳极。
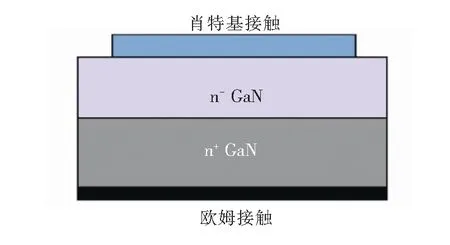
图2 垂直GaN SBD器件结构图
GaN SBD的基本工作原理如下:阳极金属与半导体接触时形成肖特基接触,实现GaN SBD的单向导电。该结构的肖特基接触与欧姆接触是通过材料的掺杂浓度来实现的,与欧姆电极接触的GaN为重掺杂。正向偏压时,势垒高度变低,电子容易从半导体流向金属,形成从金属到半导体的电流;反向偏压时,势垒高度增大,电子很难通过高势垒,从而达到反向截止的目的,便实现了器件的单向导电性。
3.2 结构优化进展
在制作GaN SBD时,由于GaN材料与衬底材料之间的晶格失配和热膨胀系数的不同,生长的GaN外延层有较高的缺陷密度和较差的表面形貌,外延片质量降低,器件的泄漏电流增加。1986年,Amano等[15]用MOCVD成功地外延出表面光滑无裂纹的GaN单晶层,引发了GaN材料的研究热潮。1999年,Bandic等[16]研究了SiO2钝化和场板结构对器件性能的影响,实现了击穿电压为250~450 V、漏电流为10-5A/cm2的GaN SBD。从此以后,对于GaN SBD的研究更加深入。接下来,我们重点从终端方面介绍GaN SBD的研究进展。
Johnson等[17]研究了带有P+保护环结构的GaN SBD作为整流二极管的结构,如图3所示。垂直结构的GaN SBD整流二极管的击穿电压为250 V,当开启电压为1.8 V时,导通电阻为1.7~3.0 mΩ·cm2。采用反向恢复电流暂态波形分析,结果表明空穴寿命水平为15 ns,GaN整流器在正向电流密度和开启电阻方面与之前的器件对比有明显的改善。
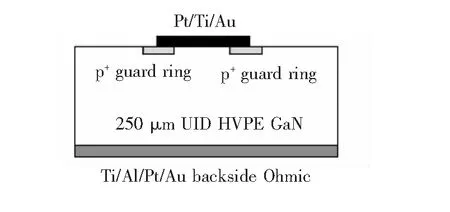
图3 带有P+型保护环的垂直GaN SBD结构图
Fig.3 Vertical GaN SBD structure with P+type protection ring
文献[18]介绍了一种带有悬浮金属环的垂直结构GaN SBD,如图4所示。带有悬浮金属环的器件击穿电压为353 V且有非常快的反向恢复时间28 ns,无悬浮金属环GaN SBD的击穿电压为159 V。两者对比发现,带有悬浮金属环的器件性能有很大的改善,因为悬浮金属环的存在缓解了肖特基阳极边缘电场的集中强度,使器件的击穿电压有所提高。

图4 带有悬浮金属环的垂直GaN SBD截面结构图
Fig.4 Vertical GaN SBD section structure with suspended metal ring
2013年,Lei等[19]仿真设计了有场板结构的垂直GaN SBD,介质材料分别采用SiO2与Si3N4,结构如图5所示。对于介质为SiO2的器件,在ND=1016cm-3、介质厚度为0.1 μm、场板长度为2 μm时,器件击穿电压达到494 V;对于介质为Si3N4的器件,在ND=1016cm-3、介质厚度为0.2 μm、场板长度为2 μm时,器件击穿电压达到570 V。

图5 带有场板结构的GaN SBD结构图
2016年,Kone等[20]制备了有无保护环的两种准垂直结构GaN SBD,如图6所示。C-V与I-V测试结果表明,保护环可以减小器件的反向泄漏电流,器件的反向击穿电压由300 V以下上升到400 V左右。他们采用深能级瞬态谱对GaN SBD中高电阻边缘终端保护环引入的缺陷进行了分析。在离子注入形成终端结构的同时,已有的缺陷能级被加强并且引入了新的深缺陷能级,所以要注意离子注入的条件以及后续退火条件的研究。

图6 GaN SBD器件结构图
4 AlGaN/GaN异质结 SBD
4.1 器件结构与工作原理
传统的AlGaN/GaN SBD器件结构如图7所示,从下到上依次为衬底(蓝宝石或者SiC)、GaN缓冲层、GaN沟道层、AlGaN势垒层以及肖特基电极和欧姆电极。

图7 传统AlGaN/GaN SBD器件结构图
图8所示为金-半肖特基接触能带随偏压的变化。从图中可以看出,在正向偏压时,势垒有所下降。当势垒降低到一定程度时,电子可以从半导体运动到金属。外加偏压越大,势垒降低越多,正向电流就越大,即更多的电子通过阴极进入到2DEG沟道,再经过肖特基势垒流出。在反向偏压时,势垒高度扩展耗尽结下方的2DEG,阻断电子的流通沟道。

图8 金属与AlGaN/GaN结构在零偏(a)、正偏(b)和反偏(c)时的能带图。
Fig.8 Energy band diagram of metal and AlGaN/GaN structure under zero bias(a), positive bias(b), and negative bias(c), respectively.
4.2 外延结构对于器件性能的优化
4.2.1 缓冲层对器件性能的影响
2006年,Yoshida等[21]通过改善外延片材料质量,制备出击穿电压超过1 000 V的Si衬底AlGaN/GaN SBD。2007年,Miyoshi、Kuraoka等[22]研究了含有AlN缓冲层与不含AlN缓冲层的AlGaN/GaN SBD的性能。含有AlN缓冲层的器件的反向泄漏电流降低了两个数量级,反向击穿电压明显升高。这是因为加入了AlN缓冲层后,器件外延片质量有所提高,使器件的反向泄漏电流下降,击穿电压上升。
2011年,Lee等[23]研究了一种高性能的AlGaN/AlN缓冲层的AlGaN/GaN SBD,结构如图9所示。在阴阳极间距为30 μm时,器件的击穿电压达到3 489 V,反向电压为-2 000 V,泄漏电流为0.2 μA,导通电阻为7.9 mΩ·cm2,开关特性得到优化,反向恢复时间为17 ns。

图9 AlGaN/AlN 缓冲层的SBD结构图
2014年,Wen等[24]提出了AlGaN/GaN复合缓冲层结构,如图10所示。采用AlGaN/GaN复合缓冲层可以降低表面粗糙度散射和合金无序散射,增加外延片的质量,提高二维电子气的迁移率,从而提高器件的电学特性。
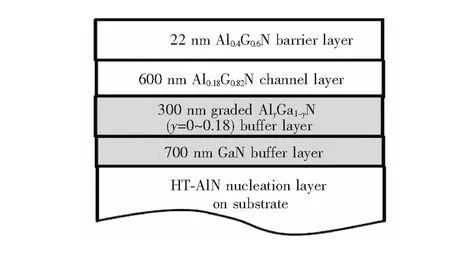
图10 复合缓冲层结构示意图Fig.10 Schematic diagram of composite buffer layer structure
4.2.2 盖帽层对器件性能的影响
2008年,NJR公司的Kamada[25]采用低温淀积GaN保护层的方法,降低了AlGaN/GaN肖特基势垒二极管的表面漏电流,实现了耐压达到1 000 V的Si衬底AlGaN/GaN SBD。
2012年,Jae-Hoon等[26]研究了带有SiCN盖帽层的AlGaN/GaN SBD,如图11。由于SiCN盖帽层的引入,器件的性能与传统器件相比有明显的提高,开启电压为0.7 V,当电压为1.5 V时电流为4.1 A,反向击穿电压为630 V。SiCN盖帽层的引入对器件表面进行了有效的钝化,使外延片拥有更好的表面形貌。
2015年,Kang等[27]对有无GaN盖帽层的AlGaN/GaN SBD(图12)进行了研究。实验结果表明,GaN盖帽层的引入不仅可以有效地减小反向泄漏电流,抑制正向电流的衰退,而且还降低了AlGaN势垒层的电场分布密度,尤其是肖特基电极边缘的电场分布密度,提高了器件的击穿电压。

图11 含有SiCN盖帽层的AlGaN/GaN SBD器件结构图
Fig.11 Structure of AlGaN/GaN SBD device with SiCN cap layer

图12 含有GaN盖帽层的AlGaN/AlN SBD器件结构图
Fig.12 Structure of AlGaN/AlN SBD device with GaN cap layer
4.2.3 AlN/GaN和AlGaN/GaN不同外延片结构对于器件性能的影响
2014年,Feng等[28]研究了AlN/GaN和AlGaN/GaN不同外延片上采用相同工艺制作的SBD。通过电学特性对比发现,AlN/GaN SBD势垒高度大,但是击穿电压低、泄漏电流大。这是因为AlN/GaN外延片大的晶格失配导致的位错密度比较大,导致器件出现大的漏电流和低的击穿电压。
综上所述,制作器件时所选外延片的质量好坏对器件性能有很重要的影响。因此,对外延片结构进行适当的改进,减小外延片的晶格失配密度与位错密度,提高外延片的质量对器件性能有很大的改善。
4.3 肖特基电极结构对器件性能的优化
在传统SBD结构中,肖特基接触一般是由高功函数金属与势垒层接触形成,从而实现器件的单向导电性。肖特基接触作为制作SBD工艺流程中最关键的工艺步骤直接影响到器件的性能,因此,对于肖特基电极的研究至关重要。这里介绍几种优化的肖特基电极结构及其对SBD器件性能的影响。
4.3.1 双金属阳极结构
2005年和2006年,Yoshida等[21,29]就提出了场效应肖特基势垒二极管(FESBD),结构如图13所示。肖特基电极由传统的高功函数金属改为高功函数金属与低功函数金属结合组成,低功函数金属有利于降低器件的开启电压,高功函数金属有利于减小器件的漏电流。正偏时,电流主要从低功函数金属通过,可以降低开启电压;反偏时,高功函数金属耗尽下方二维电子气,从而减小器件漏电流。

图13 FESBD器件结构图
4.3.2 混合阳极结构
2008年,Takatani等[30]提出了混合阳极二极管(SOCFED),结构如图14所示。该结构的阳极由肖特基电极和欧姆电极组成,并且在肖特基接触下方利用RIE系统选择性注入氟离子体实现反向阻断。

图14 混合阳极SBD器件结构图
2011年,Park等[31]改进了FESBD器件结构,如图15所示。该器件的开启电压从1.5 V减小到1 V,导通电阻也随之减小了一半。

图15 改进的混合阳极SDB结构图
4.3.3 凹槽肖特基电极结构
2012年,Bahat-Treide等[32]研究了凹槽式肖特基电极结构,如图16所示,通过减薄势垒层厚度,使肖特基接触更加接近二维电子气沟道,器件的开启电压由1.47 V降低至0.43 V,且击穿电压为1 000 V。

图16 凹槽阳极结构的AlGaN/GaN SBD结构
Fig.16 Schematic sketch of the fully recessed Schottky barrier diode with slanted field plate lateral geometry
2015年,清华大学科研团队[33]研究了凹槽阳极、阳极刻蚀区粗糙度对器件的影响,通过优化刻蚀条件,使漏电流减小、击穿电压升高,实现了0.73 V的开启电压,且采用场板结构使击穿电压达到2 070 V。
4.3.4 含有介质层的肖特基电极结构
2013年, Lenci等[34]提出了一种无金的栅边缘终端SBD器件结构(GET-SBD)。阳极结构由不含金属的20 nm TiN/20 nm Ti/250 nm Al/20 nm Ti/60 nm TiN 组成,并且采用了栅极边缘终端结构,如图17所示。这种结构有效地减小了反向泄漏电流,在电压为-600 V时,漏电流密度为1 μA/mm。
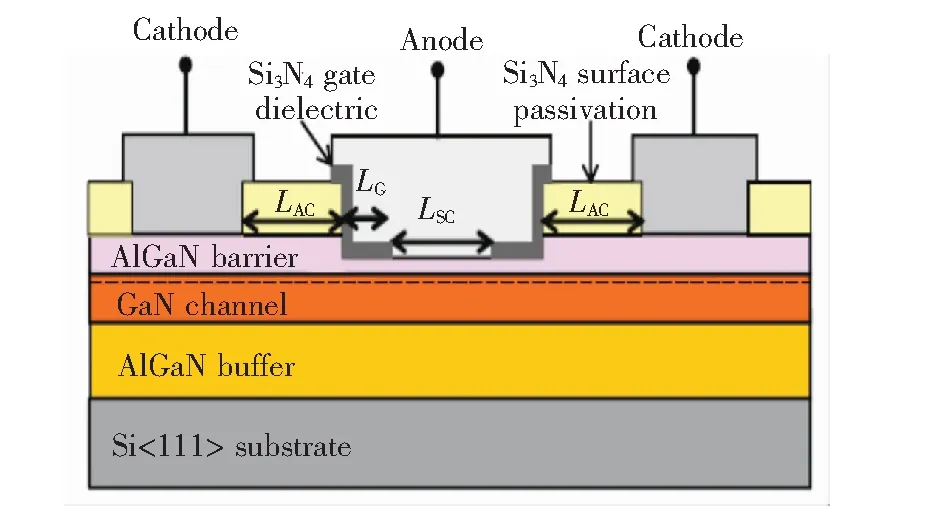
图17 新型栅边缘终端SBD器件结构
Fig.17 Structure of a new type of gate edge terminal SBD device
4.3.5 混合阳极与凹槽相互结合肖特基结构
2015年,Lee等[35]提出了一种肖特基阳极结构,如图18所示,在混合阳极结构的基础上,减小肖特基接触下的势垒层厚度,有效地解决了漏电流大的问题。该器件开启电压达到了0.34 V,击穿电压达到802 V,反向泄漏电流在电压-15 V时为1.82 μA/mm。
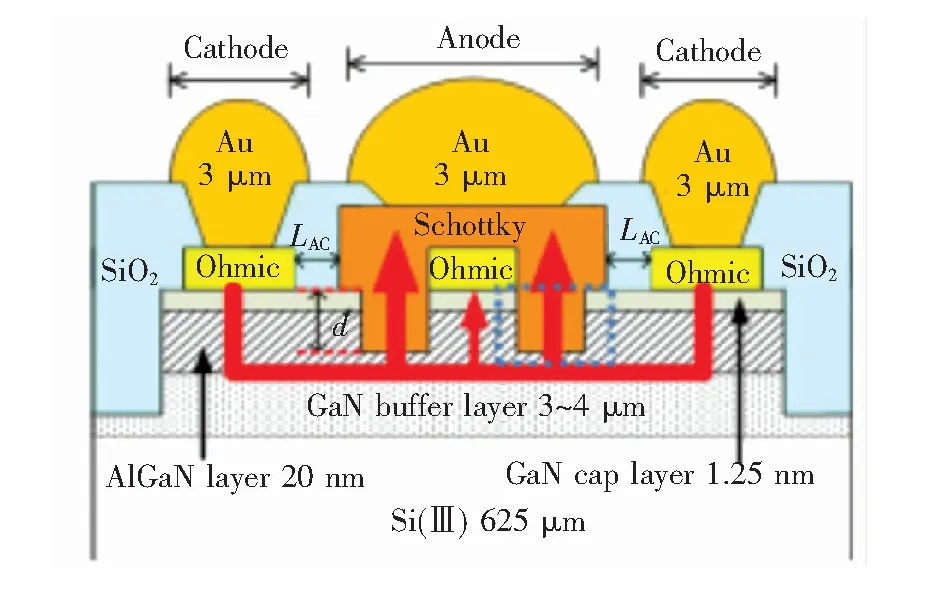
图18 混合阳极与凹槽结构SBD结构图
综上所述,对于器件肖特基结构的优化改进,可以起到优化器件的开启电压、击穿电压、反向漏电流的作用,可见肖特基电极的结构对于器件性能的优化有很重要的影响。
4.4 终端结构对于器件性能的影响
SBD的击穿电压是SBD应用的一个软肋,如何提高SBD的击穿电压,一直是人们努力的方向。为此人们提出了多种提高器件击穿电压的终端结构,如场板、P+型保护环、悬浮金属环等。
4.4.1 场板结构
场板结构的原理是使阳极附近的电场随着场板扩展,降低耗尽层的曲率,使肖特基阳极附近的电场强度减小,提高器件的击穿电压,达到优化器件的反向击穿性能的目的。
Yoshida等[36]研究了一种带有场板结构的高击穿电压肖特基势垒二极管,采用了场板和钝化层结构,如图19所示。器件的击穿电压在阴阳间距为20 μm时,达到了1 000 V左右,其漏电流低于1.5E-6 A/mm。
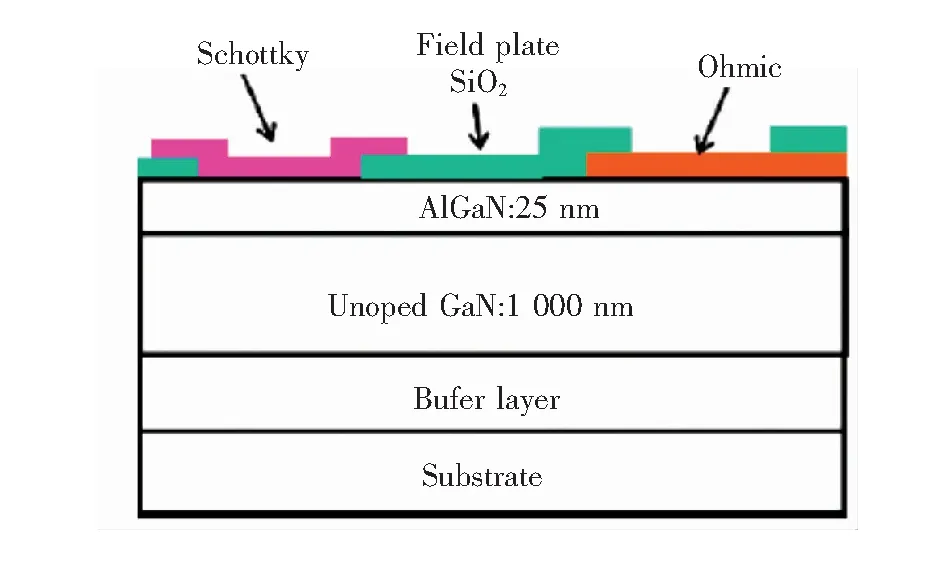
图19 含有场板的横向SBD结构示意图
Fig.19 Schematic diagram of transverse SBD structure with field plate
2015年,Zhu等[37]提出了具有凹槽阳极和双场板结构的横向AlGaN/GaN SBD,如图20所示。该结构利用凹槽阳极来降低开启电压,利用双场板来提高击穿电压。阴阳极间距为25 μm时,开启电压小于0.7 V,反向击穿电压为1.93 kV,实现了AlGaN/GaN SBD低开启电压和高击穿电压的性能。

图20 凹槽和双场板结合的SBD结构图
Fig.20 SBD structure of anode with groove and double field plate
4.4.2 P+型保护环
传统P+型保护环结构如图21所示。
利用P+型保护环来提高SBD的反向击穿电压,这种工艺是首先采用局部氧化的方法,在肖特基边缘形成一层二氧化硅,然后扩散一层P+型的保护环结构。这种机构的作用类似于场板结构,都是通过减小接触电极的电场强度,以此来提高SBD的反向击穿性能。这种P+型保护环的终端结构大多应用于垂直结构的GaN SBD,在上文已有所介绍,这里就不做过多阐述。

图21 含有P+型保护环的SBD结构
4.4.3 悬浮金属环
Lee等[38]提出了一种采用悬浮金属环的AlGaN/GaN SBD结构,如图22所示。该器件在阳极和FMR之间的距离Rs=5 μm,并且含有3个FMR时,击穿电压达到了930 V。实验表明击穿电压随着Rs的增加先增大后减小。这是因为耗尽区随着FMR扩展,电场分布在更广阔的区域并且击穿电压会有所上升;然而,当Rs超过一定数值后,击穿发生在达到FMR之前,击穿电压又会有所下降。实验还发现随着FMR数量的增加,击穿电压也有所增加,因为耗尽区扩展到更广泛的区域。

图22 带有悬浮金属环的SBD结构图
Lee等[11]制备研究了SBD器件,结构如图23所示。该结构采用悬浮金属环终端,并且氧化阳极金属Ni为NiO。在氧化时间达到5 min时,泄漏电流达到1 nA,击穿电压达到750 V并且表现出很快的反向恢复特性。
5 总结与展望
GaN材料作为第三代宽禁带半导体材料,由于其耐高压、耐高温、抗辐射、电子迁移率高等优点,应用前景十分广泛。在低压高速应用领域,要求器件的导通电阻小、反向恢复时间短,可以通过增加缓冲层、使用双金属阳极或者凹槽结构来优化器件性能;在高压大功率领域,要求器件的击穿电压大、正向电流大,可以通过增加缓冲层、使用各种终端结构等来优化器件性能。GaN基SBD器件已经取得不小的进步,但是仍然存在着不少问题:泄漏电流问题还没有得到完全解决,击穿电压和截止频率还有待提高,材料成本仍然是个问题。所以,人们需要在以下几个方面继续取得突破性进展:(1)进一步优化材料生长的各个条件,提高外延片的质量;(2)继续研究新型的缓冲层与盖帽层结构,抑制器件的泄漏电流;(3)继续研究新的肖特基电极结构,提高器件的电学特性;(4)研究新型的终端结构,改善器件性能;(5)兼顾器件各个结构之间的相互结合,促进器件各个方面性能的提高;(6)对在Si衬底上生长进行进一步的探索,降低器件的制作成本,使制造技术融入到传统的硅工艺生产中。
GaN基SBD作为第三代半导体器件中的一员,在未来各个领域的实际应用中必将有着十分广阔的前景。国内的GaN基SBD研究应该更进一步紧跟国际先进发展水平,促进我国半导体产业的进步和发展。
[1] MISHRA U K, PARIKH P, WU Y F. AlGaN/GaN HEMTs—an overview of device operation and applications [J].Proc.IEEE, 2002, 90(6):1022-1031.
[2] SAITO W, NITTA T, KAKIUCHI Y,etal.. On-resistance modulation of high voltage GaN HEMT on sapphire substrate under high applied voltage [J].IEEEElectronDev.Lett., 2007, 28(8):676-678.
[3] 王磊. AlGaN/GaN肖特基势垒二极管制作工艺与器件特性研究 [D]. 北京: 清华大学, 2011. WANG L.StudiesonFabricationandCharacteristicsofAlGaN/GaNSchottkyBarrierDiodes[D]. Beijing: Tsinghua University, 2011. (in Chinese)
[4] VON KLITZING K. The quantum Hall effect [J].Phys. B, 1983, 117(2):6605-6612.
[5] KHAN A, BHATTARAI M, KUZNIA A,etal.. High electron mobility transistor based on a GaN-AlxGa1-xN heterojunction [J].Appl.Phys.Lett., 1993, 63(9):1214-1215.
[6] 祃龙, 王燕, 余志平, 等. AlGaN/GaN材料HEMT器件优化分析与I-V特性 [J]. 半导体学报, 2004, 25(10):1285-1290. MA L, WANG Y, YU Z P,etal.. AlGaN/GaN HEMT device optimization andI-Vcharacteristics [J].Chin.J.Semicond., 2004, 25(10):1285-1290. (in Chinese)
[7] MENG L. GaN power devices came into being, to create a new era of power applications [R/OL]. [2016-10-15].http://archive.eetchina.com/www.eet-china.com/ART_8800562744_640279_NT_7ec4972c.HTM.
[8] 李文雯. AlGaN/GaN肖特基二极管特性分析及结构优化 [D]. 西安: 西安电子科技大学, 2013. LI W W.PerformanceStudyandStructureOptimizationofAlGaN/GaNSchottkyDiode[D]. Xi’an: Xidian University, 2013. (in Chinese)
[9] LEI Y, LU H. Influence of field plate on surface-state-related lag characteristics of AlGaN/GaN HEMT [J].J.Semicond., 2015, 36(7):074007-1-4.
[10] BAIK K H, IROKAWA Y, REN F,etal.. Design of junction termination structures for GaN Schottky power rectifiers [J].Solid-StateElectron., 2003, 47(6):975-979.
[11] LEE S C, HA M W, LIM J Y,etal.. Suppression of leakage current of Ni/Au Schottky barrier diode fabricated on AlGaN/GaN heterostructure by oxidation [J].Jap.J.Appl.Phys., 2006, 45(4B):3398-3400.
[12] MENEGHINI M, BERTIN M, STOCCO A,etal.. Degradation of AlGaN/GaN Schottky diodes on silicon: role of defects at the AlGaN/GaN interface [J].Appl.Phys.Lett., 2013, 102(16):163501-1-3.
[13] MENEGHINI M, BERTIN M, DAL SANTO G,etal.. A novel degradation mechanism of AlGaN/GaN/Silicon heterostructures related to the generation of interface traps [C].ProceedingsofIEEEInternationalElectronDevicesMeeting,SanFrancisco,CA,USA, 2012:13.3.1-13.3.4.
[14] 曹东升. GaN基肖特基二极管的输运和击穿特性研究 [D]. 南京: 南京大学, 2011. CAO D S.StudyonElectricalTransportandBreakdownCharacteristicsofGaN-basedSchottkyBarrierDiodes[D]. Nanjing: Nanjing University, 2011. (in Chinese)
[15] AMANO H, SAWAKI N, AKASAKI I,etal.. Metalorganic vapor phase epitaxial growth of a high quality GaN film using an AlN buffer layer [J].Appl.Phys.Lett., 1986, 48(5):353-355.
[16] BANDIC Z Z, BRIDGER P M, PIQUETTE E C,etal.. High voltage (450 V) GaN Schottky rectifiers [J].Appl.Phys.Lett., 1999, 74(9):1266-1268.
[17] JOHNSON J W, ZHANG A P, LUO W B,etal.. Breakdown voltage and reverse recovery characteristics of free-standing GaN Schottky rectifiers [J].IEEETrans.ElectronDev., 2002, 49(1):32-36.
[18] LEE S C, HER J C, KIM S S,etal.. A new vertical GaN Schottky barrier diode with floating metal ring for high breakdown voltage [C].ProceedingsofThe16thInternationalSymposiumonPowerSemiconductorDevicesandICs,Kitakyushu,Japan, 2004:319-322.
[19] LEI Y, SHI H B, LU H,etal.. Field plate engineering for GaN-based Schottky barrier diodes [J].J.Semicond., 2013, 34(5):054007.
[20] KONÉ S, CAYREL F, YVON A,etal.. DLTS analysis of high resistive edge termination technique-induced defects in GaN-based Schottky barrier diodes [J].Phys.Stat.Sol.(a):Appl.Mater.Sci., 2016, 213(9):2364-2370.
[21] YOSHIDA S, LI J, TAKEHARA H,etal.. Fabrication of AlGaN/GaN HFET with a high breakdown voltage of over 1 050 V [C].ProceedingsofIEEEInternationalSymposiumonPowerSemiconductorDevicesandIC’s,Naples,Italy, 2006:1-4.
[22] MIYOSHI M, KURAOKA Y, ASAI K,etal.. Improved reverse blocking characteristics in AlGaN=GaN Schottky barrier diodes based on AlN template [J].Electron.Lett., 2007, 43(17):953-954.
[23] LEE G Y, LIU H H, CHYI J I. High-performance AlGaN/GaN schottky diodes with an AlGaN/AlN buffer layer [J].IEEEElectronDev.Lett., 2011, 32(11):1519-1521.
[24] WEN H J, ZHANG J C, LU X L,etal.. Improved mobility of AlGaN channel heterojunction material using an AlGaN/GaN composite buffer layer [J].Chin.Phys. B, 2014, 23(3):037302-1-4.
[25] KAMADA A, MATSUBAYASHI K, NAKAGAWA A,etal.. High-voltage AlGaN/GaN Schottky barrier diodes on Si substrate with low-temperature GaN cap layer for edge termination [C].ProceedingsofThe20thInternationalSymposiumonPowerSemiconductorDevicesandIC’s,Orlando,FL,USA, 2008:225-228.
[26] LEE J H, JEONG J H, LEE J H. Enhanced electrical characteristics of AlGaN-based SBD with in situ deposited silicon carbon nitride cap layer [J].IEEEElectronDev.Lett., 2012, 33(4):492-494.
[27] KANG H, WANG Q, XIAO H L,etal.. Effects of a GaN cap layer on the reliability of AlGaN/GaN Schottky diodes [J].Phys.Stat.Sol.(a):Appl.Mater.Sci., 2015, 212(5):1158-1161.
[28] LÜ Y J, FENG Z H, LIN Z J,etal.. Comparison of electrical characteristic between AlN/GaN and AlGaN/GaN heterostructure Schottky diodes [J].Chin.Phys. B, 2014, 23(2):27101-1-5.
[29] YOSHIDA S, LI J, IKEDA N,etal.. AlGaN/GaN field effect Schottky barrier diode (FESBD)[J].Phys.Stat.Sol. (a):Appl.Mater.Sci., 2005, 2(7):2602-2606.
[30] TAKATANI K, NOZAWA T, OKA T,etal.. AIGaN/GaN Schottky-Ohmic combined anode field effect diode with fluoride-based plasma treatment [J].Electron.Lett., 2008, 44(4):320-321.
[31] PARK K, PARK Y, HWANG S,etal.. 1 kV AlGaN/GaN power SBDs with reduced on resistances [C].ProceedingsofThe23rdInternationalSymposiumonPowerSemiconductorDevicesandICs(ISPSD),SanDiego,CA,USA, 2011:223-226.
[32] BAHAT-TREIDEL E, HILT O, ZHYTNYTSKA R,etal.. Fast-switching GaN-Based lateral power Schottky barrier diodes with low onset voltage and strong reverse blocking [J].IEEEElectronDev.Lett., 2012, 33(3):357-359.
[33] TSOU C W, WEI K P, LIAN Y W,etal.. 2.07-kV AlGaN/GaN Schottky barrier diodes on silicon with high Baliga’s figure-of-merit [J].IEEEElectronDev.Lett., 2016, 37(1):70-73.
[34] LENCI S, DE JAEGER B, CARBONELL L,etal.. Au-free AlGaN/GaN power diode on 8-in Si substrate with gated edge termination [J].IEEEElectronDev.Lett., 2013, 34(8):1035-1037.
[35] LEE H S, DONG D Y, PARK Y,etal.. 0.34 VT AlGaN/GaN-on-Si large Schottky barrier diode with recessed dual anode metal [J].IEEEElectronDev.Lett., 2015, 36(11):1132-1134.
[36] YOSHIDA S, IKEDA N, LI J,etal.. High power AlGaN/GaN Schottky barrier diode with 1 000 V operation [J].MrsOnlineProc.Libr., 2011, 892:0892-FF05-02.1-6.
[37] ZHU M D, SONG B, QI M,etal.. 1.9-kV AlGaN/GaN lateral Schottky barrier diodes on silicon [J].IEEEElectronDev.Lett., 2015, 36(4):375-377.
[38] LEE S C, HA M W, HER J C,etal.. High breakdown voltage GaN Schottky barrier diode employing floating metal rings on AlGaN/GaN hetero-junction [C].ProceedingsofThe17thInternationalSymposiumonPowerSemiconductorDevicesandICs,SantaBarbara,CA,USA, 2005:247-250.

吴月芳(1993-),女,河北廊坊人,硕士研究生,2015年于燕山大学获得学士学位,主要从事GaN宽禁带半导体器件的研究。

E-mail: wuyf@emails.bjut.edu.cn郭伟玲(1966-),女,山西垣曲县人,教授,硕士生导师,2003年于北京工业大学获得博士学位,主要从事半导体器件可靠性和宽禁带半导体器件的研究。
E-mail: guoweiling@bjut.edu.cn
Progress on Structure Optimization of GaN Based Schottky Diode
WU Yue-fang, GUO Wei-ling*, CHEN Yan-fang, LEI Liang
(KeyLaboratoryofOpto-electionicsTechnology,MinistryofEducation,BeijingUniversityofTechnology,Beijing100124,China)*CorrespondingAuthor,E-mail:guoweiling@bjut.edu.cn
As a wide band gap semiconductor device, GaN based Schottky barrier diode (SBD) has the characteristics of high voltage, high thermostability, low conduction resistance and other excellent characteristics, which makes it widely used in the field of power electronics. This paper first summarizes the problems to be solved in the development of SBD. Then, the structure, working principle and structure optimization of GaN SBD are introduced. Next, the structure, working principle and structure optimization of AlGaN/GaN SBD are summarized, and the effects of these structures on the performance of AlGaN/GaN SBDs are discussed from the perspective of epitaxial wafer structure, Schottky electrode structure and edge termination structure of AlGaN/GaN SBD.
Schottky barrier diode(SBD); epitaxial wafer; Schottky electrode; edge terminal; structure optimization
1000-7032(2017)04-0477-10
2016-10-28;
2016-12-24
国家高技术研究发展计划(863) (2015AA033305); 北京16教师队伍建设—青年拔尖项目(市级)(PXM2016_014204_000017_00205938_FCG)资助 Supported by National High Technology Research and Development Program of China (863) (2015AA033305); 16-Outstanding Young Teachers Team Construction Project of Beijing(Municipal) (PXM2016_014204_000017_00205938_FCG)
TN311.7
A
10.3788/fgxb20173804.0477
