碳化硅金属氧化物半导体场效应晶体管短路特性
2016-12-19王小浩彭志高李宗鉴
王小浩,王 俊,江 希,彭志高,李宗鉴,沈 征
(湖南大学电气与信息工程学院,长沙410082)
碳化硅金属氧化物半导体场效应晶体管短路特性
王小浩,王 俊,江 希,彭志高,李宗鉴,沈 征
(湖南大学电气与信息工程学院,长沙410082)
器件的短路能力对整流器及其故障保护具有极其重要的意义。当器件故障运行时,为避免器件损坏,须在最短的时间内将故障予以切除,而此时器件的最大短路运行时间为系统保护装置提供了有力的时间支持。主要研究了碳化硅金属氧化物半导体场效应晶体管(SiC MOSFET)在短路条件下的运行能力,以Cree公司的1 200 V/ 19 A SiC MOSFET为模型,设计了硬件电路,测试其不同电压等级下的短路电流;并在直流电压等级为600 V的条件下,测试了不同栅极电压、不同温度工况下的短路电流。研究结果表明器件的短路峰值电流随着栅极电压的升高而增大,而其短路运行时间却大幅降低;温度对短路运行时间的影响则相对不甚明显;同时还给出了器件在不同工况下的最大短路运行时间Tsc(max)。
短路测试;短路电流;短路能力
半导体技术的发展,一直是电力电子设备进步的决定性力量,传统硅基器件开关的结构设计和制造工艺已经日趋完善,甚至接近其材料本身所决定的理论极限[1]。20世纪90年代后期,碳化硅和氮化镓等宽禁带半导体材料的研发进展引起了半导体器件专家学者们的注意。与传统的硅材料相比,碳化硅具有击穿场强高、热稳定性好、较高的热导率等优点,能够满足更高性能的电力电子装置与系统对高压、高温、高效率及高功率密度的需求,在高温高频大功率等场合具有十分可观的应用前景,使其成为了近年来研究的热点[2]。在宽禁带半导体器件中,碳化硅MOSFET由于其较低的导通电阻,更高的温度运行能力,更快的快关速度,在中等功率场合趋于取代传统的硅材料器件;而其开关速度快,致使其开关损耗远小于传统的硅基器件[3],同时由于碳化硅MOSFET具有更小的芯片面积和更高的电流密度,与硅材料相比,其短路承受能力将会有所不同。为了保证电力电子装置安全可靠的运行,功率开关设备往往需要在安全的短路运行时间内保证检测保护电路能够有效地甄别故障并予以切除,所以器件的短路承受能力对系统的安全运行具有十分重要的意义。
本文从此角度出发,设计硬件电路,模拟设备运行时器件的短路故障。分析了不同电压等级下器件的短路电流情况,同时对比分析了直流电压等级为600 V时,在不同栅极驱动电压15 V、19 V和不同温度25℃和150℃时的短路电流特性,并给出了器件的最大短路承受时间。实验结果表明,随着栅极电压的升高,短路电流峰值将会增加,而短路承受时间Tsc却随着栅极电压的升高而减小;同时Tsc随着温度的升高也会降低,但是影响不甚明显。
1 SiC MOSFET静态特性
为了更好地分析器件的短路特性,事先对器件的静态特性进行测量。在T=25℃和T=150℃,Vgs分别为11、13、15、17、19 V时,对其I-V特性进行测试,如图1和图2所示。由图1和图2可以看出,随着栅极电压的升高,由于栅极沟道宽度和导电能力的增加,流过器件的电流也随之增大[4];而导通电流却随着温度的升高而降低。分析可知:在正常导通条件下,SiC MOSFET的导通电阻Rds(on)主要由沟道电阻Rch(负温度系数)和漂移区电阻Rdrift(正温度系数)决定[5]。当温度升高,由栅极电压决定的沟道宽度足够宽时,继续增加栅极电压,对导通电流的影响则并不明显;此时随着温度的升高,起主要作用的漂移区电阻Rdrift随着温度的升高而迅速增加,导通电阻Rds(on)增大,导致漏源电流在相同栅极电压的情况下随着温度的升高而降低[6-7]。根据实验结果:当漏源电流Id=19 A时,T=25℃时,栅极电压由15 V变为19 V时,Rds(on)减小20.3%;T=150℃时,Rds(on)减小8%;而当漏源电流Id=19 A时,Vgs=15 V时,温度由25℃变为150℃时,Rds(on)增加86.3%;Vgs=19 V时,Rds(on)增加114.7%。

图1 T=25℃时SiC MOSFET的I-V特性Fig1.I-V characteristic of SiC MOSFET at T=25℃

图2 T=150℃时,SiC MOSFET的I-V特性Fig2.I-V characteristic of SiC MOSFET at T=150℃
2 短路测试原理
SiC MOSFET的短路测试电路如图1所示,其中开关S1采用Infine公司的1 200 V/140 A IGBT,型号为IRG7PH50UpbF;S2为Cree公司的1 200 V/ 19 A SiC-MOSFET,型号C2M0160120D,二者作为短路测试器件。在电路中串联大电流IGBT的目的是为了能够测量到MOSFET损坏瞬间流过的短路电流。同时由于SiC MOSFET开关速度快,为了能够更好地测量其短路电流,本文采取的开关时序为IGBT提前500 ns开通以使其先进入导通状态,而延时500 ns关断。同时为了减小电流测量的振荡,在测试电流采样模块中加入了RC滤波电路,其中R=47 Ω,C=470 pF。

图3 短路测试原理Fig.3 Schematic of short-circuit test
3 SiC MOSFET短路特性
3.1 电压对短路电流的影响
当T=25℃,Tsc=5μs,Vgs分别为15 V和 19 V时,器件在不同电压等级下(Vds=200、400、600 V)的短路电流如图4和图5所示。从图中可以看出:器件的短路电流峰值随着电压的增加而升高,且达到短路电流峰值的时间随着电压的升高而逐渐减小,并且在Vds=600 V时,t=0.8μs时短路电流峰值达到最大Id=93 A。当Vgs=19 V时,从器件的I-V特性可知器件的通流能力增强,在相同电压等级下,其短路电流峰值相比Vgs=15 V时将会大大提高,同时达到短路电流峰值的时间也将会缩短,此时在Vds=600 V时,t=0.6μs,且短路电流总体趋势呈现先上升后下降的趋势[8]。
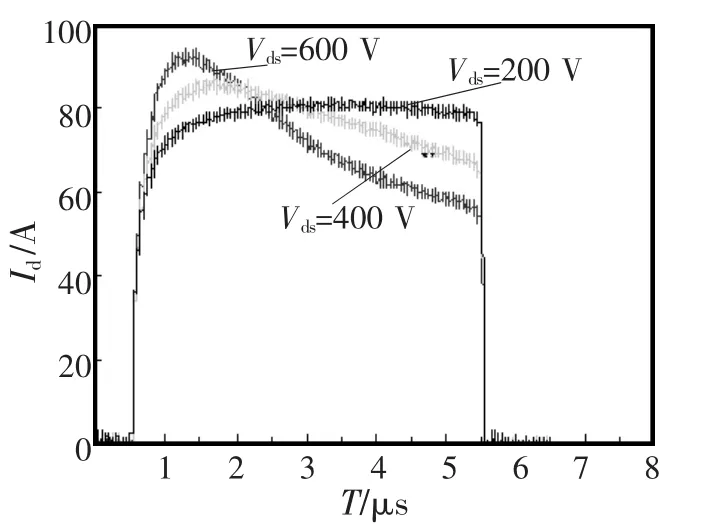
图4 Tsc=5μs,Vgs=15 V时,不同电压等级下的短路电流Fig.4 Short-circuit currents at different drain-sourcevoltage when Tscis 5μs and Vgsis 15 V
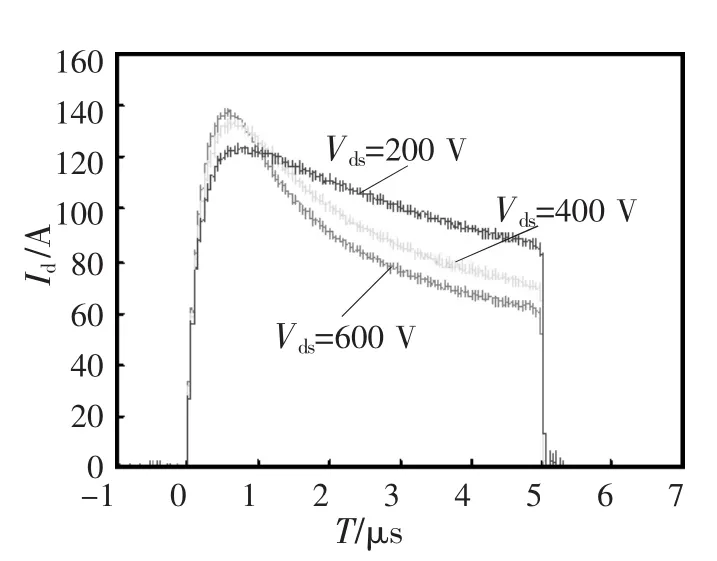
图5 Tsc=5μs,Vgs=19 V时,不同电压等级下的短路电流Fig.5 Short-circuit current at different drain-source voltage when Tscis 5μs and Vgsis 19 V
分析可知,在脉冲来临的初始时刻,由于沟道迁移率随着结温的升高(由功耗导致)而增加,电流在开始的短暂时间里一直保持着上升状态,随着结温的进一步升高,受主要载流子散射机理的影响,通道迁移率发生改变。随着结温的继续增加,其他散射机制(声散射等)将成为主导,致使电流达到峰值后开始下降[5,9]。
3.2 栅极电压和温度对短路电流及运行时间的影响
为了分析不同栅极电压和温度对器件的短路电流以及短路时间的影响,对其进行深入探索。图6为T=25℃时,不同栅极电压下器件的短路电流情况。从图中可以看出随着栅极电压的升高,器件的短路电流峰值将会增大,且达到短路电流峰值的时间也会有所减小。当Vgs=15 V时,Imax=85 A;同时器件在Tsc=10.5μs时出现了约7 A的漏电流,此时,Tsc=10.5μs也即器件在Vgs=15 V,T=25℃,电压等级600 V下的最大短路承受时间。此时若继续增加器件的短路时间,器件在关断后将会由于较大的漏电流和发热导致结温过高而导致器件烧毁。而Vgs=19 V时,Imax=138 A;而此时器件在Tsc=7.2μs时出现7 A左右的漏极漏电流,Tsc=7.2μs也即器件在Vgs=19 V、T=25℃、电压等级600 V下最大短路承受时间。
随着温度的升高,器件的短路承受时间将会有所降低。图7为T=150℃时器件的短路电流情况。分析可知,当T=150℃、Vgs=15 V时,短路峰值电流Imax=87 A,与T=25℃时的峰值电流相当;而当Vgs=19 V短路峰值电流Imax=118 A,与T=25℃时相比出现了显著的降低,此时器件达到最大短路电流峰值的时间有所减小。此外,T=150℃时,当Vgs=15 V时,器件在Tsc=10μs时出现了约10 A的漏极漏电流,此时若继续增加器件的短路运行时间,器件将会由于结温过高而导致炸裂;当Vgs=19 V时,器件在T=7μs时出现较大的漏极漏电流。

图6 T=25℃、V=600 V时,不同Vgs的短路电流Fig.6 Short-circuit current at different gate-source voltage when T is 25℃ and Vdsis 600 V

图7 T=150℃、V=600 V时,不同Vgs的短路电流Fig.7 Short-circuit current at different gate-source voltage when T is 150℃ and Vdsis 600 V
3.3 最大短路承受时间
为了洞察器件的短路能力,由第3.2节分析可知,不同栅极电压和不同温度下器件的短路承受时间如图8所示。
由图可以看出,随着栅极电压的升高器件的短路时间将会显著减小。T=25℃时Vgs从15 V变为19 V时,短路承受时间降低了31%;T=150℃时,降低了30%。分析可知:SiC MOSFET的导通电阻主要由沟道电阻Rch和漂移区电阻Rdrift组成,在短路情况下,漂移区的载流子在强电场的作用之下被迅速的扫出,致使漂移区电阻非常小,此时器件的电流主要由沟道电阻Rch决定[5]。而Rch与沟道电子迁移率、栅极偏置电压和阈值电压均有关,随着栅极电压的升高,短路电流随之增大,过高的功耗导致结温迅速升高,致使器件在更短的时间内损坏。
而由于SiC材料的耐高温特性,可以使得其工作在更高的温度工况下运行[10]。从图8中还可以看出:Vgs=15 V、T=150℃时,短路时间仅比室温时缩短0.5μs;而Vgs=19 V时,缩短0.2μs。由此可知温度对SiC MOSFET短路承受时间的影响并不是十分明显。

图8 不同Vgs和T的短路承受时间Fig.8 Short-circuit tolerance time at different gatesource voltages and different temperatures
4 结语
本文从1 200 V/19 A的SiC MOSFET的静态特性入手,研究了不同电压等级下器件的短路电流情况;并以此为契机,进一步深入分析了不同栅极电压、不同温度条件下器件的短路能力。研究表明:随着电压等级的升高,短路电流峰值随之增大,且达到最大短路电流峰值的时间也会缩短;在同一电压等级600 V下,随着栅极电压的升高,器件的短路电流峰值随之增大,同时器件的短路承受时间也急剧下降,在Vgs为15 V、T=25℃时,最大短路承受时间Tsc(max)为10.5μs,Vgs为19 V、T为25℃时,最大短路承受时间为7.2μs;器件的短路峰值电流会随着温度的升高而降低,但温度对短路承受时间Tsc(max)的影响不明显。
[1]孙凯,陆珏晶,吴红飞,等.碳化硅MOSFET的变温度参数建模[J].中国电机工程学报,2013,33(3):37-43,17.Sun Kai,Lu Juejing,Wu Hongfei,et al.Variable temperature parameters modeling of silicon carbide MOSFET[J].Proceedings of the CSEE,2013,33(3):37-43,17(in Chinese).
[2]钱照明,张军明,盛况.电力电子器件及其应用的现状和发展[J].中国电机工程学报,2014,34(29):5149-5161.Qian Zhaoming,Zhang Junming,Sheng Kuang.Current situation and development of power electronic devices and their applications[J].Proceedings of the CSEE,2014,34(29):5149-5161(in Chinese).
[3]张斌锋,许津铭,钱强,等.SiC MOSFET特性及其应用的关键技术分析[J].电源学报,2016,14(4):39-51.Zhang Binfeng,Xu Jinming,Qian qiang,et al.Analysis on characteristics of SiC MOSFET and key techniques of its applications[J].Journal of Power Supply,2016,14(4):39-51(in Chinese).
[4]Lyu Hongliang,Zhang Yimen,Zhang Yuming,et al.Analytic model of I-V Characteristics of 4H-SiC MESFETs based on multiparameter mobility model[J].in IEEE Transactions on Electron Devices,2004,51(7):1065-1068.
[5]Huang Xing,Wang Gangyao,Li Yingshuang,et al.Shortcircuit capability of 1200V SiC MOSFET and JFET for fault protection[C].Applied Power Electronics Conference and Exposition(APEC),2013 Twenty-Eighth Annual IEEE.Long Beach,CA,USA,2013:197-200.
[6]Roschke M,Schwierz F.Electron mobility models for 4H,6H, and 3C SiC[MESFETs][J].IEEE Transactions on Electron Devices,2001,48(7):1442-1447.
[7]Kawamura T,Hori D,Kangawa Y,et al.Thermal conductivity of SiC calculated by moleculardynamics[J].Japanese Journal of Applied Physics,2008,47(12):8898-8901.
[8]Castellazzi A,Funaki T,Kimoto T,et al.Short-circuit tests on SiC power MOSFETs[C].Power Electronics and Drive Systems(PEDS),2013 IEEE 10th International Conference on.Kitakyushu,2013:1297-1300.
[9]Awwad A E,Dieckerhoff S.Short-circuit evaluation and over current protection for SiC power MOSFETs[C].Power Electronics and Applications(EPE'15 ECCE-Europe),2015 17th European Conference on,Geneva,2015:1-9.
[10]Wang Zhiqiang,Shi Xiaojie,Tolbert L M,et al.Temperature-dependent short-circuit capability of silicon carbide power MOSFETs[J].IEEE Transactions on Power Electronics,2016,31(2):1555-1566.
Short-circuit Characterization of SiC MOSFET
WANG Xiaohao,WANG Jun,JIANG Xi,PENG Zhigao,LI Zongjian,Z.John SHEN
(College of Electrical and Information Engineering,Hunan University,Changsha 410082,China)
The short-circuit capacity of semiconductor devices is critical to converter and protection appliance.With running in abnormal condition,the fault must be cut off as soon as possible so as to prevent the devices undergo catastrophic breakdown,so the maximum short-circuit running time of the device provides a powerful time support for the system protection design.In this paper,the operational capability of silicon carbide metal oxide semiconductor field effect transistor(SiC MOSFET)under short-circuit conditions is investigated.Based on the model of 1 200 V/19 A SiC MOSFET fabricated by Cree(C2M0160120D),the hardware circuit is designed,and the short-circuit current under different voltage levels is tested.At the same time,the short-circuit current is also tested under different gate-source voltages and different temperatures when the DC voltage level is 600 V.The results show that the short-circuit peak current increases with the increasing of gate-source voltages,instead,the short-circuit running time of the device decreases apparently,and the temperature does not have much impact on Tsc.At last,this paper also gives the maximum short-circuit duration time of the device.
short-circuit test;short-circuit current;short-circuit capacity

王小浩
王小浩(1989-),男,硕士研究生,研究方向:电力电子器件及应用,E-mail:937457704@qq.com。
王俊(1979-),男,通信作者,博士,教授,研究方向:电力电子技术、碳化硅(SiC)功率器件的研究、电力电子器件的智能驱动及高功率密度变换器等,E-mail:junwang@hnu.edu.cn。
江希(1992-),男,硕士研究生,研究方向:电力电子器件及应用,E-mail:jiangxi6@126.com。
彭志高(1992-),男,硕士研究生,研究方向:电力电子器件及应用,E-mail:a15116369100@163.com。
李宗鉴(1990-),男,博士研究生,研究方向:电力电子器件,高功率密度变换器,E-mail:LZJQ1@163.com。
沈征(1964-),男,博士,教授,研究方向:电力电子器件、新型电力传输系统、电能质量及汽车电子等,E-mail:johnshen@ieee.org。
10.13234/j.issn.2095-2805.2016.6.53
TN 386
A
2016-08-11
国家自然科学基金资助项目(51577054)
Project Supported by the National Natural Science Foundation of China(51577054)
