光子计数成像探测器电荷感应层Ge薄膜特性研究
2016-11-02郑鑫陈波王孝东张宏吉李云鹏于再超
郑鑫,陈波,王孝东,张宏吉,李云鹏,于再超
(1.中国科学院长春光学精密机械与物理研究所,长春 130033;
2.中国刑事警察学院,沈阳 110854;3.长春特种设备检测研究院,长春 130000)
光子计数成像探测器电荷感应层Ge薄膜特性研究
郑鑫1,陈波1,王孝东1,张宏吉1,李云鹏2,于再超3
(1.中国科学院长春光学精密机械与物理研究所,长春130033;
2.中国刑事警察学院,沈阳110854;3.长春特种设备检测研究院,长春130000)
为了研究光子计数成像系统中感应电荷层Ge薄膜的制备工艺,改善光子计数成像系统的成像稳定性,采用直流磁控溅射法在熔石英衬底上制备了Ge薄膜,分析了工作气体Ar气通入量对Ge薄膜沉积速率的影响,利用表面轮廓仪及四探针表面电阻仪对样品分别进行了表面粗糙度及电学性能的表征。结果表明:随着Ar气通入量的增加,Ge薄膜沉积速率先上升后下降,在Ar气通入量为15sccm时,Ge薄膜的沉积速率出现极大值;Ge薄膜的表面粗糙度及薄膜电阻率均随着Ar气通入量的升高而增大;薄膜越厚,其电阻受氧化影响越小,电学性能越稳定。
Ge薄膜;直流磁控溅射;Ar气通入量;沉积速率;电学性质
由于基于微通道板的位敏阳极光子计数成像探测器具有信噪比高、背景噪声低、耐辐射、探测量子效率高等优点,使其在微弱光信号领域具有传统CCD成像系统所无可比拟的优势,因此被广泛应用于空间探测与天文观测等领域[1,2]。它的结构由微通道板、位敏阳极和位置读出电路三部分组成[3,4]。根据电荷接收方式不同,其成像电荷读出方式可分为直接读出方式和感应读出方式两种[5,6],前者是由位敏阳极直接收集经MCP倍增后输出的电荷,当电子云入射到金属阳极表面通常会产生大量二次电子而导致图像的畸变;而后者感应读出方式中,MCP输出的电荷先轰击呈高阻抗特性的半导体Ge膜,产生感应电荷后由背面的位敏阳极进行收集[7]。相比直接读出方式,电荷感应读出方式可有效克服图像畸变,避免了位敏阳极次级电子重新分布所引起的分布噪声[8],因此更适合工程中的应用。
在嫦娥三号卫星上搭载的用于对地球等离子体层He+辐射(30.4nm)进行观测的月基极紫外(EUV)相机,以及即将发射的风云三号卫星上搭载的用于对极光辐射的LBH带(140nm~180nm)进行观测的广角极光成像仪中,均采用了感应电荷位敏阳极光子计数成像探测器系统。月基EUV相机工作正常,传回图像良好。
Ge薄膜作为直接与电子云接触的电荷感应层,其电阻值大小会直接影响电荷在膜层的扩散速度,从而影响电荷保持分布形状的时间常数,是影响系统性能的重要参数[9]。
国内外研究者大多采用电子束蒸发与热蒸发等方式制备Ge膜[5,8],其成像质量尚有提高空间。由于相对于电子束蒸发等蒸镀法,磁控溅射法制备出的Ge薄膜更加均匀、致密,空隙组分更小,且薄膜对基底的附着力更强[10],更有利于提高成像系统的性能,因此本文采用直流磁控溅射方法制备Ge薄膜。而直流溅射中工作气体Ar气的通入量是一个重要的工艺参数,其对溅射速率及薄膜的质量都有很大的影响。因此本文研究了不同Ar气通入量对沉积速率、薄膜表面形貌及电学性能的影响,以优化Ge薄膜沉积工艺,为今后工程应用奠定基础。
1 实验方法
利用JGP600型四靶磁控溅射镀膜机,在不同工作气压下直流磁控溅射沉积Ge薄膜,基片选用粗糙度为0.5nm~0.6nm的Φ65mm熔石英。实验前,基片用乙醇进行超声清洗,然后用氮气快速吹干,以除去表面杂质、油污等。溅射靶材为高纯度Ge靶。溅射时本底真空为5×10-4Pa,通过流量显示仪与蝶阀控制气体流量及工作气压,设定Ar通入量分别为10、15、19、22sccm,沉积时间均为10分钟。薄膜电阻采用Jandel RM3-AR型方阻仪进行测量,测量压力控制在20N左右,每个样品取5个不同位置测量后取平均值,以增加实验结果的可靠性,测量室温控制在23摄氏度。薄膜厚度采用KLA Tencor公司的P-16+型台阶仪对样品台阶进行多次测量取平均。样品表面粗糙度用Zygo公司的VIEW 6000 STP型轮廓仪测得。
2 结果讨论
2.1Ar气通入量对Ge薄膜沉积速率的影响
在其他工艺参数不变的条件下,只改变Ar气通入量,获得四组样品。通过台阶仪对样品膜厚进行测量,由于沉积时间均为10min,可分别计算获得四组样品镀制时的沉积速率。图1为溅射电流恒定时,Ge薄膜沉积速率与Ar气通入量之间的关系。由图1可见,随着Ar气通入量的增加,薄膜沉积速率先增大后减小,在Ar气通入量为15sccm时薄膜沉积速率最大,为6nm/min。

图1 薄膜沉积速率随Ar气通入量的变化曲线
这一现象可以用溅射原理及气体放电理论来解释。首先溅射是离子与物质表面原子在碰撞过程中发生能量与动量转移,最终将物质表面原子激发出来的复杂过程。在对系统预抽真空后,充入惰性气体Ar,在正负电极间外加电压,Ar原子被大量电离为Ar+离子和可以独立运动的电子,其中的电子将加速飞向阳极衬底,而Ar+会加速飞向作为阴极的靶材,并在撞击中释放出相应的能量,发生溅射以及二次电子发射等现象[11]。
由于分子的平均自由程与分子的密度成反比,因此在相对较低的气压条件下,电子的自由程较长,在阳极上消失的几率较大,其通过碰撞过程引起气体分子电离的几率较低;且由于低气压会使离子在阴极上溅射的同时发射出二次电子的几率较小,这些均导致溅射速率在气压较低时相对较小。随着气压的升高,电子的平均自由程减小,其与气体分子碰撞几率增大,且阴极二次电子发射几率增大,导致Ar原子的电离几率增加,溅射速率得到提高。但是当气体压力过高时,真空腔内Ar气分子增多以及Ar气分子的平均自由程减小均使得溅射出来的靶材原子与Ar气分子碰撞次数增多,导致溅射粒子能量在碰撞中大量损失,部分溅射粒子甚至会被散射回靶材表面沉积下来,致使粒子到达基片的数量减少,能量降低,因而其沉积到衬底的速率反而下降[11]。
2.2Ge薄膜表面形貌分析
通过轮廓仪对四组样品进行表面粗糙度的测试,测试结果如图2所示。由图可见四组样品的表面粗糙度均方根值(RMS)分别为0.964nm、1.041nm、1.277nm、1.306nm。可见随工作气压的升高,样品整体粗糙度呈现增大的趋势。
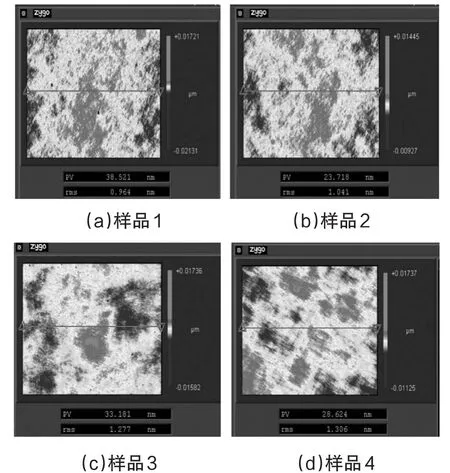
图2 Ge薄膜表面粗糙度测试结果
这是由于溅射气压较低时,气体分子密度较小,溅射粒子的平均自由程较大,使得入射到衬底表面的原子与气体分子的碰撞几率较小,因而其能量较高,这有利于提高沉积时原子的扩散能力,提高沉积薄膜的致密程度。随着溅射气压的提高,溅射粒子的平均自由程减小,使得入射原子的能量降低,因而不利于薄膜组织的致密化,粗糙度增大。
2.3薄膜电阻率的分析
Ge薄膜电阻受测试温度影响很大,其在不同环境温度下的测试结果是不同的。由文献[12]可知,Ge薄膜为负电阻率温度系数(TCR)材料,其电阻随测试温度的变化接近线性。因此在测量薄膜电阻时需严格保证环境温度的一致。
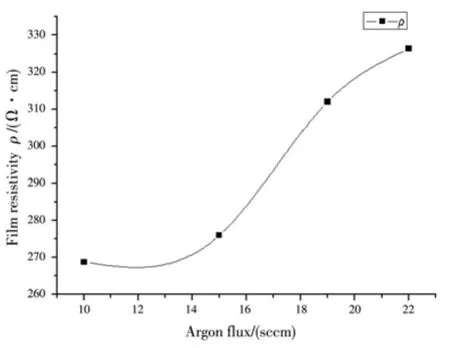
图3 Ge膜电阻率随Ar气通入量的变化曲线
对于薄膜材料的电阻率可以由关系式ρ=Rs×df得到,其中Rs是在室温环境下利用四探针方阻仪测得的薄膜表面方阻,df为相应的薄膜厚度。图3所示为Ge薄膜电阻率随Ar气通入量的变化情况。
从图中可以看出,在恒流模式下,薄膜的电阻率随Ar气通入量的升高而增大,Ar气通入量较低时(10sccm)薄膜电阻率较小,为268.8Ω·cm,当Ar气通入量升高到22sccm时,所制备的薄膜电阻率最大,为326.4Ω·cm。
这是由于工作气压较低时,溅射粒子能量大,沉积薄膜结构致密,空隙组分小,电阻率低;随着气压的升高,溅射粒子散射增多,到达衬底时能量降低,迁移率低,薄膜结构疏松,空隙组分大,自由电子被空隙边界散射的几率更大,所以电阻率较大。这与薄膜表面粗糙度测试结果相一致。
2.4薄膜电阻氧化特性分析
由于暴露在空气中的Ge薄膜表面极易形成氧化层GeO2,磁控溅射的非晶Ge薄膜暴露在空气中形成的氧化层厚度约为0.5~1nm[13],而GeO2的电阻率可达105Ω·cm,所以随着暴露在空气中的时间增加,氧化层厚度逐渐增加,薄膜电阻也将随之增加。
将样品在大气下放置60天后电阻趋于稳定,对比其阻值如下表所示。

表1 薄膜电阻测试结果
由上表可见,膜厚为60nm的2号样品静置60天后其薄膜电阻增大了44MΩ,增加量为95.6%,而48nm的4号样品电阻增加了68MΩ,增量为100%,说明薄膜厚度越大,其氧化后电阻的增加量越小,电学性能受氧化的影响越小,电阻越稳定。
产生这一现象的原因可以用电阻并联的模型来定性解释。如图4所示,Ge薄膜与GeO2薄膜可以等效成两个独立的电阻并联。

图4 Ge膜与氧化层等效电阻模型
根据公式


其中,d为薄膜总厚度,m为GeO2厚度,ρ、ρ′分别为Ge与GeO2电阻率,R为薄膜总电阻,R1为GeO2电阻,R2为Ge电阻,代入并整理可得:

由于ρ′〉〉ρ,所以公式(2)中ρ/ρ′→0,最后可得:

由公式(3)可知,膜厚d越小,即越接近氧化层厚度m时,m对R的影响越大;相反的,膜厚d越大,R受m影响越小,当d〉〉m时氧化层的影响几乎可以忽略不计。由此可知,薄膜越厚,氧化对薄膜的电学性能影响越小,薄膜电阻越稳定。这就定性解释了表1中较厚的薄膜放置在空气中时电阻增加量相对较小的现象。
3 结论
本文采用直流磁控溅射法制备了可应用于光子计数成像探测系统中位敏阳极电荷感应层的Ge膜,对Ar气通入量这一重要工艺参数及薄膜性能进行了研究,结果表明:(1)随着Ar气通入量的增加,薄膜沉积速率先增大后减小,在Ar气通入量为15sccm时沉积速率出现了一个极大值6nm/min;(2)薄膜表面粗糙度及薄膜的电阻率均随工作气压的升高而逐渐增大,在Ar气通入量为10sccm时,电阻率为268.8Ω·cm,当Ar气通入量升高到22sccm时,所制备的薄膜电阻率为326.4Ω·cm。(4)薄膜越厚其在大气下的电阻相对越稳定。
[1]何玲平.极紫外光子计数探测器成像特性研究[D].北京:中国科学院研究生院博士学位论文,2010.
[2]卜绍芳,尼启良,何玲平,等.极紫外波段微通道板光子计数探测器[J].中国光学,2012,5(3):302-309.
[3]尼启良,何玲平,刘世界,等.使用感应电荷位敏阳极的极紫外单光子成像系统[J].光学精密工程,2010,18(12):2543-2548.
[4]李敏,范鲜红,尼启良,等.微通道板在12~40nm波段的量子效率测量[J].光学精密工程,2008,16(1):1-5.
[5]Jagutzki O,Lapington J S,Worth L B C,et al.Position sensitive anodes for MCP read-out using inducedchargemeasurement[J].NuclearInstruments and Methods in Physics Research Section A:Accelerators,Spectrometers,DetectorsandAssociated Equipment,2002,477(1):256-261.
[6]Barnstedt J,Grewing M.Development and characterisation of a visible light photon counting imaging detector system[J].Nuclear Instruments and MethodsinPhysicsResearchSectionA:Accelerators,Spectrometers,Detectors and Associated Equipment,2002,477(1):268-272.
[7]Martin C,Jelinsky P,Lampton M,et al.Wedge-and -strip anodes for centroid-finding position-sensitive photon and particle detectors[J].Review of Scientific Instruments,1981,52(7):1067-1074.
[8]赵菲菲,赵宝升,张兴华,等.Ge薄膜特性及其在光子计数成像系统中的应用[J].光学学报.2009,29(11):3236-3240.
[9]李云鹏,郑鑫,陈波,等.Ge薄膜性能及其在光子计数成像探测器中的应用[J].光学精密工程,2014,22(5):1143-1149.
[10]De Sande J C G,Afonso C N,Escudero J L,et al. Optical properties of laser-deposited a-Ge films:a comparisonwithsputteredande-beam-deposited films[J].Applied optics,1992,31(28):6133-6138.
[11]唐伟忠.薄膜材料制备原理、技术及应用[M].北京:冶金工业出版社,2008:47-68.
[12]李云鹏.空间环境Mo/Si多层膜与Ge膜稳定性研究[D].北京:中国科学院研究生院博士学位论文,2015.
[13]Henrich V E,Fan J C C.Auger spectroscopy studies of the oxidation of amorphous and crystallinegermanium[J].JournalofAppliedPhysics,1975,46(3):1206-1213.
Study of the Characterization of Germanium Films as
the Charge Induce Layer in Photon Counting Imaging Detector
ZHENG Xin1,CHEN Bo1,WANG Xiaodong1,ZHANG Hongji1,LI Yunpeng2,YU Zaichao3(1.Changchun Institute of Optics,Fine mechanics and Physics,Chinese Academy of Sciences,Changchun 130033;
2.National Police University of China,Shenyang 110854;
3.Changchun Special Equipment Inspection and Research Institute,Changchun 130000)
In order to investigate the preparation process of the charge induce layer of Ge film in the photon counting imaging detector and improve the imaging stability of the photon counting imaging system,Ge films were deposited on the fused silica substrates with direct current magnetron sputtering method.The influences of the inlet argon flux on the deposition rate were analyzed.Then the surface roughness and the electric properties of the Ge films were measured by surface profiler and four-point probe surface resistance tester respectively.The results show that the deposition rate of the Ge film increases with the argon flux and achieves a maximum rate at inlet content of 15sccm,and then the deposition rate begins to decrease with further increment of the argon flux;that both the roughness and film resistivity of the Ge films increase with the argon flux;and that the thicker the film,the smaller the influence of oxidation on film resistivity and more stable of the electric property.
Ge film;direct current magnetron sputtering;argon flux;deposition rate;electric property
O484.4
A
1672-9870(2016)04-0038-04
2016-03-27
国家自然科学基金(U1531106)
郑鑫(1986-),女,硕士,研究实习员,E-mail:zhengx@ciomp.ac.cn
