4H-SiC基超结器件各向异性的TCAD建模分析*
2016-08-18陆秋俊王中健
陆秋俊,王中健
(1.无锡职业技术学院,江苏无锡214121;2.中国科学院上海微系统与信息技术研究所,上海200050)
4H-SiC基超结器件各向异性的TCAD建模分析*
陆秋俊1*,王中健2
(1.无锡职业技术学院,江苏无锡214121;2.中国科学院上海微系统与信息技术研究所,上海200050)
基于文献报道的4H-SiC材料的各向异性物理特性,首次提出4H-SiC基超结器件的各向异性物理模型,并对不同晶向的碰撞电离分别进行考虑。基于该模型,我们对(0001)和(112-0)两种晶向晶圆的4H-SiC超结器件的电学特性进行了研究。与(11-20)晶圆相比,(0001)晶圆的碰撞电离系数较小,可以实现更高的击穿电压VB。由于碰撞电离各向异性,与传统4H-SiC基器件相比,超结器件的二维电场分布可以将(11-20)晶圆器件的击穿电压VB从(0001)晶圆器件的60%提高到72%。
功率器件;超结;4H-SiC;各向异性碰撞电离系数;击穿电压(VB).
当前硅基功率器件的设计已经达到了硅材料的极限[1]。与硅相比,在功率器件领域SiC材料具有更优秀的电学特性[2-3],其临界击穿电场比硅高10倍,热导率比硅高3倍,载流子的饱和迁移速率比硅高2倍[4]。由于这些特性,SiC材料是未来高功率MOSFETs的发展方向及选择之一[5]。在SiC的多型体中[6],其中一些结构如3C-SiC,4H-SiC,6HSiC已经开始在电子器件领域商用。表1对这3种SiC多型体的特性进行了比较。其中,4H-SiC具有更大的禁带宽度,更高的电子/空穴迁移率比(μn/ μp),以及较低的电场各向异性,因此得到更广泛的应用。
本文利用TCAD软件分析并设计了基于4H-SiC材料的超结垂直双扩散 MOSFET(VDMOS)。由于4H-SiC材料为六方晶格结构,不同晶向下的物理特性也不相同。基于文献[8,13-14]中报道的实验结果,我们在物理模型中考虑了4H-SiC材料的各向异性,如各向异性碰撞离化系数(IIC),晶圆晶向等。通过对(0001)和(1120)两种晶向晶圆4H-SiC基超结器件漂移区的主要电学特性如击穿电压(VB),电场分布(E),电子-空穴迁移率,以及碰撞电离等进行分析,我们说明了碰撞电离各向异性等对器件性能的影响。
本文在第1节中简要介绍了SiC材料的物理特性及优势,接着介绍了SiC材料的六方晶格结构及SiC超结器件在不同晶向晶圆中漂移区的示意图。在第3节中讨论了SiC超结器件的各向异性物理模型,电场公式及漂移区的导通电阻。第4节对结果进行了讨论,并在第5节中给出结论。本文中所使用的参数及符号分别在表1~表3中给出。
项目来源:江苏省科技厅前瞻性研究项目(BY2014024)
收稿日期:2015-07-24修改日期:2015-08-23

表1 SiC多型体的电学特性
1 4 H-SiC晶格及超结器件漂移区结构
如图1所示,4H-SiC晶体为六方晶格结构。图1中所示元胞有4个轴,其中3个为a轴(a1,a2,a3),相邻轴之间的夹角为120度。a1轴的晶向用米勒指数<112-0>表示。第 4轴为c轴,晶向表示为<0001>,与所有a轴垂直。与a轴和c轴垂直的晶面分别为a晶面和c晶面。

图1 4H-SiC材料的六方晶格结构
图2为超结器件漂移区在4H-SiC材料2种不同晶向晶圆(0001)和(110)上的截面示意图。其中,Wn和Wp分别表示n型及p型柱区的宽度,Na和Nd分别为受主和施主掺杂浓度,tepi为外延层厚度。Cp表示单元间距,等于Wn+Wp。Ex和Ey分别表示横向和纵向电场,某点的实际电场强度E可以表示为E2x+ E2y,在击穿电压条件下E达到临界电场强度(Ec)。从图2可以看出对(0001)晶向晶圆,Ey平行于<0001>晶向,而对(11-20)晶面晶圆,Ey平行于<112-0>晶向。

图2 (a)4H-SiC超结器件漂移区单元(.b)(00 01)晶圆器件电场与晶向关系:Ey平行于<0001>晶向(.c)(110)晶圆器件电场与晶向关系:Ey平行于<11-20>晶向.
2 4 H-SiC基超结器件的各向异性物理模型
2.1碰撞电离系数(IIC)
在高电场的作用下,自由载流子可以获得足够的能量发生碰撞电离,引起雪崩击穿,从而导致失效。因此在设计功率MOSFETs时,需要考虑碰撞电离。碰撞电离产生率表示为[15][16]:


文献[7,17-18]对碰撞电离系数进行了测量,然而测得的结果并不相同。文献[15]利用雪崩二极管(APD)对报道的碰撞电离系数进行了比较,实验结果与文献[13-14,19]中给出的碰撞电离系数更为一致。此外,实验发现当电场垂直于c轴时器件的击穿电压要低于电场平行于c轴时。考虑到这一特性,文献[8]利用p+n二极管对不同晶向下的碰撞电离系数进行了研究。E∥平行于<0001>晶向及E⊥平行于<112-0>晶向时的碰撞电离系数分别表示为:

其中,α=(αe,αh),a=(ae,ah),b=(be,bh),以及 E=。ae,be为与电子碰撞电离率相关的拟合系数,ah,bh为空穴电离率的拟合系数。表2列出了不同晶向下这些拟合系数的解析值[8,13-14]。利用这些参数拟合出不同晶向的碰撞电离系数αe,αh,如图3所示。
碰撞电离是分析器件击穿电压的重要参数,不同晶向(<0001>和<112-0>)下的雪崩倍增因子表示为[7]:


表2 各向异性4H-SiC材料碰撞电离系数的拟合参数[8,13-14]
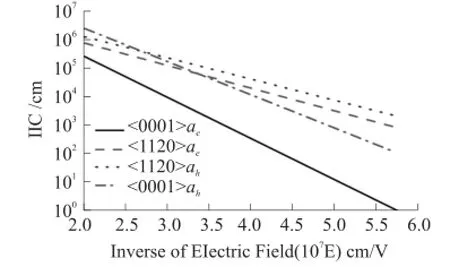
图3 4H-SiC材料不同晶向方向碰撞电离系数(IIC)的数值计算结果
其中w为耗尽区宽度,x为耗尽区的起点坐标。在公式中,我们使用了平均离化率(αn=αp).。当离化率积分等于1时,器件击穿,因此等式(6)简化为[20]:

2.2迁移率模型
晶格散射,离化杂质散射和压电散射是SiC在低场中限制载流子平均自由程的主要机制。在低电场下,载流子速度随着电场线性增加。广泛使用的低电场下的载流子迁移率模型是 Caughey-Thomas模型[20]。载流子迁移率与掺杂浓度之间的关系表示为:

其中N为总的掺杂浓度,μmin,μmax,Nre f及αa为拟合参数。
拟合参数与温度的关系可表示为:

其中,T为温度,FP为式(8)中的拟合参数μmin,μmax,Nref,αa,FP0为 300 K条件下 FP的值。表 3为(110)晶向下载流子迁移率模型的拟合参数。而(0001)晶向下的迁移率通过关系 μe,⊥=0.83μe,∥及μh,⊥=1.15μh,∥[8]得到。
2.34H-SiC超结器件不同晶向的电场模型
根据文献[1,21]中对4H-SiC材料不同晶向物理特性的研究,我们对基于4H-SiC的超结器件不同晶向下的电场模型进行了修正。我们沿如图2所示的截线X-X′及Y-Y′对平衡对称SiC超结器件的二维电场(Ex,Ey)进行分析。当器件处于关断状态时,
表3 <110>晶向方向上的低场迁移率模型参数[8]

表3 <110>晶向方向上的低场迁移率模型参数[8]
Holes 0 -0.57 113.5 -2.6 2.40×10182.9 0.69 -0.2 FP0and γ for respective FP μmin/(cm2/V/s)γmin μmax/(cm2/V/s)γmax Nref/cm-3γref αa γa Electrons 5 -0.57 1010 -2.6 1.25×10172.4 0.65 -0.146
在n型和p型柱区之间形成一个横向耗尽区,同时在p+/n-柱区,以及n+/p-柱区之间形成两个突变的垂直结。随着漏极电压上升,横向和纵向pn结耗尽区宽度逐渐增加。超结结构通常具有较高的高宽比tepi>>Cp,因此在较低的漏极偏压下,横向n/p柱区发生完全耗尽,而垂直方向完全耗尽需要较高的漏极偏压。因此在超结器件中,横向pn结的击穿电压较低。为实现较高的击穿电压,需要对横向电场进行重点考虑。对六方晶格4H-SiC结构,修正后二维电场分布可用泊松方程表示:

其中∥和⊥分别表示为平行和垂直于c轴,Ex与Ey相互垂直。当p/n柱区在横向和纵向完全耗尽后,进一步增加漏极偏压并不会改变超结器件漂移区结构中的电荷分布。横向和纵向电场分布又可以表示为Ex(⊥,∥)=-∂Ψ/∂x及Ey(∥,⊥)=-∂Ψ/∂y。方程的解析解[28]:

其中式(12)定义的Ey0(||,⊥)沿x方向周期性变化,同时关于y轴反对称,并与掺杂水平及结构尺寸相关。式(12)右边第二项E0(||,⊥)表示为:

由击穿电压VB决定,与掺杂浓度及位置无关。如图 2所示超结器件的漂移区,Ex(⊥,||)=(Ex(⊥),Ex(||))及Ey(⊥,||)=(Ey(||),Ey(⊥)),其中∥和⊥分别表示为平行和垂直于c轴。对于关断状态,超结器件可以承受最大击穿电压VB。此时,Ex(⊥,||)(x=0,y=tepi)=(Ex(⊥),Ex(||))=0,Ey0(||,⊥)(x=0,y=tepi)= E0(||,⊥)。沿截线Y-Y′方向的最大电场Ey,max(||,⊥)等于临界击穿电场Ec,等于在位置(x=0, y=tep)i有:

2.4RonA优化
SiC超结器件在漂移区中加入柱区的主要作用为提高击穿电压,此时n型柱区和p型柱区恰好完全耗尽,从而形成理想的“平顶”电场分布和均匀的电势分布,这个条件被称为电荷平衡条件[1]。超结器件的比导通电阻通常定义为当栅极偏压VGS>Vth器件导通时,源漏电极之间沿电流路径方向单位面积的电阻。从图2所示的元胞结构可得到4H-SiC结构的比导通电阻RonA。对于电子单极型器件,电流只在n型柱区的非耗尽区内流过。当采用欧姆接触电极取代Na+区域,RonA可以表示为:

为实现最大电压,N型柱区和P型柱区的宽度相同,此时
电子在不同方向上的低场体迁移率(cm2/Vs)可以表示为[8]:

其中,μn(∥)和μn(⊥)分别为平行和垂直于c轴方向的电子迁移率。迁移率的各向异性主要是由不同方向上电子的有效质量不同导致的。式(16)为RonA的简化公式,可以看出RonA与掺杂浓度和外延层厚度tepi有关。不同几何尺寸下RonA和VB与掺杂浓度之间的关系如图4所示。随着外延层掺杂浓度的增加,超结扩散区的串联电阻逐渐降低,VB也随之降低。与Si基超结扩散区结构相比,可以在SiC基器件中使用更高的掺杂浓度,从而降低SiC超结器件的RonA。

图4 在不同外延层厚度下,不同晶向晶圆,RonA,VB关于掺杂浓度的关系
3 结果及讨论
在4H-SiC晶圆中,不同晶向的碰撞电离系数也不相同。这主要是由4H-SiC的六方晶格结构导致不同方向上的原子束缚不同引起的。因此在对SiC基超结器件仿真时需要对其各向异性进行考虑。表2中是两种晶向碰撞离化系数的拟合参数,表3中分别是低场条件下的迁移率参数及高场条件下的饱和速度参数[22]。从图3可以发现<1 12-0>晶向下的碰撞电离系数大于<0 001>晶向。
3.1不同晶向碰撞电离系数对4H-SiC超结器件的影响
本节,我们对基于(0001)和两种晶圆的超结器件的仿真结果进行比较,从而分析不同晶向下碰撞离化系数对4H-SiC超结器件漂移区电学特性的影响。在仿真中,除了晶圆晶向,器件的结构,尺寸和掺杂浓度完全相同。图5(a)为超结器件击穿电压(VB)和柱区掺杂(Np)之间的关系,结果显示(1120)晶向器件的击穿电压小于(0001)晶向。当掺杂浓度高于3×1016/cm3时,两种晶向器件的击穿电压开始降低,其击穿电压的差别也逐渐减小。当掺杂浓度高于1×1017/cm3时,两种晶向器件的击穿电压几乎相同,此时器件的击穿电压也很小。当柱区掺杂浓度Np为1×1016/cm3时,(0001)晶向器件的击穿电压为4 260 V,(1120)晶向器件的击穿电压为3 100 V,只有(0001)晶向器件的72%。文献[13]报道了基于4H-SiC晶圆制造的p+n二极管,实验结果显示(1120)晶向器件的击穿电压只有(0001)晶向器件的50%~60%。主要原因在于在p+n二极管中,电场主要为一维方向,而在超结器件中,电场为二维电场,因此使用超结器件结构可以降低(1120)晶圆较高的碰撞电离系数对器件性能的影响。
图5(b)所示为击穿电压条件下Ex沿截线X-X′的仿真结果。除了晶圆晶向外,器件结构,尺寸和掺杂浓度完全相同。Ex的最大值为 3.65×105V/cm。图5(c)所示为击穿电压条件下Ey沿截线Y-Y′的仿真结果,对(0001)晶向器件,Ey,max为2.4×106V/cm,对(1120)晶向器件,Ey,max为1.8×106V/cm,其中在(0001)晶向和(1120)晶向器件上施加的击穿电压分别为4 250 V和3 100 V。图5(d)为在Y-Y′截线上电子和空穴沿Y方向的碰撞电离系数αe和αh。我们可以发现对于(1120)晶向,αe远高于(0001)晶向,而αh则低于(0001)晶向。因此,(1120)晶向器件在较低的电压下发生雪崩击穿。为更进一步对4H-SiC超结器件的各向异性进行分析,我们采用表2中的拟合参数对电场对碰撞电离系数αe,αh影响进行了计算,结果如图5(e)所示。从图5可以看到(1120)晶圆的碰撞电离系数已经初步达到引起击穿的水平。碰撞电离系数的计算结果与图3所示的数值结果吻合,从而验证了我们的结果。
图5(f)为基于两种晶圆的超结扩散区关态漏电流与漏极电压之间的关系。其中漏极电压从0 V上升到击穿电压。开始阶段,关态电流在1×10-18A/mm量级,与制造的高压4H-SiC肖特基二极管的漏电流接近[31]。在击穿电压条件下,电场EF等于EFc,漏电流迅速增加,主要由于碰撞电离在耗尽区产生大量载流子导致。
从上面的分析和计算可以看出(0001)晶向4H-SiC晶圆的各向异性弱于(1120)晶圆,可以实现更高的击穿电压。
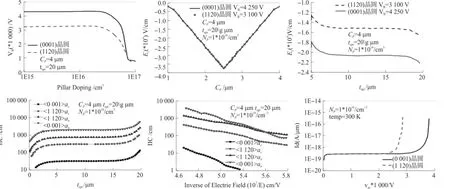
图5 基于(00 01)和(11 2-0)两种晶圆4H-SiC超结器件电学特性比较:(a)VB与Np的关系;(b)Ex与Cp的关系;(c)Ey与Cp的关系;(d)IIC(αe,αh)与tepi的关系;(e)采用TCAD软件计算电场对IIC(αe,αh)的影响;(f)关断状态漏电流Id与漏源电压Vds之间的关系。
3.2各种尺寸下柱区掺杂对击穿电压的影响
我们对4H-SiC基超结器件击穿电压VB与参杂浓度Np之间的关系进行了仿真,结果如图6(a)~6(c)所示。同时我们也对(0001)和(1120)两种晶圆对器件的影响进行了比较。结果显示,当我们增加柱区掺杂浓度时,器件的VB逐渐下降。同时,可以发现当我们增加Cp的宽度时,优化的柱区掺杂浓度随之降低。此外,VB随外延层tepi厚度的增加而增加。对于基于(1120)晶圆的器件,其BV低于基于(0001)晶圆的器件,表明(0001)晶圆的各向异性弱于(1120)晶圆,因此需要更高的电场引起碰撞电离从而发生雪崩击穿。

图6 基于(00 01)和(110)两种晶圆4H-SiC基超结器件VB与Np的关系
4 结论
本文提出了4H-SiC基超结器件的各向异性物理模型,并对不同晶向下各向异性碰撞电离系数对4H-SiC基超结器件电学特性的影响进行了分析。与<110>晶向相比,<0001>晶向的碰撞电离系数较小,可以实现更高的击穿电压。传统4H-SiC基器件,(110)晶圆器件的击穿电压只有(0001)晶圆器件的50%~60%。由于碰撞电离系数的各向异性,超结器件的二维电场分布可以改善(110)晶圆器件的性能,击穿电压达到(0001)晶圆器件的72%。
[1] Fujihira T.Theory of Semiconductor Superjunctiondevices[J]. Jpn J Appl Phys,1997,36(10):6254-6262.
[2] GU C,LIU S,MA R,et al.Investigation on VRSM Characteristics of 4H-SiC Junction Barrier Schottky Diode[J].Chinese Journal of Electron Devices,2015,38(4):725-729
[3] Maboudianr,Carraro C,Senesky D G,et al.Advances in Silicon Carbide Science and Technology at Themicro-and Nanoscales[J]. J Vac Sci Technol A,2013,31(5):050-805.
[4] Neudeck P G.The VLSI Handbook[M].NASA Glenn Research Center,CRC Press LLC,2006:5-1.
[5] Wang Z,Shi X,Xue Y,et al.Design and Performance Evaluation of Over Current Protection Schemes for Silicon Carbide(SiC)Power Mosfets[J].IEEE Trans.Ind.Electron,2014,61(10):5570-5581.
[6] Choi H.Overview of Silicon Carbide Power Devices[R].Fairchild Semiconductor.
[7] Konstantinov A,Wahab Q,Nordell N,et al.Ionization Rates and Critical Fields in 4h silicon Carbide[J].Appl Phys Lett,1997,71 (1):90-92.
[8] Hatakeyama T,Fukuda K,Okumura H.Physical Models For Sic and Their Application to Device Simulations of 4H-SiC Insulatedgate Bipolar Transistors[J].IEEE Trans Electron Devices,2013,60(2):613-621.
[9] Patrick L,Choyke W J.Static Dielectric Constant of Sic[J].Phys Rev B,1970,2:2255-2256.
[10]Chow T P.High Voltage Sic Power Devices[C]//High-Temp.Electronics in Europe,2000:99.
[11]Weitzelc,Palmour J,Carter J,et al.Silicon Carbidehigh-Power Devices[J].IEEE Trans.Electron Devices,1996,43(10):1732-1741.
[12]Bhatnagar M,Baliga B J.Comparison of 6H-SiC,3C-SiC,and Si for Power Devices[J].IEEE Trans.Electron Devices,1993,40 (3):645-655.
[13]Hatakeyama T,Watanabe T,Shinohe T,et al.Impact Ionization Coefficients of 4h-Silicon-Carbide[J].Appl Phys Lett,2004,85 (8):1380-1382.
[14]Hatakeyama T,Nishio J,Ota C,et al.Physical Modeling and Scaling Properties of 4h-sic Power Devices[C]//SISPAD,2005:171-174.
[15]Akturk A,Goldsman N,Aslam S,el al.Comparison of 4h-sic Impact Ionization Models Usingexperiments and Self-Consistent Simulations[J].J Appl Phys,2008,104(2):026101-026101-3.
[16]Salemi S,Goldsman N,Ettisserry D P,et al.The Effect of Defects and Their Passivation on Thedensity of States of the 4h-Silicon-Carbide/Silicon-Dioxide Interface[J].J Appl Phys,2013,113 (5):053-703.
[17]Ng B,David J,Tozer R,et al.Nonlocal Effects in Thin 4h-SiC Uv Avalanchephotodiodes[J].IEEE Trans Electron Devices,2003,50(8):1724-1732.
[18]Raghunathan R,Baliga B.Measurement of Rlectron and Hole Impact Ionization Coefficients for Sic[C]//ISPSD,1997:173-176.
[19]Nakamura S,Kumagai H,Kimoto T,et al.Anisotropy in Breakdown Field of 4h-SiC[J].Appl Phys Lett,2002,80(18):3355-3357.
[20]Fulop W.Calculation of Avalanche Breakdown Voltages of Silicon P-N Junctions[J].Solid-State Electronics,1967,10(1):39-43.
[21]Yu L,Sheng K.Modeling and Optimal Device Design for 4h-SiC Super-Junction Devices[J].IEEE Trans.Electron Devices,2008,55(8):1961-1969.
[22]Khan I,Cooperr J.Measurement of High-Field Electron Transport in Silicon Carbide[J].IEEE Trans Electron Devices,2000,47 (2):269-273..

陆秋俊(1969-),男,汉族,江苏无锡人,无锡职业技术学院,电气工程师,主要从事计算机应用技术与电气技术的教学和科研,luqj@wxit.edu.cn;

王中健(1981-),男,汉族,四川夹江人,中国科学院上海微系统与信息技术研究所,助理研究员,目前主要从事半导体器件仿真设计与制程开发,wangzj@mail. sim.ac.cn。
TCAD Modeling of Anisotropy 4H-SiC Superjunction Devices*
LU Qiujun1*,WANG Zhongjian2
(1.Wuxi Institute of Technology,Wuxi Jiangsu 214121,China;2.Shanghai Institute of Microsystem And Information Technology,Chinese Academy of Sciences,Shanghai 200050,China)
Based on reported experimental physical properties of anisotropic 4H-SiC,physical models of anisotropic 4H-Silicon carbide(4H-SiC)have been proposed first time for superjunction(SJ)devices.Anisotropic impact ionization is also considered in this model.Using proposed model,we investigated the electrical properties of anisotropic 4H-SiC SJ devices with respect to wafer orientation(0001)and(1120).Compared to the conventional anisotropic 4H-SiC devices,the breakdown voltage(VB)of(1120)SJ devices is increased to72%of(0001)wafer devices from 60%due to the bidirectional electric field profile.
power device;superjunction(SJ);4H-SiC;anisotropic impact ionization coefficient(IIC);Breakdown Voltage(VB)
TN386.1
A
1005-9490(2016)03-0505-07
EEACC:256010.3969/j.issn.1005-9490.2016.03.002
