商用0.18 μm CMOS工艺抗总剂量辐射性能研究
2016-05-19寇春梅谢儒彬洪根深吴建伟
寇春梅,谢儒彬,洪根深,吴建伟
(中国电子科技集团公司第58研究所,江苏无锡214035 )
商用0.18 μm CMOS工艺抗总剂量辐射性能研究
寇春梅,谢儒彬,洪根深,吴建伟
(中国电子科技集团公司第58研究所,江苏无锡214035 )
摘要:对国内标准商用0.18 μm工艺MOSFET和电路进行总剂量效应研究。其STI隔离区域二氧化硅在总剂量达到50k rad(Si)时,端口3.3 V NMOS晶体管漏电达到了10(-9)A级,达到100k rad(Si)以上时,内核1.8 V NMOS晶体管出现场区漏电。通过电路总剂量辐照试验,表明NMOS晶体管是薄弱点。需要开发STI场区总剂量加固技术,以满足抗辐射电路研制要求。
关键词:商用工艺;总剂量;辐射;MOSFET
1 引言
随着电子元器件在空间环境中的应用日益增多,辐射环境下电路的失效问题也越来越受到关注,空间辐射在体硅CMOS器件中引起总剂量辐射效应(Total Ionizing Dose effects,TID),造成了元器件的电学性能退化。总剂量辐射效应是一个长期导致失效的过程,其影响主要是由于在SiO2中产生氧化陷阱电荷,同时在Si/SiO2界面形成界面态造成的[1]。
2 现状
20世纪80年代以来,国外对于大尺寸以及超深亚微米工艺制造的MOS器件的总剂量辐射效应进行了充分的研究[2~4],形成抗辐射1.0 μm~90 nm体硅及SOI CMOS工艺技术,抗总剂量水平达到1M rad(Si)以上。国内建立了抗辐射1.0 μm~0.35 μm体硅及SOI工艺技术,抗总剂量水平为100k rad(Si),存在较大差距。
3 近期进展
近年来,商用微电子芯片的总剂量辐射加固技术得到了飞速的发展,部分器件总剂量的失效水平由几十krad(SiO2)增长到200 krad(SiO2),如图1所示为商用CMOS工艺随着器件特征尺寸的减小,总剂量加固能力的比较[5]。

图1 CMOS工艺总剂量水平随特征尺寸减小的发展趋势
中国科学院上海微系统与信息技术研究所与中国科学院特殊环境功能材料与器件重点实验室分别研究了国产标准商用0.18 μm工艺宽沟[6]与窄沟[7]MOSFET抗总剂量辐射能力,宽沟器件宽长比为W/L= 10 μm/0.18 μm,窄沟器件宽长比为W/L=0.22 μm/ 20 μm,栅氧化层厚度为3~4 nm,隔离层采用浅沟槽隔离,厚度约为390 nm,工作电压为1.8 V。辐照偏置条件主要选取ON偏置,即栅压为1.8 V,漏极、源极和衬底接地。器件辐照实验用中国科学院新疆理化技术研究所60Coγ射线。
图2为MOSFET在不同总剂量下电流电压特性曲线。从图中可以看出,随着总剂量的增加,器件漏电流增加。在剂量为100 krad(Si)时,宽沟器件(W/L= 10μm/0.18μm)曲线变化很小,说明该器件在100 krad (Si)仍能保持很好的电学特性,器件能承受的总剂量在100 krad(Si)以上;而窄沟器件(W/L=0.22 μm/20 μm)漏电流明显增大,增幅达4个数量级。之后宽沟器件漏电流变化较为明显,而窄沟器件趋势逐渐变缓。当总剂量达到500 krad(Si)时,宽沟与窄沟器件的漏电流均达到10-7A。在该剂量下,器件无法正常关断,将导致功能失效,静态功耗增加。

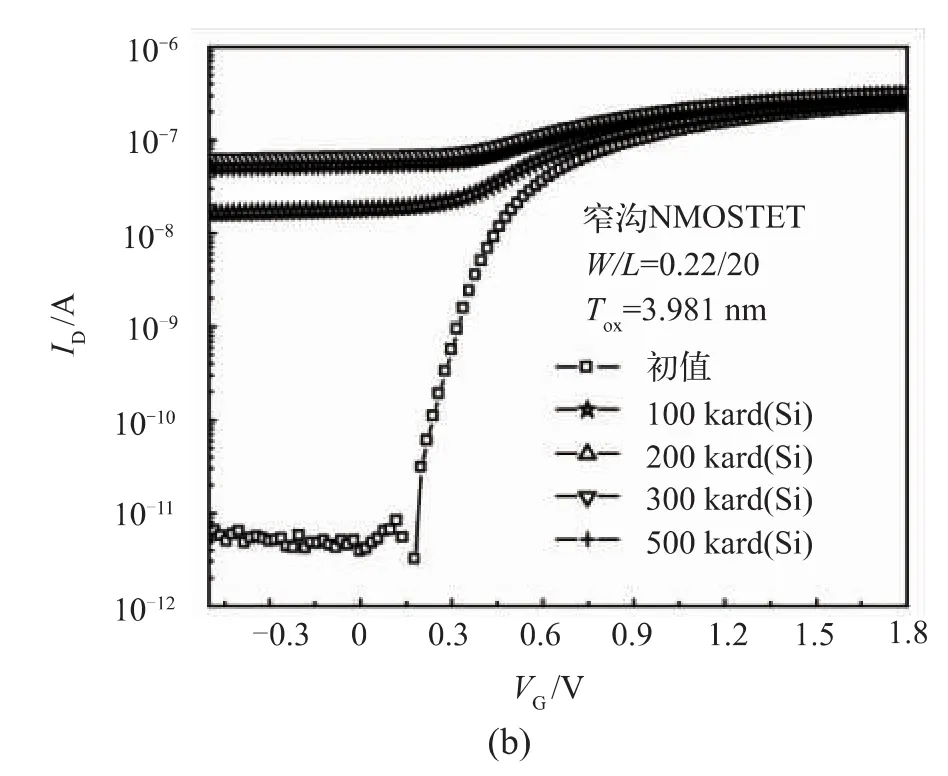
图2 MOSFET辐射前后电流-电压曲线
提取MOSFET不同总剂量下的阈值电压,如图3所示。从图上可以看出,宽沟器件的阈值电压几乎不随总剂量变化,说明0.18 μm工艺MOSFET栅氧化层对总剂量不敏感;而窄沟器件由于辐射感生反窄沟道效应,阈值电压出现变小的趋势。

图3 MOSFET阈值电压随总剂量变化曲线
4 实验
中国电子科技集团公司第58研究所对采用国内商用0.18 μm工艺的3.3 V NMOS、PMOS单管器件进行辐照试验,NMOS器件宽长比为W/L=10 μm/ 0.35 μm,PMOS器件宽长比为W/L=10 μm/0.3 μm,辐照偏置为ON偏置,栅极电压为3.6 V(1.1 Vdd),漏极、源极和衬底接地。器件辐照实验用中科院上海应用物理研究所60Coγ射线。试验结果见表1。

表1 国内商用0.18 μm工艺
根据辐照试验结果可以看出,NMOS管在辐照后关态漏电流变大,主要原因可能是STI场区隔离形成正电荷积累,导致STI场区与源漏接触部分在辐照后发生反型,造成源漏漏电。同时可以看出,PMOS管在辐照后Idsat没有发生明显的下降,说明SPACER区域的抗辐射性能能够满足要求。
同时中国电子科技集团公司第58研究所也对采用国内标准商用0.18 μm工艺的3.3 V NMOS、1.8 V NMOS单管器件进行辐照试验,3.3 V NMOS器件宽长比为W/L=10 μm/0.35 μm,1.8 V NMOS器件宽长比为W/L=10 μm/0.18 μm,辐照偏置为ON偏置,栅极电压为3.6 V/2 V(1.1 Vdd),漏极、源极和衬底接地。器件辐照实验用中科院上海应用物理研究所60Coγ射线。实验器件典型转移特性曲线随总剂量变化关系如图4所示。


图4 实验器件典型转移特性曲线随总剂量变化关系
如图4所示,3.3 V NMOS晶体管,其在50 krad (Si)剂量点时关态漏电流已经达到了10-9量级,当总剂量累积到500 krad(Si)时,其关态漏电流已经明显增加,达到了10-5量级;1.8 V NMOS晶体管在100 krad (Si)剂量点时漏电流都没有发生明显变化,当总剂量累积到500 krad(Si)时,其关态漏电流达到了10-6量级。以上结论与其他单位研究所得结论相一致,其结果代表了标准商用0.18 μm工艺器件的抗总剂量辐射能力。
对标准商用0.18 μm工艺电路进行了电离总剂量辐照试验,Vdd1表示3.3 V电源,Vdd2表示1.8 V电源,其辐照情况见表2。

表2 国内商用0.18 μm工艺电路总剂量静态电流随总剂量变化表50 rad(Si)/s静态偏置100 k

50 rad(Si)/s静态偏置150 k后100℃,168 h退火
从上述结果可以看出,剂量率为50 rad(Si)/s的情况下,100 krad(Si)辐照后静态电流发生明显增大的现象,超过了规范要求,如图5所示的EMMI测试发现漏电在NMOS晶体管处。增加50%总剂量辐照后,进行100℃168 h退火,其退火后电路静态电流下降到正常水平,说明该工艺无法确保电路在高剂量率辐射情况下的抗总剂量辐射性能。

图5 商用电路总剂量辐照后EMMI测试图
5 讨论
对于MOS集成电路,特别是大规模、超大规模集成电路,MOSFET间的隔离通常靠高阈值的场区,其氧化层较厚。但是在电离辐射环境下,辐射损伤与SiO2层的厚度成正比,因此场氧化层在经过电离辐射后,将产生更多的正电荷积累。随着器件特征尺寸的减小,STI隔离已经逐步替代了LOCOS隔离,然而总剂量辐射损伤导致的STI隔离失效依然存在,如图6所示。
STI侧壁SiO2与Si界面处的正电荷积累将会导致STI/衬底界面处的P型硅发生反型,从而形成漏电通道。根据图7所示,在STI隔离结构中,至少存在3条漏电通道,图7(a)是单个器件侧墙的漏电通道,它将导致亚阈区漏电电流的增加;图7(b)是NMOS的源/漏区通过STI隔离与另一个NMOS漏/源区的泄漏电流;图7(c)是NMOS的源/漏区与N阱之间通过STI隔离形成漏电流。

图6 STI隔离总剂量损伤示意图
6 结论
目前国内标准0.18 μm工艺的MOSFET晶体管栅氧化层对总剂量辐射效应不敏感,STI场区抗总剂量能力非常薄弱,3.3 V的端口器件更是如此,器件失效的主要原因来源于STI场区边缘漏电。电路总剂量辐照实验结果也表现出3.3 V端口电源静态电流显著增加,因此,研制满足100 krad(Si)的抗辐射电路,需要开发STI场区总剂量加固技术。
参考文献:
[1] Schwank J R, Shaneyfelt M R, Fleetwood D M, Felix J A, Dodd P E, Paillet P, Ferlet-Cavrois V. Radiation Effects in Mos Oxides [J]. IEEE Trans.on Nuclear Science, 2008, 55 (4):1833-1853.
[2]何宝平,陈伟,王桂珍. CMOS器件60Coγ射线、电子和质子电离辐射损伤比较[J].物理学报,2006,55 (7): 3546-3551.
[3]李冬梅,王志华,皇甫丽英,勾秋静,雷有华,李国林. NMOS晶体管高剂量率下总剂量辐照特性研究[J].电子器件,2007,30(3):748-751.
[4] Schwank J R, Winokur P S, McWhorter P J, Sexton F W, Dressendorfer P V, Turpin D C. Physical mechanisms contributing to device 'rebound' [J]. IEEE Trans on Nuclear Science,1984,31: 1434-1438.
[5] P E Dodd, M R Shaneyfelt, J R Schwank, et al. Future Changes in radiation Effects [C]. 10th European Conference on radiation Effects on Components and Systems, 2009.
[6]刘张李,胡志远,张正选,邵华,宁冰旭,毕大炜,陈明,邹世昌. 0.18 μm MOSFET器件的总剂量辐照效应[J].物理学报,ActaPhys Sin,2011,60(11).
[7]吴雪,陆妩,王信,席善斌,郭旗,李豫东. 0.18 μm窄沟NMOS晶体管总剂量效应研究[J].物理学报,ActaPhys Sin,2013,62(13).
寇春梅(1980—),女,河北衡水人,2002年毕业于四川大学微电子学专业,2011年北京大学软件工程硕士毕业,主要研究方向为微电子制造技术。

图7 STI隔离中漏电通道示意图
Study of Commercial 0.18μm CMOS Total Ionizing Dose Effects
KOU Chunmei, XIE Rubin, HONG Genshen, WU Jianwei
(China Electronics Technology Group Corporation No.58 Research Institute, Wuxi 214035,China)
Abstract:The paper focused on the total ionizing dose effects of commercial fabrication process MOSFETs and circuits. When irradiation runs up to 50k rad (Si) , The STI oxide traps a large number of positive charges. It leads IO NMOSFETs' leakage currents reach nanoamps. When irradiation runs up to 100k rad (Si), Core NMOSFETs leakage currents become obviously. The IO NMOSFETs are vulnerable. The STI oxide needs radiation hard to meet radiation-hardened circuits manufacture.
Keywords:commercial fabrication process; total ionizing dose; radiation; MOSFET
作者简介:
收稿日期:2015-11-7
中图分类号:TN406
文献标识码:A
文章编号:1681-1070(2016)04-0040-05
