铟凸点对倒装互连影响的研究
2016-03-15杨超伟闫常善王琼芳李京辉韩福忠封远庆杨毕春左大凡俞见云
杨超伟,闫常善,王琼芳,李京辉,韩福忠,封远庆,杨毕春,左大凡,赵 丽,俞见云
铟凸点对倒装互连影响的研究
杨超伟1,闫常善2,王琼芳1,李京辉1,韩福忠1,封远庆1,杨毕春1,左大凡1,赵 丽1,俞见云1
(1. 昆明物理研究所,云南 昆明 650223;2. 中国人民解放军驻298厂军代室,云南 昆明 650114)
制作了2种形式的铟凸点:即直接蒸发沉积的铟柱和将铟柱回流得到的铟球。分别讨论了铟柱和铟球对倒装互连的影响,着重讨论了铟球和铟柱分别和芯片倒装互连后的剪切强度,结果发现在互连未回流的状态下铟球的剪切强度是铟柱的1.5倍,回流后铟球的剪切强度是铟柱的2.8倍。此外,分析讨论了长时间放置在空气中的铟球对倒装互连的影响,结果发现长时间放置在空气中的铟球和芯片互连后,器件的电学与机械连通性能会受到很大的影响。
铟凸点;铟柱;铟球;倒装互连
0 引言
目前,红外焦平面探测器已经大量应用于军事、工业、环境、医学等方面[1-4],并且随着科技的进步,人们对大面阵探测器的需求正在不断增加[5]。然而,伴随着像元数目的增加,焦平面和读出电路的设计及互连的难度也在不断增大。传统金丝引线键合技术暴露出明显的缺点,例如:互连电阻高、电路过长、封装尺寸大及互连密度低等缺点。倒装互连技术[6]不仅能很好克服上述的缺点,而且其成本低廉,因此得到广泛的应用。
作为红外焦平面探测器的一种重要的材料,金属铟具有一些特殊的物理特性,例如:在液氦温区下,具有良好的延展性;常温下具有很好的柔软性,很容易实现键合。具有良好的机械和电气互连特性,特别适用于红外探测器低温工作要求。因此,对于红外探测器的倒装互连来说,铟凸点是至关重要的。
本文制作了2种形式的铟凸点:即直接蒸发沉积的铟柱和将铟柱回流得到的铟球。分别讨论了铟柱和铟球对倒装互连的影响,着重分析对比了铟球和铟柱分别和芯片倒装互连后的剪切强度。此外,分析讨论了长时间放置在空气中的铟球对倒装互连的影响。
1 实验
1.1 样品的制备
铟柱和铟球的制备过程如图1所示,依次为:光刻UBM孔,UBM沉积,光刻铟柱孔及热蒸发沉积铟,剥离得到铟柱,铟柱湿法回流成球[7]。
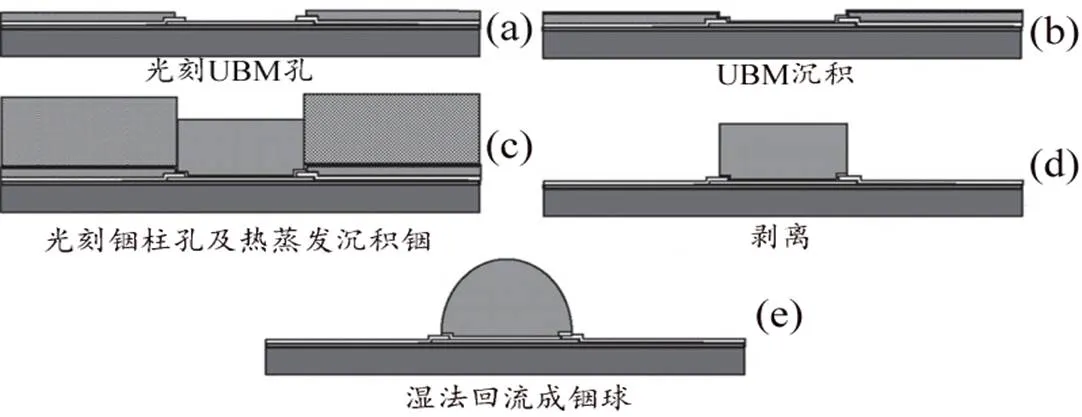
图1 铟球制备流程图
采用SET公司的FC150倒装焊机对芯片和铟凸点电路进行互连,互连后的样品利用回流炉进行了回流。此外,本文所涉及倒装互连均为单边混成技术,即芯片一侧没有铟,芯片上的金属电极为金属Au。
1.2 样品的形貌分析
采用日本的Olympus金相显微镜对样品进行了形貌分析。
1.3 样品的剪切强度的测试
采用Dage4000拉力测试仪对互连后的样品进行剪切强度的测试。
2 实验结果与讨论
2.1 铟柱与铟球对倒装互连的影响
图2所示的是铟柱与铟球的形貌图。图2(a)所示的是铟柱形貌图,从图中可以看到铟柱形状不规整,表面粗糙,凹凸不平。图2(b)和图2(c)所示的是不同放大倍数下的铟球形貌图,从图中可以看到铟球大小均一,表面清洁,光滑。

图2 铟柱与铟球的形貌图
铟球相比铟柱来说,对倒装互连的好处在于:1)由光刻直接形成的铟柱,不仅形状不规整,表面粗糙,凹凸不平,而且高度也会参差不齐。铟柱回流缩球后基本形成了一个个的球形,高低不同的铟柱缩为球形后,高度差变小,更利于互连焊接;2)由于在互连焊接工艺中,焊接铟柱时需要一定的压力,在探测器上可能造成机械损伤,所以在完成焊接任务的前提下,应尽量减小压力。球形的几何形状在焊接开始时接触面较小,并且回流缩球后表面更为清洁,铟更软,使用较小压力便可完成焊接;3)铟球相比铟柱的高度要高,铟凸点高度增加的作用在于:①铟凸点在受到热冲击时的抗疲劳寿命和铟凸点的高度成正相关,即铟凸点的高度越高其抗击热冲击的寿命就越长[8];②有助于减小对焊接中调平的要求;③提高铟柱的高度可以为芯片和读出电路互连后提供足够的间隙,从而有利于点胶时胶的流动,进而实现良好的灌胶封装。
此外,更为重要的是,铟球相比铟柱来说,倒装互连后铟球的剪切强度要高于铟柱的剪切强度,这样有助于增强器件的可靠性,下面就这种情况进行分析讨论。
表1所示的是铟柱和铟球分别和芯片互连后未回流的剪切强度。从表1中可以看到铟球的平均剪切强度是铟柱的1.5倍,铟球剪切强度的增强的原因[9]可以归结为铟球的晶粒取向的各向异性,而铟柱则表现为一定的择优取向。此外,我们还研究了铟柱和铟球分别和芯片互连后进行回流的情况,下面就这种情况进行分析和讨论。

表1 铟柱和铟球分别和芯片互连后未回流的剪切强度
图3(a)所示的未互连的芯片表面形貌图。图3(b)所示的是铟球和芯片互连分开后,芯片的表面形貌图,从图3(b)中可以看到芯片的接触压点上布满了铟的痕迹,而且铟层较厚,并且大部分的断面都不是接触压点处,也不是铟焊点的UBM处,而是铟焊点的内部,这说明焊接铟球焊点与芯片接触压点之间有较好的浸润性,这样就能够保证读出电路与芯片之间有较强的机械强度[10]。图3(c)所示的是铟柱和芯片互连后,芯片的表面形貌图,从图3(c)中可以看到芯片的接触压点上布满了铟的痕迹,但是和图3(b)中的铟层相比较薄。这也就表明铟柱焊点与芯片接触压点之间浸润性不太好,断面有可能发生在铟焊点的表面,铟柱和芯片之间互连的机械强度较弱。下面就铟柱和铟球互连回流后器件的剪切强度进行分析讨论。
表2所示的是铟柱和铟球分别和芯片互连回流后的剪切强度,从表2中可以看到铟球的平均剪切强度是铟柱的2.8倍,产生这种现象的原因,正如前面讨论的铟球和芯片接触压点有较好的浸润性,而铟柱和芯片接触压点之间的浸润性较差。对于铟球来说,由于在缩球的过程中能够很好除去铟表面的氧化物,因此,在互连后回流的过程中,温度在铟的熔点的附近时,芯片接触压点上的Au和In会生成金属间化合物[11-12],这样就能够保证铟凸点读出电路与芯片互连的电学与机械连通性能[10,12-14]。但是,通常铟柱表面会有一层氧化层[15],由于氧化层的存在阻挡了Au和In的浸润反应[14],最终导致铟柱和芯片之间互连的机械强度比较弱。
2.2 长时间放置在空气中的铟球对倒装互连的影响
图4(a)所示的是未进行互连的芯片的表面形貌图,图4(b)所示的是正常铟球(回流缩球后未长时间放置的铟球)和芯片互连回流后分开的芯片表面的形貌图。从图4(b)中可以看到芯片的接触压点上布满了铟的痕迹,而且铟层较厚,并且大部分的断面都不是接触压点处,也不是铟焊点的UBM处,而是铟焊点的内部,这说明铟球焊点与接触压点之间有较好的浸润性。正如前面所讨论的,在回流的过程中,芯片接触压点上的Au和In会生成金属间化合物,这样就能够保证铟凸点读出电路与芯片互连的电学与机械连通性能。

图3 芯片表面形貌图

表2 铟柱和铟球分别和芯片互连回流后的剪切强度

图4 芯片表面形貌图
图5所示的是未进行互连的芯片的表面形貌图,以及在空气中放置5个月的铟球和芯片互连回流后分开的芯片表面的形貌图。从图5(b)中可以看到芯片的接触压点上布满了铟的痕迹,但是和图4(b)中的铟层相比较薄。这也就表明铟球焊点与芯片接触压点之间浸润性不太好,断面有可能发生在铟焊点的表面,铟凸点和芯片之间互连的机械强度比较弱。下面就上述两种情况下的铟球分别和芯片互连回流后的剪切强度进行分析和讨论。
表3所示的是正常铟球和在空气中放置5月后的铟球分别和芯片互连回流后的剪切强度的大小。从表3中可以看到正常铟球的平均剪切强度是在空气中放置5个月后的铟球的2.4倍。产生这种现象的原因可能是由于铟球长时间暴露在空气中导致铟球表面形成了一层氧化层,由于氧化层的存在阻挡了铟球和芯片接触压点之间的浸润作用。
此外,有些接触压点上没有出现铟的痕迹,如图5(c)和图5(d)所示。产生这种现象的原因可能是有些铟球表面的氧化层较厚,严重影响铟球和芯片接触压点的浸润作用,即氧化层的存在阻挡了In和Au的浸润反应作用[14],最终造成In和Au无法实现键合作用,因此就导致了如图5(c)和图5(d)中所示的情况,芯片上有些接触压点上没有出现铟的痕迹,也就是说Au和In根本没有实现浸润键合作用,这样就直接导致铟球和芯片无法实现电学连通,最终导致器件盲元的产生,严重影响器件的性能[15]。
3 结论
本文讨论了铟球和铟柱对倒装互连的影响,结果表明铟球相比铟柱来说,不仅有助于倒装互连,而且可以大大提高互连后器件的可靠性。此外,分析讨论了长时间放置在空气中的铟球对倒装互连的影响,结果发现长时间放置在空气中的铟球和芯片互连后,器件的电学与机械连通性能会受到很大的影响,最终导致器件可靠性极大降低和器件盲元的产生。

图5 芯片表面形貌图。(a) 未进行互连的芯片的表面形貌图;(b),(c) 和(d)在空气中放置5个月的铟球和芯片互连回流后分开的芯片表面的形貌图

表3 正常铟球和在空气中放置5月后的铟球分别和芯片互连后的剪切强度
[1] Kukkonen C A, Gunapala S D, Bandara S V, et al. Commercialization of quantum well infrared photodetector QWIP focal plane arrays[C]//, 1999, 3698: 706-714.
[2] Schneider H, Walther M, C Sch€ onbein, et al. QWIP FPAs for high-performance thermal imaging[J]., 2000,7: 101-107.
[3] Gunapala S D, Bandara S V, Singh A, et al. 8 to 9mm and 14 to 15mm two-color 640×486 GaAs/AlGaAs quantum well infrared photodetector (QWIP) focal plane array camera[C]//, 1999, 3698: 687-697.
[4] 陈效双, 许娇, 胡伟达, 等. 长波HgCdTe红外探测器的暗电流机理研究进展[J]. 红外技术, 2015, 37(5): 353-360.
CHEN Xiaoshuang, XU Jiao, HU Weida, et al. Research Progresses on Dark Current Mechanisms of Long-wavelength HgCdTe Infrared Detectors[J]., 2015, 37(5): 353-360.
[5] Vural K, Kozlowski L J, Cooper D, et al. 2048×2048 HgCdTe focal plane arrays for astronomy applications[C]//, 1999, 3698: 24-35.
[6] 耿红艳, 周州, 宋国峰, 等. 红外探测器倒装互连技术进展[J]. 红外与激光工程, 2014, 43(3): 722-726.
GENG Hongyan, ZHOU Zhou, SONG Guofeng, et al. Flip chip bonding technology for IR detectors[J]., 2014, 43(3): 722-726.
[7] 王泰升, 鱼卫星, 卢振武, 等.一种新型焦平面电互连工艺: CN102881607A[P]. 2013-01-16.
WANG Taisheng, YU Weixing, LU Zhenwu, et al. A new focal plane of the electrical interconnection process: CN102881607A[P]. 2013-01-16.
[8] JIANG Jutao, Stanley Tsao, Thomas O’Sullivan, et al. Fabrication of indium bumps for hybrid infrared focal plane array applications[J].., 2004, 45: 143-151.
[9] 刘豫东, 张钢, 崔建国, 等.织构对铟凸点剪切强度的影响[J]. 红外与毫米波学报, 2004, 23(3): 225-228.
LIU Yudong, ZHANG Gang, CUI Jianguo, et al. Effectts of texture on the shear strength of indium bump[J]., 2004, 23(3): 225-228.
[10] 何力, 杨定江, 倪国强, 等. 先进焦平面技术导论[M]. 北京: 国防工业出版社, 2011: 306-310.
HE Li, YANG Dingjiang, NI Guoqiang, et al.[M]. Beijing: National Defense Industry Press, 2011: 306-310.
[11] LEE Chin C., WANG Chen Y., Goran Matijasevic. Au-In Bonding Below the Eutectic Temperature[J]., 1993, 16(3): 311-316.
[12] 陈明园, 秦明, 李俊武. 一种基于Au-In共晶的低温键合技术[J].仪表技术与传感器, 2009: 205-207.
CHEN Mingyuan, QIN Ming, LI Junwu. Au-In Bonding at Low Temperature[J]., 2009: 205-207.
[13] HUANG Qiuping, XU Gaowei, YUAN Yuan, et al. Development of indium bumping technology through AZ9260 resist electroplating[J]., 2010, 20(5): 055035.
[14] CHU Kunmo, LEE Jungsub, CHO Hanseo, et al. Characteristics of Indium Bump for Flip-Chip Bonding Used in Polymeric-Waveguide- Integrated Optical Interconnection Systems[J]., 2004, 43(8B): 5922–5927.
[15] 张智超, 赵建忠. 氧化层对于倒装焊接质量的影响和分析[J]. 激光与红外, 2009, 39(10): 1074-1077.
ZHANG Zhichao, ZHAO Jianzhong. Affect and analysis of oxidation layer for the quality of flip chip bonding[J]., 2009, 39(10): 1074-1077.
Dissecting the Influence of Indium Bumps for Flip-chip
YANG Chaowei1,YAN Changshan2,WANG Qiongfang1,LI Jinghui1,HAN Fuzhong1,FENG Yuanqing1,YANG Bichun1,ZUO Dafan1,ZHAO Li1,YU Jianyun1
(1.,650223,;2.298,650114,)
Two types of indium bumps have been fabricated: indium columns fabricated by direct evaporation and indium balls after reflowing indium columns.The impacts of indium columns and indium balls on flip-chip were discussed, and in particular the shear strength of indium columns and indium spheres was tested after flip-chip. Results reveal that the shear strength of indium spheres is 1.5 times higher than that of the indium columns without reflowing after flip-chip, and 2.8 times higher than that of the indium columns with reflow after flip-chip, respectively. In addition,the effects resulted from indium spheres which were exposed in the air for a long time for flip-chip were dissected. Results unravel that the indium spheres have negative influences on the electrical and mechanical connectivity of devices after flip-chip.
indium bump,indium column,indium ball,flip-chip
TN215
A
1001-8891(2016)04-0310-05
2016-01-21;
2016-03-15.
杨超伟(1988-),男,硕士,研究方向为电子器件封装。E-mail:ycw20xx@163.com。
