基体负偏压对类金刚石涂层结构和性能的影响
2015-11-30纪锡旺许振华贺莉丽何利民郝俊文甄洪滨
纪锡旺,许振华,贺莉丽,何利民,郝俊文,甄洪滨
(1北京航空材料研究院,北京100095;2华东理工大学 机械与动力工程学院,上海200237;3中航工业 南方航空工业(集团)有限公司,湖南 株洲412002;4赛屋涂层技术有限公司,天津300308)
类金刚石涂层(Diamond-Like Carbon Coating,DLC)是一种性质类似于金刚石的非晶碳膜,具有超高硬度、高弹性模量、低摩擦因数、高抗磨损性能,以及优异的光电物理性能和稳定的化学惰性。在机械领域已经被广泛应用,作为零件耐磨保护层和刀具涂层已取得了良好使用效果。在光电学、声学、医学等领域有着广阔的应用前景[1-4]。根据制备方法不同,类金刚石涂层可分为含氢和不含氢两大类,因此,DLC也被称为非晶碳膜和非晶含氢碳膜。对含sp3键较高的(通常大于70%)类金刚石涂层分别记为Ta:a-C和Ta:a-C:H,而对含sp3键较低的,则分别记为a-C和a-C:H[5]。
DLC涂层制备技术主要包括离子束沉积法、磁控溅射法、阴极电弧法、等离子体增强化学气相沉积法、脉冲激光法等[6-8]。不同制备技术和工艺条件所得到的涂层性能和结构大相径庭。在不同制备方法和工艺条件下得到的DLC涂层中sp3键含量相差甚大。碳离子之所以能形成sp3键是因其具有足够的能量E,E的大小决定了sp3键含量。能量E的主要来源:产生碳离子时由电离源提供的能量E1;离子沉积时负偏压提供的轰击能量E2;沉积到基体表面的离子在温度的作用下形成涂层,此时温度提供能量E3,故E=E1+E2+E3。理想状态下,当碳离子具备足够大的能量时,sp3键含量最高。但实际涂层制备过程中,E对sp3的形成机制受制于E1,E2和E3的变化。而三者又分别来源于电离源、基体偏压和沉积温度这三个工艺参数。由此可见,电离源、基体偏压和沉积温度对形成sp3键至关重要。同时它们还对DLC涂层的表面形貌、厚度、界面结合强度、硬度等产生重要影响。目前,国内外关于此三种工艺参数对DLC涂层性能影响的研究较少,尤其从离子能量角度出发研究工艺参数对sp3键形成的影响作用机制尚存在诸多空白。
本工作利用DC-PECVD技术在YG8硬质合金基体上制备一系列DLC涂层。在同一实验条件下,保持离子源、温度及其他工艺参数不变,研究不同基体负偏压对涂层形貌、结构、硬度和界面结合强度的影响规律。同时,探讨基体负偏压对sp3键形成的作用机制。
1 实验
1.1 试样制备
以YG8硬质合金为基体材料,尺寸为17mm×10mm×5mm;基体经抛光后用清水清洗5min,超声波清洗20min,去离子水浸泡5min,最后经无水乙醇脱水并烘干后装入真空室内的转架上待用。制备涂层后,试样采用电木粉热相样,经200,400,600,1000,1200#砂纸依次打磨,并用3μm的金刚石抛光膏抛光至镜面,用清水冲洗干净,烘干后观察涂层截面SEM形貌。其余测试所用试样只需用无水乙醇将表面清洗干净并烘干即可。
1.2 实验方法
采用DC-PECVD技术制备DLC涂层,两个离子束源安装于腔体内壁,以纯度为97.00%的C2H2为反应气体。待真空室内真空抽至5.0×10-3Pa以下时,使用纯度为99.999%的Ar和1000V负偏压,对基体进行30min溅射清洗;清洗后,将基体负偏压增大到1100V,采用磁控溅射技术沉积Cr层20min作为过渡层;最后通入C2H2,流量50sccm持续240min,离子束电压为1200V。在上述参数保持不变的条件下,通过采用800,900,1000,1100V和1200V的基体负偏压制备出5种涂层。
1.3 性能测试
DLC涂层表面形貌的观察在Nanoscope III a型原子力显微镜(AFM)和Quanta200型扫描电子显微镜(SEM)下进行,同时SEM观察涂层截面形貌并且测量其厚度,每个试样的涂层厚度在不同位置测量3次,取平均值;用RT200型粗糙度仪测试涂层的表面粗糙度,每个试样测试10次取平均值;硬度采用Duramin型显微硬度计测试,载荷为0.49N,保持时间为15s,在每个试样的涂层表面测试5个点取平均值;采用WS-2005涂层附着力自动划痕仪测试涂层界面结合性能,加载速率20N/min,最大载荷200N,划痕速率5mm/min,划痕长度设定为5mm;拉曼光谱测试采用RM2000型显微共焦拉曼光谱仪,激光器波长514.5nm,显微尺寸范围1μm;采用X射线光电子能谱(XPS)对DLC的杂化键含量进行测试。
2 结果与讨论
2.1 表面形貌
图1分别是负偏压为800,1000V和1200V时DLC涂层的SEM图。由图1(a)可知,当负偏压为800V时,DLC涂层表面存在一些尺寸不规则的大颗粒。涂层表面的微观形貌与涂层生长行为密切相关,涂层的生长一般可以分为两个阶段:首先,等离子体中的正离子和中性基团移向基体表面,在基体表面发生吸附并沉积反应;其次,具有高能量的离子在基体表面迁移扩散,等离子体中的活性氢也会对离子进行刻蚀[9]。负偏压较低时往往导致活性氢能量降低,从而对涂层刻蚀作用较小,同时离子能量较低,使沉积离子迁移扩散能力减弱。因此所得涂层的有机相较多,涂层表面疏松、粗糙[10]。随着负偏压增大到1000V(图1(b)),大颗粒尺寸明显减小,并且小颗粒数量减少,表面变得光滑致密,粗糙程度降低。当偏压为1200V时(图1(c)),大颗粒全部消失,小颗粒数量显著下降。这是因为偏压增大使得离子对基体的轰击能量增强,沉积离子在基体表面上流动性变强,扩散能力提高,涂层结构连续,致密度提高。图2为不同负偏压条件下DLC涂层的粗糙度。可知,涂层表面粗糙度在0.06~0.14μm之间,随着负偏压增大呈减小趋势,该结果与图1中所观察到的现象是一致的。研究结果表明,适当提高基体负偏压可有效改善涂层表面形貌并降低其表面粗糙度。

图1 不同负偏压下样品的SEM 图(a)800V;(b)1000V;(c)1200V Fig.1 Micrographs of samples with different negative bias voltages(a)800V;(b)1000V;(c)1200V

图2 不同负偏压下DLC涂层的粗糙度Fig.2 Roughness of DLC coatings with different negative bias voltages
2.2 涂层厚度
图3是负偏压为1000V时DLC涂层的横截面形貌图。图4为负偏压与涂层厚度的对应关系图。由图3的SEM横截面形貌结果表明,涂层生长连续、致密,涂层/基体间的界面结合良好,无缺陷和分层现象,涂层厚度分布均匀性较好。
图3,4可知,涂层厚度随负偏压增大呈先增大后减小趋势,当负偏压为1100V时涂层厚度最大值约为3.2μm。负偏压增大使沉积离子轰击能量增强,单位时间内沉积到基体表面的离子数量增多,涂层变厚。当负偏压继续增大至1200V,涂层厚度急剧下降到1.4μm。这是因为沉积离子轰击能量过大,对涂层表面的粒子产生反溅射作用,导致涂层厚度逐渐减小。因此,适当的负偏压有利于沉积离子向基体表面运动,吸附和扩散,从而沉积形成涂层。但是如果负偏压值过大,由于入射能量增强,则导致周围离子或基团被打散,从而使得涂层厚度下降。由此可见,涂层厚度可通过调节负偏压大小进行控制。

图3 负偏压1000V时DLC涂层的SEM横截面形貌Fig.3 Cross-sectional morphology of DLC coating with negative bias voltage of 1000V

图4 负偏压与涂层厚度的关系Fig.4 Relationship between negative bias voltage and thickness of coatings
2.3 涂层结构
图5为在不同负偏压下制备所得DLC涂层的Raman谱图。可以发现,每个试样的Raman光谱均呈现出典型的不对称倾斜散射峰,这表明制备所得的是典型的DLC涂层。对每个Raman光谱进行高斯拟合,1580cm-1附近的是G(graphite)峰,1350cm-1附近的是D(disorder)峰。G峰代表石墨结构并且对应在C=C链或芳香烃环中每对sp2键的纵向振动;D峰只对应着环上的sp2键的横向振动[11]。D峰和G峰的积分强度比ID/IG与sp2/sp3比值有着一定的关系[12],当ID/IG越小时sp3键的相对含量越多。G峰向低波数位置移动时说明,sp2键紊乱程度增加和sp3键相对含量的增大。通过ID/IG的变化和G峰位置偏移可以定性地分析sp3键的相对含量变化。
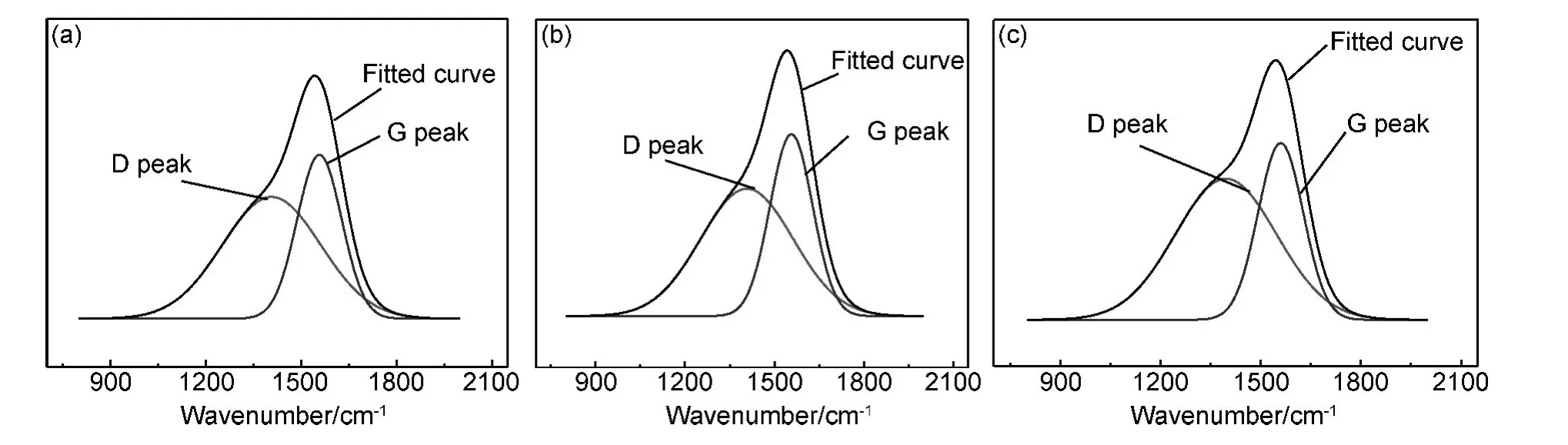
图5 不同负偏压下 DLC涂层的Raman光谱(a)800V;(b)1000V;(c)1200V Fig.5 Raman shift of DLC coatings with different negative bias voltages(a)800V;(b)1000V;(c)1200V
不同负偏压下Raman光谱高斯拟合结果如表1所示。可知,负偏压从800V增加到1000V,ID/IG值由1.63减小为1.5,同时G峰位置从1559cm-1移动到1555cm-1处。负偏压继续增大至1200V,ID/IG比值随之从1.5增大到1.7,G峰位置从1555cm-1移动到1558cm-1。ID/IG积分强度比随负偏压增大呈先增大后减小趋势,即sp3键的相对含量随负偏压增加先增大后减小。负偏压增大导致沉积离子轰击能量增加,此时形成的sp3键增多。当负偏压超过1000V且继续增大时对应的离子轰击能量也进一步增强,但sp3键含量反而呈下降趋势。

表1 不同负偏压下Raman光谱拟合数据Table1 Fitted data of Raman shift under different negative bias voltages
为了进一步定量地分析DLC涂层中sp3键的含量,得到基体负偏压与sp3键含量的函数关系,本工作采用XPS对其组分进行检测(图6)。根据实测曲线可知,sp3键含量均大于51%,负偏压1000V时sp3键含量最高(约67.9%)。随着负偏压逐渐增大,sp3键含量先增大后减小。采用高斯拟合法对实测数据拟合(式(1)):

图6 不同负偏压下对应的sp3键含量Fig.6 Relationship between sp3 content and negative bias voltage

式中:sp3键含量最小值y0=0.5,拟合曲线最高峰横坐标xc=943,w和A 均为常数,分别为245,53。对2式(1)求导得到曲线变化率xc)。当=0时,y达到最大值,处于最高峰位置,此时x=xc=943,即负偏压943V时sp3键含量出现最大值。拟合曲线中最高峰位置与实验数据最高峰位置相差Δx=56V,由此可初步推断:在本实验条件下,sp3键含量最高峰位置应该位于943~1000V之间。实测曲线与拟合曲线表明:基体负偏压对sp3键形成作用有限,基体负偏压过小或过大会导致sp3键含量降低,只有选取适当的负偏压才会对形成sp3键最为有利。同时,基体负偏压产生的轰击能量E2对sp3键形成具有重要影响。理想状态下,E2增大使总能量E也增大,E增大则sp3键含量升高。但研究结果显示,虽然E2增加会导致E大幅度提高,但是sp3键含量却呈下降趋势,这是因为E2由负偏压决定,负偏压过度增大导致离子能量太高,使C—H键破裂,H元素从涂层中逸出产生石墨化[13],从而导致sp3键含量下降。因此,能量E2过度增加将导致sp3键含量降低。由此可见,当E1和E3固定不变时,总能量E对sp3键含量的影响受轰击能量E2制约,只有选取合适的轰击能量E2才能得到最高sp3键含量的DLC涂层。
2.4 显微硬度
sp3键决定DLC涂层的力学性能,因此DLC涂层显微硬度受sp3键含量影响。图7为硬度与负偏压的关系图。可知,DLC涂层显微硬度均在1700~2500之间,随着负偏压增大而先增加后减小;负偏压为1000V时硬度达到最大值2500。此变化趋势与图6中sp3键含量的变化规律基本相符。故sp3键含量决定DLC涂层显微硬度值。因此,DLC涂层显微硬度值可通过基体负偏压控制。
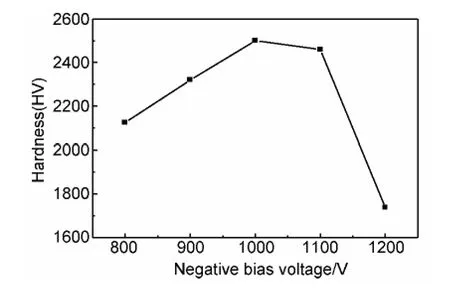
图7 硬度与负偏压的关系Fig.7 Relationship between hardness and negative bias voltage
2.5 界面结合性能

图8 不同负偏压下涂层划痕SEM 形貌图(a)800V;(b)1000V;(c)1200V Fig.8 Micrographs of the scratch track under different negative bias voltages(a)800V;(b)1000V;(c)1200V
图8是负偏压为800,1000V和1200V时涂层划痕SEM形貌图。采用划痕法测试涂层界面结合性能,划针压入时,涂层与基体的变形不同步导致涂层沿着划痕向两边形成整齐排列的小裂纹,呈鱼骨状。当划针继续压入时达到临近载荷,此时涂层在界面处发生脆性剥落,试样在划擦过程中会出现涂层变形、涂层与基体共同 变形和涂层剥落三个阶段[14]。图8(a)局部放大图显示,在划痕初期的边缘上出现了裂纹扩展,随着划痕载荷进一步增大,出现了起皱和脱落,这说明涂层/基体之间存在较大的内应力,使得涂层/基体的界面结合性能较差。当负偏压为1000V时(图8(b)),划痕轨迹纵向呈现的涂层起皮现象不明显,从局部放大图可以看到该现象持续的痕迹最长,裂纹扩展数量最少。随着载荷的增加,起皱和脱落面积比其余两个试样小,此涂层/基体之间的应力值最小,且结合性能最优。图8(c)是负偏压为1200V时的划痕形貌,此时涂层划痕轨迹边缘出现涂层大面积起皮甚至脱落,裂纹扩展明显且数量最多,这可能是涂层内应力过大导致涂层/基体间的结合性能变差。
图9是结合强度与负偏压的对应关系图。负偏压从800V增大到1100V时,涂层/基体间的结合力逐渐增大,当负偏压为1100V时,涂层/基体间的结合力达到最大值60N。负偏压继续增大至1200V时,结合力反而降低,这与图8的划痕形貌所呈现的结果基本一致。因为负偏压增大导致离子轰击基体的能量增强,充足的能量足以使离子渗透涂层表面外层并诱发压应力,同时提高了离子进入基体表面的能力,很容易形成致密的网络微观结构,增强了涂层与基体的结合。另一方面,如果涂层中的原子和基体结合很弱,那么,这些结合不紧密的原子会在高能量粒子的轰击下反溅出来,只有和基体紧紧结合的原子才能沉积下来形成涂层,从而改善涂层/基体间的界面结合性能[15]。当负偏压增长过大,由于高能量离子对基体的轰击作用,可能会产生过大的内应力从而导致涂层的结合能力下降。由此可知,适当的离子轰击有利于提高涂层/基体间的结合性能,但不宜过大。

图9 结合强度与负偏压的关系Fig.9 Relationship between adhesion and negative bias voltage
3 结论
(1)随着负偏压增大,涂层表面变得平整光滑、致密,大颗粒尺寸下降,小颗粒数量减少,粗糙程度降低。负偏压为1000V时,sp3键含量最大,约为67.9%。负偏压产生的轰击能量E2过大将导致sp3键含量降低。只有选取合适的轰击能量E2才能得到最高sp3键含量的DLC涂层。显微硬度随负偏压的变化规律与sp3键含量变化规律基本相符,显微硬度值由sp3键含量决定。
(2)涂层厚度、界面结合力随负偏压增大均先增大后减小,在负偏压为1100V时分别达到最大值3.2和60N。在负偏压为1000~1100V时,涂层具有最优综合性能。
[1]OHGOE Y,HIRAKURI K K,SAITOH H,et al.Classification of DLC films in terms of biological response[J].Surface & Coatings Technology,2012,207:350—354.
[2]VENGUDUSAMY B,MUFTI R A,LAMB G D,et al.Friction properties of DLC/DLC contacts in base oil[J].Tribology International,2011,44(7-8):922—932.
[3]DAI Wei,KE P L,MOON M-W,et al.Investigation of the microstructure,mechanical properties and tribological behaviors of Ti-containing diamond-like carbon films fabricated by a hybrid ion beam method[J].Thin Solid Films,2012,520(19):6057—6063.
[4]MARTINEZ-MARTINEZ D,SCHENKEL M,PEI Y T,et al.Microstructure and chemical bonding of DLC films deposited on ACM rubber by PACVD[J].Surface & Coatings Technology,2011,205(Suppl 2):75—78.
[5]李敬财,何玉定,胡杜军,等.类金刚石薄膜的应用[J].新材料产业,2004,124(3):39—42.LI J C,HE Y D,HU D J,et al.Application of DLC films[J].Advanced Materials Industry,2004,124(3):39—42.
[6]杨发展,王世庆,沈丽如,等.不同方法制备的类金刚石薄膜的XPS和Raman光谱的研究[J].光谱学与光谱分析,2011,31(7):1080—1083.YANG F Z,WANG S Q,SHEN L R,et al.XPS and Raman studies of diamond-like carbon films prepared by various deposition techniques[J].Spectroscopy and Spectral Analysis,2011,31(7):1080—1083.
[7]王雪敏,吴卫东,李盛印,等.脉冲激光沉积掺 W类金刚石膜的性能[J].稀有金属材料与工程,2010,39(7):1251—1255.WANG X M,WU W D,LI S Y,et al.Properties of W doped diamond-like carbon films prepared by pulsed laser deposition[J].Rare Metal Materials and Engineering,2010,39(7):1251—1255.
[8]苟伟,李剑锋,楚信谱,等.脉冲辉光PECVD制备DLC薄膜的结构和性能研究[J].真空科学与技术学报,2008,28(增刊1):33—37.GOU W,LI J F,CHU X P,et al.Microstructures and properties of diamond-like carbon films grown by plasma enhanced chemical vapor deposition[J].Chinese Journal of Vacuum Science and Technology,2008,28(Suppl 1):33—37.
[9]SCHENG Y H,WU Y P,CHEN J G,el a1.On the deposition mechanism of a-C:H films by plasma enhanced chemical vapor deposition[J].Surface & Coatings Technology,2000,135(1):27—33.
[10]常海波,徐洮,张治军.直流负偏压对类金刚石薄膜结构的影响[J].化学研究,2005,16(1):35—38.CHANG H B,XU Y,ZHANG Z J.Effect of direct current negative bias on the structure of diamond-like carbon films[J].Chemical Research,2005,16(1):35—38.
[11]宋贵宏,杜昊,贺春林.硬质与超硬涂层[M].北京:国防工业出版社,2007.159—162.SONG G H,DU H,HE C L.Hard and Superhardcoating[M].Beijing:National Defense Industry Press,2007.159-162.
[12]周顺,严一心.脉冲真空电弧离子镀在不锈钢上沉积类金刚石薄膜的研究[J].真空,2005,42(2):15—18.ZHOU S,YAN Y X.Structure and mechanical properties of DLC films by pulsed vacuum arc ion deposition[J].Vacuum,2005,42(2):15—18.
[13]谢鹏,汪建华,王传新,等.硬质合金刀具上的类金刚石薄膜硬度的研究[J].硬质合金,2008,25(4):257—260.XIE P,WANG J H,WANG C X,et al.Study on hardness of diamond-like carbon film on cemented carbide blades[J].Cemented Carbide,2008,25(4):257—260.
[14]石志峰,黄楠,孙鸿,等.钛过渡层对类金刚石薄膜的膜基结合力以及摩擦学性能的影响[J].功能材料,2008,39(8):1340—1343.SHI Z F,HUANG N,SUN H,et al.Effects of different Ti-interlayer deposition time and bias voltage on the adhesive and tribological properties of DLC films[J].Journal of Functional Materials,2008,39(8):1340—1343.
[15]邵霄.TiC/DLC多层类金刚石薄膜的研究[D].西安:西安工业大学,2008.SHAO X.Study on TiC/DLC multilayer diamond-like carbon films[D].Xi’an:Xi’an Technological University,2008.
