双探针原子力显微镜针尖对准方法研究
2015-10-25张华坤高思田施玉书王鹤群
张华坤,高思田,,李 伟,施玉书,王鹤群
(1.合肥工业大学仪器科学与光电工程学院,安徽 合肥 230009;2.中国计量科学研究院,北京 100029)
双探针原子力显微镜针尖对准方法研究
张华坤1,高思田1,2,李 伟2,施玉书2,王鹤群2
(1.合肥工业大学仪器科学与光电工程学院,安徽合肥230009;2.中国计量科学研究院,北京100029)
双探针对顶测量可以有效地消除传统原子力显微镜(AFM)的探针形状对关键尺寸(CD)测量的影响。测量前需要将两个探针针尖(A和B)接触到一起作为测量零点,为实现双探针纳米级对准,提出一种渐进式平面扫描方法。首先,通过视觉图像引导两个探针对准到1μm以内。然后,两个探针继续接近,同时探针A在YOZ平面内对探针B扫描成像,并逐步缩小扫描范围和扫描步进,得到其针尖的纳米级坐标(YB,ZB)。最后,将探针A在Y和Z方向分别移动至YB和ZB,在X方向继续接近探针B直至两探针接触。实验证明,该方法可有效地实现双探针对准,且对准精度为10nm。
计量学;双探针;原子力显微镜;对准方法;关键尺寸
1 引言
集成电路中需测量的三维参数包括线边缘粗糙度、线宽变化度、侧壁夹角、侧壁轮廓及粗糙度等[1],其中,通常所说的关键尺寸(CD)即线宽在三维测量中尤为重要。多种仪器可对纳米尺度的线宽进行测量,光学显微镜、扫描电子显微镜(SEM)、透射电镜(TEM)以及扫描探针显微镜(SPM)等在微纳测量中被广泛应用。光学显微镜的使用较为简便,测量速度快,但是受衍射极限影响,只能应用在100nm以上的线宽测量中;SEM可以获得焦平面上的二维图像且分辨率较高(1nm),但难以得到几何结构的三维信息;TEM能够达到极高的分辨率(0.1nm),但是对样品的破坏性处理使得TEM难以用于量值溯源。
原子力显微镜(AFM)是SPM的一种,现在已成为微纳测量领域最重要的工具[2]。AFM的优势在于:(1)实现准三维测量;(2)动态AFM对样品具有非破坏性;(3)分辨率高(可达几个nm)。但是,由于AFM探针的针尖有一定的锥角且在测量时倾斜放置,传统的AFM很难获得准确的CD尺寸。因此,对AFM的改进成为当前线宽测量的研究热点。德国联邦物理技术研究院(PTB)研制了多种特殊探针,其中组合式探针[3]是在传统的探针末端粘接一个垂直的悬臂,以实现垂直结构的测量,但是并不能完成真正的三维测量;喇叭形探针[4]用于接触式测量,其测量模式分为测量顶端的Top-down模式和测量侧壁的CD模式,测量重复性优于1nm。然而,该方法需要预先了解被测物的几何形状,而且逐点接触式测量消耗大量的时间,增加了测量的复杂性。碳纳米管探针(CNT)[5]具有极高的长宽比,可深入到沟槽中进行测量,因此众多的AFM制造商试图采用CNT作为探针,可是,CNT极易弯曲,且弯曲程度不可预知,导致测量时产生较大的偏差。据实验数据表明:用CNT测量线宽时,探针根部的偏转达到了5.8nm。2003年,美国Xidex公司开发了dualprobe NanoCaliperTMAFM[6],即两个探针作为卡钳独立测量线条的两侧。其测量关键是将两个探针相互接触来定义一个零点。但是,NanoCaliperTMAFM并未成功实现。
本文提出一种双探针对准方案,将两个探针在三维方向上纳米级对准,消除AFM探针尺寸对CD测量的影响,实现真三维测量。
2 双探针测量原理
测量之前先将两个探针在三维方向上对准,如图1所示。xAC和xBC分别代表探针接触时相对参考点的位置,然后将两个探针分开,分别测量线条的两侧,xA和xB表示测量时探针与参考点的距离。线宽WF的测量结果为:

其中:dM=dL+dR为测量线宽时探针与侧壁的间距,当两个探针对准时,两者尺寸之和wL+wR等于xBC-xAC-dA,dAB为双探针对准时两针的间距,因此,式(1)又可写成:

其中xB-xBC和xAC-xA分别为两个探针在测量中的位移,当采用接触模式测量时,dM=dAB=0,上式可进一步简化为:

图1 双探针对顶测量原理

当采用非接触式测量时,(dM-dA)≤dM。因此,双探针对顶测量消除了探针形状的影响,而且消除了部分测量误差,提高了测量结果的准确性[6]。
3 Akiyama音叉探针
音叉式探针是一种自激励自传感的AFM探针,它通过外部激励而振动,同时能感知振动的变化(包括幅度、相位和频率)。它不需要光学探测部分,简化了测量装置的结构。Akiyama探针(AProbe)将悬臂对称地固定在音叉的两个叉指上,把音叉在平面内的张合运动转化为悬臂在垂直方向上的简谐运动[7,8](图2)。探针尺寸(悬臂的宽度、厚度,探针的长度等)为微米级,针尖直径甚至只有15nm左右,图3为采用SEM获取探针准确的几何尺寸。由于针尖外倾,能够接触到纳米结构的侧壁,所以这种探针适用于线宽测量。

图2 A-Probe(运动转化)
探针工作在调幅(AM)模式下,即外部激励使音叉谐振并带动悬臂振动。外界条件不变(温度、湿度等),当探针自由振荡时,探针的固有频率保持不变;当探针逐渐接近样品时,近场力作用到探针上,导致音叉的固有频率发生改变,此时激励保持恒定,因此探针的振幅减小,音叉产生的电信号减弱,电信号的幅度和相位信息通过外接电路获得,见图4。

图3 A-Probe的SEM图像

图4 A-Probe AM模式
4 对针方案
鉴于A-Probe的尺寸在微米范围,采用高分辨率镜头和CCD获取探针水平和垂直方向的图像,参考SEM下的探针图像(图3),利用亚像素边缘检测算法计算出针尖的位置,再通过位移机构使得两个探针接近到亚微米范围[9]。对于实现纳米级的双探针对准,尚需对两针之间的近场力做深入的研究。
近场力涵盖的范围很广,包括静电力、离子斥力、范德华力和毛细管力等。AFM针尖到样品之间距离为几百纳米时就存在近场力的作用,一般的动态AFM工作距离在样品上方十几纳米至几十纳米处,而静态AFM则距离样品只有0.2~0.3nm[10]。因此,当两个探针之间的距离足够小时,两者之间的近场力可以被检测出来。
选用音叉探针实现双探针对准,外接信号源激励音叉使其在谐振频率点处振动,属于动态AFM。一般来说,动态AFM在测量样品时,探针沿Z轴的位移随样品表面的起伏而变化,因而Z轴的变化即代表样品表面的轮廓。然而,由于探针针尖仅有15nm左右,用一侧探针对另一侧探针成像很容易造成针尖的损坏,使得对准产生较大的误差,不利于后续测量。故提出一种渐进式平面扫描方式,既可对针尖成像,又可避免探针的损坏。如图5所示,将固定的探针B的顶点设置为零点,垂直方向为Z轴,与镜头平行和垂直方向分别为X、Y轴,A、B两探针沿X方向相对放置。固定在纳米台上的探针A 沿YOZ平面扫描,在平面扫描过程中,X向位移始终保持不变。这种扫描方式类似AFM的恒高模式,既能对探针成像,又能使两个探针保持一定距离,从而避免损坏。由图3可知,探针的外边缘与悬臂的夹角约为105°,探针倾斜放置,与水平面夹角为10°,探针外边缘与垂直方向的夹角约为5°,见图6。

图5 一侧探针扫描另一侧探针

图6 探针夹具示意图
对针按以下步骤进行:(1)在视觉对针完成后,将探针A在Y和Z轴沿正向分别移动1.5 μm,然后对探针B进行扫描,扫描范围为3 μm×3 μm,步进为30nm。当探针B的形貌出现在图像中时,计算其顶点位置,然后移动探针A使得探针B在A的2 μm扫描范围内。(2)继续对探针B成像,扫描范围为2 μm×2 μm,步进为20nm。同第一步,移动探针A使得探针B在A的1 μm扫描范围内。(3)继续扫描探针B,扫描范围为1 μm×1 μm,步进为10nm。通过逐步缩小扫描范围并减少扫描步进的方式获得探针B纳米级的二维坐标。
5 实验
实验系统如图7所示,Zurich HF2LI型锁相放大器内置有信号源,可以提供音叉探针的外部激励(通过前置放大电路输入到音叉上)。同时音叉探针输出电信号,通过前置放大电路将微弱的电信号放大后输入锁相放大器。探针工作在AM模式时,锁相放大器可同时输出幅度信号和相位信号。
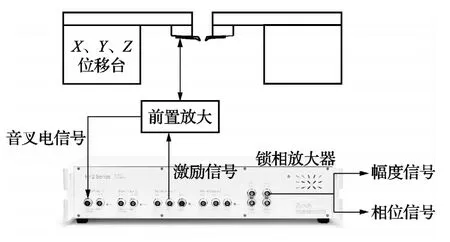
图7 实验系统
AM模式下外部激励信号的频率始终等于音叉探针的谐振频率,探针的谐振频率一般在44~46 kHz之间,在此范围内对探针扫频以确定其谐振频率点。图8显示了实验所用探针的幅频和相频曲线。
获得探针的谐振频率后,锁相环输出同频率的激励信号让探针谐振。当两个探针距离较远时近场力较弱,音叉探针难以检测到力的变化,因此整个扫描图像比较平坦(图9a,图中纵坐标为1V-探针的信号幅度值)。X方向继续接近,每10nm扫描一次,当双探针足够接近时,A探针可对B探针成像,图中显示为锥形(图9b)。X向位移台继续移动,探针A继续平面扫描,在扫描过程中当两探针接触时探针A的振幅降至最低,在图中显示为比较平坦的图像顶部(图9c)。
图9(b)中出现的锥体的顶点即为探针的针尖,Y和Z方向移动探针A都会使锥体顶点的位置发生变化。如图10所示,图10(a)是探针A移动前对探针B扫描成像;当探针A在Y方向上移动400nm,并且在Z方向上移动200nm时,探针B的针尖位置也随之变化,见图10(b)。
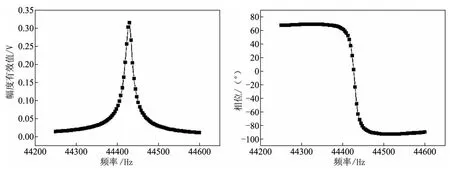
图8 音叉探针的幅频和相频曲线

图9 恒距离平面扫描图像
图11(a)、(b)分别显示了2 μm×2 μm和1 μm×1 μm的扫描图像,计算可得探针B在图11 (b)中的坐标为YB=630nm,ZB=650nm。将探针A在Y和Z方向分别移动至YB和ZB,再将其在X方向退后1 μm,以10nm为步进向探针B移动,得到探针A的力接近曲线,见图12(部分显示),图中箭头处即为两个探针的接触点,此时探针A振幅最小。
6 结论
本文研究了一种双探针纳米级对准方法。高分辨率成像系统将双探针接近至1 μm以内,避免了探针相互碰撞而损坏。利用渐进式平面扫描方法在纳米尺度上对探针针尖成像,精确地获取探针针尖的二维坐标。当两个探针在二维方向上对准后,继续接近使得两针接触,实现三维方向上的纳米级双探针对准,对准精度为10nm。利用更小的步进可以进一步提高对准的精度。如何减小噪声和位移系统精度对双探针对准精度的影响将是今后研究的重点。
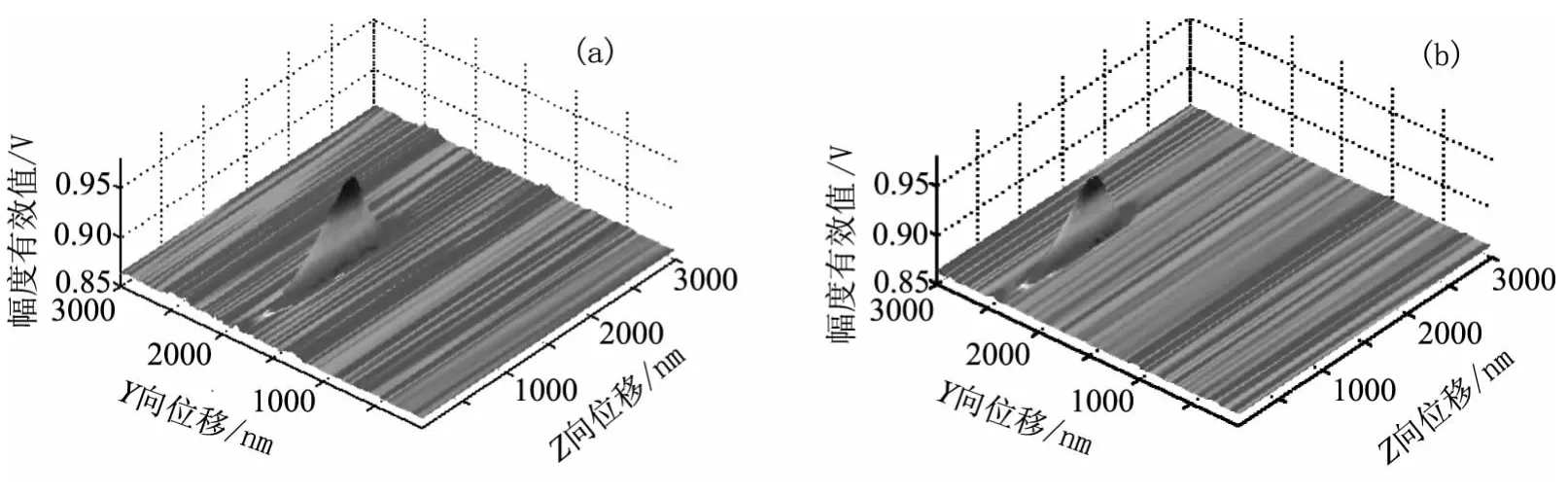
图10 探针B针尖位置随探针A位置的变化

图11 逐步缩小扫描范围和扫描步进的图像

图12 探针A的力接近曲线
[1]高思田,王春艳,叶孝佑,等.纳米技术与纳米计量[J].现代计量测试,2000,(1):3-12.
[2]卢明臻,高思田,杜华,等.计量型原子力测头用于纳米台阶高度样板的测量[J].计量学报,2008,29(3):193-197.
[3]Dai G L,Wolff H,Pohlenz P,et al.Atomic force probe for sidewall scanning of nano and microstructures[J].Applied physics letters,2006,88(17):171908.
[4]Dai G L,Heidelmann M,Kübel C,et al.Reference nano-dimensional metrologybyscanningtransmission electronmicroscopy[J].MeasurementScienceand Technology,2013,24(8):085001.
[5]Solares S D.Characterization of deep nanoscale surface trenches with AFM using thin carbon nanotube probes in amplitude-modulationandfrequency-force-modulation modes[J].Measurement Science and Technology,2008,19(1):015503.
[6]Mancevski V,McClure P F.Development of a dual-probe CaliperTMCD-AFMfornearmodel-independent nanometrology[C]//SPIE.Metrology,Inspection and Process Control for Microlithography XVI,Santa Clara,US,2002,83-91.
[7]Akiyama T,Staufer U,Rooij N F,et al.Symmetrically arranged quartz tuning fork with soft cantilever for intermittent contact mode atomic force microscopy[J].Review of Scientific Instruments,2003,74(1):112-117.
[8]Akiyama T,Rooij N F,Staufer U,et al.Implementation and characterization of a quartz tuning fork based probe consisted of discrete resonators for dynamic mode atomic force microscopy[J].Review of Scientific Instruments,2010,81(6):063706.
[9]Zhang H K,Gao S T,Lu M Z,et al.Dual AFM probes alignment based on vision guidance[C]//ICMI.Sixth InternationalSymposiumonPrecisionMechanical Measurements,Guiyang,China,2013,891627.
[10]Giessibl F J.Advances in atomic force microscopy[J].Review of Modern Physics,2003,75(3):949-983.
Study on Tip Alignment Method of Dual-probe Atomic Force Microscopy
ZHANG Hua-kun1,GAO Si-tian1,2,LI Wei2,SHI Yu-shu2,WANG He-qun2
(1.School of Instrument Science and Opto-electronics Engineering,Hefei University of Technology,Hefei,Anhui 230009,China;2.National Institute of Metrology,Beijing 100029,China)
Dual probes alignment measurement can virtually eliminate the effect of tip shape of traditional atomic force microscopy(AFM)on critical measurement(CD).Two tips(probe A and probe B)need contact to each other before measurement to establish a zero reference point.A method of progressive two-dimensional scanning is used to realized dualprobe nanoscale alignment.Firstly,it will align two probes to within 1μm through vision guidance.Secondly,the two probes continue to close,probe B is scanned by probe A in plane XOZ while reducing the scanning range and scanning step gradually to get the nanometer coordinate of probe B(YB,ZB).Lastly,the probe A will be move to YBand ZBin X and Z directions respectively,untill the probe A moves to touch the probe B in X direction.Results indicated that this method can effectively align dual probes,and the alignment accuracy is 10nm.
Metrology;Dual probes;Atomic force microscopy;Alignment method;Critical dimensional
TB92
A
1000-1158(2015)01-0001-05
10.3969/j.issn.1000-1158.2015.01.01
2014-05-08;
2014-08-27
国家科技支撑计划(2011BAK158B02)
张华坤(1986-),男,安徽合肥人,合肥工业大学在读博士生,主要从事精密测量和纳米计量方面的研究。zhanghk@nim.ac.cn
