一种双栅结构抗单粒子翻转加固SRAM存储单元
2015-09-16姚思远刘文平
姚思远 刘文平


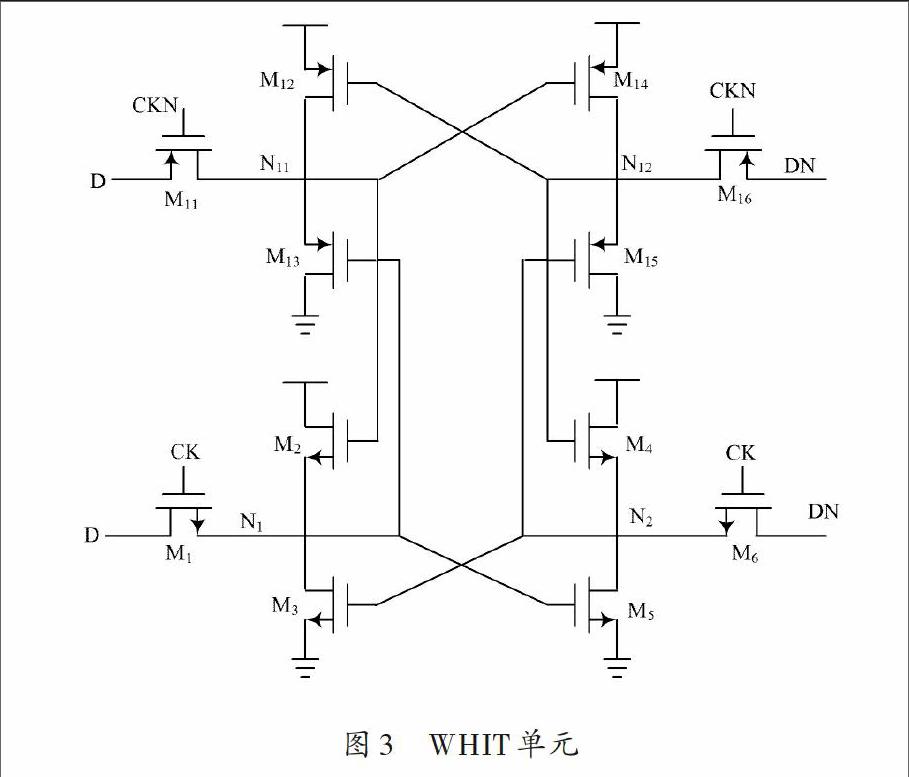
摘 要: 通过对单粒子效应以及抗单粒子翻转电路加固原理进行分析,提出一种基于双栅MOS结构的具有单粒子翻转加固能力的SRAM存储单元。该单元在实现抗单粒子翻转加固的同时具有快速翻转恢复、快速写入、低静态功耗的特点。基于0.18 μm CMOS工艺进行电路仿真,结果显示该加固单元读/写功能正确,翻转阈值大于100 MeV· cm2/mg。可以预测,该电路应用于空间辐射环境下将有较好的稳定性。
关键词: 单粒子翻转; 双栅结构; SRAM存储单元; 加固设计
中图分类号: TN603?34 文献标识码: A 文章编号: 1004?373X(2015)18?0102?04
Abstract: A SRAM memory unit with single event upset (SEU) strengthening ability based on dual?gate MOS structure is proposed by analyzing the single event effects and SEU?resisted circuit strengthening theory. This unit has characteristics of fast upset recovery, quick writing and low static power consumption while realizing SEU?resisted strengthening. The circuit was simulated with 0.18 μm CMOS technology. The simulation results indicate that the strengthening unit can read and write properly, and the SEU threshold is better than 100 MeV·cm2/mg. It is predicted that this circuit would have good stability in the space radiation environment.
Keywords: SEU; dual?gate structure; SRAM memory unit; strenthening design
在外层空间以及核爆等辐射环境中,辐射效应已经成为电子系统的主要可靠性问题之一。为确保计算机的可靠性,工作于太空中的集成电路必须经过抗辐射加固设计。存储器在集成电路中占有特殊的地位,几乎在任何电子系统中都不可缺少,因此对于存储器的保护更加重要。集成电路关键尺寸的不断减小以及低电压技术的应用,使得单粒子翻转的临界电荷随之减小,可靠性问题更加突出。对抗单粒子翻转加固技术提出了更高的要求。本文主要讨论存储单元的抗单粒子翻转加固设计。
1 SRAM单元加固技术
SRAM单元加固技术主要分为2种:一种是基于6管标准单元进行加固;另外一种加固设计的主要思想是通过多管结构引入冗余节点。
第1种方法如图1所示,是标准6管单元通过存储节点引入电容电阻设计的加固方法[1]。该单元通过引入RC延迟,使得单粒子入射产生的瞬态脉冲传播过程被延迟,上拉PMOS或者下拉NMOS有足够的时间恢复翻转节点电压,从而保护整个单元逻辑不发错误翻转。该加固方法引入RC延迟,虽然能够达到一定的单粒子加固能力,但是同时受到电容电阻的影响写入时间大大增加。并且电容电阻将会占用很大的芯片面积。
第2种加固设计技术主要通过多管结构,引入冗余节点来保护单元电路在发生单粒子入射时不发生逻辑翻转。这里介绍两种典型的多管加固结构。
图2所示为Rockett提出的加固存储单元[2],该单元在标准6管结构的基础上增加了6个MOS管,并增加2个冗余节点。由于数据写入需要传输过程,因此写入时间较长。
图3所示是Whitaker等人提出的加固存储单元。该单元包括2个稳定结构,分别为4个PMOS管构成的稳定结构和4个NMOS管构成的稳定结构。该单元具有较大的翻转阈值和较短的写入时间,但是由于使用PMOS管下拉以及NMOS管上拉,因此存在电位退化现象。电位退化现象引起MOS管无法完全关断,存在导电通路,最终导致翻转恢复时间较长,静态功耗很高。
2 新型SRAM加固存储单元
抗单粒子翻转存储单元加固设计主要从以下几个方面进行优化:
(1) 翻转阈值尽可能大;
(2) 翻转恢复时间尽可能短;
(3) 静态功耗尽可能小;
(4) 写入速度尽可能快;
(5) 晶体管数尽可能少。
通过对已有加固结构的研究分析,提出了如图4所示的抗单粒子翻转加固存储单元。该加固存储单元由10个MOS管构成。其中N5,N6为读写管;P1,P2,N1,N2为非均匀双栅MOS管。P1与P2,N1与N2分别构成相互交叉耦合结构,当发生单粒子入射时,能够保护电路逻辑不发生翻转;由P3,P4,N3,N4组成的翻转恢复驱动结构,通过一个导通的MOS管为发生翻转的节点提供恢复电流。
为了方便分析双栅结构存储单元,将其等效为图5所示的结构,将双栅MOS管等效为2个MOS管串联。
如图5所示,P1,P2,P3,P4,N1,N2,N3,N4用来描述双栅稳定结构,其中P2,P4栅极接地,N1,N3栅极接电源电压,保持常通状态。P1,P3宽长比大于P2,P4宽长比,N2,N4宽长比大于N1,N3宽长比,目的是当敏感节点发生翻转时,其他冗余节点能够保持正确电位;由P5,P6,N5,N6构成翻转恢复驱动结构,通过一个导通的MOS管为发生翻转的节点提供恢复电流,可以提高敏感节点翻转恢复速度。
2.1 写操作过程
该加固单元有3对冗余存储节点。Q,Qb;P,Pb;N,Nb存储着互补的电位信息。当读/写信号为低电位时,读写管N7和N8关断。若存储“1”状态,则P1,P6导通,N2,N6关断,使节点P,Q,N保持为“1”;同时P3,P5关断,N4,N5导通,使节点Pb,Qb,Nb保持为“0”。
若要向存储单元写入“0”,则D置为“0”,Db置为“1”。读写信号为高电位,读写管N7和N8导通。节点Q通过N8放电到“0”,则节点N电位为“0”,N5与N4关断。Qb通过N7充电到“1”,则节点Pb电位为“1”,P6与P1关断。节点Nb电位为“1”,N2与N6导通为Q提供下拉。此时节点P电位为“0”,P5与P3导通,为Qb提供上拉。写入过程完成。写入“1”过程与上述相似。
2.2 翻转恢复过程
存储器数据为“1”时,节点Q,P和N为“1”,节点Qb,Pb和Nb为“0”。该状态下N2,N6,P3和P5的漏结反偏,因此相应节点Q,N,Pb,Qb是敏感节点。节点发生翻转后的恢复过程如下:
2.2.1 节点Q发生翻转
若单粒子入射N6的漏端,节点Q处电压产生一个负向跳变,则N节点变为“0”,N5,N4关断。由于P2相对P1是弱管,所以节点P保持为“1”,P3,P5保持关断。则Qb处于高阻态,电位保持为“0”。导通的P6使节点Q恢复为“1”。
2.2.2 节点Qb发生翻转
若单粒子入射P5的漏端,节点Qb处电压产生一个正向跳变,则Pb节点变为“1”,P1,P6关断。由于N3相对N6是弱管,所以节点Nb保持为“0”,N2,N6保持关断。则Q处于高阻态,电位保持为“1”。导通的N5管使节点Qb恢复为“0”。
2.2.3 节点N发生翻转
若单粒子入射N2的漏端,节点N处产生一个负脉冲,N4,N5关断。由于N1相对P6是弱管,节点Q保持为“1”,则节点P保持为“1”,P5,P3保持关断。此时Qb节点处于高阻态,电位保持为“0”。导通的N1和P6使节点N恢复为“1”。
2.2.4 节点Pb发生翻转
若单粒子入射P3的漏端,节点Pb处产生一个正脉冲,P1,P6关断。由于P4相对N5是弱管,节点Qb保持为“0”,则节点Nb保持为“0”,N2,N6保持关断。此时Q节点处于高阻态,电位保持为“1”。导通的P4和N5使节点Pb恢复为“0”。
数据为“0”时的翻转恢复过程与上述过程相似。
3 仿真结果及分析
该单元的仿真验证使用0.18 μm工艺的CMOS器件模型。为了验证存储单元的抗单粒子翻转能力。在仿真中,单粒子入射对电路的影响可以表示为一个瞬时电流脉冲,这个电流脉冲为双曲函数型[4?5]:
[I(t)=I0?(e-tτα-e-tτβ)]
式中:[I0]是电流源峰值电流;[τα]是与电荷收集速度相关的时间常数;[τβ]是粒子撞击相关的时间常数。
100 MeV· cm2/mg的LET(Threshold Linear Energy Transfer),产生的轨迹电荷量约为1 pC/μm。单粒子入射效应分析时常采用入射深度[6]为1.5 μm。因此100 MeV· cm2/mg的LET产生的总电荷量约为1.5 pC。为了比较几种加固存储单元的性能,需要选择相同参数的电流源来模拟单粒子入射过程。双曲函数电流源选择上升因子[τα]=10 ps,下降因子[τβ]=200 ps,则峰值电流为1 mA时收集电荷总量Q约为0.2 pC。
图6模拟的是单粒子入射发生在N5的漏极。在8 ns时写入数据“0”,12 ns时N5管的漏极处发生单粒子入射,节点Qb产生一个负脉冲,节点Nb电位同时也产生一个负脉冲。其他节点电压基本保持不变。随后节点Qb与Nb电压恢复。
为了模拟该存储单元对单粒子翻转的加固能力,通过增加Q值来获得存储单元的单粒子翻转临界电荷。如图7所示为对该存储单元进行临界电荷的仿真结果。当Q值为8.3 pC时,发生单粒子入射后电压无法自动恢复到正确值。因此可以确定该存储单元的单粒子翻转临界电荷为8.2 pC。
表1是对几种抗单粒子翻转加固存储单元的性能对比。选用ROCK单元,WHIT单元以及标准6管单元进行比较。主要比较的指标有:临界电荷、写入时间、翻转恢复时间、静态功耗、晶体管数量。
表1 加固单元性能比较
本文将翻转恢复时间定义为:节点电压从跳变为0.9 V到恢复为0.9 V所需要的时间。由于本文单元设计了翻转恢复驱动结构,因此翻转恢复时间较短。写入时间是指从时钟信号为0.9 V到存储节点电压为0.9 V的时间。因为本文存储单元的读写管与存储节点直接相连,因此与ROCK单元相比具有更短的写入时间。静态功耗是指存储单元在锁存状态下的功耗,本文存储单元8管稳定结构采用PMOS管上拉NMOS管下拉,没有电源到地的导电通路,因此与WHIT单元相比静态功耗明显减少。本文加固单元临界电荷值为8.2 pC对应LET值大于100 MeV· cm2/mg,与其他单元相比抗单粒子翻转能力显著提高。
4 结 语
本文提出了一种新型的抗单粒子翻转加固SRAM存储单元,其双栅稳定结构在减少器件个数的同时保证在发生单粒子入射时存储数据不发生翻转。LET值大于100 MeV· cm2/mg;另外通过翻转恢复驱动结构设计可以实现单粒子翻转的快速恢复,翻转恢复时间0.64 ns。该加固存储单元不但克服了以前加固单元写入速度慢,静态功耗大的不足,同时具有更强的抗单粒子翻转能力,以及更快的翻转恢复速度。
参考文献
[1] 王一奇,赵发展,刘梦新,等.基于RHBD技术的深亚微米抗辐射SRAM电路的研究[J].半导体技术,2012(1):18?23.
[2] ROCKETT L. An SEU hardened CMOS data latch design [J]. IEEE Transactions on Nuclear Science, 1989, 35(6): 1682?1687.
[3] WHITAKER S, CANARIS J, LIU K. SEU hardened memory cells for a CCSDS reed solonm encoder [J]. IEEE Transactions on Nuclear Science, 1991, 38(6): 1471?1477.
[4] 刘文平.硅半导体器件辐射效应及加固技术[M].北京:科学出版社,2013.
[5] 刘必慰,陈书明,梁斌.一种新型的低功耗SEU加固存储单元[J].半导体学报,2007(5):755?758.
[6] 陈超,吴龙胜,韩本光.130 nm NMOS 器件的单粒子辐射电荷共享效应[J].半导体技术,2010(1):46?49.
