Hf0.5Zr0.5O2铁电薄膜的制备和性能研究
2014-07-02李晨雨朱俊陈欢文
李晨雨,朱俊,陈欢文
(电子科技大学电子薄膜与集成器件国家重点实验室,四川 成都610054)
Hf0.5Zr0.5O2铁电薄膜的制备和性能研究
李晨雨,朱俊,陈欢文
(电子科技大学电子薄膜与集成器件国家重点实验室,四川 成都610054)
运用脉冲激光沉积方法,在Pt(111)基片上沉积制备Hf0.5Zr0.5O2铁电薄膜。通过对X射线衍射(XRD)分析表明,薄膜的正交相随衬底温度升高而增强,随薄膜厚度增加而减小。P-E电滞回线实验表明,提高衬底温度有助于增强薄膜铁电性能。400℃氧气中原位退火后薄膜剩余极化(2Pr)达到8μC/ cm2。5V以下薄膜漏电流密度为3.2×10-6A/cm2。Hf0.5Zr0.5O2薄膜的疲劳特性测试表明,在经过2×109次反转后可参与翻转总极化值有一定下降。
脉冲激光沉积;Hf0.5Zr0.5O2薄膜;铁电;XRD;疲劳测试
0 引 言
因为铁电存储器具有双稳态极化特性,普遍被认为是应用前景广泛的非易失性存储器。大多数研究都集中在钙钛矿结构的传统铁电材料上。然而传统钙钛矿结构的铁电薄膜在应用于硅基铁电存储器上,已经被证明有很多困难,如铁电尺寸效应、小的帯隙、与硅的界面许多不匹配、结晶过程中因热处理导致的退化等[1]。
近年来,二元氧化物HfO2、ZrO2因其高的介电常数,被广泛应用于场效应管栅介质层[2]。和大多数二元氧化物相似,HfO2、ZrO2被认为一般成中心对称的晶体结构,具有线性的介质特性。因此尽管这些氧化物被成功地引入微电子技术,但人们并没有考虑到它们除了电介质的这种有限的功能外的其他用途。
最近Johannes Müller等报道,HfO2薄膜在不同元素掺杂的情况下会出现铁电性,如Si,Y,Al, Zr[3-7]。这将对铁电存储器的发展产生很大的推进作用。氧化铪基铁电体与CMOS工艺兼容,为铁电存储器制造提供了更简便的方法。而且由于它的介电常数高,可以有效地减少FeFETs器件的尺寸,从而提高电路集成度,且适合未来开发三维器件。在各种掺杂材料中,Zr被认为最有发展前景,因为它的化学特性与Hf几乎相同。与其他掺杂材料相比在特定成分比附近(Hf∶Zr=1∶1)都具有较为明显的铁电性,适合大量生产。
掺杂HfO2薄膜的铁电性一般被认为来源于形成了非中心对称的Pbc21正交相晶体结构[3-7]。一般正交相的Hf0.5Zr0.5O2只有在高压环境下才是稳定相。但薄膜状态的Hf0.5Zr0.5O2在二维张应力或拉应力环境下很可能产生正交相的转换。Johannes Müller等人用原子层累积(ALD)技术制备了铁电性能良好的Hf0.5Zr0.5O2薄膜。通过XRD图谱分析,在30.5°的(111)取向的峰被认为是正交相的衍射峰[8]。
本文采用脉冲激光沉积(PLD)技术在以Pt(111)为底电极的 Si(001)基片上生长 Hf0.5Zr0.5O2铁电薄膜。并对其进行了XRD,P-E电滞回线,I-V特性,进行疲劳测试。
1 实验
本文所使用的Hf0.5Zr0.5O2靶材是由HfO2、ZrO2按照1∶1的化学计量比配置烧制而成。以Pt为底电极的Si(001)基片作为衬底材料。使用由沈阳中科仪器公司生产的PLD外延设备以及德国LAMBDAPHYSIK公司生产的脉冲宽度为30nsN的KrF准分子激光器(波长为248nm)。实验前基片分别是丙酮、酒精。在去离子水中用超声清洗3分钟,然后经过高纯度N2吹干后,迅速放入真空腔体。控制激光脉冲能量为140mj,频率为3Hz。在20pa氧压不同温度下生长Hf0.5Zr0.5O2薄膜。生长完成后薄膜在5×104pa氧压下原位退火30min。为了对薄膜进行电性能测试,本文利用电子束蒸发在Hf0.5Zr0.5O2薄膜上制备的Ti/Au电极,电极面积为0.00025cm2。
采用英国Bede公司生产的D1型多功能X射线衍射(XRD)仪分析薄膜生长取向以及结晶程度。I-V性能表征采用Hewlett-Packard 4155B半导体参数分析仪。P-E电滞回线测试和疲劳特性测试采用Radiant RT66A铁电测试仪。
2 结果与分析
2.1 薄膜结构分析
图1 为在不同衬底温度下生长的Hf0.5Zr0.5O2薄膜的XRD2θ扫描图谱。结果显示随着衬底温度升高,薄膜在28.5°的 (-111)单斜相衍射峰和38.5°的(102)正交相衍射峰均增强。说明薄膜结晶性能随衬底温度升高而增强。但是考虑到Hf0.5Zr0.5O2薄膜的铁电性能,应抑制中心对称的单斜相结构产生。

图1 不同衬底温度下制备的Hf0.5Zr0.5O2薄膜的XRD图谱
图2 是在相同条件下制备厚度不同的Hf0.5Zr0.5O2薄膜的XRD2θ扫描图谱。可以看到随着薄膜厚度增加,单斜相衍射峰(-111)逐渐增强。正交相衍射峰(102)则逐渐减弱。说明减小薄膜厚度可以有效地抑制单斜相产生。

图2 不同厚度Hf0.5Zr0.5O2薄膜的XRD图谱
2.2 薄膜铁电性能分析

图3 不同衬底温度下制备的Hf0.5Zr0.5O2薄膜的P-E电滞回线
图3 为不同衬底温度制备的Hf0.5Zr0.5O2薄膜的电滞回线。由图3可以看到,正常室温下薄膜呈顺电相。随着衬底温度升高,薄膜的剩余极化强度增强,矫顽场减弱。说明提高衬底温度可以有效提高薄膜铁电性,与前面XRD分析结果相符合。
图4 为400℃下制备的Hf0.5Zr0.5O2薄膜经过在400℃氧气中原位退火后的电滞回线。退火后的薄膜铁电性能提升较大,10V下最大剩余极化可以达到8μC/cm2。当电压加到11V时,薄膜漏电比较严重。同时看到,P-E曲线窗口没有闭合,这可能是由于采用了非对称的上下电极而导致的。

图4 400℃下氧气中原位退火后Hf0.5Zr0.5O2薄膜的P-E电滞回线
2.3 薄膜漏电性能分析
铁电薄膜的性能与其绝缘特性密切相关,因此测试薄膜漏电性能,图5所示。在测试范围内薄膜漏电流随电压增大而增加。在正负电压下,薄膜的漏电流曲线对称。在1V下薄膜漏电流密度为3.9×10-7A/cm2,在5V电压下漏电流密度为3.2×10-6A/cm2。结果表明Hf0.5Zr0.5O2薄膜具有良好的绝缘性能。

图5 在pt/Si上生长的Hf0.5Zr0.5O2薄膜的I-V特性曲线
2.4 薄膜疲劳特性分析
图6 为Hf0.5Zr0.5O2薄膜的疲劳特性曲线。测试频率1MHz,测试电压8V。由图6可以看到,薄膜的剩余极化在经过107次翻转后开始明显减小。经过2×109次翻转后,薄膜可参与翻转的总极化值下降了24.6%。这可能是在极化反转过程中,晶体内部内应力来不及释放,造成微小裂纹,破坏了电场的连续性,使得晶体的部分自发极化不能被电场反转,导致剩余极化减小。
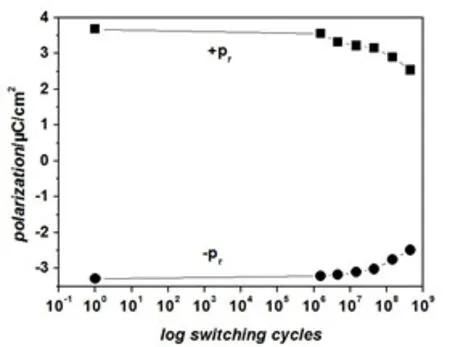
图6 在pt/Si上生长的Hf0.5Zr0.5O2薄膜的疲劳特性曲线
3 结 论
通过使用脉冲激光沉积法,在以Pt为底电极的Si(001)基片上制备出了Hf0.5Zr0.5O2铁电薄膜。其铁电性主要来源于非中心对称的正交结构。正交相与衬底温度和薄膜厚度有关。随着衬底温度升高,正交相增强。随着厚度增加正交相减弱。薄膜铁电性能随衬底温度增高而增强。在400℃氧气中原位退火后,薄膜剩余极化可以达到8μC/cm2,5V下漏电流密度达到3.2×10-6A/cm2。薄膜剩余极化在经过2×109次翻转后,可参与翻转总极化值下降了24.6%。实验表明Hf0.5Zr0.5O2具有良好的铁电性能和绝缘性能,能满足作为MFIS结构中铁电材料的要求。
[1]D.S.Jeong,R.Thomas,R.S.Katiyar,et al.Emerging memories:resistive switching mechanisms and current status[J].Rep.Prog.Phys.2012,75:076502.
[2]赵毅.高K栅介质研究进展[J].半导体技术,2004,29 (5):16-19.
[3]T.S.B?scke,J.Müller,D.Br?uhaus,et al.Ferroelectricity in hafnium oxide thin films[J].Appl.Phys.Lett. 2011,99:102903
[4]J.Müller,U.ScHf?der,T.S.B?scke,et al.Ferroelectricity in yttrium-doped hafnium oxide[J].Appl.Phys. 2011,110:114113.
[5]S.Müller,J.Müller,A.Singh,et al,Incipient ferroelectricity in Al-doped HfO2thin films[J].Adv. Funct.Mater,2012,22:2412.
[6]J.Müller,T.S.B?scke,U.ScHf?der,et al,Ferroelectricity in simple Binary ZrO2and HfO2[J].Nano Lett,2012,12:4318.
[7]M.H.Park,H.J.Kim,Y.J.Kim,et al.Evolution of phases and ferroelectric properties of thin Hf0.5Zr0.5O2films according to the thickness and annealing temperature[J],Appl.Phys.Lett,2013,102:112914.
[8]J.Müller,T.S.B?scke,D.Br?uhaus,et al,Ferroelectric Zr0.5Hf0.5O2thin films for nonvolatile memory applications[J].Appl.Phys.Lett,2011,99:112901.
责任编辑王荣辉
TN304
A
1674-5787(2014)03-0149-03
10.13887/j.cnki.jccee.2014(03).045
2014-04-22
李晨雨(1988—),男,重庆北碚人,硕士研究生,主要从事HfZrO系列铁电薄膜的制备及性能研究。
