盲埋孔结构多层厚铜印制板工艺的研究
2014-05-04天津普林电路股份有限公司天津300308
黄 镇(天津普林电路股份有限公司,天津 300308)
盲埋孔结构多层厚铜印制板工艺的研究
Paper Code: S-113
黄 镇
(天津普林电路股份有限公司,天津 300308)

以一典型含有复杂盲埋孔结构的多层(18L)厚铜PCB产品的工艺制造过程为主线,较详细的介绍了产品结构设计、主要工艺过程以及厚铜压合、层间对位等难点工艺的应对问题,并最终通过实际实验及分析得出较适用的工艺方法,为此类产品的加工提供了很好的指导意义。
多层压合;厚铜;盲埋孔
1 前言
随着电子信息时代的飞度发展,PCB产品的平均层数在不断增加,其中一部分应用电源线圈领域的PCB产品,其多为层数在10层以上的厚铜产品,且含有复杂的埋盲孔结构。此类多层埋盲孔产品的压合结构设计,无疑是其工艺过程的一个关键点,并且随之而来的涨缩比例、层间对位、以及板面压合翘曲等方面进行控制,也经常会让诸多工艺设计者头疼不已。
本文以典型含有复杂盲埋孔结构的多层(18 L)厚铜PCB产品的工艺制造过程为主线,较详细的介绍了产品结构设计、主要工艺过程以及厚铜压合、层间对位等难点工艺的应对问题,并最终通过实际实验及分析得出较适用的工艺方法,为此类产品的加工提供了很好的指导意义。
2 产品结构分析
以下为此18层厚铜产品孔结构(如图1所示),其铜厚要求均为105 μm,整体设计板厚达到约3.2 mm,产品压合将是主要工艺难点。
另外,如图1的产品外型及孔结构,在L2至L15层之间除了L11-L12、L13-L14以外,其余每层之间均有孔连接,孔结构非常复杂。这对产品结构设计的合理性,及盲埋孔工艺设计带来挑战。
3 产品结构可制造性设计
依据孔结构要求,设计叠层架构如下:先做L2-L11全积层结构,后与另外三个芯板(L12-L13、L14-L15、L16-L17)进行压合成为18层板。其中L2-L11全积层结构含有L6-L7的埋孔,其余积层为盲孔,L12-L13及L14-L15两个芯板含有埋孔结构。埋孔使用机械钻加工,后进行孔化,盲孔使用开窗激光钻方法加工。
产品整体工艺将历经4次激光钻、5次压合、8 次孔化、13次图转,工艺流程复杂,难点工艺在于厚铜板的多次压合及最后一次压合的层间对位。
3 主要工艺层可制造性设计
依照产品可制造性设计原则,依据最初要求以及现有工艺能力,设计产品加工主要工艺层规格。
(1)依照产品结构设计,产品理论最终板厚约为3.6 mm。
(2)与客户协商在可以满足产品使用要求前提下,外层最终铜厚设计为70 μm。
(3)表面工艺变更为无铅热风。
(4)盲孔结构使用开窗激光钻法加工,孔径设计为0.2 mm。
(5)埋孔结构使用机械钻加工,孔径设计为0.3 mm。
(6)通孔孔径设计为1.7 mm。
(7)因产品压合次数较多,板厚公差设定为± 15%;
4 拼版设计
因产品单元结构较小(25 mm×26.5 mm),设计使用面包板拼版结构加工,并优化各内层的平衡铜分布,尽力较少厚铜无铜区域,以减低对压合的影响,同时优化最终的成型铣程序,减少平衡铜对成型铣影响(图1)。
5 层间对位及芯板比例匹配设计
产品的最后一次压合为L2-L11的全积层芯板,与另外三个芯板L12-L13、L14-L15、L16-L17进行压合,此次压合的层间对位将是整体工艺的主要难点。为保证四个芯板的比例一致性,设计工艺控制为:在L2-L11全积层芯板压合后使用XRAY测得其涨缩比例,后再投产L12-L13、L14-L15、L16-L17三个芯板,其中L12-L13、L14-L15的埋孔钻孔比例与L2-L11 XRAY实测比例一致,L16-L17的内层图形转移比例与L2-L11 XRAY实测比例一致。这样在四个芯板到达最后一次压合时,可实现一致的图形比例,避免不同比例的压合层间错位的出现(图2)。

图1 拼版示意图

图2
6 主要工艺难点识别管控
(1)L6-L7、L12-L13、L14-L15芯板为 0.1 mm,105 μm/150 μm基铜规格,因板厚过薄,机械钻埋孔无法去毛刺。应对办法为:使用次外层化学清洗,酸洗微蚀法处理去毛刺。
(2)L6-L7、L12-L13、L14-L15芯板为 0.1 mm,105 μm/150 μm基铜规格,图形转移、AOI检测、棕化等序易出现操作性折片。应对办法为:对产品周转、搬运、操作过程进行特殊管控。
(3)最后一次压合结构不对称,是关键难点(存在可能的对位、板面翘曲等问题)。应对办法为:设定使用含有销钉定位的Pinlam系统压合,并设计备用实验方案。
7 样品工艺过程的主要问题
L2-L11开窗激光钻的积层结构,为有L6-L7开始进行全积层工艺加工,历经4次压合,每次压合后进行图转,在盲孔对应位置蚀刻开窗,后进行激光钻及孔金属化,依照所设计的工艺及对位系统可正常加工。但过程加工中,遇到的主要问题为:经多次压合,板材收缩太大。
L2-L11全积层结构,历次压合后XRAY测试比例趋势如图3所示:样品加工过程L6-L7钻孔预放比例为:X1.0006,Y1.0008,每次压合后X、Y方向的收缩均较大,Y方向单次压合收缩最大达到了约万分之7.8(比例缩小值)。最后一次压合后,实际反算可满足最终1:1比例的预放比例为:X1.00106,Y1.00281。
过程中发现此问题后,在保证对位的情况下,对第二次及以后的压合比例进行了适当人为调整(调整值),以避免最终比例收缩太大。

图3 压合后XRAY测试比例趋势图
8 工艺难点突破 —— 最终压合
最终压合(第5次压合)为四个芯板压合(表1),且四个芯板板厚差距较大,L2-L11板厚约2.2 mm,而其余三个芯板板厚仅约0.3 mm,为保证保证层间对位,设计使用 Pinlam 冲孔定位压合。
(1)压合实验一
为验证不对称结构的压合问题,不影响线圈性能的前提下,设计实验试压以下两种结构:其中A结构为正常压合结构,B结构为将L12-L13及L14-L15两个芯板移到了L2-L11的前面,试压验证两种结构对的板面翘曲程度影响(图4)。
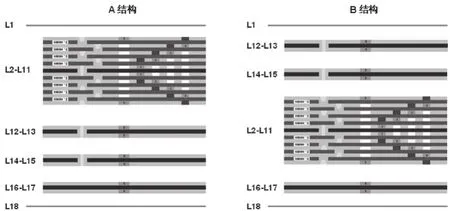
图4
实际试压结果为:A、B两种结构压合后表现出轻微板翘(可接受),却都出现了严重的层间偏移(图5),其中A结构相对偏移量最大约0.2 mm(相对中心),B结构最大偏移量约0.16 mm,且由各层中心偏移量可以看出,较大的偏移量主要出现在L14-L15等较薄的芯板上,偏移方向主要为Y方向。初步分析,冲孔定位法可能存在问题,同时存在一定程度的薄、厚芯板涨缩不一致(图5~图8)。

图5 A、B两种结构均出现了层间错位

表1

图6 A结构各层相对中心偏移量

图7 B结构各层相对中心偏移量

图8 A、B层间错位金相
(2)实验二
为验证冲孔定位法是否存在问题,将 L12-L13、L14-L15、L16-L17 三个芯板单独压合,并且定位法同使用热熔定位,压合后检验对位情况,未出现类似整体压合出现的严重层间偏移。
依据三个芯板压合未出现错位的结果,同样使用热熔定位法,按照正常产品结构(A结构)试压2P板,检查层间对位,结果对位良好。后按此法加工其余产品,均无问题。由此分析,以冲孔定位法进行压合时出现层间偏移现象,而热熔定位法则没有此问题,说明两种定位方式针对此产品结构存在压合效果上的差异。

(3)结果分析
两种定位方式对此产品的压合形成了不同效果,经分析原因:热熔定位方式为采用两点定位,且定位孔为使用XRAY钻靶标中心形成,定位孔周围周围有铜层支撑,在进行套销钉热熔时,可起到较好的定位作用。而冲孔定位方式,采用中心定位法,所使用冲孔模具大小固定,且冲孔对位靶标与实际冲孔位置有一定距离。
当板材收缩较大时,冲孔定位法情况下,冲孔定位靶标与实际冲孔位置距离变小了,但冲孔模具仍按照固定距离冲孔,将会出现冲孔错位,导致冲出来的孔边缘遗留一部分基材,无外围铜层支撑,在套销钉压合过程中容易出现拉脱,从而出现层间错位,而热熔则不会有类似问题。
9 结语
(1)多层厚铜埋盲孔PCB产品在电源应用领域已趋于常见,此类产品因其较复杂的埋盲孔结构的存在,所以合理设计压合结构及各个工艺层的对位系统是整体可制造型设计的关键点。
(2)厚铜产品的压合,在选用半固化片时须考虑使用充足的胶量,以避免贫胶、白斑问等问题的发生。另外,因胶量多,压合次数多,所带来的板材收缩较大的问题,需依照经验在最初的预放比例时给予考虑。
(3)此产品的最后一次压合,各芯板比例的一致性可通过按照工艺过程比例控制来获得。同时此次压合也验证了厚度差距较大的芯板压合时,只要压合所用半固化片结构较为对称情况下,对板面翘曲的影响贡献不大。
(4)针对板材收缩较大的情况,压合工艺过程需要依据产品特点考虑选用适合的层间定位方法,如在此情况下热熔两点定位法更优于冲孔定位法。
[1] 柴均钊. 压合理论及应用探讨[J]. 印制电路信息, 2000, 11.
[2] 吕永. 厚铜板压合工艺研究[C]. 2012秋季国际PCB技术/信息论坛论文集.
[3] Clyde F. Coombs Jr. PRINTED CIRCUITS HANDBOOK, Sixth Edition.
黄镇,电子科学与技术(微电子技术)专业,负责工艺研发相关工作。
Study on the process of multilayer thick copper board with blind and buried via structure
HUANG Zhen
This article is based upon a typical multilayer(18 Layer) thick copper PCB production, which is with bilnd and buried Via structure, it particular introduced the design and main process of the production, also the press of thick copper and lanmination method for this special structure. And finally based on the analysis of actual experiment, it raised some proposal which is more suitable for the special structure, provided good guidance significance to the manufaction.
Multilayer Pressing; Thick Copper; Blind and Buried Via
TN41
A
1009-0096(2014)04-0165-04
