宽禁带半导体关键设备技术及发展
2013-03-23颜秀文
颜秀文,武 祥
(中国电子科技集团公司第四十八研究所,湖南 长沙 410111)
随着微电子技术的发展,传统Si和GaAs半导体器件性能已接近其材料本身决定的理论极限。而以碳化硅(SiC)、氮化镓(GaN)为代表的宽禁带半导体材料,由于具有宽带隙、高饱和漂移速度、高临界击穿电场等突出优点,成为制作大功率、高频、高温及抗辐照电子器件的理想替代材料(材料性能参数见表1)。以雷达T/R组件的应用为例,宽禁带半导体器件在同等电特性条件下,可以使体积缩小为Si器件的1/2以上,质量至少减轻一半,是实现T/R组件高性能、小型化的关键[1-4]。

表1 半导体材料性能参数[5]
美国WBGSTI、欧洲ESCAPEE和日本NEDO等多项研究计划都在大力推动宽禁带半导体技术发展。国际上多家半导体厂商相继推出高功率、高频、高温的宽禁带半导体产品,并已向军用、民用领域进行应用扩展。在美国,Cree公司l0 W和60 W的A/AB类放大器已经实用化[6]。SiC MESFET已经正式装备美国海军的新一代E2D(先进鹰眼)预警机[7]。在欧洲,SiCrystal公司已实现准75mm、准100mmSiC衬底的量产,Rohm、ABB等已推出SiC电子器件产品并已实现工业应用。
1 宽禁带器件发展面临的设备问题
国内宽禁带半导体功率器件 (主要是SiC MESFET和GaN HEMT)的研究始于20世纪末,经过10多年的发展,国内已在宽禁带半导体材料与器件方面积累了一定经验。但与国外最高水平相比还有很大差距。从技术层面上讲,国外设备禁运、国产设备技术落后是导致我国宽禁带器件技术水平上不去的重要原因。尤其是用于宽禁带材料、器件制造的关键设备依赖进口,严重制约了我国宽禁带器件技术水平的发展。主要体现在:
(1)晶体生长和器件工艺温度高。SiC晶体生长温度高达2400℃,GaN外延的工艺温度也高达1300℃~1600℃。因此,一般半导体工艺设备通常不能直接用于宽禁带半导体材料和器件的研制。
(2)材料硬度大,化学性质稳定。SiC晶体的莫氏硬度高达9,仅次于金刚石。因此,用于SiC材料的切割、研磨、倒角和抛光方面的工艺设备,要求具有更高的稳定性和可靠性。
(3)器件制造涉及多种特殊工艺。SiC材料难以直接金属化的方式形成欧姆接触,SiC半导体的掺杂及热激活也是个技术难题,通常采用SiC离子注入技术解决。这对离子注入设备的注入温度、注入能量、注入均匀性等方面提出了特殊要求。
可见,宽禁带半导体材料及器件制造设备通常具有高温、高稳定、高可靠、工艺特殊等特点,通用半导体工艺设备已难以满足宽禁带半导体材料和器件的研制需要,必须花大力气予以解决。
2 宽禁带半导体制造关键装备
宽禁带半导体材料及器件制造设备涉及长晶、切割、研磨、倒角、抛光、SiC外延(或GaN外延)、离子注入、退火、刻蚀、金属化等10多种设备。其中,长晶、外延、注入等过程涉及的设备直接影响到晶体质量和器件性能,在某种程度上直接决定了宽禁带器件的性能指标。因此,宽禁带半导体制造装备技术的自主可控关键是要重点解决长晶、外延、注入等过程涉及的SiC晶体生长炉、SiC外延生长炉、SiC高温离子注入机和GaN高温MOCVD设备。
2.1 SiC晶体生长炉
改进Lely法是利用在超过1800℃高温时,SiC高温升华分解的特性进行晶体生长,是目前生长大尺寸SiC晶体的主要方法。改进Lely法又被称为籽晶升华法或物理气相输运法[8]。通常,SiC晶体生长温度要求在2100~2400℃范围内,生长的反应室压力控制在1.33×10-4~2.66×103Pa之间,源和籽晶区间(如图1所示)的温度梯度要求在20~35 ℃/cm[9,10]。
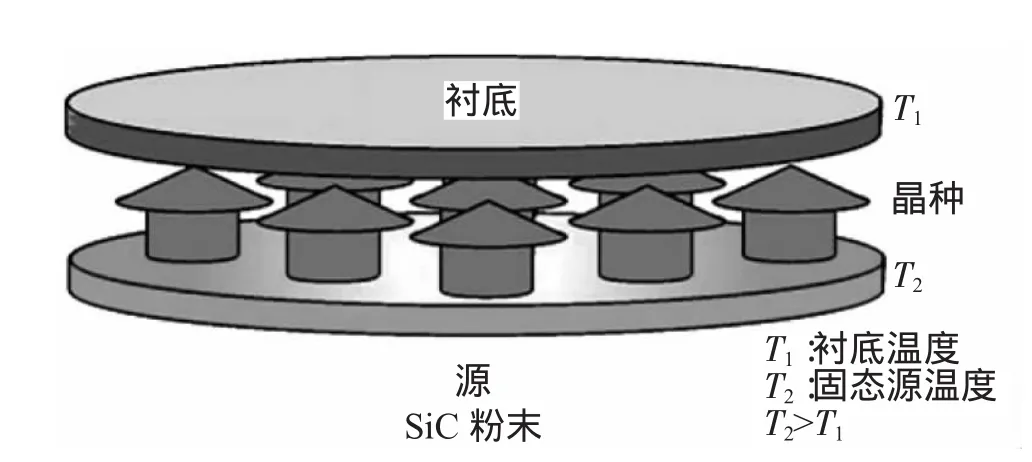
图1 源和籽晶温度梯度结构示意图
因此,对SiC晶体生长设备而言,不仅要求实现高温环境,而且对温度梯度、反应压力、气体流量都有高精度控制要求。另外,由于SiC高温分解产物众多,晶型多样,对内壁材料、杂质控制要求高,因此,工艺支持尤为重要。
图2为SiC晶体生长(改进Lely法)设备反应室结构示意图。可见SiC晶体生长炉的反应器主要由射频加热器、SiC粉料、坩埚、保温层、籽晶、气流层等组成。设备的主要技术指标要求如表1所示。

图2 SiC晶体生长反应室结构示意图

表1 SiC晶体生长炉主要技术指标要求[11]
2.2 SiC外延生长炉
SiC化学气相外延(CVD)生长的原理如图3所示:CVD气源组份主要采用SiH4-C3H8-H2体系。SiH4→Si+2H2,C3H8→3C+4H2,Si+C→SiC。通常SiC CVD外延的温度要求在1200~1800℃范围内,反应压力控制在1.33×104~1.01×105Pa之间[12,13]。

图3 SIC CVD反应原理图
对SiC CVD外延生长设备而言,根据结构、水冷、反应压力的不同,可分为卧式冷壁常压反应器、卧式热壁常压反应器和立式冷壁低压反应器。其中,美国Emcore推出了商用立式冷壁SiC CVD外延系统,并已在SIMENS和Howard大学获得应用。德国AIXTRON推出了商用卧式热壁SiC CVD外延系统(如图4所示),该系统通过独特的内套管设计实现了反应器内部的层流。目前德国AIXTRON公司VP2400HW配置有6×准100mm载片量,是国际领先的碳化硅商用CVD设备生产商[14]。设备的主要技术指标要求如表2所示。

图4 VP508型SiC外延生长炉
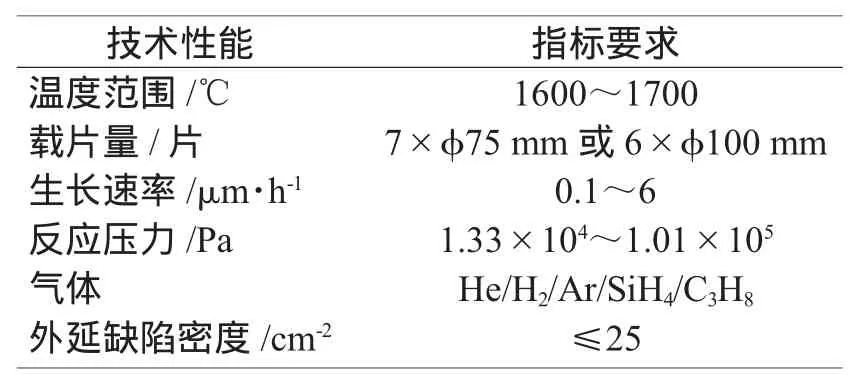
表2 SiC外延生长炉主要技术指标要求[15]
2.3 SiC离子注入机
与硅材料相比,SiC材料难以通过扩散实现半导体掺杂,离子注入和外延是实现SiC半导体掺杂的主要方式。与传统的离子注入设备相比,SiC离子注入要求注入温度更高、注入能量更高,以激活掺杂的注入离子。以,Al+注入SiC掺杂为例,200℃条件下进行Al+注入掺杂,在1600℃退火后,Al+激活率只有4%;如果在600℃下进行Al+注入掺杂,经1600℃退火后,理论上注入Al+可达到90%的激活率[16]。因此,SiC离子注入通常要求注入温度达到500~600℃,注入能量单电荷达到30~350 keV,注入能量双电荷最高达到700 keV。
SiC离子注入机的原理如图5所示,通过离子源引出离子束进行质量分析、束聚焦、分离、偏转,注入到高温靶盘晶片表面,实现SiC晶体材料的离子注入掺杂。目前,国际上仅有日本ULVAC公司推出了量产型碳化硅离子注入设备“IH-860D SIC”(见图6),已在SiC电力电子器件领域获得广泛应用[17]。设备的主要技术指标要求如表3所示。

图5 SiC离子注入结构示意图

表3 SiC离子注入机主要技术指标要求[18]

图6 UHVCVD公司IH-860D SIC设备
2.4 GaN高温MOCVD
MOCVD设备是GaN晶体材料外延生长的核心装备。对高频、大功率微波器件所需的高Al组份AlGaN/AlN、AlGaN/GaN材料外延生长而言,Al组份严重依赖于生长温度。通常,高质量高Al组分AlGaN材料外延需要1400℃的高温条件。LED领域GaN MOCVD外延生长的反应温度通常控制在1200℃以下;用于太阳能电池制造的GaAs MOCVD反应温度更低,通常控制在800℃以下[19]。设备的主要技术指标要求如表4所示。
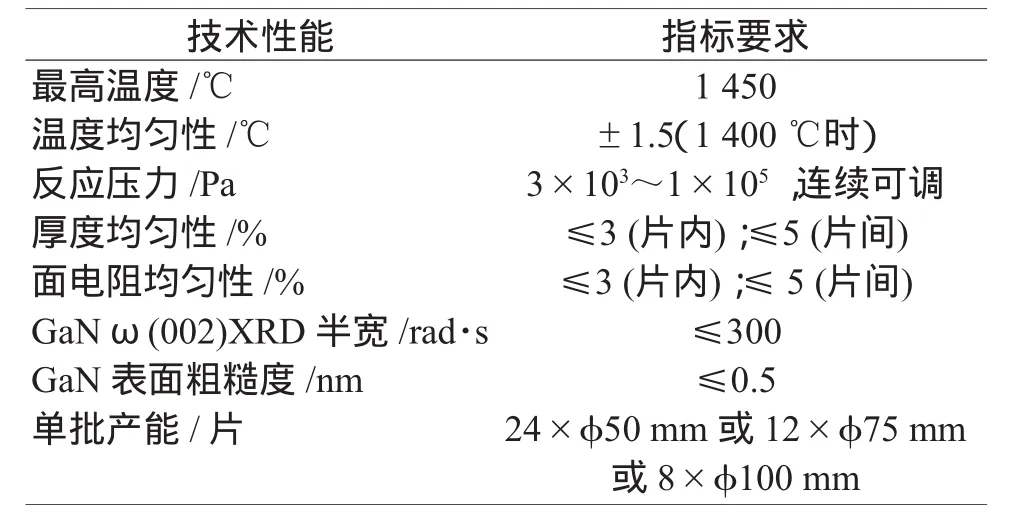
表4 GaN高温MOCVD主要技术指标要求[21]
目前,国际上GaN MOCVD设备市场基本被德国AIXTRON公司和美国VEECO公司所垄断。用于高Al组份AlGaN材料外延的高温MOCVD设备德国AIXTRON公司的AIX2600G3 HT(见图7)机型较为成熟,可达到1400℃工艺温度,能够满足24×准50mm或12×准75mm或8×准100mm的产能需要[20]。国内,目前已研发出1200℃以下实验型MOCVD设备产品,且生产效率和生产成本差距甚远;实用化的高温MOCVD设备国内还是空白。高温MOCVD设备难以突破,在技术层面主要由于1400℃条件下长期运行带来的加热隔热、源材料预分解、副反应严重、反应器污染等问题。

图7 AIX260G3 HT高温MOCVD设备
3 结 论
宽禁带半导体设备技术是宽禁带半导体器件发展的技术支撑和重要基础。对SiC、GaN、AlN等宽禁带晶体材料而言,要求研制的晶体生长炉满足宽禁带晶体材料大尺寸、低缺陷、低成本的技术发展趋势。同时,宽禁带材料制备新工艺的发展也带动了晶体生长设备的技术创新,如用于氮化物宽禁带材料制备的HVPE设备、氨热法合成设备、钠盐LPE设备等。对宽禁带器件制造而言,要求研制的外延设备、MOCVD设备满足衬底材料大尺寸,外延层低缺陷、高均匀性、高一致性,低成本的技术发展趋势。同时,宽禁带器件制造还要求离子注入特殊工艺,满足碳化硅等材料的选择性掺杂、欧姆接触等,最终实现宽禁带器件的高性能、低成本。
目前,宽禁带半导体技术理论体系日臻完善,宽禁带半导体材料日趋成熟,宽禁带半导体器件也已取得突破,为宽禁带半导体设备技术的发展带来了巨大机遇。随着技术的进步。宽禁带半导体器件在军工电子、电力电子、半导体照明等应用领域将迅速扩大,具有巨大的市场发展潜力。我们必须科学分析、冷静面对宽禁带半导体技术带来的历史机遇,制订科学的发展规划,加大宽禁带半导体设备技术的投入力度,抓住宽禁带半导体发展的新机遇。
[1]毕克允,李松法.宽禁带半导体器件的发展[J].中国电子科学研究院学报,2006,1(1):21-26.
[2]张波,邓小川,陈万军,等.宽禁带功率半导体器件技术[J].电子科技大学学报,2009.38(5):618-623.
[3]蔡树军,冯震,敦少博,等.宽禁带半导体研究现状与发展趋势[C].第十五届全国化合物半导体、微波器件和光电学术会议,中国广州,2008:509-512.
[4]周万幸.宽禁带半导体功率器件在现代雷达中的应用[J].现代雷达,2010,32(12):1-6.
[5]Osamu Oda.Compound Semiconductor Bulk Materials and Characterizations[M].World Scientific,Japan,2007.
[6]郑新.新型半导体功率器件在现代雷达中的应用研究(Ⅰ)[J].半导体技术,2009,34(9):828-833.
[7]郑新.新型半导体功率器件在现代雷达中的应用研究(Ⅱ)[J].半导体技术,2009,34(10):937-942.
[8]Michael Shur.SiC Materials and Devices[M].World Scientific,USA,2007.
[9]Cassidy J B,Johnson R w.Status of silicon carbide(SiC)as a wide-band gap semiconductor for high-temperature applications:Review[J].State Electronics,1996,39(10):1409-1415.
[10]Q.S.Chen,V.Prasad,H.Zhang,et al.Silicon Carbide Crystals-Part II:Process Physics and Modeling[M].Elsevier B.V,USA,2009.
[11]F.Peter,K.Tsunenobu,L.Ley,et al.Silicon Carbide:Growth,Defects,and Novel Applications[M].World Scientific,UK,2004.
[12]M.Razeghi,M.Henini.Optoelectronic devices:III-nitrides[M].Elsevier B.V.UK,2004:43.
[13]M.G.Spencer.SiC Growth technology in Europe[R].KGB Consulting Ltd,2010.
[14]J.A Powell,J B.Petit.Advances in Silicon Carbide Chemical Vapor Deposition(CVD)for Semiconductor Device Fabrication[C].NASA Technical Memorandum,2005.
[15]永広和夫.窒化物系化合物半導体に係る技術戦略マップ作成に関する調査報告書[R].Japan,2007.
[16]www.aixtron.com
[17]A.Hallena,M.S Jansona,Y.Kuznetsova,et al.Ion implantation of silicon carbide[J].Solid-State Lett.2002,186:186-194.
[18]R.Nipoti,F.Mancarella,F.Moscatelli,et al.Carbon-Cap for Ohmic Contacts on Ion-Implanted 4H-SiC[J].Solid-State Lett.2010,13(12):432-435.
[19]Moscatelli,Andrea Scorzoni,Antonella Poggi,et al.Advances in selective doping of SiC via ion implantation[J].Mater.Res.Soc.Symp.Proc.2006,Vol911:1-7.
[20]Talal Mohammed.MOCVD growth and characterization of Al-rich AlN/AlGaN epilayers and quantum wells[D].Kansas State University,USA,2007.
[21]H.Yu,E.Ulker,E.Ozbay.MOCVD growth and electrical studies of p-type AlGaN with Al fraction 0.35[J].J.Crystal Growth.2009,66:221-225.
