具有SiC缓冲层的Si衬底上直接沉积碳原子生长石墨烯
2011-12-11康朝阳李利民徐彭寿
唐 军 康朝阳 李利民 徐彭寿,*
(1中国科学技术大学国家同步辐射实验室,合肥230029;2合肥彩虹蓝光有限公司,合肥230011)
具有SiC缓冲层的Si衬底上直接沉积碳原子生长石墨烯
唐 军1,2康朝阳1李利民1徐彭寿1,*
(1中国科学技术大学国家同步辐射实验室,合肥230029;2合肥彩虹蓝光有限公司,合肥230011)
石墨烯是近年发现的一种新型多功能材料.在合适的衬底上制备石墨烯成为目前材料制备的一大挑战.本文利用分子束外延(MBE)设备,在Si衬底上生长高质量的SiC缓冲层,然后利用直接沉积C原子的方法生长石墨烯,并通过反射式高能电子衍射(RHEED)、拉曼(Raman)光谱和近边X射线吸收精细结构谱(NEXAFS)等实验技术对不同衬底温度(800、900、1000、1100°C)生长的薄膜进行结构表征.实验结果表明,在以上衬底温度下都能生长出具有乱层堆垛结构的石墨烯薄膜.当衬底温度升高时,碳原子的活性增强,其成键的能力也增大,从而使形成的石墨烯结晶质量提高.衬底温度为1000°C时结晶质量最好.其原因可能是当衬底温度较低时,碳原子活性太低不足以形成有序的六方C-sp2环.但过高的衬底温度会使SiC缓冲层的孔洞缺陷增加,衬底的Si原子有可能获得足够的能量穿过SiC薄膜的孔洞扩散到衬底表面,与沉积的碳原子反应生成无序的SiC,这一方面会减弱石墨烯的生长,另一方面也会使石墨烯的结晶质量变差.
石墨烯;分子束外延;Si衬底;碳化硅;同步辐射
1 引言
石墨烯自从2004年被Geim研究小组1发现以来引起了人们越来越多的关注.由于其奇特的物理和化学特性,如高的载流子迁移率(约为200000 cm2·V-1·s-1)、2室温下亚微米尺度的弹道传输特性(300 K时可达0.3 μm)、3优良的导热性能(可达5000 W·m-1·K-1)、4单分子气敏特性、5等,石墨烯有望在微电子器件、传感器及储能材料等方面获得广泛应用.目前在石墨烯的制备方面已经取得积极的进展,发展了机械剥离、1晶体外延生长、6,7化学氧化、8化学气相沉积9和有机合成10等多种制备方法.然而,这些方法制备的石墨烯通常需要特殊的衬底或需要把制备的石墨烯转移到其它合适的衬底材料上才能进行微电子器件的设计和利用,不能直接与目前广泛应用的Si基半导体工艺相结合,而且转移过程中会不同程度地破坏石墨烯的结构和性质.因此,为了能把石墨烯器件和Si基衬底很好地结合起来,在Si基衬底上直接制备出石墨烯材料是一个很好的途径.Hackley等11尝试利用在Si衬底上沉积一定厚度的非晶碳膜,然后用不同的温度退火制备出了多晶石墨薄膜,但是实验结果显示该薄膜并不具有石墨烯的特征.为了和在SiC单晶上外延生长石墨烯的方法相结合,最近出现了一些先在Si衬底上生长SiC然后在真空中高温退火生长石墨烯的报道,12-14但是这种方法不得不考虑的一个问题就是太高的退火温度会使Si衬底受到破坏,而且用此方法生长的石墨烯质量也不高.我们已经开展了利用固源分子束外延(MBE)技术在Si衬底上通过直接沉积C原子的方法制备石墨烯的工作.15研究结果发现在衬底温度达到800°C时在Si衬底上形成了石墨烯,而在C原子沉积的初始阶段形成的一层碳化硅缓冲层促进了较高质量石墨烯的形成.为了在Si衬底上制备更高质量的石墨烯,在本文中我们尝试先在Si衬底上生长一层高质量的SiC缓冲层,然后直接沉积C原子生长石墨烯.
2 实验
样品是在自建的固源分子束外延(SSMBE)设备上制备的.Si和C源由电子束蒸发器提供.生长室和预处理室本底真空可达到6.0×10-8Pa,样品架温度可达到1300°C.蒸发速率和薄膜厚度通过石英晶振膜厚监测仪原位测量并经过台阶仪校准,膜厚监测仪型号为MAXTEK公司的TM-350.
衬底选择p型Si(111).放入真空室前,衬底经过如下处理:(1)使用分析纯的四氯化碳、丙酮、乙醇、去离子水超声清洗以除去油污;(2)用浓硫酸和双氧水混合液浸泡后并用去离子水冲洗,除去残余的金属和有机物;(3)5%的氢氟酸溶液浸泡3 min以刻蚀掉表面的原生氧化层;(4)去离子水冲洗数次并用高纯氮气吹干,迅速放入到真空室.样品的制备步骤如下:(1)衬底温度升高至800°C,生长约30 nm厚的Si缓冲层,Si源的蒸发速率约为0.5 nm·min-1; (2)衬底温度升高到850°C条件下,单独蒸碳,对清洁的Si(111)表面进行碳化,碳化时间约为15 min,蒸发速率约为0.1 nm·min-1;(3)保持在1000°C条件下通过Si、C原子共沉积方法外延SiC薄膜,保持硅碳比为1.5:1,其中碳的蒸发速率为1 nm·min-1,薄膜厚度约为100 nm,SiC缓冲层的中止面是(0001)面;(4)改变衬底温度,分别保持为800、900、1000、1100°C条件下单独沉积C原子生长石墨烯薄膜,保持碳原子的蒸发速率约为0.05 nm·min-1,沉积的碳膜厚度约3 nm.
生长过程中利用RHEED实时监测样品表面结构的变化,生长后的样品分别进行Raman和NEXAFS表征.RHEED的工作电压在21 kV,发射电流为50 mA.Raman利用美国SPEX公司的RAMANLOG 6激光拉曼仪在室温下采集数据,使用波长为514.5 nm的氩离子激光器激发,波数精度为±1 cm-1.样品中C的K边NEXAFS谱的采集是在合肥国家同步辐射实验室(NSRL)U19光束线软X射线磁性圆二色实验站完成的,光子能量扫描范围为280-320 eV,入射光与衬底的夹角为40°,采用全电子产额(TEY)模式收集信号.
3 结果与讨论
图1为实验过程中获得的不同样品表面的RHEED图.图1(S0)为生长Si缓冲层后获得的衬底表面RHEED图,从图中可以看出具有较清晰的Si(111)-(7×7)重构,表明衬底表面清洁有序.为了阻止沉积到衬底表面的碳原子与衬底硅原子的反应,在Si(111)衬底表面先生长一层高质量的SiC缓冲层.根据我们16-18以前获得的Si表面外延生长SiC的优化工艺条件,我们选择在1000°C条件下通过Si、C原子共沉积方法外延SiC薄膜,保持硅碳比为1.5: 1,其中碳的蒸发速率为1 nm·min-1.图1(S1)、(S2)、(S3)、(S4)为不同样品在1000°C下生长了SiC薄膜后样品表面的RHEED图.从图中可以看出,每个样品在生长SiC后表面的晶格结构都表现为衍射条纹,且条纹明锐细长,由此说明在Si衬底上异质外延生长的SiC薄膜的结晶质量都比较好.在覆盖有SiC缓冲层的Si衬底上,分别在不同衬底温度下直接沉积碳原子.图1(S1ʹ)、(S2ʹ)、(S3ʹ)和(S4ʹ)分别为保持衬底温度为800、900、1000和1100°C条件下,沉积了约3 nm碳薄膜后获得的RHEED图,保持碳原子的蒸发速率约为0.05 nm·min-1.从图中可以看出沉积碳后,SiC的衍射条纹变得较模糊甚至几乎消失,但是每个图中都出现了由于沉积碳膜而产生的衍射环.虽然每个衍射环的半径及出现的位置类似,但是衍射环的明锐度有差异.图1(S1ʹ)中衍射环较弱且SiC薄膜的衍射斑点几乎完全消失;图1(S2ʹ)中衍射环也较弱但SiC薄膜衍射斑点仍然存在;图1 (S3ʹ)中不仅SiC薄膜的衍射斑点还存在,而碳膜的衍射环较明锐且出现了二级环;图1(S4ʹ)中衍射环又变得较弱,但SiC斑点却变得较明显.因此,通过样品表面RHEED图的变化可以看到,在800°C下沉积碳原子形成的碳膜可能不够致密且结晶度较差,对碳化硅缓冲层的有序性也有影响,因此在RHEED图中只能看到衍射环存在;而到900°C后形成的碳膜致密度和结晶度提高,致使RHEED图中不仅出现衍射环还能看到弱的SiC斑点;提高到1000°C后,碳原子的活性进一步提高,可以形成结晶度较好的碳膜,所以在RHEED图中可以看到具有二级的碳膜衍射环且SiC的衍射斑点也较清晰;最后到1100°C后,RHEED图中的衍射环却变弱,这可能是由于SiC缓冲层是在1000°C下制备的,当衬底温度升到1100°C后,会使SiC缓冲层中的孔洞等缺陷增加,来自衬底的部分Si原子具有足够的能量通过SiC缓冲层中的孔洞等缺陷扩散到样品表面与沉积的碳原子反应,从而阻止表面碳膜的生成,致使碳膜的生长速率和结晶质量降低.
Raman光谱是碳材料的标准表征技术,也是一种高效率、无破坏的石墨烯检测手段.拉曼谱的形状、宽度和位置与外延层的层数和外延层与衬底界面信息等有着紧密的联系.19,20为了研究样品表面生长的碳薄膜的结构特点,对样品进行了拉曼光谱的测试,结果如图2所示,图中所有样品扣除了SiC缓冲层的影响.图2中(a)、(b)、(c)、(d)和(e)图分别对应于在800、900、1000、1100°C条件下生长的碳膜样品和高定向热解石墨(HOPG)的拉曼谱.从图中可以看出,在制备的所有样品的拉曼谱中都存在G峰、2D峰和D峰.拉曼谱中位于1580 cm-1附近的G峰是由于布里渊区中心声子退化E2g模式导致的,它是样品中C-sp2键的反映.如果在拉曼中发现G峰,就可以说明样品中含有碳的sp2网状结构.21位于2700 cm-1附近的2D峰,是由在第一布里渊区K点附近涉及双声子双共振拉曼激发引起的,22通常G峰和2D峰可以作为石墨烯形成的特征拉曼峰.根据图2拉曼结果可以判断,在800、900、1000、1100°C条件下生长的碳膜样品都具有石墨烯的结构特征;但是不同温度下样品的拉曼谱中G峰、2D峰及D峰的强度、位置和峰形各不相同,说明所制备石墨烯薄膜的质量有差异.为了得到更准确的拉曼谱峰的信息,我们利用Xpspeak软件对拉曼谱中的G峰和Dʹ峰进行了拟合,如图3所示.对于不同温度下获得的样品在~1600 cm-1位置的峰实际上可以分解为两个峰,分别为来自石墨烯的位于~1580 cm-1的G峰,和位于~1623 cm-1处的Dʹ峰.Dʹ峰和位于1350 cm-1附近的D峰都是C-sp与C-sp3键的体现,此二峰是由石墨的无序性诱导(disorder-induced)与缺陷引起的.对于极为有序、无缺陷的单晶石墨或石墨烯样品的拉曼光谱观察不到这两个峰的存在.22另外我们还对图2中的主要谱峰进行了拟合分析,得到了G峰和2D峰的准确位置、半高宽等信息,并计算了G峰与D峰积分强度比值(IG/ID),和2D峰与G峰积分强度的比值(I2D/IG),如表1中所示.
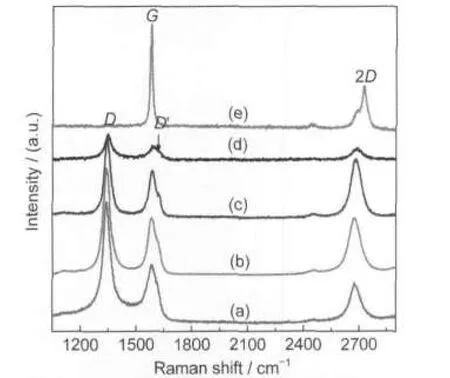
图2 不同温度下生长碳膜样品扣除SiC信号后得到的拉曼谱图(a-d)及HOPG的拉曼谱图(e)Fig.2 Raman spectra of the samples grown at different temperatures after deducting SiC single (a-d)and HOPG(e)(a)800°C,(b)900°C,(c)1000°C,(d)1100°C;HOPG:highly oriented pyrolytic graphite;G:the band located at~1580 cm-1in the Raman spectrum,2D:the band located at~2700 cm-1in the Raman spectrum,D:the band located at~1350 cm-1in the Raman spectrum, Dʹ:the band located at~1620 cm-1in the Raman spectrum

图3 不同温度下的拉曼谱中G峰和Dʹ峰的分解谱图Fig.3 Line shape fits of G and Dʹbands in Raman spectra grown at different temperatures(a)800°C,(b)900°C,(c)1000°C,(d)1100°C
从表1中可以看出,随着生长温度的增加,G峰位置向高频移动.一般认为G峰的移动是薄膜中存在应力的体现;23另外可以看出在1000°C下制备的样品的G峰半高宽是最小的,半高宽小表示晶体取向性好.由于D峰代表的是石墨烯薄膜内的缺陷,而G峰代表的是石墨烯薄膜的结晶性,因此人们通常利用G峰与D峰积分强度的比值(IG/ID)来标定石墨烯薄膜质量的好坏.通过计算,表1中也给出了不同样品的IG/ID比值,可以看出IG/ID比值随衬底温度升高而增大,到1000°C最大,为0.58,而再升高温度IG/ID比值又减小了,这说明随生长温度从800°C增加到1000°C,石墨烯薄膜的质量不断提高,在衬底温度1000°C时石墨烯质量最好,但是更高温度后又变差了.Cançado等24利用拉曼光谱结合扫描隧道显微镜(STM)技术研究石墨烯的晶粒尺寸与D、G峰关系时,给出了一个利用D、G峰积分强度比值(ID/IG)计算石墨烯晶粒面内尺寸(La/nm)的经验公式:

式中,Elaser为拉曼测试时使用的激光能量(文中使用的激光波长为514.5 nm,能量为2.41 eV).表1最后一列给出了利用上式计算获得的不同温度下制备的石墨烯晶粒面内尺寸大小,可以看出在1000°C下制备的样品中石墨烯的晶粒面内尺寸最大,为23.2 nm.除G峰外,2D峰也是石墨烯结构特征的反应.由图2可以看到,所有样品都存在2D峰.表1分别给出了不同样品拉曼谱中2D峰的位置和半高宽.一般说来,目前制备的多层石墨烯的堆垛结构大致分为两类.一类是较为有序的AB类型的伯尔纳堆垛结构(AB Bernal stacking),25它包括通过微机械剥离HOPG获得的石墨烯和Si端面6H-SiC高温退火制备的石墨烯.这种堆垛结构的石墨烯的拉曼2D峰经洛伦兹(Lorentzian)拟合之后,单层石墨烯只具有单峰结构且半高宽约为24 cm-1,双层石墨烯可以分为四个峰,三层石墨烯可分为六个峰,四层石墨烯可分为三个峰,四层以上到体相的HOPG的2D峰都只能分成双峰结构.25另一类石墨烯薄膜因在面内旋转无序(rotational random)而形成一种被称为乱层堆垛的石墨烯结构(turbostratic stacking graphene structure).25如C端面6H-SiC高温退火形成的石墨烯则具有这种堆垛结构.其拉曼谱的2D峰和AB类型的伯尔纳堆垛结构的单层石墨烯2D峰的峰形和位置非常相似,都为洛仑兹单峰且都位于~2680 cm-1附近,但是它们的半高宽有差别,单层石墨烯2D峰的半高宽约24 cm-1,而乱层堆垛结构的石墨烯2D峰的半高宽在45-60 cm-1范围内.25,26由图2(a,b,c,d)中可以明显看出,所有样品的2D峰都为单峰结构,位置均在2680 cm-1附近,且半高宽约为60 cm-1左右.由此可以看出,我们制备的石墨烯薄膜都是具有乱层堆垛的石墨烯的结构特征.对于乱层堆垛结构的石墨稀薄膜其厚度不能根据拉曼谱中2D峰的位置进行估算,但是可以根据2D峰和G峰的积分强度的比值(I2D/IG)进行估算.根据研究石墨烯层数与I2D/IG比值给出的经验关系,27,28由1000°C下样品的I2D/IG=2.31可以推算出此条件下制备的样品中石墨烯层的厚度约为2-3层.

图4 不同衬底温度下生长的样品及HOPG的C K吸收边的NEXAFS谱图Fig.4 C K-edge NEXAFS spectra of the samples at different substrate temperatures and HOPGA:the peak located at 285 eV;B:the peak located between 285 and 292.2 eV;C:the peak located at 292.2 eV; HOPG:highly oriented pyrolytic graphite
近边X射线吸收精细结构谱(NEXAFS)是一种同步辐射特有的研究各种材料电子结构和原子局域结构的强有力的实验技术.石墨烯晶格主要是由C-sp2杂化态的C原子组成的.每个C原子在晶格平面内通过三个很强的σ键和其它三个C原子相连接构成了石墨烯片层具有刚性结构的骨架.每个C原子都有四个价电子,这样每个C原子贡献出一个未成键的π电子,在垂直石墨烯晶格平面方向形成π轨道,且π电子在晶体中可以自由移动赋予石墨烯良好的导电性.利用NEXAFS技术可以清楚地描述石墨烯中碳原子的两种键的电子状态.为了研究不同温度对SiC/Si衬底上外延生长C薄膜的成键状态和电子结构的影响,对不同衬底温度下(800、900、1000、1100°C)生长的样品及高定向热解石墨(HOPG)进行了C的K边NEXAFS测试,如图4所示.从图中可以看到,C的K边NEXAFS谱主要包括三个特征峰:在285.0 eV处的峰,285.0-292.2 eV间的峰,以及在292.2 eV处的峰,分别用A、B和C标记.A峰和C峰分别对应碳的内壳层能级电子被X射线激发跃迁到导带的π*和σ*轨道所形成的吸收峰(C 1s→C―C π*峰和C 1s→C―C σ*峰).29其中σ*峰存在两个分峰,这是由于六方对称的石墨烯网格中每个晶胞中含有两个不同位置的C原子,每个C原子与相邻原子之间会形成不同的σ键.A峰和具有分裂结构的C峰的出现标志着有序的石墨烯六方网络结构的sp2杂化的C原子的存在.30图4中的B峰实际上存在两个峰,一个位于287.1 eV处的吸收峰对应于由于表面氧化带来的C=O π*态的吸收,31另一个位于287.6 eV处的吸收峰对应于SiC中C―Si sp3的吸收峰,32由此也说明了SiC缓冲层的存在.从图中可以看出,衬底温度800°C的样品,尽管A峰和具有双峰结构的C峰都存在,但是C峰的两个子峰并不能清晰地分辨,表明在此温度下虽然形成了石墨烯的六元碳环,但有序性不好;生长温度升高到900°C后,A峰和C峰的强度增强,且C峰的两个子峰σ1*和σ2*可以完全分辨;到1000°C后A峰和C峰的相对吸收强度达到最大,且C峰的两个子峰更能清晰地分辨,其谱形和HOPG的谱形较为类似,表明在此温度下形成的石墨烯薄膜的质量和有序性都是最好的;到1100°C后,A峰和C峰的强度减小,且C峰的两个子峰分辨的清晰度也减弱,这表明到1100°C后石墨烯薄膜的生长减弱且有序性变差.通过NEXAFS谱的结果可以清楚地知道,在SiC/Si衬底上,沉积的碳原子在800°C衬底温度已经形成石墨烯,并随温度的增加,生长的石墨烯质量和有序性逐渐改善,到1000°C形成结晶质量最好的石墨烯,随后再提高衬底温度,石墨烯的质量开始下降.这个结果和拉曼结果是一致的.
综上所述,当衬底温度由800°C升高到1100°C后,石墨烯的晶体质量先升高后降低,而在1000°C时达到最佳结晶质量.其原因可能是因为随着衬底温度的提高,碳原子的活性增强,其成键的能力也增大,从而使形成的石墨烯结晶质量会提高.但由于SiC薄膜是在1000°C条件下外延获得的,Si衬底异质外延的SiC缓冲层通常会存在类似三角形的孔洞缺陷,32当衬底温度升高到1100°C后,SiC缓冲层的孔洞缺陷会增多,来自衬底的Si原子有可能获得足够的能量穿过SiC薄膜的孔洞扩散到衬底表面,从而与沉积到衬底表面的碳原子反应生成无序的SiC,这一方面会减弱石墨烯的生长,另一方面也会降低形成的石墨烯的结晶质量.
4 结论
利用MBE共沉积方法,首先在Si(111)衬底上外延生长一层质量较好的SiC缓冲层,然后在SiC/ Si表面直接沉积碳原子制备石墨烯薄膜,并研究了不同衬底温度(800、900、1000、1100°C)对石墨烯结构的影响.结果发现在上述衬底温度下均能制备出石墨烯,但在1000°C时制备的石墨烯的质量最好,过高的衬底温度会降低石墨烯的质量,所形成的石墨烯薄膜具有类似C端面6H-SiC单晶退火后形成的乱层堆垛的石墨烯结构特征.
(1) Novoselov,K.S.;Geim,A.K.;Firsov,A.A.Science 2004,306, 666.
(2) Service,R.F.Science 2009,324,875.
(3) Morzov,S.V.;Novoselov,K.S.;Katsnelson,M.I.;Schedin,F.; Elias,D.C.;Jaszczak,J.A.;Geim,A.K.Phys.Rev.Lett.2008, 100,016602.
(4) Balandin,A.A.;Ghosh,S.;Bao,W.Z.;Calizo,I.; Teweldebrhan,D.;Miao,F.;Lau,C.N.Nano Lett.2008,8,902.
(5) Ganhua,L.;Ocola,L.E.;Junhong,C.Appl.Phys.Lett.2009, 123,083111.
(6) Kang,C.Y.;Tang,J.;Li,L.M.;Pan,H.B.;Yan,W.S.;Xu,P. S.;Wei,S.Q.;Chen,X.F.;Xu,X.G.Acta Phys.Sin.2011,60, 047302.[康朝阳,唐 军,李利民,潘海斌,闫文盛,徐彭寿,韦世强,陈秀芳,徐现刚.物理学报,2011,60,047302.]
(7) Berger,C.;Song,Z.;Li,T.;Li,X.;Ogbazghi,A.Y.;Feng,R.; Dai,Z.;Marchenkov,A.N.;Conrad,E.H.;First,P.N.;de Heer, W.J.Phys.Chem.B 2004,108,19912.
(8) Stankovich,S.;Dikin,D.A.;Dommett,G.H.B.;Kohlhaas,K. M.;Zimney,E.J.;Stach,E.A.;Piner,R.D.;Nguyen,S.T.; Ruoff,R.S.Nature 2006,442,282.
(9)Di,C.A.;Wei,D.C.;Yu,G.;Liu,Y.Q.;Guo,Y.L.;Zhu,D.B. Adv.Mater.2008,20,3289.
(10)Wu,J.S.;Pisula,W.;Mullen,K.Chem.Rev.2007,107,718.
(11) Hackley,J.;Ali,D.;DiPasquale,J.;Demaree,J.D.;Richardson, C.J.K.Appl.Phys.Lett.2009,95,133114.
(12) Ouerghi,A.;Kahouli,A.;Lucot,D.;Portail,M.;Travers,L.; Gierak,J.;Penuelas,J.P.;Shukla,A.;Chassagne,T.;Zielinski, M.Appl.Phys.Lett.2010,96,191910.
(13) Tang,J.;Liu,Z.L.;Kang,C.Y.;Yan,W.S.;Xu,P.S.;Pan,H. B.;Wei,S.Q.;Gao,Y.Q.;Xu,X.G.Acta Phys.-Chim.Sin. 2010,26,253.[唐 军,刘忠良,康朝阳,闫文盛,徐彭寿,潘海斌,韦世强,高玉强,徐现刚.物理化学学报,2010,26, 253.]
(14) Suemitsu,M.;Fukidome,H.J.Phys.D:Appl.Phys.2010,43, 374012.
(15) Tang,J.;Kang,C.Y.;Li,L.M.;Yan,W.S.;Wei,S.Q.;Xu,P.S. Phys.E 2011,43,1415.
(16) Liu,Z.L.;Liu,J.F.;Ren,P.;Xu,P.S.Journal of Inorganic Materials 2008,23,549. [刘忠良,刘金峰,任 鹏,徐彭寿.无机材料学报,2008,23,549.]
(17) Liu,Z.L.;Liu,J.F.;Ren,P.;Xu,P.S.Chinese Journal of Vacuum Science and Technology 2008,28,992.[刘忠良,刘金峰,任 鹏,徐彭寿.真空科学与技术学报,2008,28,992.]
(18) Liu,J.F.;Liu,Z.L.;Wu,Y.Y.;Xu,P.S.Journal of Inorganic Materials 2007,22,720. [刘金峰,刘忠良,武煜宇,徐彭寿.无机材料学报,2007,22,720.]
(19) Ni,Z.H.;Chen,W.;Fan,X.F.;Kuo,J.L.;Yu,T.;Wee,A.T.S.; Shen,Z.X.Phys.Rev.B 2008,77,115416.
(20) Röhrl,J.;Hundhausen,M.;Emtsev,K.V.;Seyller,T.;Graupner, R.;Ley,L.Appl.Phys.Lett.2008,92,01918.
(21) Thomsen,C.;Reich,S.Phys.Rev.Lett.2000,85,5214
(22) Pimenta,M.A.;Dresselhaus,G.;Dresselhaus,M.S.;Cancado, L.G.;Jorioa,A.;Saito,R.Phys.Chem.Chem.Phys.2007,9, 1276.
(23) Ferralis,N.;Maboudian,R.;Carraro,C.Phys.Rev.Lett.2008, 101,156801.
(24) Cançado,L.G.;Takai,K.;Enoki,T.;Endo,M.;Kim,Y.A.; Mizusaki,H.;Jorio,A.;Coelho,L.N.;Magalhães-Paniago,R.; Pimenta,M.A.Appl.Phys.Lett.2006,88,163106.
(25)Malarda,L.M.;Pimentaa,M.A.;Dresselhaus,G.;Dresselhaus, M.S.Phys.Rep.2009,473,51.
(26) Faugeras,C.;Nerrire,A.;Potemski,M.;Mahmood,A.; Dujardin,E.;Berger,C.;de Heer,W.A.Appl.Phys.Lett.2008, 92,011914.
(27) Ferrari,A.C.;Meyer,J.C.;Scardaci,V.;Casiraghi,C.;Lazzeri, M.;Mauri,F.;Piscanec,S.;Jiang,D.;Novoselov,K.S.;Roth, S.;Geim,A.K.Phys.Rev.Lett.2006,97,187401.
(28) Gupta,A.;Chen,G.;Joshi,P.;Tadigadapa,S.;Eklund,P.C. Nano Lett.2006,6,2667.
(29) Batson,P.E.Phys.Rev.B 1993,48,2608.
(30) Fischer,D.A.;Wentzcovitch,R.M.;Carr,R.G.;Continenza, A.;Freeman,A.J.Phys.Rev.B 1991,44,1427.
(31)Coleman,V.A.;Kunt,R.;Karis,O.J.Phys.D:Appl.Phys. 2008,41,062001
(32) Pedio,M.;Giglia,A.;Mahne,N.Phys.Scr.2005,115,308.
July 13,2011;Revised:October 12,2011;Published on Web:October 18,2011.
Direct Graphene Growth by Depositing Carbon Atoms on Si Substrate Covered by SiC Buffer Layers
TANG Jun1,2KANG Chao-Yang1LI Li-Min1XU Peng-Shou1,*
(1National Synchrotron Radiation Laboratory,University of Science and Technology of China,Hefei 230029,P.R.China;2Hefei IRICO Epilight Technology Co.,Ltd.,Hefei 230011,P.R.China)
Graphene is a newly discovered material with many functions.The preparation of graphene on suitable substrates is a challenge in the material preparation field.In this paper,graphene thin films were grown on Si substrates covered with SiC buffer layers(SiC/Si)by the direct deposition of carbon atoms using molecular beam epitaxy(MBE)equipment.The structural properties of the samples produced at different substrate temperatures(800,900,1000,1100°C)were investigated by reflection high energy electron diffraction(RHEED),Raman spectroscopy and near-edge X-ray absorption fine structure (NEXAFS).The results indicate that the thin films grown at all temperatures exhibit the characteristics of graphene with a turbostratic stacking structure.As the substrate temperature increases the crystalline quality of the graphene improves.However,a very high temperature decreases the quality of graphene. The best graphene films were obtained at a substrate temperature of 1000°C.This is due to the low substrate temperature resulting in a too low carbon atom activity for the formation of an ordered six-member ring of C-sp2.When the substrate temperature was too high the silicon atoms in the substrate became so active that silicon atoms diffused to the surface of the sample through SiC buffer defects and they bonded to the depositing carbon atoms,which resulted in a lower crystallization quality of the carbon layers.
Graphene;Molecular beam epitaxy;Si substrate;SiC;Synchrotron radiation
10.3866/PKU.WHXB20112953
∗Corresponding author.Email:psxu@ustc.edu.cn;Tel:+86-551-3602037.
The project was supported by the National Natural Science Foundation of China(50872128).
国家自然科学基金(50872128)资助项目
O641;O472;O59;O782
