高性能PZT压电厚膜及MEMS微驱动器技术研究
2011-10-16曹茂盛赵全亮刘红梅邱成军
曹茂盛,路 冉,赵全亮,刘红梅,邱成军,袁 杰
(1.北京理工大学 材料学院,北京 100081;2.黑龙江大学 电子信息工程学院,哈尔滨 150080;3.中央民族大学 信息工程学院,北京 100081)
0 引 言
压电材料是一种能够实现机械能-电能转换的功能材料,广泛应用在换能器、驱动器、传感器及智能结构器件中。随着微电子技术的发展,特别是微电子机械系统 (MEMS)的出现,智能结构器件的尺寸越来越小,其特征尺寸达到μm甚至nm量级。作为实现机械能-电能转换的压电材料,压电MEMS器件已越来越引起人们的关注,在压电MEMS器件中,由于器件尺寸和制作工艺的限制,传统的体型压电材料已不适合应用于 MEMS器件,而压电薄膜材料成为最合适的选择。其中,PZT基压电薄膜材料以其压电性能强、介电常数高、稳定性好等优异性能,成为当今发展最快的压电材料。
然而,PZT薄膜的压电驱动力还偏小,这限制了其在压电 MEMS器件中的应用。为了提高PZT薄膜的压电驱动力,近年来发展了厚度>1 μm的PZT厚膜技术。研究发现PZT厚膜具有体型PZT压电陶瓷材料的良好性能,如压电性能强、输出信号高、使用频率范围宽等;而且 PZT厚膜还兼顾PZT薄膜的特点,即工作电压低、尺寸小、质量轻、易于同MEMS技术兼容等。
目前,制备PZT基薄膜和厚膜的主要方法有:射频磁控溅射法 (RF)[1-2]、脉冲激光沉积(PLD)[3]、金属有机化学气相沉积(MOCVD)[4]、溶胶-凝胶法(Sol-Gel)[5-10]、丝网印刷[11-12]、化学溶液沉积法(CSD)[13]等。其中,溶胶-凝胶法成膜组分均匀可控、易于大面积成膜、低成本、易与MEMS技术兼容,被认为是制备PZT厚膜最有潜力的方法之一[14]。但是,溶胶-凝胶法制备的PZT厚膜也存在一些问题,例如,厚膜基体中很容易产生大量的微孔和微裂纹,这些微孔和微裂纹会降低厚膜的密度,使其电学性能降低。而且,压电厚膜在工作产生形变时造成微裂纹扩展,会导致材料提前失效。
为了减少溶胶-凝胶法在PZT厚膜制备中产生的微孔和微裂纹,通常在PZT厚膜基体中掺入有机高分子溶剂或颗粒增强相,来改善 PZT厚膜的力学和电学性能,相关研究已经取得了进展。本文介绍了几种典型的压电厚膜制备方法,包括PZT压电厚膜、取向PZT压电厚膜、PZT纳米粉体增强PZT压电厚膜(0-3复合PZT厚膜)[15-18,7]、添加 ZnO 四针体的 PZT 压电厚膜[19-20](ZnOw-PZT),并介绍了无阀型 MEMS压电型微泵、V型阀式压电MEMS微泵、压电悬臂梁和三压电悬臂驱动的悬浮膜片式MEMS微镜的性能与技术特点。
1 实验过程
1.1 (100)取向的PZT压电复合厚膜
将钛酸四丁酯溶液和硝酸锆的乙二醇单甲醚溶液混合搅拌澄清,再加入蒸馏后的乙酸铅冰醋酸溶液,共同在80℃下回流搅拌2 h后,再加入 PVP的乙二醇单甲醚溶液,80℃下回流搅拌1 h形成淡黄色澄清PZT溶胶。在制备工艺中通过控制溶液的pH值(3左右)来控制水解速度。其中,Pb∶Zr∶Ti∶PVP=1.1∶0.52∶0.48∶1,多余的10%乙酸铅是用于补偿PZT膜在退火时产生的铅挥发。在制备PT溶胶时,将加有乙酰丙酮的钛酸四丁酯溶液溶于乙二醇单甲醚中,搅拌澄清,再与蒸馏后的乙酸铅的冰醋酸溶液混合,在 80℃下回流搅拌3 h,形成稳定的淡黄色澄清PT溶胶。PZT和PT溶胶的制备流程见图1。
已有的PZT厚膜,大多都是沿 (110)取向生长,(110)取向的PZT厚膜具有良好的铁电性能,而压电性能不够理想;为了满足MEMS器件的要求,需要制备 (100)取向的PZT厚膜。本文通过在Pt/Cr/SiO2/Si衬底和 PZT厚膜之间制备 PT过渡层,用逐层旋涂方法,制备了 (100)取向的PZT压电厚膜。首先,通过匀胶机在Pt/Cr/SiO2/Si衬底上涂覆一层澄清PT溶胶,形成PT湿凝胶膜。然后,将PT湿凝胶膜放入高温管式炉中,在300~350℃热解干燥处理5 min后形成干凝胶膜,再经650~700℃处理1~3 min形成结晶化的PT种子层。随后,在 PT种子层上涂覆一层 PZT溶胶后,放入高温管式炉中 450℃下热解干燥处理30 min。如此重复交替涂覆PZT膜多次,当膜厚达到所需厚度时,700℃处理 5~15 min,形成PZT厚膜。最后再按照第一步制备 PT薄膜的方法,在PZT厚膜顶层制备一或二层 PT膜,使其表面更加平整,而且还可以提高 PZT厚膜的结晶化程度和电学性质[21]。
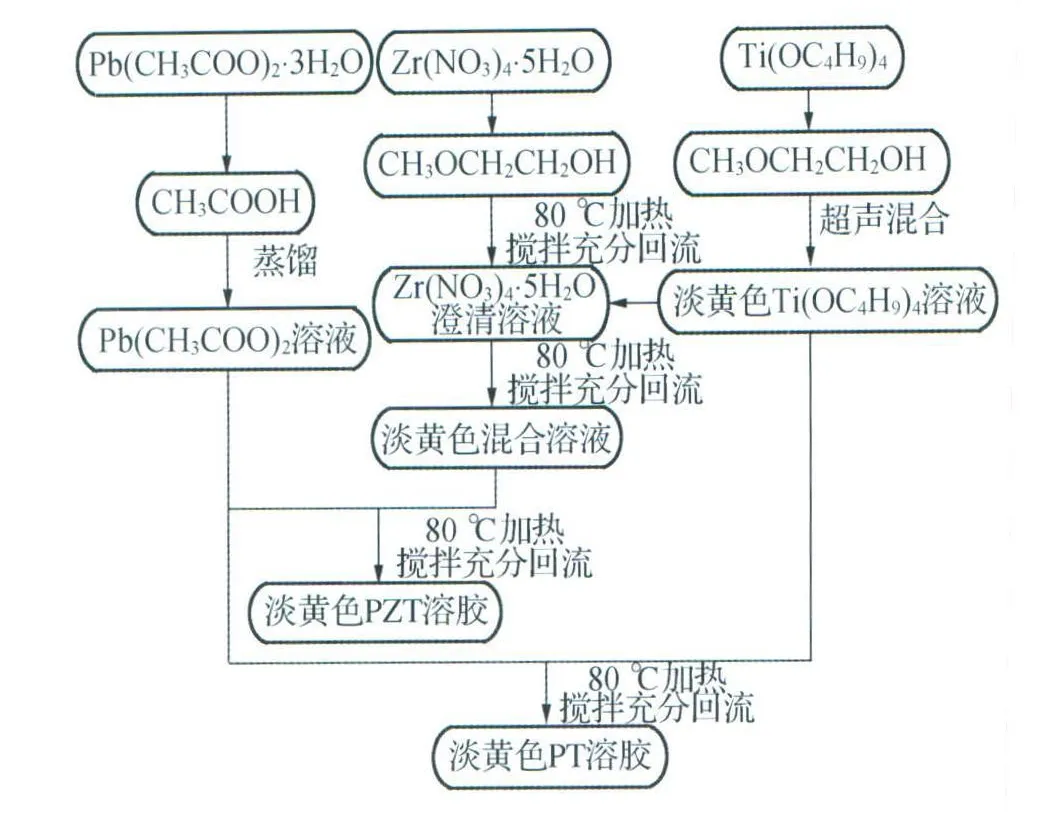
图1 PZT和PT溶胶的制备流程图Fig.1 Flow chart of preparation PZT and PT sol
1.2 0-3复合型PZT压电厚膜
将制备好的PZT溶胶倒入玻璃培养皿中,在100℃下干燥5~6 h形成干凝胶,然后用刀片将培养皿中干凝胶刮下,在玛瑙研钵中研磨成干凝胶粉,将干凝胶粉放入管式炉中于400℃预烧 0.5 h,得到未结晶的PZT粉末,再利用球磨机将获得的PZT粉末进行球磨30~40 h,再将 PZT粉末中加入一定量的分散剂继续球磨5~10 h得到未结晶的 PZT纳米颗粒。将PZT纳米颗粒与PZT溶胶-凝胶混合,超声处理,获得均匀的 PZT浆料[16]。
先在衬底上通过匀胶机涂覆一层澄清 PT溶胶,放入高温管式炉中热解干燥,形成种子层来增强薄膜和衬底之间的附着力,并使 PZT厚膜更好地结晶成相。再涂覆带有PZT纳米颗粒的PZT浆料,同样放入高温管式炉中热解干燥,如此逐层涂覆,当膜厚达到所需厚度时,将基片放入高温管式炉中退火处理,形成 PZT厚膜。
1.3 ZnOw-PZT压电复合厚膜
首先将高温管式炉升温至 950℃,保持管式炉的石英管一端密封,另一端始终敞开。然后在石英舟中撒上一层Zn粉,将石英舟慢慢推至管式炉中央,保温4 min。在反应过程中,Zn粉上方会产生浓重的白烟,这是Zn粉在与氧气燃烧反应生成ZnO。待反应结束,再将石英舟缓缓拉出,冷却到室温,可以看到石英舟中存在白色絮状物质,这就是最终产物纳米ZnOw。将ZnOw按照摩尔浓度为0.05 mol/L的比例添加到乙醇溶液中,超声混合,可以形成白色ZnOw悬浊液浆料。
通过匀胶机在Pt/Cr/SiO2/Si衬底上涂覆一层PT溶胶,然后将PT湿凝胶膜放入高温管式炉中热解干燥,形成干凝胶膜,再经高温处理形成结晶化的 PT薄膜如此反复两次。在PT种子层上涂覆一层PZT溶胶,将PZT湿凝胶膜放入高温管式炉中进行热解干燥处理,形成PZT干凝胶膜。再将ZnOw悬浊液浆料旋涂在具有PZT干凝胶膜的硅基衬上,按照上述制备PT膜的工艺条件,制备PZT干凝胶膜,当膜厚达到所需厚度时,将基片放入高温管式炉中退火处理,形成ZnOw-PZT复合厚膜。将已制备的ZnOw-PZT复合厚膜放入稀醋酸中浸泡 30 s,去除厚膜表面凸出的多余纳米ZnOw[20-21]。
2 PZT压电复合厚膜的性能及结构表征
2.1 PZT复合厚膜的结构表征
PT与PZT的晶格常数非常接近,匹配良好,物理化学性质也相似,同属于压电材料。它不仅能够为 PZT的生长提供晶种,还可减缓层间扩散和界面反应。因此,本文将采用 PT薄膜作为种子层。为了得到更好的结晶择优取向且致密的结晶化种子层,我们尝试了不同热解和退火温度及时间,图2(a)为两种方法制备的 PT薄膜XRD图。可以看出,这两种方法制备的 PT,均呈单相钙钛矿结构,且呈 (100)方向择优生长。
通过尝试不同热解和退火温度及时间,我们得到最佳热解条件为450℃,30 min;最佳退火条件为700℃,5 min。为了制备更大厚度的 (100)择优取向PZT厚膜,我们研究了厚度对PZT厚膜结晶性的影响。图2(b)为不同厚度的PZT压电复合厚膜XRD图,所有 PZT厚膜均呈现钙钛矿相结构,随着厚度增加,(100)峰强度逐渐降低,而(110)峰强度则逐渐升高。1 μm 和 1.5 μm 厚度的PZT厚膜均呈现 (100)择优取向,而2 μm厚度的PZT厚膜则呈现 (110)择优取向。这是因为当PZT厚膜的厚度较小时,受衬底应变能的影响,沿膜法线方向的应变能较小,因此,PZT厚膜比较容易沿PT种子层的取向方向生长;当 PZT膜厚度增加时,衬底所产生的应力得到释放,衬底平面方向的应变能变小,PT种子层对较上层的 PZT膜的取向生长引导作用也越来越弱。
为了避免PZT纳米晶粒对厚膜的 (100)取向生长产生不利影响,我们选择未结晶的 PZT纳米颗粒制备 (100)取向的PZT压电复合厚膜。图2(c)是不同厚度的未结晶 PZT纳米颗粒增强PZT压电复合厚膜XRD图,可以看出随着膜厚增加,PZT压电复合厚膜 (100)峰缓慢减弱。这是因为,(100)取向PT过渡层为PZT压电复合厚膜(100)方向生长的种子层,随着膜厚的增加,PZT压电复合厚膜的生长受PT过渡层的影响逐渐减小。
图2(d)为2 μm厚的PZT厚膜和厚度分别为1.5,2,3,4 μm 的 ZnOw-PZT复合厚膜的XRD图谱。可以看出,所有的 ZnOw-PZT复合厚膜都呈钙钛矿相结构,主峰分别对应于 (100)和 (110)方向。与相同厚度的PZT厚膜相比,其XRD图区别不大。随着厚度增加,ZnOw-PZT复合厚膜的(100)取向减小,而(110)取向增强。

图2 (a)不同工艺条件下制备的PT膜;(b)不同厚度的PZT复合压电厚膜;(c)(0-3)复合法制备的不同厚度的PZT压电复合膜;(d)PZT厚膜和不同厚度的ZnOw-PZT复合厚膜Fig.2 (a)XRD patterns of PT prepared in two ways;(b)XRD patterns of PZT in different thicknesses;(c)XRD patterns of(0-3)PZT piezoelectric composite thick film with different thickness;(d)XRD patterns of PZT thick films and ZnOw-PZT thick films
2.2 PZT压电复合厚膜的形貌与组织表征
图3(a)为 2 μm 退火时间为 5 min的 PZT厚膜的SEM照片。可以看出,PZT厚膜表面晶粒均匀致密,晶粒尺寸则在微米和亚微米量级之间。图3(b)为PZT厚膜的截面图,从图中看出,膜的厚度大约为 1.5~2 μm。
图3(c)和图3(d)是厚度为 3 μm 未结晶PZT纳米颗粒增强PZT压电复合厚膜的表面和断面SEM图,从图中可以看出,厚膜表面平整无裂纹,断面清晰致密。
图3(e)和图3(f)分别为ZnOw的 SEM和嵌入 PZT厚膜中ZnOw的SEM照片。图中显示,ZnOw的3个单针已紧密地嵌入PZT厚膜中,在边界结合处也没有产生微裂纹。由于ZnOw的针腿长度大于PZT厚膜的厚度,所以多余的表面ZnOw会影响厚膜的表面平整度。本文采用了稀乙酸清洗和表面加涂PT薄膜的方法,去除了残留在复合厚膜表面的ZnOw,从而明显改善了ZnOw-PZT复合厚膜的表面质量。
图3(g),图3(h)是厚度分别为 2 μm 的ZnOw-PZT复合厚膜表面和截面SEM 照片,制备工艺条件为450℃热解 30 min;700℃退火5 min。可以看出,ZnOw-PZT复合厚膜表面平整,晶粒尺寸均一,断面清晰整齐。
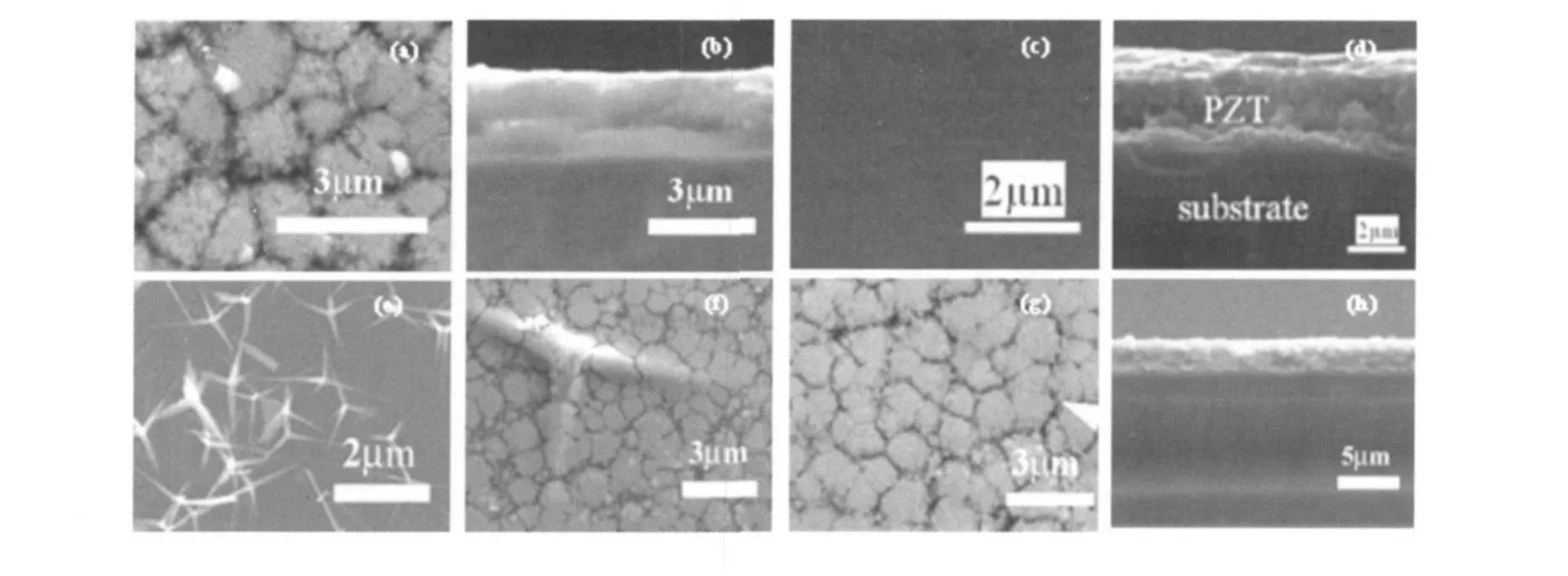
图3 (a),(b)厚度2 μm退火时间为 5 min的PZT厚膜表面和截面 SEM;(c),(d)厚度为3 μm的 PZT纳米颗粒增强的PZT压电复合厚膜表面形貌和断面SEM;(e)ZnOw的 SEM照片;(f)嵌入PZT厚膜中ZnOw的 SEM照片;(g),(h)厚度为 2 μm的 ZnOw-PZT复合厚膜表面和截面SEM照片Fig.3 (a),(b)Surface and cross section SEM photographs of 2 μm-thick PZT piezoelectric thick film at annealing time of 5 min;(c),(d)Surface and cross section SEM photographs of 3 μm-thick PZT thick film enhanced by uncrystallized PZT nanoparticle;(e)SEM of ZnOw;(f)SEM of ZnOwin PZT thick films;(g)(h)Surface and cross section SEM photographs of 2 μm-thick ZnOw-PZT piezoelectric thick film
2.3 PZT压电复合厚膜的电学性能
图4(a)中曲线1是 (100)取向 PZT压电厚膜,2为未结晶PZT纳米颗粒增强的 (100)取向PZT压电复合厚膜电滞回线,从图中可以看出,未结晶PZT纳米颗粒增强的(100)取向PZT压电复合厚膜电滞回线饱和性优于 (100)取向PZT压电厚膜,且添加PZT纳米颗粒后,PZT压电厚膜矫顽场变化不大,剩余极化强度增大了57 μ C/cm2。
图4(b)为2 μm 厚的(100)取向PZT压电厚膜和ZnOw-PZT复合厚膜的电滞回线,测试最大外加电压为90 V,频率为 10 Hz。它们的剩余极化强度 Pr分别为 27 μ C/cm2和 24 μ C/cm2,自发极化强度 Ps分别为 38 μ C/cm2和 33 μ C/cm2,矫顽场Ec均为177 kV/cm。ZnOw-PZT复合厚膜的Pr略小于(100)取向 PZT压电厚膜,这可能是因为部分PZT被ZnOw替代,而ZnOw则属于非铁电物质的原因。
如表1所示,(100)取向PZT压电厚膜和未结晶(0-3)PZT压电复合厚膜分别在450℃热解30 min,700℃退火5 min,介电常数测试频率为100 kHz时,厚度分别为3,4和5 μm的样品介电常数,可见添加PZT纳米颗粒的压电厚膜介电常数明显提高。

表1 PZT与PZT纳米颗粒增强的PZT复合压电膜的介电常数Table 1 Dielectric constant of PZT thick films and PZT thick films enhanced by PZT nanoparticle
图5是2 μm厚的PZT厚膜和不同厚度ZnOw-PZT复合厚膜的的介电性能。随着测试频率的增加,相对介电常数εr逐渐减小,在较低测试频率时,界面极化对εr会有贡献,而在高频时,界面极化的贡献较小,所以在低频带时,εr相对较高。与相同厚度的 (100)取向 PZT压电厚膜相比,ZnOw-PZT复合厚膜的介电常数和介电损耗则是微量下降。根据有效媒质理论分析,当引入低介电相ZnOw时,高介电相 PZT基体的介电常数将会降低[19]。
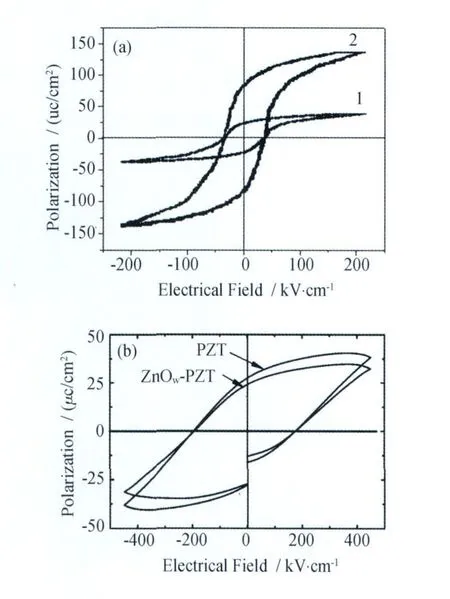
图4 (a)(0-3)复合法制备的PZT压电复合厚膜和(100)取向 PZT压电厚膜电滞回线;(b)2 μm厚的PZT和ZnOw-PZT复合厚膜的铁电回线Fig.4 (a)Ferroelectric hysteresis loops of(0-3)PZT thick films and(100)oriented PZT thick films;(b)Ferroelectric hysteresis loops of 2 μm-thick ZnOw-PZT composited thick films
3 高性能压电MEMS器件
PZT厚膜因其优良的性能及易与半导体技术集成等特点,成为MEMS器件最有前途的候选材料之一。为此,我们以高性能压电厚膜为驱动材料,制作了几种典型的微机械系统 (MEMS)。简要介绍如下:
3.1 压电微泵
采用MEMS技术,在硅基衬底上制作了扩散/收缩管型无阀式压电微泵[22-24],见图6。该设计采用无阀泵结构,降低了器件的复杂性。同时,因为整体设计中没有可以移动的机械部分,微驱动器的寿命也得到了提高。通过将压电片与硅膜片粘合,可以实现压电驱动膜片的微变形,从而可实现压电微泵的主要功能。

图5 2 μm厚的 PZT和不同厚度 ZnOw-PZT复合厚膜的的介电性能Fig.5 Dielectric constant of 2 μm-thick PZT thick films and ZnOw-PZT at different thickness

图6 无阀型压电MEMS微泵Fig.6 Valveless MEMS Micro-pump
3.2 V型阀微驱动器
采用MEMS技术制作了压电片驱动的V型阀微驱动器[18,25]。微驱动器整体由驱动腔体和阀体组成,驱动腔体又包括硅杯结构以及硅杯上粘合的压电片。驱动腔体是制作微驱动器的关键性部件,它与单向流动阀体配合,实现微驱动器泵送流体的功能。图7为V型阀驱动器的SEM照片。其中图7(a)为V型阀的整体照片,图7(b)为 V驱动腔的实物照片。图7(c)和图7(d)分别为制作好的单向微阀正面和背面的 SEM照片,可以看出,阀片厚度薄至 10 μm 左右,阀体边缘清晰整齐。该V型阀结构只需一片硅片,因此,器件设计和制作的复杂性明显降低。

图7 V型阀驱动器的SEMFig.7 SEM photograph of V type valve microactuator
3.3 硅基PZT压电厚膜微悬臂梁结构
采用半导体光刻工艺,利用BHF/HCl溶液成功地刻蚀了PZT纳米颗粒增强的PZT厚膜,并运用微机械加工技术刻蚀出硅悬臂梁结构,见图8[26-28]。利用激光多普勒测振仪 (LDV)测试压电悬臂梁频率响应特性。结果表明,压电悬臂梁显示了较高的Qm值 (~799),具有很好的工作效率和频率稳定性。

图8 (a)单个微压电悬臂梁图;(b)微压电悬臂梁阵列Fig.8 (a)A micro-cantilever;(b)Micro-cantilever array
3.4 三压电悬臂驱动的悬浮膜片式MEMS微镜阵列
采用溶胶-凝胶法在101.6 mm的Si片上制备了大面积PZT厚膜,与MEMS技术相结合,制作了三压电悬臂驱动的悬浮膜片式 MEMS微镜[28]。图9(a)为101.6 mm Si基大面积PZT厚膜;图9(b)为划片后的一个4×4的微镜阵列单元,可以看出微镜阵列单元的尺寸约为8 mm×8 mm;图9(c)为微镜阵列SEM 照片;图9(d)是单个的微镜SEM照片。
测试表征结果显示,大面积 PZT厚膜致密平整;PZT厚膜的湿法刻蚀图形干净整齐,满足器件制作要求;ICP深硅刻蚀成功释放了悬浮结构,微镜陈列集成制作成功。通过在不同的单个悬臂上施加电压信号,微反射镜面在不同的谐振频率下可以实现沿Z轴的垂直运动和绕X轴、Y轴的转动方式。
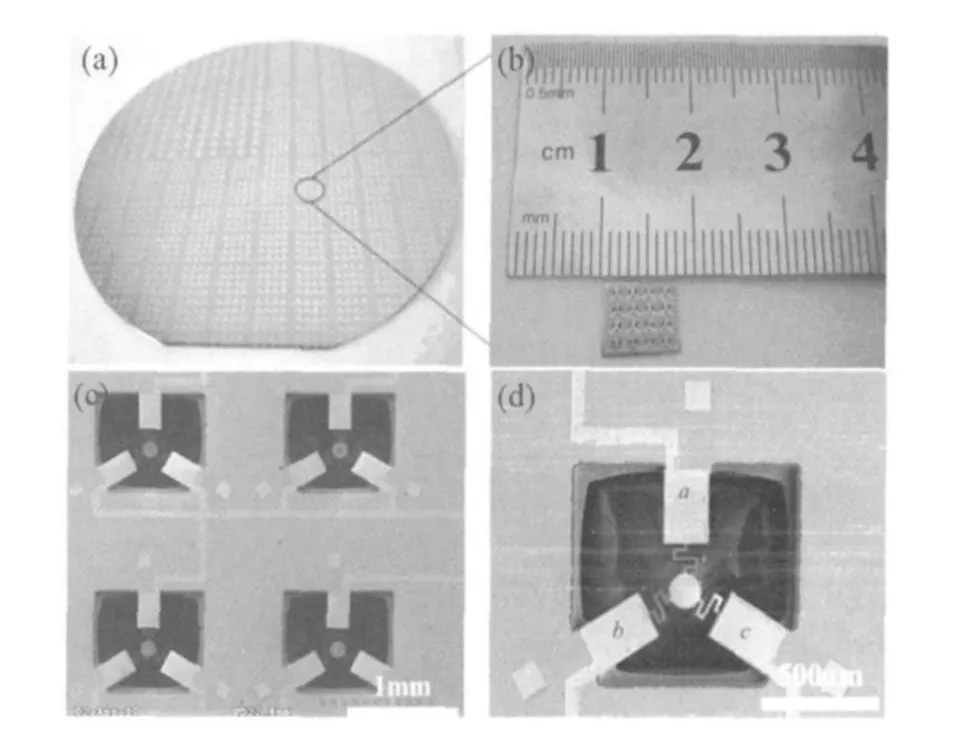
图9 (a)Si片上制备的大面积PZT厚膜;(b)4×4的微镜阵列单元;(c)微镜阵列SEM照片;(d)单个的微镜SEM照片Fig.9 (a)PZT thick films on big area Si substrate;(b)4×4 micro-mirror array;(c)SEM photograph of micro-mirror array;(d)SEM photograph of a micro-mirror
4 结 论
本文基于溶胶-凝胶法制备了PZT压电复合厚膜,包括PZT纳米颗粒增强的PZT压电复合厚膜和添加ZnOw的硅基ZnOw-PZT复合厚膜的工艺条件,给出最佳热解条件为450℃,30 min;最佳退火条件为700℃,5 min。通过结构和性能表征分析得出,PT种子层对 PZT压电复合膜(100)取向生长有很好的引导作用,但随着PZT复合压电厚膜厚度的增加作用逐渐减弱;PZT纳米颗粒的添加,改善了PZT压电复合厚膜的致密度,提高了电滞回线的饱和度,增大了 PZT压电复合厚膜剩余极化强度,介电常数也得到了明显提高;ZnOw的添加有效地改善了PZT复合厚膜的表面质量,降低了材料的介电常数和介电损耗。更重要的是,ZnOw增强的复合厚膜,微裂纹明显减少。基于压电复合厚膜技术,本文介绍的无阀型压电MEMS微泵采用了无阀结构,整个器件没有可移动的部分,使微驱动器寿命得到了提高;V型阀式压电MEMS微泵整个设计只需一张硅片,使器件制作的复杂性明显降低;运用微机械加工技术刻蚀出的硅悬臂梁结构,具有很高的工作效率和频率稳定性;首次提出设计了具有三压电悬臂驱动的悬浮膜片式MEMS微镜,解决了大面积PZT厚膜制备、PZT厚膜的图形化和 ICP深硅刻蚀等关键技术,实现了微反射镜面的六轴转动。
[1]Park C S,Lee S M,Kim H E.Effects of excess PbO and Zr/Ti ratio on microstructure and electrical properties of PZT films[J].Journal of the American Ceramic Society,2008,91(9):2 923-2 927.
[2]Wu J G,Zhu J L,Xiao D Q,et al.Preparation and properties of highly(100)-Oriented Pb(Zr0.2Ti0.8)O3thin film prepared by RF magnetron sputtering with a PbOx buffer layer[J].Journal of Applied Physics,2007,101(9):094 107.
[3]Yu Y H,Lai M O,Lu L,et al.Measurement of residual stress of PZT thin film on Si(100)by synchrotron X-Ray rocking curve technique[J].Journal of Alloys and Compounds,2008,449(1-2):56-59.
[4]Yokoyama S,Honda Y,Morioka H,et al.Dependence of electrical properties of epitaxial Pb(Zr,Ti)O3thick films on crystal orientation and Zr/(Zr+Ti)ratio[J].Journal of Applied Physics,2005,98:094 106.
[5]Park G T,Choi J J,Park C S,et al.Piezoelectric and ferroelectric properties of 1-μm-thick lead zirconate titanate film fabricated by a double-spin-coating process[J].Applied Physics Letters,2004,85:2 322.
[6]Shim D,Pak J,Nam K,et al.Enhanced fatigue characteristics of sol-Gel derived PZT thin films[J].Journal of Alloys and Compounds,2008,449(1-2):32-35.
[7]Duan Z X,Yuan J,Zhao Q L,et al.Preparation and ferroelectric properties of double-scale PZT composite piezoelectric thick film[J].Chinese Physics Letters,2008,25(4):1 472-1 475.
[8]Suarez-Gomez A,Sato-Berru R,Toscano R A,et al.On the synthesis and crystallization process of nanocrystalline PZT powders obtained by a hybrid sol-gel alkoxides route[J].Journal of Alloys and Compounds,2008,450(1-2):380-386.
[9]Sakamoto W,Masuda Y,Yogo T.Fabrication and properties of perovskite Pb(Yb,Nb)O3-PbTiO3thin films through a sol-gel process[J].Journal of Alloys and Compounds,2006,408(412):543-546.
[10]Zhang S Q,Fei W D,Li W L,et al.Ferroelectric properties of highly(111)-oriented Pb(Zr1-X,Tix)O3thin films with different Zr/Ti ratios[J].Journal of Alloys and Compounds,2009,487(1-2):703-707.
[11]Lee S G.Preparation and electrical properties of sol infiltrated Pb(Zr0.7Ti0.3)O3ferroelectric thick films[J].Journalof Alloys and Compounds,2008,454(1-2):406-409.
[12]Lee S G,Young J S,Jin K C,et al.Structural and dielectric properties of Pb(Zr,Ti)O3heterolayered thick films[J].Journal of Alloys and Compounds,2008,449:73-76.
[13]Karan N K,Thomas R,Pavunny S P,et al.Preferential grain growth and improved fatigue endurance in Sr substituted PZT thin films on Pt(111)/TiOx/SiO2/Si substrates[J].Journal of Alloys and Compounds,2009,482(1-2):253-255.
[14]Wang G S,Remiens D,Dogheche E,et al.Fabrication and electrical properties of lead zirconate titanate thick films on Si substrate by using lanthanum nickelate buffer layer[J].Journal of the American Ceramic Society,2006,89(11):3 417-3 420.
[15]刘红梅,赵全亮,段中夏,等.用于压电悬臂梁的PZT厚膜的溶胶-凝胶制备及表征 [J].哈尔滨工业大学学报,2007,(9):1 499-1 502
[16]Duan Z X,Yuan J,Zhao Q L,et al.Oriented growth of PZT thick film embedded with PZT nanoparticles[J].Journal of Harbin lnstitute of Technology,2009,(16):232-236.
[17]刘红梅,邱成军,张德庆,等.M EMS集成应用的纳米结构PZT厚膜形成工艺研究 [J].高技术通讯,2006,(6):606-609.
[18]邱成军,刘红梅,张辉军,等.溶胶-凝胶法制作 PZT微驱动器的研究[J].材料工程,2007,(8):24-27.
[19]Zhao Q L,Cao M S,Yuan J,et al.Thickness effect on electrical properties ofPb(Zr0.52Ti0.48)O3thick films embedded with ZnO nanowhiskers prepared by a hybrid sol– gel route[J].Materials Letters:2010,(64):632-635.
[20]Zhao Q L,Cao M S,Yuan J,et al.Preparation and electrical properties of Pb(Zr0.52Ti0.48)O3thick films embedded with ZnO nanowhiskers by a hybrid sol-gel route[J].Journal of Alloys and Compounds,2010,(4):1 472-1 475.
[21]Ren T L,Zhang L T,Wang X N,et al.High quality ferroelectric capacitor for feram applications[J].Integrated Ferroelectrics,2002,(46):47-53.
[22]Qiu C J,Zhao Q L,Zhang H J,et al.A valve-less PZT micropump with isosceles triangle crosssection diffuser elements[C]//Proceedings of the 1st IEEE International Conference on Nano/Micro Engineered and Molecular Systems,2006:18-21.
[23]Zhao Q L,Yuan J,Liu H M,et al.Stationary fluid dynamic behaviour of V-shaped diffuser/nozzle elements for valveless micropump[J].Chinese Physics Letters,2008,(25):1 359-1 361.
[24]邱成军,曹茂盛,孟丽娜,等.溶胶-凝胶法制作 PZT薄膜微驱动器的工艺研究[J].云南大学学报,2005,(27):325-329.
[25]Qiu C J,Zhang H J,Qu W,et al.A novel design and fabrication of V type valve microactuator with PZT prepared by sol-gel[C]// Proceeding of the 1st IEEE International Conference on Nano/Micro Engineered and Molecular Systems,2006:18-21.
[26]Qiu C J,Bu D,Qu W,et al.Design and simulation of MEMS silicon micro-cantilever resonant sensor[C]//International Conference on Smart Materials and Nanotechnology in Engineering,2007:591-594.
[27]Liu H M,Zhao Q L,Cao M S,et al.Electromechanical properties of micro-cantilever actuated by enhanced piezoelectric PZT thick film[J].Chinese Physics Letters,2008,(25):4 128-4 130.
[28]赵全亮.PZT基压电复合厚膜制备及压电MEMS微镜集成制作技术研究[D].北京:北京理工大学博士学位论文,2010.
