高灵敏压力传感器过载保护结构设计*
2011-10-08揣荣岩刘晓为
揣荣岩,孙 瑞,刘晓为,王 健
(1.沈阳工业大学信息科学与工程学院,沈阳110870;2.哈尔滨工业大学MEMS中心,哈尔滨150001)
采用MEMS技术的小量程、高灵敏压力传感器通常有平膜、岛膜、梁膜等结构[1-2],在设计过载保护时,一般采用凸台等方法实现,形成方法有背部刻蚀技术、硅直接键合(SDB)技术、玻璃刻蚀技术等[3-4]。然而这些结构的腔体尺寸较大,进一步提高灵敏度受到限制,而且降低了硅片利用率,增加了制造工艺的复杂度,提高了生产成本[5]。目前小量程、高灵敏压力传感器的研究热点集中在牺牲层结构压力传感器,这主要是因为牺牲层结构压力传感器弹性膜片很薄,厚度可做到2 μm,甚至更薄。在这样薄的结构上,如果(采用扩散硅或多晶硅薄膜作为牺牲层结构压力传感器的应变电阻,其厚度相对较大,对弹性膜片应力分布影响很大,不利于牺牲层结构压力传感器的性能优化,因此采用多晶硅纳米薄膜制作应变电阻更能发挥牺牲层技术的优点。
通常压力传感器的应变电阻是在单晶硅片上扩散或注入杂质的方式实现[6],为了改善温度特性,后来也采用了多晶硅薄膜[7],但普通多晶硅薄膜的应变因子较小,不利于提高灵敏度。最新研究结果表明[8],多晶硅纳米薄膜具有显著的隧道压阻效应,表现出比常规多晶硅薄膜更优越的压阻特性,重掺杂条件下其应变因子仍可达到34,具有负应变因子温度系数,数值小于1×10-3/℃,电阻温度系数可小于2×10-4/℃。因此,在牺牲层结构压力传感器上,采用多晶硅纳米薄膜作应变电阻,可以提高灵敏度,扩大工作温度范围,降低温度漂移[9]。然而,牺牲层结构非常薄,如何提高传感器的过载能力显得尤为重要。对此,本文在保证传感器满量程范围内线性响应的前提下,调整牺牲层厚度,通过弹性膜片与衬底的适当接触来有效提高传感器的过载能力。
1 牺牲层结构压力传感器
牺牲层结构压力传感器是指弹性膜片利用牺牲层技术制作而成的压力传感器,结构示意图如图1所示,其中 AB(A′B′)为膜片宽度 a,AA′(BB′)为膜片长度b,H1为膜片厚度,H2为牺牲层厚度。

图1 牺牲层结构压力传感器
在表面微加工中,由淀积到衬底和牺牲层上的薄膜作为结构层,对微小结构的尺寸更易控制,器件的尺寸得以减小。然而,这些结构层的机械性能高度依赖于淀积和随后的加工过程,相对低的淀积速率虽然限制了所制作器件的厚度[10],但是由于结构层厚度低,所以能制作出量程更小、灵敏度更高的压力传感器。
本文以量程0.1 MPa的牺牲层结构压力传感器为例,设计出电压源E=5 V时,满量程输出为60 mV的压力芯片。为了满足灵敏度的设计要求,改变弹性膜片的宽度、长度、厚度和牺牲层厚度对应力分布进行模拟仿真(模拟仿真时多晶硅杨氏模量EX=1.7×1011N/m2,泊松比PRXY=0.24,多晶硅纳米薄膜应变因子G=30),经过优化后[11],得到满足设计要求的弹性膜片尺寸:长度 a=300 μm、宽度 b=150 μm、膜片厚度 H1=3 μm、牺牲层厚度 H2=3.5 μm。
针对所设计的压力传感器芯片,进行了投片实验,其主要工艺步骤如下:①在硅衬底上,采用PECVD方法淀积一层二氧化硅作为牺牲层;②采用PECVD方法淀积一层二氧化硅,经过光刻形成腐蚀通道;③在牺牲层上采用LPCVD方法淀积一层多晶硅作为结构层,经过光刻形成腐蚀孔;④用氢氟酸溶液释放牺牲层,再采用LPCVD方法淀积一层多晶硅,从而使腔体密封;⑤热氧化一层二氧化硅作为绝缘层,在其上采用LPCVD方法淀积多晶硅纳米薄膜作为电阻层;⑥采用PECVD方法淀积一层二氧化硅作为钝化层,并利用离子注入方法对电阻层进行局部掺杂,形成应变电阻;⑦利用光刻技术对钝化层进行光刻,从而形成引线孔。最后,蒸铝形成金属布线。
试制的芯片实拍照片如图2所示。

图2 压力芯片照片
采用气体加压的方式对芯片样品进行了测试。测试温度条件为室温,激励源为1 mA恒流源,其输出特性测试结果如图3所示。

图3 压力芯片输出特性测试结果
由图3可见,随着压力载荷的增加,输出电压并未随之线性增加,其增加的程度逐渐减小,而且满量程输出未达到设计要求。经过分析,出现图3所示的现象应该是由于芯片的密封腔体有泄漏引起的。虽然有泄漏,但芯片仍然表现出了压力敏感特性,而且利用多晶硅纳米膜研制的硅杯结构压力传感器能够满足设计要求[9]。因此,改善工艺解决泄漏问题后,牺牲层结构多晶硅纳米膜压力传感器的性能应该能满足设计要求。
2 牺牲层厚度对过载能力的影响
对于上述0.1 MPa传感器,当最大应力达到硅的断裂强度4.5×108N/m2时,膜片底部与衬底不发生接触,过载能力不高。如果减小牺牲层厚度使膜片断裂前与衬底接触便可提高过载能力,牺牲层厚度越小过载能力越强,但不可避免会引入非线性形变,因此本文将利用静态线性分析与非线性接触分析相结合的方法,对牺牲层厚度进行优化设计,提高压力传感器的过载能力。
2.1 过载能力及极限过载能力
对于采用湿法腐蚀的扩散硅压力传感器,其压力敏感结构上的二氧化硅和氮化硅等绝缘或保护层厚度比弹性膜厚度小很多,一般在结构分析和应力分布分析中可以忽略它们的影响[12-13]。但是,本文的牺牲层结构压力传感器的多晶硅弹性膜片厚度为3 μm、二氧化硅绝缘层厚度为 0.5 μm,二氧化硅层厚度相对于多晶硅而言不可以忽略,所以在优化模拟仿真时需要考虑其对应力分布的影响。
利用有限元法对上述0.1 MPa传感器的力敏结构进行模拟分析,可知当加载压力使膜片上的最大应力刚好达到硅的断裂强度时,膜片中心的挠度为1.6 μm。显然,牺牲层厚度 H2<1.6 μm 时,膜片在断裂前可与衬底接触,因此,需要采用非线性接触分析来计算过载能力;而牺牲层厚度H2≥1.6 μm时,无需考虑膜片与衬底接触问题。
牺牲层厚度H2<1.6 μm时,随着牺牲层厚度的减小,使膜片与衬底刚好接触所加载的压力也随之减小,当牺牲层厚度减小使该加载压力减小到刚好满量程压力时,牺牲层厚度不可再减小,否则传感器在量程范围内将出现了非线性形变,这样便确定了减小牺牲层厚度提高过载能力的极限值。经过仿真,膜片长度 a=300 μm、宽度 b=150 μm、膜片厚度H1=3 μm时,对应的牺牲层厚度最小值为0.3 μm。下面利用有限元分析软件对此参数的压力传感器进行非线性接触分析。按照模型建立、网格划分、接触对建立、加载、求解的顺序进行模拟仿真。当最大应力达到硅的断裂强度时,加载压力为1.55 MPa,仿真结果如图4所示,其中点O处于膜片中心。

图4 四分之一弹性膜片极限变形剖面图
在压力传感器实际设计中,出于工艺精度的考虑,相比满量程加载时,牺牲层厚度的最小值应该留有余量。若以量程的50%为余量,则牺牲层厚度最小值应为加载0.15 MPa时对应的尺寸。经过仿真后,留有余量的牺牲层厚度最小值为0.5 μm,此时当膜片最大应力达到硅的断裂强度时,加载压力为1.35 MPa。
牺牲层厚度H2>1.6 μm时,进行线性分析仿真,以H2=3.5 μm为例,按照模型建立、网格划分、加载、求解的顺序进行线性模拟仿真。当最大应力达到硅的断裂强度时,加载压力为0.47 MPa,其应力分布的仿真结果如图5所示。

图5 四分之一弹性膜片极限变形时应力分布图
2.2 牺牲层厚度与过载能力间的关系
利用非线性接触分析与线性分析的仿真方法,对牺牲层厚度 H2在 0.3 μm ~3.5 μm 之间变化时进行具体的仿真,给出了膜片最大应力达到硅的断裂强度时,衬底和膜片之间的距离ΔH与牺牲层厚度H2的关系,如图6所示。同时也给出了膜片最大应力达到硅的断裂强度时所施加的压力载荷Pmax(过载能力)与牺牲层厚度H2关系,如图7所示。
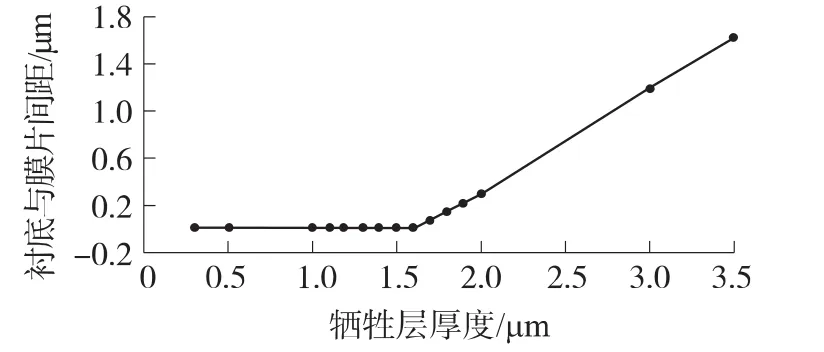
图6 牺牲层厚度H2与衬底和膜片间距ΔH关系

图7 过载能力Pmax与牺牲层厚度H2关系
由图7可见,牺牲层厚度H2小于1.6 μm时,由于弹性膜片在断裂前受到衬底的支撑,传感器的过载能力随牺牲层厚度的减小得到显著提高。
3 讨论
通过前面对过载能力的分析可以看到,对于牺牲层结构压力传感器,可以通过减小牺牲层厚度的方法提高过载能力,但牺牲层厚度不可过小,否则传感器在量程范围内将出现了非线性形变。对于量程为0.1 MPa的牺牲层结构压力传感器,牺牲层厚度最小值为0.3 μm,其过载能力为 1.55 MPa,明显大于牺牲层厚度较大且弹性膜片断裂前不和衬底接触的压力传感器的过载能力,比牺牲层厚度为3.5 μm传感器的过载能力(0.47 MPa)提高223%。在实际设计中,为了保证传感器在正常工作压力范围内的线性精度,应该根据工艺精度,适当增加牺牲层厚度。如果将上述最小牺牲层厚度值(0.3 μm)增加到0.5 μm,则相应的过载能力降低为1.35 MPa,仍然比牺牲层厚度为3.5 μm 传感器的过载能力(0.47 MPa)高180%。
从图6的仿真结果可以看到,当H2≤1.6 μm时,ΔH=0,弹性膜片在断裂时已经和衬底接触,传感器的过载能力可得到有效提高。这一点可从图7的仿真结果得到进一步说明,当H2≤1.6 μm时,膜片最大应力达到硅的断裂强度时所施加的压力载荷Pmax随H2减小急剧变大,这是因为此时膜片与衬底接触,传感器应变非线性变化程度增加,抗过载能力得到了极大的提高;当 H2>1.6 μm 时,Pmax随着 H2变大缓慢增加,基本保持在最小值附近。因此通过适当控制牺牲层厚度,可以有效提高传感器的抗过载能力。
4 结论
针对牺牲层结构压力传感器的过载保护设计,本文在保证传感器满量程范围内线性响应的前提下,调整牺牲层厚度,通过弹性膜片与衬底的适当接触来有效提高传感器的过载能力。利用有限元法,对传感器弹性膜片的应力分布进行了静态线性分析和非线性接触分析,得到了下述结论。
对于牺牲层结构压力传感器,可以通过减小牺牲层厚度的方法提高过载能力,但牺牲层厚度不可过小,否则传感器在量程范围内将出现了非线性形变。
对于量程为0.1 MPa的牺牲层结构压力传感器,通过适当控制牺牲层厚度,可以使传感器的过载能力提高180%~220%。
[1]BAO Minghang,YU Lianzhong,WANG Yan.Stress Concentration Structure with Front Beam for Pressure Sensor[J].Sensors and Actuators,1991,28(2):105-112.
[2]PEDERSEN C,JESPERSEN S.T,KROG J.P,CHRISTENSENSERL C,et al.Combined Differential and Static Pressure Sensor Based on a Double-Bridged Structure[J].Sensors Journal,IEEE.,2005,5(3):446-454.
[3]KOVACS G T A,MALUF N I,PETERSEN K E.Bulk Micro-Machining of Silicon[J].Proceedings of the IEEE,1998,86(8):1536-1551.
[4]BUSTILLO J M,HOWE R T,MULLER R S,et al.Surface Micromaching for Microelectromechanical Systems[J].Proceedings of the IEEE,1988,86(8):1552-1574.
[5]WANG Xujian.Overload Protection Design of Silicon Pressure Sensor[J].Instrument Technique and Sensor,2010,(1):7-9.
[6]ZHAO Yulong,ZHAO Libo,JIANG Zhuangde.A Novel High Temperature Pressure Sensor on the Basis of SOI Layers[J].Sensors and Actuators,2003,108(1):108-111.
[7]Suski J,Mosser V,Goss J.Polysilicon SOI Pressure Sensor[J].Sensors and Actuators,1989,17(3):405-414.
[8]揣荣岩,刘晓为,霍明学,等.掺杂浓度对多晶硅纳米薄膜应变系数的影响[J].半导体学报,2006,27(7):1230-1235.
[9]LIU Xiaowei,LU Xuebin,CHUAI Rongyan.Polysilicon Nanofilm Pressure Sensor[J].Sensors and Actuators A,2009,154(1):42-45.
[10]French P J,Gennissen P T J,Sarro P M.New Silicon Micromaching Techniques for Microsystems[J].Sensors and Actuators,1997,62(1):652-662.
[11]揣荣岩,崔林,王健,等.多晶硅纳米薄膜牺牲层压力敏感结构设计[J].仪表技术与传感器,2010,(2):10-13.
[12]赵艳平,丁建宁,杨继昌,等.微型高温压力传感器芯片设计分析与优化[J].传感技术学报,2006,19(5):1829-1831.
[13]倪智琪,姚素英,张生才,等.SOI单晶硅压力传感器模拟计算与优化设计[J].传感技术学报,2003,16(1):92-95.
