遥感 CCD相机的抗辐射策略研究
2010-11-06郭永飞
郭永飞
(中国科学院长春光学精密机械与物理研究所,吉林长春 130033)
1 引 言
随着遥感 CCD相机的广泛应用,对其抗辐射性能的研究越来越深入。空间环境不同于地面,宇宙中存在着大量的粒子,遥感 CCD相机会受到辐射和重粒子的冲击而发生各种辐射效应,造成其工作的异常或故障。同时,由于遥感 CCD相机具有工作周期长和不可维护性,对其可靠性的要求非常高。从国内外对遥感事故的统计数据可以发现 40%的故障源于空间辐射[1],因此,抗辐射技术是保证遥感 CCD相机高可靠性的关键因素,是目前航天电子领域的研究重点和热点。
本文在对空间辐射环境进行分析的基础上,对辐射危害进行研究,分别从辐射总剂量和单粒子等方面提出了遥感 CCD相机抗辐射策略和具体的设计,并利用实验对抗辐射措施进行了验证。
2 空间辐射
空间辐射环境根据来源不同主要分为太阳活动、宇宙射线、范艾伦辐射带 (Van Allen Belt)和次级辐射,处于不同的轨道辐射环境也不同。对于围绕地球运行的航天器威胁最大的是位于赤道上空的内、外范艾伦辐射带,它们主要由高能质子(30~100 MeV)和高能量电子 (0.4~1 MeV)组成,受辐射的剂量率可分别达到 1和 10 Gy/h。
(1)太阳活动
太阳辐射是空间辐射环境中最活跃和最主要的因素,长期观测发现,依据粒子能量和通量的不同,可将太阳活动分为缓变型太阳活动和爆发型太阳活动,它们的辐射影响不同。前者太阳风的主要成分为电子和质子,发射粒子流的速度为300~900 km/s;后者太阳风的主要成分为大量的带电粒子流和高能射线,发射的粒子流的速度高达 2 000 km/s以上,能量比前者高出几个数量级。
太阳活动周期为 11年。如太阳耀斑等爆发型太阳活动在太阳活动低年发生概率较小,在太阳活动峰年发生概率极大。太阳耀斑属于小概率,其特点是持续时间短、总能量小,但功率极高,一般高能质子 (约 30 MeV)喷射持续时间可为数百分钟至数天,总剂量为 0.1~10 Gy。太阳辐射对航天电子设备和宇航员具有极大的破坏性,因此一直是空间辐射领域的研究重点。
(2)宇宙射线
宇宙射线是密度极小,能量极高的各向同性粒子,其成分的 83%为高能粒子,具有极大的贯穿能力。所以飞行器在外层空间运行所受的辐射是相当严重的,处于地球卫星中的航天电子系统每年所接受到累积辐射剂量可达 100 Gy以上,其中暴露于表面的元器件更高。
(3)范艾伦辐射带
在没有爆发型太阳活动时,辐射带内高能粒子的组成和分布相对稳定。当爆发型太阳活动发生,或星际磁场对地球磁场产生扰动时,辐射带内高能粒子的能谱和通量会激增且辐射带更靠近地球,从而导致地球卫星,甚至地面电气设备的故障。
(4)次级辐射
当本源高能粒子穿过遥感器材料时,会发生核反应,激发出次级粒子和射线。
目前主要关注的比较平稳的低地轨道环境(即轨道高度 100~1 000 km)其典型的辐射剂量是每年 0.1 krad,对于寿命期 3~5年的飞行器,总辐射剂量 <0.5 krad。在地球极地轨道,飞行器经过离子宇宙线和太阳耀斑等区域会沉积大量的辐射,虽然辐射过程很短,辐射剂量每年只有3 krad左右,但长期积累的辐射总剂量较为可观。
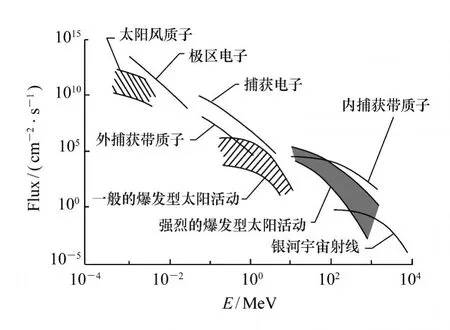
图1 空间辐射环境[2]Fig.1 Space radiation environment[2]
一个飞行器的总剂量通常会达到 10~100 krad。W ilson等人粗略地给出了空间环境的组成离子和能谱 ,如图1所示[2]。
3 辐射危害
空间辐射对遥感 CCD相机的辐射效应主要分为 3类:
(1)辐射总剂量 (Total I onizingDose,T ID)
辐射总剂量是指电子器件在辐射环境下器件在发生重大改变 (永久故障)前所能承受的总吸收能量级。
(2)单粒子效应 (Single Event Effect,SEE)
单粒子效应是指单个高能粒子撞击对电子器件的瞬间扰动或是永久性的损伤,分为单粒子翻转效应 (Single EventUpset,SEU)和单粒子闩锁效应(Single EventLatch,SEL)。
(3)位移效应 (DisplacementDamage,DD)
位移效应是指单个高能粒子撞击电子器件时,粒子与晶格原子在碰撞过程中使原子核离开它正常的位置形成晶格缺陷。
3.1 TI D
辐照总剂量主要是指带电粒子 (如电子、质子等),γ射线和 X射线与物质相互作用在半导体器件内产生过量电子/空穴及其后在器件内部不同位置所产生的一系列物理过程,如复合、输运等对器件电性能的影响[3]。没有外加电场时,复合的趋势较强;有外加电场时,电子和空穴沿电场方向相向运动,由于电子的迁移率非常高,能很快离开氧化物,从而使得空穴得以在氧化物内累积,形成栅氧空穴捕获。电场强度越大,电子迁移率越高,栅氧捕获越强,这就是加电半导体器件的T ID损伤比不加电半导体器件受损严重的原因。
辐照总剂量效应对金属-氧化物硅 (MOS)器件影响大;辐射将最终在 SiO2绝缘层产生正的氧化物陷阱电荷,在 Si/S iO2界面产生界面陷阱电荷,结果导致器件的电性能参数明显退化,甚至功能失效,是一种累积的损伤行为。一般来说,对短时间的总剂量效应 (如核爆炸产生的γ射线和X射线)主要是氧化物陷阱电荷的损伤;对于长时间的总剂量效应 (空间辐射环境)则主要来自界面陷阱电荷损伤[2]。
3.2 SEE
单粒子效应则主要对短沟道的大规模集成电路产生影响。除了在半导体机理上的单粒子效应外,其半导体生产材料和工艺的变化也使大规模集成电路对单粒子效应更加敏感。最近研究表明,在 MOS器件的沟道长度、结深和栅氧厚度等比缩小 (由 0.5μm至 0.18μm工艺)的同时,器件工作电压并未能随之等比减少,这就导致器件沟道区的横向和纵向电场以及氧化层纵向电场显著增加,引起对单粒子效应敏感。
单粒子效应在行为上可分为 SEL和 SEU。1)SEL

图2 非门结构Fig.2 NOT gate configuration
SEL发生在瞬时密集的电子/空穴形成的电流使寄生的晶体管导通,在 CMOS集成电路中寄生着双极性晶体管构成的 PNPN器件[4],以图2(a)中的非门为例,P衬底上 NMOS的 n+、P衬底的 p-、以及 N阱的 n+接触垫可以构成水平的寄生 NPN晶体管的Vsub,N阱上 PMOS的 p+、N阱的 n-、以及 P衬底的 p+接触垫可以构成垂直的寄生 PNP晶体管的Vwell;图2(b)为寄生 PNPN的等效电路。正常情况下,Vsub和Vwell集电结零偏置,发射结正偏置,处于截止状态,此时VDD和GND之间具有很高的阻抗。当高能粒子射入阱和衬底之间时,阱和衬底之间就会出现短时间的导通,由于电势差的存在,就会造成Vsub的发射结正偏置,Vsub的导通又会导致Vwell的导通,从而使得 PNPN进入正反馈,此时VDD和 GND呈现低阻态。
如没有限流措施,低阻态产生的大电流可将器件内金属线熔断,造成永久性损伤,甚至可将器件烧毁,不能恢复,属于“硬故障”。若有限流措施,单粒子使电路“死机”,但断开电源并重新上电,能恢复电路功能,属于“软故障”。
2)SEU
SEU效应指当单个高能粒子轰击器件电路时,电子器件内部因强烈电离而在很小空间范围内形成等离子体,当等离子体径迹附近存在电势差时,会引起电荷的转移[5],当电荷转移足够大时,使器件的逻辑状态翻转,出现逻辑功能和数据混乱。单个位翻转称为 SEU,多个位翻转称为MBU。以图3中寄存器单元为例,当高能粒子轰击左下侧的NMOS管并致其导通时,会导致A点因接地而从 1变 0,进而会导致B点从 0变 1。这种错误不会使逻辑电路损坏,也属于“软错误”,重新上电后可恢复功能。

图3 SEU效应的本质Fig.3 Essence of SEU effect
3.3 DD
高能粒子入射到电子元器件及材料时,当它充分地靠近被辐射材料晶格原子的原子核,或与原子核产生弹性碰撞时,晶格原子在碰撞过程中得到机械能,会离开它正常的位置,从而形成器件功能部位的晶格缺陷。如果入射高能粒子能量足够大,会使晶格内大量原子发生位移,形成大的缺陷簇。晶格缺陷会导致器件性能参数 (晶体管放大系数、太阳电池和 CCD等光电敏感器件的转换效率)退化,缺陷逐步累积,直至器件丧失功能,因此 DD造成的损伤属于累积效应[6]。DD与T ID表现类似但本质不同,T ID与器件加电状况有关,DD的损伤与加电与否无关。另外 T ID损伤对象更广,DD的损伤对象为双极性器件、太阳电池和 CCD等光电敏感器件。
4 抗辐射策略
遥感 CCD相机是航天遥感有效载荷中重要的部分[7],它主要由 CCD传感器、预放器、时序发生器和驱动器、视频处理器、数据合成器、控制与接口电路组成。如图4所示。
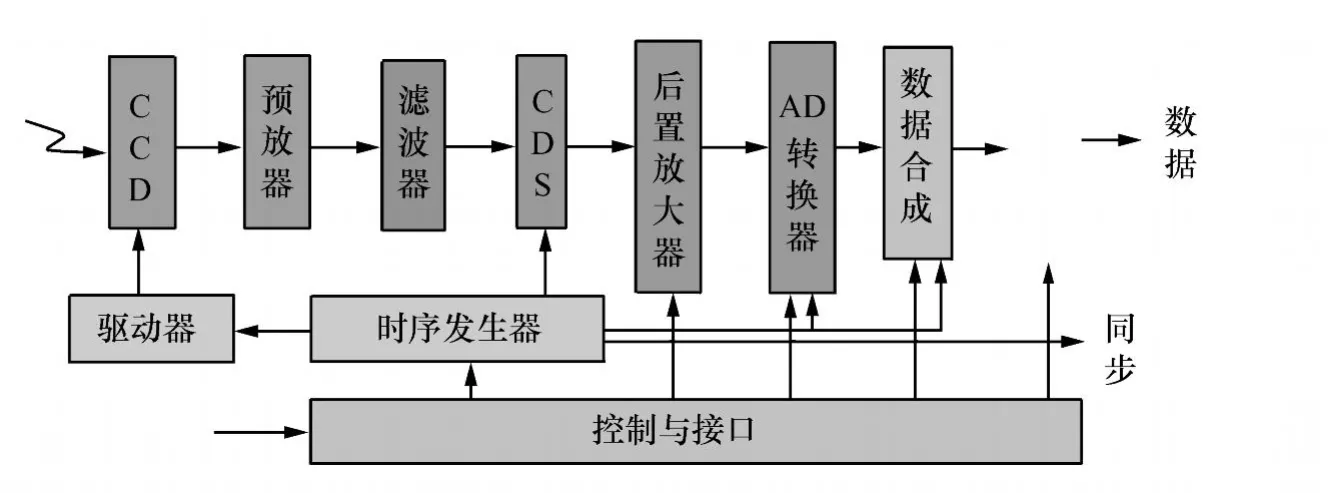
图4 遥感 CCD相机的组成Fig.4 Structure of CCD remote sensing camera
图4中各器件和模块的作用为,CCD传感器:将投影图像转换为电压图像;预放器:阻抗匹配和放大以驱动视频传输线;时序发生器:产生CCD工作所需的时序脉冲;驱动器:放大时序脉冲功率,驱动大电容负载;视频处理器:降低噪声、减少频率混淆、AD转换 (滤波器、CDS、后置放大器和 ADC);数据合成:将多路图像数据进行整合和编排;控制与输出:接受外部的控制信号和输出图像数据。
遥感 CCD相机涉及光电变换和电子学等领域的技术,从图4可见其主要采用 CCD传感器、集成电路和 FPGA等电子元器件构成,在空间应用中电子元器件会受到电磁场的辐射和重粒子的冲击而发生各种辐射效应,造成其工作的异常或故障。为了提高遥感 CCD的可靠性,必须采取抗辐射策略和具体的设计。
4.1 CCD传感器抗辐射措施
CCD传感器的物理基础是 MOS电容器。图5给出三相 CCD的结构图。在空间辐射环境中受到辐射时,在 Si表面和 S iO介质层内都会产生各种辐射缺陷,使表面复合和体内复合增大,MOS阈值电压漂移,电荷转移效率下降。另外,电荷激发的量子效应易受到辐射影响,可导致噪声性能逐渐衰退。

图5 CCD的结构示意图Fig.5 Structure sketch of CCD
NASA Goddard宇航中心探测器实验室对哈勃太空望远镜 (HST)宽视场摄像机中的 CCD探测器性能进行了测试。结果表明,辐射使 CCD性能明显退化,主要为电荷转移效率 (Charge Transfer Effect,CTE)降低、暗电流增加、亮疵点数增加。CTE退化可引起光探测精度降低、噪声增加。CTE和暗电流的变化是由于质子诱导的位移损伤引起的,因此 CCD传感器辐射损伤主要是 T ID和DD效应的结果。
在遥感 CCD相机中,CCD传感器要接受外部入射的光子,将有部分面对外太空,不能采用常规的抗辐射加固的办法。提高 CCD抗辐射能力的主要措施有两个方面:
(1)器件工艺改进
提高 SiO介质层抗辐射性能,采用薄栅介质(50~75 nm)可有效减小 CCD电压漂移;在氧化物中掺铬可有效抑制表面态形成,提高负偏压下CCD的抗辐射能力;在氧化物生长工艺中严格控制 SiO中的 Na含量,抑制阈值电压漂移,可用氧化铝或氮化硅、二氧化硅组成多层栅介质,削弱平带电压漂移。
美国休斯公司加固的埋栅 CCD,在 1×104Gy(s)剂量辐照下,阈值电压漂移可小于 2 V,表面栅 CCD阈值电压漂移小于 1.5 V,平均暗电流仅为辐射前的 1.75倍。
(2)器件降额使用
通过有意降低 CCD传感器承受的电、热等应力,可降低其辐射失效率。在设计上将 CCD传感器的饱和电子数保留 20%的余量,可保证在使用寿命期内因辐射效应引起的暗电流增加而不影响其动态范围。另外,CCD传感器的实际驱动速率要选择在其额定速率的 50%以内,并尽可能地采用多路输出的形式,以克服因辐射效应带来的CTE退化降低光探测精度。充分地采用导热措施,使 CCD传感器的工作温度保持在低水平上,以抑制因辐射效应引起的暗电流增加并降低辐射失效率。
4.2 集成电路抗辐射措施
遥感 CCD相机中的预放器、驱动器、视频处理器和控制与接口均采用了一定规模的集成电路,其中 CMOS集成电路占主导地位。提高CMOS集成电路抗辐射能力的主要措施有 5个方面:
(1)选择抗辐射器件
通常,给定辐射剂量的相对影响取决于芯片技术的实际结构。在材料选取方面,SO I(Silicon-On-Insulator),SOS(Silicon-On-Sapphire),GaAs等材料的抗辐射能力比 Si要高,如 SO I器件中 MOS管和衬底之间绝缘隔离,降低了寄生 PNPN回路增益,减少了可能的激发电流,从而消除了 SEL。另外,在基片的工艺上应尽量选用0.3μm以上器件,同时保证选择的器件具有一定的辐射设计余量 (RDM >2)。
(2)器件屏蔽和加固
在选择抗辐射器件出现困难时或者选择抗辐射器件达不到应用要求时,设计者就只有求助于另一种解决方法—附加屏蔽和加固。这是抗辐射的一个传统和自然的办法,即采用抗辐射材料加固器件和在外壳和架构上的铝板外涂覆抗辐射材料加强对辐射的屏蔽,如图6所示。
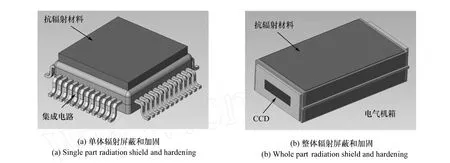
图6 辐射屏蔽和加固Fig.6 Radiation shield and radiation hardening

表1 遥感 CCD相机部分集成电路降额使用Tab.1 Derating use of part ICs in remote sensing CCD camera
如NASA已经应用了 Rad-pakTM和 Rad-coatTM涂覆技术[8]。但是,屏蔽的作用对高能粒子有限,且屏蔽材料的厚度受到航天器体积和重量的制约,辐射加固的器件价格昂贵又难以供货。另外由此增加了重量也是不希望有的。
(3)器件降额使用
通过有意降低预放器、驱动器、视频处理器和控制与接口等采用的集成电路器件承受的电、热等应力,以降低其辐射失效率。表1所示为遥感CCD相机中采用的部分集成电路降额使用设计。
针对不能采取降额使用的辐照敏感器件,进行最坏情况分析(即最大辐射剂量下),确保在使用寿命期内性能和功能满足要求。
(4)抗闩锁 (SEL)电路
尽管遥感 CCD相机中 CMOS结构的集成器件有众多优点,但它并非完美无缺。主要是CMOS结构会形成电路的闩锁 (又称闭锁、自锁、闸流效应),这是 CMOS集成器件与生俱来的寄生效应,它会严重影响集成器件的功能,造成集成器件功能混乱甚至集成电路器件根本无法工作或烧毁。由于 CMOS集成器件的 SEL主要表现为内部的低阻态产生的大电流,只要限制其电流大小,就可避免将 CMOS集成器件烧毁。
抗 SEL措施包括:限流、基于电流检测的电源管理、周期性切机、设备自检等。限流是最常用的一种典型方法,一般是在 CMOS集成器件的电源入口串接小限流电阻,如图7所示。因不同的CMOS集成器件工作频率和负载有差异,工作电流IDD的区别会很大,从几~几十毫安。为此,可针对每个 CMOS集成器件的使用情况进行设计和调试确定,举例如下:

图7 CMOS集成器件限流方法Fig.7 Limit currentmethod of CMOS integrate element
CMOS集成器件的动态工作电流为IDD=10 mA,额定工作电压VDD=5 V,器件电压为4.75~5.25 V,该器件的闩锁ISEL=200 mA。
先计算出ΔV的值,ΔV=VDD-VB,要保证器件正常工作,VB应选取不小于 4.75 V,则ΔVmax=0.25 V,然后求出RL。

当该器件进入闩锁时,可以认为VB是 0 V,则故障电流为:

该Ifail远小于ISEL=200 mA,这里需要注意RL的功率要远大于 5×40=200 mW。
限流可以防止 CMOS电路进入锁定态或进入锁定态后器件不遭损坏,经断电再重新启动后电路可退出锁定。限流对单粒子效应产生的锁定可起到相同的保护作用。
此方法的不足表现在,其一,由于串接电阻,增加了功耗;其二,由于IDD是动态工作电流,IDD的变化会引起VB的变化,因此串接电阻的方法适应于 CMOS数字集成器件;其三,此方法只能用于动态工作电流≤10 mA,且闩锁电流 /工作电流≥20的 CMOS集成器件。

图8 LDO限流Fig.8 LDO limit current
基于电流检测的电源管理可以实时监视电流大小,一旦电流超过某一设定阈值,则认为发生了SEL,即自动进行限流的过程,从而消除闩锁。现在常用的设计是在单个器件或多个器件的供电回路中加入具有限流功能的低压差稳压器 (LDO),该LDO电路应该采用双极性晶体管电路构成,因为它本身要具有 SEL免疫能力,如图8所示。
采用LDO电流检测的电源管理方法可以有效地克服串接电阻限流方法的诸多不足,特别是IDD是动态工作电流的变化引起VB的变化,而VB是由 LDO设定的输出值,即固定的,所以此方法适应于通用的 CMOS集成器件。另外,此方法可用于动态工作电流≥10 mA,且闩锁电流 /工作电流≤20的抗 SEL的设计。举例如下:
CMOS集成器件的动态工作电流IDD=25 mA,额定工作电压为 5 V,器件电压为 4.75~5.25 V,该器件的闩锁ISEL=400 mA。闩锁电流 /工作电流 =16。采用 LDO进行限流控制时,LDO选取MAX883,它的输入电压为 3~11 V,输出电压可设定为 4.65~5.35V,在ΔV=0.3 V时的续流能力为 200 mA,限流控制为 350 mA。
设定VDD=5.20 V,VB=4.9 V,保证正常工作ΔV=0.3 V。当该器件进入闩锁时,LDO限流控制到 350 mA,该限流值应小于ISEL=400 mA,可以防止某 CMOS集成器件进入锁定态。因MAX883具有 200 mA续流能力,可以将多个该器件采用一个 LDO进行限流保护,如用 6片时,正常工作电流为∑IDD=150 mA,当任何一片器件进入闩锁时,即可防止某 CMOS集成器件进入锁定态。
(5)增加冗余能力
冗余设计方法是公认为比较可靠的对付辐射效应的方法。遥感 CCD相机的冗余能力采用物理上完全双机冷备份,包括电源变换,输入和输出接口均可具有主份或备份独立控制。针对一些重要的 CMOS集成器件也要采用双电路冷备份,无法实现双机冗余冷备份的电路设计则采用了热备份设计。此外,对冗余电路进行周期性切机是防止小电流闩锁的有效方法,采取冷备份方式还有助于 T ID退火。遥感 CCD相机的冗余如图9所示。

图9 遥感 CCD相机的双机冷备份冗余设计Fig.9 Two system redundancy design of remote sensing CCD camera
4.3 FPGA抗辐射措施
自 2003年 FPGA成功应用于火星探测任务之后,国内外航天领域对 FPGA的应用兴趣大增[9]。遥感 CCD相机中时序发生器和数据合成器采用了 FPGA来实现其复杂的功能,因此 FPGA器件是遥感 CCD相机中的关键部位,其抗辐射措施十分重要。提高 FPGA抗辐射能力的主要措施有 5个方面:
(1)选择抗辐射 FPGA
通常,给定辐射剂量的相对影响取决于芯片技术的实际结构。针对 FPGA类型,如 Xilinx的SRAM型 FPGA,要选择具有抗辐射能力强的型号。如果在该型号获取困难时,就要选择工艺上具有特殊结构的 FPGA,如 Actel的反熔丝的 FPGA,在根本上提高 FPGA抗辐射能力。在基片的工艺上尽量选用 0.25μm以上器件,同时保证选择的器件具有一定的辐射设计余量。
(2)FPGA屏蔽和加固
FPGA的屏蔽和加固可以借鉴集成器件单体屏蔽和加固的技术,即采用抗辐射材料加固器件加强对辐射的屏蔽。这里不再阐述。
3)FPGA降额使用
通过有意降低 FPGA的工作频率和功耗,设计上将 FPGA的工作频率保留 50%的余量,以降低其辐射失效率,如表2所示。

表2 遥感 CCD相机中 FPGA的降额使用Tab.2 Derating use of FPGA in CCD remote sens ing camera
(4)FPGA抗闩锁 (SEL)电路
FPGA动态工作电流IDD=300 mA,该器件的闩锁ISEL为 880~1000 mA。闩锁电流 /工作电流为 2.9~3.3,因此 FPGA抗闩锁要采用 LDO进行限流控制。若 LDO选取MAX883,它在ΔV=0.3 V时的续流能力仅为 200 mA,不能满足 FPGA动态工作电流的需要。一种解决办法是选择能够保证FPGA正常工作电流且限流控制小于ISEL的 LDO;另一种解决办法是将两片MAX883并联使用来达到 FPGA的使用需求,即续流能力达400 mA,限流控制能力为 700 mA,小于 FPGA的ISEL。
但对 FPGA采用LDO进行限流控制时,要特别关注 FPGA需上电配置的特性。对 Actel的反熔丝的 FPGA,因无需上电配置,可以不予以考虑;而对于 Xilinx的 SRAM型 FPGA必须要注意,此类的 FPGA的控制逻辑数据需由外部在上电时进行配置,这期间 FPGA的工作电流将很大,有时将超过限流控制的电流,因此需要设计特别的电路,即能在 FPGA上电配置期间提供足够的电流能力,在其配置结束后,又能起到当单粒子闩锁发生时,LDO进行限流控制。如图10所示。

图10 FPGA的 LDO限流控制Fig.10 LDO l imit current control of FPGA
举例如下,两片 LDO1和 LDO2(MAX883)处于常工作状态,一片 LDO3(LM2941)仅在配置阶段起到提供足够的配置电流的作用,LM2941的续流能力为 1.5 A,配置完毕后由 FPGA控制其关断。LDO1和LDO2提供正常工作和单粒子闩锁发生时的限流控制。
(5)FPGA抗SEU
对于 Xilinx的 SRAM型 FPGA,当单粒子产生的位翻转发生在器件的控制或配置单元时,配置单元的翻转会导致 FPGA功能错误,即发生了SEFI[10]。因此 FPGA抗 SEU的常用方法是 3倍冗余法 (Triple Module Redundancy,T MR)和部分3倍冗余法 (Partial TripleModule Redundancy,PTMR)。冗余设计方法是被公认为比较可靠的对付辐射效应的方法。图11所示为 Xilinx推荐的 3倍冗余设计逻辑,这种逻辑充分地考虑了 SEU产生的影响。虽然 T MR提高了可靠性[8],但是也会使模块的速度降低 (有的甚至低到原来的 80%)、占用资源和功率增加 (约为 3.2倍)。所以要根据实际情况对关键部分使用 PT MR。
另外,FPGA在进行信号处理时需要进行逻辑运算、算术运算和移位旋转运算等逻辑运算,这些运算由内部的 CLB实现,而这些部件在受到辐射影响后,运算结果可能出现异常,甚至错误。因此,在 FPGA设计时需要考虑对关键运算结果的检验,以获得计算结果的正确性。常用的结果检验方法有 Berger预测法[11]、余数判断法检测法、 奇偶校验等。

图11 Xilinx推荐的 3倍冗余设计逻辑Fig.11 Three time redundancy design logic recommended by Xilinx
5 抗辐射措施验证
抗辐射措施验证的目的是获得空间辐射参数与遥感 CCD相机器件在施加抗辐射措施后受损程度的关系,验证包括空间飞行验证和地面模拟验证,在空间验证成本太高。因此,建立简化的地面模拟验证环境来模拟实际的空间辐射是常用的抗辐射验证方法。抗辐射验证可以分为辐射环境设置 (辐射源选取,试验标准)、器件受损参数测定、以及后续数据分析 3个环节。
5.1 抗辐射总剂量验证
随器件受不同辐射其受损程度也不同,如一般器件的 T ID损伤多数表现为参数的变化。验证时首先将未被辐射的器件进行参数测定,然后将施加抗辐射措施和未施加抗辐射措施的 CCD相机或器件分别或同时置于辐射源下,常见辐射源包括脉冲激光、X射线、Co60γ源,总剂量控制在4~5不同的档位,如图12和图13所示。

图12 抗辐射总剂量验证试验Fig.12 Validating experiment of anti-radiation TD I

图13 CCD器件抗辐射总剂量验证试验Fig.13 Validating experiment of CCD′s anti-radiation TD I
5.2 抗单粒子验证
抗单粒子验证可采用高能离子源 (锎、镅、锶等)、中子模拟源、电子加速器和重离子加速器等,在大量单粒子效应普查阶段,最好选用脉冲激光,以降低成本;而在关健芯片的定量验证时,须采用重离子源或加速器。验证方法可见上节的叙述,并参见图12和图13。
5.3 抗辐射评估
在辐射验证试验和空间环境估算的基础上,即可对 CCD相机和所使用的器件抗辐射能力进行评估。M IL-HDBK-814采用了辐射设计极限(Radiation Design Breakpoint,RDBP)来评估 T ID损伤,该方法通过辐射设计边界 (Radiation Design Margin,RDM)来界定抗辐射能力。在 RDBP中,当 RDM <2~3时,认为试验样品不满足抗辐射要求;当 2~3<RDM <10~100时,认为该试验样品为抗辐射需求的关键部件,需审慎对待;当RDM >10~100时,认为该试验样品完全满足抗辐射需求。
6 结束语
在遥感 CCD相机的广泛应用中,由于相机具有工作周期长和不可维护性,对其可靠性的要求非常高。遥感 CCD相机受到辐射和重粒子的冲击而发生各种辐射效应,会造成其工作的异常或故障,因此,抗辐射技术是保证遥感 CCD相机高可靠的关键问题。本文沿着辐射、辐射损伤、抗辐射措施等因果关系,着重介绍和分析了辐射来源的种类、辐射的损伤机理、抗辐射措施、辐射验证试验、以及抗辐射加固保障技术。该文的试验和分析会为提高遥感 CCD相机的抗辐射能力提供有益参考。
[1] BED INGFIELD K,LEACH R,ALEXANDER M.Spacecraft system failures and anomalies attributed to the natural space environment[R].Washington:NASA Reference Publication,1996:1390.
[2] W ILSON J,TOWNSEND L,SCH IMMERL ING W,et al..Transport methods and interactions for space radiations[R].Washington:NASA Reference Publication,1991:1257.
[3] 张立国,李豫东,刘则洵,等.TD I-CCD总剂量辐射效应及测试.光学 精密工程,2009,17(12):2925-2930.(in Chinese)ZHANGL G,L I YD,L IU Z X,et al.Influence of total dose effects on TD I-CCD and corresponding test methods.Opt.Precision Eng.,2009,17(12):2925-2930.
[4] 特劳特曼 R.CMOS技术中的闩锁效应问题及解决方法[M].北京:科学出版社,1994.TROUT MAN R.Latchup in CMOS Technology[M].Beijing:Academic Publishers,1994.(in Chinese)
[5] DUSSAULT H,HOWARD J W Jr,BLOCK R C,et al..High-energy heavy-ion-induced charge transport across multiple junctions[J].IEEE Trans.Nucl.Sci.,1995,42(6):1780-1788.
[6] SROUR J,MARSHALL C,MARSHALL P.Review of displacement damage effects in silicon devices[J].IEEE Trans.Nucl.Sci.,2003,50(3):653-670.
[7] 岳俊华,李岩,武学颖,等.多 TD I-CCD拼接相机成像非均匀性的校正.光学精密工程,2009,17(12):3085-3088.YUE J H,L IY,WU X Y,et al.Correction of imaging non-uniformity formulti-TD ICCD mosaic camera[J].Opt.Precision Eng.,2009,17(12):3085-3088.(in Chinese)
[8] M ILLWARD D G,STRTOBEL D J.The effectiveness of RADPAKT M IC′s for space radiation hardening[C].Proc.40thECTC Conference,LasVegas,USA,20-23 May,1990.
[9] S W IFT G,ALLEN G,GEORGE J,et al..Upset susceptibility and design mitigation of power PC405 processors embedded in virtexII-Pro FPGAs[C].Military and Aerospace Applications of Programmable Devices and Technologies Conference(MAPLD),Washington,USA,7-9 Sept,2005.
[10] KOGA R,PENZ IN S H,CRAWFORD K B,et al..Single event functional interrupt(SEFI)sensitivity in microcircuits[C].RADECS,Cannes,France,15-19 Sep,1997.
[11] YU ID,S W IFT G,CARM I CHAEL C.Single event upset susceptibility testing of the Xilinx virtex II FPGA[C].Military and Aerospace Applications of Programmable Devices and Technologies Conference(MAPLD),Washington,USA,8-10 Sept,2002.
