大功率光电器件光波导键合技术研究
2024-10-10张晨璐罗燕魏紫东王乐庭谢雅尚吉扬
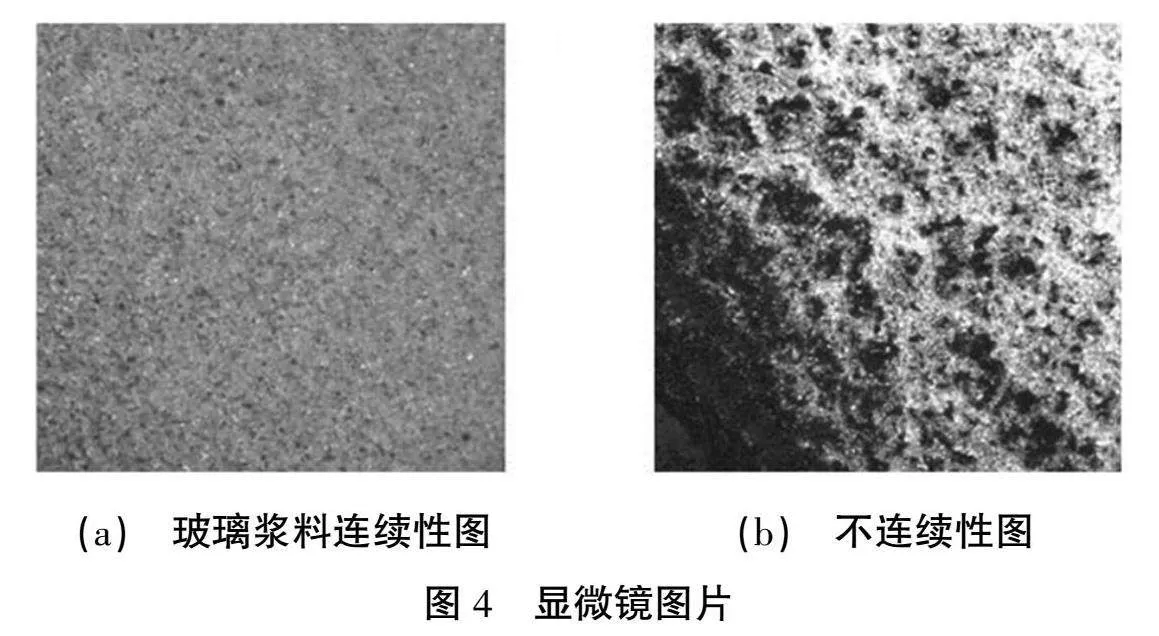

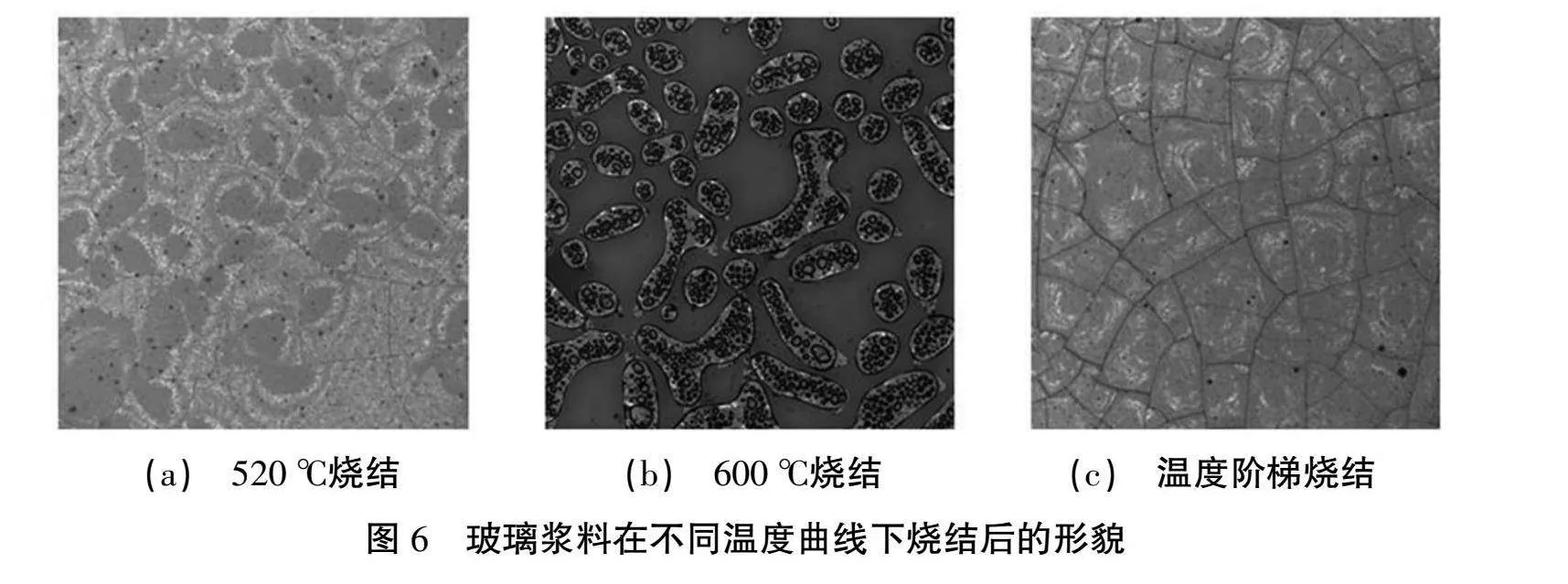


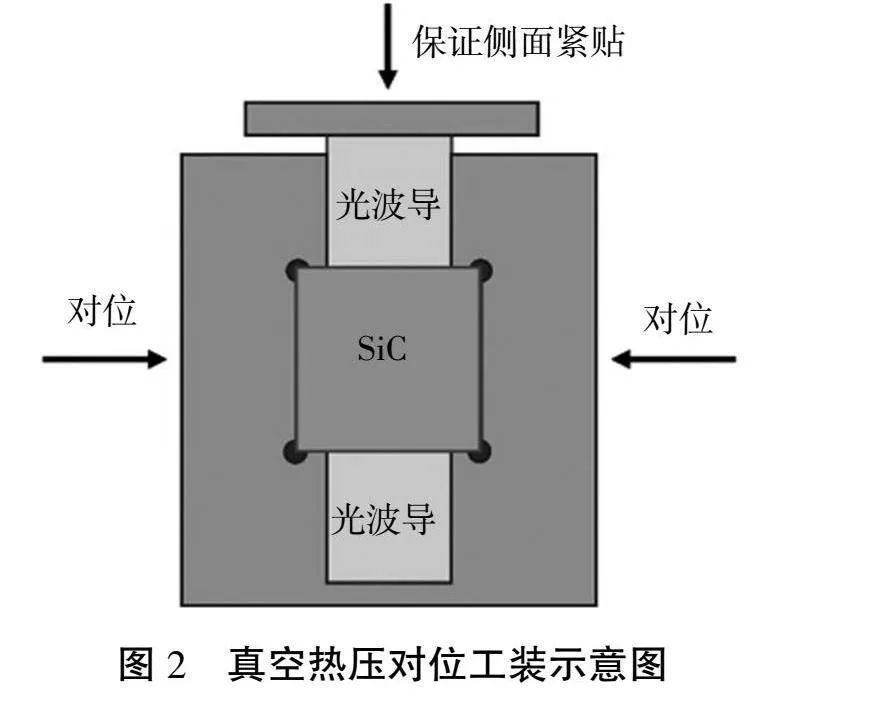
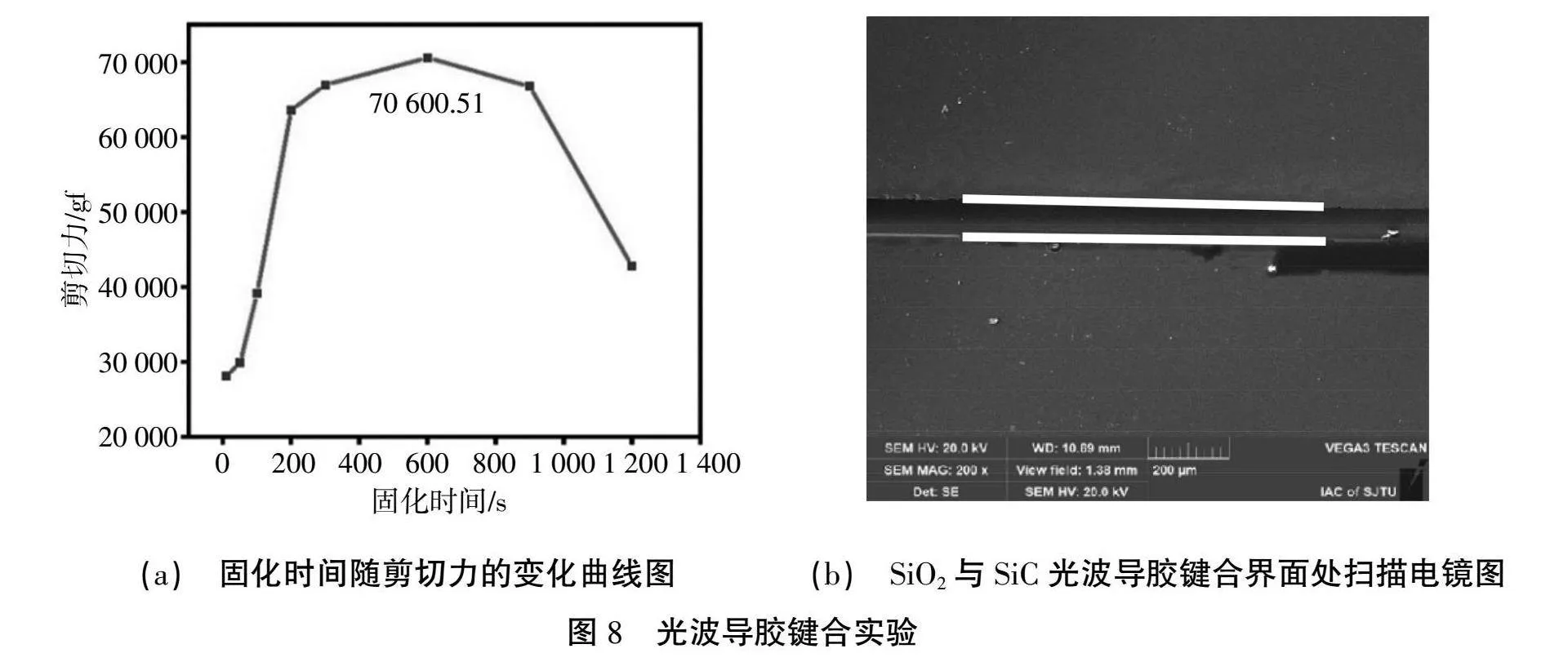
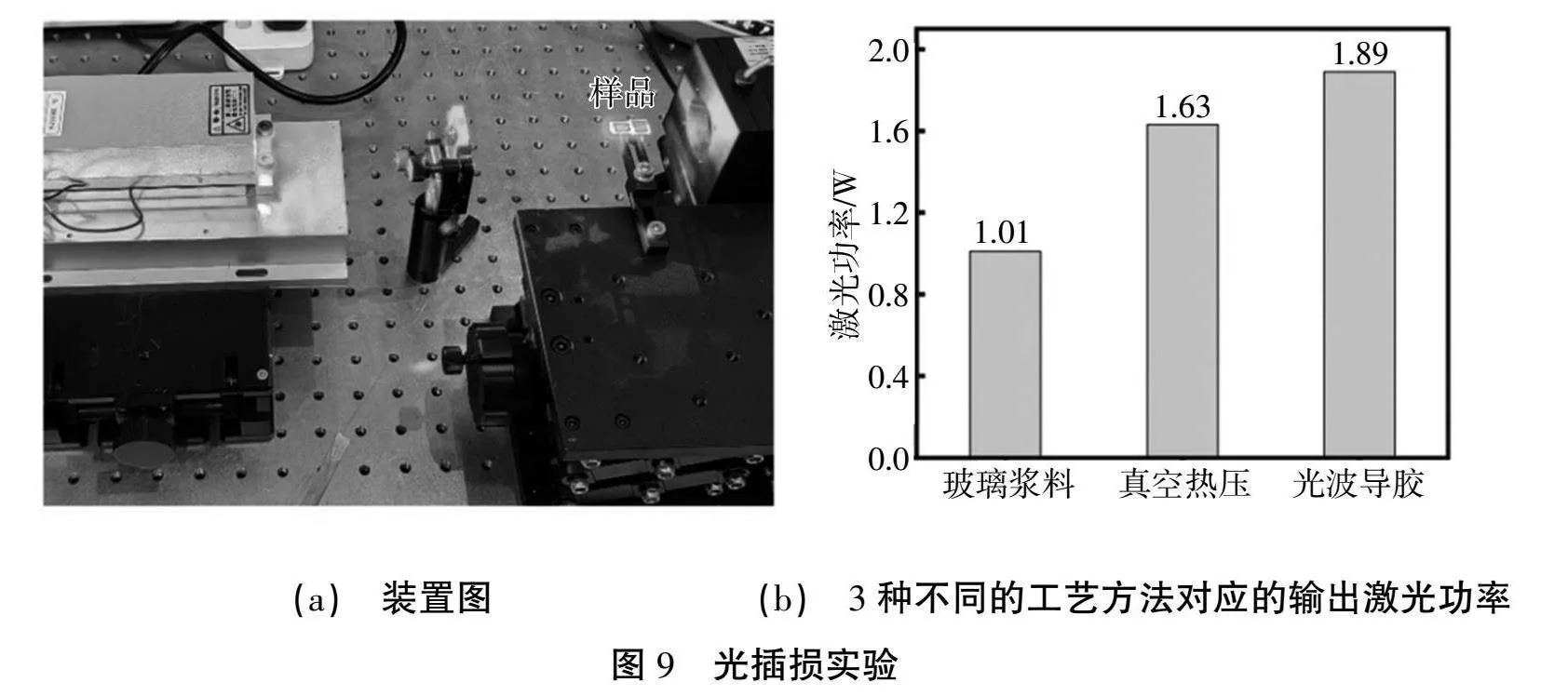
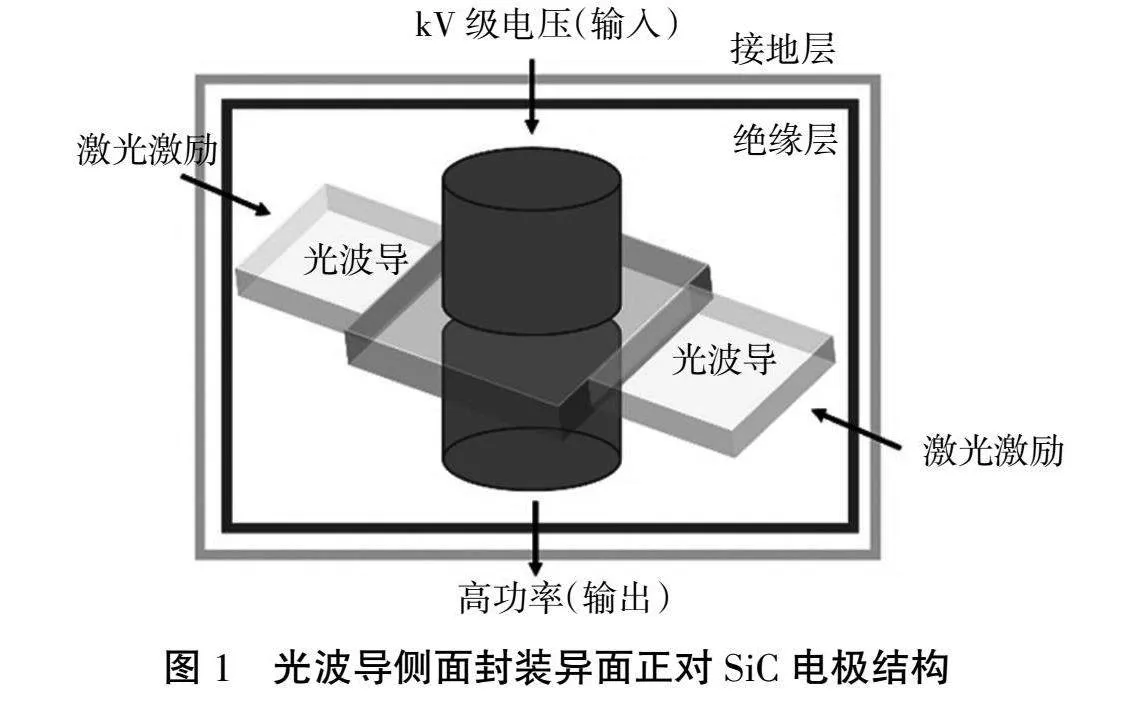
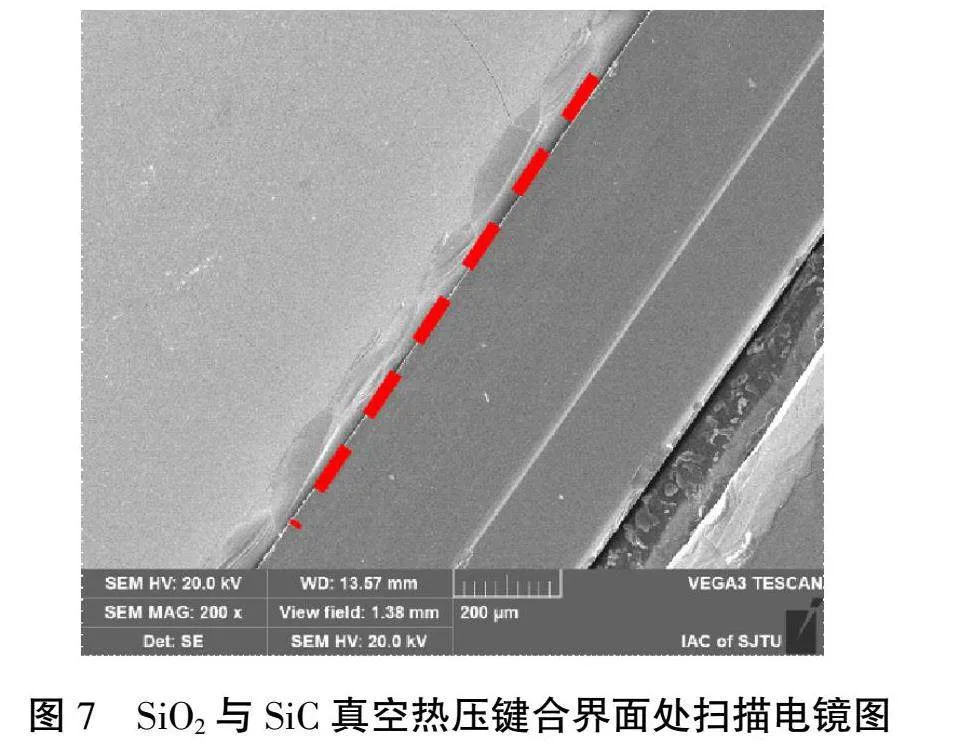
摘 要:光导开关是一种新型半导体光电子器件,在光通讯、雷达、微波等领域广泛应用,但在高工作电压的条件下会发生表面击穿等问题,因此需要对其进行封装提高侧面的耐压性能。该文选用光波导的方式对碳化硅晶片进行封装,通过玻璃浆料烧结键合、真空热压键合和光波导胶键合3种方法对小面积的侧面异质键合进行研究。通过3种方法的工艺优化及键合质量性能测试,光波导胶键合方法对激光功率的损耗最小,实现器件耐压值提升至10 kV。
关键词:光导开关;玻璃浆料烧结;真空热压;光波导胶;键合方法
中图分类号:TN36 文献标志码:A 文章编号:2095-2945(2024)29-0072-05
Abstract: The photoconductive semiconductor switches (PCSS) is a new type of semiconductor optoelectronic device, which is widely used in optical communication, radar, microwave and other fields, but surface breakdown will occur under the condition of high working voltage, so it is necessary to package it to improve the side voltage performance. In this paper, the silicon carbide wafer is encapsulated by optical waveguide, and the small area side hetero bonding is studied by glass paste sintering bonding, vacuum hot pressing bonding and optical waveguide glue bonding. Through the process optimization and bonding quality performance test of the three methods, the optical waveguide adhesive bonding method has the lowest loss of laser power, and the voltage withstand value of the device is improved to 10 kV.
Keywords: photoconductive semiconductor switches(PCSS); glass paste sintering; vacuum hot pressing; optical waveguide adhesive; bonding method
随着微电子和微波技术的高速发展,迫切需要一种体积小的开关器件[1-2],其中光导开关作为一种新型的快速电子器件,与传统的脉冲功率领域中的其他开关相比,具有重复频率高、体积小、能以超高的功率容量工作的优异特性[3-7]。然而,光导开关在数千伏的高工作电压下,会出现表面击穿的问题从而导致光导开关无法正常工作,因此设计具备高可靠性的光导开关结构、提高光导开关的耐压特性是当下的研究重点[8-9]。
封装对高压开关器件的性能至关重要,针对大功率光导开关器件高峰值功率激光激励、超高压工作、高可靠长寿命工作的需求,周幸叶等[10]提供了一种光导开关的封装结构,光导开关两端搭接的2个台面相互隔离,避免沿面击穿,向壳体的密闭空间内部填充绝缘材料,对光导开关实现全面保护,提高器件的工作电压。美国劳伦斯·利弗莫尔国家实验室提出了采用光波导的方式对碳化硅进行封装的方法[11],但对具体键合工艺没有明确的方法介绍,值得深入探究。
碳化硅(SiC)光导开关因具有传统开关器件不可比拟的特性,在高技术领域中具有广泛的应用前景[12-14]。为进一步提高其耐压特性同时保持体积小的特点,本文选择采用光波导封装的方式提高侧面的耐压性能[15-16]。碳化硅侧面需激光激励,由于空气受激光辐照易产生电离,加之碳化硅受激光激励载流子在表面聚集,可能导致电极之间产生沿边击穿,因此使用光波导进行侧面封装,一方面可让激光透过,另一方面起到绝缘的作用。
光波导与碳化硅为异质键合,键合界面直接影响激光的透过率。同时,由于光波导与碳化硅为侧面键合,键合面积小、精度难控制,键合材料异形设备难兼容。本文针对光波导与碳化硅小面积异质键合,选用玻璃浆料烧结键合、真空热压键合、光波导胶键合3种工艺方法进行研究。
1 实验
1.1 光导开关结构设计
图1所示为光波导侧面封装异面正对SiC电极结构的设计示意图,异面正对的光导开关耐压高,响应速度快,使用光波导封装的方式提高电极侧面的耐压性能。其中,SiC晶片尺寸为10 mm×10 mm×1 mm,光波导选用的二氧化硅(SiO2)尺寸为10 mm×8 mm×0.9 mm。
1.2 实验方法
1.2.1 玻璃浆料烧结键合
在SiC侧面安装网版,一端倒入适量玻璃浆料(型号:07MHS400),使用刮板将玻璃浆料从网版的一端刮向另一边,保证印刷后的浆料均匀铺展,将SiC放入对位工装中,侧面与SiO2齐平,放入烘箱中,玻璃浆料烧结形成键合,使用激光共聚焦显微镜观察不同温度参数下键合面的形貌特征。
1.2.2 真空热压键合
首先在SiC侧面蒸镀SiO2介质层,通过SiC介质层与SiO2完成键合。将SiC蒸镀SiO2的侧面与SiO2紧靠,置于对位工装中,如图2所示,放入真空热压设备的真空腔内,设置温度和施加压力数值,在高温和压力的作用下完成键合。
1.2.3 光波导胶键合
将UVLED点光源固化机的照射头固定在距离放置样品19.5 mm的高度上方,如图3所示,将SiC晶片放入对位工装中,在其侧面涂覆UV光敏胶(NOA61),与SiO2对齐。待10 min胶预固化后,放置于照射头的正下方开始照射。降至室温之后,从工装中取出键合后的SiC和SiO2,使用推拉力测试仪进行剪切强度测试选取最佳参数。
2 结果与讨论
2.1 玻璃浆料烧结键合
玻璃浆料的成分是由玻璃粉料和黏合剂经配制形成,在预处理的过程中,浆料中的水分和有机溶剂通过挥发和分解耗尽。预处理后需要在显微镜下检查,确保印刷成功,如图4(a)所示为印刷浆料连续性的图,图4(b)为不连续性的图。浆料印刷成功以后,室温下放置10 min,让玻璃浆料流平。经初步干燥后,采用分段保温的形式将烧结炉温度逐步升高到300 ℃进行预烧结,充分挥发水分以及燃尽有机溶剂。
浆料的玻璃化温度为450 ℃以上,由300 ℃经30 min升高到520 ℃,维持30 min,如图5中T1温度曲线所示。烧结结果显示晶体间形成黏接,但浆料玻璃化不充分,未形成透明状态(图6(a))。但当温度上升到600 ℃时,如图5中T2温度曲线所示,完成玻璃化转变,但由于高温保持时间过长,玻璃浆料烧结至一侧晶体上成颗粒状,有大量气泡出现(图6(b))。因此在温度上升时应使用温度阶梯,如图5中T3所示,先上升至520 ℃让浆料颗粒充分扩散黏结,形成互连,再上升至560 ℃,维持10 min后升至600 ℃,完成玻璃化转变,SiC和SiO2两者表面接触良好,形成一层很薄的透明混合层,成功键合(图6(c))。
2.2 真空热压键合
SiC与SiO2的直接键合实现难度大,多为晶圆级的高温高压键合,键合温度高达800~1 100 ℃,对于真空环境实现难度更大。针对SiC与SiO2的侧面小面积键合,需采用中间介质层来实现绝缘键合。由于SiC与SiO2为异质材料,在SiC表面蒸镀SiO2介质层,通过SiC介质层与SiO2完成键合。为探索最优异的参数条件,选择不同的加热温度、压力进行真空热压键合,见表1。
从表1中得知,在温度较低或者压力较小的情况下,SiO2与SiC之间的作用力为静电力相互吸引,没有键合成功,由此可知温度和压力2个参数对于真空热压键合极其重要。上下温度设置为750 ℃、施加300 kg压力的实验条件能热压成功,如图7所示为SiO2与SiC键合界面处的扫描电镜图,观察到两者紧密地键合在一起。但在热压键合的过程中,工艺难控制,样品在压后易碎。
2.3 光波导胶键合
UV光敏胶是一种透明、不含溶剂的单组分黏合剂,在紫外光的照射下能迅速固化,是一种坚韧、有弹性的黏合剂,光透过率高,能用于光波导互联工艺中。
为探索最优异的参数条件,先使用SiO2与SiO2通过UV光敏胶进行键合,分别制备固化时间为10、50、100、200、300、600、900和1 200 s的样品,将其放在推拉力测试仪下进行剪切力测试,以探求最优异的固化时间。如图8(a)所示为固化时间随应力的变化,随着紫外光照固化时间的延长,应力不断上升,在600 s时剪切力达到最大值,为70 600.51 gf,而随着时间的再次延长,剪切力反而出现下降的趋势,因此通过前期的参数探究,选择最佳的固化时间为600 s。将SiO2与SiC放入对位工装中,选定固化时间为600 s,进行侧面键合,紫外光照后胶呈透明状态,光透过率高,如图8(b)所示为SiO2与SiC键合界面处的扫描电镜图,观察到光波导胶的宽度约为80 μm。
2.4 键合质量性能比较
将以上使用3种不同工艺方法侧面键合的SiO2与SiC样品进行键合质量性能比较,传统的SiC光导开关空气条件下在5 kV发生击穿,而采用光波导封装的SiC光导开关则在10 kV的条件下仍能正常工作,表明3种工艺方法均能提升光导开关的侧面耐压强度。
为进一步研究3种工艺方法形成的异质键合界面对激光透过率的影响,进行光插损实验(图9(a)),使用连续激光器测量侧面键合后的样品对532 nm激光的吸收损耗。将激光功率的输出值设定为2.7 W,实验结果如图9(b)所示,玻璃浆料键合的样品输出功率为1.01 W,相较于其他2种方法光插损值略大,但其通过烧结形成的玻璃混合层具有密封效果好、键合强度高的特点,可应用于半导体或玻璃器件的腔体封装。真空热压过程中是通过本体SiO2和SiC原子间的键合形成,由于两者中间没有添加外界的连接剂,剪切强度一般,工艺难控制。光波导胶键合的样品具有最高的激光透过率,为1.89 W,同时光波导胶具有增透膜的作用,有助于提高激光透过率,且工艺操作便捷。
为探究光波导胶键合的应用场景,使用脉冲激光器对键合后的SiO2与SiC样品进行测试,观察到样品能耐峰值功率为1.5 MW的脉冲激光,且光波导胶没有损坏。综上所述,通过光波导胶封装之后SiC光导开关正常工作条件下具有良好的耐高压性能,且激光透过率高,是一种优异的能应用于大功率光电器件封装的方法。
3 结论
通过对以上玻璃浆料烧结键合、真空热压键合和光波导胶键合3种方法的研究,我们得出以下结论:
1)玻璃浆料烧结过程中晶体互连实现键合,晶相和晶体界面难以控制,光透过率相较于其他2种方法较低,可应用于半导体或玻璃器件的腔体封装。
2)真空热压键合实现难度较大,工艺难控制,样品在热压后容易碎,光插损较小。
3)光波导胶键合工艺操作十分便捷,3种方法中激光透过率最高,且光波导胶具有增透膜的作用,能耐峰值功率为1.5 MW的脉冲激光。
参考文献:
[1] 吴永宇,张小平,单欣岩,等.一种硅基二氧化硅结构的超快全光开关[J].激光与光电子学进展,2018,55(4):248-253.
[2] SINGH K, KAUR G. All-optical half-adder and half-subtracter based on semi-conductor optical amplifier[J]. Open Journal of Communications & Software, 2014,1(1):42-51.
[3] 董妍.高功率光导开关的研究[D].成都:电子科技大学,2018:1-11.
[4] 罗燕,丁蕾,赵毅,等.SiC光导开关衬底与电极界面场强仿真与优化设计[J].强激光与粒子束,2022,34(6):45-50.
[5] CUI H J, YANG H C, XU J, et al. Sublinear current-voltage characteristics of linear photoconductive semiconductor switch[J].IEEE Electron Device Letters,2016,37(12):1590-1593.
[6] 张永平.碳化硅光导开关的制备与性能研究[D].上海:上海师范大学,2014:10-40.
[7] JAMES C, HETTLER C, DICKENS J. Design and Evaluation of a Compact Silicon Carbide Photoconductive Semiconductor Switch[J]. IEEE Transactions on Electron Devices, 2011,58(2):508-511.
[8] DANIEL M, WILLIAM S, ALAN B, et al. High power lateral silicon carbide photoconductive semiconductor switches and investigation of degradation mechanisms[J]. IEEE Transactions on Plasma Science, 2015,43(6):2021-2031.
[9] SAMPAYAN S E, BORA M, BROOKSBY C, et al. High voltage wide bandgap photoconductive switching[J].Materials Science Forum,2015(821-823):871-874.
[10] 周幸叶,谭鑫,吕元杰,等.一种光导开关的封装结构:CN112614900B[P].2022-08-30.
[11] GEORGE J C. Photoconductive switch package: US9171988B2 [P].2015-10-27.
[12] 刘强.新型SiC光导开关特性研究[D].西安:西安电子科技大学,2011:9-38.
[13] AGARWAL A K. An overview of SiC power devices [C]// 2010 International Conference on Power,Control and Embedded Systems, November 29-December 1, Allahabad, India. New York: IEEE,2010.
[14] 李国鑫.碳化硅功率器件的发展与数值建模[J].科技创新与应用,2021,11(13):67-71.
[15] 杜泽晨,张一杰,张文婷,等.碳化硅器件封装进展综述及展望[J].电子与封装,2022,22(5):10-16.
[16] 李江,姜楠,葛琳,等.光波导激光陶瓷的研究进展与展望[J].激光与光电子学进展,2018,55(3):7-27.
