肖特基结多数载流子积累新型绝缘栅双极晶体管*
2024-04-27段宝兴刘雨林唐春萍杨银堂
段宝兴 刘雨林 唐春萍 杨银堂
(西安电子科技大学微电子学院,宽禁带半导体材料与器件教育部重点实验室,西安 710071)
绝缘栅双极晶体管(insulated gate bipolar transistor,IGBT)是现代功率半导体器件的核心,因其良好的电学特性得到了广泛的应用.本文提出了一种具有肖特基结接触的栅半导体层新型多数载流子积累模式IGBT,并对其进行特性研究和仿真分析.当新型IGBT 处于导通状态,栅极施加正向偏压,由于肖特基势垒二极管极低的正向导通压降,使得栅半导体层的电压几乎等于栅极电压,从而能够在漂移区中积累大量的多数载流子电子.除了现有的电子外,这些积累的电子增大了漂移区的电导率,从而显著降低了正向导通压降.因此,打破了传统IGBT 正向导通压降受漂移区掺杂浓度的限制.轻掺杂的漂移区可以使新型IGBT 具有较高的击穿电压,同时减小了关断过程中器件内部耗尽层电容,因此整体米勒电容减小,提升了关断速度,减小了关断时间和关断损耗.分析结果表明,600 V 级别的击穿电压时,新型IGBT 的正向导通压降,关断损耗和关断时间相比常规IGBT 分别降低了46.2%,52.5%,30%,打破了IGBT 中正向导通压降和关断损耗之间的矛盾.此外,新型IGBT 具有更高的抗闩锁能力和更大的正偏安全工作区.新型结构的提出满足了未来IGBT 器件性能的发展要求,对于功率半导体器件领域具有重大指导意义.
1 引言
2020 年9 月,中国政府在第75 届联合国大会上明确提出了力争在2030 年前实现“碳达峰”,2060 年前实现“碳中和”.功率半导体器件在实现双碳目标中发挥着关键作用,因为功率半导体器件是电力电子系统的基础,具有变频、变压、整流、功率放大和管理等重要作用,能够实现对电能的调节、控制和转换,从而提高整个系统的能源转换效率和可持续性,降低能耗减少碳排放,进而实现节能减排.而绝缘栅双极晶体管(insulated gate bipolar transistor,IGBT)作为功率半导体器件的核心,其重要程度不言而喻.IGBT 的概念起源并发展于20 世纪80 年代的早期[1],它是由双极型晶体管(bipolar junction transistor,BJT)和金属氧化物半导体场效应晶体管(metal oxide semiconductor field effect transistor,MOSFET)组成的复合全控型电压驱动式功率半导体器件[2],兼具了BJT 低正向导通压降和MOSFET 高输入阻抗两方面的优点[3],在消费电子、电力系统、工业系统、新能源汽车、可再生能源发电等多个领域得到广泛应用.因此在双碳目标的背景之下,开发设计出性能更加优异的新型IGBT 器件将对于建设资源节约型和环境友好型社会具有重大意义.
在IGBT 当中,击穿电压和正向导通压降之间存在着矛盾[4],通常来说,要想获得较高的击穿电压,器件漂移区的掺杂浓度须低,但是低掺杂浓度会使得正向导通压降较高.同时在IGBT 中还存在着另一个关键问题,即正向导通压降和关断损耗之间的矛盾.要想获得低正向导通压降,需要增强漂移区的电导调制效应,但是会在漂移区中存储大量的载流子,在关断时难以在短时间内将它们抽取或复合,因此会造成关断损耗增大.研究者们也进行了大量相关研究来致力于改善正向导通压降和关断损耗之间的关系.沟槽栅IGBT 消除了平面栅带来的结型场效应晶体管(junction field effect transistor,JFET)效应,从而能够减小正向导通压降[5].逆导型IGBT 在集电极处为电子提供了通路,从而能快速关断,减小关断损耗[6].此外,载流子存储层沟槽栅IGBT[7],具有P 型环和点注入的沟槽栅 IGBT 结构[8],具有自偏置PMOS 的IGBT结构[9],以及最近提出的集电极工程半超结双向IGBT、阶梯分离式沟槽栅IGBT、平面阳极栅超结IGBT[10-12],都可以改善正向导通压降和关断损耗之间的折中.
为了更好地解决IGBT 中存在的问题,本文将积累的思想应用在IGBT 上,提出了一种具有肖特基结接触的栅半导体层新型多数载流子积累模式IGBT (novel majority carrier accumulation mode IGBT with Schottky junction contact gate semiconductor layer,AC-SCG IGBT),在满足耐压的条件下,以同时降低正向导通压降和关断损耗.所提出的AC-SCG IGBT 在常规IGBT 的侧面引入了具有肖特基结接触的N-N+-N 的栅半导体层.器件导通时高电势的栅半导体层在漂移区积累多数载流子电子用以增强电导率以降低正向导通压降,电子的引入使得漂移区掺杂浓度与正向导通压降无关,通过轻掺杂保证耐压并改善关断特性.除此之外,较好的抗闩锁能力和较高的击穿电压使得其具有更大的正偏安全工作区(forward biased safe operating area,FBSOA).本文所提出的IGBT 为硅基IGBT,也是当前最为主流的IGBT 材料,对硅基IGBT 的研究永远不会过时.当然随着第3 代半导体材料SiC 的发展,一些IGBT 的研究也会应用SiC 作为衬底材料或者是形成硅与SiC 的异质结,亦或是采用SiC 作为封装的基板材料,基于SiC 宽带隙的特点,其应用在IGBT 上会使其在更高温度、更高阻断电压和更高的辐射环境下工作.Synopsys 公司推出的用以对半导体器件进行模拟仿真的软件Sentaurus TCAD[13]已经被用来实现AC-SCG IGBT 的特性,仿真结果表明,在600 V级别的击穿电压下,AC-SCG IGBT 的正向导通压降为0.84 V,关断损耗为0.77 mJ/cm2,关断时间为155.8 ns,与常规IGBT 相比分别降低了46.2%,52.5%,30.0%.
2 器件结构
图1 显示了常规沟槽型IGBT 和所提出的AC-SCG IGBT 的结构示意图.AC-SCG IGBT 的特征是具有肖特基结接触的N/N+/N 的栅半导体层,它位于器件的侧面区域,从N+发射极到P+集电极,覆盖整个漂移区,其两端连接栅极和集电极.为了实现较好的电隔离,栅半导体层和左侧结构用一层薄SiO2进行分隔[14].与常规的沟槽栅IGBT相比,所提出的AC-SCG IGBT 制作工艺的不同在于其采用了深沟槽刻蚀技术.图2 为AC-SCG IGBT 的工艺流程,图2(a)为通过外延形成P+/Nbuffer/N;图2(b)为根据合适的深宽比进行从上到下的深沟槽刻蚀;图2(c)为沟槽内进行SiO2生长,刻蚀掉底部的SiO2,留下沟槽侧壁氧化层;图2(d)为通过外延回填在沟槽内形成N/N+/N;图2(e)为离子注入;图2(f)为通过背面减薄工艺减薄P+衬底,最后金属化形成电极.深沟槽刻蚀为许多高性能纵向器件的制备提供了可行的技术,比如应用深沟槽刻蚀技术的器件[15-18].

图1 两种器件结构示意图 (a)常规IGBT 结构;(b) ACSCG IGBT 结构Fig.1.Schematic cross sections of the two devices: (a) Conventional IGBT structure;(b) AC-SCG IGBT structure.

图2 AC-SCG IGBT 的工艺流程图 (a)外延;(b)深沟槽刻蚀;(c) SiO2 生长;(d)外延回填;(e)离子注入;(f)背面减薄和金属化Fig.2.Process flow for AC-SCG IGBT: (a) Epitaxy;(b) deep trench etching;(c) performing SiO2 growth;(d) epitaxial backfilling;(e) ion implantation;(f) back thinning and metallization.
AC-SCG IGBT 积累层的形成如图3 所示,当对栅极施加正向偏压,整个Nside栅半导体层的电势为栅极电压VG减去肖特基二极管的内建电势φbi,由于φbi值很小,因此Nside栅半导体层的电势几乎与栅极电压相同.该电压会将漂移区中带负电荷的电子吸引到靠近氧化层的界面处形成高密度的电子积累层,电子由图3 中圆形符号表示.在导通时,积累的电子和注入的空穴会对N 型漂移区的电导进行调制,从而增大电导率,减小正向导通压降.需要注意的是,根据半导体物理知识,栅半导体层上的电势与肖特基结接触形成的势垒ΦBN无关,ΦBN的作用可以减小漏电流.此外,漂移区中积累电子形成的同时,栅半导体层也会产生等量的空穴,设置N+区可阻断栅极和集电极之间的空穴电流[19].表1 显示了常规IGBT 和所提出的ACSCG IGBT 的关键参数和电学特性值.
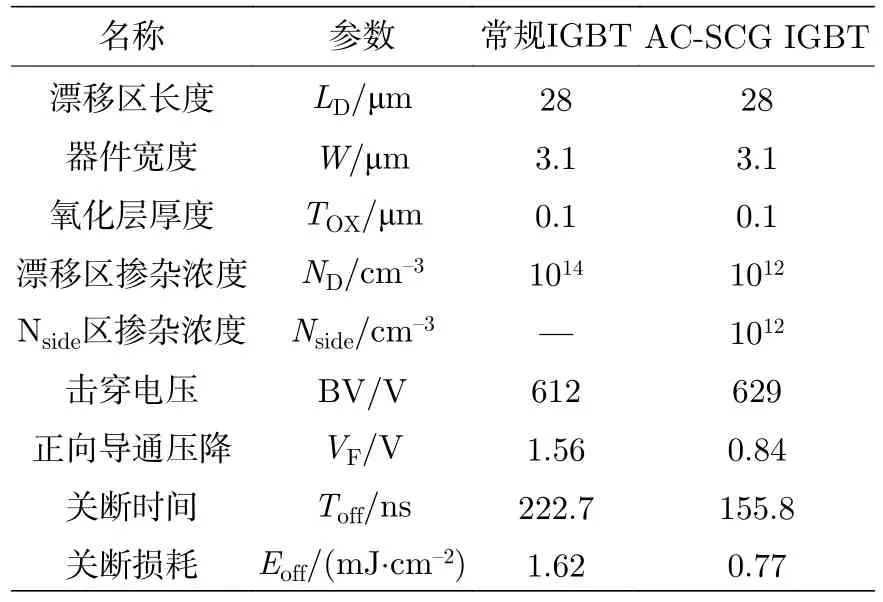
表1 常规IGBT 和AC-SCG IGBT 的关键参数和电学特性值Table 1.Key parameters and electrical characteristic values of the conventional IGBT and AC-SCG IGBT.

图3 正栅极电压下AC-SCG IGBT 积累层的截面示意图及栅半导体层的电位分布Fig.3.Schematic cross sections of AC-SCG IGBT accumulation layer and potential distributions of the gate semiconductor layer under the positive gate voltage.
3 仿真结果与分析
图4 为常规IGBT 和AC-SCG IGBT 的击穿电压和正向导通压降随漂移区掺杂浓度的变化情况.需要注意,由图1(b)可知,在AC-SCG IGBT中,其漂移区掺杂浓度和栅半导体层的Nside区域和N 型区域的掺杂浓度相同,漂移区掺杂浓度发生改变时,二者随之改变.从图4(a)可以看出,常规IGBT 的击穿电压和正向导通压降都随着漂移区掺杂浓度的升高而降低,二者之间存在矛盾,这与大多数常规器件中的规律是一致的.从图4(b)可以看出,AC-SCG IGBT 的正向导通压降几乎不受漂移区掺杂浓度的影响,打破了击穿电压和正向导通压降之间的矛盾.因此,对于AC-SCG IGBT,可以选择低漂移区掺杂浓度以获得高击穿电压和低正向导通压降.

图4 两种器件的BV 和VF 随ND 变化的曲线图 (a)常规IGBT 结构;(b) AC-SCG IGBT 结构Fig.4.BV and VF as a function of ND of the two devices:(a) Conventional IGBT;(b) AC-SCG IGBT.
图5(a)为常规IGBT 和AC-SCG IGBT 在击穿时沿线AA'的垂直电场分布,可以看出二者都呈现出近似梯形的电场分布,这是因为N 型buffer区的引入对纵向电场进行调制.它们主要都是由P 型阱区和N 型漂移区之间的反偏结承担电压,耗尽层主要在N 型漂移区内延伸.结果表明,常规IGBT 和和AC-SCG IGBT 的击穿电压分别为612 V 和629 V,二者的击穿电压都处于600 V 的级别.图5(b)则显示了AC-SCG IGBT 在击穿时沿线BB'的垂直电场分布,栅半导体层主要依靠反偏的肖特基二极管承担电压,耗尽层在Nside区域当中,N+区域与N 型buffer 区的作用相同.对于AC-SCG IGBT 来说,其沿线AA'的垂直电场分布不仅仅受到N 型buffer 区的影响,还受到沿线BB'均匀电场的调制,从而使得沿线AA'的电场分布更加均匀.
图6 为AC-SCG IGBT 在击穿时栅氧化层两侧的电势分布,通过仿真分析的结果可以明显看出栅氧化层两侧的电势分布几乎一致,在同一水平位置不存在横向压降,因此薄氧化层不会被击穿.

图6 AC-SCG IGBT 栅氧化层两侧的电势分布Fig.6.Potential distribution on both sides of AC-SCG IGBT gate oxide.
图7 为常规IGBT 和AC-SCG IGBT 的输出特性在不同栅极电压的变化情况.由于漂移区中靠近氧化层附近电子的积累,增强了电导率,因此AC-SCG IGBT 的输出电流明显高于常规IGBT.栅极电压越大,栅半导体层和N 型漂移区之间的电势差就越大,这样在器件处于导通状态时就会积累更多的电子,因此输出电流较高,正向导通压降较低.图7 内的插图则为在VG=10 V 时,输出特性的放大图,正向导通压降的值为电流密度等于100 A/cm2时对应的电压.仿真结果表明,ACSCG IGBT 的正向导通压降为0.84 V,与常规IGBT 的1.56 V 相比降低了46.2%.图8 则进一步显示了两种器件在相同栅压VG=10 V 下的饱和特性对比,虽然由于漂移区小部分缩减形成栅半导体层带来的多数载流子积累效应,新结构的输出电流会大于传统结构,但随着集电极电压的逐渐增大最终达到饱和电流时,仿真结果显示新结构的饱和电流其实只略微大于传统结构.由于二者饱和电流相差很小,因此对短路耐受能力影响不大.
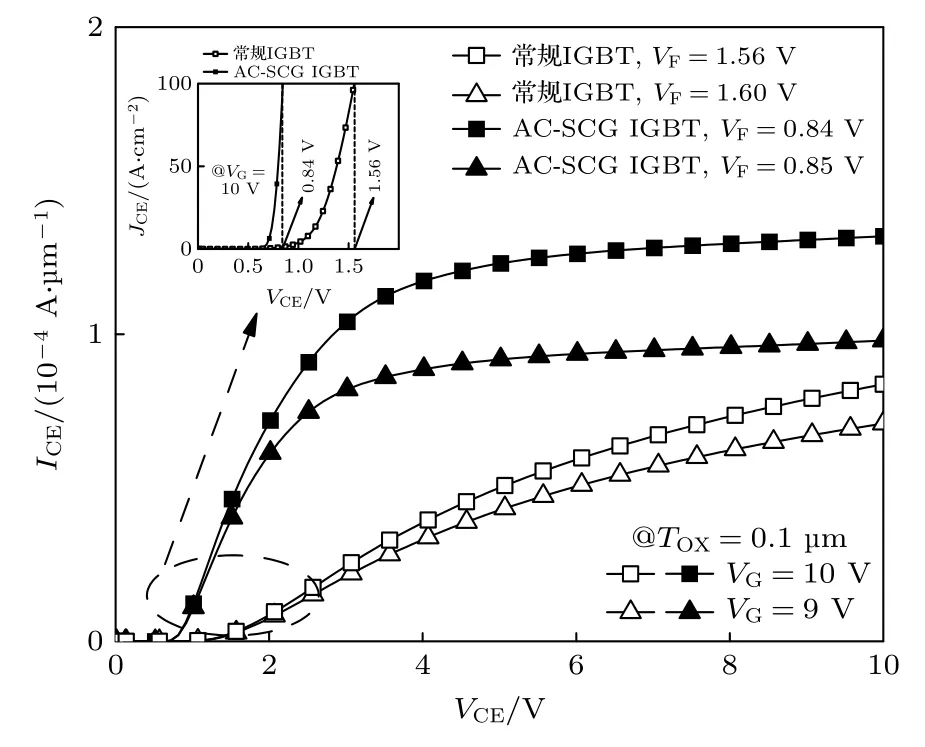
图7 两种器件在不同VG 下的输出特性Fig.7.Variation of output characteristics for the two devices under VG.
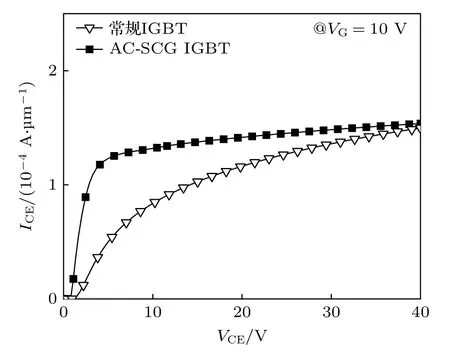
图8 两种器件在VG=10 V 下的饱和特性Fig.8.Saturation characteristics for the two devices under VG=10 V.
AC-SCG IGBT 的输出特性也与氧化层厚度TOX有关.从图9 可以看到,随着TOX的减小,ACSCG IGBT 的正向导通压降逐渐减小,导通特性更好.这是因为当TOX较小时,氧化层电容会相应增大,在相同的栅极电压下,漂移区靠近氧化层一侧会积累更多的电荷,使得电子密度增加,因此会得到更大的输出电流和更低的正向导通压降.

图9 AC-SCG IGBT 在不同TOX 下的输出特性Fig.9.Variation of output characteristics for the AC-SCG IGBT under TOX.
图10(a)为带感性负载的IGBT 开关电路,图10(b)则为常规IGBT 和AC-SCG IGBT 关断特性的曲线图.从图10(b)可以看出,与常规IGBT相比,AC-SCG IGBT 在关断过程中电压VCE上升更快,关断时间短,关断损耗低.从图11 可以看出,当漂移区掺杂浓度相同时,AC-SCG IGBT 的米勒电容CGC几乎与常规IGBT 一样,并没有因为氧化层的延长而增大,这是因为在关断时ACSCG IGBT 在集电极处多串联了一个肖特基势垒电容,从而削弱了氧化层延长增大电容带来的影响.因此,具有低漂移区掺杂浓度的AC-SCG IGBT内的耗尽层电容更小,因此整体米勒电容更小,如图11 仿真结果所示.低的米勒电容可以使得ACSCG IGBT 在关断过程中VCE上升快,能够快速关断,从而减小关断时间和关断损耗.仿真结果表明,AC-SCG IGBT 的关断损耗为0.77 mJ/cm2,关断时间为155.8 ns,与常规IGBT 相比分别降低了52.5%和30.0%.

图10 开关电路与关断特性图 (a)带感性负载的IGBT开关电路图;(b)两种器件的关断特性曲线Fig.10.Switching circuit and turn-off characteristics diagram: (a) Switching circuit with inductive load for IGBT;(b) turn-off characteristics for the two devices.

图11 两种器件的米勒电容Fig.11.CGC as a function of VCE of the two devices.
图12 为常规IGBT 和AC-SCG IGBT 的正向导通压降和关断损耗的折中曲线.折中曲线是通过改变集电极P 区的掺杂浓度以得到不同VF值下的Eoff[20].从图12 可以看到,与常规IGBT 相比,在击穿能力相同的条件下,AC-SCG IGBT 的正向导通压降和关断损耗分别降低了46.2%和52.5%.可以证明所提出的AC-SCG IGBT 具有更低的正向导通压降和关断损耗,在二者之间取得了比常规IGBT 更好的折中特性.

图12 两种器件VF 和Eoff 的折中曲线图Fig.12.Trade-off curves between VF and Eoff for the two devices.
除了上述优异的电学特性外,与常规结构相比,新结构还提高了电学可靠性.图13 为两种器件在不同栅压下I-V曲线组成的FBSOA,可以看到AC-SCG IGBT 具有更大的FBSOA.这是因为,与常规IGBT 相比,AC-SCG IGBT 的P-well区域的尺寸更小,因此该区域的体电阻更小,所以其抗闩锁能力更强;加之漂移区轻掺杂带来较好的耐压特性,AC-SCG IGBT 的FBSOA 更大.
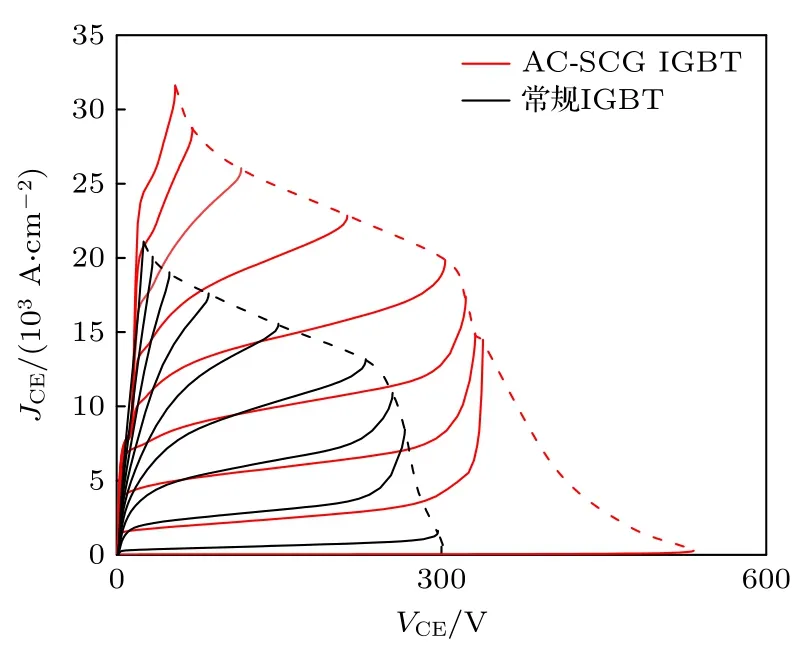
图13 两种器件的FBSOAFig.13.FBSOA of the two devices.
4 结论
针对目前在IGBT 中存在的固有问题和矛盾,本文提出了一种具有肖特基结接触的栅半导体层新型多数载流子积累模式IGBT 器件结构,并通过仿真研究其击穿、输出、关断、安全工作区等相关特性.由于积累的作用,AC-SCG IGBT 漂移区的电导率提高,漂移区的掺杂浓度不受正向导通压降的限制,可以采用低漂移区掺杂浓度以获得高击穿电压和低正向导通压降.此外,轻掺杂的漂移区使得器件在关断过程中内部的耗尽层电容较小,因此整体的米勒电容较小,能够快速关断从而减小关断时间和关断损耗.结果表明,在600 V 级别的击穿电压下,与常规IGBT 比,AC-SCG IGBT 的正向导通压降和关断损耗分别降低了46.2%和52.5%,实现了更低的正向导通压降和关断损耗,打破了二者之间存在的矛盾.与此同时,AC-SCG IGBT 具有更强的抗闩锁能力,加之轻掺杂带来的较好的耐压特性,使其具有更大的FBSOA.新型结构的提出,其优异的性能将为IGBT 领域提供更多的创新和可能性.
