III 族氮化物半导体及其合金的原子层沉积和应用*
2024-02-21仇鹏刘恒朱晓丽田丰杜梦超邱洪宇陈冠良胡玉玉孔德林杨晋卫会云彭铭曾郑新和
仇鹏 刘恒 朱晓丽 田丰 杜梦超 邱洪宇 陈冠良 胡玉玉 孔德林 杨晋 卫会云 彭铭曾 郑新和
(北京科技大学数理学院,磁光电复合材料与界面科学北京市重点实验室,北京 100083)
1 引言
传统半导体(Si,Ge)受限于较低的禁带宽度,存在不能承受高温高压环境等缺点,在许多领域尤其是光电子领域和高频高功率器件方面的应用受到诸多限制.为了解决这一问题所开发的第2 代半导体材料(GaAs,InP 等)除了具有更大的禁带宽度,其电子迁移率和电子饱和速度也有了很大的提升.但是由于热导率和击穿场强不高,在功率特性方面也受到了一定限制.为了满足无线通信、雷达等应用对高频率、高效率、宽禁带、大功率器件的需要,化合物半导体的研究重心开始向宽禁带半导体发展,其中最具代表的为氮化镓(GaN)和碳化硅(SiC).凭借着大的禁带宽度、高击穿场强、高电子饱和速度等优势,十分适合在大功率器件中发挥作用[1–4].III 族氮化物半导体(包括氮化铟(InN)、氮化铝(AlN)、GaN)中除了InN 的禁带宽度较窄,GaN 和AlN 均属于宽禁带半导体.且III 族氮化物半导体自发展以来一直备受关注,尤其是GaN.由于其材料特性尤其优秀,使得其成为最具代表性的第3 代半导体材料,成为高温、高频、大功率微波器件的首选材料之一.与半导体硅相比,GaN 的禁带宽度、电子漂移速率、电子迁移率和击穿场强的数值分别为硅的3—4 倍、2—4 倍、1.5 倍和11 倍.目前GaN 的应用主要集中在军用方面,但随着技术的发展,民用领域也逐步布局GaN 的应用.尤其在未来5G 技术方面、超高压、新能源汽车等方面的迅速发展,GaN 可以应用的领域会愈来愈广[5–7].相较于GaN,AlN 拥有着更大的禁带宽度(约6.2 eV),并且还有着高热导率、高击穿场强、高热稳定性和良好的紫外透过率等优势,使其在高功率、高温/高压/高频电子器件、紫外/深紫外发光二极管(light-emitting diode,LED)光电器件中有着非常广阔的应用前景[8–13].而在所有的氮化物半导体中,InN 具有良好的稳态和瞬态电学传输特性,它有最大的电子迁移率、最大的峰值速率、最大的饱和电子漂移速率和最小的禁带宽度等优异性质,这使得InN 相对于GaN 和AlN 来说更适合制备高频率、高速率器,有望应用于新型高频太赫兹通信和全光谱太阳能电池领域[14–17].伴随着III 族氮化物半导体的大规模应用,高质量半导体材料的制备技术也随之发展,而且这是非常重要的环节.
进行可靠利用的前提是制备出高质量的薄膜材料,常用的III 族半导体制备方法主要包括金属有机物化学气相沉积(metal-organic chemical vapor deposition,MOCVD)[18,19]、分子束外延(molecular beam epitaxy,MBE)[20]、氢化物气相外延(hydride vapor phase epitaxy,HVPE)[21,22]等,但这些方法无一例外的都用到了高温.以氮化镓为例: MOCVD制备GaN 的温度通常在1000—1100 ℃;HVPE 沉积GaN 的温度在1000—1050 ℃;MBE 沉积GaN的温度在650—750 ℃之间.除了反应温度过高、源材料成本高、设备复杂等问题,部分方法还需要用到超高真空条件,其中MBE 沉积GaN 所需的真空要达到10–8Pa 量级,因此这种方法沉积GaN的成本变得非常高昂.高昂的成本和极高的温度使得这些方法沉积的GaN 很难大批量沉积以及应用到对温度敏感或者不耐高温的材料上,且高温沉积也会因为薄膜和衬底之间热膨胀系数不同导致较大的双轴应力[23,24].以光伏器件中常用的导电衬底掺氟氧化锡(fluorine-doped tin oxide,FTO)和氧化铟锡(indium tin oxide,ITO)为例,FTO 在温度超过约550 ℃、ITO 在温度超过300 ℃后会出现明显软化,导电性能大幅下降.在这些相关器件中,低温氮化物的沉积便成为一个急需解决的问题.因此寻求一种稳定、高效、可控并且沉积温度不高的制备方法便变的尤为重要.
原子层沉积(atomic layer deposition,ALD)作为一种日趋成熟的技术,在III 族氮化物沉积的领域逐步大放异彩.由于其独特的自限制反应特性,使得其沉积III 族氮化物的温度可以达到较低的水平[25,26].同MOCVD 等技术相比,ALD 可以实现高共形性和高均匀性的薄膜沉积,非常适合在复杂的三维结构表面进行薄膜的沉积,甚至于具有高深宽比的结构表面也能进行均匀厚度的沉积[27–29].此外,ALD 还具有厚度精确可控、成分易调、源材料利用率高等优点,使得ALD 可以进行精确、简单、可控的薄膜沉积.ALD 作为一种特殊的化学气相沉积方法,是通过将一个反应拆分成两个“半反应”,在每个“半反应”之间用惰性气体进行吹扫.在“半反应”脉冲期间,前驱体充分的吸附在衬底的活性位点上达到饱和或者与已饱和吸附前驱体进行饱和反应,在达到饱和吸附或者反应之后不会进一步吸附或者反应,这被称为“自限制反应”.ALD的这种特殊的反应机制,使得可以通过调控反应周期的次数控制沉积薄膜的厚度.而又因为每一反应周期只沉积一个原子层厚度的薄膜,所以ALD 可以精确将所沉积出薄膜的厚度控制在原子级别.借助于ALD 这种特殊的反应机制,ALD 可以在较低的温度下进行III 族氮化物的精确沉积,而这种温度足够满足在一些不耐高温的衬底或者对温度比较敏感的器件上进行高质量氮化物薄膜的沉积.
2 二元氮化物薄膜的原子层沉积生长及应用
2.1 ALD 生长GaN 的机制及应用
GaN 的ALD 沉积发展较早,其沉积方式主要有热原子层沉积(thermal atomic layer deposition,T-ALD)和等离子体增强原子层沉积(plasma enhanced atomic layer deposition,PE-ALD)两种,通常使用镓的金属有机物和NH3作为前驱体进行沉积.1992 年,Khan 等[30]利用原子层外延技术成功制备出GaN 薄膜,所使用的前驱体为三乙基镓(triethylgallium,TEG)和NH3.沉积温度在450—900 ℃,打破了GaN 单晶外延的最低温度记录.所沉积GaN 薄膜的结晶性和光学质量与传统低压MOCVD 方法获得的GaN 薄膜相当,并显示出非常好的带边发光性能.而Karam 等[31]在1995 年利用T-ALD 通过三甲基镓(trimethylgallium,TMG)和NH3作为前驱体在550 ℃下成功沉积出GaN薄膜,并展现出与1000 ℃下MOCVD 沉积GaN 相同的光致发光性质,背景载流子浓度也小于1016cm–3,证实了原子层外延是低温生长氮化物薄膜的有力工具.自此,利用ALD 进行氮化物半导体沉积的工作便逐步增多,在随后的工作中,针对不同的需求从不同的角度对GaN 的ALD 沉积进行详细的优化.虽然目前经过多年的研究且已经取得了显著进展,仍有一些关键问题需要解决.比如,ALD 方法可以精确地控制沉积,但晶体质量问题仍然是一个挑战,引入的晶格缺陷和界面缺陷可能导致半导体薄膜性能降低.其次,生长速率过低也限制了ALD 技术的应用范围,尤其在一些大面积涂层制备中,需要在不牺牲质量的前提下提高ALD 的生长速率.此外,衬底的选择对于薄膜生长也至关重要.虽然GaN 衬底被认为是GaN 外延的最佳选择,但高昂的成本限制了其难以大量应用.因此,其他衬底材料,如Si、蓝宝石等便成为了常用的衬底材料.然而,不同衬底的晶格匹配和热膨胀系数差异可能导致晶体缺陷和应力问题,影响材料性能.而目前利用原子层沉积生长GaN 最常用的技术为PE-ALD,PE-ALD 采用等离子体作为反应前驱体,所使用的前驱体活性高,可以使沉积薄膜的温度进一步降低.图1 是一个利用等离子体增强原子层沉积进行沉积GaN 的示意图.

图1 等离子体增强原子层沉积沉积GaN 的示意图Fig.1.Schematic diagram of GaN deposited by plasma-enhanced atomic layer deposition.
2.1.1 ALD 生长GaN 的质量优化以及机制探究
GaN 由于具有自发极化效应可以在异质结界面处形成高电子迁移率的二维电子气,二维电子气的存在是制造高电子迁移率晶体管的关键.但通常会对GaN 的晶体质量要求很严格,所以需要对GaN 的外延生长进行细致及全面的优化.通常GaN 的沉积采用异质外延,然而这会导致GaN 薄膜中存在高密度的缺陷,会对高敏感度的表面和界面产生不利的影响,严重影响内部载流子的传输.此外,薄膜沉积中会不可避免的出现O,C,H 等杂质,杂质的存在会导致背景载流子浓度升高.因此提高GaN 结晶性、降低缺陷密度和杂质含量是研究工作中重要的内容之一.Liu 等[32]早期的工作便试图解决这一问题,他们利用PEALD 在Si(100)衬底表面沉积出具有光滑表面的多晶GaN 薄膜.但发现界面处存在约2 nm 的无定形界面层,分析该界面层后确定是GaxOy和GaN 的混合物,这是薄膜内O 杂质含量过高导致的.为了消除该界面层,他们在GaN 生长之前引入AlN 缓冲层和等离子体预处理进行改善.AlN 缓冲层的引入使薄膜初始沉积阶段表现出更好的结晶性和更低的O 杂质含量,而等离子体对Si 衬底进行原位预处理可以有效减小界面层和非晶过渡层厚度,并使沉积的GaN 薄膜拥有更高的每循环生长速率(growth rate per cycle,GPC)、更好的结晶度、更高的薄膜密度以及更低的杂质含量[33].该工作通过引入缓冲层进行缓解GaN 和衬底的晶格失配和热失配,使结晶提前.最终降低了杂质含量和提升了晶体质量证明这是一个较好的方法,但该方法仍旧只得到了多晶GaN,不足以实际应用.为了将GaN 质量继续提升,Liu 等[34]通过进一步进行原位高温烘烤和等离子体处理,成功使GaN 从初始沉积便遵循着层层沉积模式,在蓝宝石衬底表面沉积出单晶品质的外延GaN 薄膜(图2).高分辨率透射电子显微镜(high-resolution transmission electron microscope,HRTEM)结果显示出GaN 具有非常高的结晶品质以及清晰的蓝宝石/GaN 界面,并获得了GaN和衬底之间的外延关系.掠入射X 射线衍射(grazingincident X-ray diffraction,GIXRD)显示薄膜为(002)方向的六方单晶结构,且(002)摇摆曲线的半峰宽(full width at half-maximum,FWHM)仅为666"(0.185°).该方法通过高温烘烤和等离子体预处理在沉积前的阶段使N 取代了衬底的O 位点,从而抑制了薄膜中O 杂质含量,在350 ℃下获得了高品质单晶薄膜.然而,尽管采取此方法获得了高品质GaN 薄膜,却依旧含有9%—12%的O杂质含量.究其根本,O 杂质来源主要有两种途径,一是反应腔室中未排除干净的氧气或者水蒸气;二是一些PEALD 设备所使用的石英管制ICP 源也会引入一些O 杂质[35].而为了排除等离子体发生器所带来的O 杂质的影响,Gungor 和Alevli[36]将等离子体发生器改装成不锈钢材质,称之为空心阴极等离子体辅助原子层沉积(hollow-cathode plasma-assisted atomic layer deposition,HCPAALD),以此为基础研究了Si(100)衬底上生长的不同厚度(5.37—81.40 nm)GaN 的特性.结果表明,生长5.37 nm GaN 薄膜中O 杂质含量为7.81%,而随着厚度增加至81.40 nm 后,O 杂质仅为3.59%.相对于普通PEALD 生长的高达10%以上的O 杂质含量,足以说明利用不锈钢材质等离子体发生器可以显著降低GaN 薄膜中引入的O 杂质.这一方法也促使了人们思考ALD 生长GaN 的影响因素太繁杂,需要从生长的不同方面来考虑提升GaN的质量.除此之外,他们还对GaN 随厚度的生长行为作了研究,发现在200 ℃的窗口内,GaN 薄膜呈现多晶状态.随着薄膜厚度从5.37 nm 增长到48.65 nm,晶粒尺寸变大、O 杂质含量降低、光学薄膜密度和局部结晶度均得到改善.但随着膜厚的继续增大,相应的这些结果并没有得到进一步改善.即厚度超过48.65 nm 的GaN 薄膜具有不同的沉积行为.该方法显著降低了GaN 薄膜内的杂质含量,尤其是O 含量.虽然HCPA-ALD 这种方法可以生长出O 杂质含量比较低的GaN 薄膜,但这种方法需要重新改装设备,复杂且难以推广.因此除了从此类方法上寻找途径外,更需要从底层的物理角度去理解ALD 生长GaN 各种机制,并以此为基础设计更好的实验和方法,得到更理想的薄膜.

图2 (a)未经预处理的氮化镓薄膜的GIXRD 曲线;(b) 预处理样品的XRD 曲线;(c) (002) GaN 峰的XRD ω 扫描摇摆曲线;(d),(e)未经预处理和预处理的GaN/蓝宝石界面的HRTEM 图像;(f) 预处理和未预处理的氮化镓的初始生长示意图;(g) 预处理的GaN 薄膜的选区电子衍射图.氮化镓是外延的,存在 氮化镓//[100]蓝宝石平面排列;(h) 图(b)中黄色矩形所包围的GaN/蓝宝石界面区域的放大图[34]Fig.2.(a) GIXRD patterns of the non-pretreated GaN thin film;(b) XRD patterns and (c) XRD ω-scan rocking curve of the (002)GaN peak of the pretreated sample;(d),(e) HRTEM images of the non-pretreated and pretreated GaN/sapphire interfaces,respectively;(f) the schematic diagram of the initial growth of pretreated and non-pretreated GaN;(g) selected area electron diffraction of the pretreated GaN thin film,GaN is epitaxial,with a GaN//[100]sapphire plane alignment;(h) magnification of the GaN/sapphire interface region enclosed by the yellow rectangle in panel (b) [34].
为了解ALD 沉积GaN 的机制,Shukla 等[37]使用空心阴极等离子体原子层沉积在Si(100)衬底上沉积GaN 并通过原位椭偏监测不同沉积条件下的单个化学吸附和等离子体诱导的配体去除/交换过程(图3).分析发现,当衬底温度高于200 ℃时,GaN 表现为(002)择优取向的六方单相多晶薄膜,且拥有低于检测极限的C 杂质含量和轻微的富镓化学计量.此外,提升等离子体功率也有助于配体的去除,进而增强化学吸附以实现理想的薄膜沉积.结果表明,衬底温度和等离子体功率是薄膜性能关键影响因素,200 ℃和150 W 是GaN 薄膜结晶的阈值.在该研究中,Shukla 等详细剖析了单个ALD 周期内每个脉冲的反应情况,从底层向展示了ALD 沉积GaN 的过程和机制,为优化GaN 沉积提供了宝贵的经验.2019 年,Gungor 和Alevli[38]利用HCPA-ALD 沉积了不同厚度(6.57—84.35 nm)的GaN 薄膜,研究了其折射率和光学声子模式,并进一步分析了GaN 薄膜结晶性和电子浓度的变化.在300—1000 nm 的波长范围内,GaN 的折射率随着厚度的增大而增大,并在52.01 nm 左右稳定下来;但在红外区域的折射率并没有随着厚度的增大而发生明显改变.通过拉曼测试分析发现,峰的FWHM 与薄膜结晶无序性有关,而声子频率偏移与电子浓度直接相关.具体表现为薄膜厚度越小,结晶度越好;薄膜厚度越大,结晶无序性越大.而同样是以52.01 nm 为节点,低于52.01 nm时,GaN 的禁带宽度随着薄膜厚度的增大而增大,其原因是薄膜结构无序性的增加;而在大于52.01 nm 时,GaN 的禁带宽度减小,但仍然高于块体GaN(3.39 eV),这种现象是因为薄膜中压应力的存在.声子频率蓝移则意味着电子浓度的升高.与Shukla 等[37]工作不同的是,这一工作从多种角度对ALD 沉积GaN 薄膜的多种性质做了细致的研究,揭示了GaN 与厚度相关的结构、结晶、光学性质和电学性质的变化.虽然得到了较好的结果,但沉积的GaN 薄膜的质量仍不完美,呈现多晶状态.为了提升GaN 的质量,研究人员从反应能量的角度出发进行优化沉积过程.Deminskyi 等[39]通过分析ALD 周期内化学反应的过程和增加前驱体反应的有效性,设计了在两个前驱体脉冲中间额外增加一个B-脉冲.通过此B-脉冲可以向表面同时提供高能物质和反应物质,可以从前驱体表面有效的去除乙基配体,形成氢位点表面.从而在后面的脉冲中可以有效地被氮化,大大提升了沉积GaN的质量.Lee 等[40]则基于对能量的考虑,在每个ALD沉积周期中引入原位低功率He/Ar 等离子体处理,促成有效的退火效应.由于潘宁效应,GaN 的晶体质量得到了显著改善.结果显示GaN 薄膜具有高质量的(0002)六方结构的纳米级单晶品质和非常光滑的表面.其X 射线的摇摆曲线的FWHM 仅有168′′.这两种方式另辟新径,从反应的过程出发对ALD 沉积方式进行了优化,使沉积的GaN薄膜质量得到了大幅提升,为ALD 沉积GaN 探索了新的方法.此种方法属于提供额外的能量促进反应,由于附加的能量较小,因此不会对衬底或者薄膜造成损伤,且可以有效地改进ALD 反应的过程,生长出质量较好的薄膜.
ALD 与其他薄膜生长方式不一样的原因是引起独特的反应过程,其中相当重要的部分是设计的前驱体不同.与化学气相沉积前驱体相比,ALD 前驱体需要有更高的反应活性和更高的热稳定性,以确保表面交换和化学吸附反应顺利进行,防止热分解反应出现.因此,只有合适的前驱体才可以使ALD的沉积达到理想的效果.2020 年,Rouf 等[41]开发了一种全新的前驱体来促进GaN 薄膜的生长,并取得了振奋人心的研究成果.他们合成了一种高挥发性的三(二甲胺基)镓(III)(tris(dimethylamido)gallium(III))作为Ga 前驱体,并结合 NH3等离子体使用 ALD 进行GaN 的沉积.在 130—250 ℃的温度下GaN 可进行自限制生长,GPC 为1.4 Å/周期.在Si 衬底上生长的GaN 显示出较低的C 和O杂质含量,并且具有接近随机的化学计量比;而在没有AlN 缓冲层的4H-SiC 衬底上首次成功生长出高质量的GaN,其禁带宽度为3.42 eV.2021 年,他们继续使用这种新型前驱体用来生长GaN 薄膜并研究了GaN 的特性[42].结果发现存在着3 个温度窗口.在350 ℃的沉积温度下,不需要AlN 缓冲层即可得到外延薄膜,表现出接近理想的化学计量比,且没有检测到C 杂质.透射电子显微镜(transmission electron microscopy,TEM)结果显示衬底和薄膜之间存在一个尖锐的界面.薄膜的禁带宽度为3.41 eV,费米能级为1.90 eV,为无意的n 型掺杂.X 射线衍射(X-ray diffraction,XRD)对应于(0002)和(0004)的衍射峰证实了c轴生长.结果表明,这种新型前驱体对于生长高质量GaN 是一种极为有效的方法,沉积的GaN 薄膜在各方面都表现出极高的质量.但缺点是这种前驱体合成的方法较为复杂,且过程中有爆炸的风险,增加了大范围推广的难度以及操作风险.上述研究工作使用了不同的方法得到了质量较高的GaN 薄膜,但需要改造设备或者进行自行设计前驱体,不具备通用性,所以限制了技术的传播与应用.为了更为简捷地提高GaN 的质量,需要研究人员在更能广泛传播的基础上进行相应技术的优化.
GaN 的质量与众多因素有关,除了沉积方式和参数带来的影响之外,衬底的影响也格外重要.GaN 与衬底之间存在着晶格失配和热失配,导致在生长过程中无法按照理想的晶格进行排列,可能会出现非晶过渡层或者因应力出现高密度的缺陷.因此需要采取一些措施提高异质外延GaN 的质量.此外,由于可以通过与衬底形成功能性结构,例如异质结等,多种衬底也被用来研究GaN 的生长行为和性质.近年来除了在常规衬底——蓝宝石、硅之外,多种其他衬底,尤其是柔性衬底被选择用来沉积GaN.其中,He 等[43]通过PE-ALD 成功在多层石墨烯衬底上沉积出多晶GaN 薄膜,并证实了平滑的GaN/石墨烯界面.令人感兴趣的是通过有缺陷的石墨烯衬底可以沉积出更高结晶质量的GaN 薄膜,通过分析发现是因为石墨烯表面的缺陷可以提供成核位点,使GaN 可以更早开始结晶.在此基础上进一步探究了PE-ALD 在多层石墨烯衬底表面沉积GaN 的机制,包括界面特性和成核行为.虽然取得了较好的初步成果,但GaN的质量仍不理想,距离最终的应用还需继续提升GaN 的质量.因此,在2022 年进一步研究了GaN在石墨烯/蓝宝石衬底上的原子层沉积[44],并成功沉积出纳米级的近单晶GaN.研究表明使用高质量的单晶石墨烯可以沉积出更高结晶质量的GaN.GaN 在石墨烯表面首先形成成核岛,该成核岛整体上相当于一个缓冲层,为后续的GaN沉积提供了有利条件,证实了在较低沉积温度下GaN 在石墨烯衬底上独特的沉积行为.该工作为低温下沉积高质量GaN 薄膜奠定了基础,也为改善GaN/石墨烯异质结的电子和光学器件性能提供了可能.这些工作通过优化生长条件得到了相对较好的GaN薄膜,但缺乏对GaN 其他性质,如光学性质和电学性质的详细探究,也缺乏与其他衬底生长的GaN的横向对比以及对器件的进一步探索和验证.在未来的研究中,关于此方面的探索仍需加强.
He 等[45]使用 PE-ALD 在低温(290 ℃)下在有 Al2O3缓冲层的不锈钢衬底上成功沉积了 GaN薄膜.分析表明,GaN 呈现(002)择优取向多晶结构,并对GaN 的形貌、结构和光学特性进行了初步的研究,证实了不锈钢衬底上高质量GaN 的生长.2021 年,He 等[46]详细研究了PE-ALD 在Kapton衬底表面的GaN 沉积.研究发现,随着沉积温度的升高,GaN 的O 杂质含量和表面粗糙度增加.当温度继续升高至250 ℃时,GaN 会在Kapton衬底中发生扩散行为.通过引入Al2O3或者AlN缓冲层则可以完全抑制GaN 的扩散,并且还可以有效减小GaN 薄膜中O 杂质的含量以及改善GaN的表面形貌.这为GaN 在柔性电子器件中的应用提供了一种可行的方法.考虑到MoS2与GaN 之间近乎完美的面内晶格匹配度和较小的热膨胀系数,Song 等[47]首次利用PE-ALD 在单层MoS2上直接沉积出GaN 薄膜.发现GaN 薄膜在初始沉积阶段可以很好的结晶,但随着沉积的继续,出现了随机分布的晶粒.由此详细研究并总结了GaN 在MoS2表面的沉积过程,即遵循二维生长(逐层生长)到三维生长(岛状生长)的过程.并根据GPC和表态形态随ALD 周期的变化,提出了GaN 生长的4 个阶段,对理解GaN 的生长起到了一定帮助.为了一步得到高质量的GaN 薄膜,Song 等[48]进一步使用两步沉积法进行改善.即首先在260 ℃下进行沉积,然后升温至320 ℃继续沉积.通过较低的起始沉积温度有利于维持单层MoS2以支持随后的GaN 沉积,成功实现了理想的逐层沉积方式.沉积的GaN 薄膜具有高的结晶度、择优取向、极其光滑的表面、低的O 杂质含量以及接近平衡的Ga/N 比例.相对于直接高温沉积会对衬底造成破坏以至于打破了最初均匀薄膜沉积,两步沉积法明显了提升了所沉积GaN 的质量,为GaN/MoS2异质结或宽光带探测等奠定了基础.Qiu 等[49]首次将GaN 通过PE-ALD 技术沉积在FTO 表面,详细研究并优化了其沉积条件.所有厚度FTO/GaN 薄膜均保持与裸FTO 一致的透过率,但禁带宽度大于3.4 eV.值得注意的是,结果显示随着GaN 沉积厚度的增大,费米能级明显向上移动,同时导带最小值和价带最大值也随之变化,共同导致GaN 禁带宽度逐渐变小.虽然所生长的GaN 薄膜仍处于非晶状态,但是得到了GaN 能带结构随厚度变化的规律.又因之衬底选用了光伏领域中常用的FTO 衬底,因此可以通过调整GaN 的厚度进将GaN 的能带结构调节到合适的位置以将其作为电子传输层应用在太阳能电池中.
2.1.2 ALD 生长GaN 的应用探索
以上这些工作对不同衬底上利用ALD 生长GaN 的生长现象和机制进行了系统研究,但是距离未来可预见的应用还存在着非常大的差距.需要进行更加详细、更加完备的、涉及器件的研究,才会发挥出其最终的利用价值.截至目前,利用ALD沉积GaN 并进行应用的工作非常少,这主要是因为GaN 的质量仍达不到要求.已有的相关应用工作中,Wei 等[50]首次将PE-ALD 制备的GaN 作为电子传输层引入到钙钛矿太阳能电池中.发现即使在GaN/钙钛矿界面处存在0.59 eV 的能带失配,仍然将太阳能电池的效率从10.38%大幅提升至15.18%,初步的研究发现其原因是GaN 可以促进电子提取,并减少FTO/钙钛矿界面处的载流子重组.Qiu 等[51]通过PE-ALD 量子点敏化太阳能电池的TiO2光阳极和量子点表面沉积了一层超薄GaN 层,该GaN 层与量子点之间形成了Type-II能带结构的核壳结构.拓宽了光响应范围以及提高了外量子效率,使太阳能电池的短路电流密度得到了较大的提升.这些工作为ALD-GaN 的应用开辟了一个较新的方向,是对GaN 的低温沉积和应用的探索和验证,使GaN 的应用不只是局限于高温方法或常规领域,在器件中进行应用也有着相当有效的价值.因此,在未来的研究中,纯粹的GaN 生长工作可能不是唯一的研究方向,利用ALD 的生长优势将GaN 作为一些功能材料或者结构进行应用也不失为一种有效的方法,且可以在未来展现出极大的应用潜力.但需要首先解决的是保证沉积GaN 的质量,否则可能无法完全发挥出GaN 的优势以实现更加理想的效果.
2.2 ALD 生长AlN 的机制与应用
2.2.1 ALD 生长AlN 的质量优化以及机制探究
AlN 是一种极具发展前景的宽禁带宽度(6.2 eV)半导体,其优异的热导率、高电阻率、化学稳定性和高介电常数使其成为高电子迁移率晶体管(high electron mobility transistor,HEMT)、LED 等器件中潜力巨大的材料.AlN 也常用做生长GaN 薄膜的缓冲层以减小GaN 和衬底之间因晶格失配和热失配而产生的应力,其次用AlN 缓冲层可以提高GaN 薄膜的电子迁移率和电子浓度.因此,提升AlN 的生长质量也有非常大的意义.与GaN 类似,常规生长AlN 的方法均为高温方法,超高的温度限制了AlN 的直接应用.而氮化物沉积工艺需要与传统金属氧化物半导体制造中的后端线工艺相兼容,所以需要低的温度和高的保形性.因此,低温沉积AlN 的工作便开始有所研究.实际上,利用ALD 沉积AlN 的研究早在2004 年便已开始,Lee 和Kang[52]利用AlCl3和NH3/Ar/H2分别作为Al 和N 的前驱体进行了AlN 原子层沉积.GPC 为0.042 nm/周期,Cl 和H 杂质浓度分别控制在0.23%和2.01%,AlN 薄膜在经过650 ℃退火之后显示出良好的抗氧化性能.而随着技术的不断进步和研究的不断深入,不同衬底上AlN 的ALD 生长以及AlN 的ALD 生长机制也逐步出现.Liu 等[53]研究了使用PE-ALD 在Si(100)衬底上使用三甲基铝(trimethylaluminum,TMA)和Ar/N2/H2(1∶3∶6)混合等离子体作为前驱体进行AlN薄膜的沉积,详细优化了其沉积参数并初步分析了其生长行为.在饱和沉积条件下,AlN 薄膜呈现出均匀的纤锌矿结构,并与Si 衬底之间有着完美的界面,随着厚度的增大有形成(002)优先取向的趋势.随后,Liu 等[54]利用 PE-ALD 在 250 ℃的温度下在Si (100),Si (111) 和蓝宝石衬底上生长了多晶AlN 薄膜.目的是比较不同衬底对 AlN 生长的影响.研究结果表明,所有AlN 薄膜都沿着c轴呈现优先取向,形成六方纤锌矿结构.X 射线反射率数据显示,AlN 薄膜和衬底之间的边界非常清晰.值得注意的是,生长在蓝宝石表面的AlN 薄膜显示出最大的晶粒尺寸和粗糙度,而 AlN/Si (100)薄膜在 532 nm 波长处显示出最高的折射率.相比之下,AlN/蓝宝石薄膜的折射率较低.AlN/Si 和AlN/蓝宝石薄膜在可见光范围内的消光系数k值均为零,这表明它们具有光学透明度.Zhang 等[55]系统研究了不同沉积温度下AlN 薄膜的特性,不仅对AlN 结晶行为作出了研究,还揭示了AlN 薄膜中复杂的杂质成分.其实验结果显示,AlN 薄膜在250 ℃时开始结晶并呈现出六方纤锌矿结构.随着温度的升高,结晶质量伴随着沉积速度和折射率也随之改善.而X-射线光电子谱(X-ray photoelectron spectroscopy,XPS)显示除了主要的Al-N 成分外,还含有Al-O,Al-Al,Al-O-N 复合物成分.Schilirò等[56]研究了PE-ALD 在GaN/sapphire衬底上不同厚度AlN 的特性.在衬底上所有的AlN薄膜均呈现出c轴方向,平面内的结晶排列与GaN 衬底的六边形结构完全匹配,且无论薄膜厚度如何均表现为致密无针孔.TEM 结果显示,第1层的AlN 便表现出很好的排列,但在薄膜上部观察到了堆垛层错以及AlN 平面的微小偏移.这些成果对提升ALD 生长AlN 的质量进行了充分的研究,可以发现,通过优化沉积条件后,可以在多种衬底表面低温生长出较高质量的AlN 薄膜.但为了进一步将其应用,还仍需进一步减小薄膜中的杂质含量.O 作为AlN 薄膜中经常检测到的一种杂质,对薄膜有着很大的影响.O 的活泼性较高,其存在可以与Al 结合形成Al2O3,非常影响AlN的性质.Gungor 和Alevli[57]通过改变H2等离子体的功率和时间详细研究了O 在ALD 沉积AlN薄膜中的掺入情况.分析发现,随着H2等离子体流量的增大,薄膜中的O 杂质浓度会下降并有一个极值,即超过极值后进一步增大H2等离子体流量并没有进一步减小O 的含量.可能原因之一是AlN薄膜中过量的Al(即富铝)造成的,用N2/H2沉积的AlN 薄膜固定了更多的铝,也因此引入了更多的O,使得O 扩散到了AlN 的晶粒中,以N—Al—O 键形式形成AlON.该方法分析了引入O 杂质的原因,通过此分析可以知道在AlN 薄膜中降低O 的含量是一个比较困难的挑战.为了得到更低O 杂质的薄膜,Strnad 等[58]通过N2等离子体增强工艺对AlN 沉积的杂质进行调控.通过在等离子体气体中加入H2或者NH3,在不需要等离子体剂量饱和的情况下有效地消除了氧气的污染,最终将AlN 薄膜中的O 杂质含量控制在0.3%,是一个振奋人心的结果.
而研究人员仍希望可以获得更高结晶质量的AlN,因此促使人们从其他角度进行思考.基于对ALD 具体的反应进行考虑,从能量的角度上对AlN沉积作出了改进,相应的方法包括以下一些报道.Tian 等[59]利用ALD 系统研究了在两个前驱体脉冲之间额外添加N2等离子体作为激活方法来提高TMA 和NH3之间的反应活性.研究发现,H2等离子体确实可帮助打破TMA 中的Al—CH3键或增加NH3的反应性,使沉积的AlN 薄膜获得更高的质量.进一步的研究表明增大H2的流速可提升AlN 的结晶质量,当流速为100 mL/min 时,获得最好的(002)的择优取向.Kao 等[60]则通过在每个ALD 循环中使用He/Ar 等离子体进行逐层原位原子层退火处理引入额外的能量,在300 ℃下获得高度结晶的AlN 外延层.XRD 显示AlN(0002)的FWHM 仅有 176.4′′,而原子力显微镜和HRT EM 均显示AlN 薄膜具有非常光滑的表面.Seppänen 等[61]也通过在每个ALD 周期后引入Ar 等离子体进行原位退火以沉积AlN,并成功提升了AlN 薄膜的结晶度.除此之外还发现Si(111)衬底上沉积的AlN 在期望的(002)方向的结晶是有利的,更适合作为AlN 沉积的衬底.Kot 等[62]比较了直接电感耦合等离子体和间接电容耦合等离子体沉积AlN.结果显示,在均使用200 W 的等离子体功率基础上,直接电感耦合等离子体源沉积的AlN 薄膜在GPC、均匀性、折射率、固定和移动电荷以及残余O 含量方便表现出更好的特性.而将功率提升至600 W 后,可以进一步降低残余O 含量并增强击穿场强.Dallaev 等[63]研究了使用相对容易获得且方便处理的N2H5CL 和Al(C4H9)3分别作为N 和Al 的前驱体进行AlN 的沉积,并研究退火对AlN 薄膜的影响.分析结果发现,AlN 薄膜在沉积后处于非晶和多晶的中间状态,在经过退火后促进了层聚结成簇的趋势,导致晶粒尺寸明显变大,最终晶粒尺寸约为20 mm×20 nm.而且发现即使使用含氯的前驱体,但由于没有达到HCl 分子反应的所需温度,因此并没有在AlN 中发现任何Cl 杂质.而Legallais 等[64]则在衬底支架底部连接额外的电源,研究衬底偏压对Si(100)上沉积AlN的影响.发现通过衬底偏压调整离子能量,可以大大促进氮化程度,使所沉积的AlN 薄膜质量得到明显改善.根据XPS 的数据分析,相对于没有偏压的AlN 薄膜,在低衬底偏压(5 W)下,形成了一个高质量的界面层,使AlN 的N—Al 键数量提升了14%.Mohammad 等[65]使用多波长原位椭圆偏振仪实时监测AlN 的ALD 沉积.发现薄膜沉积GPC和TMA 吸附量与等离子体功率相关,也与衬底温度有关.GPC 在100—200 ℃内显示出轻微的增长,在250 ℃时出现了激烈的增长,表明在此温度时开始出现热分解;当衬底温度超过200 ℃时,结晶度有了明显改善,且所有样品均呈现出单相纤锌矿多晶状态,并表现出高度随机的元素组成.Iihom等[66]使用原位椭偏仪实时监测了射频等离子功率和等离子体曝光时间对ALD 沉积AlN 薄膜的影响.发现随着射频功率的增大,AlN 薄膜的GPC、晶粒尺寸、折射率和应力都有所增大,且伴随着表面粗糙度的降低;而与之相对应的是随着等离子体曝光时间的增加,AlN 的GPC、晶粒尺寸和折射率会有所降低,且表面粗糙度增大.推测原因是空心阴极放电产生的等离子体中的多种活性物质(Ar+,Ar*,H*,NH*,)会通过不同方式影响TMA 分解和AlN 成核与沉积过程.射频功率越高,HCD 等离子体中活性物质密度越高,促进了TMA 的分解和AlN 成核与沉积过程,进而提高了AlN 的薄膜质量;等离子体曝光时间越长,HCD等离子体中活性物质密度越低,从而抑制了TMA的分解和AlN 的成核和沉积过程,降低了AlN 薄膜的质量.以上总结的报道通过引入等离子体、原位退火、施加偏压、增大等离子体功率或曝光时间等方法来额外增大反应能量,有效地提升了AlN结晶质量.这些方法可以在较低的温度下增大反应能量,为AlN 的ALD 生长提供了新的思路.AlN结晶质量的提高可以大幅降低薄膜内部的缺陷密度和杂质浓度,从而可以减小器件中的漏电流以及增大阈值电压.因此可以利用此类技术实现将高质量的AlN 作为钝化层沉积在对温度敏感的器件中,避免高温对器件或结构造成损伤.然而缺点是牺牲了反应时间、增加了生长成本或改造成本,使整个生长过程所持续的时间大幅延长或者生长成本大幅增加.不过对于器件体积越来越小以及结构层厚度越来越薄的情况,上述缺点所带来的问题在一定条件下也是可以被接受的.
ALD 的优势在于可以依靠自限制反应实现逐层生长以实现高质量薄膜的沉积,但实际中的ALD 沉积具有非理想性,阻碍了逐层生长,出现成核延迟与岛状生长并导致表面粗糙度变大.相对于TALD,PEALD 可以更大程度上抑制这一现象,因为可以形成更多的晶核.因此为了控制成核阶段的不均匀性,Yun 等[67]在295—342 ℃下使用T-ALD,以TMA 和NH3为前驱体研究了Si和TiN 衬底上不同的AlN 成核和沉积行为.对于两种衬底均出现随着沉积温度的升高,AlN 沉积速度也随之增大.但不同的是观察到了TiN 衬底上的易成核和线性沉积,Si 衬底上的抑制成核现象.这种现象是因为水的预处理的Si 衬底对AlN 的成核没有促进作用,而NH3处理的TiN 衬底增加了衬底上的活性位点数量,形成了(NH2)–或者(NH)2–,进而促进了成核的发生(图4).证实了NH3在衬底上的解离对于随后AlN 沉积所需的制造均匀的核是至关重要的.TALD 也具有一些优势,即不会对敏感衬底造成等离子体损伤,且在三维纳米结构中TALD 沉积的薄膜保形性更好.但考虑到NH3在较低温度下反应不完全,从而导致杂质含量升高或者需要大幅升高温度进行加剧反应,因此需要采用反应性更强的氮源进行替代.基于此方面的考虑,Jung 等[68]则对使用肼(N2H4)替代NH3作为N前驱体进行生长AlN 薄膜的可行性进行了研究.与常规使用的“NH3”作为前驱体来说,N2H4具有更高的反应活性,故沉积AlN 的GPC 更高,且表现出更低的杂质浓度.在225 ℃的温度下沉积的AlN 薄膜Al/N 比例为1∶1.1,证明了N2H4在TALD中低温沉积AlN 的可行性及优势.Parkhomenko等[69]也使用N2H4作为前驱体在375—475 ℃ 的温度范围内对T-ALD 沉积AlN 的行为进行了研究.研究发现所沉积的AlN 薄膜为非晶,经过1000 ℃退火后可转变为多晶.Al/N 接近化学比例,并伴随有一定的C 和O 杂质,O 杂质含量最低至4%.所沉积的AlN 质量与其他技术得到的AlN质量相当.但是由于N2H4在气相中的转化,沉积温度不允许进一步降低.为了通过TALD 得到结晶质量更高的AlN 薄膜,Tiwari 和Dixit[70]则使用三(二甲氨基)铝(tri(dimethylamido) aluminum,TDMAA)作为Al 的前驱体,并在300 ℃沉积出了高质量的AlN 薄膜.薄膜具有光滑的表面、适度的电阻、低的漏电流和大的禁带宽度.较好的电学性质说明利用这种前驱体沉积出的AlN 质量极佳.而且由于不存在直接的金属-碳键,AlN 中C 杂质含量较少.
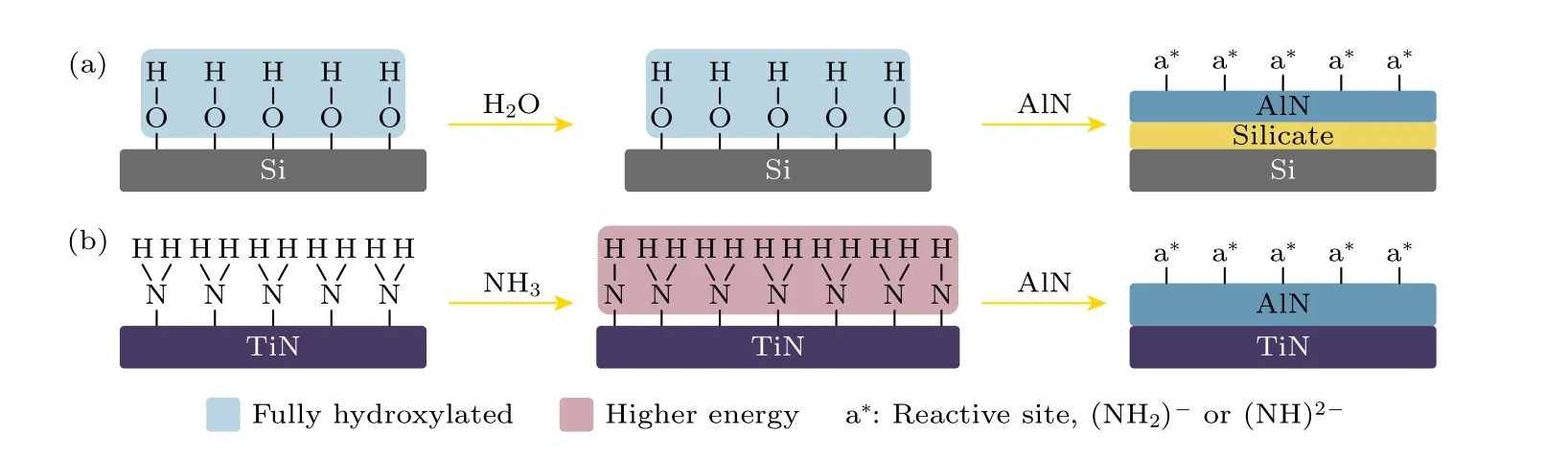
图4 (a) H2O 和(b) NH3 预处理后的成核示意图.蓝色区域、红色区域和a*分别代表完全羟基化状态、较高能量状态和反应性部位,如离解的NH3[67]Fig.4.Schematics of nucleation after (a) H2O and (b) NH3 pretreatment.The blue region,the red region and a* represent the fully hydroxylated state,a higher energy state,and a reactive site such as dissociated NH3,respectively[67].
2.2.2 ALD 生长AlN 的应用探索
AlGaN/GaN HEMT 由于非常优异的电学性质,非常适合射频和功率领域.然而由于栅极金属和AlGaN 之间肖特基势垒较低,使传统AlGaN/GaN HEMT 的导通电压较低.另一方面,由于电流崩塌效应,AlGaN/GaN HEMT 在高速和大功率应用方便受到很大的限制.这种现象是由于AlGaN 表面的电荷俘获效应导致的,会使HEMT产生动态性能退化、栅极滞后、漏极滞后等问题.通常为了解决这两个问题,会引入SiO2,Al2O3,SrO2等氧化物作为栅极电解质或接入区的钝化层.但氧化物存在会形成Ga—O 键的问题,且有证据表明这是导致电流崩塌的界面源之一.因此,氮化物介电材料更受研究人员青睐,尤其是禁带宽度大且晶格失配小的AlN.Liu 等[71]通过T-ALD 在400 ℃下制备AlN 作为栅极电介质,同时也作为钝化层引入到金属-绝缘体-半导体高电子迁移率晶体管(metal-insulator-semiconductor high-electron-mobility transistors,MIS-HEMT)中.具有AlN 薄膜的MISHEMT 表现出增强的开关比率,并减小了沟道片状电阻.在4 V 的偏压下,栅极漏电流减小了3 个数量级,阈值电压滞后减小了60 mV,并且抑制了电流崩塌退化.Zhang 和Wang[72]利用TALD 沉积10 nm 的AlN 作为MIS-HEMT 的栅极电介质和钝化层.得到了更高的Ion/Ioff比率,在5 V 的偏压下栅极漏电流减小了5 个数量级,并抑制了电流崩塌退化.Tzou 等[73]利用PE-ALD 进行N2/NH3等离子体预处理以及随后的AlN 薄膜沉积,有效地去除了表面的氧化镓层,并有效钝化了表面的缺陷.在40 V 的静态漏极偏压(VDSQ)下,电流塌陷率为22.1%,150 ℃下电流崩塌率为40.2%,且阈值电压无偏移.HEMT 在高温下的击穿电压为687 V,并在高功率操作下依然具有良好的可靠性.Zhao 等[74]采用T-ALD 沉积30 nm 的非晶AlN 钝化层应用在HEMT 上,具有很好的界面状态和薄膜质量,成功钝化了表面缺陷并抑制了失态漏电.并发现非晶AlN 作为HEMT 的栅极电介质漏电率更低,比结晶态AlN 更有前途.这些工作显著说明了AlN 在HEMT 器件中卓越的改进效果,也证明了AlN 作为钝化层的潜力.
在一些其他器件中,也逐步出现应用AlN 的工作.Kim 等[75]通过PE-ALD 在p-GaN 顶部沉积多功能AlN/Al2O3层,改善了蓝光发光二极管的能源效率.AlN/Al2ON层钝化了GaN 的表面防止其氧化并减少了GaN 的表面缺陷态,通过增大GaN 的表面电势提高了进入多量子阱的空穴注入效率,减小了漏电电流.总体上改善了InGaN/GaN LED 的辐射重组率,提高了光发射效率.将LED的电光转换效率、外量子效率以及LED 的峰值效率分别提高了29%,29%和30%.Chen 等[76]则使用ALD 在多鳍结构的GaN 表面沉积AlN 薄膜作为隧道势垒层,不仅钝化了GaN 的表面,而且降低了导通电压,改善了击穿电压,从而提升了器件的可靠性.Kim 等[77]通过ALD 在金属/GaN 结上沉积AlN 用于钝化表面.与无AlN 的样品相比,具有AlN 的样品表现出更高的势垒高度和更低的理想系数.XPS 分析表明在无AlN 薄膜样品的高理想系数与GaN 表面存有原生Ga2O3有关.Schilirò等[78]用PE-ALD 在GaN 上沉积超薄AlN 薄膜.分析发现在第1 个AlN 原子层便具有尖锐的外延界面,并在界面处形成了二维电子气体(2DEG),其片状电荷密度ns≈ 1.45 × 1012cm–2.而导电原子力显微镜和I-V测量均显示通过AlN 势垒的电流传输高度均匀.通过AlN 薄膜的电子传输遵循Fowler-Nordheim(FN)隧穿机制,平均势垒高度〈ΦB〉=2.08 eV,与预测结果一致.Kim 等[79]通过T-ALD 制备了AlN/GaN 和AlGaN,对比发现AlN/GaN 没有边界陷阱,并显示出较低的界面缺陷密度和较低的反向泄漏电流.XPS 数据显示,在最初的ALD 沉积过程中,大部分Al 原子和N 原子更倾向于与氧原子结合,导致AlGaN 层的形成推迟,产生了有缺陷的界面层.这些工作利用ALD技术将AlN 薄膜引入到器件中,可以钝化表面缺陷、降低漏电流、提升器件性能.利用ALD 优化AlN 薄膜的质量以及将其沉积在器件中以改善器件性能已经取得了相当大的进步,充分表明了利用ALD 沉积AlN 的实用性和有效性,为使用ALD沉积AlN 在更多领域内的应用坚定了信心.在未来的研究中,重点可能会放在超薄单晶AlN 薄膜的可控沉积、进一步降低沉积温度以及发挥AlN在HEMT 和LED 器件中的最大应用价值.
2.3 ALD 生长高品质InN 的探索
InN 具有高的电子迁移率(20000 cm2/(V·s))和最低的电子有效质量(0.023m0),这使得InN 具有优异的电子输运性能和高速开关特性,是高频率、高速率晶体管以及相关光电器件结构的理想材料.利用InN 与GaN 或AlN 形成合金材料,可以获得禁带宽度从近红外到深紫外可调的光源、探测器或者光电转换器.但是,InN 的分解温度低且氮平衡蒸气压高,因此传统的CVD 方法生长InN 存在很大的挑战.相比于传统的CVD 方法,ALD 可以克服热力学的限制,解决N 平衡蒸气压高的问题,实现低温和厚度可控的InN 薄膜生长.考虑到利用ALD 技术已经成功沉积出高质量的GaN 和AlN 薄膜,因此ALD 沉积InN 薄膜也是一种非常有前景的技术.Boris 等[80]利用ALD 沉积InN 并研究了N2浓度对InN 薄膜的影响.研究发现,在不同的N2浓度下,薄膜特性有明显差异,更低的N2浓度可以得到表面更平滑的InN 薄膜.进一步分析发现,等离子体源中N2的相对浓度在10%时,N 原子密度达到最大值,然而随着N2相对浓度的进一步增加会导致N 原子产生量的大幅减少.在Ar/N2/H2混合等离子体源中随着N2相对浓度的降低,可以增强N 原子和NHx物种的产生.因此低N2浓度可以产生高N 原子浓度,使得InN 薄膜显示出较大的岛屿尺寸和更低的C 杂质含量.Alevli 和Gungor[81]对N2/H2流速对HCPA-ALD沉积InN 薄膜特性的影响进行了详细的研究.研究发现,H2的等离子体流量的变化与InN 薄膜的特性之间有着明显的关系,并确定了最佳的H2和N2的流量值.而等离子体中H2的加入可以完全或者部分缓解薄膜的应变,而且随着H2浓度的增大,InN 厚度逐渐减小并且粗糙度极值变大.推测所沉积InN 薄膜表面粗糙的原因是沉积InN 薄膜中占据主要作用的N2等离子体数量的减少,并由于H2在反应部位的吸附,导致InN 薄膜表面形成了孔隙结构.Deminskyi 等[82]采用NH3作为ALD沉积InN 的N 源,发现NH3等离子体的流量同样是沉积高结晶和低杂质InN 薄膜的一个重要参数.他们发现在240—260 ℃之间存在一个窄的沉积窗口,且InN 的结晶质量也随着沉积温度的升高而明显改善.最终沉积的InN 薄膜为多晶结构,禁带宽度为1.9 eV,内部C 杂质和O 杂质含量(原子百分比)分别低于1% 和5%,In/N 比例为1.1.Ilhom 等[83]则研究了不同的N2等离子体成分在低温PE-ALD 沉积InN 薄膜中的作用,并采用原位椭偏仪实时观测单个配体交换和去除过程.实验分析结果显示薄膜沉积出现两种模式,包括早期较快速增长的GPC 以及50 cycles 之后稳定增长的GPC,并且获得了GPC 线性增长时ALD 自限制反应的化学吸附和配体去除过程.在无氢的含氮等离子体(N2或者Ar/N2)、100 W RF 等离子体功率以及衬底温度高于200 ℃的条件下产生了随机单相的结晶六方InN 薄膜,且化学计量比接近1∶1.而通过添加H2改变等离子体成分则导致了相当剧烈的微观结构变化,形成了高度立方相氧化物(c-In2O3)薄膜.这种变化产生在等离子体的脉冲过程中,氢自由基促进了预吸附前驱体三甲基铟(trimethylindium,TMI)表面基团的羟基(—OH)形成.温度或者等离子体功率的过低会导致产生非晶态InN 薄膜,主要是由于结晶所需的表面能量不足;但较高的等离子体功率也会导致晶体损伤,导致产生弱晶态的InN 薄膜.Woodward 等[84]利用掠入射小角X 射线散射对3 种不同等离子体下的外延InN 的初期PE-ALD的动力学进行了原位探究.研究发现,沉积模式与等离子体中N 物种的产生有关,高浓度的N 物种促进Volmer-Weber沉积(岛状沉积),低浓度促进Stranski-Krastanov沉积(层状沉积).岛形成的临界厚度、岛与岛中心的距离以及岛的半径随着离子通量增大而增大.此外,岛与岛中心的距离和面密度仅在等离子体脉冲期间发生变化,甚至在已吸附的TMI 被等离子体完全反应之后,仍然随着脉冲继续变化.Rouf 等[85]研究了3 种不同的In 前驱体对沉积InN 薄膜的影响.所使用3 种前驱体的内环位置上的基团分别为—NMe2,—Me 和—H,如图5 所示.随着基团尺寸的减小,前驱体的热稳定性和挥发性也随之增大,所沉积的InN 薄膜具有更好的结晶质量、更好的光学性质、更低的粗糙度以及更接近理想的In/N比例.而根据量子化学模拟表明较小的基团会减少沉积薄膜表面上的空间位阻,使配体和In 中心之间的键变弱.所以,在使用PEALD 沉积InN 的过沉中,可以通过控制通入特定的等离子体物种来控制InN 的生长动力学,生长出符合预期的InN 薄膜.O’brien 等[86]使用一种新的高挥发性的In 前驱体,并成功利用ALD 沉积出了高质量的六方InN 薄膜.在沉积InN 时,观察到了两个温度窗口.在高温区间,前驱体在腔室中经历了气相热分解,并产生了活性更强的In(III)化合物,同时保留了自限制性沉积行为.密度泛函理论计算显示该前驱体通过释放3 个丙烯分子和N2分解成一个较小的三配位In(III)化合物,并导致了在较高温度区间的GPC 的增长.这一工作展示了一种全新的前驱体并研究了其沉积InN 时的反应过程,为配体和前驱体的设计提供了重要的参考.通过了解以上工作,可以说明ALD 技术是沉积InN 薄膜的一个非常有效的方法,而且不同种类N 等离子体前驱体、In 前驱体、气体流速、气体含量都会对最终生长InN 薄膜的质量产生很大的影响.通过优化沉积条件、改变前驱体物种、设计新型前驱体材料可以得到高质量的InN 薄膜,为InN 的实质应用推进了一大步.
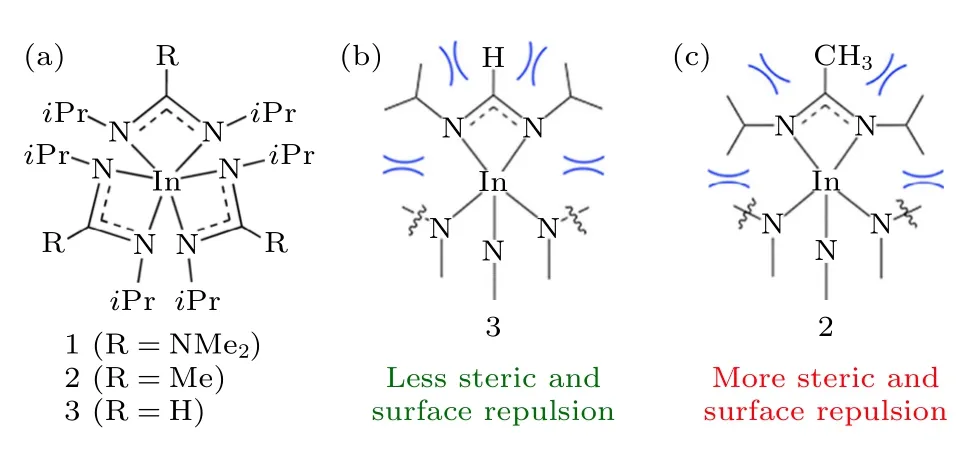
图5 (a) 用于InN 的ALD 研究的三种六价In(III)前体1—3;(b)前体3 的改进的表面化学示意图,显示与(c)前体2 相比,其iPr 基团的立体和表面排斥力下降[85]Fig.5.(a) Hexacoordinated In(III) precursors 1–3 used for the ALD study of InN;schematics of the suggested improved surface chemistry for (b) precursor 3,showing the decrease in steric and surface repulsion of its iPr groups in comparison to (c) precursor 2[85].
为了获得不同用途的InN 薄膜,科研人员也研究了各种衬底表面的InN 生长,并对InN 生长的行为和机制进行了分析.Feng 等[87]利用PE-ALD系统地研究了InN 的沉积参数,并确定了最佳的工艺窗口.在最优条件下,比较了InN 与不同衬底的晶格失配情况.分析表明,在ZnO(0001)衬底上获得了晶格失配最小的外延InN 薄膜,并通过高分辨率X 射线衍射和HRTEM 测试分析,发现薄膜是完全松弛的,在界面中没有发现空隙和界面层,为提升ALD 生长InN 薄膜的质量奠定了基础.Peng 等[88]通过PE-ALD 发展了在非晶衬底(玻璃和聚酰亚胺)上低温沉积多晶InN 的方法.发现在最初的沉积阶段,InN 薄膜为非晶状态.随着沉积周期的增加出现岛屿并开始选择晶体取向.在经过800—1200 周期后,薄膜转变为多晶并具有光滑的表面.其原因是起始随机分布的岛屿随着生长周期的增加,会因为表面自由能的差异争夺空间以选择生长晶体取向.表面自由能最低的晶粒生长速度很慢导致被相邻的晶粒掩盖,最终使晶向正确的方向得以继续生长,表现为非晶到多晶的转变.Woodward 等[89]研究了利用PE-ALD 在GaN(0001)衬底上沉积InN 薄膜,并利用原位掠入射小角X 射线散射研究了不同沉积温度下InN 的表面拓扑演变.结果显示在沉积温度窗口下,ALD 沉积InN 薄膜是以Stranski-Krastanov (层状沉积)模式进行的.其中2D-3D 的转变分别发生在180 ℃的2.3 个单层、250 ℃的1 个单层和320 ℃的1.5 个单层之后,相应的初始岛与岛中心的距离为7.4 nm,11.6 nm 和11.7 nm.180 ℃时的2D-3D转变的延迟可能是InN 结晶度降低、团簇形成的激活障碍或原子扩散不足导致的.此外,岛的粗糙度也随着沉积温度的升高而增大,这是因为在320 ℃时岛的形状随着沉积周期的增加逐渐向圆柱形转变.Hsu 等[90]在通过ALD 在4H-SiC 衬底上沉积高结构质量的纳米级InN 薄膜.结果显示InN 薄膜在第1 层通过4H-SiC 的位错形成松弛,然后便展现出近乎同轴的外延沉积,并显示出非常光滑的形态.XRD 和TEM 分析发现尖锐且光滑的InN/4H-SiC 界面,即使InN 薄膜只沉积2.3 nm,也表现出很高的结构质量.通过拉曼光谱确认了导致薄膜出现松弛的原因可能是晶界点缺陷引起的不均匀的应力.InN 生长面临另一个严重的问题是In 的金属团聚现象,这通常是InN 低的分解温度,In 原子高的表面扩散性和高自黏性引起的.In 团聚会严重影响InN 的发光性能、局部禁带宽度以及不良界面等问题.基于此,An 等[91]通过在Si(100)衬底摸索生长InN 薄膜的条件,优化了InN 的薄膜的性质,解决了In 团聚的问题,获得了具有良好结晶性的InN 薄膜.他们通过调整沉积温度、In 前驱体脉冲时间、In 前驱体的反应时间和N2时间不仅解决了金属In 的团聚问题,还提出了InN 的沉积模型.最终沉积出无In 团聚的多晶InN 薄膜,表现为(002)择优取向的六方结构,晶粒平均尺寸为120 nm.虽然使用ALD 沉积InN 的工作已经取得了一定的进展,但相较于GaN 和AlN 相对成熟的技术,仍然还存在许多的问题有待解决.比如,获得单晶品质的InN 薄膜、减少In 团聚或InN 薄膜内部杂质和缺陷密度、不同衬底表面高质量InN 的外延等.但由于目前对InN 材料本身的了解还不够完全彻底,再加之使用ALD 生长InN 薄膜的工作不够完善,因此还需要在此基础上进行更加详细、更加深入和更长时间的研究.
综上所述,利用ALD 进行氮化物半导体生长的工作发展较早,而随着研究的推进,数量也逐渐增多.为了全面总结和比较近年来ALD 生长二元氮化物半导体的工作,我们将相关的信息整理到表格中以供查阅,相关信息主要包括前驱体材料、沉积温度和所使用的衬底等.详细信息见表1.
3 ALD 生长三元合金氮化物研究进展及应用探究
3.1 ALD 生长三元合金氮化物的研究进展
III 族氮化物半导体(InN,GaN 和AlN)由于可以形成合金相并且可以通过调整合金成分将禁带宽度从深紫外到红外进行连续调控,在光电子领域已经成为极具竞争力的材料.常用生长合金的技术主要有脉冲激光沉积、MOCVD、MBE、HVPE等.其中MOCVD 和MBE 是其中最主要的沉积技术,可以生长出杂质含量极低的高质量单晶薄膜.但此类技术普遍沉积温度太高,会对富In 薄膜的生长造成严重限制.因为InxGa1–xN 在0.05 图6 数字合金化的示意图Fig.6.Schematic diagram of digital alloying. Ozgit-Akgun 等[97]利用HCPA-ALD 以数字合金化方法生长了AlxGa1–xN 薄膜.为了调整合金成分,使用了包含由不同AlN 和GaN 子循环(AlN/GaN=1∶3,1∶1,3∶1)的超循环进行沉积.根据GIXRD 数据显示,随着AlN 子循环比例的增大,峰值会逐渐向更高的2θ 值转移,这是由于原子半径更小的Al 并入到了纤锌矿晶格中.利用Vegard 定律可以进一步确定AlxGa1–xN 中x的数值.通过计算发现最后得出的晶格常数c与无应变的薄膜有所差异,这可能是AlN 在GaN 上的沉积速率(GaN 在AlN 上的沉积速率)与AlN 在AlN上的沉积速率(GaN 在GaN 上的沉积速率)会有所不同.另一个原因则可能是AlN 的ALD 沉积表现出轻微的成核延迟,导致初始GPC 较低,而GaN 的GPC 在初始阶段会比较高.进一步的研究发现随着AlxGa1–xN 中的Al 含量从0.68 增至0.96,薄膜的折射率从2.03 降至1.96,与AlN 的折射率(n=1.94)相当.而透射光谱中AlGaN 的吸收边也随着Al 含量的增大发生蓝移,表明AlxGa1–xN的禁带宽度也随之增大.Nepal 等[98]则通过PEALD 进一步研究了包括了AlxGa1–xN,InxAl1–xN和InxGa1–xN 在内的III-族氮化物合金薄膜.通过调整InN,AlN 和GaN 子循环比例,在Si(111)、蓝宝石和GaN(0001)衬底上沉积出了具有广泛化学计量范围的合金薄膜.分析发现在GaN 衬底上沉积的所有合金薄膜均是光滑和均匀的,并具有和衬底相当的粗糙度.而InAlN 的表面粗糙度偏大表明InAlN 是所有合金薄膜中最难沉积的材料,原因是因为InN 和AlN 的最佳沉积温度相差最大.GaN 上沉积的所有薄膜均为(0001)取向的,表明薄膜是外延薄膜.高分辨率X 射线衍射所测得的InAlN 和InGaN 中In 的含量与XPS 测得的In 含量也保持一致.并通过MadMax 仿真可以得出GaN衬底上的含In 合金薄膜均为松弛状态.AlGaN/Si(111)薄膜随着Al 含量从42%增大到59%,吸收边也从4.30 eV 增至4.77 eV,与带边相关的光谱位置和XPS 测量得到的化学计量一致.基于此可以判定,ALD 可以解决传统方法生长合金薄膜中难以调控化学计量的问题.Portillo 等[99]通过相同的方法在保持等离子体脉冲时间不变的情况下,在300 ℃成功沉积了AlxGa1–xN 和InxGa1–xN 薄膜.通过调整AlN 或InN 与GaN 的子循环次数调整合金成分变化,可以将禁带宽度有选择性地从深紫外调整到红外区,通过飞行时间二次离子质谱仪也证实了薄膜成分的分布.没有观察到InGaN 的XRD 衍射峰,但观察到了AlGaN 的衍射峰且表现为六方晶向.X 射线反射曲线显示AlGaN 和InGaN 的周期性中断和短周期Kiesser 边缘.而通过分析发现合适的TMI 前驱体蒸气压、等离子体脉冲时间和循环次数是使薄膜结晶的一个重要参数.Choi 等[100]则利用T-ALD 在低温(342 ℃)下以TMA,TEG 和NH3为前驱体,成功沉积出高铝含量(Al/Ga~ 5.5)的AlGaN 薄膜.DTF 计算证实Ga 物种的表面反应活性较小,导致加入GaN子循环后反应性降低.TEM 图片表明形成了光滑的AlGaN 薄膜,并在非晶基质中发现有小块晶粒.进一步分析发现GPC 对AlN 和GaN 子循环脉冲比存在依赖性,可以得出GaN 融入到了AlN 薄膜中,而化学成分与脉冲比无关.即使AlGaN 薄膜的化学组成与AlN 和GaN 循环比的关系很小,但是依旧可以调整薄膜的电学性能.通过引入足够数量的AlN 子循环,可以实现接近理论介电常数的逐层沉积.以上这些工作从不同类型的ALD、不同的沉积方法、不同的衬底方面系统地探究了ALD沉积多种三元合金薄膜的性质,通过改变子循环比例得到了禁带宽度、电学性能等性质可调的薄膜.虽然从某种意义上说还不甚完美,但仍取得了非常积极的进步,并以较好的实验结果证实了利用ALD调整三元合金薄膜性质的优越性,为其在更多领域中得到应用打下了基础. 借助于ALD 可调节合金薄膜禁带宽度的特点,对基于相关薄膜器件的设计非常有利.Kim等[101–103]在2020 年发表了多篇文章报道了ALD沉积AlGaN/GaN 肖特基二极管的电流传输机制.他们首先在GaN 衬底上用ALD 沉积了不同厚度的AlGaN 形成肖特基二极管,并对其电子传输机制进行了详细的研究[101].结果显示,在348 K 以上,含5 nm 和10 nm 厚薄膜的正向电流传输可以用不均匀肖特基势垒的热电离发射模型进行解释.但由于更薄的(5 nm)的AlGaN 薄膜拥有更高的表面/界面状态密度,导致更薄的隧穿屏障,更易发生直接隧穿;而10 nm 厚度的AlGaN 薄膜中与线位错相关的缺陷增强隧穿(trap-assisted tunneling)占据主导地位.进一步使用ALD 以不同AlN/GaN脉冲比(2∶1,1∶1,1∶2)进行沉积AlGaN,制备AlGaN/GaN 肖特基二极管[102].发现在低偏压区,脉冲为2∶1 样品的电流传输机制可以由蒲尔-弗朗克效应(Poole-Frenkel effect)发射解释,而脉冲为2∶1 样品的负温度依赖性与AlGaN 薄膜中的受体水平有关.此外,发现1∶1 和1∶2 脉冲比的样品有着0.24—0.29 eV 的快速界面陷阱且有着较高的缺陷密度.而在2∶1 脉冲比的样品观察到了0.34 eV 的体缺陷.通过I-V测试发现随着沉积温度的升高,AlGaN/GaN 肖特基二极管的势垒高度下降,理想系数增大.在高反向偏压下,电流流动的主要贡献来自于缺陷增强隧穿.由于AlGaN/GaN界面附近氧化层中的电荷缺陷,导致平带电压漂移和缺陷电荷密度都有所增大[103].尽管利用ALD 生长合金材料制备的器件特性还不够好,但对于了解ALD 生长合金材料的性质以及在器件和材料方面的影响机制仍具有一定意义.在未来的工作中需要进一步提升合金薄膜的质量,借助ALD 在低温下如果能获得与MOCVD 相似的薄膜质量,那对于AlGaN/GaN 异质结等其他结构的制备将具有非常巨大的提升. 本文综述了ALD 沉积氮化物半导体及其合金的研究进展,全面介绍了不同的沉积方法、沉积衬底、材料特性和多样化的应用领域.通过ALD 技术,可以精确控制氮化物半导体中的缺陷密度、界面质量和电学性能等关键参数,可以用于制备高性能的电子器件、光电器件和传感器等.此外,ALD还为氮化物半导体材料的纳米尺度加工以及集成电路的制备提供了可能. 尽管ALD 沉积氮化物半导体已经取得了显著的成果,但仍然存在一系列关键挑战和问题,需要进一步深入研究和探索.这些问题包括但不限于如何提高ALD 沉积氮化物半导体的沉积速率和质量,如何精确优化ALD 反应条件和前驱体选择以实现更精确的控制,以及如何有效实现对氮化物半导体的掺杂和表面修饰.此外,还需要致力于设计和制备新型的氮化物半导体结构和器件,以满足不断增长的应用需求.理论模拟和表征技术的进一步发展将有助于深入了解ALD 沉积氮化物半导体的沉积机制和物理性质,从而为材料设计和应用开发提供有力指导. 综上所述,ALD 沉积氮化物半导体代表着材料科学和半导体技术领域的重要进展,具有广阔前景.尽管已经取得了显著成就,但在面临的挑战面前,我们仍需不断努力.这些问题的解决将为氮化物半导体材料的进一步开发和应用提供坚实的基础.期待ALD 技术在氮化物半导体领域继续推动更多的创新和突破,为我们解决重大科学和技术难题提供新的途径.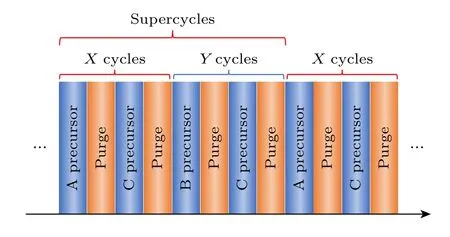

3.2 ALD 生长三元合金氮化物的应用探索
4 结论与展望
