AlGaN/GaN HEMT器件高温栅偏置应力后栅极泄漏电流机制分析
2024-01-22陈欢欢,张贺秋*,邢鹤,夏晓川,张振中,蔡涛,叶宇帆,郭文平,席庆南,黄慧诗,梁晓华,梁红伟
陈 欢 欢, 张 贺 秋*, 邢 鹤, 夏 晓 川, 张 振 中, 蔡 涛,叶 宇 帆, 郭 文 平, 席 庆 南, 黄 慧 诗, 梁 晓 华, 梁 红 伟
(1.大连理工大学 集成电路学院, 辽宁 大连 116024;2.元旭半导体科技股份有限公司, 山东 潍坊 261000; 3.江苏新广联科技股份有限公司, 江苏 无锡 214192; 4.中国科学院 高能物理研究所, 北京 100049 )
0 引 言
由于GaN材料具有较大禁带宽度,AlGaN/GaN HEMT器件在高温等方面有极大的应用潜力,如在商业和军事、能源工业的石油和天然气勘探、汽车和航空航天应用等[1-2].虽然AlGaN/GaN HEMT器件在高温微波大功率领域有较大的优势,但是由于其材料的性质及其复杂结构,器件在高温应用中产生很多缺陷,造成器件性能变差,如阈值电压的漂移、大的栅极泄漏电流等[3-4].AlGaN/GaN HEMT器件的沟道中二维电子气(2DEG)通过肖特基栅极调控,栅极泄漏电流增大会导致器件的功耗增大,可靠性发生很大程度的退化[5].因此,研究栅极泄漏电流机制对器件的高温可靠性是非常重要的.
2017年Lee等研究了325 ℃下器件高温存储48 h后的特性变化,认为是由栅极金属扩散导致器件发生退化[6].2019年Kargarrazi等将器件在500 ℃下存储25 h后,认为是由AlGaN/GaN界面发生应变使器件栅极泄漏电流发生较大程度的退化[7].2021年Lu等研究了栅极-10 V、漏极60 V电压应力下,150 ℃存储300 h后器件特性,发现界面陷阱导致阈值电压漂移,势垒层的退化是造成福勒-诺德海姆(Fowler-Nordheim,FN)隧穿和陷阱辅助隧穿(trap assisted tunneling,TAT)的原因[8].栅极泄漏电流的途径有很多,高温存储后器件栅极泄漏电流已经远远超过热电子发射所造成的泄漏,普尔-弗伦克尔(Poole-Frenkel,PF)发射电流被认为是反向低偏压下主导的泄漏机制,低至中偏压下,陷阱辅助隧穿机制主导栅极泄漏电流,高偏压下则由福勒-诺德海姆隧穿主导[9-11].本文通过对AlGaN/GaN HEMT器件进行高温存储研究栅极泄漏电流的退化机制.
1 实 验
AlGaN/GaN HEMT器件结构如图1所示.通过有机金属化学气相沉积法(metal-organic chemical vapor deposition,MOCVD)生长的蓝宝石衬底上方的异质结构由2 μm GaN缓冲层、400 nm GaN沟道层、0.8 nm AlN插入层、23 nm AlGaN势垒层(Al组分为23%)和2.5 nm GaN帽层(从下到上)组成.在沉积源极和漏极金属之前,通过干法蚀刻阻挡二维电子气(2DEG)以达到器件隔离的目的.源极和漏极结构均为Ti(30 nm)/Al(240 nm)/Ti(30 nm)/Au(50 nm)/Pt(30 nm),在850 ℃的N2气氛中退火2 min形成欧姆接触.源极和漏极是对称的,它们之间的距离为50 μm.AlGaN/GaN HEMT器件在沉积栅极金属之前用SiO2钝化以提高其防水性能.钝化层开窗口后,沉积Pt(50 nm)/Au(100 nm)以形成肖特基接触的栅极,其长度为30 μm,宽度为500 μm.

图1 AlGaN/GaN HEMT 器件结构
具体实验过程是在高温装置mK2000B上加热器件,温度设置为250 ℃,mK2000B的探针连接安捷伦B1505半导体参数分析仪.在加热过程中,对栅极施加-2 V电压应力,并定期测试器件肖特基特性,直到器件失效.测试参数设置:漏-源电压Vds为0 V;栅-源电压Vg从-8 V扫描至1 V,步长为0.1 V.
2 结果和分析
2.1 高温存储
图2(a)显示了器件在250 ℃下施加应力0~420 min后的肖特基特性,间隔为10 min.可以看出,栅极泄漏电流随着应力时间的增加而增大,这表明栅极退化程度随着应力时间的增加而变得剧烈.
图2(b)是无应力、应力后及在室温下静置后的器件栅极泄漏电流密度对比图.3种状态的器件测试条件相同,漏-源电压均为0 V,栅-源电压从-8 V扫描至1 V,温度条件均为室温.与受到应力后的器件相比,无应力器件的栅极泄漏电流密度增加了两个数量级,受到应力器件在室温下静置后栅极泄漏电流密度恢复了约20%.

(a) 250 ℃下器件栅极泄漏电流

(b) 器件栅极泄漏电流密度
在图3中,电容-电压特性显示了受到应力后器件的阈值电压正向漂移,这是势垒层电荷和应力期间产生的界面状态共同作用的结果.为了分析HTGB后栅极泄漏电流机制,需要AlGaN势垒层的电场.电场的表达式如式(1)[12]所示,其中npol为极化电荷面密度,其与Al组分x的关系由式(2)给出.
(1)

图3 无应力器件和室温下静置后器件的电容-电压特性
(0.059 3x+0.049 2x2)C/m2
(2)
式中:x为0.23,C为电容密度,ε0为真空介电常数,q为电荷量,ns为沟道中电子的面密度,P为极化强度.AlGaN的相对介电常数εAlGaN与Al组分x的关系由下式[13]给出:
εAlGaN(x)=10.4-0.3x
(3)
沟道中电子的面密度ns由式(4)[5]给出,其中C可通过图3获得,Von为开态电压,取0 V,Voff为关态电压,取-8 V.
(4)
根据上述参数和式(1),可获得受到应力器件在室温下静置后的电场,如图4所示,其中插图显示了器件电容和二维电子气(2DEG)面密度.

图4 受到应力器件在室温下静置后的电场
2.2 栅极泄漏电流机制分析
器件栅极泄漏电流的机制包括热电子发射(thermionic emission,TE)、普尔-弗伦克尔发射、福勒-诺德海姆隧穿和陷阱辅助隧穿[14].示意图如图5所示,其中Efm和Efs分别代表栅极和GaN的费米能级.

图5 栅极泄漏电流机制
2.2.1 热电子发射 首先分析正向偏置下的栅极泄漏电流机制,在这个电压偏置范围,考虑是热电子发射引起栅极泄漏电流[5].肖特基接触的栅极泄漏电流方程如下式所示:
(5)
式中:Js为反向饱和电流密度;n为理想因子;T为热力学温度,取值为298 K;k为玻尔兹曼常数.
反向饱和电流密度Js由下式给出:
(6)
式中:A*为理查逊常数,取值为33.5 A/(cm2·K2);φb为肖特基势垒高度.
式(7)、(8)分别由式(5)、(6)变形得到:
(7)
(8)
根据式(7)可以做出电流密度-电压(lnJ-Vg)曲线,如图6所示,根据其截距可求出饱和电流密度Js,斜率可求出理想因子n,其值为2.07.肖特基势垒高度可根据式(8)求得,其值为0.67 V.
2.2.2 普尔-弗伦克尔发射 经过计算,由热电子发射引起的反向偏置电流远小于实际测得的电流(负几十次方量级),因此忽略反向偏置下热电子发射引起的漏电.在小反向偏置电压下栅极泄漏电流考虑由普尔-弗伦克尔发射引起,其电流由下式[9]给出:

图6 热电子发射的电流密度-电压曲线
(9)
式中:c为常数,E为电场强度,φt为电子从缺陷能级发射的势垒高度.由式(9)变形可得
(10)
其中
(11)
(12)
若由普尔-弗伦克尔发射引起栅极泄漏电流,则ln(JPF/E)与E1/2应有较好的线性关系.
根据式(10),结合图2(b)与图4,可以做出ln(JPF/E)与E1/2曲线,如图7所示,对应电压为-0.4~-3.6 V.图中线性拟合较好,说明在此电压范围内,栅极泄漏电流由普尔-弗伦克尔发射引起.

图7 ln(JPF/E)与E1/2 曲线
2.2.3 陷阱辅助隧穿 在阈值电压附近,栅极泄漏电流由陷阱辅助隧穿机制主导[10].陷阱辅助隧穿电流JTAT由下式[15]给出:
(13)

图8为lnJTAT与E-1曲线.若电流由陷阱辅助隧穿引起,则二者呈良好线性关系.对应电压为-4.5~-5.4 V.
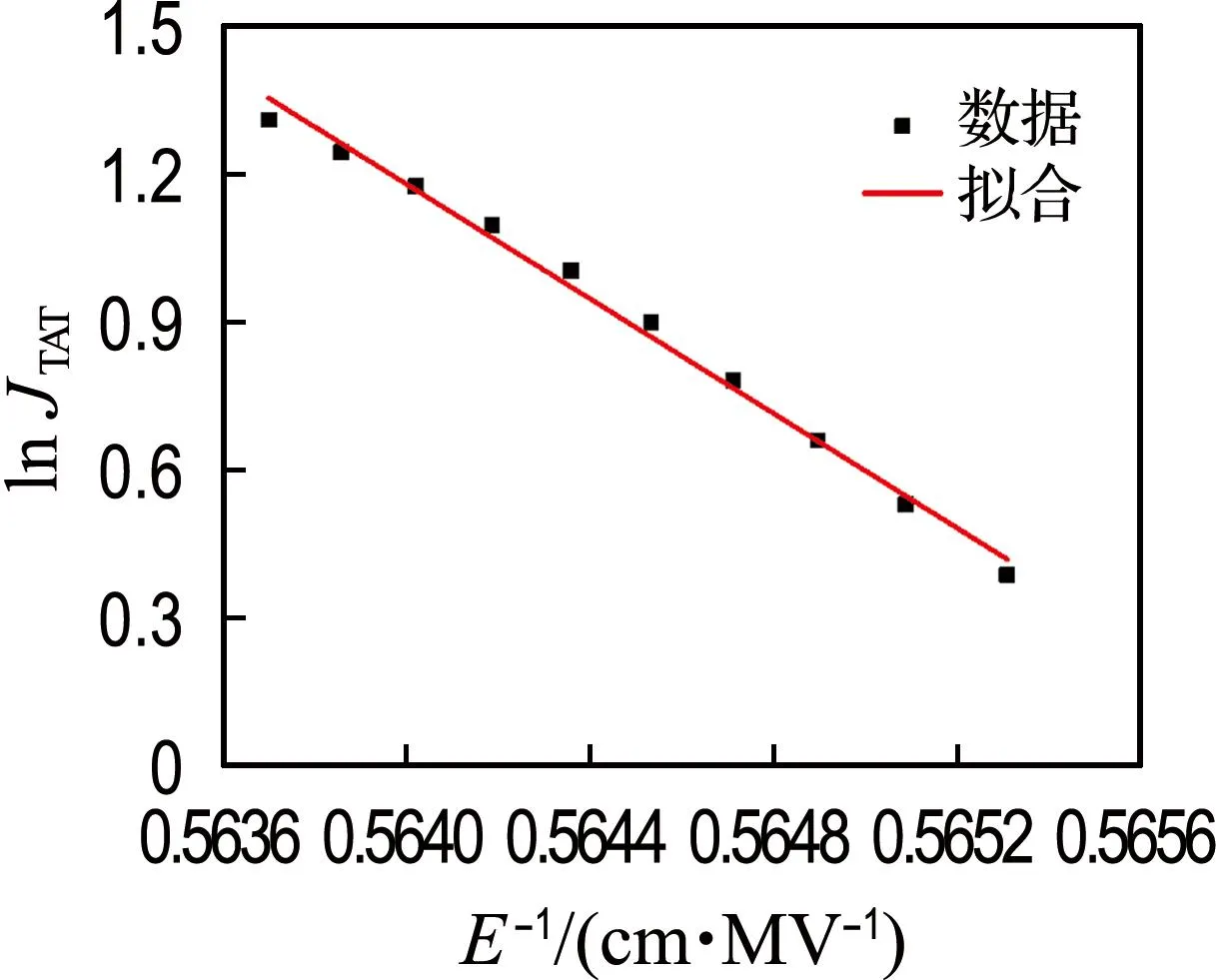
图8 ln JTAT与E-1曲线
2.2.4 福勒-诺德海姆隧穿 在大反向偏置电压下,栅极泄漏电流由福勒-诺德海姆隧穿引起[11].福勒-诺德海姆隧穿概率由下式[16]给出:
(14)

(15)
Al组分x为0.23.AlN禁带宽度为6.2 eV,GaN禁带宽度为3.4 eV,得到AlGaN禁带宽度为4.2 eV.
在大反向偏置电压下器件电场达到饱和,为1.75 MV/cm,在该电场下福勒-诺德海姆隧穿概率为99.9%,接近1.隧穿电流密度JFN与电场E的关系由下式[5]给出:
(16)
其中
(17)
式中:φeff为有效势垒高度.式(16)经过变形得
ln(JFN/E2)=lnA-B/E
(18)
图9为ln(JFN/E2)与E-1曲线.若电流由福勒-诺德海姆隧穿引起,则二者呈良好线性关系.对应电压为-6.0~-7.9 V.

图9 ln(JFN/E2)与E-1曲线
3 结 语
AlGaN/GaN HEMT器件的性能会受到栅极泄漏的影响.不同电压下栅极泄漏电流受到不同的调控机制.在正向偏置范围内,栅极泄漏电流由热电子发射引起.在反向偏置范围内,普尔-弗伦克尔发射在小电压范围内占主导地位;阈值电压附近的范围由势垒层中的陷阱辅助隧穿引起;在大电压范围内,福勒-诺德海姆隧穿主要导致栅极泄漏电流.
