一种具有多晶硅二极管栅极结构的槽栅IGBT 设计
2022-09-27胡汶金赵一尚李泽宏
王 波 ,胡汶金 ,赵一尚 ,李泽宏 ,任 敏
(1.川投信息产业集团有限公司,四川成都 610000;2.电子科技大学电子薄膜与集成器件国家重点实验室,四川 成都 610054)
绝缘栅双极型晶体管(IGBT)器件作为中高功率开关应用的关键半导体器件,受市场需求的影响,其一直朝着降低开关损耗、提高工作频率和提高器件可靠性的方向发展[1-2]。在传统槽栅IGBT 结构中,减小关断损耗会造成器件正向导通压降的提升,从而对器件的导通特性产生不利影响。随着场截止技术和载流子存储技术的发展,人们实现了对IGBT 正向导通压降VCE(ON)与关断损耗EOFF两者矛盾关系的较好的优化[3]。而在优化器件开启损耗EON的方向上,较高的开关速度虽然可以减小器件的开启损耗,但同时会带来较大的电流电压振荡,造成栅极电阻Rg无法较好地调控IGBT 的集电极电压和电流的变化率(dVCE/dt和dICE/dt);同时受到IGBT 开启速度的影响,电路中的续流二极管(Freewheel Diode,FWD)的反向恢复速度也随之加快,导致FWD 反向恢复时的阳极电压变化率dVKA/dt过大,进一步造成集电极电流和电压的变化过快,最终在系统中引发较为严重的电磁干扰EMI 噪声问题,对器件及应用系统的可靠性产生不利影响,这种情况在小电流应用环境中尤为明显[4]。
EMI 噪声的主要来源是开启瞬态较高的dV/dt和dI/dt,而以上两个参数主要受位移电流Idis的影响[5-7]。

式中:CGCOX1为栅极-集电极电容(密勒电容)的一部分;Vacc为槽栅周围电势;VGE为栅极电压。当栅极附近的电势变化速率dVacc/dt大于栅极电压变化速率dVGE/dt时,位移电流Idis将会通过部分栅氧化层电容对栅极充电,使得实际参与充电的栅电流IG_eff=IG+Idis增大,进而导致dV/dt和dI/dt的不可控现象。
基于以上研究,业内对优化开启损耗EON和电磁干扰噪声EMI 噪声之间的折中关系的主要方向为减小IGBT 的密勒电容CGC和槽栅附近电势Vacc的变化率dVacc/dt。其中,减小密勒电容的主流思路是减小栅极与集电极之间的交叠面积,或直接实现密勒电容的减小,或是通过将栅极集电极电容转换为栅极发射极电容以实现密勒电容的间接减小[8-13]。
基于此,本文在具有场截止层的传统槽栅IGBT 结构的基础上,提出了一种具有多晶硅二极管栅极结构的槽栅IGBT 结构(Poly Silicon Diodes Gate Structure for Trench Gate IGBT,PDG-TIGBT)。该结构通过在沟槽内部引入多晶硅二极管结构,使多晶硅二极管中低掺杂P 型Poly 栅极区域内形成的耗尽电容与原本的栅氧化层电容串联实现更小的密勒电容,同时该耗尽电容的存在可提升开启瞬态过程中的槽栅底部的电位,减小位移电流对栅极的影响,减小开启过程中电压和电流的过冲,增强栅极电阻Rg对dV/dt和dI/dt的控制能力,有效改善IGBT 开启损耗和EMI 噪声之间的折中关系。
1 器件结构和工作机理
图1(a)是场截止层槽栅IGBT(Trench Gate IGBT with Field-Stop Layer,FS-TIGBT)结构的横截面图,图1(b)是本文所提的具有多晶硅二极管栅极结构的槽栅IGBT(PDG-TIGBT)的横截面图。PDG-TIGBT 与FSTIGBT 结构除槽栅结构外均保持一致。为实现PDGTIGBT 的栅极结构,在N+Poly 栅极和槽栅底部之间引入P+Poly 栅极和P-Poly 栅极,其中P+Poly 栅极主要作为N+Poly 栅极和P-Poly 栅极之间的缓冲结构,P-Poly栅极则用于实现多晶硅二极管结构,通过控制P-Poly栅极的掺杂浓度可以使该区域与IGBT 的漂移区区域相互耗尽形成耗尽电容,该耗尽电容一方面可以有效提升开启瞬态过程中的槽栅底部的电位,另一方面与原本的栅氧化层电容串联实现更小的密勒电容。
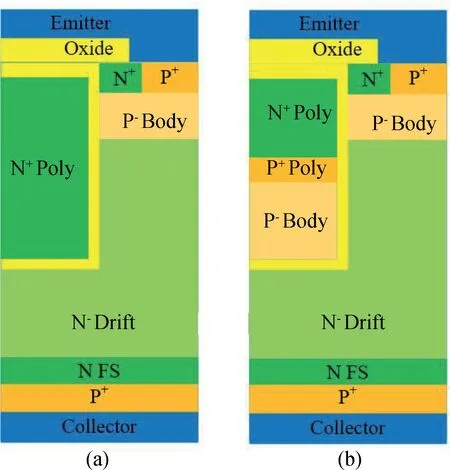
图1 (a)FS-TIGBT 和(b)PDG-TIGBT 的结构横截面图Fig.1 The cross section of the (a) FS-TIGBT and (b) PDG-TIGBT
图2 则展示了PDG-TIGBT 栅极结构的主要工艺制程的步骤。与传统槽栅IGBT 栅极结构相比,PDGTIGBT 需要经过多次P--P+-N+多晶硅层的淀积与刻蚀以形成多晶硅二极管栅极结构。同时,与传统槽栅IGBT 工艺不同的是,为了避免IGBT 其他区域推结、退火、介质层形成等工艺的热过程对P-Poly 栅极掺杂造成影响,本次工艺制程将沟槽的刻蚀、栅氧化层的生长以及Poly 栅极的淀积与掺杂过程安排在场限环、P 型基区、N 型发射区以及P 型接触区的推结过程之后。图2(a)为PDG-TIGBT 的主要掺杂区域如N 型FS 层、N-漂移区、P 型基区、N+发射区和P+接触区的形成结果示意图,其中N 型FS 层作为整个结构的衬底,而N-漂移区采用外延工艺实现。接下来,如图2(b)所示,实现槽栅结构中沟槽的刻蚀和栅氧化层的淀积。下一步则用于实现槽栅内部的多晶硅二极管结构,如图2(c)、(d)和(e)所示,进行P-Poly栅极、P+Poly 栅极和N+Poly 栅极的淀积与刻蚀。最后进行BPSG 介质层的淀积与刻蚀工艺、器件表面的金属化工艺,如图2(f)所示。经过以上几个工艺步骤,PDG-TIGBT 中包含多晶硅二极管栅极结构的正面结构已完全实现。
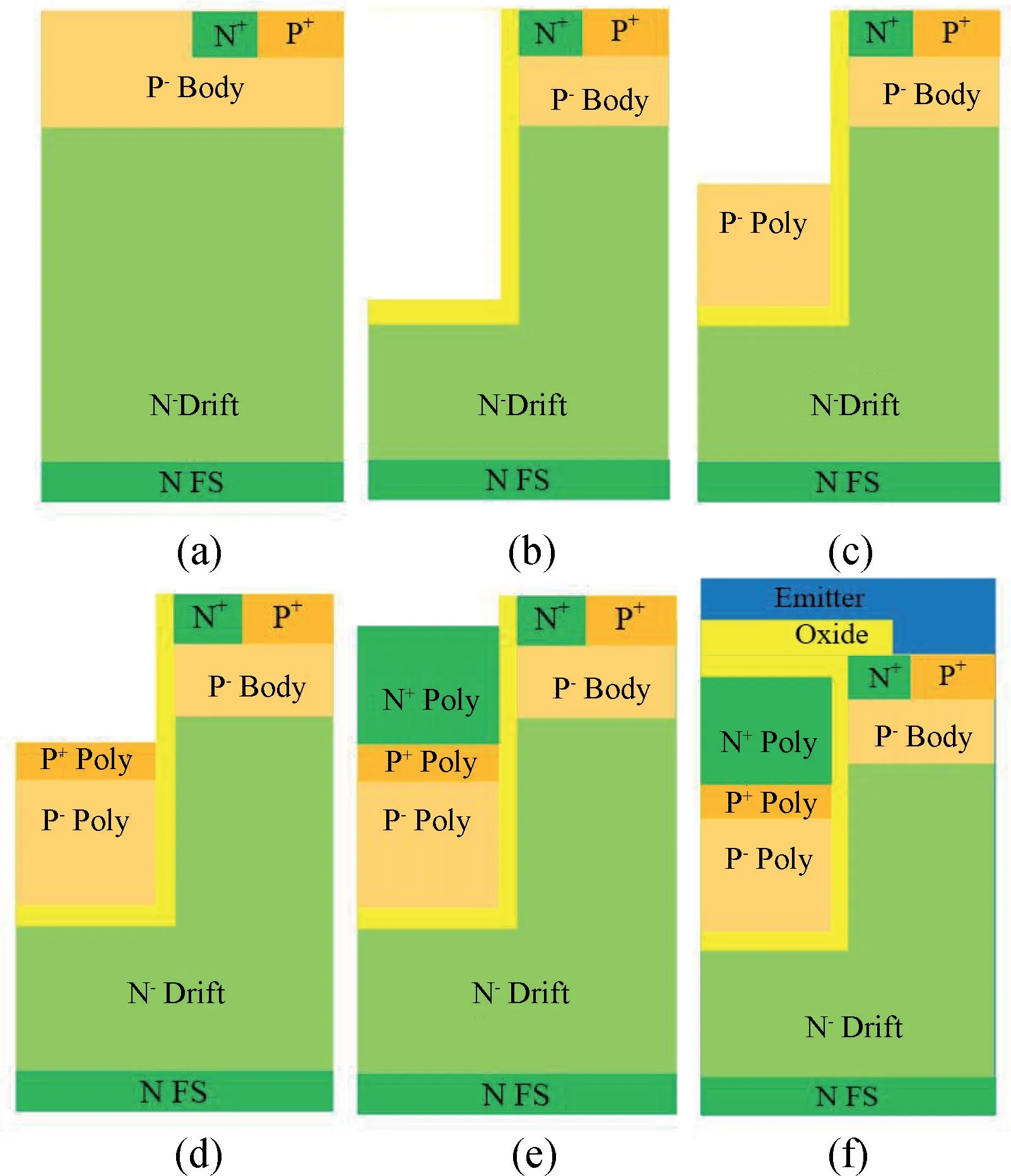
图2 PDG-TIGBT 栅极结构的主要工艺设计步骤。(a)N 型FS 层、N-漂移区、P 型基区、N+发射区和P+接触区的形成;(b)槽栅的刻蚀和栅氧化层的淀积;(c)P-Poly 栅极的淀积与刻蚀;(d)P+Poly 栅极的淀积与刻蚀;(e)N+Poly 栅极的淀积与刻蚀;(f)BPSG 介质层与金属的淀积与刻蚀Fig.2 The major process design of the PDG-TIGBT gate structure.(a) Formation of N FS-layer,N- drift,P-base,N+ emitter and P+ contact;(b) Trench etching and oxide deposition;(c) PPoly deposition and etching;(d) P+ Poly deposition and etching;(e) N+ Poly deposition and etching;(f) BPSG and metal deposition and etching
图3 为简化后的两种结构的电容等效电路示意图。由图3(a)可知,传统FS-TIGBT 的密勒电容仅由栅极与N-漂移区之间的半导体电容CGCOX组成。而由图3(b)可知,本文所提的PDG-TIGBT 结构的密勒电容受到P-Poly 硅栅与N-漂移区之间的耗尽电容的影响可大幅度减小,密勒电容由耗尽电容Cd与CGCOX串联组成。FS-TIGBT 和PDG-TIGBT 两种结构的密勒电容的表达式为:
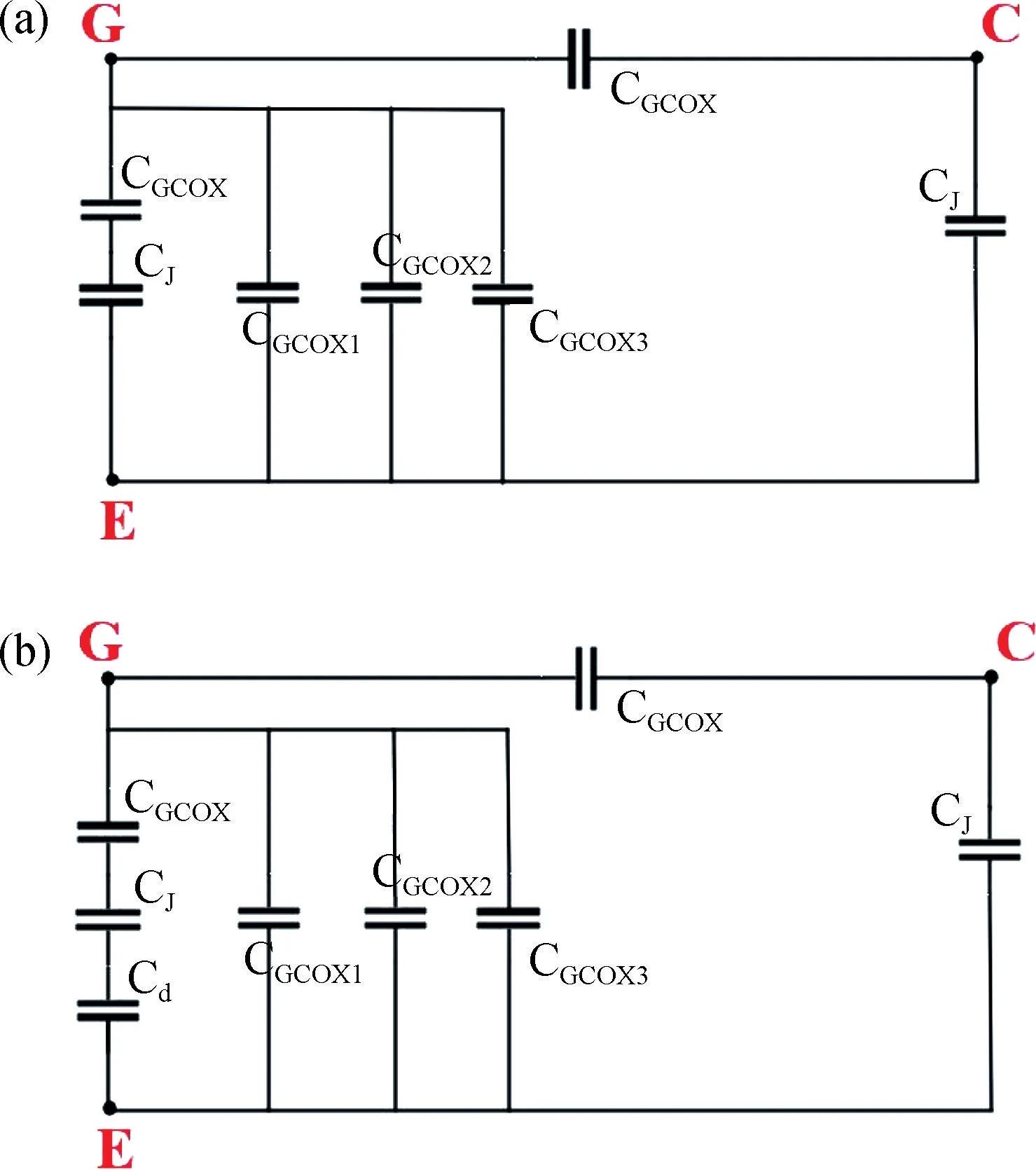
图3 (a)FS-TIGBT 和(b)PDG-TIGBT 电容等效电路Fig.3 The capacitances network of the (a) FS-TIGBT and (b) PDG-TIGBT

Cd的存在可大幅度减小PDG-TIGBT 的密勒电容,通过调节P-Poly 栅极的掺杂改变耗尽电容Cd的大小,从而进一步实现对密勒电容和槽栅附近电势的优化。该结构在密勒电容上的优化一方面可以加快器件的开关速度,减小IGBT 的开关损耗;另一方面,减小密勒电容可以有效减小器件的位移电流Idis,从而减小位移电流对栅极驱动的影响。同时,本结构中的耗尽电容Cd可有效提升槽栅附近的电势Vacc,由于槽栅附近的电势Vacc初始值Vfix会强烈影响开启时的dICE/dt,Vfix越大,空穴在槽栅附近积累的数量越少,致使槽栅附近电势Vacc增长速率变缓,即dVacc/dt减小,从而可以有效减小位移电流Idis对槽栅的影响,减小开启过程中器件的dV/dt和dI/dt,抑制器件的EMI 噪声,实现IGBT的EMI 噪声与开启损耗EON折中关系的进一步优化。
2 结构仿真与数据分析
为验证所提PDG-TIGBT 结构在开启损耗EON与EMI 噪声两者折中关系上的优化,本文利用Sentaurus仿真软件对FS-TIGBT 和PDG-TIGBT 两种结构进行静态特性和动态特性的对比仿真,重点分析两种结构在密勒电容及开关特性上的区别。两种结构的关键结构参数如表1 所列。

表1 FS-TIGBT 和PDG-TIGBT 结构的关键工艺参数Tab.1 Key process parameters of FS-TIGBT and PDG-TIGBT
图4 为两种结构正向阻断特性的对比图,其中图4(a)为两种结构在相同结构参数下的正向阻断电压仿真结果,图4(b)为两种结构在正向阻断状态下沿槽栅侧壁的电场分布对比示意图。由图可知,PDG-TIGBT 的击穿电压略高于FS-TIGBT,同时两种结构的电场峰值均位于槽栅底部拐角处,且FS-TIGBT 结构的电场峰值略大于PDG-TIGBT 电场峰值。该现象的主要原因是在器件的正向阻断过程中,由于PDG-TIGBT 中P-Poly栅极与N-漂移区之间形成耗尽区域,使漂移区内的电场得到进一步的优化,但P-Poly 不同于与发射极相连的屏蔽栅极,该结构仅能较小幅度优化漂移区内的电场分布,实现对阻断能力的小幅度提升。

图4 FS-TIGBT 和PDG-TIGBT 的(a)击穿电压曲线和(b)沿槽栅侧壁的电场分布Fig.4 (a) BVs and (b) electric field along trench gate sidewall of FS-TIGBT and PDG-TIGBT
由于PDG-TIGBT 结构中引入的P-Poly 硅栅与N-漂移区之间在高集电极电压下形成耗尽电容Cd,该电容与原本栅极附近的半导体电容CGCOX串联使结构的密勒电容大幅度降低。图5 为两种结构密勒电容随集电极电压VCE变化曲线的对比示意图,从图中可以看出,PDG-TIGBT 在0~600 V 的集电极电压范围内均小于FS-TIGBT,在小集电极电压范围内改善较小,在大集电极电压范围内改善较为明显。其中,在集电极电压为600 V 时,FS-TIGBT 密勒电容为40.9 pF,PDGTIGBT 密勒电容仅为11.98 pF,本文所提结构的密勒电容减小了70.7%。大集电极电压下密勒电容的大幅度减小可以有效改善开关过程中位移电流对栅极驱动的影响,同时可以有效减小器件的开启损耗,具体的量化效果将由开关特性的仿真结果展示。
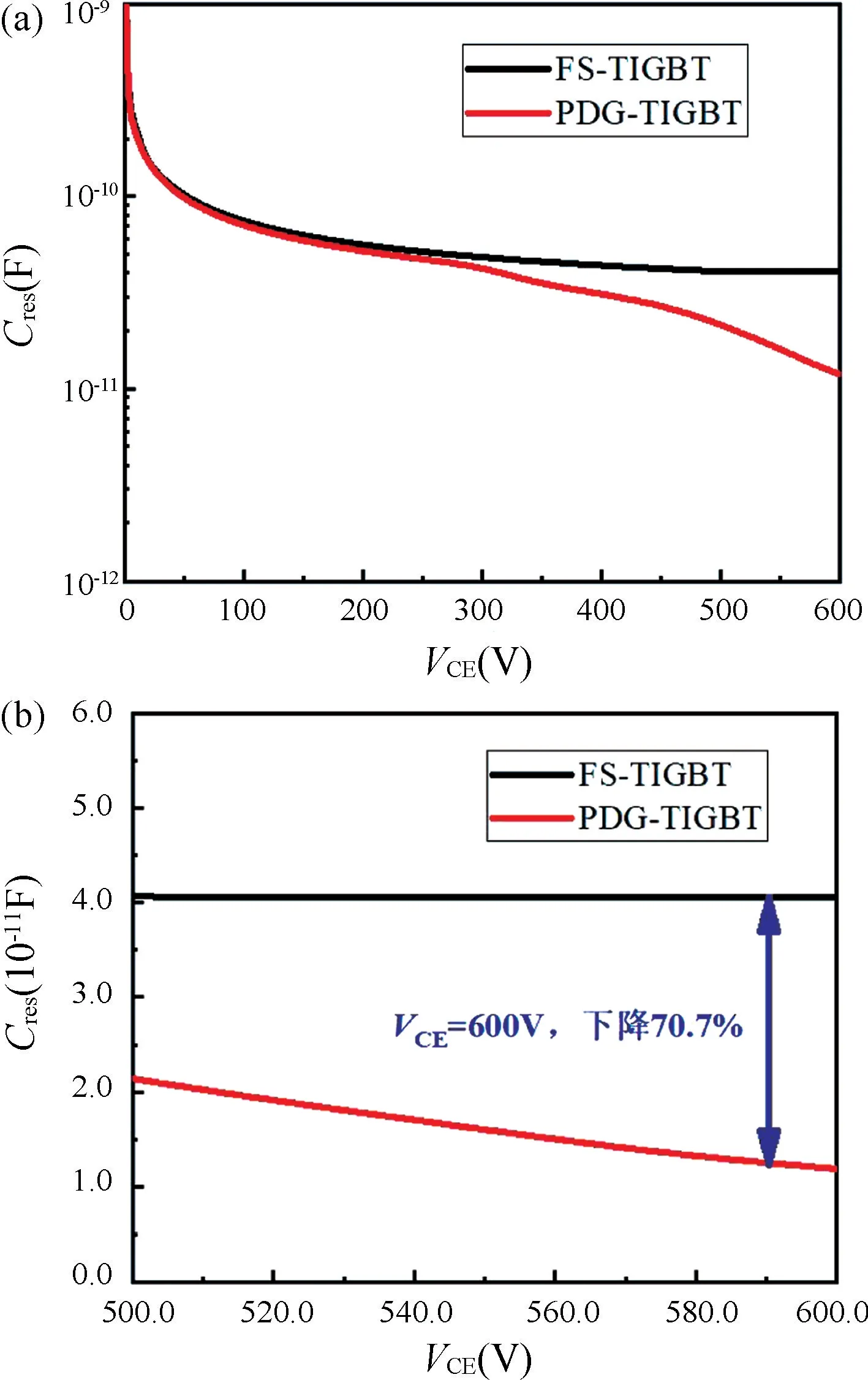
图5 (a)两种结构密勒电容随集电极电压变化曲线;(b)高集电极电压下两种结构密勒电容大小对比Fig.5 (a) Miller capacitance CGC versus VCE;(b) Comparison of Miller capacitance CGC of FS-TIGBT and PDG-TIGBT at high collector voltage
接下来重点分析PDG-TIGBT 对EMI 噪声与开启损耗EON折中关系的改善效果。图6 所示为IGBT 开启特性仿真所采用的感性负载仿真电路,其中负载电流源Iload为40 A,电源电压VCC为600 V,栅极电压范围是0~15 V,栅极电阻Rg为80 Ω,杂散电感LS1和LS2的值分别为50 nH 和30 nH。电路选取硅基的PIN 二极管作为续流二极管FWD,并设置IGBT 与FWD 的面积之比为2 ∶1。

图6 IGBT 感性负载开关电路Fig.6 Circuit schematic with inductive load for IGBT transient turn on analysis
图7 为栅极电阻Rg为80 Ω、负载电流为0.1 倍率的额定电流即Iload为4 A 时,采用如图6 所示的开关电路对FS-TIGBT 和PDG-TIGBT 两种结构进行开启特性及EMI 噪声相关特性的仿真分析。图7(a)显示了两种结构在开启过程中槽栅底部电势Vacc的变化,如图所示,PDG-TIGBT 结构受耗尽电容Cd的影响有效抬升了槽栅底部电势Vacc。图7(b)和(c)则展示了槽栅底部空穴浓度和电势变化率dVacc/dt的波形对比曲线,PDG-TIGBT 结构中Vacc电位的提升使更少的空穴聚集在槽栅附近,从而可以有效减小Vacc的增长速率dVacc/dt。图7(d)通过对比两种结构集电极电流及其变化率的变化曲线进一步展示了PDG-TIGBT 结构在EMI 噪声特性上的优化,如图所示,PDG-TIGBT 结构有效抑制了集电极电流ICE的过冲,并实现了更小的集电极电流变化率dICE/dt。通过对图7 分析可得,由于密勒电容在集电极电压VCE为600 V 时减小70.7%,dVacc/dt最大值从63.4 V/μs 下降到48.5 V/μs,即dVacc/dt(max)减小了23.5%,从而实现了最大dICE/dt从914.4 A/μs 下降到495.9 A/μs,使dICE/dt(max)减小45.8%,同时将ICE过冲由44.1 A 抑制到36.3 A。

图7 小电流下两种结构开启特性对比。(a) Vacc开启波形对比;(b) Vacc和槽栅底部空穴浓度开启波形对比;(c) Vacc和dVacc/dt 开启波形对比;(d)ICE和dICE/dt 开启波形对比Fig.7 Comparison of turn on characteristics of two structures at small current.(a) Comparison of Vacc during turn on period;(b) Comparison of Vacc and hole density at the bottom of trench gate;(c) Comparison of Vacc and dVacc/dt;(d) Comparison of ICE and dICE/dt
图8 对比了负载电流为0.1 倍率的额定电流即Iload为4 A 时,不同栅极电阻Rg下的FS-TIGBT 和PDGTIGBT 两种结构集电极电压VCE和集电极电流ICE的变化曲线,其中Rg取值范围为20~600 Ω。从图中可以看出,不同Rg下的PDG-TIGBT 的集电极电流ICE峰值均低于FS-TIGBT,且随着Rg的增大,PDG-TIGBT 结构下的VCE和ICE的相应变换趋势比FS-TIGBT 的更为明显,即PDG-TIGBT 结构下的VCE和ICE对Rg的变换更为敏感,具有更高的dICE/dt和dVCE/dt的可控性。

图8 1/10 额定电流下不同Rg(20~600 Ω)下(a)FS-TIGBT 和(b)PDG-TIGT 的开启特性曲线对比Fig.8 Simulated turn-on characteristics of (a) FS-TIGBT and the (b) PDG-TIGBT with various Rg(20-600 Ω) at 1/10 rated current
图9 则进一步详细地展示了小电流下两种结构的集电极电流峰值ICE(max)及集电极电流变化率最大值dICE/dt(max)随栅极电阻Rg的变化关系。在20~300 Ω 的典型栅极电阻仿真范围内,相同Rg下PDG-TIGBT 的集电极最大电流ICE(max)平均下降22.1%,集电极电流变化率最大值dICE/dt(max)平均下降71.7%,展现出更强的电流可控性。
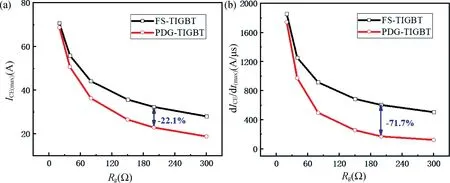
图9 (a)Rg-ICE(max)和(b)Rg-dICE/dt(max)的开启特性折中曲线对比Fig.9 Turn-on trade-off relationships between (a) Rg and ICE(max),(b) Rg and dICE/dt(max) at 1/10 rated current
图10 为开启损耗EON与续流二极管反向恢复时的阳极电压变化率最大值dVKA/dt(max)、开启过程中dICE/dt发生震荡时的最大值dICE/dt(max)之间的折中曲线示意图,两种折中曲线示意图可以较为量化地展示电磁干扰噪声EMI 与开启特性之间的折中关系。其中dICE/dt(max)、dVKA/dt(max)等EMI 噪声相关参数均在0.1倍率的负载电流4 A 下进行仿真,EON则是在额定负载电流40 A 下进行仿真。图10(a)为两种结构的开启损耗EON与集电极电流变化率最大值dICE/dt(max)的折中曲线对比,从图中可以看出,在相同的EON条件下,PDG-TIGBT 对应的dICE/dt(max)相比传统的FS-TIGBT结构减小了84.2%。同时,从图10(b)所示的开启损耗EON与续流二极管FWD 反向恢复电压最大值dVKA/dt(max)的折中曲线对比图中可以看到,在EON保持一致的前提下,PDG-TIGBT 的dVKA/dt(max)下降了44.4%。由上面描述可知,与传统的FS-TIGBT 结构相比,所提PDG-TIGBT 结构在一定程度上优化了dICE/dt、dVKA/dt与EON之间的折中关系,有效地改善了器件开启特性与EMI 噪声特性之间的矛盾关系。

图10 (a)EON-dICE/dt(max)和(b)EON-dVKA/dt(max)的折中曲线对比Fig.10 Trade-off relationships between (a) EON and dICE/dt(max),(b) EON and dVKA/dt(max)
3 结论
本文提出了一种可有效改善IGBT 的开启损耗EON和EMI 噪声折中关系的具有多晶硅二极管栅极结构的槽栅IGBT(PDG-TIGBT)结构,并基于传统槽栅IGBT工艺提出了适用于所提结构的工艺制程。对比于传统FS-TIGBT 结构,在栅极电阻Rg为80 Ω、集电极电压VCE为600 V 的仿真条件下,所提PDG-TIGBT 结构的密勒电容CGC比FS-TIGBT 降低了70.7%,槽栅底部电位Vacc则抬升了约146%。
基于耗尽电容Cd导致的密勒电容CGC的减小及槽栅底部电位Vacc的抬升,PDG-TIGBT 可以有效抑制位移电流的产生。仿真结果显示,在开启瞬态槽栅底部电位增长速度dVacc/dt减小23.5%,集电极电流变化速率dICE/dt(max)减小45.8%,ICE过冲由44.1 A 抑制到36.3 A。同时,通过仿真不同栅极电阻Rg下的两种结构的开启特性曲线发现,PDG-TIGBT 结构的集电极电压VCE和集电极电流ICE对栅极电阻Rg的变化更为敏感,即具有更高的dICE/dt和dVCE/dt可控性。更重要的是,PDG-TIGBT 结构实现了开启损耗EON与EMI噪声折中关系的进一步优化,仿真结果显示,在EON保持一致的前提下,PDG-TIGBT 的dICE/dt(max)减小了84.2%,dVKA/dt(max)下降了44.4%。
