一种高集成双向隧穿场效应晶体管
2022-09-02杨宝新
杨宝新,刘 溪
(沈阳工业大学信息科学与工程学院,沈阳 110870)
1 引言
集成电路设计的主要方向是实现更高的集成度以及更好的性能,而同时,缩减制造成本也是芯片厂商所喜闻乐见的。多栅极场效应晶体管在近年来是业界的主流[1-2]。采用矩形栅极结构的新型晶体管(RGUC-FET)设计,可以实现很好的正反向以及亚阈值性能[3],但在小尺寸下实现掺杂工艺成本高昂[4-5]。结合肖特基势垒晶体管无掺杂以及隧穿晶体管的低亚阈值摆幅的优点设计出的深肖特基势垒场效应晶体管(HSB-BTFET)可以实现不错的器件性能[6-8]。相对来说,器件的水平面积是可以进一步优化的。在此提出一种高集成双矩形栅极U形沟道双向隧穿场效应晶体管(DRGUC-BTFET)。相比于RGUC-FET以及HSB-BTFET,能够使用更小的水平芯片面积而做到更好的直流特性。
2 器件结构
DRGUC-BTFET的结构如图1所示。在设计上,栅极围绕在结构的顶部,硅体被刻蚀成U形结构;通过对硅片两侧的再次刻蚀,将源漏电极插入U型硅片两侧垂直部分的一定高度,在源漏电极与沟道接触位置形成深肖特基势垒来达到减小反向泄漏电流的目的;栅极和辅助栅极之间通过绝缘层进行隔离;辅助栅级生成在衬底氧化层的顶部,围绕水平沟道和部分垂直沟道。DRGUC-BTFET包含U型沟道和矩形环绕的主控栅极与辅助栅极,有着左右对称的结构。这种结构具有通过增加纵向沟道高度来增加有效沟道长度的特性,矩形环绕的主控栅极与矩形环绕的辅助栅极对源漏区与沟道实现完全包裹,控制能力相比于先前的栅极结构有较大增强。最主要的是,环形栅极结构在不改变电学特性的基础上,大大降低了器件的工艺难度及水平面积,降低了生产成本。
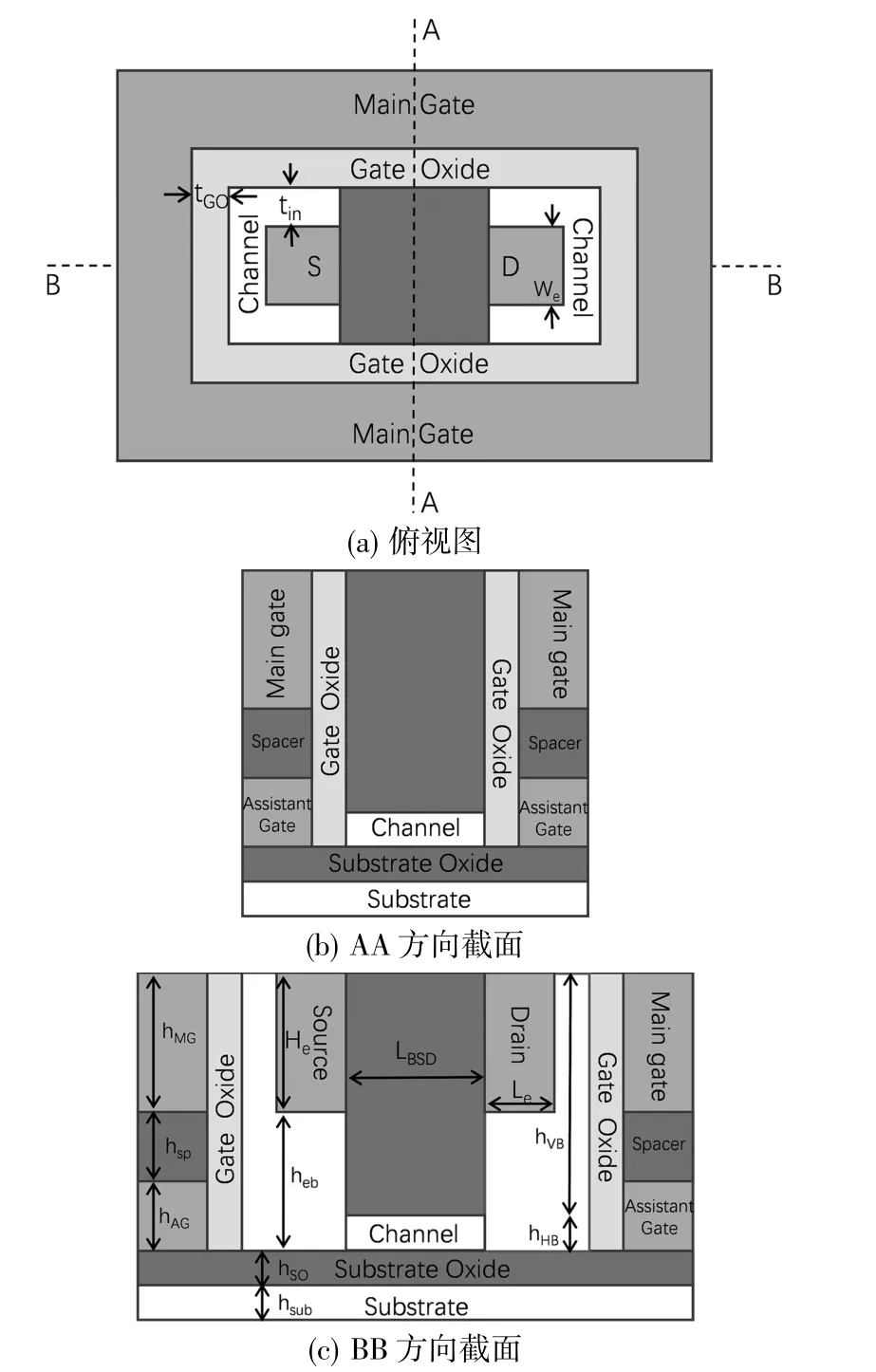
图1 DRGUC-BTFET结构图
图中,hMG为主控栅极的高度;hAG为辅助栅极的高度;hSP是主控栅极与辅助栅极之间的隔离层高度;LBSD是源极电极和漏极电极之间的距离;tGO是栅极氧化层的厚度;hVB和hHB分别是垂直和水平沟道的高度;Le是源/漏电极的长度;he是源/漏电极的插入高度;heb是源/漏电极和沟道底部之间的距离。
U形沟道用于增加有效沟道长度,减小短沟道效应。主控栅极控制靠近源区和漏区的沟道的上部垂直部分,辅助栅极控制沟道的下部垂直部分和水平部分。
3 对比分析
在此将提出的DRGUC-BTFET与同一课题组先前提出的HSB-BTFET以及RGUC-FET的性能进行比较。如图2所示为HSB-BFET结构图。其中W为沟道宽度,Li为源/漏电极到中心的辅助栅极的本征沟道距离,LSD为源漏电极的宽度,LSD为源漏电极的长度,ttunnel为发生隧道效应位置的本征硅的厚度,tox为栅极氧化层的厚度,LAG为辅助栅极的长度,H为整体沟道的高度。
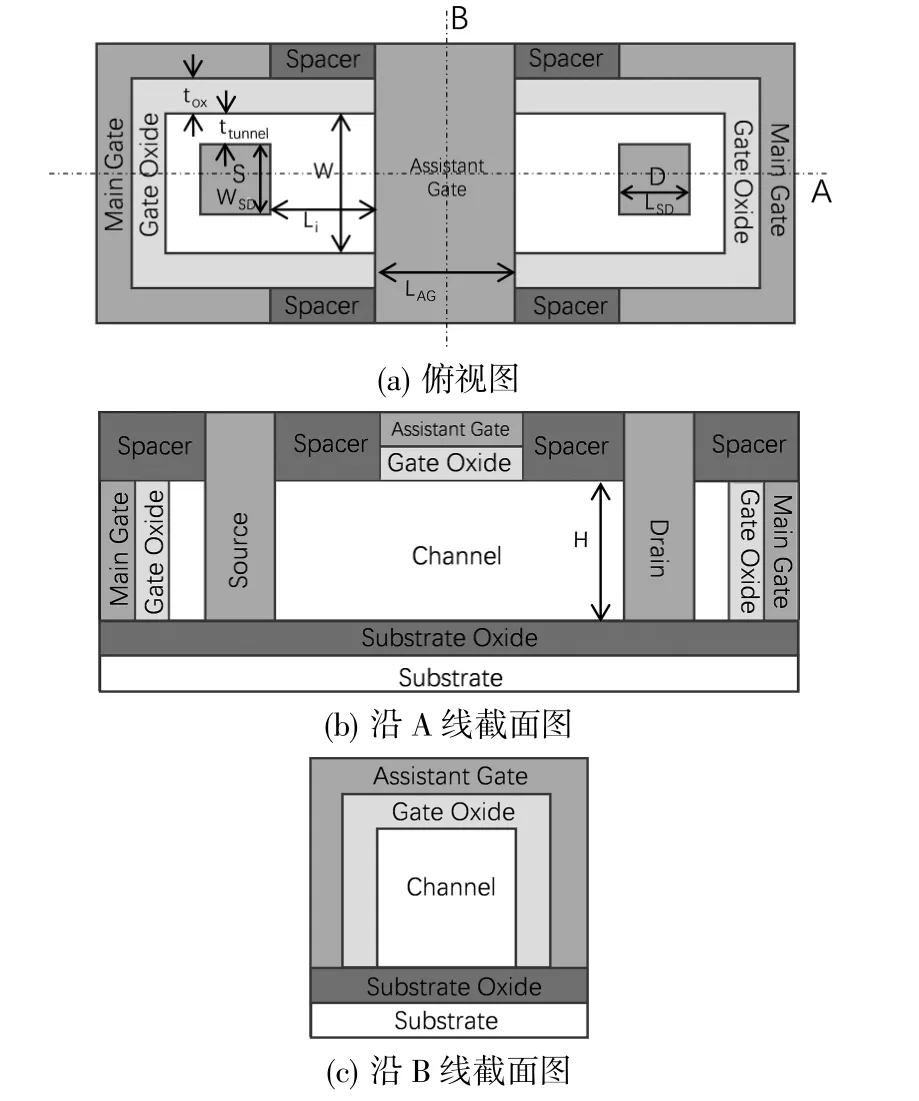
图2 HSB-BTFET结构图
如图3所示为RGUC-FET的结构图。其中hGATE为主控栅极的高度,tbh为垂直部分的体硅高度,tbv为水平方向上的体硅的长度,tsp为隔离形成U形沟道的隔离层的厚度,W为垂直部分沟道的宽度,tox为栅极氧化层厚度,tgate为主控栅极厚度。

图3 RGUC-FET结构图
如图4所示为DRGUC-BTFET、HSB-TFET以及RGUC-FET之间的传输特性比较。具体器件参数在图中给出。

图4 三种FET结构的传输特性曲线比较
从图中可以看出,DRGUC-BTFET实现了比RGUC-FET更好的正向导通特性和更陡峭的亚阈值斜率。更值得说明的是,DRGUC-BTFET在栅极电压反向偏置时具有更低的漏电流,从而会有更低的静态功耗和更低的反向漏电流。本设计可以实现更低的亚阈值摆幅,同时将器件的水平面积减小到相当于RGUC-FET的四分之一,且无需掺杂工艺;相比于HSB-BTFET,也可以实现更好的直流特性,同时将水平面积减少到约十分之一。性能提升的主要原因在于DRGUC-BTFET的栅极和辅助栅极之间的隔离距离增加到了10nm,两个栅极相互影响变得很小。如图5所示为截止状态下DRGUC-TFET的垂直沟道部分的二维电场强度分布以及空穴浓度分布图,此时栅极电压为-0.8V。
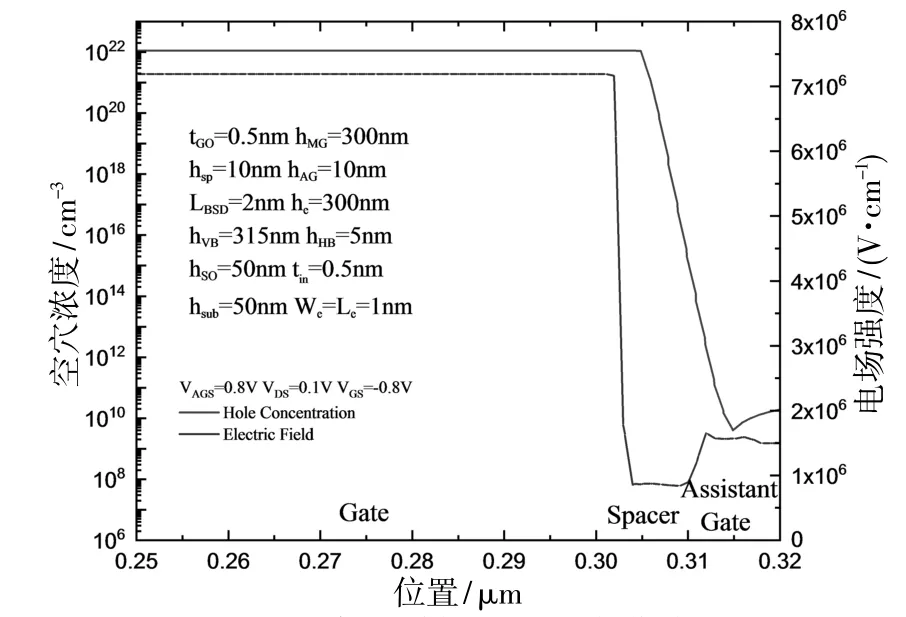
图5 垂直沟道部分电分布曲线图
从图中可以看出,栅极与辅助栅极之间区域的最强电场强度小于1×106V/cm。当栅极电压反向偏置时,垂直沟道的上部分电场强度很高,在强电场的激发下产生大量载流子,但在主控栅极与辅助栅极隔离层部分的电场强度以及空穴浓度都大大降低。此区域为隔离区域,由绝缘材料组成,并没有强大的电势差来发生大量的隧穿。相对于沟道的其他部分,隔离层的空穴浓度要低的多,此处的沟道相当于一段电阻很大的区域。
DRGUC-BTFET金属电极部分与沟道形成的高肖特基势垒完全阻断了激发的电子从源极进入沟道的流动,在关断状态时源极与沟道之间得到很强的电阻。通过充分利用纵向空间,保持栅极和辅助栅极之间合理的距离,减小主控栅极与辅助栅极相互间的电场影响。同时,足够长的隔离区对减小反向泄漏电流也有不小的助益,可以防止由带带隧穿引起的能带弯曲。对于RGUC-FET和HSB-BTFET器件来说,为提高集成度,漏、栅电极之间的距离不能太大,这将导致由于带带隧道效应产生电子空穴对,空穴会直接流向源极形成持续电流,导致器件静态功耗增加。
对于所设计的DRGUC-BTFET,还有阻碍带带隧穿漏电流的另一道防线。以N型DRGUC-BTFET为例,在漏极附近发生带带隧穿效应产生电子空穴对时,电子会在正向偏置漏极的作用下流向漏极,施加到辅助栅上的正电压引起的电场效应,会排斥空穴,并阻止空穴通过水平沟道,从而显着抑制由带带隧道效应产生的电子空穴对形成的连续电流。
这三种FET的水平沟道总电流密度分布对比情况如图6所示。观察截止状态下水平沟道硅体中的二维电流密度分布,可见DRGUC-BTFET在源极区附近的空穴浓度相比于其他器件来说要低得多,未掺杂区的空穴浓度也很低,源极电阻很大,源极接触与硅体之间的界面上形成肖特基势垒,因此在水平电流密度方面,DRGUC-BTFET比RGUC-FET以及HSB-TFET都低得多。同时也可看到,与另外两种器件相比,DRGUC-BTFET可以实现更低的静态功耗。考虑到所提出的DRGUC-BTFET还具有更高的正向导通电流驱动,因此,Ion/Ioff比也得到了提高。
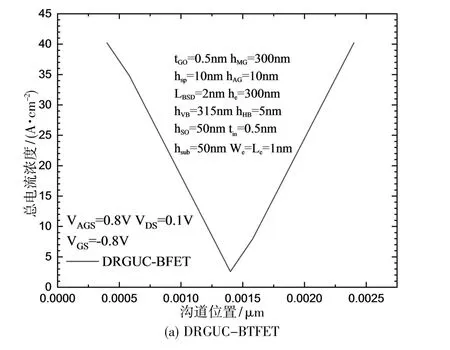
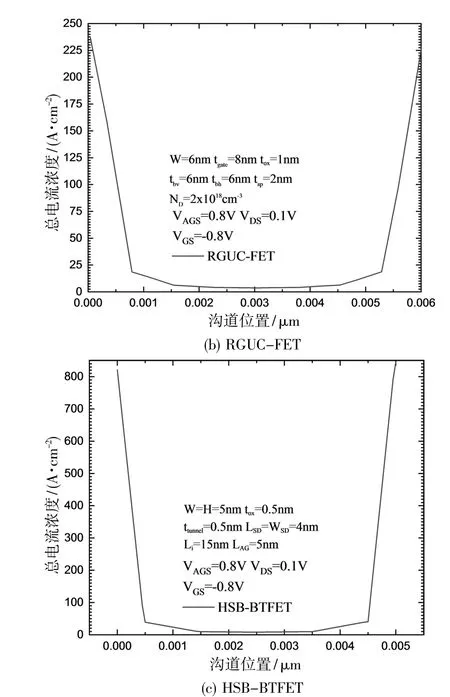
图6 三种FET的水平沟道总电流密度分布对比
4 结束语
DRGUC-BTFET作为一种高度集成的双矩形栅极U形沟道双向隧穿场效应晶体管被提出,在现有研究成果基础上有新的改进。其源漏电极距离的减小不会导致器件性能的显着下降,同时由于结构的改进,器件的水平面积有了进一步的明显减小,因此有利于实现更高的集成度。通过将其传输特性与之前研究中的RGUC-FET以及HSB-BTFET做出比较,验证了在反向偏置关断状态下,新设计实现了更好的正向导通电流和更低的漏电流,多方面证明新设计DRGUC-BTFET器件的技术价值。
