高负偏光照稳定性的溶液法像素级IZTO TFT*
2022-07-22荆斌徐萌彭聪陈龙龙张建华李喜峰
荆斌 徐萌 彭聪 陈龙龙 张建华 李喜峰†
1) (上海大学材料科学与工程学院,上海 200072)
2) (上海大学,新型显示技术及应用集成教育部重点实验室,上海 200072)
1 引言
近年来,非晶氧化物薄膜晶体管由于具有高迁移率、低漏电率及大面积制造兼容等特点已广泛应用于平板显示产业[1,2].目前产业广泛使用磁控溅射制备非晶氧化物薄膜[3].随着印刷工艺的发展,迫切需要开发溶液技术氧化物薄膜晶体管(thinfilm transistor,TFT)[4,5],然而溶液法制备的非晶氧化物TFT 普遍存在偏压稳定性差,特别是光照负偏压稳定性,阻碍其实际应用[6].常用的TFT 结构主要有刻蚀阻挡层型(etch stopper layer,ESL)[7]和背沟道刻蚀(back-channel etched,BCE)结构[8].BCE 结构简单、制程步骤少、成本低,但要实现BCE结构,必须解决非晶氧化物有源层与源漏电极的刻蚀选择比低的问题.我们以前的研究发现,非晶氧化物铟锌锡氧化物(indium-zinc-tin-oxide,IZTO)与传统源漏电极Mo/Al 的刻蚀选择比高,容易实现BCE 结构TFT[9].此外,溶液法 TFT 的研究主要集中在开发新材料、提升迁移率等方面,但对应力稳定性,尤其是光照负偏压稳定性(negative bias illumination stress,NBIS)的研究较少[10-12].金属氧化物带隙中电离态氧空位(或与氧相关的缺陷态)的产生是氧化物TFT 光照不稳定的原因[13,14],为了抑制氧化物TFT 在光照负偏下的不稳定,需降低由氧空位引起的类施主态的密度,目前主要有两种办法:一是掺入合适的元素来抑制氧空位的产生[15,16];二是通过表面处理,如热退火处理[17]、等离子体处理[18,19]和紫外光(ultraviolet,UV)辐照处理[20].N2O 等离子体处理也是目前采用比较多的表面处理方式,因为通常TFT 采用PECVD 生长SiO2作为钝化层,可以在生长SiO2前原位进行N2O等离子体表面处理,可减少额外的处理步骤,Hsieh等[21]认为N2O 等离子处理会钝化铟镓锌氧化物(indium-gallium-zinc-oxide,IGZO)薄膜,从而改善光照下的稳定性;在我们之前的研究中,IGZO薄膜经过UV 辐照处理后,IGZO TFT 在光照偏压下表现出优异的稳定性[22].而溶液法制备的氧化物薄膜与磁控溅射制备的薄膜相比,其氧相关的缺陷态更多[23],但很少有研究将等离子体用来处理溶液法制备的氧化物薄膜以解决溶液法制备的TFT的光照偏压稳定性问题,因此研究表面处理对溶液法制备氧化物TFT 的稳定性至关重要.同时,目前研究的溶液法氧化物TFT 多为单个器件[24-26],而用于显示驱动的TFT 均为像素阵列,与单个器件性能有着显著的差异,为了满足显示驱动的需求,迫切需要研究溶液法像素级TFT 阵列的光照负偏压稳定性.基于此,本文采用溶液法制备BCE 结构的像素级IZTO TFT 阵列,并利用N2O 等离子体处理控制IZTO 的氧相关缺陷态,研究其偏压稳定性,特别是光照偏压稳定性,达到显示驱动的要求.
2 实 验
2.1 溶液配制
本文TFT 像素阵列绝缘层和有源层为溶胶法制备的HAO 和IZTO 薄膜.将一定量的八水氧氯化铪(HfCl2O·8H2O,98%,Sigma-Aldrich)和仲丁醇铝(Al(OC4H9)3,99%,Alfa-Aesar)分别溶解在乙二醇甲醚中,Hf 和Al 的比例为2∶1,在室温中搅拌至澄清,得到HAO 前驱体溶液.将五水合氯化锡(SnCl4·5H2O,98%,Sigma-Aldrich)、二水合醋酸锌(Zn(OC2H4)2·8H2O,98%,Sigma-Aldrich)和六水合硝酸铟化铟(ln(NO3)3·6H2O,99.99%,Sigma-Aldrich)溶于乙二醇甲醚中,其中In:Zn∶Sn=4∶1∶4,并搅拌至澄清,然后加入乙醇胺作为稳定剂,形成IZTO 前驱体溶液.接着将配制好的HAO和IZTO 溶液在70 ℃水浴环境中搅拌2 h,结束后再在室温下进行24 h 老化.两者溶液溶度均为0.3 mol/L.
2.2 薄膜及器件制备
首先,在玻璃基板上溅射Al/Mo 叠层结构作为栅极并图形化.然后,将HAO 溶液旋涂到栅极上,在270 ℃下退火1 h,重复5 次.紧接着在HAO薄膜上制备有源层IZTO 薄膜,薄膜再经过300 ℃/1 h 退火处理,重复两次达到50 nm 的厚度.其次湿法刻蚀IZTO 薄膜,形成沟道图案,并在450 ℃后退火.随后220℃下进行N2O 等离子体处理30 s.然后溅射源漏导电层,通过湿法刻蚀进行图形化,形成源极和漏极,长宽比为18∶8.最后,通过等离子增强化学气相沉积(plasma enhanced chemical vapor deposition,PECVD)沉积一层200 nm 的SiO2保护层,并在空气氛围中进行300 ℃退火2 h,图1 给出了制备的IZTO TFT 器件示意图及4.5英寸的像素阵列显微镜图像.
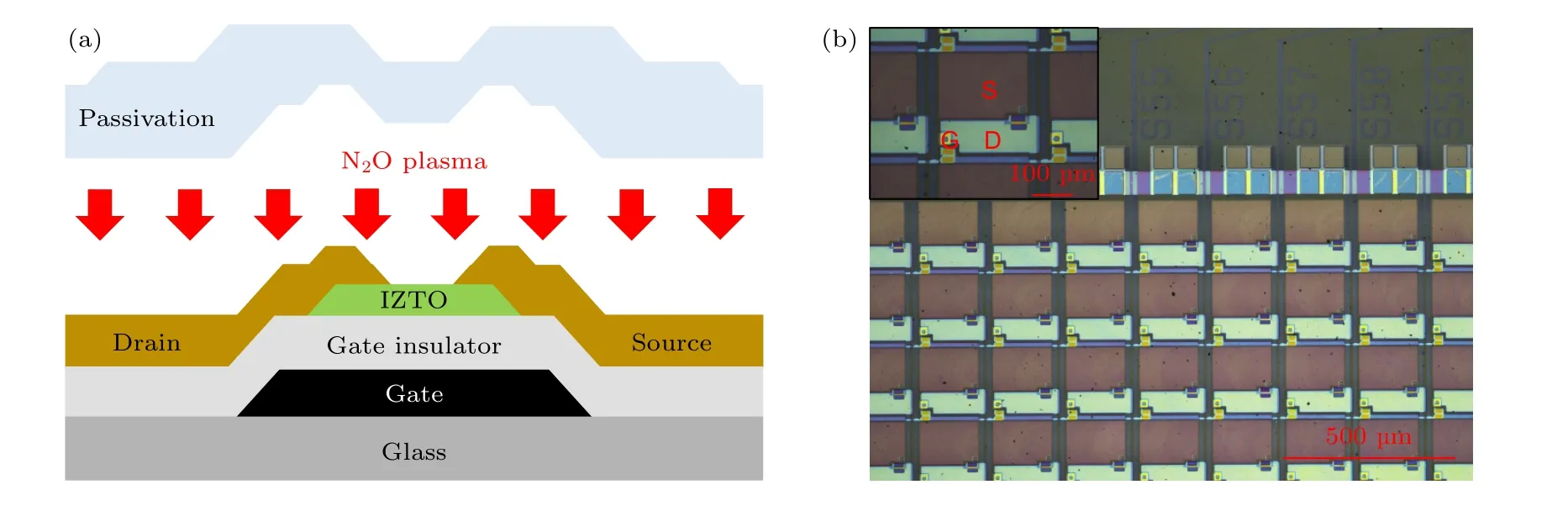
图1 IZTO TFT (a) 器件截面示意图;(b) 像素阵列10 倍显微镜图像(插图为50 倍)Fig.1.(a) Schematic cross section of an IZTO TFT;(b) microscope images of the IZTO TFTs array with magnification 10 times(Inset shows 50 times).
2.3 IZTO 薄膜表面形貌表征和TFT 器件电学性能
使用原子力显微镜(AFM,Nanonavi SPI-400SPM)观察IZTO 薄膜表面形貌;使用X 射线光电子能谱(XPS,ThermoESCALB250XL)分析IZTO 薄膜的化学成分;采用半导体特性分析系统(4200-SCS,Keithley)测试器件的转移曲线、输出曲线、偏压稳定性;光照偏压稳定性照射光源为10000 lux 的LED 背光源.
3 结果与讨论
图2 给出了有无N2O 等离子处理的IZTO 薄膜AFM 图(2 μm×2 μm).无处理和N2O 处理后IZTO薄膜的均方根粗糙度(root mean square,RMS)分别为0.55 和0.26 nm,经N2O 处理后IZTO 薄膜表面变得更光滑,光滑的IZTO 薄膜表面有利于在有源层和钝化层之间形成良好的界面,从而增加器件的稳定性、减少亚阈值摆幅和提高载流子迁移率[27].
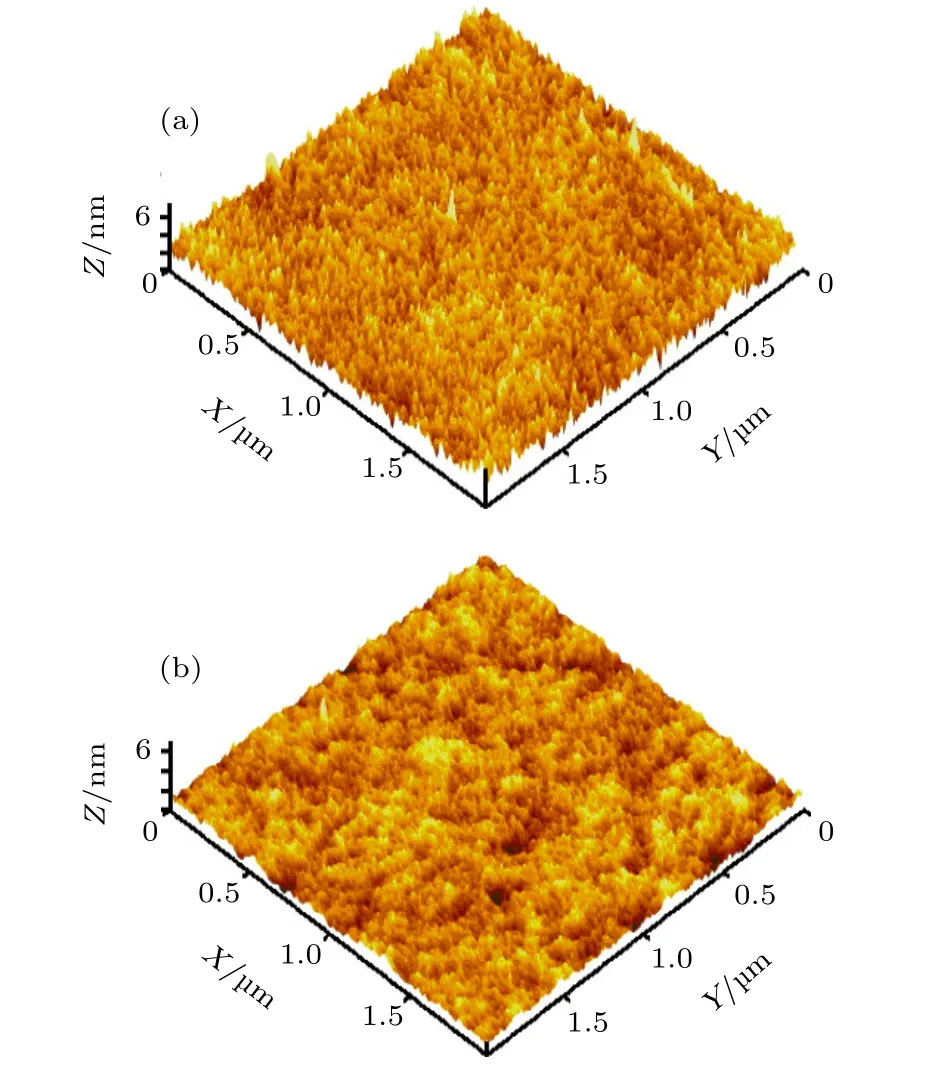
图2 IZTO 薄膜AFM 图 (a) 无处理;(b) N2O 等离子体处理Fig.2.AFM images of the IZTO film:(a) without N2O plasma treatment ;(b) with N2O plasma treatment.
图3(a)给出了IZTO TFT 在黑暗环境下的传输特性曲线,插图为探针测试实物图,表1 记录了从图3(a)曲线中提取的性能参数.与未经处理的IZTO TFT 相比,经过N2O 等离子体处理的IZTO TFT表现出优异的电学性能,阈值电压(Vth)从—0.5 到0.1 V,饱和迁移率(μsat)从29.12 到51.52 cm2·V—1·s—1,亚阈值摆幅(SS)从204 到137 mV·dec—1.无N2O 等离子处理的IZTO TFT 的Vth较负归因于在PECVD沉积SiO2钝化层过程中产生了额外的陷阱状态[28].当对有源层进行N2O 等离子处理时,背沟道附近会形成富氧区,可有效防止SiO2沉积过程中对背沟道的损坏,从而使得Vth正移[29].迁移率的增加和SS 的减少是由于经过N2O 等离子体处理的IZTO薄膜缺陷态密度减少,较高的金属键密度和较低的缺陷会使得电子通过重叠金属s 轨道时具有更好的电子传导路径[30].图3(b)和图3(c)给出了有无N2O 等离子体处理IZTO TFT 的输出特性曲线.经N2O 等离子体处理和无处理的IZTO TFT 的饱和电流分别110 和82 μA,可见经过处理后的IZTO TFT 表现出更高的电流水平.在较低栅极电压范围内,都表现为线性关系,电流也没发生阻塞现象,这说明IZTO TFT 的有源层IZTO 和源漏电极间均形成良好的欧姆接触[24].

表1 有无N2O 等离子体处理的IZTO TFT 性能对比Table 1.Device performance comparison of IZTO TFT without and with N2O plasma treatment.

图3 (a) 有无N2O 等离子体处理的IZTO TFT 转移曲线;(b) 无处理的IZTO TFT 输出曲线;(c) N2O 等离子处理的IZTO TFT 输出曲线Fig.3.(a) Transfer characteristics of an IZTO TFT without and with N2O plasma treatment;output characteristics of an IZTO TFT (b) without and (c) with N2O plasma treatment.
为了分析有无N2O 等离子处理的IZTO 薄膜中氧相关化学位移的变化,进行了O 1s XPS 分析,其化学位移如图4 所示.以碳1s 峰(284.6 eV)对XPS 谱进行校准,对数据进行高斯拟合,可以将其分解为3 个峰,对应的能级分别约为529.9,531.2和531.8 eV.位于529.9 eV 附近的峰为金属氧化物键,位于531.2 eV 附近的峰为与晶格缺陷有关的氧原子,位于531.8 eV 附近的峰为与金属氢氧化物等有关的氧原子[31].可以看出,经过N2O 等离子处理后,金属氧化物键的峰强度从47.17%增加到57.79%,氧空位的峰强度从27.42%降低到19.43%.这些结果表明,N2O 等离子处理可以在背沟道附近形成富氧区域,使得氧相关缺陷减少,同时富氧区的形成也可以有效地防止SiO2沉积过程中造成的损坏,并产生更好的电性能.

图4 IZTO 薄膜O 1s XPS图谱 (a) 无处理;(b) N2O等离子体处理Fig.4.XPS of O 1s spectra on the surface of IZTO film (a)without and (b) with N2O plasma treatment.
图5(a)和图5(c)分别为有无N2O 等离子体处理后IZTO TFT 在10000 lux (LED 背光源)光照下施加VGS=+5 V 的偏压测试,测试时间为3600 s.随着光照时间的增加,在光照正偏压(positive bias illumination stress,PBIS)下Vth发生正向偏移,分别偏移了0.04 和0.02 V,这基本没有发生漂移,主要是因为在光照下,氧空位(VO)会电离产生电子,在去除光照后,这些电子不会完全和电离态的VO复合,留在导带上,弥补了被界面捕获的电子[32].图5(b)和图5(d)为有无N2O 表面等离子体处理后IZTO TFT 在NBIS 下的稳定性,无N2O 等离子处理的IZTO TFT 在NBIS 下Vth逐渐向负方向移动,3600 s 后偏移了0.3 V,如图5(e)所示.在之前的报告中,NBIS 诱导的Vth偏移主要是在光照射下,使得中性态的VO电离[33],IZTO 薄膜中电离态的氧空位在负偏压作用下移动到IZTO/HAO 界面处,使得Vth发生负漂.在N2O 表面等离子处理后,ΔVth降低到0.1 V,表明N2O 有助于减少的形成,图5(f)为经过N2O 表面等离子体处理后的IZTO 薄膜的能带图,经过N2O 表面等离子处理后表面处于富氧状态,氧原子填充了氧空位,降低了中性VO的密度.为了更好地理解N2O 等离子体处理对IZTO 表面的影响,我们制作了一个示意图,如图6 所示.在N2O表面处理之后,氧空位被氧自由基钝化,从而形成更多的金属键,使得IZTO 薄膜表面更加致密,从而使得IZTO TFT 表现出了较好的稳定性,这表明对IZTO 有源层表面进行N2O 表面等离子体处理可以改善IZTO TFT 的光致不稳定.
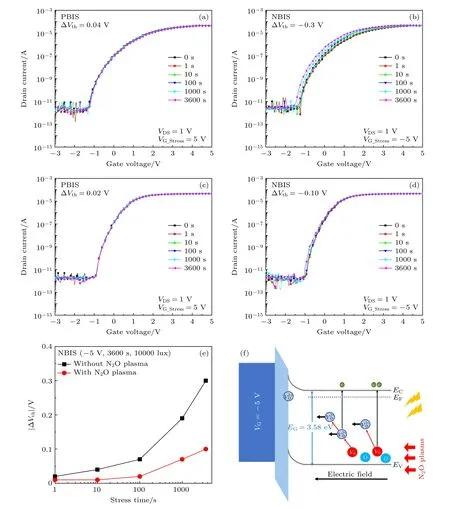
图5 IZTO TFT 的PBIS 和NBIS 稳定性 (a) 和(b) 为无处理,(c) 和(d) 为N2O 等离子体处理;(e) 阈值电压随偏压时间的变化;(f) N2O 等离子体处理后IZTO TFT 的能带图示意图Fig.5.Stability for IZTO TFT:Stability of (a) untreated and (c) treated PBIS;stability of (b) untreated and (d) treated NBIS;(e) plots of voltage shift versus time;(f) band diagram of IZTO TFT with N2O plasma treatment.

图6 IZTO 薄膜的原子模型 (a) 无处理;(b) N2O 等离子处理Fig.6.Atomic model of the IZTO film (a) without and (b) with N2O plasma treatment.
阵列中各个器件的负偏压光照稳定性对显示至关重要,为此,对各个位置测试了负偏压光照稳定性,分别为阵列左上、右上、左下和右下的器件,光照负偏压稳定性如图7 所示.经过3600 s 负偏压光照稳定性测试之后,阈值电压分别漂移了—0.15,—0.13,—0.19 和—0.2 V,符合负偏压光照稳定性小于0.2 V 的条件,满足目前显示的要求.中间器件相对周围器件稳定性较好的原因是,在旋涂IZTO 薄膜的时候,外围的厚度均匀性没有中间的好,在固化薄膜过程中,其表面可能引入更多的缺陷态.

图7 阵列中各个位置器件负偏压光照稳定性分布 (a) 左上;(b)右上;(c) 中间;(d)左下;(e) 右下;(f) 阵列整体负偏压光照稳定性Fig.7.Illumination stability distribution of devices under negative bias in the array:(a) Top-left;(b) top-right;(c) middle;(d) bottom-left;(e) bottom-right;(f) the negative bias illumination stress stability of the array.
同时,为了评估像素阵列中器件的性能均匀性,按照一定分布选取了20 个器件进行了转移曲线测试,从中提取了相关电学参数,如图8 所示.经N2O 等离子体处理的器件迁移率平均值为(50.75 ± 5.06) cm2·V—1·s—1,亚阈值摆幅为(141.2 ±14.16) mV·dec—1,无处理的器件迁移率平均值为(27.25 ± 5.29)cm2·V—1·s—1,亚阈值摆幅为(218.9 ±16.42) mV·dec—1.

图8 20 个器件迁移率和亚阈值摆幅分布 (a),(b) N2O 等离子体处理;(c),(d) 无处理Fig.8.Histogram of threshold voltage and mobility for the IZTO TFTs:(a),(b) With N2O plasma treatment;(c),(d) without N2O plasma treatment.The data are collected from 20 TFTs.
4 结论
本文采用溶液法制备了高光照负偏压像素极IZTO TFT,并研究了其光照负偏压稳定性.对比了N2O 等离子体处理与未处理的器件性能,IZTO TFT 的开关电流比为2.3×107、阈值电压为0.1 V、亚阈值摆幅为137 mV·dec—1、饱和迁移率为51.52 cm2·V—1·s—1,且光照负偏压稳定性低于0.2 V.器件的优异性能主要是由于等离子处理后IZTO 薄膜表面变得更加光滑,表面氧相关缺陷态降低,M—O 键的密度增加.结果表明,制备的4.5 英寸的IZTO TFT 像素阵列满足显示驱动需求.
