高温对MOSFET ESD 防护器件维持特性的影响*
2022-07-19李明珠蔡小五曾传滨李晓静李多力倪涛王娟娟韩郑生赵发展
李明珠 蔡小五 曾传滨 李晓静† 李多力 倪涛 王娟娟 韩郑生 赵发展
1) (中国科学院微电子研究所,硅器件中心重点实验室,北京 100029)
2) (中国科学院大学,北京 100049)
静电放电 (electro-static discharge,ESD) 防护结构的维持电压是决定器件抗闩锁性能的关键参数,但ESD 器件参数的热致变化使得防护器件在高温环境中有闩锁风险.本文研究了ESD 防护结构N 沟道金属-氧化物-半导体(N-channel metal oxide semiconductor,NMOS)在30—195 ℃的工作温度下的维持特性.研究基于0.18 µm 部分耗尽绝缘体上硅工艺下制备的NMOS 器件展开.在不同的工作温度下,使用传输线脉冲测试系统测试器件的ESD 特性.实验结果表明,随着温度的升高,器件的维持电压降低.通过半导体工艺及器件模拟工具进行二维建模及仿真,提取并分析不同温度下器件的电势、电流密度、静电场、载流子注入浓度等物理参数的分布差异.通过研究以上影响维持电压的关键参数随温度的变化规律,对维持电压温度特性的内在作用机制进行了详细讨论,并提出了改善维持电压温度特性的方法.
1 引言
静电放电(electro-static discharge,ESD)失效是导致集成电路故障的主要原因之一,几十年来一直威胁着半导体器件及电路的可靠性[1−3].ESD 保护结构经常被用于集成电路的ESD 防护设计中[4,5].一般来说,ESD 防护结构设计应遵循ESD 设计窗口,即触发电压小于栅氧击穿电压以避免损坏内部电路,维持电压大于电源工作电压以避免闩锁[6−8].集成电路的封装和部分操作在某些情况下是在高温环境中进行的[9],由于ESD 参数的热致变化[10],高温工作环境会导致ESD 保护结构的参数偏离ESD 设计窗口,当维持电压降低至工作电压以下时,器件会有闩锁风险,这种热致参数变化使得ESD 保护设计变得更加复杂.因此有必要系统、全面地分析ESD 保护结构的温度变化特性,以确保带有ESD 防护设计的集成电路在高温环境中工作的可靠性.MOSFET 是一种常用的ESD 防护结构.Li 等[11]研究了二极管、二极管串及栅接地N 沟道金属-氧化物-半导体(grounded-gate N-channel metal oxide semiconductor,GGNMOS) 在–40—110 ℃的温度范围内ESD 特性的温度依赖性.Wang 等[12]介绍了GGNMOS 和栅触发NMOS (GTNMOS)的触发电压随温度的变化特性,并对其内部物理机制作了详细研究.可控硅 (silicon controlled rectifier,SCR) 作为一种ESD 防护结构,其有较好的面积效率,常被用作高效ESD 防护结构.Wang 等[13]研究了SCR 在高温下的触发与维持特性.Tazzoli 等[14]提出了一种高维持电压的SCR,研究了 SCR 的温度依赖特性,发现ESD 脉冲时间导致的自加热效应会导致维持电压变化.Won 等[15]研究了SCR 在30—225℃的宽温度范围内的触发电压及维持电压的温度依赖特性,结合理论分析高温下发射结电势差(VBE)降低与电阻率升高是维持电压和二次击穿电流降低的主要原因.而基于CMOS 和Bipolar-CMOS-DMOS (BCD) 工艺制造的各种典型SCR 的温度依赖性分别被介绍和研究[16,17].通过改进SCR 结构,可实现ESD 触发电压和维持电压在高温环境中的稳定性[18,19].Do 等[20]为了满足ESD设计窗口研究了浮动技术减小4H-SiC GGNMOS 的触发电压,并进行了高温评估.Wu 等[21]通过TLP测试与TCAD 仿真研究了DDSCR 的高温ESD特性.然而,在以上大多数研究中,只考虑了传统或新型ESD 保护装置的特性随温度的变化,以验证其在工作温度范围内的可靠性.部分研究对触发电压的温度依赖特性及相关物理机制进行了详细研究.而决定ESD 器件抗闩锁性能的维持电压与维持电流的温度依赖性虽然被报道,但大部分研究只关注于提高维持电压以实现抗闩锁在工作温度范围内的可靠性,并未对ESD 器件维持电压的温度依赖性进行底层物理机制探讨和模拟仿真分析.
本文分析了用于ESD 保护的部分耗尽绝缘体上硅 (PDSOI) NMOS 器件维持电压的温度特性.通过传输线脉冲(transmission line pulse,TLP)测试器件I-V曲线获得了维持电压随温度的变化规律.此外,通过半导体工艺及器件模拟工具(TCAD)模拟仿真,研究了器件维持电压温度依赖性的潜在物理机制.
2 器件结构参数及实验设置
研究器件为基于0.18 µm PDSOI 工艺制备的NMOS 器件,测试及仿真器件的具体参数如下:栅长L为0.8 µm,栅宽W为960 µm,栅氧厚度TOX为12.5 nm,埋氧层厚度TBOX为400 nm,硅膜厚度TSi为300 nm,侧墙宽度Lspacer为0.1 µm,N+区掺杂浓度CN+为1×1020cm–3,P 阱掺杂浓度CP为1×1017cm–3.
为了改善NMOS 的ESD 特性,本文所使用的NMOS 采用了金属硅化物扩散层阻隔工艺.实验所用的测试测试系统可模拟人体静电放电模式产生脉宽为100 ns,上升沿为5 ns 的脉冲方波,其匹配的加热模块为器件提供25—200 ℃的测试温度.
在ESD 测试过程中,器件处于栅触发工作模式:栅极施加1.5 V 直流电压,源极、体引出电极和衬底均接地,并在漏极施加TLP 脉冲方波,用示波器对漏极的瞬态电流和电压进行采样,多次重复得到ESDI-V曲线.整个测试过程均在设定的工作温度下进行,实验设有30,60,100,150 和195 ℃共5 个测试温度.集成电路应用中的高温电子大多应用于汽车行业.其中汽车电子中的发动机控制、电动/混合动力车的环境温度峰值可达150 ℃,而集成电路的结温最高可比环境温度高25 ℃.本文所研究的温度范围涵盖一般军用高温电子器件的最高工作温度指标(175 ℃).
3 测试与仿真结果
在之前的研究中,对PDSOI NMOS 作为ESD防护器件的触发机理及触发电压的高温响应特性进行了分析[12].本文将对PDSOI NMOS 作为ESD防护器件的维持电压的温度特性进行讨论研究,研究发现高温对器件的维持电压有明显的影响,并对具体的作用机理进行了解释分析.如图1 所示为被测器件在各温度下GTNMOS 的ESDI-V曲线,横坐标表示ESD 电压,纵坐标表示已归一化为单位栅宽的ESD 电流.图1 插图为ESDI-V曲线维持的细节图.提取曲线由负阻区进入电压、电流均递增的区域的转折点处的电压,计为维持电压VH.由图1 可知,随着温度从30 ℃上升至195 ℃的过程中,被测器件的维持电压VH呈现下降趋势.

图1 不同温度下GTNMOS 的ESD I-V 曲线.插图为曲线维持处的细节Fig.1.The ESD I-V curves of NMOS under different temperatures.Insert:the detail in holding points.
为探究PDSOI NMOS 的VH随温度的变化机理,通过TCAD 对器件进行了建模,用多脉冲仿真方法对器件模型进行了高温ESD 仿真分析.仿真设置中,器件的漏极(Drain)上加载线性函数(piecewise linear function,PWL)设定的电流方波,栅极施加1.2 V 直流电压,其余电极包括源极(Source)、体引出电极(Body)、衬底(Substrate)均接地.图2(a)所示为不同温度下GTNMOS 的多脉冲仿真所得的ESDI-V曲线,插图为GTNMOS脉冲仿真ESDI-V曲线维持处的细节图.图2(b)为不同温度下GGNMOS 的多脉冲仿真所得的ESDI-V曲线,插图为GGNMOS 脉冲仿真ESDI-V曲线维持处的细节图.图3 展示了TLP 测试与TCAD仿真数据对比,虽然TLP 测试与TCAD 的维持电压数值有差别,但两者的维持电压随着温度的升高均减小.图3 所示的维持电压数值上的差距是由于仿真工艺设置与实际工艺条件存在一定差异性,且TCAD 仿真过于理想化,未考虑实际测试的接触电阻与导线电阻.因为2D 模型不同于实际的PDSOI NMOS 器件,所以仿真曲线中的VH绝对值不同于TLP 测量的PDSOI 的ESDI-V曲线所得,但是在TCAD 仿真中已经获得了VH随温度变化的相同趋势,这对于分析高温下的维持特性和机制至关重要的.由图2 仿真可知,直流栅压的施加使得NMOS 的VH随温度变化的幅度减小,但并不影响NMOS 维持电压随温度的变化趋势.直流栅压与温度是两种影响NMOS 的VH的因素,为了更直观地分析VH的温度依赖性的内在物理机制,对GGNMOS 多脉冲高温ESD 仿真结果进行解析.
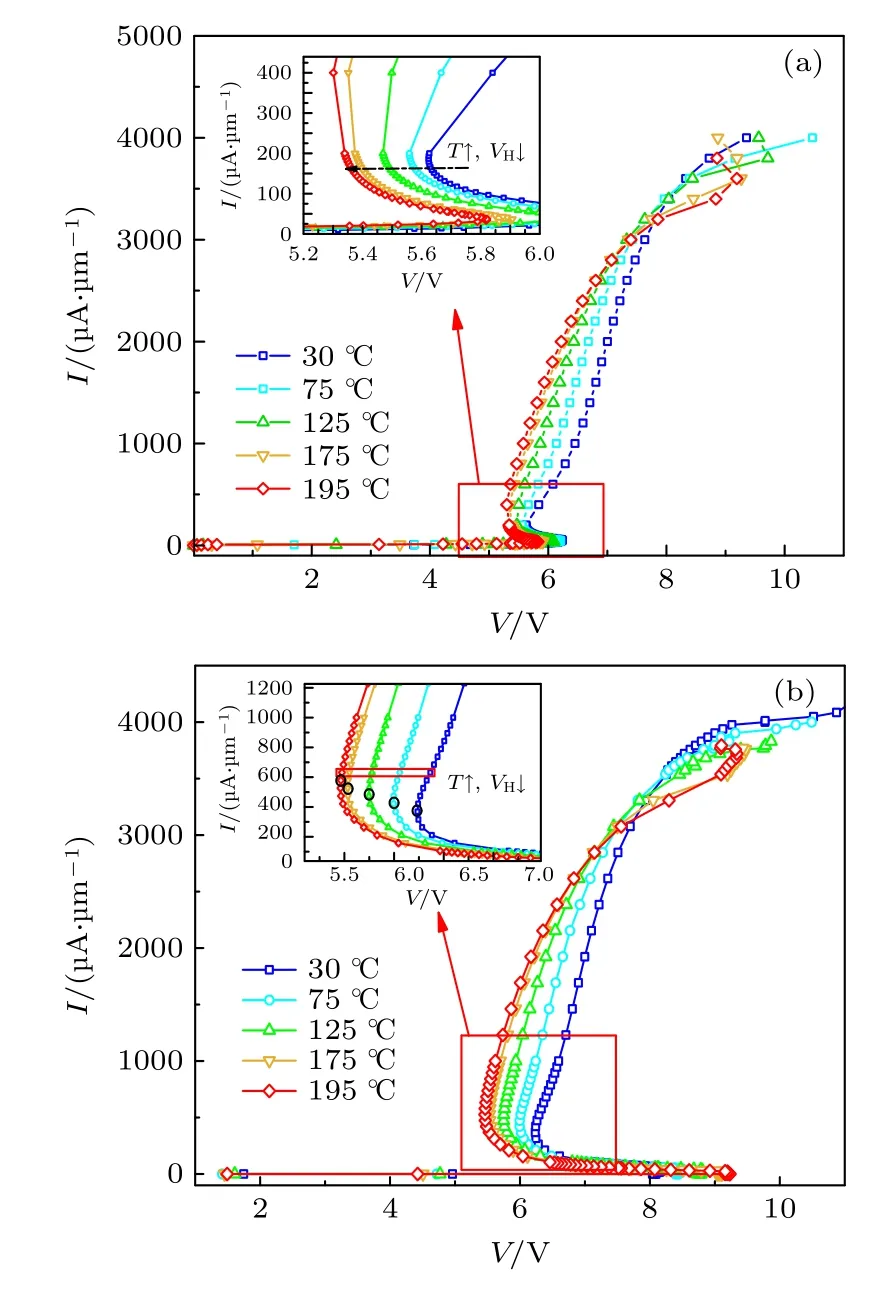
图2 不同温度下,(a) GTNMOS 和(b) GGNMOS 的TCAD仿真ESD I-V 曲线,插图为曲线维持处的细节Fig.2.The TCAD simulated ESD I-V curves of (a) GTN MOS and (b) GGNMOS under different temperatures,where the insert is the detail in holding points.

图3 不同温度下GTNMOS 的TLP 测试结果与TCAD 仿真结果对比Fig.3.The TLP tested holding voltage and TCAD simulated holding voltage under various ambient temperatures.
4 维持电压的温度特性分析
4.1 NMOS 维持电压
NMOS 工作在维持状态时,主要通过开启MOS结构内部的寄生双极结型晶体管(bipolar junction transistor,BJT)释放ESD 大电流,这个电流一般远高于MOS 的沟道电流IDS.当寄生BJT 开启时,MOS 结构的内部电流通路以及等效电路图如图4所示.器件工作在BJT 状态下时,主要有4 部分电流:MOS 沟道电流IDS、寄生BJT 的集电极电流IC、发射极电流IE、基极电流IBody.如图4 所示,在电流流过的路径上,维持电压主要由三部分组成:

图4 PDSOI NMOS 器件截面图及作为ESD 防护器件工作时的工作机制示意图Fig.4.Cross-sectional view and the equivalent circuit of the PDSOI NMOS.

其中,降落在雪崩场上的电压Vava=VDB.通过研究漏-体结电势差VDB、维持电流IH、体电阻RBody和源-体结正向开启的开启电压VBSon的温度特性来解析维持电压随温度的变化的内在物理机制.
4.2 维持电压温度特性分析
对图2(b)中方框标注的一组5 个同样电流方波中70%—90%时间范围内的同一特定时刻不同温度下GGNMOS 的VDB,VBSon,RBody及注入电子浓度进行分析.不同温度下静电势分布情况如图5 所示,由电势分布可知,在不同温度下,维持电压VH中漏-体结电势差VDB占比最多.随着环境温度从30 ℃上升至195 ℃,VDB逐渐减小,且温度效应最为明显.沿Path 1 路径上–1—1 µm 的静电势分布曲线如图6 所示,不同温度的静电势沿着Path 1 减小.当温度从30 ℃升至195 ℃,电势差减小了0.87 V.

图5 施加相同ESD 电流脉冲的GGNMOS 在不同温度下静电势分布Fig.5.Electrostatic potential distributions of GGNMOS under various ambient temperatures when the Drain is subject to the same ESD current pulsing.The Source and the Body are grounded.

图6 施加相同ESD 电流脉冲的GGNMOS 在不同温度下的源-体界面位置 (沿Path 1 路径) 的静电势分布曲线Fig.6.Electrostatic potential distributions in the drainbody surface of GGNMOS along path 1 under various ambient temperatures when the drain is subject to the same ESD current pulsing.The Source and the Body are grounded.
维持电压大部分降落在漏-体结上来维持雪崩所需的电场,因此VDB主要由耗尽区电场决定.寄生BJT 开启后,自由载流子注入耗尽区,这种注入的载流子对耗尽区电荷有中和作用,而耗尽区的电荷分布对电场分布会造成影响.因此,将电场随温度变化的特性分为两部分:1)不施加ESD 电流的静电场随温度的变化规律;2)施加ESD 电流时的电子注入随温度的变化规律.如图7 所示为不施加ESD 电流时的电场随温度的变化情况,可以看出,电场在耗尽区处最大,且随着温度从30 ℃上升至195 ℃,耗尽区电场减小.漏-体结的载流子输运方式主要为电子在空间电荷区的漂移运动,其主要的自由载流子为电子,如图8 所示为施加相同ESD 电流时不同温度下器件内部的电子浓度的分布.不同温度下,漏极与源极处的电子浓度最高,这也是因为寄生BJT 的电流主要为电子电流.而随着环境温度从30 ℃上升至195 ℃,漏-体结内电子浓度升高,用来中和耗尽区的正电荷的电子增多,导致电场进一步下降.因此随着温度的升高,耗尽区静电场减小,且增大的注入电子浓度增大进一步削弱了耗尽区电场,导致VDB降低.

图7 不施加ESD 电流脉冲的GGNMOS 在不同温度下的电场分布Fig.7.Electric field distributions of GGNMOS under various ambient temperatures when the drain,the source and the body are grounded.

图8 施加相同ESD 电流脉冲的GGNMOS 在不同温度下的电子浓度分布Fig.8.Electron density distributions of GGNMOS under various temperatures when the drain is subjected to the same ESD current pulsing.The source and the body are grounded.
如图9 所示为器件在施加相同电流时不同温度下器件沿Path 2 路径上的静电势分布.仿真结果表明,沿着Path 2 电势升高,电势差VBSon随温度的升高而降低,当温度从30 ℃升高至195 ℃时,电势差降低0.19 V.由图7 可知,温度升高削弱了源-体耗尽区的静电场,而图8 显示漏-源耗尽区注入电子浓度变化不明显,即VBSon的降低主要是由静电场的温度依赖性造成的.

图9 施加相同ESD 电流脉冲的GGNMOS 在不同温度下的源-体结界面位置 (沿Path 2 路径) 的静电势分布Fig.9.Electrostatic Potential distributions in the drainsource surface of GGNMOS along path 2 under various temperatures when the Drain is subjected to the same ESD current pulsing.The Source and the Body are grounded.
在30 ℃时,对于掺杂衬底中的杂质全部电离,且本征激发并不显著.随着温度升高,晶格振动散射逐渐成为载流子主要散射方式,此时载流子迁移率随着温度的升高而降低,所以电阻率随温度的升高而升高[22].因此RBody随着温度的升高而升高.如图10 所示施加相同ESD 电流在不同温度下器件的电流密度分布,随着温度从30 ℃升至195 ℃,从漏接触极接流向体接触极的电流密度明显减小.施加相同的ESD 电流,但电流密度分布随着温度的升高而减小,因此这也间接说明体电阻RBody随温度的升高而升高.结合之前的电阻率分析,随着温度的升高,RBody随着温度的升高而增大.

图10 施加相同ESD 电流脉冲的GGNMOS 在不同温度下的电流密度分布Fig.10.Current density distributions of GGNMOS under various temperatures when the drain is subjected to the same ESD current pulsing.The Source and the Body are grounded.
对图2(b)中圆圈标注的一组5 个点从维持电流IH的角度进行分析,由仿真结果可知,当温度从30 ℃上升到195 ℃,IH共增大约200 µA/µm.ESD 电流由器件漏极流入,在器件内部分别经过体电阻RBody、寄生BJT 和NMOS 沟道 (电流分别记为IBody,IBJT和IDS),最终通过体接触电极和源极接触流出 (分别记为IB,contact和IS,contact),因此电流之间存在以下关系

分析电流关系如下:

其中β为寄生BJT 的电流增益,(4) 式成立的前提是寄生BJT 开启,即:

其中,IESD为该ESD 器件泄放的总电流,即流入漏极接触的电流,将 (4) 式代入 (6) 式中可得

当寄生BJT 开启,器件处于维持状态时,最小的ESD 电流即为维持电流IH,即:

式中,IESD的最小值(IESD)min可由(5)式来限定,将(5)式和(7)式代入(8)式可得

由(9)式可知,IH的值由寄生BJT 的电流增益β、源-体结的正向开启电压VBSon、体电阻RBody和NMOS 沟道电流IDS控制.仿真结果中IDS随温度的变化总幅度约为10 µA/µm,对IH随温度的变化量的贡献仅占约5%.
Khanna 等[23]描述了双极型晶体管的电流增益的温度依赖性,二者关系为

其中,T为温度;β(T)为温度为T时的BJT 晶体管电流增益;T0为常数,T0=273 K;β(T0)为温度为T0时的电流增益;ς为温度系数,满足

由(10)和(11)式可知,双极型晶体管的电流增益β会随温度的升高而增大.
图9 所示的仿真结果表明VBSon会随温度的升高而降低.之前的仿真结论证明,温度升高会导致体电阻RBody升高.如(9)式所述,维持电流IH与寄生BJT 的电流增益β、源-体结的正向开启电压VBSon和体电阻RBody密切相关.温度升高导致β增大,间接导致IH增大;而同时温度增加会导致VBSon降低和RBody升高,以上因素都会间接使得IH随温度的上升而下降.因此温度通过对β的影响占主导地位,使得IH随温度的升高而增大.
4.3 VDB,VBSon,IH,RBody 对NMOS 维持电压温度依赖性的作用结果分析
由以上对VDB,VBSon,IH,RBody的分析可知,在器件处于维持状态时的电流路径上,电势主要降落在漏-体反偏结上.漏-体结电势差VDB主要由漏-体耗尽区电场决定,而耗尽区电场可分为两部分影响:不施加电信号的静电场和注入电子浓度中和电荷.随着温度的升高,不施加电信号的耗尽区静电场减小,且注入电子浓度随着温度的升高而增大,对耗尽区电场有进一步削弱作用.因此这两种因素的共同作用使得VDB随着温度的升高有减小趋势,与VH的变化趋势一致.与VDB随温度的变化原因分析相同,VBSon随温度的变化也受两种因素影响.但源-体耗尽区注入电子浓度随温度的变化差异不大,因此主要是由源-体耗尽区静电场的温度变化导致VBSon降低.而维持电流IH的升高是由于双极型晶体管的电流增益β随着温度的升高而增大.在相同的ESD 电流下,由电流的分布状态可知,寄生体电阻RBody随着温度的升高而增大.IH与RBody随着温度的升高而增大,与VH的温度变化趋势相反.由图5 的电势分布及图6 的电势差值可知,VH主要由VDB决定,VH变化趋势与VDB一致.由图2(b)仿真结果可知,随着温度的升高,VH降低0.78 V,而VDB和VBSon总的降低幅值为1.1 V.IH与RBody随着温度的升高而增大,这减缓了VH随温度的变化.因此可以通过增大IH或RBody来减小VH随温度升高减小的特性.但是,增大IH大注入电流对耗尽区电场有削弱作用,会导致VDB降低,因此增大IH时需综合考虑影响效果.
5 结论
本文研究了ESD 防护器件PDSOI NMOS 的维持电压VH的温度特性.实验结果证明,随着温度的提高,NMOS 的维持电压减小.通过与TLP测试结果吻合良好的TCAD 模拟仿真,分析了电场、电流密度、电势、电子浓度等多个物理参数在不同温度下的分布情况,详细讨论了对VH温度依赖性的物理机制.TCAD 仿真结果显示,漏-体结电势差VDB和源-体结正向开启电压VBSon随温度变化的趋势与VH的温度变化趋势一致,但维持电流IH和体电阻RBODY随着温度的升高而增大.且VH的温度依赖性主要是由VDB的温度特性决定的.基于以上物理参数随温度的变化分析,本文提出,通过增大RBody与IH来削弱VH随着温度增加而减小的趋势.从而降低VH的温度依赖性.本文对维持电压温度特性及其内在物理机制的研究有助于设计温度免疫的抗闩锁ESD 保护结构.
