氮化物垂直腔面发射激光器的发展与挑战(特邀)
2022-03-24王玉坤郑重明龙浩梅洋张保平
王玉坤,郑重明,龙浩,梅洋,张保平
(厦门大学电子科学与技术学院(国家示范性微电子学院),厦门361005)
0 引言
半导体激光器有多种结构,例如分布反馈式激光器(Distributed Feedback Laser Diode,DFB-LD)、边发射激光器(Edge-emitting Laser,EEL)和垂直腔面发射激光器(Vertical-cavity Surface-emitting Laser,VCSEL)等。其中,VCSEL 可以依托其垂直腔的特点制备成二维阵列,进行大尺寸二维集成,并且拥有圆形远场光斑、单纵模输出、低功耗、圆片测试等优点。
VCSEL 在半导体激光器历史中发展虽较晚,但其研究已超过40年。1977年,东京工业大学的伊贺健一等第一次提出了VCSEL 的构想[1-2]。这种结构是一种上下法布里-珀罗腔(F-P),两片反射镜夹着中间的有源层。典型的制作方法是在蓝宝石衬底上外延制备下分布布拉格反射镜(Distributed Bragg Reflector,DBR),接着制备相应量子阱等有源层结构,之后再制备上DBR。电泵VCSEL 器件则还要额外制备上电极和底电极等结构。最初的VCSEL 主要基于砷磷化物(如:GaInAsP)材料体系制备。通过氧化有源区边缘的砷化物来形成电流和光学限制层,从而实现对腔内光场和电流的局域化。
与传统的边发射激光器相比,VCSEL 有如下优点:1)圆形光斑,易与光纤耦合;2)同一基底上能够同时制作多个器件,从而实现二维集成,降低成本,提升效率[3-4];3)谐振腔长度为微米量级,与波长接近,纵模间距较大,器件容易实现单纵模工作,动态单模性较好,拥有较大的弛豫震荡频率[3];4)制备过程中无需解理外延片形成谐振腔,腔长可通过外延精确控制,激射波长重复性高。
1979年,在提出VCSEL 概念两年后,伊贺健一便在77 K 温度下实现了第一支电注入GaInAsP/InP VCSEL 的脉冲激射[5];1987年其又在77 K 实现了GaAs/AlGaAs VCSEL 的脉冲激射[6];1989年实现了室温下GaAs/AlGaAs VCSEL 的连续激射[7],阈值电流小于10 mA。相较于红外及红光GaAs 基VCSEL 的迅速发展,具有更优越特性的GaN 可见光VCSEL 仍处于实验室研究阶段,发展缓慢[8]。这主要源于高质量GaN薄膜生长及器件工艺的困难[9]。1989年,AMANO H 等在Mg 掺杂GaN 中引入电子束辐射,首次成功实现了稳定的p-GaN 薄膜[10]。1991年,NAKAMURA S 等采用热退火方法解决了GaN 中p 掺杂的问题,并阐明其机理[11]。而第一支GaN VCSEL 是在1996年由REDWING J M 等[12]报道的具有全外延结构的光泵浦GaN VCSEL,阈值泵浦能量高达2.0 MW/cm2。
红光以及红外波段VCSEL 主要使用GaAs 材料体系,其中650 nm、850 nm、980 nm 波段主要应用在短距离光通信中,1.3 μm 和1.55 μm 波段主要应用在长距离光纤通信中。此外,GaAs VCSEL 在传感、医疗、红外照明、激光雷达、原子钟等方面也有着广泛的应用。与GaAs VCSEL 相比,GaN VCSEL 的发光波长集中于紫外与可见光波段。可以应用于半导体激光照明、可见光通信、激光投影显示、高密度光存储、生物医疗、微型原子钟及传感器等方面[13]。
由于VCSEL 出光方向与外延片表面垂直,集成为高密度二维阵列时,能够提供比单管边发射激光器更大的发光功率,因此,可见光波段的GaN VCSEL 适用于需要高准直性光源的应用场合,如:剧院、博物馆、温室、汽车车灯、飞机头灯等情景照明。在可见光通信方面,黄绿光GaN VCSEL 可应用于短距离塑料光纤通信[14]和对海探测以及水下光通信领域[15]。在显示方面,GaN VCSEL 可以完整覆盖红绿蓝三基色,同时其光束又有较好的方向性及准直性,可应用于激光电视、家庭影院、汽车或飞机挡风玻璃投影等领域。另外,GaN VCSEL 的小体积以及低功耗在移动穿戴设备中的微投影仪和视网膜投影技术等方面也将发挥重要的作用。
GaN 基紫外LED 已经在紫外固化、皮肤治疗、净化水源、杀菌消毒、疫情防治、生化检测、紫外通信等方面被广泛应用[16]。VCSEL 相比于LED 具有体积更小、相干性好、光束集中等优点,紫外VCSEL 也将有更大的应用前景。
UVA 波段(320~400 nm)一般应用于紫外固化[16]。例如:显示屏、电子医疗、仪表等行业的UV 胶黏剂固化;建材、家具、家电、汽车等行业的UV 涂料固化;印刷、包装等行业的UV 油墨固化;微电子行业的元件装配UV 固化等。代表波长为395 nm 和365 nm。目前常见的紫外固化光源为汞灯和紫外LED,若采用UV VCSEL 代替UV LED 和汞灯,则具有体积更小、功率密度高、单色性好,可设置最合适波长等优势。
UVB 波段(280~320 nm)主要应用在医学(294~310 nm)和农业生产(310 nm)两个方面[16]。在医学方面,可以用于皮肤病治疗(310 nm)、癌症治疗(310 nm)、健康保健、免疫治疗(310 nm)、维生素D3促进生成(294~304 nm)、生化试剂检测、荧光检测以及蛋白质、DNA 和细菌识别等[17]。其中皮肤病治疗的主要原理是利用310 nm 紫外线对皮肤的黑斑效应,加速皮肤新陈代谢,提高皮肤细胞生长力,从而有效治疗多种光照性皮肤病,如:白癜风。在健康保健领域,UVB 光的照射可以调节高级神经功能、改善睡眠、降低血压等;同时,UVB 光能促进生成维生素D3[17],波长为293 nm 的UVB 光使人体内产生维生素D3的效率是阳光的2.4 倍。在农业生产方面,主要应用在植物照明(310 nm)、水消毒和食品运输等。使用窄带310 nm UVB 光源照射水果和蔬菜从而产生某种植物化学物质,这种物质可以大大降低癌症和心血管疾病的风险[17]。
目前,大多UVB 光都采用紫外LED 开展上述研究应用,而VCSEL 具有激光器的多项特点,例如:单色性好、线宽窄,可以进一步改善治疗效果,并有利于研究不同波长的治疗影响。研究表明窄带宽的UVB(310 nm)光源相比宽带宽的UVB(280~320 nm)光源,对皮肤病的治疗效果更好,因为后者对正常皮肤的红斑和晒伤风险更高[17],而前者对邻近部位的不良副作用也更低[17]。使用UVB VCSEL 作为光源,则将更易控制治疗范围,更容易选择最合适的治疗波长,减少对正常部位的损伤。
UVC 波段(200~280 nm)主要用于杀菌消毒、生物防治。原理是利用UVC 波长的紫外线破坏微生物机体细胞中的DNA 或者RNA 分子结构,造成其生长性细胞或再生性细胞死亡,达到杀菌消毒的效果。根据这一特性,UVC 光源被广泛应用到空气、水、物体表面杀菌消毒。在2019 新冠疫情中,越来越多的UVC LED 被应用于医疗防护中。而UVC VCSEL 可以凭借其功率密度高、发光更集中的特点,发挥其更显著的杀菌消毒效果。
1 Ⅲ族氮化物VCSEL 研究进展
GaN VCSEL 的相关研究起步较晚,GaAs 基VCSEL 诞生的十多年后,才出现GaN VCSEL 的身影。1989年,日本的科学家AMANO H 等生长出高质量的GaN 薄膜并解决了p 型掺杂和量子阱有源区的问题[10],之后有关GaN VCSEL 的研究开始逐步进行。GaN VCSEL 的研究最早开始于1995年,东京工业大学的HONDA T 等首先对GaN VCSEL 的阈值特性进行了理论计算研究[18]。第一个光泵GaN VCSEL 在1996年由ATMI 公司的REDWING J M 等[12]实现。之后的1996 到2007年,东京大学[19-20]、布朗大学[21]、日本NTT 公司[22]、厦门大学[23]、台湾交通大学[24]、瑞士洛桑理工大学[25]等机构的研究小组也相继报道了具有不同DBR 结构的GaN VCSEL 的光泵激射。具有里程碑意义的事件发生在2008年,王兴宗研究组[26]制备出了世界上第一支电注入蓝光GaN VCSEL,这是第一次成功实现电注入GaN VCSEL,随后越来越多的研究人员投入到电注入GaN VCSEL 的研发之中。
1.1 可见光VCSEL
GaN VCSEL 是Ⅲ族氮化物半导体激光器中的代表之一,InxGa1-xN 是一种典型的Ⅲ-N 族半导体材料系统,其禁带宽度在0.7~3.4 eV 范围内连续可调,因此,理论上InGaN 材料可以覆盖全部可见光波段。目前受到应用驱动和高In 组分InGaN 外延的瓶颈,GaN VCSEL 主要集中在蓝绿光波段。而发展GaN 蓝光和绿光VCSEL 的挑战在外延生长与结构设计方面[27]。
在早期研究中,蓝紫光波段GaN VCSEL 报告较多。1999年,俄罗斯科学院的KRESTNIKOV I L 等实现了第一支蓝光GaN VCSEL[28]。同年,东京大学的SOMEYA T 等报道了第一支蓝光混合双DBR 结构的GaN VCSEL[19],这意味着有实用价值的蓝色VCSEL 在GaN 材料系统中实现。之后,蓝紫光波段GaN VCSEL 的研究进展飞速,研究人员也通过使用双介质DBR 替代混合DBR 结构来获得更高品质因子(Q值)的谐振腔,提高器件质量。
近期,在蓝紫光波段GaN VCSEL 的研究中比较有代表性的机构包括:布朗大学、台湾交通大学、日亚公司、厦门大学、名城大学、斯坦雷电气公司等研究单位,比如:台湾交通大学的王兴宗教授研究组于2008年制成了第一支电注入蓝光GaN VCSEL[26],开创了电注入GaN VCSEL 的先河。日亚公司在2008年实现了最大输出功率可达700 μW 的蓝光电泵浦GaN VCSEL[29]。厦门大学的张保平研究室[30]于2014年制造了Q值高达3 570、阈值电流低至0.93 mA 的高质量VCSEL。2015年,索尼公司使GaN VCSEL 输出功率首次达到了毫瓦量级[31]。随后,日本名城大学通过合理优化生长参数实现了高质量AlInN/GaN DBR 的生长,以此为基础在2018年报道了连续输出功率6 mW,阈值电流密度9 kA/cm2(对应阈值电流4.5 mA),斜率效率0.87 W/A,发散角5.1°的蓝光VCSEL[32];次年报道了腔长为4λ,连续输出功率1.8 mW,微分电阻90 Ω 的蓝光VCSEL,并且探究发现GaAs 体系的短腔结构并不适合GaN 体系VCSEL[33]。2019年,斯坦雷电气公司基于埋入SiO2横向光限制技术,采用花状结构实现了441.7 nm 环形阵列锁相GaN VCSEL[34],具有高达30%的差分量子效率、15.8 mW 的高输出功率和2.8°的窄发散角度。同年斯坦雷电气公司[35]和索尼公司[36]又分别在增大输出功率和减小阈值电流两个方面取得了突破。2020年,斯坦雷电气公司提出了蓝色GaN VCSEL 中的一种新型纳米圆柱波导[37],在光输出功率和电光转换效率方面提供了横向光学约束和优异的输出性能。2020年,加利福尼亚大学的KEARNS J A 等将埋入式隧道结(Buried Tunnel Junction,BTJ)应用在半极性GaN VCSEL 中[38],在减小损耗和提高注入效率方面获得很大改善。台湾交通大学的CHANG T C 等第一次将TiO2高反射率差光栅(High-index-contrast Grating,HCG)引入电驱动GaN VCSEL,并成功激射[39]。2020年,厦门大学张保平等通过引入横向光学限制[40],使所需载流子浓度降低,降低了有源区结温和光谱展宽,实现了GaN VCSEL 较低的阈值电流和较高的输出功率[41]。同年,耶鲁大学ELAFANDY R T 等报道了一种使用纳米多孔GaN 与GaN 交替的底部导电DBR 的蓝光VCSEL[42],其激射波长为434 nm,阈值电流密度为42 kA/cm2,最大光输出功率为0.17 mW。
在绿光GaN VCSEL 方面,由于量子限制Stark 效应和高密度缺陷和位错,绿光发射InGaN/GaN 量子阱的量子效率较低[43],被称为“绿色间隙”[44]。2008年,CAI L E 等[23]通过优化InGaN/GaN 量子阱的生长,首次实现了光泵浦下蓝绿光GaN VCSEL 的激射,室温下激射波长为498.8 nm,线宽为0.15 nm。
近年来,厦门大学张保平研究室在绿光VCSEL 方面取得较多进展[43]。2016年,WENG G 等首次实现了电注入绿光GaN VCSEL 的连续激射[45],该GaN VCSEL 器件采用InGaN 量子点作为增益介质,室温连续激射波长为560.4 nm,并且具有0.61 mA 的低电流阈值。2017年,MEI Y 等[46]使用InGaN 量子点作为有源区,通过调节腔长将该器件的波长从491.8 nm(蓝绿色)拓展到565.7 nm(黄绿色),覆盖了大部分的“绿色间隙”。同年,XU R B 等[47]通过使用量子阱有源区中的量子点(QD-in-QW),实现了电注入下同时发射蓝光和绿光的GaN VCSEL,该器件首先在约2 μA 的阈值电流处激射,发射波长为545 nm 的绿光,随着电流的增加,在430 nm 处出现另一个激射峰,阈值电流约为5 mA。2018年,XU R B 等[48]通过将宽谱蓝光InGaN/GaN 量子阱与微腔相结合,实现了基于量子阱中局域态的绿光VCSEL,由于谐振腔效应,与腔模共振的局域态发光模式的复合效率大幅提升,使得大注入电流下绿光(493 nm)得到显著提升,实现激射。以上研究为绿光VCSEL 的后续发展提供了重要的思路。
2020年,索尼公司的研究人员报道了基于多层介质膜的绿光VCSEL[49],在半极性GaN 衬底上设计了腔长为20 μm,底部DBR 为多层弯曲介质膜(Ta2O5/SiO2)的结构。其顶部DBR 与p-GaN 层之间插入一层30 nm 的ITO 层,阈值电流为1.8 mA(对应阈值电流密度为14.4 kA/cm2),激射波长为515.2 nm。
1.2 紫外VCSEL
目前,用于制作紫外VCS EL 的材料主要是AlGaN 合金体系。Ⅲ族氮化物材料AlN、GaN、InN 及其合金半导体都具有直接带隙、耐高温、抗辐射、抗腐蚀、击穿电压高、热导率高等优点。通过改变其中的Al 组分,可以调节AlxGa1-xN 的禁带宽度,使得在3.4 eV 到6.0 eV 之间连续变化[50],非常适合应用于近紫外(320~400 nm)、中紫外(280~320 nm)及深紫外(200~280 nm)的半导体激光器(Laser Diode,LD)、发光二极管(Light Emitting Diode,LED)和光电探测器(Photodetector,PD)等。
紫外波段的半导体激光器中,传统的边发射激光器发展较快,较早实现了光泵和电泵激射[51-55]。相比于边发射激光器,VCSEL 在紫外波段的进展则相对缓慢。1995年,东京工业大学的HONDA T 等首先在紫外波段对AlGaN VCSEL 的阈值特性进行了理论计算研究[18]。1996年,REDWING J M 等实现了光泵激射的紫外VCSEL[12]。近30年来,紫光、蓝光、绿光波段的VCSEL 都实现了光泵浦和电泵浦激射,但是至今没有紫外电泵VCSEL 的报道。
1.2.1 UVA (320~400 nm)VCSEL
1996年,美国先进技术材料公司(Advanced Technology Materials,Inc.)的REDWING J M 等成功实现了紫外363 nm 光泵VCSEL 的激射[12],其结构和不同激发功率下的光谱如图1。上、下DBR 均由30 个周期的Al0.40Ga0.60N(39.7 nm)/Al0.12Ga0.88N(37.2 nm)构成,有源层为10 μm 的GaN。激射波长为363.5 nm,激射阈值为2 MW/cm2。
2000年,布朗大学(Brown University)的ZHOU H L 等制备出了383 nm 光泵激射的VCSEL[56],阈值功率为30 mW,线宽小于0.1 nm,其结构如图2。有源区为20 对In0.03Ga0.97N(4 nm)/GaN(6 nm)量子阱,上DBR 为HfO2/SiO2,下DBR 为60 对GaN/Al0.25Ga0.75N。这种混合DBR 结构相比于全氮化物DBR 结构,上表面的介质膜DBR 制备工艺简单、反射率高且高反带的带宽更宽。

图2 383 nm VCSEL 的结构、发光光谱与输出功率曲线[56]Fig.2 Structure,emission spectrum and output power of the 383 nm VCSEL[56]
2010年,南洋理工大学的CHEN R 等采用纳米球光刻(Nanosphere Lithography,NSL)制备了平均直径约为500 nm 的纳米柱[57],实现了底部为AlxGa1-xN/AlyGa1-yN DBR、顶部为SiO2/HfO2DBR 组成的纳米柱阵列结构的VCSEL。该结构可以提供优异的光学限制,降低激射阈值,如图3所示。该器件在343.7 nm 处激射,激射阈值为0.52 MW/cm2。

图3 343.7 nm VCSEL 的场发射扫描电子显微镜图片和PL 光谱[57]Fig.3 FESEM image and PL spectra of the 343.7 nm VCSEL[57]
2015年,乔治亚理工学院LIU Y S 等制备了In0.03Ga0.97N/Al0.15Ga0.85N 量子阱的紫外VCSEL[58],其结构如图4(a),激射波长367.5 nm,线宽为1.4 nm,阈值为1 MW/cm2,是当时报道的最低阈值。该器件采用了混合DBR 结构,氮化物作为下DBR,HfO2/SiO2作为上DBR。2016年,该课题组又优化了类似结构的紫外VCSEL[59],其结构如图4(c)。该VCSEL 激射波长为374.9 nm,阈值为1.64 MW/cm2。两支VCSEL 的相关光谱如图4(b)、(d)。

图4 367.5 nm 和374.9 nm VCSEL 的结构和发光光谱[58-59]Fig.4 Structure and emission spectra for the 367.5 nm and the 374.9 nm VCSELs,respectively[58-59]
2018年,台湾交通大学的CHANG T C 等采用TiO2高对比度光栅(High-Contrast Grating,HCG)作为顶部反射镜,制备了紫外光泵VCSEL[60]。其激射波长为369.1 nm,具有0.69 MW/cm2的阈值,输出特性如图5。HCG 具有厚度薄、高反带宽、偏振可调以及谐振波长灵活可调等优点,已经在长波长GaAs 系的VCSEL 中得到了广泛研究,但其制造工艺特别复杂,尚未进入实际应用。

图5 HCG VCSEL 的输出特性[60]Fig.5 Output characteristics of the HCG VCSEL[60]
2019年,乔治亚理工大学的PARK Y J 等引入空气隙DBR 来增大DBR 两种材料折射率差[61],实现了具有高反射率的DBR,进而利用该结构实现了阈值功率密度低至270 kW/cm2的375 nm 激射,其结构如图6。

图6 375 nm VCSEL 的结构,发光光谱和输出曲线[61]Fig.6 Structure,emission spectrum and output characteristic of the 375 nm VCSEL[61]
2021年,厦门大学张保平研究组在UVA 波段实现了376~409 nm 的光泵激射[62],光谱如图7所示。因为器件具有双介质DBR 和利用衬底转移技术制作的楔形腔,从而实现了渐变腔长。在InGaN/GaN 多量子阱有源区采用周期性增益结构,增强了腔模场与有源层之间的耦合。腔内光场由腔长调制,因此,在单个VCSEL芯片的不同点上实现了不同波长的可调谐激光。不同波长下的阈值泵浦功率密度为383~466 kW/cm2,其中紫外部分的阈值泵浦功率密度最低。

图7 渐变腔长UVA VCSEL 的发光光谱和输出曲线[62]Fig.7 Emission spectrum and output characteristic of the graded cavity length VCSEL[62]
1.2.2 UVB(280~320 nm)VCSEL
2020年,HJORT F等报道了310 nm 的光泵VCSEL的激射[63]。器件外延层、表面形貌和整体结构如图8(a)。外延层利用MOCVD 生长,再通过电化学腐蚀的方法去除衬底,在300°C、50 MPa压力下,通过真空热压键合将台面转移到Ti/Au覆盖的硅基底上。有源层为AlGaN 量子阱,上、下DBR 均为HfO2/SiO2DBR。顶部DBR 的高反带中心为320 nm,峰值反射率超过99%。底部反射镜为介质膜DBR 和金属Al 镜组合。利用Al 反射镜,DBR在激射波长段的反射率得到了提高,激光阈值10 MW/cm2左右,线宽为3 nm,光谱如图8(b)、(c)所示。

图8 310 nm VCSEL 的结构、表面形貌、发光光谱和输出曲线[63]Fig.8 Structure,surface topography,emission spectrum and output characteristic of the 310 nm VCSEL[63]
1.2.3 UVC(200~280 nm)VCSEL
例7:The shot generally just stuns them, but it does change their attitude. (心理)
当波长进一步缩短到UVC 波段时,VCSEL 激射比近紫外和中紫外更加困难,主要是因为DBR 及有源区的光学损耗更高、制备工艺更难。近期,厦门大学张保平研究组在深紫外VCSEL 方面取得了一系列重大进展。2018年,ZHENG Z 等详细分析了AlGaN 平板微腔中的光损耗,并成功制作了基于AlGaN 量子点有源层和上、下DBR 均为HfO2/SiO2的微腔[64]。通过计算,ZHENG Z 等认为光学损耗的主要来源是界面散射损耗,可以通过减小激光剥离后的表面粗糙度以及调整粗糙界面与腔内光场驻波的波节重合来降低界面散射损耗。2021年,ZHENG Z 等成功实现了双介质膜DBR 结构的UVC VCSEL 的光泵激射[65],器件结构如图9(a)。该器件主要利用了激光剥离技术剥离蓝宝石衬底,优化抛光工艺和DBR 设计,从而制备了全介质膜DBR 结构的VCSEL。这是迄今世界上第一支UVC 波段VCSEL 激射,也是目前为止波长最短的紫外VCSEL。该有源区为5 对Al0.4Ga0.6N(2 nm)/Al0.5Ga0.5N(6 nm)多量子阱层,上DBR 为7.5 对HfO2/SiO2,下DBR 为15.5 对HfO2/SiO2,激射波长为275.9 nm,线宽为0.78 nm,阈值功率密度为1.21 MW/cm2。器件发光特性如图9(b)、(c)所示。

图9 275.9 nm VCSEL 的结构,发光光谱与输出曲线[65]Fig.9 Structure,emission spectrum and output characteristic of the 275.9 nm VCSEL[65]
2 紫外VCSEL 的难点及解决方法
相较于其他波段的VCSEL,紫外波段的VCSEL 发展受到很多挑战,尤其是深紫外波段(<280 nm)VCSEL。实现紫外波段VCSEL 面临着包括高质量晶体的获得、DBR 的制备、衬底剥离以及薄膜表面粗糙度的控制等难题。对于电泵紫外VCSEL,还需要关注电流扩展和载流子注入效率等问题。
2.1 光泵VCSEL
制备光泵紫外VCSEL 的关键问题包括[66]:1)需要较高Al 组分的AlGaN 外延片,但Al 组分越高,外延温度过高及Al 元素的表面迁移困难均导致高晶体质量的AlGaN 外延片不容易制备;2)高质量的紫外DBR制备困难,氮化物DBR 存在晶格失配、热膨胀系数失配、面内组分不均匀和低折射率差等不足,因此难以得到具有高反射率的DBR;3)介质膜DBR 需要剥离衬底的工艺,衬底转移也存在诸多困难,同时介质膜DBR在深紫外段也存在部分吸收的问题。
2.1.1 高晶体质量AlGaN 外延片的生长
AlGaN 材料,特别是高Al 组分AlGaN 材料的外延生长仍存在很多难点,其原因有以下几点:1)由于缺乏同质衬底,通常采用异质衬底外延AlGaN 材料,如:蓝宝石、SiC 和Si 衬底等。这些衬底材料与AlGaN 材料在晶格常数和热膨胀系数上存在较大差异,因此,AlGaN 薄膜中存在较大的内部张应力,容易导致薄膜内部高密度的位错、薄膜表面粗糙、龟裂、载流子迁移率低等问题,严重降低了AlGaN 的晶体质量和光电学性能;2)外延中,衬底上台阶和扭结位置具有较低的能量,有利于反应物附着和二维生长。但相比于Ga 原子,Al 原子具有粘滞系数大和表面迁移率低的特点,难以迁移到台阶或者扭结处。因此AlGaN 容易形成三维岛状生长模式,从而形成马赛克分布的亚晶粒,这些亚晶粒随着外延生长融合,产生了张应力。该张应力与亚晶粒尺寸成反比,并且随着薄膜厚度的增大而增大。当薄膜厚度到达临界厚度时,所积累的张应力能量通过位错或龟裂方式进行释放[67],而位错在AlGaN 晶体中成为非辐射复合中心,极大地恶化器件性能。图10 描述了AlGaN 多量子阱内量子效率(Internal Quantum Efficiency,IQE)与量子阱内位错密度(Dislocation Density,DD)的关系[68],可以看出,随着DD 的增大,IQE 逐渐降低;3)在MOCVD 生长AlGaN材料中,Al 金属有机源比其他金属有机源化学性质更活波,TMAl 和NH3在高温下存在严重的预反应,产生微小颗粒落在衬底上,会导致缺陷产生,同时寄生反应使源的利用效率下降。因此,为了生长高质量高Al 组分AlGaN 材料,必须克服异质外延晶格失配大、位错密度高、Al 原子表面迁移率较低、寄生反应强烈等问题,这需要从生长工艺上予以改进。
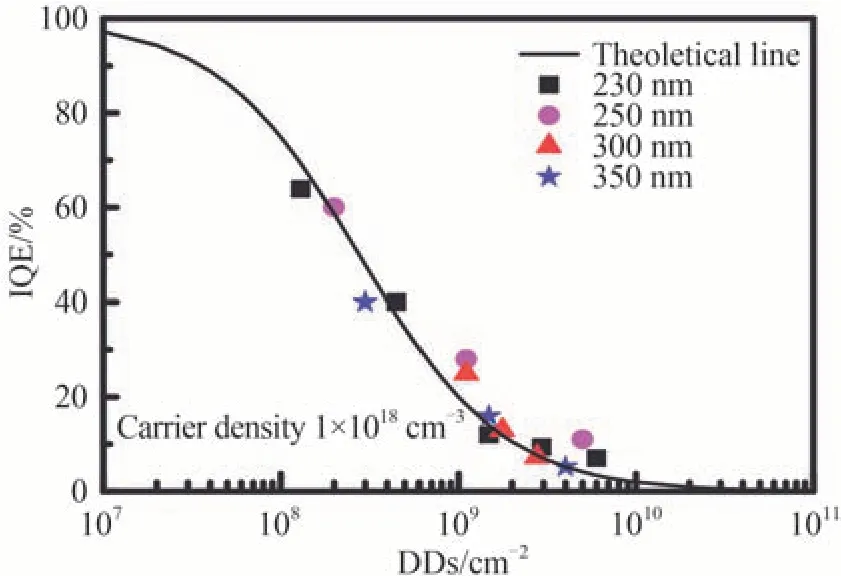
图10 AlGaN 多量子阱内量子效率(IQE)随量子阱中位错密度(DD)的变化[68]Fig.10 Variation of internal quantum efficiency of AlGaN multiple quantum wells with dislocation density in quantum wells[68]
尽管AlGaN 薄膜生长过程中存在困难,但由于其突出的应用前景,高质量的AlGaN 材料的生长始终是研究热点,也取得了许多成果。为了减少蓝宝石衬底上AlGaN 层的应力,得到高质量AlGaN 外延层,研究者们采用各种插入层技术或AlN 模板来调节应力,抑止裂纹产生。KAMIYAMA S 和AMANO H 等[69-70]分别提出了低温AlN 和AlGaN 插入层技术,获得了无裂纹的AlGaN 外延层。但是这种方法由于低温插入层的质量较低,会导致后续的AlGaN 外延层质量的劣化,而多层低温缓冲层的插入需要多个升降温过程,导致更多的热失配应力积聚,也使得这种方法的效果打了折扣。BYKHOVSKI A D 等[71]和ZHANG J P 等[72-73]分别采用GaN/AlN 以及GaN/AlGaN 超晶格结构来缓解张应力。AlN 材料的晶格常数小于AlGaN 的晶格常数,当在蓝宝石上采用AlN 模板生长AlGaN 材料时,AlGaN 会受到压应力而不易龟裂,并且AlN 的带隙宽度大,对高于200 nm 波长的紫外光完全透明。同时,AlN 材料具有优良的热导性能和热稳定性。研究结果表明,AlN 基板可以改善Ⅲ族氮化物的晶体质量,降低位错密度。所以,高质量的AlN 模板可以提高AlGaN 质量,从而提高深紫外器件的性能。然而,由于c 面蓝宝石和AlN 之间的面内晶格失配高达13%,以及TMAl 和NH3之间存在强烈的气相预反应,AlN 模板生长也面临着严峻的挑战。
此外,日本滨松光子学株式会社采用了一种侧向外延(Epitaxial Lateral Overgrowth,ELO)技术,在AlGaN 模板上制备SiO2条状掩膜,并进一步侧向外延AlGaN 材料,成功获得了Al 组分高达30%的高质量无裂纹AlGaN 外延层。但值得注意的是,这种方法对于高Al 组分的AlGaN 材料有一定的局限性,Al 组分不宜过高,上限约为30%。而且ELO 工序复杂,需要光刻、干法刻蚀以及后续的退火等过程[74]。VENNEGUES P 等报道称[75],GaN 模板上生长的髙温(High Temperature,HT)AlN 插入层通过形成V型槽结构能够有效地释放应力。因此采用MOCVD 方法在高质量GaN 模板层上,以HT-AlN 为插入层,生长了高Al 组分AlxGa1-xN(0.33≤x≤0.79)外延薄膜。研究发现,HT-AlN 插入层中的V 型槽结构对AlGaN 外延层的生长能够起到亚微米横向外延(ELO)作用,而且AlN 插入层能够有效地缓解AlGaN 薄膜中的应力,从而获得高质量无裂纹的AlGaN 薄膜。与ELO 生长方法相比,该方法具有成本低、生长工序简单等优点。
除了以上研究和探索来提高AlGaN 薄膜生长质量,目前还存在其他的改良方法:1)Al 组分渐变的AlGaN 缓冲层;2)图形化衬底等手段改善AlGaN 薄膜的晶体质量;3)表面活性剂TMIn 辅助生长,增强高Al组分AlGaN 表面吸附单体的迁移率来降低缺陷密度;4)两步生长法[76]或三步生长法[77]等。以上四种方法均可以在一定程度上提高AlGaN 晶体质量。
2.1.2 DBR 的制备
混合DBR 结构,即下DBR 为外延生长的氮化物DBR,上DBR 为介质膜(如:氧化物)DBR,这种结构仍然要面临着与全氮化物DBR 相同的外延困难。全介质膜DBR 结构,即上、下DBR 均由介质膜(通常为氧化物)材料构成。常用的DBR 材料有SiO2、HfO2、Ti3O5、Ta2O5、TiO2、ZrO2等。选用其中合适的材料,如:SiO2/TiO2、SiO2/Ta2O5、HfO2/SiO2、SiO2/ZrO2等能以较小的对数实现99%以上的反射率。由于介质膜材料种类多,折射率差较大,且制备工艺技术成熟,易于获得宽带宽、高反射率的DBR。但在紫外尤其是深紫外波段,许多氧化物同样存在着强烈的光学吸收。因为SiO2和HfO2在紫外光段具有较低的消光系数,可以有效地避免对紫外光的吸收,通常采用SiO2作为DBR 中的低折射率材料,而高折射率材料常用HfO2。各种氧化物在300 nm 处的折射率与消光系数如表1所示。

表1 各种透明氧化物在300 nm 左右的折射率与消光系数Table 1 Refractive indes and extinction coefficients for various transparent oxides around 300 nm
2.1.3 衬底的转移
全介质膜DBR 结构虽然有着宽带宽、高反射率等优点,但是需要去除外延生长使用的原始衬底并将氮化物薄膜转移到其他支撑衬底上以沉积上DBR。这种制备方式增加了器件制备工艺的复杂性。2008年日亚化学报道了第一支基于全介质膜DBR 结构的GaN VCSEL 的室温连续激射[50]。器件外延使用蓝宝石为衬底,之后将样品键合到了Si 支撑基底上,并使用激光剥离的方法将蓝宝石衬底去除。
AlGaN 外延片常用的衬底为蓝宝石衬底,是一种硬度大、禁带宽度大的材料。通常剥离蓝宝石衬底的方法有三种:激光剥离(Laser Lifted Off,LLO)[81-83]、选择带隙的光电化学腐蚀(Bandgap Selected Photoelectrochemistry Etching,BGS-PECE)[84-89]和氢氛围的各向异性热腐蚀(Hydrogen-environment Anisotropic Thermal Etching,HEATE)[90-93]。BGS-PECE 对牺牲层的极性、导电类型和带隙的宽度都有要求,Ga 极性和p 型导电材料都会使得牺牲层难以被腐蚀,并且牺牲层的带隙必须是整个外延结构中最小的。如果横向腐蚀的速率较低,则无法实现衬底与外延层的大面积剥离,这些因素都限制了该技术的应用。HEATE 方法的横向分解速率也较低,同样不利于外延片的大面积剥离。
相比之下,LLO 适用的范围更广,其原理是采用激光加热分解氮化物,只需要材料对该波段的光有吸收。通过激光加热与蓝宝石接触的外延层,当光密度达到阈值,材料就会因为吸光而产生热使自身分解,达到衬底剥离的效果。但是,相比于GaN 材料,AlGaN 材料的禁带宽度大,吸收系数小,分解温度高,使得激光剥离AlGaN 外延层更具挑战。通常,剥离AlGaN 外延层需要考虑以下几个问题:
1)若AlGaN 外延层生长在GaN 模板层上,则会导致整个AlGaN 外延层都受到了较大的张应力,而在激光剥离的过程,产生的瞬时高温使得外延层进一步膨胀,从而裂开。在较大的剥离能量下,会导致大部分AlGaN 外延层脱落。所以,为了较为完整的激光剥离效果,合适的剥离条件至关重要。
2)若AlGaN 外延层使用了AlN 模板层,则一般通过分解生长于AlN 层上的AlGaN 层来实现衬底的剥离,这需要所用的激光具有较高的能量密度,并且AlGaN 层对该激光有较高的吸收。ZHENG Z 等[65]制备的UVC VCSEL 就是利用了这种方式。
3)由于激光剥离后外延片表面的粗糙度会极大地影响腔内光学损耗,从而影响腔的品质因子。粗糙度越大,光学散射损耗越大。同时,波长越短,散射损耗也越大。所以,在深紫外波段,散射损耗是一项很重要的损耗,激光剥离后需要对AlGaN 表面进行平滑,例如化学机械抛光(Chemical Mechanical Polishing,CMP)。
2.2 电泵VCSEL
由于电泵VCSEL 和光泵VCSEL 的载流子注入方式不同,所以电泵VCSEL 在结构上要比光泵更复杂,困难更多:1)需要电流扩展结构以便向有源区提供足够且稳定的高浓度载流子,达到粒子数反转,形成持续的输出光。特定波段电泵VCSEL 的电流扩展层,需要同时满足电流输运和光子透过性。2)尽可能高的载流子注入效率。对于短波长尤其是深紫外波段VCSEL,垒层与电子阻挡层的带阶更小,电子的泄露更为严重,所以要考虑合理设置电子阻挡层(EBL)。
2.2.1 电流扩展层
在GaAs 基VCSEL 中,高电导率的GaAs/AlGaAs DBR 较容易实现。因此,电极一般都沉积在DBR 表面,电流穿过DBR 均匀注入谐振腔,不产生拥堵,如图11(a)所示[94]。但在GaN VCSEL 中生长高电导率的氮化物DBR 十分困难,尤其是p 侧DBR。因此GaN VCSEL 如果想要进行电注入就必须制备腔内接触电极,使电流绕过DBR 注入谐振腔,如图11(b)所示[26]。除了工艺较为复杂外,腔内接触电极结构也会造成电流拥堵,增大器件串联电阻以及增大谐振腔内吸收。另外由于p-GaN 的低电导率,必须在电极金属与p-GaN 之间制备电流扩展层,通常做法是沉积氧化铟锡(ITO)层或者生长隧道结以实现欧姆接触与电流扩展。

图11 VCSEL 的腔内接触[94,26]Fig.11 Intracavity contact of VCSEL[94,26]
ITO 是宽带隙的薄膜材料,其带隙为3.5~4.3 eV。由于ITO 同时具有良好的导电性和透光性,所以在可见光VCSEL 中已经得到较多的应用。但ITO 对紫外波段具有非常高的吸收系数,不适合应用于紫外VCSEL。目前有希望使用隧道结(Tunnel-junction,TJ)或者新型二维导电材料如石墨烯等作为电流扩展层以减小光学损耗,提升器件性能。最近一些AlGaN 基隧道结的应用[95-99]证明了其应用于电注入UV VCSEL的重大潜力。隧道结,即利用电子的隧穿效应,一般是重掺杂的p 区(费米能级进入价带)的价带电子隧穿到相邻的重掺杂的n 区(费米能级进入导带)的导带,从而实现导电功能。
2015年,瑞士洛桑理工学院的MALINVERNI M[98]等将埋入式的隧道结(Buried Tunnel Junction,BTJ)结构引入GaN微型LED 中。结构如图12,采用分子束外延生长GaN 隧道结,在净受主浓度接近1020cm-3的情况下实现了具有超薄耗尽宽度的p-n 结,从而实现有效的带间隧穿。此隧道结在器件中呈现n-p-n 结构,10 V 反向偏压下表现出小于5×10-5A cm-2的低泄漏电流密度。而在正向偏压3.3 V 和4.8 V 时,电流密度分别为20 A·cm-2和2 000 A·cm-2,在+5 V 测量下整个器件的比串联电阻为3.7×10-4Ω·cm2。通过隧道结结构,使得整个LED 实现了良好的电流限制与均匀的电注入,同时也证明了隧道结结构能在Ⅲ族氮化物中实现,以此替代传统的透明导电氧化(Transparent Conducting Oxide,TCO)层。

图12 埋入式隧道结结构示意图[98]Fig.12 Schematic diagram of the buried tunnel junction[98]
2016年,加利福尼亚大学的LEONARD J T 研究了405 nm VCSEL 中的ITO 膜层和隧道结两种结构在光学损耗、散热、输出功率三方面的区别[100]。根据图13 中多层ITO 薄膜的折射率和吸收系数分布[99,101-102],ITO 薄膜在紫光波段吸收系数高,在405 nm VCSEL 中ITO 造成的损耗占其总内部损耗的比例约为74%(~30 cm-1)。由于n 型氮化物在短波长(尤其是紫外)的吸收系数小于ITO,所以不仅无需限制TJ 厚度,而且还可以通过增大TJ 厚度改善电流扩散,实现了极低的损耗。在LEONARD J T 的另一项关于TJ 的研究中[99],通过使用TJ 能够将VCSEL 的模拟阈值模态增益降低到约14 cm-1,腔内接触实现<5 cm-1的损耗,突出了TJ 结构对于紫光和紫外VCSEL 在改善电流扩散和减小损耗两个方面的重要性。

图13 多层ITO 薄膜的折射率和吸收系数分布[98,100-101]Fig.13 Refractive index and absorption coefficient dispersion for multi-layer ITO films[98,100-101]
表2 列出了该器件p 侧各层材料的导热系数[103-106],具有隧道结结构的VCSEL 结构如图14所示,结合表3 和图14 可以得到,氮化物的散热能力高于氧化物,使用TJ 替代ITO 可以有效改善散热。由于p-GaN对紫外波段的吸收高于n-GaN,所以对于TJ,可以减小p-GaN 厚度以改善光学损耗,有效提升VCSEL 的性能。在12 μm 的孔径下,TJ VCSEL 的峰值功率约为550 μW,阈值电流密度约为3.5 kA/cm2,而ITO VCSEL 的峰值功率约为80 μW,阈值电流密度约为7 kA/cm2。结果表明,TJ 结构的引入降低了VCSEL 的阈值电流密度,提高了峰值功率。

表2 图14 中双介质DBR VCSEL 的p 侧部分材料的典型室温导热系数Table 2 Typical thermal conductivities for some of the materials on the p-side of the VCSEL in Fig.18 at room-temperature

图14 具有隧道结(TJ)结构的VCSEL 结构示意图[100]Fig.14 Schematic diagram of a VCSEL with TJ[100]
2.2.2 载流子注入效率(载流子泄露、p 掺杂)
2.2.2.1 电子阻挡层
对于AlGaN 基VCSEL,由于AlGaN 的p 型掺杂更加困难,导致载流子非平衡注入有源区的情况严重,电子从有源区泄露到p 区也更严重。因此,需要设计更优的电子阻挡层(EBL)来阻止电子泄露。由于在紫外VCSEL 中,尤其是深紫外波段,电子势垒层需要与量子阱中的垒层形成有效的电子带阶,材料可选择范围越来越小,必须采用AlN 或高Al 组分AlGaN 层。
在2014年,MEHNKE F 等用AlN 作为深紫外LED 的EBL[107],改善了电子泄露的问题和外量子效率。但是较厚的AlN 会带来导电性不足的缺陷;厚度变薄时,又会增加电子隧穿的概率。
1986年日本的伊贺健一等提出了多量子势垒(Multiquantum Barrier,MQB)的概念,由于电子波动性明显,MQB 对电子波存在着干涉增强的作用,合理设置各层厚度可使得对电子的反射率提高,进而起到对电子的阻挡效果[108]。2010年,日本的HIRAYAMA H 等报道了将MQB 引入深紫外LED 来提高外量子效率[109],器件结构如图15。通过将“有效”势垒高度增加了30%~50%,最终将250~260 nm 波段AlGaN LED的外量子效率(EQE)提高了2.5 倍以上。这说明MQB 结构的EBL 可以有效改善深紫外AlGaN 发光器件的性能。

图15 具有多量子势垒电子阻挡层的250 nm AlGaN 多量子阱LED 的示意图结构[109]Fig.15 Structure of the 250 nm AlGaN MQW LED with MQB EBL[109]
2.2.2.2 p 型掺杂AlGaN 材料生长
在GaN 基VCSEL 中,p 型AlGaN 层的掺杂一直很难提高,影响了空穴横向扩展能力,所以需要额外的电流扩展层以改善电流拥堵问题。目前,镁(Mg)是用于Ⅲ族氮化物最普遍的p 型掺杂剂。然而,因为Mg 受主的激活能大[110],获得高电导率p 型AlGaN 层仍然比较困难。图16 总结了Mg 掺杂AlGaN 中的激活能与Al 组分的变化关系[111-116]。Mg 的激活能从GaN 中的~170 meV 增加到AlN 中的630 meV。高的激活能意味着高Al 组分氮化物在常温下只有少部分(约1/109)的Mg 受主杂质热激活出空穴[117],这直接导致空穴浓度的下降,电阻率增大。

图16 Mg 受主激活能大小随Al 组分x 的变化[111-116]Fig.16 Variation of Mg acceptor activation energy with Al component x[111-116]
其次,Mg 在GaN 和AlN 中的固溶度低,影响了AlGaN 薄膜的有效掺杂效率。由于AlN 中的MgAl 形成焓比GaN 中MgGa 形成焓高得多,Mg 在AlN 中的固溶度比在GaN 中的固溶度低几十倍。因此,随着Al 组分增大,AlGaN 薄膜中Mg 固溶性问题变得愈加严重[118-119]。在高Al 组分AlGaN 薄膜中,受固溶度的限制,Mg 原子的掺入量低,因此相应的空穴浓度也更低。为了实现高空穴浓度,实验上通常会增大Mg 掺杂剂浓度(1020~1021cm-3)。然而,随着Mg 掺杂浓度的增大,空穴浓度会先达到饱和;若Mg 掺杂浓度继续增大,则空穴浓度会下降,形成价带尾态和杂质带。同时,当过量的Mg 掺入时,容易导致晶体质量变差,大量缺陷充当空穴的俘获或者散射中心,反而减小空穴浓度和迁移率[120]。
最后,在p 型AlGaN 材料中存在高密度的补偿缺陷,如氮空位VN[121-122],MgGa-VN[123-124],间隙Mg 原子Mgi[125]等。其中,MgGa代表占据Ga 的Mg 原子;而VN作为受主补偿中心,常常导致p 型GaN 中出现2.92 eV光致蓝光峰。相比于GaN,由于VN在AlN 中的形成能更低,VN更容易形成[121,126]。通常间隙Mg 在Ⅲ族氮化物中充当双施主[127]。由于p 型AlGaN 中的大部分点缺陷充当施主角色,自补偿效应增强,导致载流子浓度和迁移率下降。此外,在MOCVD 生长过程中,Mg 掺杂同时会引入O 和H 杂质,其中,O 通常充当施主,不利于p 型导电,而形成的Mg-H络合物使Mg 被钝化[128],在GaN 材料中Mg-H络合物的成键方式分别为(a)MgGa-N-H,(b)MgiH2,(c)MgGa-N-Gai-H2,(d)MgGa-N-Mgi-H[129-130]。只有经过高温退火后或者电子束照射后才能实现激活,获得空穴载流子。
Ⅲ族氮化物的高效p 型掺杂一直是国际性的难点,尤其对高Al 组分的AlGaN 而言,由于受主能级位置随着Al 组分增大而变深,获得低阻、高空穴浓度的难度显著增加。近年来,国际上对AlGaN 的p 型掺杂研究,除了均匀Mg 掺杂还包括:超晶格掺杂、Mg-δ掺杂法、金属调制掺杂、渐变Al 组分极化场掺杂以及其他掺杂剂等方法:
1)超晶格掺杂近年来,调制掺杂的p 型超晶格结构被用于提高Mg 的激活效率。在窄带隙GaN 层和宽带隙AlGaN 层构成的GaN/AlGaN 超晶格结构中,Mg 均匀掺杂浓度达到~1018cm-3。由于能带结构的周期性改变,空穴可以扩散到窄带隙区,使整体空穴浓度增大。SIMON J 等理论上预测[131],接近50%的受主被激活,比未由能带调制的薄膜高出10 倍左右。然而,如果AlGaN 层太厚,二维空穴气可能会聚集在超晶格界面处,这限制了自由空穴在垂直方向上的输运。为此,采用超薄AlGaN 层的短周期超晶格结构,通过量子遂穿或者热电发射过程实现空穴的垂直方向输运[132-133]。在应变界面的强极化场作用下,Al 组分为60%以上的薄膜中,受主激活能降低了17 meV[133]。这种短周期超晶格结构己经应用于AlGaN 基的深紫外LED 器件中[134-136]。另外,NIKISHIN S A 等提出了由AlN 作为垒层(1.75~1.5 nm),Mg 掺杂Al0.08Ga0.92N 作为阱层(0.5~0.75 nm)所构成的短周期超晶格结构,实现了空穴浓度为1×1018cm-3,低电阻率为6 Ω·cm[137]。同时,Mg 掺杂AlxGa1-xN/AlyGa1-yN 短周期的超晶格结构也应用在紫外LED 器件中[113],作为透明p 型电极且吸收率低。
2)δ掺杂法是指在生长过程中,脉冲式进行Mg 掺杂,使掺杂原子浓度在生长方向上呈现出类似δ函数分布的一种掺杂方法,即杂质只分布于掺杂层,其它区域为0。这样,Mg 掺杂薄层减小了自补偿,提高了Mg在Al 或者Ga 位的并入[138]。这种方法有利于减小受主激活能,提高空穴浓度。CHEN Y D 等提出在Mg 的δ掺杂过程中采用In 作为表面活性剂[139],在Al 组分高达40%的p 型AlGaN 薄膜中,空穴载流子浓度达到4.75×1018cm-3。
3)金属调制掺杂金属调制外延法(MME)适用于MBE 生长。在生长过程中,Mg 源和Ga 源周期性地切换。NAMKOONG G 等采用MME 方法对GaN 进行掺杂[140],空穴浓度能够达到1019cm-3。但是,采用该方法生长无反相畴结构的高Al 组分AlGaN 非常困难。而且,由于MgAl的形成能高,Mg 原子不容易替换Al 位置,因此,迄今采用该方法生长的p 型AlGaN 中的最高Al 组分仅为27%。
4)渐变Al 组分极化场掺杂由于AlGaN 属于极性材料,其异质结薄膜在某一晶格方向上具有内建电场。在异质结界面上存在的极性掺杂特征导致界而处出现一层高密度载流子。SIMON J 等提出一种组分渐变的异质层[141],电荷分布满足于ρ(z) =-∇·P(z)。其中,ρ(z)为电荷密度,∇为散射算符,P(z)是极化强度。当AlxGa1-xN 在(000)面上,从Al 组分x=0(GaN)渐变到x=1(AlN)生长时,此时薄膜存在着张应变,极化电荷为负电荷(ρ<0),相同数量的空穴会从各种受主杂质或者缺陷中产生来中和负电荷,效果类似于p 型掺杂。
考虑改变Al 组分渐变方向即从x=1(AlN)到x=0(GaN)渐变生长,ZHANG L 等提出了在厚AlN 缓冲层上生长组分渐变的AlGaN 层。由于厚A1N 缓冲层可以被认为是完全弛豫,因此在Al 极性面上没有应变,只存在自发极化现象[142]。由于存在晶格失配,在AlN 缓冲层上生长的AlGaN 中的应变为压应变,存在自发极化和压电极化,在AlN/AlGaN 界面上的净电荷密度为负,导致渐变的AlGaN 层出现自由移动的空穴,类似于p 型掺杂作用。目前,尽管该方法能够实现诱导产生空穴,但在器件应用方面,非故意掺杂下的载流子数量,尤其空穴数量不足[143-144]。但通过结合极化诱导方法与有意掺杂手段,能够获得接近简并的p 型掺杂效果。
5)尝试其他掺杂剂由于Mg 掺杂AlGaN 生长困难,人们也在尝试其它可能的掺杂剂。2012年,KAWANISHI H 等将碳作为掺杂剂制备p 型AlGaN 薄膜[145],Al组分为10%时,其空穴浓度达到3.2×1018cm-3。2013年,LI S 等采用Be 掺杂剂,用MBE 生长出极化掺杂的线性渐变AlxGa1-xN(x变化范围为70%~100%),诱导空穴浓度达到1018cm-3[146]。
3 总结及展望
1979年VCSEL 的问世标志着新型激光器的历史元年,而如今,距离实现第一个GaN VCSEL 已有二十多年,凭借着单色性好、方向性好、圆形光斑、可二维集成等优点,GaN VCSEL 的应用场景已经覆盖了照明、通信、投影显示、光存储、医疗、微型原子钟及传感器等各个方面。
自从1995年HONDA T 等首先对GaN VCSEL 的阈值特性进行理论计算研究以及1996年REDWING J M 等实现第一个光泵GaN VCSEL,世界各大研究机构对GaN VCSEL 的研究脚步就从未停止,之后的二十年,GaN VCSEL 的研究进展迅猛。东京大学、布朗大学、日本NTT 公司、厦门大学、台湾交通大学、瑞士洛桑理工大学等机构的研究小组也相继实现了各种结构GaN VCSEL 的光泵激射。2008年,台湾交通大学的王兴宗研究组成功实现了世界上第一支电注入GaN VCSEL,标志着GaN VCSEL 发展的新纪元。随后越来越多的研究人员投入到电注入GaN VCSEL 的研发之中,如今蓝光和绿光VCSEL 已经实现光泵和电泵激射,而紫外VCSEL 已经延伸到了深紫外波段,目前为止实现了最短波长275.9 nm 的光泵激射,电注入紫外VCSEL 的解决方案还在研究当中。
对于紫外VCSEL,氮化镓(GaN)、氮化铝(AlN)及其三元合金的Ⅲ族氮化物,具有直接带隙宽、高击穿电压、高热稳定性以及高的发光效率,AlGaN 在光学以及电学应用方面有着广阔的前景,值得进一步研究以及探索。随着氮化物VCSEL 的探索逐渐向紫外和更短波长延伸,基于AlGaN 材料的深紫外VCSEL 是今后研究的热点。然而,基于AlGaN 的紫外VCSEL 具有极大的挑战性,存在不少困难:1)低位错密度、高晶体质量的AlGaN 外延层的获得;2)低损伤的AlGaN 外延片激光剥离工艺;3)良好的电流扩展结构,以减少载流子注入过程中的损耗;4)良好的光学限制结构,以减少光的损失;5)合适的电子阻挡层,减少载流子泄露以提高载流子注入效率;6)AlGaN 的p 型掺杂仍然是亟需解决的关键问题。虽然存在着不少技术困难,但基于AlGaN 的紫外VCSEL 的未来仍充满了机遇,随着紫外,特别是深紫外波段在医疗诊断、生化医学与防治、原子捕获、光谱学、激光光刻、激光高密度存储等重要的领域有着更大的需求,它将成为支持未来信息社会必不可少的关键组件。
