N掺杂对 β -Ga2O3薄膜日盲紫外探测器性能的影响*
2021-09-17周树仁张红莫慧兰刘浩文熊元强李泓霖孔春阳叶利娟李万俊
周树仁 张红 莫慧兰 刘浩文 熊元强 李泓霖 孔春阳 叶利娟 李万俊
(重庆师范大学物理与电子工程学院, 重庆市光电功能材料重点实验室, 重庆 401331)
单斜氧化镓(β-Ga2O3)材料因其独特而优异的光电特性在日盲紫外探测领域具有广阔的应用前景, 受到国内外研究者的广泛关注.本研究工作采用射频磁控溅射技术, 在c面蓝宝石衬底上制备了未掺杂和氮(N)掺杂β-Ga2O3薄膜, 研究了N掺杂对β-Ga2O3薄膜结构及光学特性的影响; 在此基础上, 构筑了未掺杂和N掺杂β-Ga2O3薄膜基金属-半导体-金属(metal-semiconductor-metal, MSM)型日盲紫外探测器, 并讨论了N掺杂影响器件性能的物理机制.结果表明, N掺杂会导致β-Ga2O3薄膜表面形貌变得相对粗糙, 且会促使β-Ga2O3薄膜由直接带隙向间接带隙转变.所有器件均表现出较高的稳定性和日盲特性, 相比之下, N掺杂β-Ga2O3薄膜器件能展现出较低的暗电流和更快的光响应速度(响应时间和恢复时间分别为40和8 ms),与氧空位相关缺陷的抑制密切相关.本研究对开发新型的高性能日盲紫外探测器具有一定的借鉴意义.
1 引 言
日盲紫外光(200—280 nm)在进入大气层时会被臭氧层吸收, 故地球表面几乎不存在该波段的光.因此, 日盲紫外光电探测器具有较高的灵敏度和准确率[1,2], 在导弹跟踪、安全通信, 臭氧空洞检测、火灾探测等军事和民用领域有较大的应用前景[3,4].一般而言, 日盲紫外探测器选用禁带宽度大于4.4 eV的半导体材料, 目前主要集中在AlxGax–1N[5],ZnMgO[6], 金刚石[7]和单斜氧化镓(β-Ga2O3)[8]上.作为一种新型超宽禁带半导体材料, β-Ga2O3较宽的本征禁带宽度(4.9 eV)可以避免复杂的合金化过程, 同时因具有较高的热稳定性、化学稳定性和较高的临界击穿场(~8 MV/cm)等优点, 被认为是天然的日盲紫外探测材料[1,9].β-Ga2O3材料有单晶[10]、纳米结构[11]、薄膜[12]等形态, 且基于不同形态的日盲紫外探测器已得到证实[8,13].薄膜型光电探测器, 因具有重复性好、制备简单、便于实际应用等优点而备受关注.在常见薄膜型光电探测器结构中, 金属-半导体-金属(metal-semiconductormetal, MSM)结构的光电探测器具有制作方法简单和器件性能相对高的优势[13].然而, β-Ga2O3的生长过程中往往会形成一定量的氧空位(VO)相关缺陷[14], 其作为载流子俘获中心往往导致器件表现出低响应速度, 高暗电流, 这极大限制了器件的探测性能[15].因此, 如何减少VO相关缺陷对改善器件性能是非常有必要的.事实上, 除了控制生长工艺和后期氧氛围下的热处理之外[16,17], 受主杂质掺杂已被证明是减少异质外延氧化物薄膜中VO的有效方法[18−21].例如, Guo等[18]发现, 在Zn掺杂β-Ga2O3中, VO浓度随着Zn掺杂浓度升高而降低, 从而导致Zn掺杂器件的暗电流更低, 光暗比更高, 光响应速度更快.Chen等[19]利用Mg掺杂β-Ga2O3有效减少了薄膜内部的VO浓度, 掺杂后器件的暗电流明显减小.类似地, Yao等[20]通过N掺杂ZnO薄膜, 使薄膜内部VO大量减少.Balasubramaniam等[21]发现, 通过Al-N共掺ZnO可以降低VO相关缺陷, 使器件光暗比大幅度提高,光响应速度加快.此外, N3–的离子半径和电子结构接近O2–, 被认为是一种有效的受主掺杂剂[22].早在2011年, Chang等[23]通过N掺杂实现了高导电的p型Ga2O3纳米线.然而, 基于N掺杂β-Ga2O3薄膜日盲紫外探测器方面的研究却鲜有报道[24].理论研究发现, N掺杂容易进入VO相关缺陷, 并表现出较强的光吸收和明显的电子、空穴迁移率差异[22], 可能有助于提升器件光电性能.
为此, 本文报道了利用射频磁控溅射技术在c面蓝宝石衬底上外延生长未掺杂和N掺杂β-Ga2O3薄膜, 以及MSM结构光电探测器的制备和表征; 研究了N掺杂对β-Ga2O3薄膜结构和光学特性、以及薄膜中缺陷种类和含量的影响, 并详细讨论了N掺杂对器件光电性能的影响机制.结果表明, 引入N杂质使β-Ga2O3薄膜的光电特性能得到有效提升, 成为一种极具应用前景的快速响应日盲紫外光电探测器件.
2 实验过程
2.1 材料和器件的制备
本实验结合射频磁控溅射技术和后期热处理工艺, 在c面(0001)蓝宝石衬底上沉积了未掺杂和N掺杂β-Ga2O3薄膜.溅射靶材选用商业化的Ga2O3陶瓷靶(99.99%).沉积前, 衬底先后在酒精和丙酮中进行10 min的超声清洗; 经去离子水漂洗后, 放置于流动的高纯N2氛围下干燥.在薄膜生长过程中, 通过调节Ar∶N2流量比(Ar∶N2= 40∶0,32∶8, 28∶12, 24∶16, 总流量为40 sccm)实现不同浓度的N掺杂β-Ga2O3薄膜.腔体本底真空度为5.0 ×10–4Pa, 溅射功率、气压及时间分别为150 W,2 Pa和1.5 h.随后, 将所有样品放置于管式退火炉中进行900 °C, 2 h退火, 退火氛围为Ar.最后,利用金属掩膜板在β-Ga2O3薄膜表面上溅射沉积三对Ti/Au叉指电极(指间距均为200 µm), 制备出MSM结构型β-Ga2O3日盲紫外探测器件.
2.2 样品表征与器件性能检测
采用FEI Inspect F50型扫描电子显微镜表征薄膜形貌.通过Bruker D8ADVANCE A25X型X-射线衍射仪(Cu Kα1, λ = 0.1540598 nm)分析薄膜晶体结构.使用LabRAM HR Evolution型激光共聚焦拉曼光谱仪采集拉曼散射光谱和光致发光谱, 激发光源分别为532和325 nm激光器.采用U-4100型紫外-可见-近红外分光光度计采集薄膜的透射谱和吸收谱.采用Keithley 2450源表测试基于β-Ga2O3薄膜光电探测器的伏安(I-V)及光响应特征(I-t)曲线.上述所有测试均在室温下进行.
3 结果分析
图1 (a)—(d)给出了不同浓度N掺杂β-Ga2O3薄膜的SEM图.从图1(a)中可以看出, 未掺杂β-Ga2O3薄膜(样品A)表面由尺度均匀的小颗粒构成且较为平坦.相比之下, N掺杂β-Ga2O3薄膜的表面较为粗糙, 如图1(b)—(d)所示.其中, 样品C(Ar:N2=28:12)的表面形貌较平滑, 而样品B(Ar:N2= 32:8)和D (Ar:N2= 24:16)的表面出现了尺度不一的大颗粒.SEM测试结果表明, N2流量占比过低或过高均不利于获得表面平整的N掺杂β-Ga2O3薄膜, 类似现象也被Luan等[25]所报道.图1(e)显示了不同浓度N掺杂β-Ga2O3薄膜的XRD图谱.所有样品在18°, 38°和58°附近都呈现出明显的衍射峰, 分别对应β-Ga2O3晶体的(–201),(–402)和(–603)晶面[26], 另外, 样品A还出现了(–313), (–113), (–801), (–020)晶面衍射峰, 与β-Ga2O3标准卡(JCDPS # 43-1012)的位置一致, 表明通过磁控溅射和后期退火工艺制备的薄膜均为β-Ga2O3薄膜.进一步发现, N元素的引入会导致所有特征峰的强度大幅度削弱, 且随着N2流量占比增加, N掺杂β-Ga2O3薄膜的(–201), (–402)和(–603)晶面衍射峰强度和半高宽(full width at half maximum, FWHM)大小分别呈现先增大后减小、先减小后增大的变化趋势(图1(e)).图1(f)为相应N掺杂β-Ga2O3薄膜的拉曼光谱.除衬底峰外, 仅观察到β-Ga2O3预期的15种振动模式中的9种,分 别 位 于145.7, 170, 201.4, 319.2, 347.9, 474.4,630.3, 653.1, 768.4 cm–1处[27], 进一步证实制备的薄膜为单相β-Ga2O3薄膜.其峰位大致可分为三类: 低频峰、中频峰、高频峰, 低频峰(低于200 cm–1)归因于GaO4四面体/Ga2O4八面体链的平移与振动, 中频峰(300—500 cm–1)与Ga2O4八面体的变形有关, 高频峰(500—800 cm–1)源于GaO4四面体的弯曲和拉伸[27].另外, 在230.7 cm–1处的振动模式对应于红外振动模式Eu(TO/LO)[28].对比图1(e)和图1(f)可以看出, 随N2流量占比的增加, N掺杂β-Ga2O3薄膜的201.4 cm–1拉曼特征峰强度和FWHM大小都与XRD (–201)衍射峰的变化规律一致, 具体值可参见表1.从以上分析可知, N元素的引入影响了β-Ga2O3的晶格, 影响了薄膜晶体质量, 并且随N2流量占比增加, N掺杂β-Ga2O3薄膜结晶质量呈现出先变好再变差的规律(样品C的结晶质量最优).
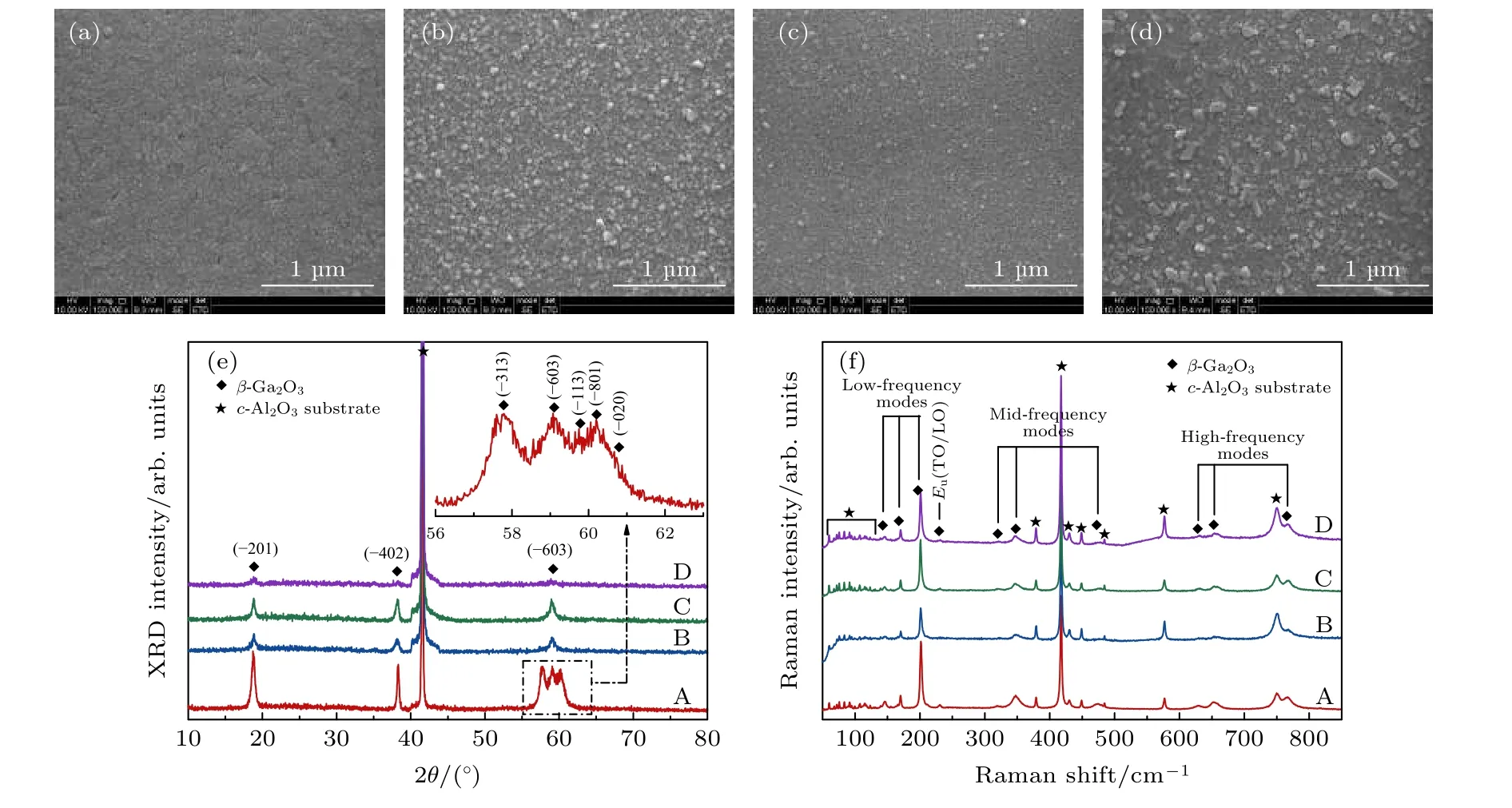
图1 N掺杂β-Ga2O3薄膜的表面形貌和晶体结构 (a)—(d) SEM图; (e) XRD图谱; (f) Raman光谱Fig.1.Surface morphology and crystal structure of N-doped β-Ga2O3 films: (a)−(d) SEM; (e) XRD; (f) Raman spectra.

表1 不同N掺杂浓度β-Ga2O3薄膜的(–201)衍射峰和201.4 cm–1拉曼特征峰的半高宽Table 1.Full width at half maximum (FWHM) of XRD diffraction peak and Raman peak.
图2(a)为不同浓度N掺杂β-Ga2O3样品的透射谱.在可见光区域, 样品均具有较高的透射率(平均透射率 > 95%); 在紫外光区域, 所有样品在250 nm左右均有一个陡峭的吸收边.随着掺杂N浓度的增加, β-Ga2O3薄膜的吸收边发生轻微蓝移.众所周知, 半导体材料的光学带隙与吸收系数之间满足Tauc关系式[29]:
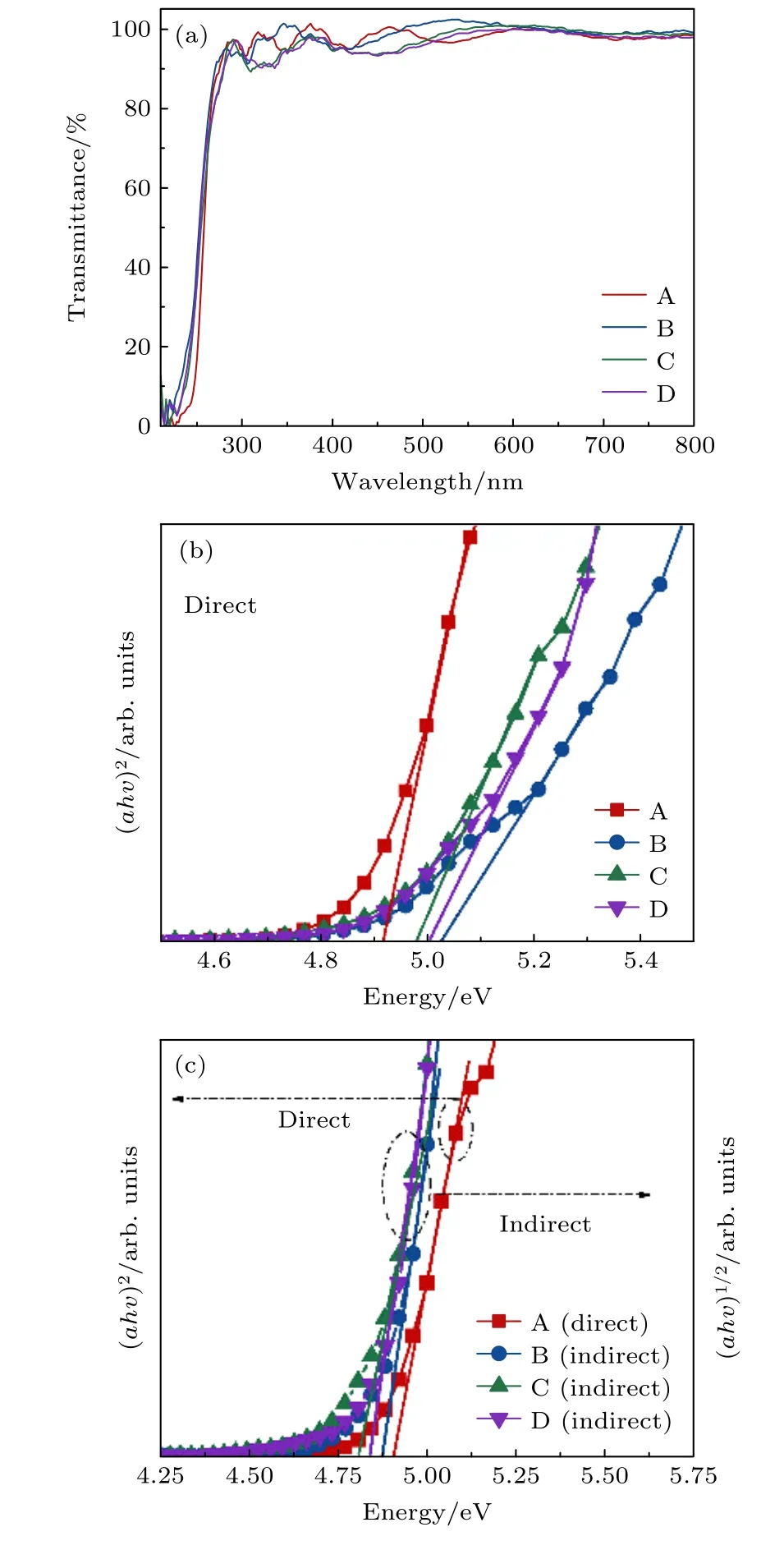
图2 (a)不同浓度N掺杂β-Ga2O3薄膜的透射光谱; (b),(c) 在直接和间接带隙下利用Tauc公式外推光学带隙图Fig.2.(a) Transmission spectra of β-Ga2O3 films doped with different N concentrations; (b), (c) Tauc plots for samples under assumptions of an indirect bandgap and a direct bandgap.

其中, α为吸收系数, hυ为光子能量, b是常量,Eg为光学带隙.当n = 1/2时, 该关系式对应直接光学带隙材料; 当n = 2时, 该关系式对应间接光学带隙材料.利用hυ和α之间的Tauc关系式, 通过外推法可估算出薄膜的光学带隙(Eg).鉴于未掺杂β-Ga2O3为直接带隙, 公式(1)中的n应取值为1/2, 估算出样品A的光学带隙为4.86 eV, 符合先前报道的结果[30].类似地, 可估算出N掺杂Ga2O3薄膜的光学带隙在5.00 eV左右(图2(b)).值得注意的是, 从合金的角度考虑, GaN的带隙小于Ga2O3的带隙, 所以GaO1–xNx薄膜的带隙理应小于未掺杂Ga2O3薄膜的带隙[31].而且, 大量文献报道其他元素Ge[32], In[33], Mg[34]等掺杂Ga2O3后,其光学带隙均变小, 与图2(b)中观察到的现象不一致.在理论研究方面, Dong等[22]发现, N占据O位后, β-Ga2O3透射光谱会发生红移现象, 暗示其光学带隙减小; 最近, Zhao等[35]借助第一性原理计算揭示, N占据Ga位将导致β-Ga2O3由直接带隙变为间接带隙, 类似转变现象也出现在Al掺杂GaAs中[36].为此, 绘制了间接带隙下N掺杂Ga2O3的光学带隙图(图2(c)), 估算的N掺杂β-Ga2O3薄膜光学带隙在4.62 eV附近, 小于未掺杂β-Ga2O3的光学带隙(4.86 eV), 符合掺杂后带隙减小的普遍规律.基于上述讨论, 本研究小组认为N掺杂后β-Ga2O3样品可能会转变为间隙带隙材料, 且N可能同时占据Ga和O位.
光致发光(photoluminescence, PL)谱测试可用于进一步揭示N掺杂对β-Ga2O3薄膜中缺陷的影响.图3(a)为样品A—D在350—800 nm的室温光致发光谱.对于未掺杂样品, 一个较宽的绿色发射带(500 nm附近)主导了整个PL谱, 源于镓氧空位对(VGa–VO)和镓空位(VGa)缺陷捕获电子[37].对N掺杂β-Ga2O3薄膜而言, 所有PL谱呈现出相似的线型, 但绿色发射带几乎消失, 表明N掺杂能有效抑制VGa–VO和VGa缺陷.图3(b)为局部放大的PL谱.所有样品的发光光谱中均可以观察到不同位置的特征峰, 分别位于~387, ~426, ~445和~467 nm.其中, 蓝色发射(440—480 nm)已被归因于氧空位缺陷(VO)提供的电子和空穴之间的复合[38]; 紫色发射(380—440 nm)与自陷激子的重组密切相关[39], 源于跃迁到导带的电子和空穴通过自捕获机制复合产生紫外光子.有趣的是, N掺杂后蓝色发射和紫色发射都大幅度消弱, 表明VO相关缺陷(VO, VGa–VO)得到有效抑制.但样品发光强度并没有随着N掺杂浓度持续减弱, 属于浓度猝灭现象[32].PL测试结果揭示, 杂质N可能同时占据Ga和O位, 有力佐证了N掺杂后β-Ga2O3薄膜转变为间接带隙[35].

图3 (a)不同浓度N掺杂β-Ga2O3薄膜的室温光致发光谱; (b)局部放大图 (350−500 nm)Fig.3.(a) Room temperature PL spectra of N-doped β-Ga2O3 films; (b) local enlarged view ranging from 350 to 500 nm.
为探究N掺杂对β-Ga2O3薄膜日盲紫外光电探测性能的影响, 本研究小组构筑了基于样品A和C的MSM结构光电探测器(记为器件A和器件C), 并进行了一系列电流-电压(I-V)和电流-时间(I-t)测试.图4(a), (b)为两种器件在暗态、365和254 nm光照下的I-V特性曲线.在10 V偏压下, 相比于未掺杂器件A的暗电流(5.1 × 10–10A),N掺杂器件C表现出更低的暗电流(1.08 × 10–11A).当施加光照强度为500 µW/cm2的254 nm紫外光时, 器件A/C都展示出较高的响应率(R)和探测度( D∗), 分别为28 mA/W, 13 mA/W和3.7 ×1011, 6.1 × 1010Jones.在不同光照强度下, 器件A的I-V曲线明显呈非线性关系(图4(a)), 即金属电极与半导体薄膜为背对背肖特基接触[26]; 相反, 器件C的I-V曲线呈现较好的线性关系(图4(b)),说明电极与薄膜之间为欧姆接触[15].并且, 两器件光电流都随着光照强度增大而增大, 这源于高的光照密度促进了电子-空穴对的产生[26].图4(c), (d)分别显示了在10 V偏压下, 通过周期性开关紫外光光源(254和 365 nm)的瞬态响应特性曲线.从图4(c), (d)中可以看到, 经过多个光开/关循环后,器件A和C仍然能对254 nm紫外光保持几乎相同的光响应, 而对365 nm光照几乎无响应, 说明该器件具有较高的稳定性和可重复性, 并表现出较好的日盲特性.众所周知, 器件的响应(上升)和恢复(衰减)时间均由快速响应和慢速响应两部分组成.图4(e), (f)给出了254 nm紫外光照下瞬态响应特性曲线的局部放大图和双指数弛豫方程拟合曲线.拟合方程如下:

图4 β-Ga2O3薄膜MSM型 日盲 紫外 器件 的光 电特 性 (a), (b) I-V特性曲线; (c), (d) 瞬态光响应特性曲线(偏压为10 V);(e), (f) 光响应时间拟合曲线Fig.4.Photoresponse performance of the β-Ga2O3 film MSM photodetectors: (a), (b) I-V curves of the MSM photodetector;(c), (d) transient light response characteristic curve under the bias voltage of 10 V; (e), (f) exponential fitting of a single cycle at 10 V illuminated with 254 nm light.

其中, I0为稳态电流, A和B均为常数, t为时间,τ1和τ2为弛豫时间常数.上升沿和下降沿的弛豫时间常数分别记为τr和τd.不难发现, 双指数弛豫方程拟合曲线与瞬态响应特性曲线有很高的拟合程度(图4(e), (f)).基于器件A和C的响应时间τr1/τr2分别为0.51/3.04, 0.04/2.38 s, 衰减时间τd1/τd2分别为0.09/0.14, 0.008/0.29 s.可见, N掺杂β-Ga2O3日盲紫外探测器可获得更快的光响应速度, 其衰减时间τd可达到ms级别.为评估本工作中基于MSM结构β-Ga2O3薄膜器件的光电性能, 表2对比了国内外各类β-Ga2O3薄膜MSM结构探测器的暗电流、上升时间(tr)和衰减时间(td).总体而言, 本工作中的日盲紫外探测器均表现出较低的暗电流和较快的响应和恢复时间, 达到中上水平.因此, 通过N掺杂是实现更快响应的β-Ga2O3薄膜日盲紫外探测器的一种有效途径.

表2 国内外Ga2O3薄膜基光电探测器的主要性能指标对比Table 2.Comparison of the representative photoresponse metrics based on Ga2O3 film photodetectors.
半导体对光子的光响应是一个复杂的过程, 涉及电子-空穴对的产生、重组、捕获和释放等过程.为清楚阐明N掺杂对器件接触类型和光电性能的影响, 图5给出了器件A和C的光响应能带示意图.一般来说, 两种材料的界面处必然存在一些无法配对的悬挂键等界面态, 并且界面态的密度主要由材料的晶格失配度和粗糙程度等因素决定.本工作中, 样品C粗糙的表面有助于提供较高的界面态密度, 易导致耗尽层宽度(λC)变窄, 促进了电子的直接隧穿(图5(d)), 从而形成了欧姆接触(图4(b)).反之, 样品A的表面相对平整, 其耗尽层宽度(λA)较宽, 电子主要以热电子发射方式越过金半界面, 从而形成了较为常见的肖特基接触(图4(a)).另外, VO缺陷是β-Ga2O3的主要施主源, 直接决定了β-Ga2O3薄膜内部本征载流子浓度.由PL光谱分析可知, 随着N的引入, β-Ga2O3薄膜内部VO浓度降低, 使薄膜本征载流子浓度减少, 明显降低了器件C的暗电流[14].光电流的产生大多由电子本征跃迁导致, 当然, 其他施主缺陷能级对导带电子的贡献也是不能忽略的.在254 nm光照下(图5(b), (e)), 大量光生电子-空穴对被迅速激发产生, 然后转移到相应的电极.同时, VO相关缺陷不仅能作为缺陷能级提供电子, 还能作为捕获中心捕获光生载流子[42].因此, 器件A中大量的VO相关缺陷提供了较多的电子, 导致光电流较大, 但同时阻碍了光生载流子分离, 响应时间较慢.相反地,器件C中存在较少的VO相关缺陷, 导致光生载流子可以迅速分离[12,19], 具有较快的响应速度.如图5(c), (f)所示, 当紫外光关闭时, 导带中的电子与价带中的空穴在复合中心迅速复合, 光生载流子快速湮灭, 同时捕获中心逐步释放已捕获的光生载流子, 延长了载流子湮灭时间[12].因此, 与器件A相比, 器件C在关闭光照时光生载流子迅速湮灭, 恢复时间明显加快.

图5 在254 nm光照下MSM型光电探测器的光响应能带示意图 (a)—(c)器件A; (d)—(f)器件CFig.5.Schematic energy band diagrams of MSM photodetector of samples A and C under 254 nm light illumination: (a)−(c) device A; (d)−(f) device C.
4 结 论
综上所述, 本研究小组采用射频磁控溅射技术和后期退火处理在c面蓝宝石衬底上生长了N掺杂β-Ga2O3薄膜, 并成功制备了快速响应的N掺杂β-Ga2O3薄膜基MSM型日盲紫外探测器.结果表明, 随N2流量占比增加, N掺杂β-Ga2O3薄膜的结晶质量呈现出先变好再变差的规律; 所有薄膜在可见光波段的平均透射率超过95%, 且N掺杂后β-Ga2O3薄膜转变为间隙带隙材料.N掺杂有效降低了薄膜内部VO相关施主缺陷能级和相应的捕获中心, 从而使暗电流减小, 响应时间缩短,器件性能得到明显改善.本研究工作为开发新型的快速响应日盲探测器提供了一定参考.
