GCM恒电流库伦测厚仪及XRF荧光光谱测厚分析仪在有机纳米银镀层厚度测量上的研究
2020-07-20王芳
王 芳
(确信乐思化学(上海)有限公司,上海 201417)
有机金属纳米银有机金属镀层的推荐测试方法是使用本公司自主研发的GCM(Galvanostatic Coulometric Measurement)恒电流库伦测厚仪来测量其厚度。该方法是一种电化学测试分析方法,采用三电极体系,在反电极和工作电极之间通电流,并根据参考电极监控测量的工作电极电势。在进行厚度检测时,将已知面积的有机金属镀层表面浸泡于特定的电解液中并施以恒定电流,通过电极电势的变化检测有机金属镀层是否完全溶解。GCM测厚方法准确有效,由于该设备还没有广泛的应用于印制线路板厂,XRF测厚法更普遍应用于镀层厚度的测量。每种元素在一定激发下可发出X射线,其强度同厚度成正比,实验室测试发现用XRF对有机金属纳米银进行厚度测量,直接读出的测量结果是相对值,与GCM的偏差很大。为更好地解决有机金属纳米银在客户端的测厚问题,研究了对传统的XRF测厚法及GCM测厚法在有机金属纳米银上的应用。
1 实验及实验过程
1.1 实验设备及测试片
本公司自主研发的GCM(Galvanostatic Coulo metric Measurement)恒电流库伦测厚仪;XRF荧光光谱测厚分析仪,型号SII SFT9200;测试采用本公司自主设计的GCM膜厚标准测试片OC-3板。
1.2 实验设计
用GCM膜厚标准测试板OC-3板,底铜厚度为60 μm。准备5种不同厚度的有机金属纳米银的样板,有机金属镀层的厚度(Std)分别是60、70、80、100、120 nm。分别用GCM和XRF测试对应5 mm×5 mm位置的厚度数值,每个厚度测试6个不同的位置,最后得到30组GCM数据及对应的30组XRF数据。然后把相关数据输入到Minitab分析软件中,就可以得到相关的线性回归曲线。
1.3 实验结果(见表1、图1)
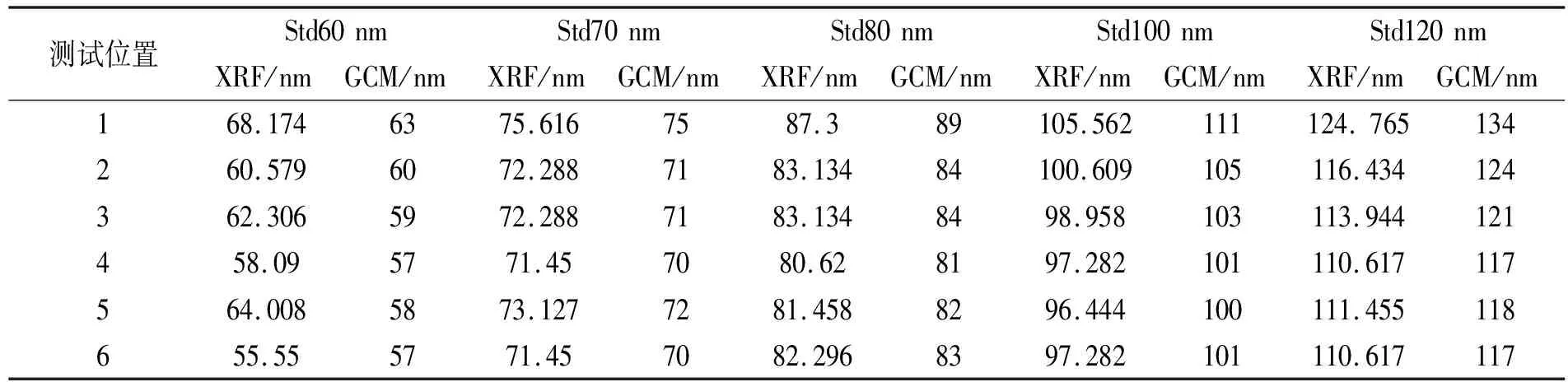
表1 GCM和XRF厚度测试结果

图1 GCM 和XRF线性回归曲线
根据Minitab的分析,可以得到关于GCM 和XRF的线性回归方程式如下:
GCM=-15.78+30.49×0.039 37XRF
例如,如果XRF的读数是102.39 nm,代入线性回归公式:GCM=107 nm。对应的5 mm×5 mm 位置的有机金属纳米银厚度即为107 nm,有了这个线性回归方程式,能够快速便捷地用XRF测试出有机金属镀层的厚度。
2 拓展研究
在实验室测试研究中还发现,上述的线性回归方式并不适用于所有的测试样板,线性回归方式的建立与Pad(方形盘)的大小,底铜铜厚有着密切的关系。
2.1 Pad的大小对有机金属纳米银厚度的影响
用GCM去测量不同大小的Pad的有机金属纳米银厚度,测试片及测试结果见图2、图3。
以5 mm×5 mm的Pad为基准,Pad的面积偏小,有机金属电镀层的厚度相对较厚,Pad的面积偏大,有机镀层的厚度相对会厚。
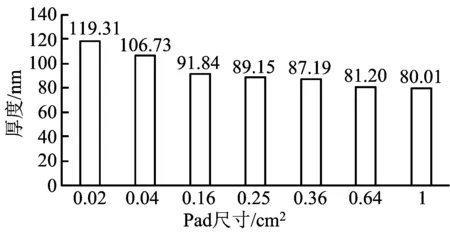
图3 Pad大小与有机金属纳米银厚度的关系
2.2 底铜厚度对回归曲线的影响
用不同大小Pad膜厚测试片底铜厚度为18 μm,用其双面5 mm×5 mm的Pad为固定测试位置,面积为0.5 cm2。准备有机金属纳米银厚度为60、80、90、100、110、120、130、160 nm的标准片,分别用GCM和XRF去测量所得厚度,所得厚度数据见表2。
所以用底铜厚度为60 μm的OC-3测试板所得到的这个线性回归公式并不适合所测试的底铜厚度为18 μm的不同大小Pad膜厚测试片。
把上述的GCM和XRF数据代入Minitab中,根据Minitab的分析,可以得到关于GCM和XRF的线性回归方程式如下:
GCM=-219.9+23.08×0.039 37XRF

表2 GCM和XRF厚度测量结果
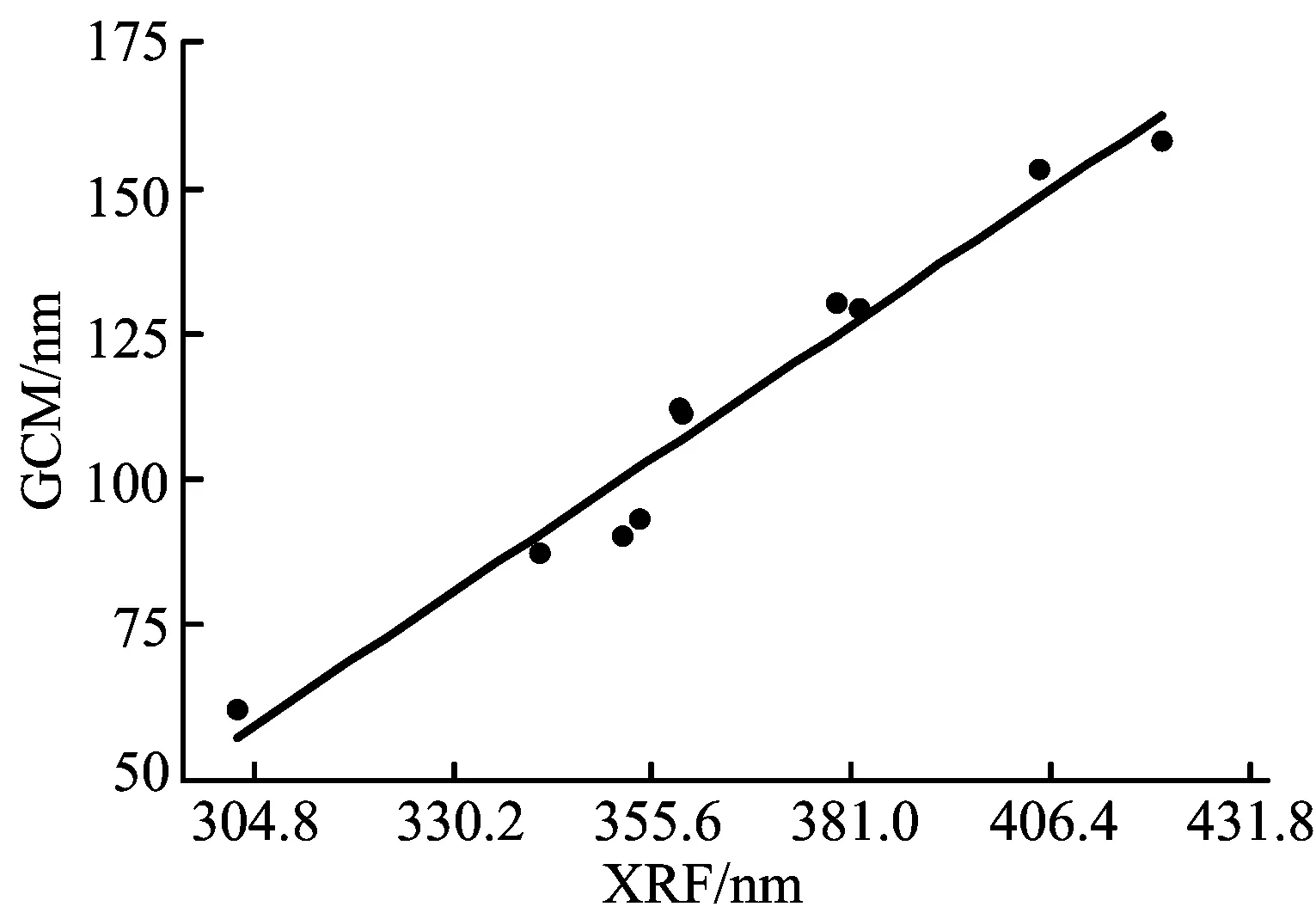
图4 校正后的GCM和XRF线性回归曲线
把上述统计的XRF数据代入新的线性回归曲线中,得到对应的有机金属镀层有机金属纳米银的对应厚度,与OC-3所得出的线性回归公式所比,新的线性回归曲线更准确地反映板面真实的有机金属镀层厚度,造成这个巨大差别的原因是OC-3的底铜与不同大小的Pad测试板的底铜厚度不一样。
3 XRF 机理研究
X射线荧光(XRF)仪器由激发源(X射线管)和探测系统构成。X射线管产生入射X射线(一次X射线),激发被测样品。受激发的样品中的每一种元素会放射出二次X射线,并且不同的元素所放射出的二次X射线具有特定的能量特性或波长特性。探测系统测量这些放射出来的二次X射线的能量及数量。然后,仪器软件将探测系统所收集到的信息转换成样品中各种元素的种类及含量。每个元素的特征X射线的强度除与激发源的能量和强度有关外,还与这种元素在样品中的含量有关。

表3 矫正后的线性回归数据
有机金属镀层有机金属纳米银在使用XRF测量其厚度过程中,所测得厚度值和所检测到的Ag信号的百分比相关。特做以下假定:①假定1 μm的Ag将放射出1 000个Ag信号。②假定1 μm的Ag将放射出1 000个Cu信号。③X-Ray激发40 μm的底铜,将产生40 000 Cu信号。
在铜厚度为40 μm的情况下,Ag信号取决于Ag测厚度,以4种不同的银厚度为例。
4 结语
GCM和XRF 均可以作为测量银层厚度的测量工具,GCM为破坏性测试,会破坏测试样板,XRF为非破坏性测试,不会对样品造成伤害,可以重复使用。GCM和XRF之前可以通过一定的关系式建立对应关系。XRF的测量对低铜的厚度有要求,建议每次根据测试板建立程式,如果条件不允许,以当厚度>35 μm时,测量程序不需要重新校准,如果铜厚<35 μm,一定要重新校准程序方程式。

表4 测量Ag信号的含量
