利用C-V法研究GaN基蓝光LED的多量子阱结构
2020-06-11郑晓思符斯列
郑晓思,符斯列
(华南师范大学 物理与电信工程学院,广东 广州 510006)
半导体照明已深入生活的方方面面. 21世纪初日本学者成功研制出高亮度的蓝色发光二极管(LED),该成果获得了2014年的诺贝尔物理学奖[1]. 其中以GaN为代表的宽带隙半导体由于具有禁带宽度大,电子漂移饱和速度大,导热性能好,化学稳定性高等优点,常被用于制作蓝色发光器件[2]. 高亮度GaN基蓝光LED具有多量子阱结构(Multiple quantum well structure, MQWs)[3],可以作为研究MQWs的样品.
C-V测量法是分析测量半导体性能的基本方法,也是高校实验课程中重要的实验内容[4]. 本文通过C-V法测量GaN基蓝光LED的InGaN/GaN多量子阱结构,通过样品的C-V曲线及对应的杂质浓度分布曲线,分析GaN基蓝光LED多量子阱结构在室温及低温下的系列参量,并讨论其随温度变化的趋势. 该实验的目的明确,操作简单,能够帮助学生进一步理解和应用C-V测量法,拓展GaN基量子阱结构等半导体物理的相关知识.
1 实验原理
在半导体发光器件中,PN结是发光最基本的结构单元. 由同种材料制成的PN结为同质结,由不同种材料制成的PN结为异质结[1]. 当采用不同带隙和掺杂方式时,比如:窄带隙夹在2个宽带隙的半导体之间,形成单量子阱结构[5]. 若交替宽窄带隙,并使势垒的宽度足够薄时,将构成超晶格结构,此时电子能够从1个量子阱隧穿到相邻量子阱. 势垒较宽时,将构成多量子阱结构,在这种结构下,电子无法从1个量子阱隧穿到相邻量子阱,即量子阱之间不耦合. 多量子阱结构可以提高光的发射效率,在这种结构下,正向电流注入PN结时,电子与空穴复合并产生光子辐射,辐射出的光子波长或颜色取决于多量子阱结构中阱层的禁带宽度. 部分Ⅲ-V族氮化物具有直接带隙和宽禁带的特点,比如GaN,常被用于制造性能优异的高效率蓝光器件[6-7].
对于具有单量子阱结构的样品,室温下的C-V曲线存在平台,其相应的载流子浓度分布曲线在量子阱位置有载流子的积累峰[5,8]. 这是因为当2种不同的半导体材料相间排列时,由于界面两侧的空穴与电子存在浓度差,载流子将发生移动,最终不移动的载流子在界面附近形成空间电荷区. 空间电荷区形成了自建电场,并令PN结的两端产生接触电势差VD,形成电子或空穴的势垒qVD. 由于空间电荷区中存在较强的自建电场,其中的载流子基本上被驱赶出去,即被耗尽,因此空间电荷区可近似为耗尽层. 量子阱两侧的载流子将向阱内转移,在阱内形成载流子积累,阱外则形成耗尽区. 当反向偏压增大时,覆盖层中的载流子将不断地向量子阱中转移,即耗尽区将随着偏压的增大而向内扩展,直至量子阱的边缘. 因此在量子阱内,载流子浓度最高,将在杂质浓度分布曲线上体现为峰值[9-12]. 当反向偏压持续增大时,耗尽区边缘处载流子耗尽较少,因此电压所引起的电荷变化主要来自阱中载流子浓度的变化. 此时的样品电容就相当于由量子阱与样品表面层所构成的平行板电容器的电容,而电容的大小主要由量子阱的厚度所决定,因此在一定电压范围内的电容变化很小,在C-V曲线上体现为平台.C-V曲线中的“平台”如图1所示,对应的杂质浓度分布曲线如图2所示.
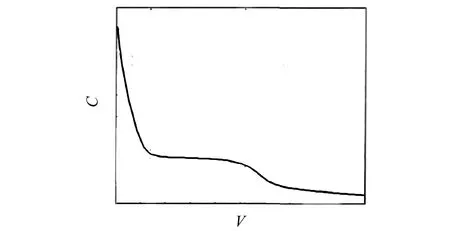
图1 C-V曲线中的“平台”

图2 杂质浓度分布曲线
若仅考虑纵向分布,PN结空间电荷区域的电势与电荷关系可用泊松方程表示为[4]
(1)
其中,ε0和εr分别为真空电容率和材料的相对电容率,ρ(x)和V(x)为空间电荷区净电荷密度和电势. PN结势垒电容C满足:
(2)
其中,l为PN结宽,S为PN结的截面积,其杂质浓度N随结宽的分布满足:
(3)
其中,e为元电荷量,N为约化杂质浓度. 当PN结为一侧是高掺杂浓度,另一侧是低掺杂浓度的突变结时,N即为低掺杂浓度一侧的杂质浓度,而结宽也主要集中在低掺杂浓度一侧[13].
实验样品为常见的GaN基蓝光LED,具有5个周期的InGaN/GaN多量子阱,其PN结可近似为突变结. 当多量子阱薄层线度与电子的德布罗意波长可比拟,且势垒足够厚时,可近似认为相邻量子阱无耦合. 因此本文将实验样品近似为由多个独立的量子阱组合而成的多量子阱结构. 在分析样品杂质浓度分布时,式(1)~(3)也适用.
样品的中心波长λ=460~465 nm,工作电压V=3.0~3.2 V,结面积S=6.25×10-4cm2,GaN的相对电容率εr=8.9,真空电容率ε0=8.854 pF/m,其外延结构如图3所示[14]. 首先在蓝宝石(Al2O3)衬底上生长1层GaN缓冲层,目的是减少外延层与蓝宝石衬底晶格失配带来的的影响. 然后依次生长1层N型AlGaN电子阻挡层,5个周期具有平整界面的InGaN/GaN多量子阱,该多量子阱结构作为LED的有源区,电子与空穴将被限制在此进行复合,并实现高效率发光. 其中窄禁带InGaN为阱层,宽禁带GaN为垒层. 之后在多量子阱层上生长1层P+型AlGaN电子阻挡层后,继续生长1层P+型GaN. 其中,“+”号表示该层的浓度较高. 此外,在N区和P区上分别蒸镀金属层以形成欧姆接触,作为注入电子和空穴的电极.

图3 样品结构
实验装置采用CV-5000型电容电压特性测试仪,用于测试PN结的势垒电容在不同偏压下的电容量,其偏压量程为0~35 V,可换向. 电容测量范围为1.000~5 000.0 pF. 实验的液氮瓶和标准Pt 100 Ω温度探头,分别用于改变样品的温度和检测样品的温度. 实验时,将样品的2根引脚与漆包线焊在一起,漆包线的两端接入测量仪. 将样品和温度探头靠紧置于紫铜做成的圆柱形恒温器内,确保温度探头能真实反映样品的温度[15]. 具体装置如图4所示.

图4 实验装置
2 实验结果与分析
2.1 室温C-V测量
将样品置于T=291 K的室温环境,外加偏压设置为+2.5~-22 V,偏压变化的步进值为0.1 V. 由计算机控制测量过程与数据处理.
实验测得样品的C-V曲线与杂质浓度分布如图5和图6所示. 图5表明,GaN基蓝光LED的PN结势垒电容虽然随所加负偏压的增大而减小,但在一定电压范围内电容变化很小,共在C-V曲线上呈现了5个平台. 图6表明,T=291 K样品的杂质浓度分布曲线呈现5个峰位.
根据图6计算得到多量子阱结构参量如表1所示. 其中,采用杂质浓度峰值的半高全宽定义量子阱宽,采用相邻2个杂质浓度峰值的半高全宽间隔定义垒宽, 如图6所示. 其中第1个量子阱峰值N阱1=6.43×1018cm-3,峰值对应的结宽l阱=44.61 nm,该峰一半峰值的左、右端所对应的位置分别为l11=43.786 nm,l12=45.622 nm,由此计算出第1个量子阱宽Δl阱1=l12-l11=1.84 nm;第2个量子阱一半峰值的左端所对应的位置为l21=58.541 nm,则第1个量子垒宽Δl垒1=l21-l12=12.92 nm. 同理得其他量子阱的阱宽及垒宽数值. 根据表1计算得到室温下MQWs结构中InGaN阱层平均杂质浓度为7.12×1018cm-3,平均阱宽为2.00 nm;GaN垒层平均杂质浓度为0.82×1018cm-3,平均垒宽为12.32 nm. 计算所得MQWs的结构参量与文献[14]一致.

图5 291 K时样品的C-V曲线
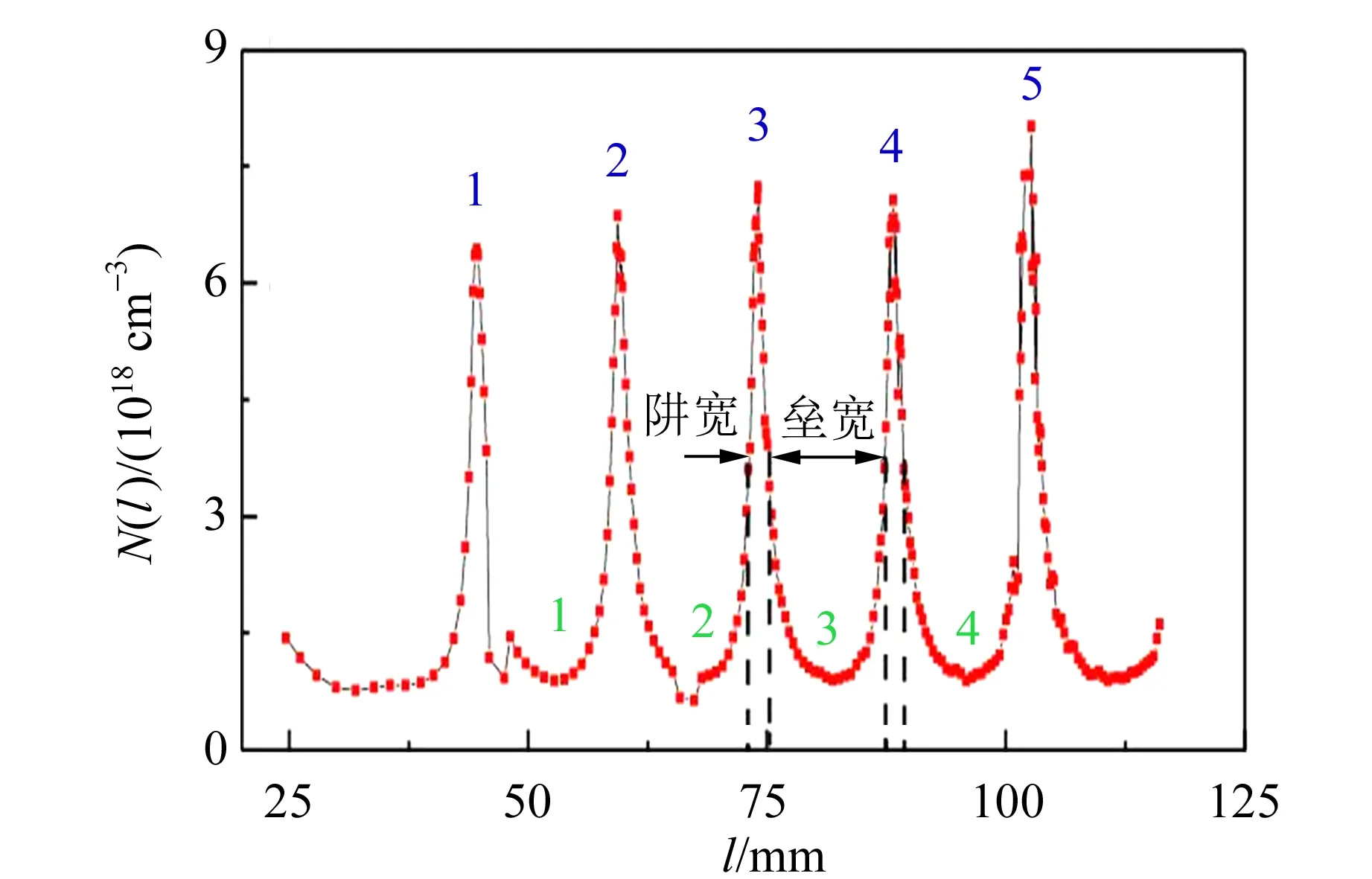
图6 291 K时样品的杂质浓度分布

表1 室温下InGaN/GaN MQWs的结构参量
2.2 变温C-V测量
通过沉降法将LED样品缓慢地放入液氮杜瓦瓶中,改变样品的温度. 实验选取的温度分别为T=223,173,98 K,变温下样品的C-V曲线如图7所示. 图7表明,随着温度降低,同一偏压下的势垒电容虽然减小,但是C-V曲线仍然呈现出5个平台的特征,并且温度越低,平台特征越明显[8]. 例如98 K下的C-V曲线与298 K下的C-V曲线比较,前者平台更为明显.

图7 变温样品的C-V曲线
变温样品的杂质浓度分布曲线如图8所示. 根据图8计算得到多量子阱结构参量随温度的变化如表2所示.
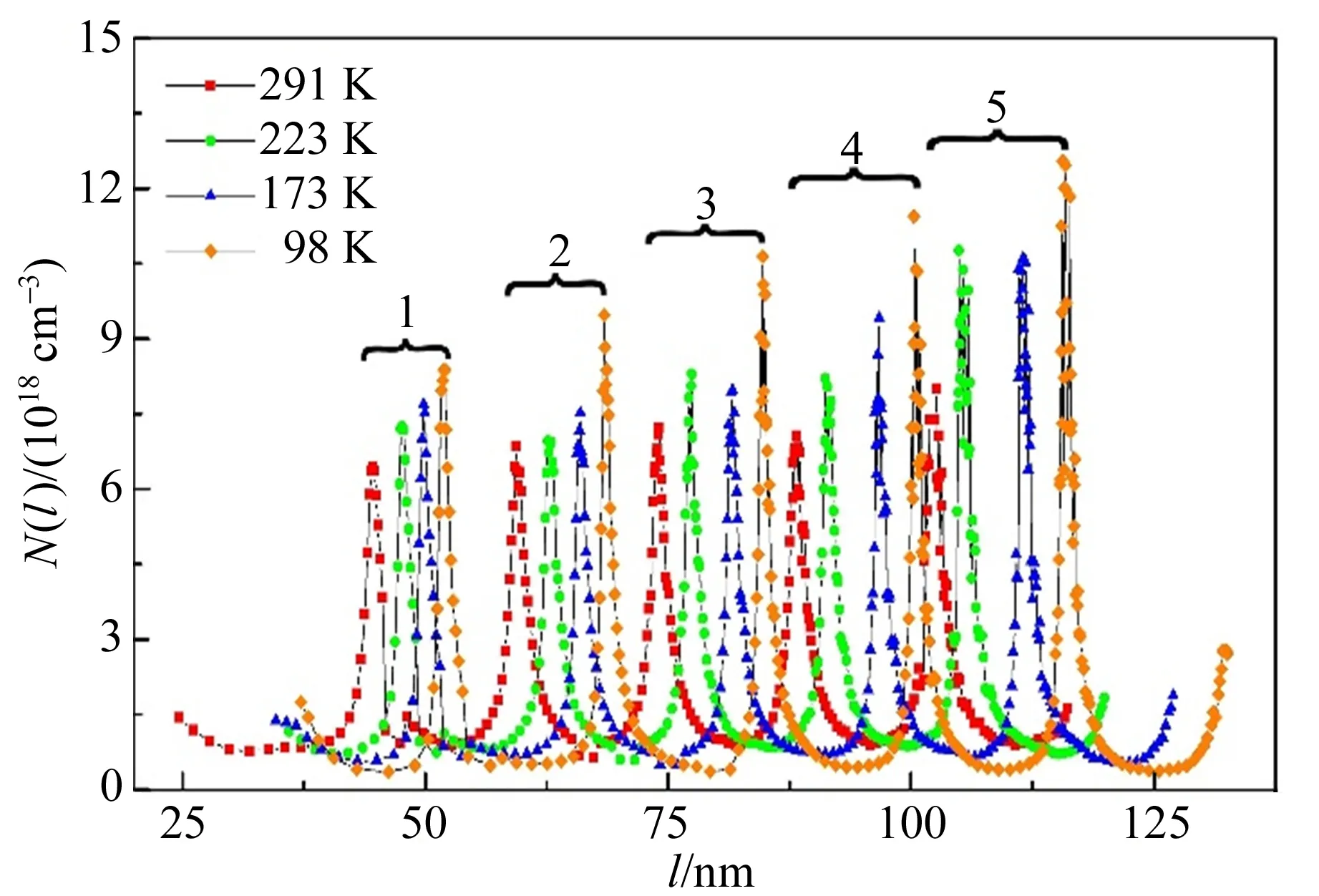
图8 变温样品的杂质浓度分布曲线

表2 低温下InGaN/GaN的MQWs系列参量
图8显示,随着温度的降低,峰值增大,这表明InGaN阱层平均杂质浓度随着温度的降低而增大,从T=291 K的7.12×1018cm-3增大到T=98 K的10.28×1018cm-3. 这是因为随着温度的降低,载流子的运动更有序,在同一反向电压下,载流子更容易克服内建电场做定向移动,即量子阱两侧的载流子向阱内的转移增加,因此阱中的杂质浓度增大.
表2显示,GaN垒层平均杂质浓度随着温度的降低而减小,从0.82×1018cm-3减小到0.42×1018cm-3. 这符合电荷守恒定律. 同时表2显示,随着温度的降低,InGaN阱层宽度变窄,从2.00 nm减小到1.24 nm. 这是因为在同一反向电压下,低温使载流子运动更有序,空间电荷区中的内建电场增强,则相应的空间电荷增多,因而空间电荷区展宽,阱层宽度变窄;而GaN垒层宽度变宽,从12.32 nm增大到14.80 nm.
3 结 论
采用C-V法测量了GaN基高亮度蓝光LED的InGaN/GaN多量子阱结构. 通过样品的C-V曲线以及对应的杂质浓度分布曲线,分析了GaN基蓝光LED多量子阱结构在室温以及低温下的系列参量. 实验结果表明:实验样品为5个周期InGaN/GaN多量子阱结构,室温下平均InGaN阱层宽度为2.00 nm,平均阱层杂质浓度为7.12×1018cm-3,平均GaN垒层宽度为12.32 nm,平均垒层杂质浓度为0.82×1018cm-3. 随着温度的降低,C-V曲线的平台特征更加显著,且InGaN/GaN多量子阱层杂质浓度增大,垒层杂质浓度减小,而且InGaN阱层宽度变窄,GaN垒层宽度变宽. 该实验是近代物理实验方法在现代新型半导体量子器件诊断中的应用. “新器件”与“旧方法”的结合,既让学生们意识到当代科技的奇妙与魅力,也使他们感受到物理实验方法在科技进步中的巨大作用.
