垂直腔面发射激光器与异质结双极型晶体管集成结构的设计和模拟
2019-10-25周广正李颖兰天代京京王聪聪王智勇
周广正 李颖 兰天 代京京 王聪聪 王智勇
(北京工业大学激光工程研究院,北京 100124)
垂直腔面发射激光器(vertical cavity surface emitting lasers,VCSELs)和异质结双极型晶体管(heterojunction bipolar transistor,HBT)都是纵向电流器件,可以集成在同一外延片上,通过HBT基极电流调制VCSELs的输出光功率.本文设计了一种VCSELs与HBT集成结构,该结构包括VCSELs和PNP InGaP/GaAs HBT,为直接串联结构,并利用PICS3D软件模拟了该集成结构的电光特性.为了模拟能够顺利进行,在模型中加入了过渡集电极.首先将HBT导通,电流由发射极流向过渡集电极,然后增大过渡集电极与N型电极之间的电压,使VCSELs导通且把过渡集电极的电流降为零.由于过渡集电极的电流为零,在实际结构中可以将其移除.模拟结果表明,当电流增益系数为400时,基极电流对输出光功率的最大调制率达到280 mW/mA.本文所设计的集成结构及其模拟方法对光电集成器件(opto-electronic integrated circuit,OEIC)具有一定的指导作用.
1 引 言
垂直腔面发射激光器(VCSELs)以其阈值电流低、调制带宽大、易于二维集成、易与光纤耦合和成本低等优点,广泛应用于短距离光通行和光互联领域[1-3].异质结双极型晶体管(HBT)具有功率密度高、增益高、带宽大、相位噪声低和线性度好等特点,是MMIC领域重要的三端器件之一[4,5].因为InGaP/GaAs HBT在制备过程中可以利用InGaP与GaAs的高选择刻蚀性[6],提高产量和均匀性,因此正逐步取代传统的AlGaAs/GaAs HBT.将VCSELs与HBT集成形成光开关集成阵列可应用于并行光处理[7].AT&T贝尔实验室[8]首次利用分子束外延(MBE)二次外延制备了GaAs量子阱激光器与HBT集成结构,其输出光功率对基极电流的调制率为1.2 mW/mA.Zhou等[7]设计和制备了GaAs/AlGaAs HBT和VCSELs集成的光电开关.光电开关的电流增益为500-700,在光输出功率为0.4和1.2 mW时的功率消耗分别为27和55 mW,直流偏置下的光功率-电流转换效率为150 W/A.将HBT集成在VCSELs中,量子阱置于HBT的基区,基极电流提供空穴载流子,发射极电流提供电子载流子,可以形成晶体管垂直腔面发射激光器(transistor VCSELs,T-VCSELs)[9-11].Shi等[10]设计的T-VCSELs包括一个Npn InGaP/GaAs HBT结构和一个6 µm的用来限制电流和光场的氧化孔径.当基极电流为7 mA时,集电极电流约为53 mA,输出光功率超过1 mW.从数值模拟中提取的参数输入到解析模型中,得到的大信号调制可达到40 Gbps.目前VCSELs与HBT集成主要有两种形式:1) VCSELs和HBT利用一次外延或二次外延生长在同一外延片上,但相互独立,利用金线相连.此方法虽然保留了HBT高电流增益特性,但是外延和芯片工艺复杂; 2) VCSELs的量子阱置于HBT的基区,形成T-VCSEL结构.因空穴是由基极提供的,基极电流对输出光功率的调制率偏低.由于VCSELs和HBT都是纵向电流器件,本文设计和模拟了一种VCSELs与HBT集成结构,将VCSELs与HBT在外延结构上直接串联,用氧化层限制电流和光场,可以集成VCSELs和HBT的优点,降低工艺复杂性,提高基极电流对输出光功率的调制率.另一方面,传统的VCSEL是两端器件,调制信号直接驱动VCSEL工作,一般需要几毫安的驱动电流,高速驱动电路较为复杂[12-14].本文设计的VCSEL与HBT集成结构是三端器件,将直流偏置与交流调制分开,调制电流可降至10 µA量级,大大降低了驱动电路的功率放大需求和驱动电路的复杂性,并可采用共N型电极(对应HBT共发射极)工作[10,15],调制信号加在基极电极,控制VCSEL光开关.通过成熟的商业软件模拟可以大大缩短研发周期[16,17],但是利用PICS3D模拟VCSEL与HBT集成结构过程中,会出现模型错误提示及计算不能自洽等问题,为此本文提出加入过渡集电极,使得模拟过程能够顺利进行.
2 理论模型
图1为VCSELs与HBT集成结构示意图,VCSELs部分包括N型电极,34对Al0.12GaAs/Al0.90GaAs下DBR,3对In0.06GaAs/Al0.30GaAs量子阱有源区,20 nm Al0.98GaAs氧化层,21对Al0.12GaAs/Al0.90GaAs上DBR; HBT部分包括P型InGaP发射区,重掺杂N型GaAs基区和P型GaAs集电区.过渡集电极的设置是为了PICS3D软件模拟能够顺利进行,N型电极、发射极、基极和过渡集电极分别记作电极1、电极2、电极3和电极4.
HBT的电流增益可表示为[5]

其中 DB和 DE分别为基极和发射极少数载流子扩散系数,NE和 NB分别为发射区和基区的杂质浓度,LE为发射区少数载流子扩散长度,WB为基区宽度,ΔEg为带隙差,kB为玻尔兹曼常数,LB为基区少数载流子扩散长度.
对于VCSELs器件,耗散功率可表示为[18]

其中 Ith为阈值电流,Rs为串联电阻,Vd为开启电压.
温升可表示为

其中 ZT为等效热阻.
阈值电流和微分效率随温度的变化可表示为

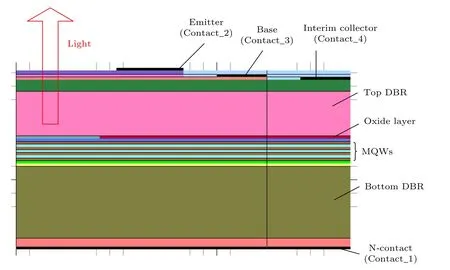
图1 VCSELs与HBT集成结构示意图Fig.1.Schematic diagram of integration of VCSELs and HBT.

输出功率可表示为

所以对VCSELs与HBT集成结构,输出功率可表示为

由(7)式可以看出,基极电流对输出光功率的调制率与HBT的电流增益成正比,同时由于阈值电流和微分效率随温度变化,使得调制率随基极电流的增大而减小.集成结构的调制响应传递函数可表示为[5,19]

其中 β0为HBT的直流电流增益,re为发射极电阻,Cin为输入电容,CBC为基极和集电极间电容,fr为弛豫振荡频率,γ 为阻尼系数,fp为寄生极点频率.等式右边第1项为HBT的交流增益,第2项为VCSEL的本征响应,第3项表达了VCSEL的寄生效应.
3 模拟结果
首先利用TFCal软件模拟了加入HBT对上DBR反射率的影响(图2).设置光从量子阱有源区入射,从上表面出射,在激射波长850 nm处上DBR的反射率为99.72%,加入HBT会对DBR最上层的相位产生影响[19,20],加入HBT后反射率为99.57%,所以加入HBT对上DBR的在激射波长处的反射率影响较小.在小于850 nm时反射率下降较多,因此实际结构中可以适当增大腔模波长,避免反射率下降而影响器件性能.
图3为平衡态时的能带,为了简化模型,采用等效材料代替整个DBR,所以DBR处的能带为水平直线.PICS3D软件模拟过程中需要满足一些自洽条件,若直接在基极或N型电极加电压,电流不能直接由发射极流到N型电极,因此模拟过程中在旁边加入一个过渡集电极.首先,在过渡集电极和基极加电压让HBT导通,电流从发射极流向过渡集电极,且过渡集电极与N型电极的电压在VCSELs阈值电压以下.图4(a)显示了HBT导通时集成结构的能带图,E-B结正偏导通,空穴在基区的扩散长度远大于基区厚度,E-B结注入基区的空穴通过扩散进入B-C结,由于B-C反偏,空穴很快被扫入集电区,过渡集电极与N型电极所加电压小于P-N结开启电压,VCSEL不能导通,因此电流流向过渡集电极.图4(b)显示了HBT导通时的集成结构内部电流分布,从图4(b)可以看出电流由发射极经过基区、集电区和P-DBR流向过渡集电极.电流会经过P-DBR是因为P-DBR掺杂较高,电阻率较低.

图2 不同结构DBR反射率Fig.2.Reflectivity of different DBRs.

图3 平衡态时集成结构的能带Fig.3.Band diagram of integrated structure at equilibrium.
逐渐增大过渡集电极和N型电极之间的电压,同时开启光子密度与漂移-扩散耦合模型,量子阱产生光增益,VCSELs达到激射条件.图5(a)为集成结构导通时的能带结构,同样E-B结正偏,B-C结反偏,过渡集电极与N型电极所加电压大于VCSEL的开启电压.图5(b)显示了导通时集成结构内部的电流分布,从图5(b)可以看出,电流从发射极经基区、集电区和VCSEL流向N型电极,氧化孔径对电流有明显的限制作用.图6显示了过渡集电极和N型电极电流随过渡集电极电压的变化(V1=-6 V).随着过渡集电极电压增大,其电流减小,N型电极电流增大,在V4=-4.1 V,即过渡集电极与N型电极的电压约1.9 V时,过渡集电极电流为零,此时可以移除过渡集电极,而不影响集成结构的电光特性.

图4 HBT处于放大状态时的(a)能带图,(b)集成结构内部电流分布Fig.4.Integrated structure when HBT is in an amplified state:(a) Band diagram; (b) current distribution.

图5 HBT和VCSEL同时导通时的集成结构 (a)能带图; (b)内部电流分布Fig.5.Integrated structure when both HBT and VCSELs were conducted:(a) Band diagram; (b) current distribution.

图6 过渡集电极和N型电极电流随过渡集电极电压的变化Fig.6.Relations of interim collector currentwith voltage of interim collector.
保持过渡集电极电流为零,进一步模拟了N型电极电流和输出光功率随电压的变化.图7为不同基极电流下N型电极的电流随电压的变化,电流增益约为400.当基极电流为22 µA时,N型电极电流约为9 mA.图8为不同基极电流下输出光功率随N型电极所加电压的变化,当基极电流为22 µA时,输出光功率超过4 mW,基极电流对输出光功率的最大调制率达280 mW/mA.模型中加入了热模型,热源包括焦耳热、光吸收、非辐射复合和Thomson热.图9(a)显示了基极电流为10 µA时器件内部的温度分布,量子阱有源区处最高温度达386 ℃.图9(b)显示了有源区最高温度和输出光功率随基极电流的变化.从图9(b)可以看出,随着基极电流的增大,有源区最高温度增加,输出光功率先增大后趋于饱和,一方面随着温度的升高量子阱对载流子的限制作用减小,另一方面增益-腔模失配增大,阈值电流增大,微分效率减小,导致输出光功率降低.

图7 不同基极电流下N型电极电流随电压的变化Fig.7.I1 varying with V1 at different base currents.
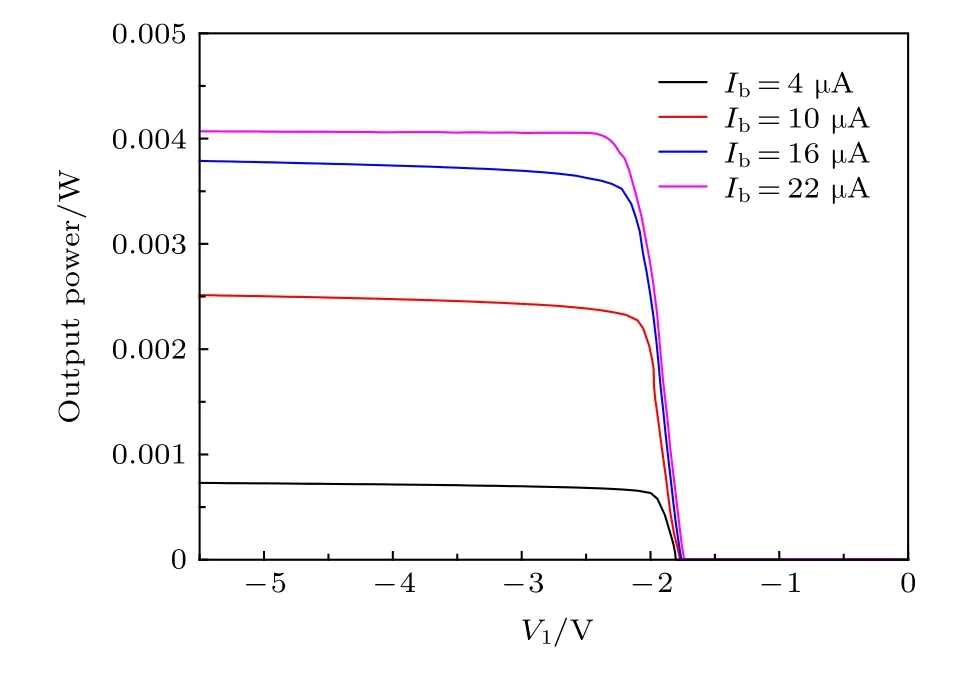
图8 不同基极电流下输出光功率随N型电极电压的变化Fig.8.Output power varying with V1 at different base currents.

图9 (a)基极电流为10 µA时器件内部温度分布; (b)有源区温度和输出光功率随基极电流的变化(V1=-6 V)Fig.9.(a) Temperature distribution of the device at a 10 µA base current; (b) temperature in active region and output power varying with the base current (V1=-6 V).

图10 集成结构的交流光增益Fig.10.The ac power gain of integration structure.
本文利用PICS3D模拟了集成结构的交流光增益特性.图10显示了基极电流为10 µA时交流光增益的模拟结果,从图10可以看出其截至频率超过1 GHz.单独模拟VCSEL得到其调制响应的-3 dB带宽为25 GHz,由(8)式可知加入HBT限制了集成结构的调制速率,需进一步优化HBT结构参数和几何尺寸来提高调制速率.
4 结 论
本文设计和建立了VCSELs与InGaP/GaAs HBT集成结构模型,利用PICS3D软件模拟了集成结构的光电特性,模拟过程中加入过渡集电极,通过先开启HBT,再改变过渡集电极与N型电极之间的电压使VCSELs导通,之后保持过渡集电极电流为零.模拟结果表明,集成结构的电流增益达到400,基极电流对输出光功率的最大调制率达到280 mW/mA.当基极电流为22 µA时,输出光功率超过4 mW.由交流光增益的模拟结果可知截至频率超过1 GHz.本文建立的集成结构和模拟方法还可用于LED,LD和DFB等发光器件与HBT的集成,对光电集成具有一定的指导作用.
