X波段FBAR用AlN薄膜制备研究
2019-04-20彭华东张永川司美菊
彭华东,徐 阳,张永川,杜 波,司美菊,蒋 欣,赵 明
(中国电子科技集团公司第二十六研究所, 重庆 400060)
0 引言
与声表面波滤波器、介质滤波器及低温共烧陶瓷(LTCC)滤波器等相比,薄膜体声波谐振器(FBAR)滤波器同时具有小体积和高性能的优势,其制作工艺还能与CMOS工艺兼容[1]。FBAR是满足射频前端高性能、小型化和集成化的最佳途径之一。目前,FBAR滤波器已广泛应用于移动通信市场[2-3]。
FBAR是一种利用声学谐振实现电学选频的新型器件,通过底电极和顶电极间压电薄膜在垂直方向的谐振进行选频,具有插入损耗小,矩形度好,体积小,可靠性高等优点。FBAR空气腔结构是目前最成功的产品结构[4],由于换能器的上、下部均为空气,当声学信号传输到顶电极上端和底电极底端时,声阻抗的巨大差异会造成声波的全反射,声能量集中在亚微米量级的声学层区域里。该空气腔结构的声泄露很小,可实现FBAR器件的高品质因数值。AlN压电薄膜具有高压电耦合系数和高声速等优点,成为FBAR滤波器首选的压电薄膜,是FBAR滤波器的核心材料,其质量直接影响FBAR滤波器的频率、品质因数及插入损耗等关键性能指标。采用金属有机化合物气相沉积[5]、脉冲激光沉积[6]和磁控溅射[7]等方法可制作AlN压电薄膜。其中,磁控溅射法因薄膜淀积易控制、薄膜应力小及膜厚均匀性好等优点,成为FBAR用AlN薄膜最佳制作方法。
X波段FBAR器件频率为8~12 GHz,AlN压电薄膜厚150~200 nm,制备优质超薄的AlN薄膜较难。目前, X波段FBAR器件用较薄的AlN压电薄膜还未见报道。本文采用中频磁控溅射法在硅基上制备了较薄的优质AlN压电薄膜,所得AlN压电薄膜用于制作X波段FBAR器件的工艺中,并成功研制出X波段FBAR器件。
1 实验
采用6英寸(1英寸=2.54 cm)(100)硅单晶片为衬底材料,溅射前使用H2SO4和H2O2(V(H2SO4)∶V(H2O2)=4∶1(体积比))漂洗10 min,HF酸(V(HF)∶V(H2O)=1∶100)漂洗1 min,冲水甩干后入腔室溅射。采用射频等离子清洗基片,采用磁控溅射法制作底电极Mo薄膜,靶材为高纯钼靶(99.99%(原子数比)),超纯氩气(99.9999%)作为溅射气体。采用中频磁控溅射法制作AlN种子层薄膜和AlN压电薄膜,靶材为高纯铝靶(99.999%),超纯氩气和氮气(99.9999%)作为溅射气体。制作了AlN(压电层)/Mo(底电极)/AlN(种子层)/Si基结构的AlN复合压电薄膜。
实验中,使用D8 DISCOVER型X线衍射仪(XRD)分析Mo和AlN薄膜的晶体结构和择优取向;采用FLX-2320S型应力测试仪测试薄膜应力;采用F-50型光反射式膜厚测试仪测试了AlN压电薄膜膜厚;采用微波探针台测试X波段FBAR器件的电性能指标。
2 结果及讨论
2.1 AlN薄膜性能分析
在硅片上制作了厚176 nm的AlN压电薄膜,测试了AlN薄膜的厚度,共测试了97点,膜厚分布如图1所示。由图可看出,AlN膜厚平均值为176.1 nm,膜厚均匀性为0.32%(1σ,即1个标准偏差),AlN薄膜具有良好的膜厚均匀性。

图1 AlN薄膜厚度分布图
在硅片上制作了Mo底电极和厚176 nm的AlN压电层,膜层结构为AlN(压电层)/Mo(底电极)/AlN(种子层)/Si基。对样品进行了XRD分析,图2、3分别为Mo薄膜(110)面和AlN薄膜(002)面的XRD摇摆曲线。由图可看出,Mo薄膜摇摆曲线的半峰宽为1.65°,AlN薄膜摇摆曲线半峰宽为2.21°。通过AlN种子层诱导Mo(110)取向的生长,Mo薄膜具有良好的择优取向。Mo(110)取向的体中心立方结构有助于生长AlN(002)取向的压电薄膜,AlN薄膜也呈现出良好的c轴择优取向,其c轴择优取向度能满足X波段FBAR器件的要求。
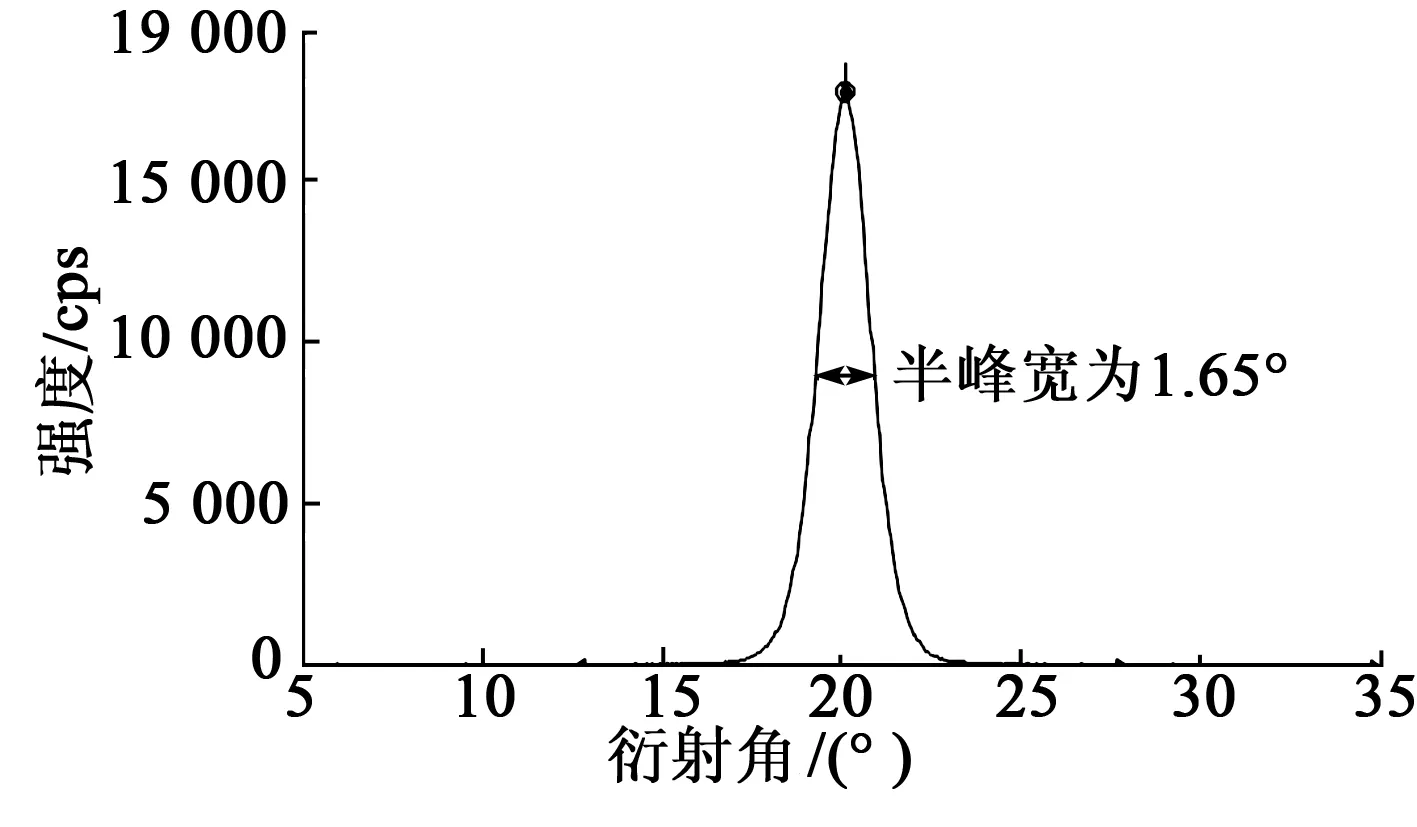
图2 Mo薄膜(110)面XRD摇摆曲线

图3 AlN薄膜(002)面XRD摇摆曲线
AlN薄膜的应力是AlN薄膜的另一个重要性能参数,如果薄膜应力过大,会导致基片发生变形、空气腔结构破裂甚至塌陷。因此,在保证AlN压电薄膜高压电性能的同时,需要减小薄膜的应力,提高器件性能和可靠性。图4为Mo(底电极)/AlN(种子层)/Si基上制作的 AlN压电薄膜应力测试图。由图5可看出,AlN薄膜应力仅为-5.02 MPa,生长的AlN薄膜应力很小。AlN薄膜应力可通过溅射气体氩气的流量进行调整。图5为氩气流量对AlN薄膜应力的影响图。由图5可见,随着氩气流量的增加,AlN薄膜应力从压应力向张应力变化,AlN薄膜应力和氩气流量几乎呈线性关系,AlN薄膜应力可控。根据实际工艺需要可对AlN薄膜应力进行调节。
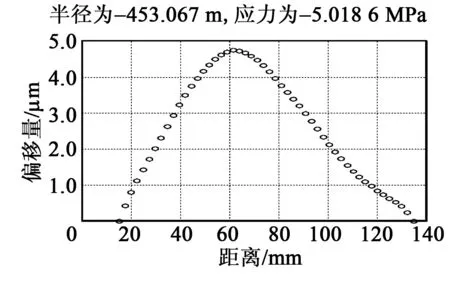
图4 AlN薄膜应力测试图
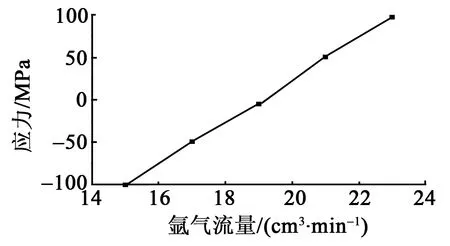
图5 氩气流量对AlN薄膜应力的影响
2.2 X波段FBAR器件的制作
采用厚150~200 nm的AlN压电薄膜,在硅基上制作了X波段FBAR器件,其结构示意图如图6所示。

图6 FBAR结构示意图
图7为X波段FBAR器件电性能测试曲线。器件谐振频率为9.09 GHz,插入损耗为-0.38 dB。FBAR器件频率已达X波段,插入损耗小,具有良好的电性能,满足应用需求。

图7 FBAR器件频率响应曲线
3 结束语
本文采用中频磁控溅射法对X波段FBAR用AlN薄膜制备技术进行了研究,获得了X波段FBAR用较薄的优质AlN压电薄膜。AlN压电薄膜的性能分析结果表明,AlN膜厚均匀性为0.32%(1σ),AlN薄膜摇摆曲线半峰宽为2.21°,AlN薄膜应力为-5.02 MPa,薄膜应力可调。制作的AlN压电薄膜应用于X波段FBAR器件,成功研制出X波段FBAR器件。
