光电耦合芯片的开路失效分析
2018-09-04张浩敏张旭武舒嘉宇刘清超
张浩敏 , 张旭武 , 舒嘉宇 , 刘清超
(1.工业和信息化部电子第五研究所,广东 广州 510610;2.宁波赛宝信息产业技术研究院有限公司,浙江 宁波 315040;3.工业和信息化部电子第五研究所华东分所,江苏 苏州 215011)
0 引言
光电耦合芯片也被称为光电隔离芯片,或简称为光耦芯片。它以光为媒介来传输电信号,对输入、输出电信号有良好的隔离作用,因此,在各种电路中都得到了广泛的应用。光电耦合芯片一般由3个部分组成:光的发射部分、光的接收部分和信号放大部分。输入的电信号会驱动GaAsP发光二极管 (LED),使之发出一定波长的光,被集成的高增益光探测器接收而产生光电流,经过进一步地放大后再输出。光电耦合芯片的输入端与输出端实现了完全的电气隔离,输出信号对输入端无影响,抗干扰能力强,工作稳定,无触点,使用寿命长,传输效率高。但是,光电耦合芯片由于集成度越来越高,在大量使用的过程中所发生的失效现象也呈现出多样、复杂的特点,甚至存在诸多不稳定的失效现象[1-5]。本论文以惠普公司的光电耦合器芯片的失效作为典型案例,采用多种失效分析技术对其进行分析与研究,最终确认器件的失效是由于铝焊盘和局部电路的腐蚀造成的。
1 案例分析
1.1 样品概况
案例分析所使用的样品为惠普公司生产的光电耦合芯片,型号为HCNW2611-000E。该芯片的通道原理图与管脚排列图如图1所示。共收到失效样品2只,编号为F1#、F2#;未使用过的同型号良品2只,编号为G1#、G2#。
器件失效现象为:用户描述已安装光电耦合芯片的驱动板装在机柜中不带电放置3个月后再上电,发现光电耦合芯片的二次侧输出端口管脚6(Vo)失效,输出端口为常高,光电耦合芯片的一次侧管脚 2(ANODE)与管脚3(CATHODE)正常,压降为1.6 V;二次侧供电也正常,二次侧各个引脚无短路现象。

图1 光电耦合芯片HCNW2611-000E的原理图
1.2 外观检查
对样品进行外观检查,发现失效样品的表面和引脚处有残留的胶体,引脚有少量的残余焊锡料存在,无明显的异物,未见其他明显的异常情况,而良品的表面和引脚处几乎看不到残留的胶体或焊锡料存在,也未见异物。失效样品F1#、F2#与良品G1#的典型外观照片如图2所示。
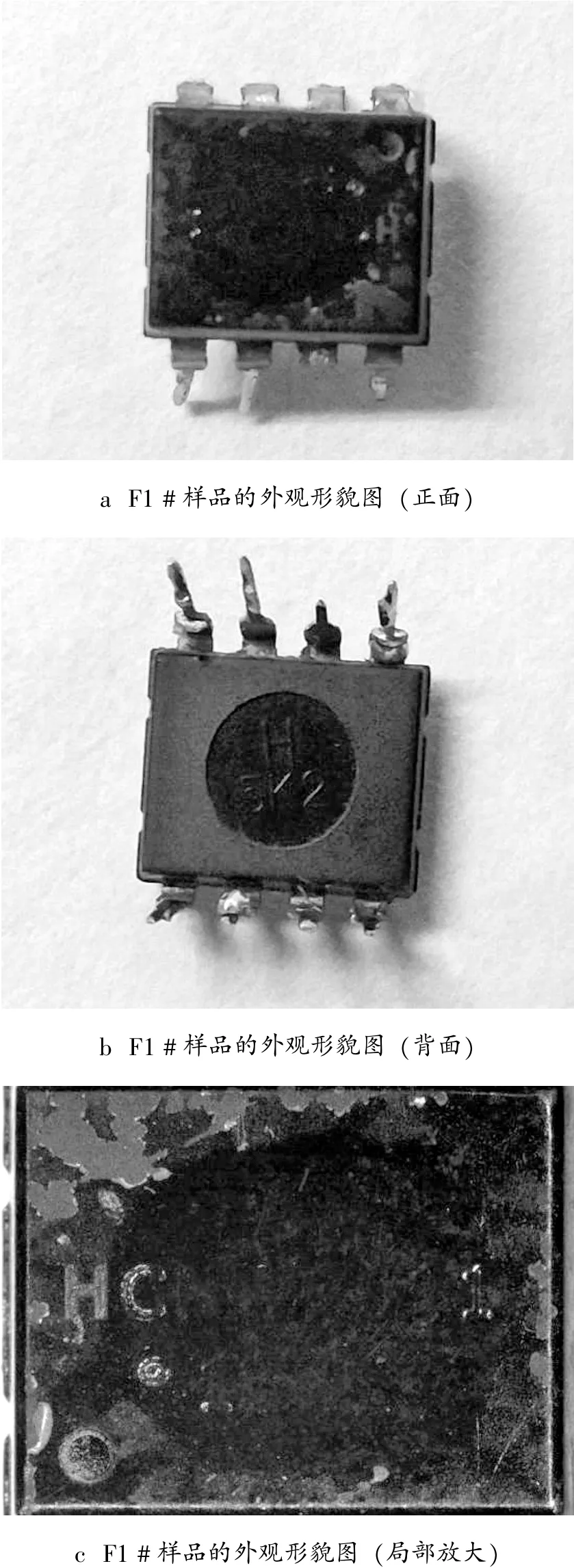


图2 失效样品F1#、F2#及良品G1#的外观形貌图
1.3 电参数测试
对样品进行V-I曲线的测试,测试结果如图3所示。对比图3中良品G1#和失效样品的测试结果可以看出,失效样品F1#的管脚5(GND)、管脚6(Vo)和F2#样品的管脚6(VO)、管脚7(VE)都呈开路状态。

图3 良品G1#和失效样品F1#、F2#的V-I曲线测试结果
1.4 X射线检查
对失效样品F1#和F2#进行X射线检查,主要观察引脚和键合线的结合情况,X射线的检查结果如图4所示。从图4中的各个形貌图可以看出,键合处不存在明显的异常情况。

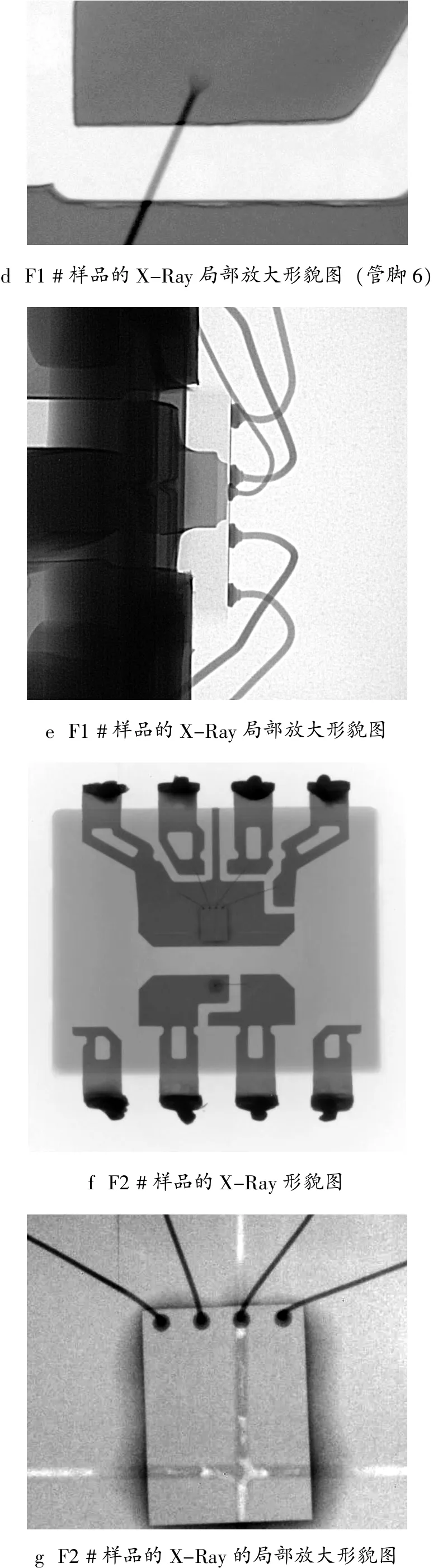

图4 失效样品F1#、F2#的X射线检测图
1.5 开封后的形貌观察、扫描电镜及能谱分析
对F1#样品进行机械开封后在光学显微镜下观察,结果如图5所示。从图5中可以发现:样品内部三极管连接端的管脚5、管脚6和管脚7焊盘存在明显的腐蚀变色的形貌,其中管脚5、管脚6的焊盘处金属与内部电路已经完全断开;对腐蚀位置进行扫描电镜 (SEM)及能谱 (EDS)分析,得到的结果如图6所示。从图6中管脚5和管脚7边缘处的能谱分析可以发现:Na、O元素的含量比较高。基板位置 (二次侧)发现明显的异物,其形貌与残留的成份分析显示与导光胶不同,其中Na、O元素的含量较高;二极管芯片表面未见异常的形貌及腐蚀性元素。
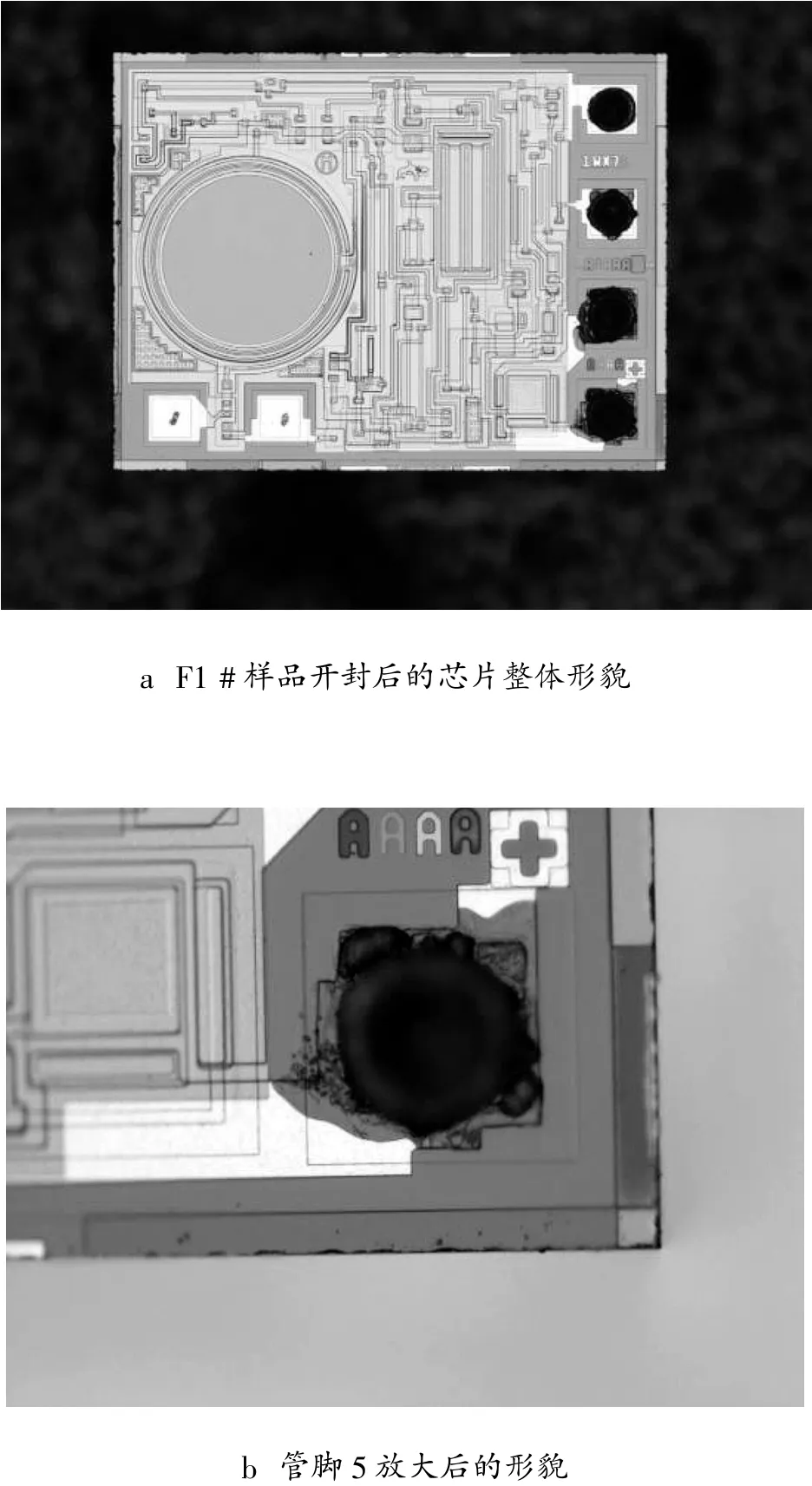
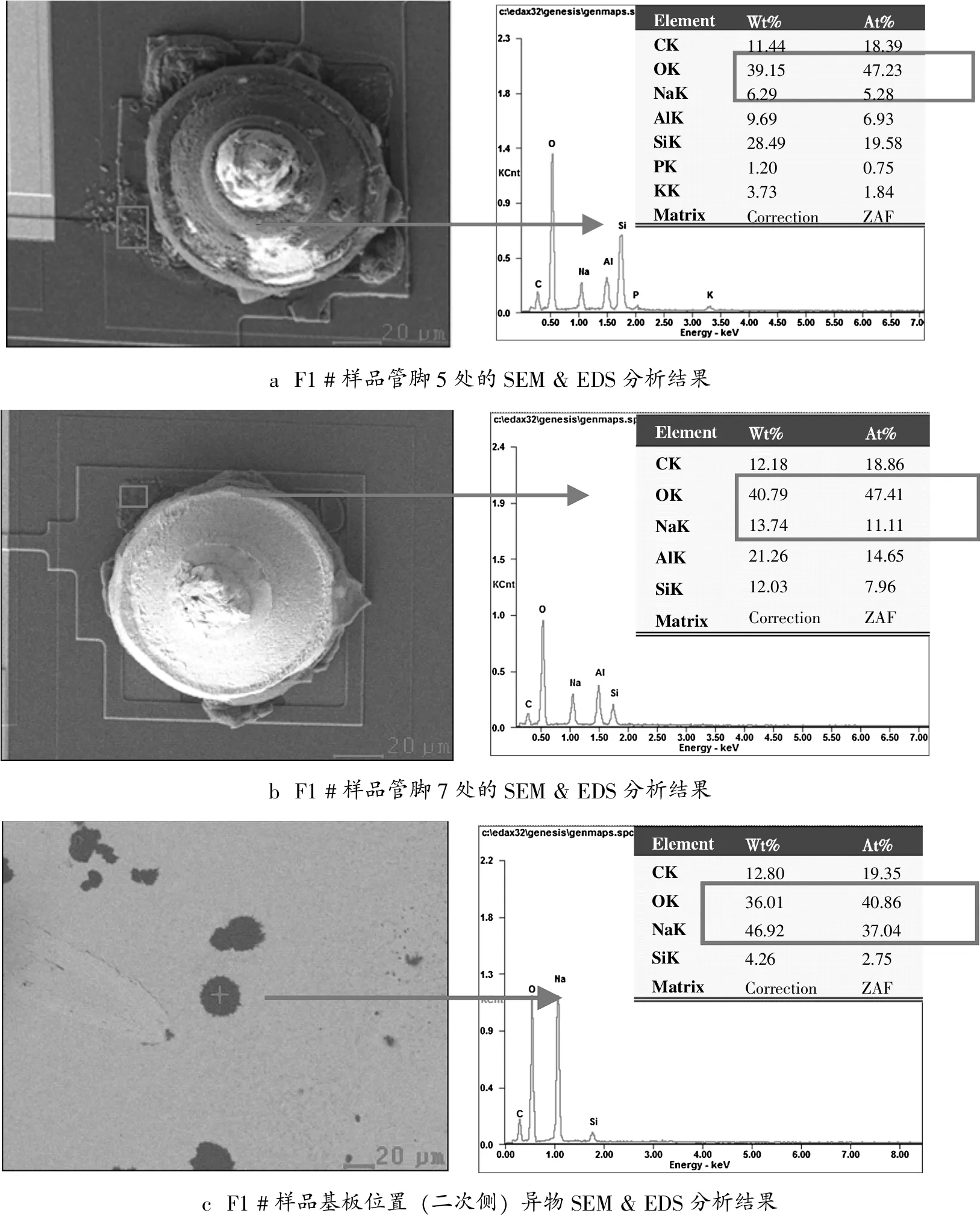
图6 F1#样品的SEM&EDS分析结果
对F2#样品进行机械开封后,在光学显微镜下观察,结果如图7所示。从图7中可以发现,样品内部管脚6、管脚7铝焊盘及其附近的电路已经严重的腐蚀并断开;对腐蚀位置进行SEM&EDS分析,结果如图8所示,从图8中可以看出,受到腐蚀的位置处Na、O元素的含量较高。基板位置(二次侧)发现明显的异物,其中Na、O元素的含量较高;二极管芯片表面未发现异常元素。

图7 F2#样品开封后整体及管脚放大后的形貌图


图8 F2#样品的SEM&EDS分析图
对G2#样品进行机械开封后,发现芯片表面的局部残留导光胶,未见有明显的污染等异常形貌,SEM&EDS分析检测也未发现有明显的异常元素,如图9所示。

图9 G2#样品开封后的外观及SEM&EDS分析结果图
2 结果与讨论
光电耦合芯片样品的主要失效模式为开路。电参数测试结果表明,失效样品F1#样品的管脚5、管脚6以及F2#样品的管脚6、管脚7都存在明显的开路。经过X射线检查,失效样品引线处未见明显的断裂、键合点未见拉脱,这说明铝线断裂或键合点脱落并非芯片开路失效的原因。对失效样品进行机械开封后发现开路管脚所对应的焊盘及其附近的电路存在明显的腐蚀形貌,对腐蚀位置进行EDS分析,发现Na和O元素的含量较高。失效样品二次侧芯片所在基板位置发现明显的异物,其Na和O元素含量也较高。对G2#样品进行机械开封后,未发现异常元素。从相关检测进行分析可以知道,失效的光电耦合芯片内部三极管处的铝焊盘和局部电路有明显的被腐蚀的形貌,而在样品的失效位置检测出含量明显偏高的Na和O元素,这说明有外部的物质进入到封装内部,对芯片表面的金属进行腐蚀,最终导致金属连接线断开,从而使样品呈现开路失效。
为了降低光电耦合芯片发生此种开路失效现象的可能性,保证光电耦合芯片封装的可靠性,首先,在芯片封装过程中就需要优化器件封装工艺,检测器件封装的气密性[6-7],需要对器件内部水汽含量进行有效的控制,防止水汽存在或被引入器件的内部;其次,需要改善光电耦合芯片的工作和存储环境,不能让器件长期暴露在潮湿或恶劣的环境中,湿气和盐雾的侵蚀很容易导致芯片表面金属连接线的腐蚀和断裂。
3 结束语
针对光电耦合芯片的开路失效问题,选取了一个典型的案例进行分析,详细地介绍了光电耦合芯片的分析过程和手段,包括所采用的形貌观察、电参数测试、X射线检测、SEM&EDS等分析手段,并与良品进行了对比。通过分析得知,导致开路的主要原因为铝焊盘和局部电路的腐蚀。同时总结和分析了导致开路失效的主要原因。
为了降低器件开路失效发生的概率,可采取的对策主要有以下两条:
a)改善器件封装工艺,检测器件封装过程中的气密性,严格地控制器件内部的水汽含量,防止在封装时把水汽引入器件的内部;
b)改善光电耦合芯片的工作和存储环境,不能让器件长期暴露在潮湿或恶劣的环境中,因为环境中的湿气和盐雾很容易进入封装内部,对芯片表面的金属进行腐蚀。
