应变Si 纳米NMOSFET单粒子效应
2018-07-23廖晨光郝敏如
廖晨光,郝敏如
(西安电子科技大学 微电子学院,陕西 西安 710071)
随着微电子集成电路技术的快速发展,以互补型金属氧化物为核心的半导体技术已进入纳米尺度,由于正常工作的集成电路受到纳米器件二级物理效应产生的影响,各种新技术以及新材料被国内外各研究院所迫切开发[1-5],目的是提高器件以及集成电路的特性。应变硅技术由于带隙可调、迁移率高等优点,并且其技术与传统的 Si工艺技术相兼容,因此被广泛应用于集成电路中,因而成为目前提高应变集成技术的重要途径之一[6-10]。单轴应变相对于双轴应变更适用CMOS集成电路制造,因此关于单轴应变Si MOSFET的性能研究备受关注[11-16]。随着应变集成器件及电路技术在空间、军事等领域的广泛应用,在辐照条件下应变集成器件及电路的应用将会越来越多,因此辐照特性及加固技术对应变集成器件的研究显得尤为重要[17-19]。由于目前抗辐射器件的研制过程周期长以及代价昂贵。因此, 对于抗辐照研究分析,前期利用计算机的模拟仿真很有必要,一方面减少了人力和成本的消耗,另一方面, 器件内部的电参数可以通过计算机模拟仿真获得。本文主要通过计算机模拟仿真验证漏斗模型的正确性,并且通过二维数值仿真分析了单轴应变Si纳米NMOSFET器件在不同漏极偏置电压,不同沟道长度以及不同注入位置对瞬态电流大小的影响。
1 器件结构
图1是单轴应变Si器件单粒子效应原理图。表1列出了器件结构以及工艺参数。表2给出了仿真单粒子效应重离子模型的参数,其中,let_f 和 wt_hi分别是线性能量传输值以及半径。方向(0,1)为单粒子垂直注入单轴应变Si器件。随着集成电路继续发展,集成电路的特征尺寸由深亚微米进入纳米级,为了更精确的研究纳米尺度的器件,本文利用Sentaurus TCAD软件进行器件仿真,同时添加了小尺寸模型,SRH和Auger复合,禁带变窄及迁移率模型等。
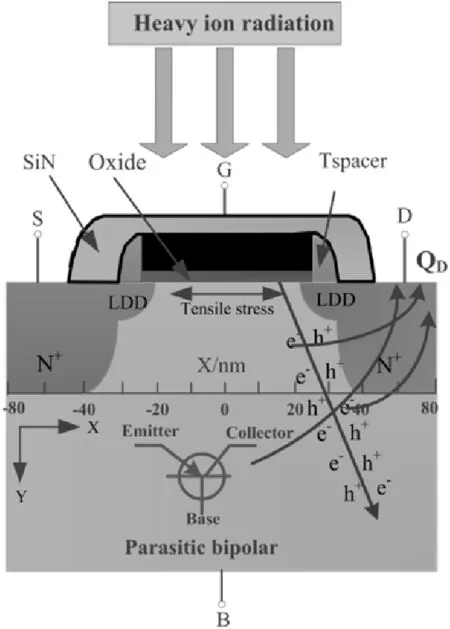
图1 单粒子效应的原理图

表1 部分器件结构以及工艺参数

表2 部分重离子模型参数
2 结果与分析
图2是单粒子注入后单轴应变Si 纳米NMOSFET器件内部电势分布的仿真模拟图。注入位置是0.00 μm, LET值是0.02 pC/μm。图2给出了单轴应变Si 纳米NMOSFET器件在0 ps, 1 ps, 5 ps, 10 ps, 20 ps 以及50 ps时的电势分布。由图2可看出,0 ps为重离子入射前电势的分布,1 ps为粒子入射的起初阶段,此刻粒子入射到漏端,产生的电场区沿着重离子的运动径迹形成,并且延伸至衬底区;20 ps后,电场区逐渐衰弱,达到50 ps时,由于单粒子辐照产生的电场完全消失。因此,由图2可得出,电荷漏斗模型与计算机的仿真模拟结果相吻合,证实了漏斗模型的正确性。

图2 电势等位线分布图
图3为在不同漏极偏置下,瞬态电流和收集电荷的变化趋势,以及电场的分布。由图3(a)可看出,随着漏极偏置电压的增大,单粒子瞬态电流峰值越高,脉冲宽度越大。根据单粒子瞬态电流的机制,漏极电压的增大,不仅增大了耗尽区漂移电流,而且增大了漏斗漂移电流和双极放大效应。此外,还可以看出不论漏极电压的大小变化,漏极瞬态电流最终值都降为0,这也说明漏极电压的变化对扩散电流没有影响。由图3(b)可知,漏极电压越大,漏斗电场越大,从而通过漏斗电场以及双极放大效应,更多的电荷被漏极收集。因此,漏极电压越大,单粒子瞬态电流峰值越高,脉冲越宽,以至于器件的单粒子翻转越容易发生。
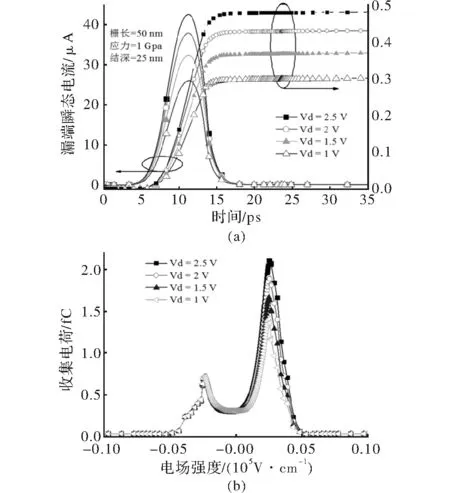
图3 电流及收集电荷分布和电场分布
随着半导体工业的快速发展,器件尺寸不断缩减导致器件的单粒子效应越来越敏感。随着沟道长度的减小,寄生晶体管的基区变薄,导致寄生晶体管更容易开启。图4是在不同沟道长度下,漏极瞬态脉冲电流的变化。由图4(a)可知,漏极瞬态脉冲电流随着沟道长度的减小而增大。表3给出了栅长为50 nm和120 nm源极和漏极的瞬态电流的大小比较。由图4(b)和表3可知,随着沟道长度的减小,寄生晶体管变得更容易开启,同时可得知双极放大效应更明显。

图4 不同沟道长度的源漏极电流

表3 源漏电流对比(L=50 nm和L=120 nm)
图5是不同的注入位置,电场分布以及漏极瞬态电流的分布。由图5(a)可看出,电场强度最大的位置是X=25 nm。同时由图5(b)可知,单粒子瞬态电流最大时的位置也是X=25 nm。因此,由图5可知,对于该器件单粒子效应的敏感位置是X=25 nm。此外,由图5(b)可看出,X=0.00 nm处的电流值稍微高于X=45 nm处,这是由于该点正好位于栅极的正中央,重离子注入时躲避了高浓度的漏区, 从而减小了复合电流, 而且距离漏/体的位置更近一些。由图5还可以看出,注入位置离敏感区越近,漏极瞬态电流越大。
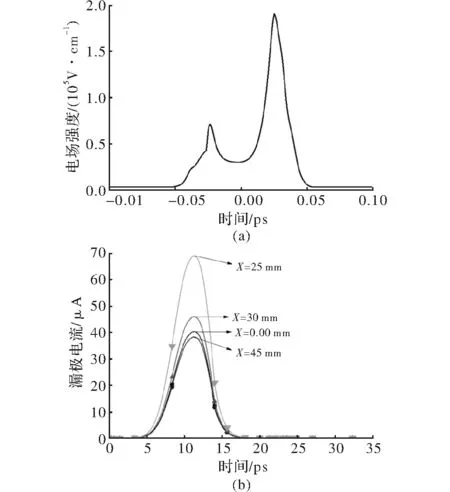
图5 不同注入位置的瞬态电流
4 结束语
本文主要通过计算机模拟仿真验证了漏斗模型的正确性,并且通过二维数值仿真分析了单轴应变Si纳米NMOSFET器件在不同漏极偏置电压,不同沟道长度以及不同注入位置对瞬态电流大小的影响。模拟结果显示,器件的单粒子瞬态电流以及收集电荷随着漏极偏置电压的增大而增大,随着沟道长度的减小而增大。由于目前微电子器件尺寸的不断缩减,导致以源区、体区以及漏区分别被看作发射区、基区以及集电区的寄生晶体管更容易开启。此外,通过仿真结果分析,不同注入位置下的单粒子效应,此处的漏极瞬态电流大小与对应位置的电场强度成正比关系。因此,本文仿真结果为研究纳米级单轴应变Si NMOSFET应变集成器件可靠性及电路的应用提供了理论指导。
