基于SolidWorks Simulation的主板散热设计
2018-02-05马建章何新文
马建章,何新文
(中国电子科技集团公司第五十四研究所,河北 石家庄 050081)
0 引言
主板处理器正朝着小型化、集成化和高功耗化的趋势发展,相对的单位体积内所发出的热量越来越高,主板散热问题也愈来愈突出并受到重视[1]。散热性是电子设备的重要指标,传统热设计中,设计师依靠经验设计样机,并通过试验和测试发现设计问题和缺点,造成人力、物力和财力的浪费和漫长的研制周期[2]。热仿真软件可以使设计师在设计阶段评估设备散热性能、改进薄弱环节。Simulation是SolidWorks公司开发的一种有限元分析工具软件,它作为嵌入式分析软件与SolidWorks无缝集成[3],可进行应力计算分析、线性与非线性分析、热设计与分析、疲劳分析等[4]。本文以某一电子设备主板散热设计分析为例,提出基于SolidWorks Simulation分析的主板传导散热的设计方法。
1 主板散热结构设计
电子通信设备主板的处理器、芯片等大功率器件一般都需要进行散热设计。某通信设备由机箱、主板、通信模块和电源等组成,设备要求工作温度最高为55 ℃。设备主板由控制单元、远传单元和基板3部分组成,其中,控制单元的控制处理器和图像处理器功率分别为22 W和6 W,远传单元的交换处理器功率为6 W。控制处理器功率最大,要求温度不超过91 ℃,因此主要针对控制处理器进行散热设计和分析。主板的结构如图1所示。
设备为密封机箱,采用传导的方式对3个处理器进行散热。综合考虑可靠性、安装性和维修性,将处理器紧贴设备底板,再通过底板的自然对流散热将热量散出去。主板采用厚铝板铣制而成,外表面进行喷漆处理,将主板固定在底板的压铆螺钉上,底板上处理器对应位置设计凸台,使用导热衬垫填充处理器与底板的缝隙。主板安装图如图2所示。

图1 主板结构

图2 主板安装
2 底板的散热设计
使用SolidWorks软件对底板散热进行仿真分析,评估其散热性能是否满足主板需要,并进一步设计底板结构。
2.1 底板散热分析
使用SolidWorks Simulation进行散热分析的具体步骤为[5]:① 创建算例;② 应用材料;③ 施加约束和载荷;④ 划分网格;⑤ 运行分析;⑥ 分析结果。
2.1.1 创建算例,应用材料
在方案设计阶段已经建立了底板、导热衬垫和主板的三维模型,只需要对模型进行简化即可进行分析。简化模型一般是删除不必要的特征,如圆角、孔等;对于装配体简化模型也包括删除不必要的零部件。在此主要考虑底板的散热性能,忽略导热衬垫、主板,计算时将主板处理器的热量赋予底板的相应位置即可。
模型简化后建立新的算例,赋予算例中零件材料参数。底板材料为5A06铝合金,其导热系数为117 W/(m·K)[6]。由于底板的长度和宽度远大于厚度,可以将其视为壳体,忽略厚度方向的尺寸,这样能简化网格,节省计算时间。需要注意的是,施加载荷和约束的点、线、面都要在定义的壳体面上[7]。
2.1.2 施加载荷和约束
根据处理器参数,在底板上处理器对应的位置赋予22 W、6 W、6 W的热量。底板的背面添加对流约束,根据文献[8]给出的公式估算平板空气对流换热系数为3.6 W/(m2·K)。环境温度设定为55 ℃。
2.1.3 划分网格,运行分析
划分网格是将模型分割成有限个单元,网格的大小决定了计算的精确度,网格越小,计算量越大,计算结果越精确[9]。在大多数SolidWorks Simulation分析过程中,默认的网格设置使离散化误差保持在可接受的范围内,同时计算时间比较短。本文使用网格控制工具,对应力集中区域进行网格细化,其他区域采用默认的网格大小。网格划分完成后,右键点击算例,选择运行,进行求解。
2.1.4 分析结果
求解完成后,软件采用云图的方式显示温度。分析结果如图3所示。从温度云图中可以看出,模型的最高温度为100 ℃,最低温度为59 ℃;即处理器的温度为100 ℃,超过要求值。底板的热量比较集中,温差达41 ℃,厚铝板铣制底板的自然对流散热效率比较低,无法满足主板散热要求。
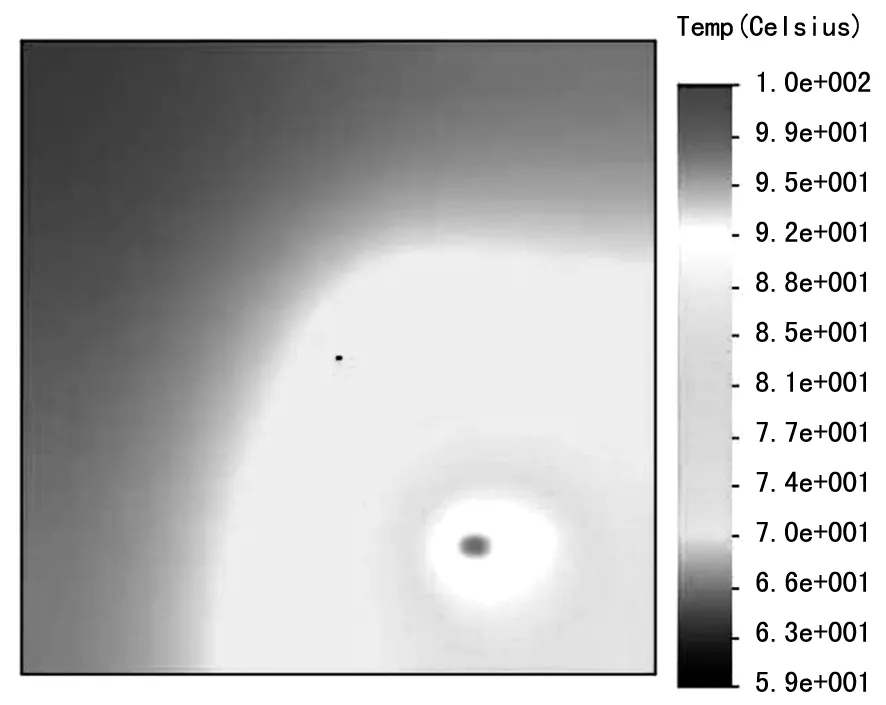
图3 底板散热仿真温度云图
2.2 底板散热改进设计
底板热量集中,为提高散热效率,考虑到成本、加工工艺和加工周期等因素,选择使用热管将热量分散。热管具有优良的导热性、等温性、热响应性、无噪声、无振动和可靠性高等特点[10]。选用中温热管,填充介质为水,管壳材料为铜,采用烧结芯,其换热系数为10 000 W/(m·K)[11]。控制处理器相应位置设计2根热管,图像处理器和交换处理器相应位置各设计1根热管。改进后的底板如图4所示。

图4 改进后底板的结构
在SolidWorks中建立装配体,加入底板和热管的模型,使用SolidWorks Simulation分析,设置热管的导热系数为10 000 W/(m·K),设置热管与底板接触为接合,运用网格控制,细化热管网格,其他参数不变。分析结果如图5所示。从图5中可以看出,模型最高温度为71 ℃,满足要求。

图5 改进后底板的散热仿真温度云图
3 导热衬垫的选择
在实际中,处理器与底板不可能紧密结合,存在较大的接触热阻,需要在处理器与底板之间加入导热衬垫。导热衬垫可以填满由于不同高度、粗糙表面和加工偏差所造成的空气间隙;其材料柔软,可以吸收应力及撞击力,避免损坏器件;材料两面的粘性使其对接触的表面具有良好湿润性,可减小热阻[12]。导热衬垫具有良好的形状适应性,在设计时,应根据接触面积、散热器的力学性能等选择合适的压缩量[13]。处理器尺寸相对较小,考虑印制板和处理器的材料力学性能,手册建议导电衬垫的压缩量为30%左右。
导热垫的厚度越大,其热阻越大,因此尽量选择较小厚度的导热衬垫。由于在散热器加工和印制板电装存在误差,为保证装配时导电衬垫能达到设计压缩量,一般选择1 mm、1.5 mm、2 mm的导电衬垫。
导热衬垫的热量传导可以简单地看作单层平壁导热,文献[14]给出了单层平壁的稳态导热公式:

(1)
式中,φ为传递的热量;λ为导热系数;A为导热面积;Δt为两侧温差;δ为厚度。
由式(1)可得:
(2)
由式(2)可以看出,导热垫传递的热量φ、导热面积A不变,导热衬垫两侧温差Δt与厚度δ成正比,与导热系数λ成反比[15],因此尽量选择厚度小、导热系数高的导热衬垫。
当环境温度为55 ℃时,要求处理器温度不超过90 ℃,即处理器与环境的温差不大于30 ℃。根据经验和仿真结果,假设底板与环境的温度差为16 ℃,则导热衬垫两侧的温度差不大于19 ℃。选择厚度为1mm的导热衬垫,压缩以后的厚度为0.7mm,计算导热系数:
通常用的高效导热衬垫的导热系数为:4 W/(m·K)、7 W/(m·K)、11 W/(m·K)等。导热材料与处理器和底板间的空气介质不能完全被消除[16],实际中导热衬垫的热阻大于理论值;同时,考虑到加工误差、理论值与实际值的误差,选择导热系数为7 W/(m·K)的导热衬垫。
在底板和热管的模型中加入导热衬垫,设置全局接触为接合,细化导热衬垫网格;在导热衬垫表面赋予相应的热量,其他参数不变,使用SolidWorks Simulation进行分析,分析结果如图6所示。从图6中可以看出,处理器最高温度为81 ℃。
按照改进后的方案研制样机进行测试,在环境温度为55 ℃,开机1 h后,测量处理器温度为83 ℃,与仿真基本相符,满足设计要求。

图6 主板散热仿真温度云图(环境温度55 ℃)
4 结束语
设备散热设计不能仅仅依靠经验,散热设计是一项系统工程。设备散热系统设计前应首先获得热源、使用环境和设备环境适应性要求等资料、参数,在此基础上再进行计算或仿真分析,同时还应考虑加工工艺、加工误差、材料成本和散热方式等因素,综合以上因素,选择适合的散热方式、散热器和导热材料等。在散热设计中使用SolidWorks Simulation软件进行仿真分析,能快速得到相应的计算和分析结果,从而极大地缩短产品的设计周期,降低试验成本,提高产品质量,值得在结构设计中推广应用[17]。
[1] 董志忠,孟勋,梁展鹏,等.散热模块材料对ATCA主板散热性能影响研究[J].工程热物理学报,2008,29(3):482-484.
[2] 卢锡铭.电子设备热仿真及热测试技术研究[J].舰船电子对抗,2013,36(3):118-120.
[3] 刘春燕,杨巍巍.基于SolidWorks 的不规则空间连接弯管设计[J].计算机系统应用,2014,23(7):260-262.
[4] 陈永当,鲍志强,任慧娟,等.基于SolidWorks Simulation的产品设计有限元分析[J].计算机技术与发展,2012,22(9):177-180.
[5] 马建章,高驰名,吴迪,等.基于Solidworks Simulation软件的背板架改进设计[J].数字技术与应用,2015(2):187-188.
[6] 宋正梅.有源相控阵天线微通道冷却技术研究[D].西安:西安电子科技大学,2013.
[7] 陈超祥,叶修梓.SolidWorks Simulation 高级教程[M].北京:机械工业出版社,2011.
[8] 余建祖,高红霞,谢永奇.电子设备热设计及分析技术[M].北京:北京航空航天大学出版社,2008.
[9] 陈超祥,叶修梓.SolidWorks Simulation 基础教程[M].北京:机械工业出版社,2010.
[10] 阿伦 D.克劳斯,艾弗兰·巴克恩.电子设备的热控制与分析[M].赵惇殳,秦荻辉,王世萍,译.北京:国防工业出版社,1992.
[11] 王健石,朱东霞.电子设备热设计速查手册[M].北京:电子工业出版社,2008.
[12] 任红艳,胡金.刚接触热阻与接触导热填料[J].宇航材料工艺,1999(6):11-15.
[13] 答邦宁.导热衬垫在印制板组件上的应用研究[J].电子机械工程,2013,29(3):50-52.
[14] 张天孙.传热学[M].北京:中国电力出版社,2007.
[15] 邱成悌,赵惇殳,蒋全兴,等.电子设备结构设计原理[M].南京:东南大学出版社,2007.
[16] 答邦宁.导热衬垫在印制板组件上的应用研究[J].电子机械工程,2013,29(3):50-52.
[17] 王丽.大功率电子设备结构热设计研究[J].无线电工程,2009,39(1):61-64.
