MEMS压力传感器工艺可靠性测试评价
2017-12-26马婷婷马书嫏张爱军
马婷婷,马书嫏,张爱军
(华润上华科技有限公司,江苏 无锡 214061)
MEMS压力传感器工艺可靠性测试评价
马婷婷*,马书嫏,张爱军
(华润上华科技有限公司,江苏 无锡 214061)
随着MEMS技术的飞速发展,可靠性问题逐渐成为MEMS器件在军事和商业中应用的重要阻碍。结合器件的工作环境,分别从高温、高温高湿、温度冲击、过电压、压力过载、温湿循环等环境负载方面探讨硅压阻式MEMS压力传感器的工艺可靠性问题。试验结果表明,环境负载后,圆片级器件特性参数基本无变化,而封装级器件特性参数有不同程度的漂移。参照工厂制定的工艺标准(<10%),封装级器件测试数据可以有效监控MEM产品的工艺质量。
MEMS;传感器;可靠性;环境负载
随着科学技术的飞速发展,IC产品的尺寸设计越来越小,性能越来越高,涵盖范围越来越广。微电子技术的微型研究带来了各行业的巨变,不仅使计算机与信息技术等领域面貌一新,而且在许多领域引发了一场微小型化的革命。机械制造领域的微小型化诞生了微机电系统即MEMS(Microelectro Mechanical Systems)。它将电子功能与机械、光学、热学、磁学等其他功能结合在一起,形成综合集成系统[1]。经过四十多年的发展,MEMS已成为世界瞩目的重大领域之一。许多世界大国都将MEMS技术作为战略性的研究领域之一,投入巨资进行专项研究。
MEMS传感器是采用微机械加工技术制造的新型传感器,是MEMS器件的一个重要分支。随着MEMS技术产业的日益成熟,MEMS传感器种类越来越多,性能也越来越强大,产品已广泛应用于汽车、医疗、军事等领域[2-8]。而相对于工艺的迅速发展,MEMS可靠性的研究落后了很多。目前MEMS可靠性的评估方法在行业内还没有标准化,工厂针对MEMS产品也仅有PCM参数测量。没有可行的可靠性测试方法,就无法验证和监控MEMS工艺的可靠性。因此,标准化可靠性评估方法的建立已迫在眉睫。
基于微电子行业器件失效机理研究和可靠性评价体系的完备,这些可靠性评价经验在预测MEMS产品的使用可靠性方面是有借鉴作用的。但是MEMS压力传感器对环境的依赖度较高,必须考虑在严酷的使用环境下传感器独特的失效模式[9-12]。
本文基于硅压阻式MEMS压力传感器的结构和工作原理等信息,反推至芯片相关工艺参数,并设计针对关键工艺参数的可靠性测试方法。
1 MEMS压力传感器结构:
与传统的压力传感器相比,MEMS压力传感器不仅体积小,而且具有较高的测量精度、较低的功耗和极低的成本[13]。绝大多数的MEMS压力传感器的感压元件是硅膜片,根据敏感机理的不同,可将MEMS压力传感器分为3种:压阻式、电容式和谐振式[14]。其中,硅压阻式MEMS压力传感器采用高精密半导体电阻应变片组成惠斯顿电桥,利用半导体材料的压阻效应[15]和良好的弹性来进行力电变换。
华润上华(CSMC)制备的硅压阻式MEMS压力传感器的标准流程如下:首先在抛光的硅衬底上经光刻注入生成四根电阻应变片,电阻应变片被设计在硅膜表面应力最大处,组成惠斯顿电桥。然后在圆片背面,从硅片中部刻蚀出一个应力杯。最后键合圆片背面。根据产品应用,即可以在应力杯中抽真空制成绝压MEMS器件,也可以维持应力杯和大气相通制成表压MEMS器件。其结构如图1所示。
产品封装后,当硅膜两边的压力差发生变化时,应力硅膜会发生弹性形变,破坏原先的惠斯顿电桥电路平衡,产生电桥输出与压力成正比的电压信号。
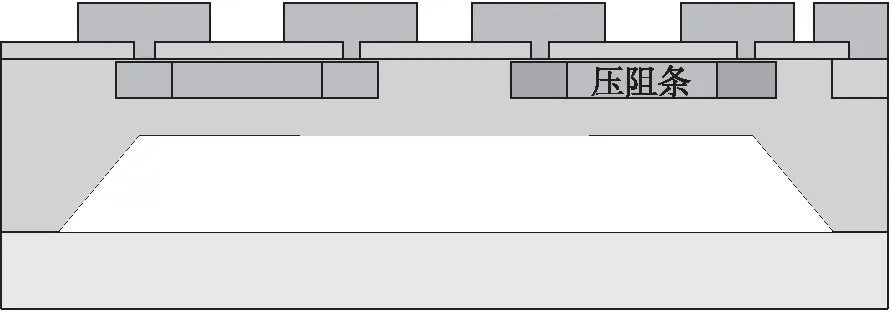
图1 硅压阻式MEMS压力传感器结构示意图
2 测试结构的确定
MEMS压力传感器的特性参数包含有零位输出、电压输出、线性度、回滞特性等。这些特性参数与惠斯顿电桥强相关。因此,惠斯顿电桥的可靠性一定程度上反映了MEMS压力传感器的可靠性。我们在圆片上设计一个典型的惠斯顿电桥结构,用来监控MEMS器件的特性参数。如图2所示:R1、R2、R3及R4是4根等电阻的压阻应变条,它们在硅膜上组成惠斯顿电桥,无外力作用时,电桥平衡,输出电压为零。当膜片受到外界压力作用时,电桥失去平衡,若对电桥加激励电源,便可得到与被测压力成正比的输出电压,从而达到测量压力的目的。
结合器件的实际使用,综合考虑器件的工作条件和环境,从高温存储、高温高湿、温度冲击、过电压、压力过载、温湿循环等方面全面建立MEMS压力传感器圆片级和封装级的可靠性考核方法。
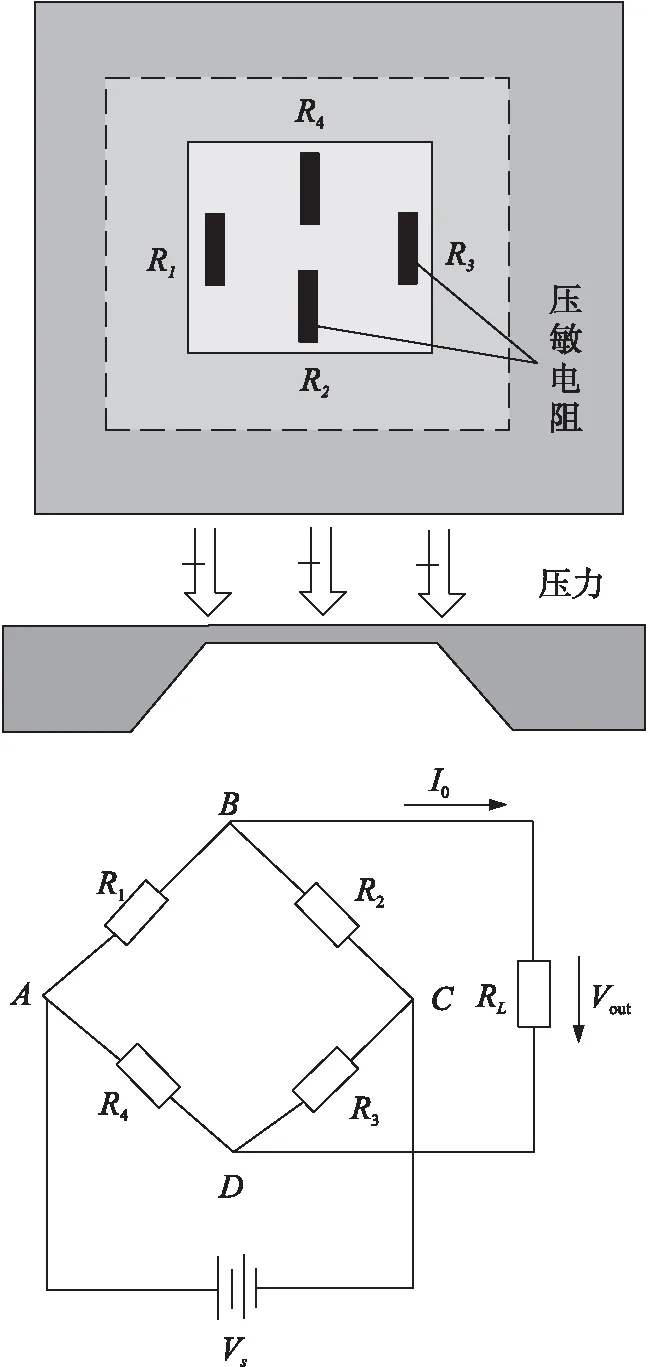
图2 测试模块结构示意图
3 圆片级MEMS可靠性考核方法
目前工厂中MEMS圆片级产品的工艺监控基本上是依赖PCM参数测量。在这里,我们结合MEMS产品的实际使用条件,通过监控零位输出电压的高温存储、高温高湿特性,考核圆片级(应力杯未释放状态)惠斯顿电桥的环境可靠性。

图3 高温存储Voff变化图(125 ℃和168 h)
3.1 高温存储可靠性考核
在125 ℃高温下,将MEMS圆片分别老化12 h、48 h和168 h后,测试零位输出电压(Voff)。通过与初始零位输出电压的对比,考核电阻应变片的工艺可靠性。
从老化数据可见,经过125 ℃的高温存储,各时间段的零位输出电压变化量都很小。即使经过168 h的高温存储,未释放状态下的压阻应变片电阻仍然比较稳定,可靠性风险较低。
3.2 高温高湿可靠性考核
在85 ℃和85%RH高温高湿条件下,将MEMS圆片分别老化24 h、72 h和168 h后,测试零位输出电压(Voff)。通过与初始零位输出电压的对比,考核电阻应变片的工艺可靠性。

图4 高温高湿存储Voff变化图(85 ℃和85% 168 h)
对比不同时间段的Voff值,发现经过85 ℃和85%RH的老化,各时间段的零位输出电压变化量都很小。即使经过168 h的高温高湿存储,未释放状态下的压阻应变片电阻仍然很稳定,可靠性风险较低。
圆片级的测试结构由于未释放应力杯,主要考核的是电阻应变片在高温、高温高湿老化后的工艺稳定性。除非工艺非常不稳定,一般情况下,电阻经过温度老化和湿度老化的可靠性风险都较低。
4 封装级MEMS可靠性考核方法:
对于释放应力杯并完成封装的MEMS器件来说,高温或高湿老化可能会影响硅膜的弹性形变,而长时间的压力负载也可能导致硅膜疲劳。这些损害会造成MEMS特性参数的漂移,严重的话会引发器件开路和短路,从而影响产品最终的可靠性。因此,封装级MEMS器件的环境负载考核更加重要。
4.1 高温存储可靠性考核
将封装的绝压MEMS器件在125 ℃高温下老化72 h后,分别测试器件在40 kPa~100 kPa下的输出电压、线性度、回滞特性参数。
由图5可见,封装器件进行72 h高温存储老化后,线性度和回滞特性良好;不同压力下的输出电压与初始值相比shift<1%。根据工艺给出的输出电压判定SPEC:shift≤±10%,可靠性风险较低。
4.2 温度冲击可靠性考核
将封装的绝压MEMS器件在-50 ℃和150 ℃高温下,进行10次循环冲击,然后测试器件在40 kPa~100 kPa下的输出电压、线性度、回滞特性参数。
由图6可见,温度冲击对线性度和回滞特性影响较低,曲线线性度和重合度良好;不同压力下的输出电压在与初始值相比shift<1%。根据工艺给出的输出电压判定SPEC:shift≤±10%,可靠性风险较低。
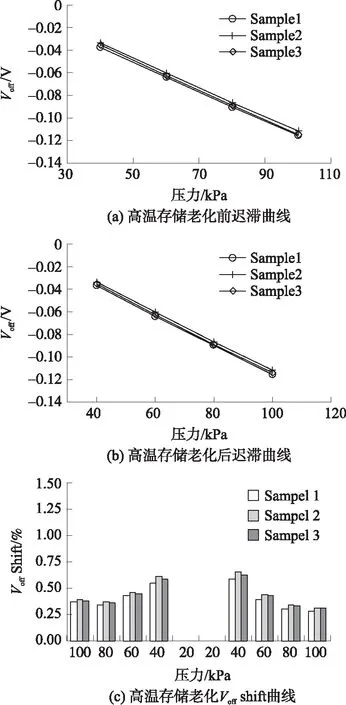
图5 高温存储老化前、后压力迟滞曲线和高温存储老化Voff shift曲线
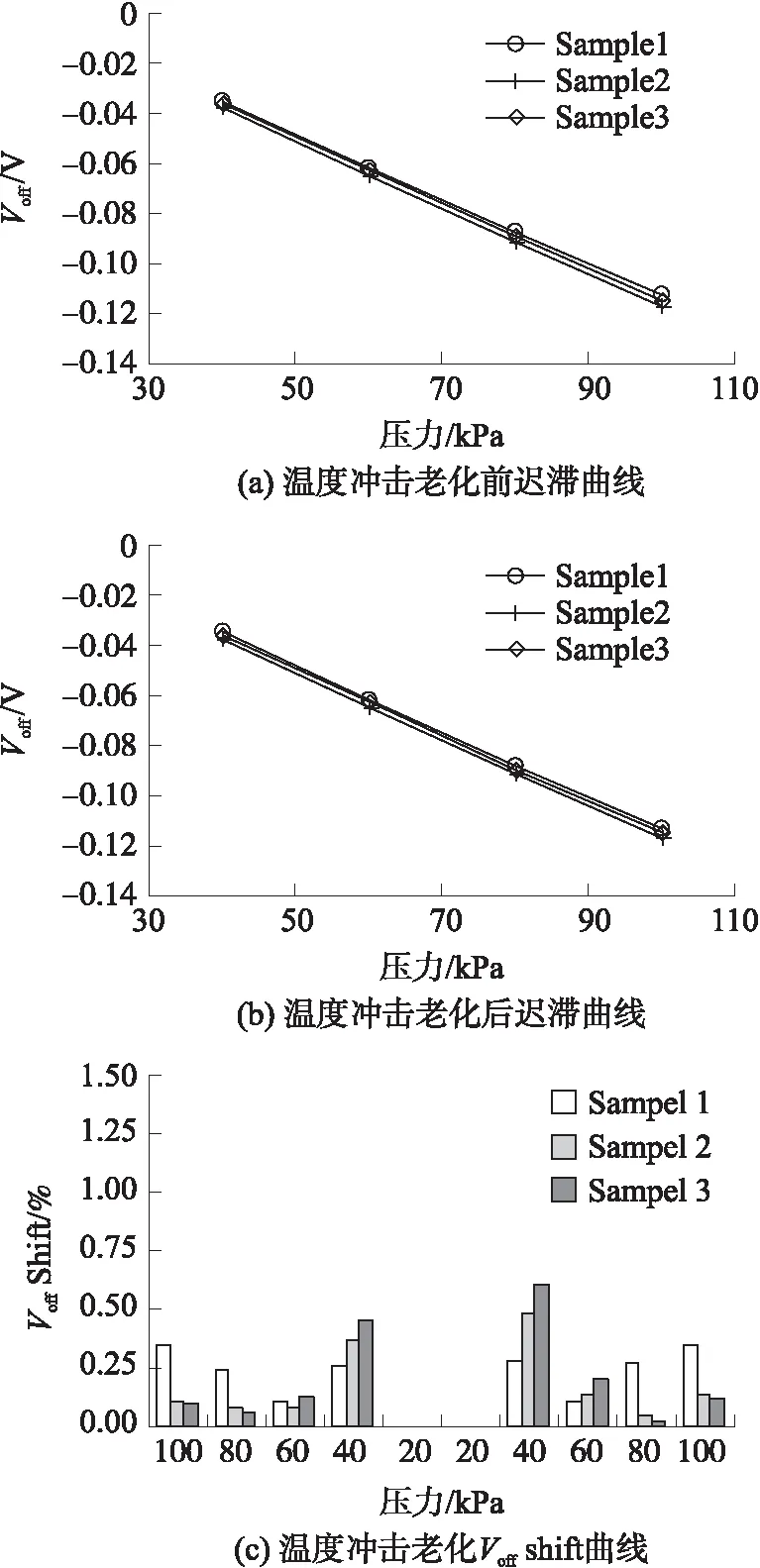
图6 温度冲击老化前、后压力迟滞曲线和温度冲击老化Voff shift曲线
4.3 温湿循环可靠性考核
将封装的绝压MEMS器件置于40 ℃~65 ℃高温,90%RH~95%RH环境下,以24 h为一个循环周期,连续循环6次,然后测试器件在40 kPa~100 kPa下的输出电压、线性度、回滞特性参数。
由图7可见,温湿循环老化对线性度和回滞特性影响也较低,曲线线性度和重合度良好;不同压力下的输出电压与初始值相比shift<1%。根据工艺给出的输出电压判定SPEC:shift≤±10%,可靠性风险较低。
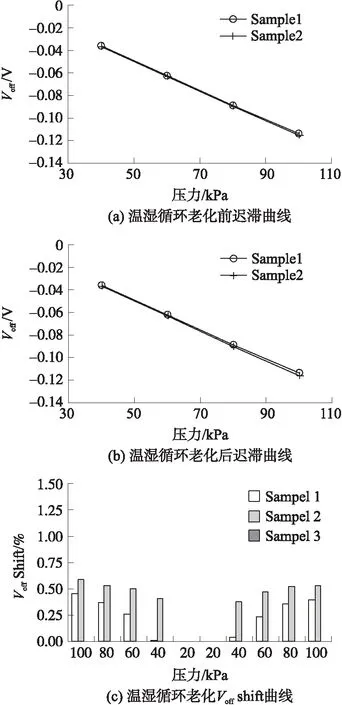
图7 温湿循环老化前、后压力迟滞曲线和温湿循环老化Voff shift曲线
4.4 电压过载可靠性考核
MEMS产品一般都是电子产品,基本都需要接电源使用,所以考核产品的电压过载可靠性也是非常必要的。将封装的绝压MEMS器件在3.2倍的工作电压下持续过电压1 min,然后测试器件在40 kPa~100 kPa下的输出电压、线性度、回滞特性参数。
由图8可见,短时电压过载对线性度和回滞特性影响较小,曲线线性度和重合度良好;不同压力下的输出电压与初始值相比shift<0.6%。根据工艺给出的输出电压判定SPEC:shift≤±10%,可靠性风险低。
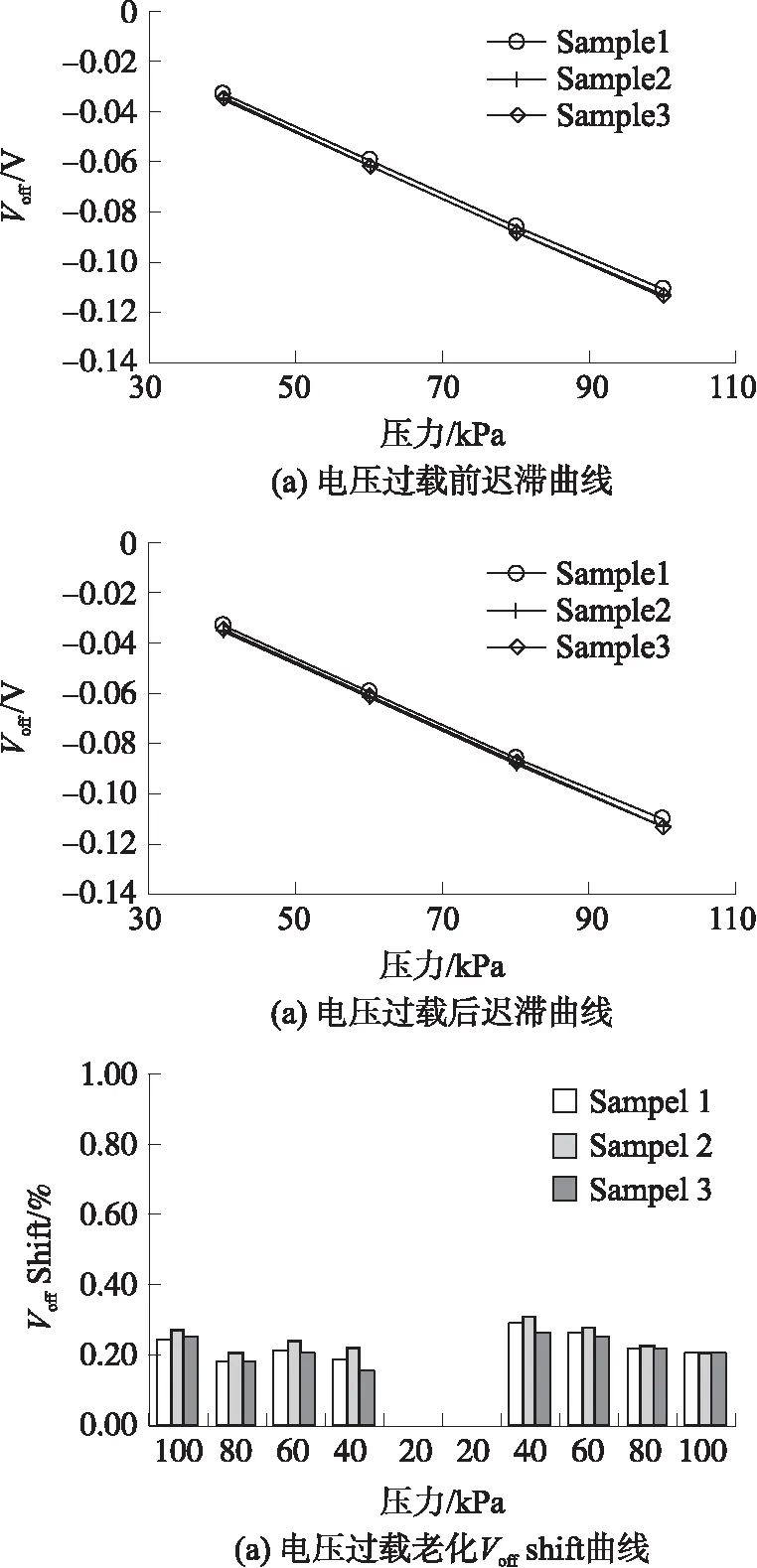
图8 电压过载前、后压力迟滞曲线和电压过载老化Voff shift曲线
4.5 压力过载可靠性考核
压力MEMS产品最重要的产品特性是压力与输出电压的线性特性,而长时间的压力负载会如何影响产品的使用性能,就需要通过压力过载实验来验证。将封装的绝压MEMS器件在120 ℃和2 atm下老化24 h后,分别测试器件在40 kPa~100 kPa下的输出电压、线性度、回滞特性参数。
由图9可见,压力过载老化对线性度和回滞特性影响也较小,曲线线性度和重合度良好;不同压力下的输出电压与初始值相比shift<5%。根据工艺给出的输出电压判定SPEC:shift≤±10%,可靠性风险较低。
对比论文中所有的测试发现,压力MEMS器件对压力过载试验最敏感。压力过载考核是判断压力MEMS器件可靠性的重要测试方法。

图9 压力过载前、后压力迟滞曲线和压力过载老化Voff shift曲线
5 结论
对于未释放应力杯的圆片来说,零位输出参数在高温和高温高湿老化后变化都不太明显,除非工艺非常不稳定,否则圆片级环境负载测试并不能有效的监控电阻应变条的工艺和质量。
而针对释放后的封装MEMS器件,输出电压在高温存储、温度冲击、温湿循环老化、电压过载、压力过载后,均有不同程度的shift。参照工艺SPEC可以有效监控电阻应变条的工艺和质量。
[1] 张兴,郝一龙,李志宏,等. 跨世纪的新技术——微机电系统(MEMS)[J]. 电子商务,1999(4):2-6.
[2] 秦永和,李伟,程本同,等. 汽车传感器的现状与发展趋势[J]. 传感器与微系统,2003,22(12):5-8.
[3] 滕敏. MEMS压力传感器在汽车上的应用[J]. 河南科技,2010(19):68-69.
[4] 郭楠,张国军,王续博,等. 基于声传感器的新型MEMS听诊探头结构设计初探[J]. 电子器件,2016,39(3):535-539.
[5] 高云,周聪聪,田健,等. 基于多传感器的无创血压测量系统的研究[J]. 传感技术学报,2015,28(5):763-767.
[6] 孙伟,李婉秋,初婧,等. 基于误差修正技术的井下人员MEMS定位方法[J]. 传感技术学报,2014,27(7):898-904.
[7] 王瑞荣. 基于奥米亚寄生蝇的三维声定位MEMS器件设计[J]. 电子器件,2014,37(2):171-176.
[8] 佟玲,邹文江,刘潇潇. 航空航天Mems传感器应用及其发展现状[J]. 电子世界,2011(1):20-21.
[9] 吴虹,李延夫. 硅压力传感器可靠性强化试验研究[J]. 微纳电子技术,2007,44(7):288-290.
[10] 鲍芳,张德平. MEMS压力传感器的可靠性评价方法[J]. 电子产品可靠性与环境试验,2013,31(5):61-66.
[11] 齐虹,王蕴辉,易德兴,等. 硅压力传感器的可靠性试验方法及失效分析[J]. 传感器技术,2001,20(4):31-33.
[12] 陈员娥,刘晴晴,马喜宏,等. 温湿度环境下高量程加速度计可靠性研究[J]. 传感技术学报,2013,26(6):830-833.
[13] 王淑华. MEMS传感器现状及应用[J]. 微纳电子技术,2011,48(8):516-522.
[14] 曹乐,樊尚春,邢维巍. MEMS压力传感器原理及其应用[J]. 计测技术,2012(S1):108-110.
[15] Kanda Y. Piezoresistance effect of silicon[J]. Sensors and Actuators A Physical,1991,28(2):83-91.
MEMSPressureSensorProcessReliabilityEvaluation
MATingting*,MAShulang,ZHANGAijun
(CSMC Technologies Co. Ltd. Jiangsu,Wuxi Jiangsu 214061,China)
Along with the rapid development of MEMS technology ,reliability issue gradually becomes the major barrier for applying MEMS sensor in military and commercial fields. Based on the sensor operation environment,environmental loads including high temperature bias,high temperature-humidity bias,temperature shock,over voltage bias,pressure cooker test,temperature-humidity cycling test are put forward to discuss silicon piezoresistive MEMS pressure sensor process reliability. The test results indicate that,after environmental loads,wafer level devices characteristic parameter has no shift,while package level devices characteristic parameter shifts in different degrees. Based on the process spec in factory(<10%),the package level devices test data could be used to availably monitor MEMS product process quality.
MEMS;sensor;reliability;environmental loads
10.3969/j.issn.1005-9490.2017.06.006
2016-05-01修改日期2016-10-21
TP212.12
A
1005-9490(2017)06-1359-05

马婷婷(1986-)女,汉族,湖北随州人,硕士研究生,华润上华科技有限公司,可靠性工程师,matt@csmc.crmicro.com;

马书嫏(1983-)男,汉族,黑龙江哈尔滨人,硕士研究生,华润上华科技有限公司,可靠性主管,masl@csmc.crmicro.com。
