大口径半球形基底膜层均匀性的分析
2017-06-01高健付新华
高健,付新华
(长春理工大学 光电工程学院,长春 130022)
大口径半球形基底膜层均匀性的分析
高健,付新华
(长春理工大学 光电工程学院,长春 130022)
针对半球面大口径球形光学元件的膜层均匀性进行了理论分析研究。通过建立半球形基底内表面的数学模型,运用膜厚理论公式表达出内表面的膜厚分布。推算了蒸发源不同位置对膜层均匀性的影响,同时对理想点源、小面源和实际蒸发特性对膜厚的影响进行了分析。该研究工作对大曲率半球膜层镀制工艺具有一定的指导意义,在改善此种表面膜层均匀性上提供了理论依据。
大口径光学元件;真空镀膜;膜厚均匀性;内表面
在真空镀膜制备工艺中,最重要的就是对镀膜膜层厚度的精确控制,膜层均匀性直接影响着成品的性能指标,较低的膜厚分布会降低光学系统的性能甚至达不到其设计要求[1-4]。在小平面基板上镀制膜层的膜厚均匀性已经有了较为深入的研究与发展,其膜厚分布有了较为完善的解决办法。但是随着更高光学质量要求的提出,一些大口径大曲率光学元件也需要进行高精度的光学薄膜镀制,比如300~500mm的卡氏系统镜头,相较于小口径平面光学元件而言,这类光学元件表面更加复杂,其镀制薄膜的难度也大大加大[5-8]。
与常规小平面镀膜方法相比,对于大口径大曲率光学元件的镀制,其蒸发源的速率控制和蒸发源相对于基板的位置需要更加精确。本文对特定曲率半径的半球形光学元件进行了膜厚均匀性的理论研究,为了改善这种半球形内表面镀膜均匀性,对这种特定形状的光学元件进行了数学模型的建立,并通过对膜厚均匀性理论的运用,对实际影响膜厚均匀性的参数进行了数学分析并且进行了优化处理。本文主要针对不同蒸发系数n和不同蒸发源位置下对膜厚均匀性的影响,进而改善膜层厚度的分布,得到半球光学元件最佳的光学性能。同时也为大口径镀膜均匀性的调节提供了一种改善方法。
1 膜厚均匀性方程
Holland和Stechelmacher通过研究指出蒸发源发射有两种形式[9],一种是向各个方向均匀发射的点源,另一种是作为平面源以余弦方式发射。在实际的膜层制备中,其蒸发源都是一个小平面源。
根据膜厚分布理论,设有质量为m的材料被蒸发出去,则其立体角dΩ内沉积的磨料为dM,通过积分可以得到m=∫dM,此时
其中,φ为垂直于蒸发面和发射方向的夹角。n为蒸发特性参数,其大小与蒸镀蒸汽的能量大小、方式及镀料有关。n=0时代表点源,n=1时代表按余弦定律蒸发的小平面源,在电子束蒸发中,它的值通常为2-3之间,在某些特殊情况会更高。
同时,在理想情况下这些材料全部沉积在基板上,设蒸发源与基板的垂直距离为r,基板的单位面积为dS,dS与蒸发方向的夹角为θ,则(1)可写成:

设镀制膜层密度为ρ,则膜厚t可以表示为:

2 数学物理模型的建立
蒸发源位于半球下方时,半球形元件内表面镀膜空间配置如图1所示,球体对称轴线为z轴,蒸发源所在平面与z轴的交点为坐标中心O;球面顶点为Q,其中R为此半球的半径长度,h为蒸发源与球底的垂直距离;设半球面内表面任意一点为P,P点距z轴的垂直距离为p,q为蒸发源离轴线的距离,则r为蒸发源与球体内表面某一点P的距离;Φ为面源和面源与任意点P连线的角度,即垂直于蒸发面和发射方向的夹角;θ表示半球面任意点P法线与蒸发方向的夹角;ω表示P点与y轴的水平夹角。

图1 真空室半球形元件蒸镀示意图
通过此坐标系的建立,其各个变量可以表示为:

由膜厚公式(3)和各变量(4)的联立可以表达出半球形元件内表面任意一点的膜厚方程为:

在实际制备薄膜过程中,考虑到蒸发源偏离了半球的对称轴线,所以蒸镀时要伴随半球的自转来获得较为均匀的膜层,也就是说,对于半球的这种特殊对称结构,其同一纬度圆环上的膜层厚度应该是相同的。所以对于膜厚表达式(5),应该对ω进行2π的积分运算,表达式为:

为了较为直观的表达膜厚的均匀性,可以选取球顶Q点为基准点,把任意一点P的膜厚与球顶Q的膜厚进行相除,得到一个相比于Q点膜厚的均匀性表达。Q点膜厚表达式为:

总膜厚可以表达为:

3 膜厚均匀性分析
3.1 理想点源与小面源下的膜层厚度分布
当蒸发源为理想点源蒸发时,n=0;蒸发源为理想小面源时,n=1。固定蒸发源的水平位置位于半球的轴线上,即q=0。通过改变h/R来表示蒸发源与半球的垂直距离,出于实际考虑,R的数值取300mm,通过MATLAB数学软件模拟函数图像如图2所示。通过图中曲线可以看出,随着h/R的增大,膜厚的均匀性呈下降趋势,且当h/R足够大时,半球的膜厚均匀性变化率呈线性变化。同时注意到当h/R=2.5时其膜厚比值大于1,说明此时Q点不在是镀膜膜厚最厚的点。在点源与小面源的分析上,通过图中曲线可以看出,在半球面的这种配置上,理想点源镀制的厚度要高于小面源的厚度,同时随着蒸发源距离半球面的距离变近,这种厚度差异越来越明显,实际镀制过程中,h/R<5时小面源的蒸发方式更为准确。

图2 不同蒸发距离理想点源与小面源蒸发膜厚分布曲线
3.2 实际蒸发源下膜层厚度分布
实际蒸发镀制中[10],蒸发源很难以点源或小面源的状态进行蒸发,通过引入蒸发系数这一变量,通过改变其数值以达到模拟或表达蒸镀分子的实际蒸发运动方式。蒸发系数n根据镀制工艺的不同而改变并适用于大部分镀膜设备,如热阻蒸发和电子枪蒸发等。分别选取h/R=2.5和h/R=5两种蒸发源位置进行对不同蒸发系数对膜厚影响的比较,如图3和图4所示。通过图片可以看出,当蒸发源位置固定时,随着蒸发系数n的增大,膜层的均匀性呈下降趋势。
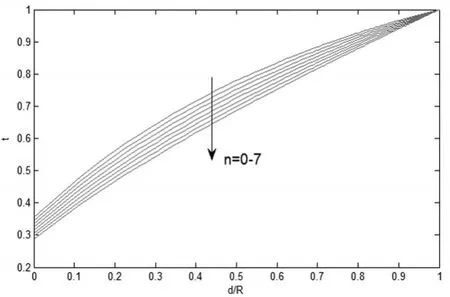
图3 蒸发距离h/R=2.5不同蒸发系数膜厚分布曲线
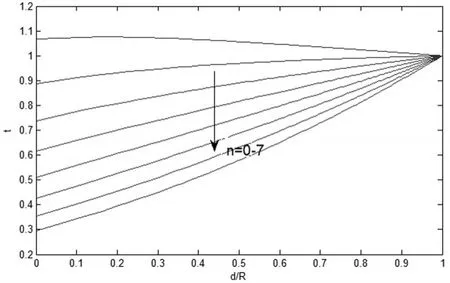
图4 蒸发距离h/R=5不同蒸发系数膜厚分布曲线
同时,蒸发系数n对不同位置的蒸发源影响也不同,对于位置较远的蒸发源(图4),n的变化对膜厚均匀性影响较小,这是因为随着蒸发源的距离增加,蒸发角度Φ比较小,cosφn对膜厚影响也相对减小。
3.3 不同水平位置蒸发源下膜层厚度分布
蒸发源的水平位置也影响着膜厚的分布,图1中q表示蒸发源的水平位置。图5为5种不同垂直高度下的蒸发源各自不同水平位置对半球边缘膜厚的影响曲线。电子束蒸发时其蒸发系数n常为2~3,蒸发系数n取2,来模拟较为实际的蒸发源。
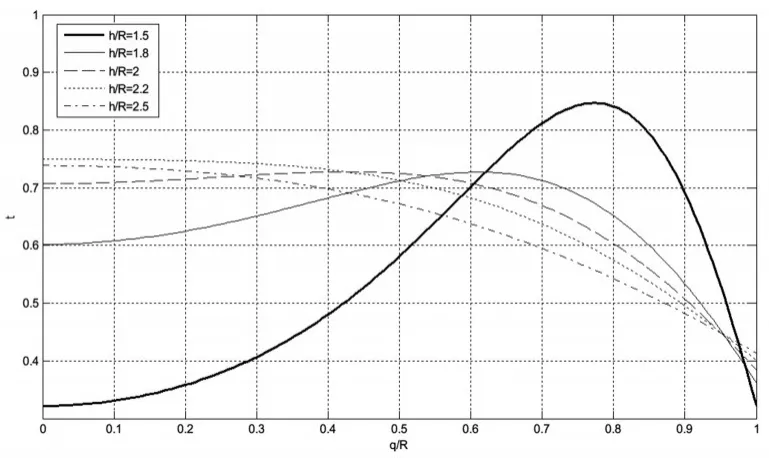
图5 不同水平位置蒸发源下半球边缘膜厚分布曲线
这里用q/R来表示蒸发源的相对水平位置,q=0时蒸发源位于正中心位置,q/R=1时,蒸发源的水平位置位于半球形元件的最边缘。通过曲线可以看出不同垂直高度的蒸发源其水平位置对膜厚的影响有着较大差异。对于垂直高度为h/R=1.5和h/R=1.8的蒸发源而言,随着蒸发源水平距离的增大,边缘厚度先逐渐增大之后急剧降低,表明在蒸发源距离半球元件较近的情况下,适当水平移动蒸发源有助于提高膜层的均匀性;但h/R大于2时,这种影响不是很明显,边缘厚度大体呈下降趋势。
4 结论
主要对半球内表面镀膜的均匀性进行了理论分析。通过对半球型元件与蒸发源的坐标系建立,运用膜厚分布理论的公式计算,表达出半球内表面各点的膜厚分布。当蒸发源位于半球正下方时,理想点源与小面源蒸发和蒸发源不同垂直高度对于膜层厚度的影响进行了分析;在实际蒸发情况下,对不同蒸发系数n对膜厚的影响也进行了探讨;对不在半球正下方的蒸发源,不同水平位置的蒸发源对半球的边缘厚度的改善也进行了模拟和解释。由此分析了对半球内表面镀膜过程中,蒸发源位置和蒸发系数对膜厚均匀性的影响,该模拟分析对大曲率形状镀膜均匀性的研究具有一定的指导作用。
[1]卢进军,刘卫国.光学薄膜技术[M].西安:西北工业大学出版社,2005.
[2]林永昌,卢维强.光学薄膜原理[M].北京:北京国防工业出版社,1986.
[3]潘栋梁,熊胜明,张云洞,等.大口径镀膜机膜厚均匀性分析[J].应用光学,2001,22(1):33-38.
[4]Musset A,Stevenson I C.Thickness distribution of evaporated films[J].SPIE,1990(1270):287-291.
[5]宋健全,刘正堂,于忠奇,等.ZnS头罩增透保护膜系制备[J].红外与毫米波学报,2001,20(3):203-206.
[6]Hong S,Kim E,Bae B S,et al.A simulation model for thickness profile of the film deposited using planar circu⁃lar type magnetron sputtering sources[J].Journal of Vacuum Science&Technology A:Vacuum,Surfaces and Films,1996,14(5):2721-2727.
[7]李香波.大口径基底镀膜均匀性研究[D].长春:中国科学院长春光学精密机械与物理研究所,2008.
[8]阴晓俊,费书国,章月州,等.有限元法计算膜厚均匀性[J].光学仪器,2001,23(5-6):5-10.
[9]唐晋发,顾培夫,刘旭,等.现代光学薄膜技术[M].杭州:浙江大学出版社,2006.
[10]高健.椭球形光学元件镀膜均匀性研究[D].长春:长春理工大学,2016.
Analysis on Membrane Layer Uniformity of Large Diameter Hemispherical Basemen
GAO Jian,FU Xinhua
(School of Optoelectronic Engineering,Changchun University of Science and Technology,Changchun 130022)
Hemispherical surface of large caliber spherical optical element,the author of this paper film uniformity are analyzed in theory research.Through the mathematical model was established,the inner surface of the spherical basal theory of film thickness formula expresses the inner surface of the film thickness distribution.Calculate the evaporation source position influence on film uniformity,and the ideal point source,non-point source and actual evaporation characteristics influence on film thickness are an⁃alyzed.The research work on the large curvature hemisphere film plating process has a certain guiding significance,to improve the uniformity of surface film layer provides theory basis.
large-caliber optical element;vacuum coating;film thickness uniformity;the inner surface
O484
A
1672-9870(2017)02-0053-04
2017-03-17
高健(1990-),男,硕士研究生,E-mail:gaojianrule@163.com
