离子束溅射制备低应力深紫外光学薄膜
2016-12-12才玺坤张立超贺健康武潇野
才玺坤,张立超,时 光,贺健康,武潇野,梅 林
(中国科学院 长春光学精密机械与物理研究所 应用光学国家重点实验室 超精密光学工程研究中心,吉林 长春130033)
离子束溅射制备低应力深紫外光学薄膜
才玺坤*,张立超,时 光,贺健康,武潇野,梅 林
(中国科学院 长春光学精密机械与物理研究所 应用光学国家重点实验室 超精密光学工程研究中心,吉林 长春130033)
采用离子束溅射制备了AlF3、GdF3单层膜及193 nm减反和高反膜系,分别使用分光光度计、原子力显微镜和应力仪研究了薄膜的光学特性、微观结构以及残余应力。在优选的沉积参数下制备出消光系数分别为1.1×10-4和3.0×10-4的低损耗AlF3和GdF3薄膜,对应的折射率分别为1.43和1.67,193 nm减反膜系的透过率为99.6%,剩余反射几乎为零,而高反膜系的反射率为99.2%,透过率为0.1%。应力测量结果表明,AlF3薄膜表现为张应力而GdF3薄膜具有压应力,与沉积条件相关的低生长应力是AlF3和GdF3薄膜残余应力较小的主要原因,采用这两种材料制备的减反及高反膜系应力均低于50 MPa。针对平面和曲率半径为240 mm的凸面元件,通过设计修正挡板,250 mm口径膜厚均匀性均优于97%。为亚纳米精度的平面元件镀制193 nm减反膜系,镀膜后RMS由0.177 nm变为0.219 nm。
离子束溅射;应力;光学特性;膜厚均匀性
1 引 言
随着光刻技术的发展,曝光光源波长不断缩小,相关研究沿着436 nm(线)→365 nm(线)→248 nm (KrF)→193 nm(ArF)→157 nm(F2)→NGL(下一代光刻技术)路线发展,而目前193 nm ArF准分子激光光刻已经成为主流的曝光技术。为实现193 nm投影光刻的性能指标,光学元件的表面须镀制低损耗并具有长期激光辐照稳定性的光学薄膜。在深紫外波段,可用的镀膜材料仅有少数的氧化物和氟化物,相比于氧化物,氟化物的消光系数更小,是深紫外波段光学薄膜的理想材料。氟化物薄膜通常采用热蒸发方法制备[1-3],由于热蒸发方法沉积粒子的能量较低,为获得致密的低损耗光学薄膜,基底需要加热至300 ℃甚至更高的温度。由于193 nm光刻物镜中的光学元件具有纳米至亚纳米量级的面形精度,在如此高的温度下镀膜并保障元件的面形具有较大难度。并且基底与镀膜材料间热膨胀系数存在差异,导致降温过程中产生较大的残余热应力,对于数百纳米厚的膜堆,如由几十层氟化物构成的高反膜系,过大的累积残余应力甚至会导致膜层的破裂[4-5],此外高温下制备的薄膜表面粗糙度也偏高。利用热蒸发方法在融石英上制备的氟化物通常具有张应力,一般采用在膜系中加入氧化物的方法平衡应力[4,6],但也可能因此制约薄膜的光学性能。近年来,离子束溅射方法制备的氟化物,具有沉积温度低、膜层致密及表面粗糙度低等优点[7-9],表现出良好的应用前景,尤其对于投影物镜中的面形精修元件,须采用低温冷镀方法,因此离子束溅射是理想的选择[10]。
本文采用离子束溅射方法制备了深紫外光学薄膜,获得了低损耗和低应力的AlF3和GdF3单层膜,由这两种材料制备的减反和高反膜系,具有良好的光学特性。
2 薄膜制备及表征
采用Veeco Spector镀膜机制备AlF3、GdF3单层膜、193 nm减反和高反膜系。图1给出了镀膜机内部结构示意图,该设备配置了16 cm的溅射源和12 cm的辅助源,沉积薄膜过程中仅使用溅射源,12 cm辅助源用于镀膜前基底的清洁。基底真空度为5×10-5Pa,Xe气为溅射气体,靶材是纯度为99.9%的金属Gd和Al, NF3为辅助气体反应溅射。沉积GdF3薄膜时离子源的束压和束流分别为900 V和225 mA,NF3气体流量为5 sccm,制备AlF3薄膜时束压和束流为700 V和175 mA,NF3气体流量8 sccm。基底为双抛融石英(Φ25 mm×1 mm)和Si片(Φ50 mm×0.4 mm)。

图1 离子束溅射镀膜机结构示意图 Fig.1 Schematic diagram of the IBS system
采用PE Lambda 1050分光光度计测试薄膜透射和反射,反射率测量时入射角为6°,光学损耗L由式(1)定义;薄膜的晶体结构使用Bruker D8 Discover X射线衍射仪测量;使用Bruker Dimension Edge原子力显微镜及Nikon Eclipse LV100显微镜观察薄膜的表面形貌;应力测量使用FSM 500TC 薄膜应力仪,用于测试应力的样品在Si片上制备,通过测量镀膜前后基底的曲率半径R0和Rd,利用Stoney公式,计算薄膜的应力,如式(2)所示。h和d分别为基底和薄膜的厚度,E和ν分别为基底的杨氏模量和泊松比。

3 实验结果与讨论
3.1 薄膜的微观结构与应力
薄膜的晶体结构采用X射线衍射仪测量,图2给出了实验制备的AlF3和GdF3薄膜的XRD图谱。其中AlF3为非晶,而GdF3表现出结晶相,其晶体结构为正交晶系,在较宽的非晶背底上观察到(101)、(020)和(111) 3个强度较弱的衍射峰,说明GdF3薄膜中结晶相的含量较低。

图2 AlF3与GdF3薄膜X射线衍射图 Fig.2 XRD patterns of AlF3 and GdF3 films
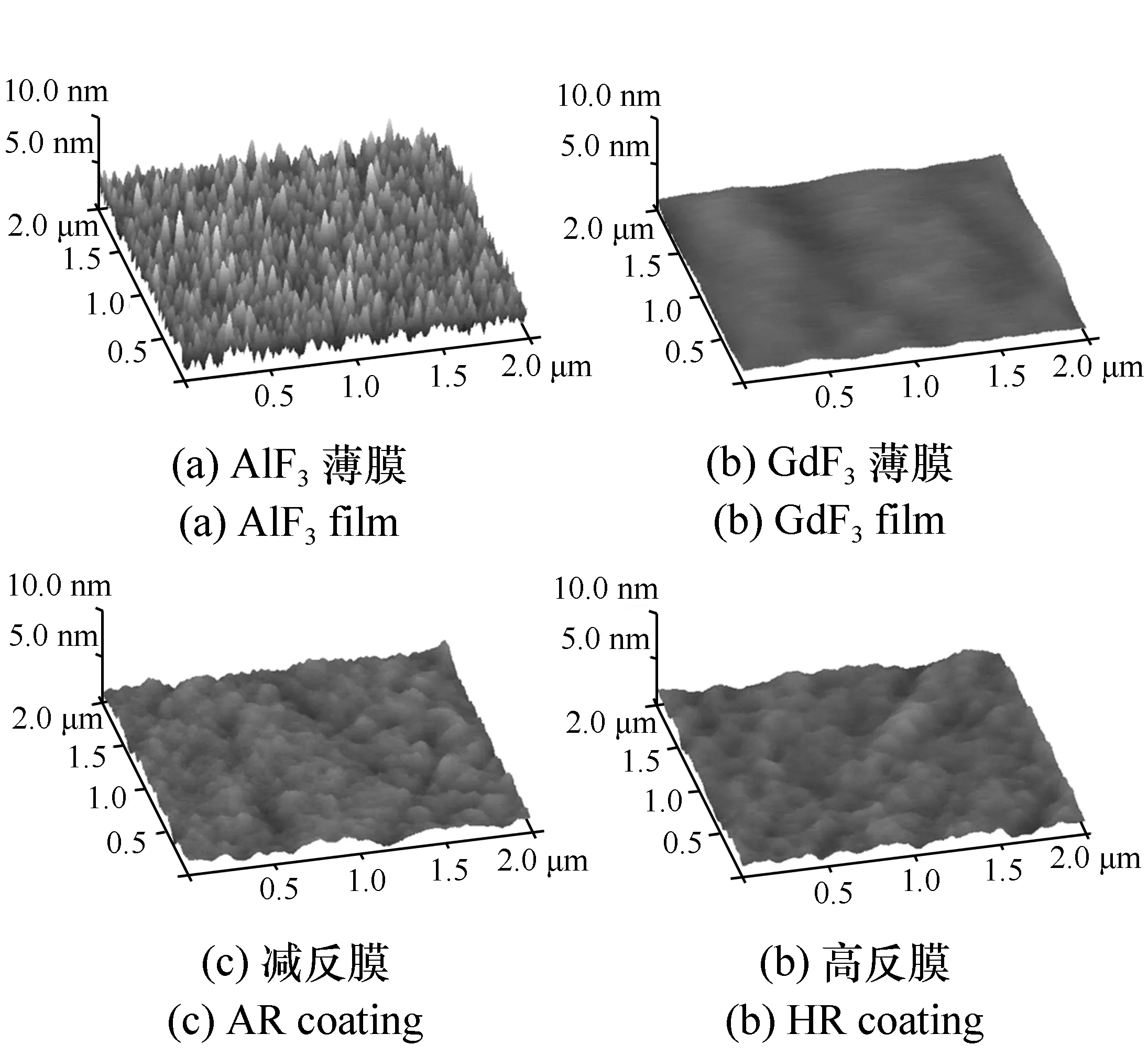
图3 单层膜及多层膜原子力显微镜图像 Fig.3 AFM images of single layers and multilayer stacks
图3为AlF3、GdF3单层膜和AR、HR膜系的AFM图像,测试范围2 μm×2 μm(256线),所有样品的均方根粗糙度在表1中给出。镀膜前所有融石英基底的粗糙度均在0.2~0.3 nm之间,AlF3薄膜的表面粗糙度为0.83 nm,而GdF3薄膜、AR和HR膜系的表面粗糙度均在0.3 nm左右,这同图3中AlF3不同于另3个样品的空间频率特性相对应。与未镀膜基底相比,离子束溅射制备的GdF3,AR和HR样品的表面粗糙度增量较小,多层膜系中每层AlF3的膜厚仅约为30 nm,因此除与材料特性相关外,AlF3薄膜相对较大的表面粗糙度也是由其膜厚累积而产生的。

表1 单层膜及多层膜的特征参数
AlF3、GdF3单层膜和AR、HR膜系的残余应力同样在表1中列出,应力测量使用的基底是直径为50 mm的Si片。可以明显看出,AlF3薄膜具有张应力,而GdF3薄膜为压应力,由于二者的应力相互补偿,因此由这两种材料交替组成的多层膜系仍具有较低的残余应力,对于AR和HR膜系,应力数值均小于50 MPa。采用离子束溅射方法制备的薄膜沉积温度均为室温,即使对于膜层数较多的高反膜系,镀膜过程中真空室的温度也始终低于40 ℃,因此薄膜的残余应力即为本征应力。薄膜应力与沉积条件及后处理方法密切相关[11-13],而对于离子束溅射制备的薄膜,束压、束流和NF3气体流量等工艺参数都有可能对薄膜特性产生影响,同样薄膜应力也可能表现出很大差异,这一结论已在实验中得到验证。图4给出了在不合适的条件下,制备的薄膜由于残余应力过大而破裂的极端情况。图4(a)和4(d)分别对应于离子束束压为600 V、NF3流量为20 sccm时制备的AlF3薄膜和束压为1 000 V、NF3流量为20 sccm时制备的GdF3薄膜。这两种条件下制备的AlF3和GdF3薄膜,当样品从真空室中取出后,几分钟时间内膜层表面几乎全部破裂或起皱,使用显微镜记录下这样的过程:对于AlF3薄膜,首先膜层表面无序地出现若干个微小的断裂,继而从初始的破损处扩展到样品大部分表面;而对于GdF3薄膜,首先从一侧开始起皱,然后连续地向未起皱处延伸直至整个样品表面。图4截取了两个时刻,图4(b)和4(e)分别对应4(a)和4(d)约5 s之后的演变情况,通过与应力释放的典型现象描述对比可以得到[14],AlF3和GdF3薄膜所表现出的特征分别对应张应力和压应力过大而出现的破裂或起皱。膜层的破裂发生在样品从真空室取出后,也可能从真空室放气过程就已经开始,这是由于从真空到大气环境下,薄膜的表面能发生变化,导致其物理厚度超过了极限厚度[14]。而在前文实验中优选的沉积条件下制备的AlF3和GdF3薄膜在显微镜下观察则具有光滑的表面,如图4(c)和图4(f)所示。因此本文中与沉积条件相关的低生长应力是AlF3和GdF3薄膜残余应力较小的主要原因。

图4 (a)AlF3破裂和(d)GdF3起皱的显微镜图片,(b)和(e)对应(a)和(d)几秒后的演变,(c)和(f)是具有光滑表面的AlF3和GdF3薄膜。 (a)、(b)中标线长度为136.58 μm,(c)、(f)中标线长度为100 μm Fig.4 Microscopic images of cracks in (a)AlF3 and wrinkles in (d)GdF3. (b) and (e) are the evolutions of (a) and (d) a few seconds later.(c) and (f) are AlF3 and GdF3 films with smooth surfaces. The label is 136.58 μm in (a) and (b), while it is 100μm in (c) and (f)
3.2 光学特性
图5(a)给出了融石英基底上制备的GdF3和AlF3薄膜的透射和反射曲线,虚线是未镀膜的基底。采用Cauchy模型同时拟合透射和反射光谱,得到193 nm处GdF3和AlF3薄膜的折射率分别为1.67和1.43,对应的消光系数为3.0×10-4和1.1×10-4。根据拟合得到的光学常数分别设计正入射时193 nm减反和高反膜系,其中高反膜为50层规整膜系。双面镀制减反膜的样品的光谱曲线如图5(b)所示,193 nm透过率为99.6%,剩余反射几乎为零,而高反膜的反射率为99.2%,透过率为0.1%,如图5(c)所示。薄膜的厚度及光学损耗如表1所示,离子束溅射方法制备的减反和高反膜系均表现出良好的光学性能。

图5 测量的透射和反射光谱 Fig.5 Measured transmittance and reflectance spectra
3.3 亚纳米面形精度元件镀膜

图6 无挡板和有挡板时AlF3薄膜膜厚均匀性 Fig.6 Thickness uniformity of AlF3 film with and without shadow mask when using flat and convex clamps
对于投影物镜中的大口径曲面元件,为保证元件表面膜系的一致性,通常采用修正挡板对膜厚均匀性进行调整。由于离子束溅射方法的有效溅射区域范围较大,并且溅射粒子的空间分布与离子源参数、靶材与离子源的夹角及靶材与基片的距离等条件密切相关,因此很难通过建立准确的理论模型预测元件表面的膜厚分布及进行挡板设计。本文采用数值计算模型设计膜厚修正挡板[15],通过若干次迭代达到满足要求的膜厚均匀性,并分别使用平面和曲率半径为240 mm的凸面金属夹具,两种夹具口径均为250 mm,在金属夹具不同位置处放置若干个Si基底件,在Si基底上制备单层AlF3薄膜来验证挡板的有效性。两个典型表面无挡板和使用修正挡板后的膜厚分布如图6所示,图中纵坐标相对均匀性U为行星盘不同位置样品膜厚相对于中心位置样品膜厚的比值。无挡板时,对于两种夹具,随着样品位置远离行星盘中心,膜厚均呈现递减趋势。平面仅通过1次挡板设计,其膜厚均匀性(定义为100%-UPV)就由91.2%提高至98.3%。对于曲率半径为240 mm的凸面,250 mm口径内无挡板时膜厚均匀性为70.0%,通过两轮挡板修正,膜厚均匀性分别为93.8%和97.5%,而210 mm口径则仅需1次挡板设计即可达到97.6%的膜厚均匀性,实现了大口径元件膜厚的快速调整。在前文优选的工艺条件下,为具有亚纳米量级面形精度的平面镀制193 nm减反膜系,其通光口径为174 mm。元件镀膜前后的面形如图7所示,RMS由0.177 nm变为0.219 nm,实现高表面质量元件镀膜面形保障。

图7 口径为174 mm的平面表面面形 Fig.7 Surface figure of a 174 mm-flat substrate
4 结 论
采用离子束溅射方法制备了低损耗、低应力的AlF3和GdF3薄膜。在优选的工艺条件下,AlF3薄膜具有张应力,GdF3为压应力,因此由这两种材料组成的多层膜系残余应力较小。通过数值计算模型实现了大口径元件膜厚的快速调整,使用纳米量级精度元件验证镀膜后面形,使离子束溅射方法具备了制备高性能深紫外光学薄膜的良好应用前景。
[1] LIU C C,LEE C C,KANEKO M,etal.. Microstructure-related properties at 193 nm of MgF2and GdF3films deposited by a resistive-heating boat[J].AppliedOptics,2006,45(7):1368-1374.
[2] 时光,梅林,张立超.球面元件表面AlF3薄膜的光学特性和微观结构表征[J].中国光学,2013,6(6):906-911. SHI G,MEI L,ZHANG L CH. Characterization of optical and microstructural properties ofAlF3thin films deposited on spherical element[J].ChineseOptics,2013,6(6):906-911.(in Chinese)
[3] ZHANG L C,CAI X K. High performance fluoride optical coatings for DUV optics[J].SPIE,2014,9281:92810A.
[4] LAUX S,BERNITZKI H,FASOLD D,etal.. Low-loss HR coatings on fused silica substrates for 193 nm micro-lithography applications[J].SPIE,2008,7101:71010Y .
[5] ULLMANN J,KERK H G,THIELSCH R,etal.. Mechanical stress in fluoride coatings[J].SPIE,1999,3738:136-147.
[6] GUNSTER S,DIECKMANN M,EHLERS H,etal.. Stress compensation in fluoride coatings for the VUV spectral range[J].OpticalInterferenceCoatings,2007,TuB5.
[7] YOSHIDA T,NISHIMOTO K,SEKINE K,etal.. Fluoride antireflection coatings for deep ultraviolet optics deposited by ion-beam sputtering[J].AppliedOptics,2006,45(7):1375-1379.
[8] 才玺坤,张立超,梅林,等.热蒸发与离子束溅射制备LaF3薄膜的光学特性[J].中国光学,2014,7(5):808-815. CAI X K,ZHANG L CH,MEI L,etal.. Optical properties of LaF3thin films prepared by thermal evaporation and ion beam sputtering[J].ChineseOptics,2014,7(5):808-815.(in Chinese)
[9] ODE A. Ion beam sputtering of fluoride thin films for 193 nm applications[J].AppliedOptics,2014,53(4):A330-A333.
[10] 张立超,高劲松.长春光机所深紫外光学薄膜技术研究进展[J].光学 精密工程,2012,20(11):2395-2401. ZHANG L C,GAO J S. Developments of DUV coating technologies in CIOMP[J].Opt.PrecisionEng.,2012,20(11):2395-2401.(in Chinese)
[11] 张金胜,张金龙,宁永强.离子辅助沉积法制备SiO2介质薄膜的应力研究[J].发光学报,2012,33(12):1304-1308. ZHANG J SH,ZHANG J L,NING Y Q. Study of SiO2dielectric film stress grown by the method of ion assisted deposition[J].ChineseJ.Luminescence,2012,33(12):1304-1308.(in Chinese)
[12] 刘华松,王利栓,姜玉刚,等.离子束溅射制备SiO2薄膜折射率与应力调整[J].光学 精密工程,2013,21(9):2238-2243. LIU H S,WANG L S,JIANG Y G,etal.. Adjustments of refractive index and stress of SiO2films prepared by IBS technology[J].Opt.PrecisionEng.,2013,21(9):2238-2243.(in Chinese)
[13] 刘华松,姜承慧,王利栓,等.热处理对离子束溅射Ta2O5薄膜特性的影响[J].光学 精密工程,2014,22(10):2645-2651. LIU H S,JIANG CH H,WANG L SH,etal.. Effects of annealing on properties of Ta2O5thin films deposited by ion beam sputtering[J].Opt.PrecisionEng.,2014,22(10): 2645-2651.(in Chinese)
[14] OHRING M.MaterialsScienceofThinFilms(Second Edition)[M]. Heidelbery:Academic Press,2001.
[15] LYNGNES O,KRAUS K,ODE A,etal.. Method for designing coating thickness uniformity shadow masks for deposition systems with a planetary fixture[C]. Society of Vacuum Coaters,2014 Technical Conference Proceedings,optical coating,2014:1817.
向您推荐《液晶与显示》期刊
● 中文核心期刊
● 中国液晶学科和显示技术领域的综合性专业学术期刊
● 中国物理学会液晶分会会刊、中国光学光电子行业协会液晶分会会刊
● 英国《科学文摘》(INSPEC)、美国《化学文摘》(CA)、俄罗斯《文摘杂志》(AJ)、美国《剑桥科学文摘》(CSA)、“中国科技论文统计源期刊”等20余种国内外著名检索刊物和文献数据库来源期刊
《液晶与显示》以材料物理和化学、器件制备技术及器件物理、器件驱动与控制、成像技术与图像处理等栏目集中报道国内外液晶学科和显示技术领域中最新理论研究、科研成果和创新技术,及时反映国内外本学科领域及产业信息动态,是宣传、展示我国该学科领域和产业科技创新实力与硕果,进行国际交流的平台。其内容丰富,涵盖面广,信息量大,可读性强,是我国专业学术期刊发行量最大的刊物之一。
《液晶与显示》征集有关液晶聚合物、胶体等软物质材料和各类显示材料及制备方法、液晶物理、液晶非线性光学、生物液晶;液晶显示、等离子体显示、发光二极管显示、电致发光显示、场发射显示、3D显示、微显示、真空荧光显示、电致变色显示及其他新型显示等各类显示器件物理和制作技术;各类显示新型模式和驱动技术、显示技术应用;显示材料和器件的测试方法与技术;各类显示器件的应用;与显示相关的成像技术与图像处理等研究论文。
《液晶与显示》热忱欢迎广大作者、读者广为利用,踊跃投稿和订阅。
地 址:长春市东南湖大路3888号 国内统一刊号:CN 22-1259/O4
《液晶与显示》 编辑部 国际标准刊号:ISSN 1007-2780
邮 编:130033 国内邮发代号:12-203
电 话:(0431)6176059 国内定价:50元/期
E-mail:yjyxs@126.com 网 址:www.yjyxs.com
Low stress DUV optical coatings deposited by ion beam sputtering
CAI Xi-kun*, ZHANG Li-chao, SHI Guang, HE Jian-kang, WU Xiao-ye, Mei Lin
(EngineeringResearchCenterofExtremePrecisionOptics,StateKeyLabofAppliedOptics,ChangchunInstituteofOptics,FineMechanicsandPhysics,ChineseAcademyofSciences,Changchun130033,China)
*Correspondingauthor,E-mail:christcxk@126.com
AlF3, GdF3single layers, AR and HR coatings at 193 nm were deposited by ion beam sputtering. The optical properties, microstructural properties and residual stress were investigated by spectral photometer, atomic force microscope and film stress measurement system, respectively. With proper deposition conditions, low loss AlF3, GdF3films with the extinction coefficients of 1.1×10-4and 3.0×10-4can be fabricated. The corresponding refractive indexes are 1.43 and 1.67. At 193 nm, the transmittance of AR coating is 99.6% and the reflectance is almost zero. While the reflectance is 99.2% and the transmittance is 0.1% for HR coating. From the results of stress measurement, AlF3film presents tensile stress, while GdF3film has compressive stress. The low growing stress is the major reason for the small residual stress of AlF3and GdF3films. The stress of multilayer coatings consisting of these two materials is less than 50 MPa. By designing shadowing masks for a flat and a convex substrate with the radius of curvature of 240 mm, thickness uniformity of both substrates in diameter of 250 mm is better than 97%. AR coating at 193 nm was deposited on the flat substrate with sub-nanometer accuracy surface and the roughness varied from 0.177 nm RMS to 0.219 nm RMS after coating.
ion beam sputtering;stress;optical properties;thickness uniformity
2016-06-17;
2016-07-25
国家重大科技专项(02专项)基金资助项目(No.2009ZX02205) Supported by National Science and Technology Major Project of China(No.2009ZX02205)
2095-1531(2016)06-0649-07
O484.41
A
10.3788/CO.20160906.0649

才玺坤(1988—),男,吉林长春人,硕士,助理研究员,2010年、2012年于浙江大学分别获得学士、硕士学位,主要从事深紫外薄膜方面的研究。E-mail:christcxk@126.com
