功率LIGBT热载流子退化机理及环境温度影响
2016-06-22张春伟刘斯扬周雷雷孙伟锋
张 艺 张春伟 刘斯扬 周雷雷 孙伟锋
(东南大学国家专用集成电路系统工程技术研究中心, 南京210096)
功率LIGBT热载流子退化机理及环境温度影响
张艺张春伟刘斯扬周雷雷孙伟锋
(东南大学国家专用集成电路系统工程技术研究中心, 南京210096)
摘要:研究了横向绝缘栅双极型晶体管(LIGBT)的热载流子退化机理及环境温度对其热载流子退化的影响.结果表明,器件的主导退化机制是鸟嘴处大量界面态的产生,从而导致饱和区阳极电流Iasat和线性区阳极电流Ialin存在较大的退化的主要原因,同时,由于Ialin的分布比Iasat的分布更靠近器件表面,故Ialin的退化比Iasat的退化更严重;而器件沟道区的碰撞电离和热载流子损伤很小,使得阈值电压Vth在应力前后没有明显的退化.在此基础上,进一步研究了环境温度对LIGBT器件的热载流子退化的影响.结果表明,LIGBT呈现正温度系数,且高温下LIGBT的阈值电压会降低,使得相同应力下其电流增大,导致器件碰撞电离的增大,增强了器件的热载流子损伤.
关键词:横向绝缘栅双极型晶体管;环境温度;热载流子效应;退化
横向绝缘栅双极型晶体管 (lateral insulated gate bipolar transistor, LIGBT)是由双极型晶体管(bipolar junction transistor, BJT)和金属氧化物半导体场效应晶体管(metal oxide semiconductor field effect transistor, MOSFET)组成的复合型功率半导体器件.它同时具备MOSFET和BJT的优点,如输入阻抗高、驱动功率低和输出能力强等,是非常理想的半导体功率输出器件.因此,LIGBT器件在功率集成电路领域得到了广泛的应用[1-3].
然而,LIGBT器件长期工作在高温、高电压和大电流条件下,器件内部的强碰撞电离会产生热载流子(hot-carrier),对器件氧化层和Si/SiO2界面造成损伤,导致界面态的产生和氧化层陷阱电荷的增加,使得器件的电学性能随时间逐渐退化.因此,作为功率集成电路可靠性问题之一,LIGBT器件热载流子退化引起了人们的广泛关注.目前, 关于LIGBT器件热载流子退化的研究主要集中于高栅压低漏压和低栅压高漏压应力条件下的LIGBT器件退化机理的分析[4-6],对于最坏栅压应力条件下LIGBT器件的热载流子退化机理以及环境温度对其热载流子可靠性影响的研究报道还很少.本文研究了常温环境中处于最坏栅压应力条件下的LIGBT器件的热载流子退化机理,并揭示了环境温度对LIGBT器件热载流子效应的影响,相关研究对于工作在高温环境中的LIGBT器件寿命的评估具有一定指导意义.
1器件结构和测试
图1为采用0.5 μm绝缘体上硅(silicon-on-insulator, SOI)工艺的LIGBT器件剖面结构图.器件的主要结构与工艺参数如下:有效沟道区长度为0.5 μm,漂移区长度为13 μm,SOI层厚度为6.5 μm,埋氧层厚度为1 μm,阳极设有N缓冲层,用于提高器件的耐压.器件的阈值电压为1.4 V,关态击穿电压为180 V.

图1 LIGBT器件剖面结构图
为了研究常温时处于最坏栅压应力条件下的LIGBT器件的退化机理以及环境温度对器件的热载流子效应的影响,选取应力条件如下:栅极电压(最坏栅压应力对应的栅极电压)Vgc=2 V,阳极电压Vac=120 V,在环境温度分别为25,75,100,120 ℃件下,对器件施加3 000 s应力,应力过程中周期性地监测器件的饱和区阳极电流Iasat(监测条件为Vgc=5 V,Vac=7 V)、线性区阳极电流Ialin(监测条件为Vgc=5 V,Vac=1 V)和阈值电压Vth(Vgc从0 V扫到7 V,Vac=1 V,利用最大跨导法求得),以反映器件性能的退化.
2测试结果及讨论
2.1热载流子退化机理
为了研究常温时处于最坏栅压应力条件下的LIGBT器件的热载流子退化机理,在应力为Vgc=2 V,Vac=120 V,温度为25 ℃的条件下对器件进行热载流子退化测试.器件Vth,Iasat和Ialin随应力时间的退化曲线如图2所示,可以看出,随着应力时间的增加,阈值电压Vth在整个应力过程中没有退化,而Iasat和Ialin的退化曲线随着应力时间的增加呈现出下降的趋势(退化率为负值表示电流减小),且Ialin退化比Iasat退化明显.
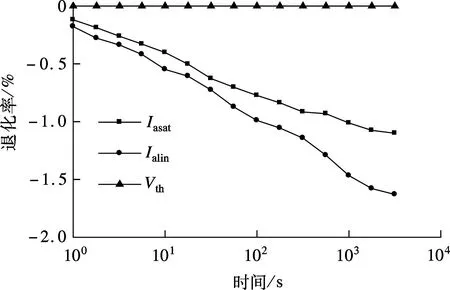
图2 LIGBT器件Iasat,Ialin,Vth随应力时间的退化曲线
由于器件的热载流子退化主要由器件Si/SiO2界面处碰撞电离产生的热载流子带来的表面损伤和电荷注入引起,因此采用TCAD仿真工具对器件Si/SiO2界面处的碰撞电离率和纵向电场进行了仿真,以便分析实验中所发生退化现象的内在机理[7-9].图3和图4分别为最坏栅压应力条件下器件碰撞电离二维分布图和器件Si/SiO2界面纵向电场分布图.由于器件热载流子损伤主要由器件Si/SiO2界面处的碰撞电离引起,因此,器件热载流子损伤的位置主要发生在表面鸟嘴处和Poly场板末端处.强碰撞电离产生的热载流子会在翻越界面势垒的过程中打破器件Si/SiO2界面附近的Si—Si和Si—O键,或者打破Si—H键,释放出H原子,而剩下的Si—, O—悬挂键就形成了界面态.界面态的产生会引起载流子散射,进而使载流子有效迁移率降低,最终导致Ialin和Iasat的减小.另外,根据图4中器件表面纵向电场的分布来看, 在Poly场板末端和鸟嘴处存在较大的纵向电场.纵向电场为负,表示电场方向从器件内部指向器件表面,有利于热空穴的注入.因此,强碰撞电离形成的大量热空穴可能会在纵向电场的作用下注入场氧化层,导致氧化层中存在正电荷陷落.这些注入的热空穴会在N型漂移区感应等电荷量的电子,相当于提高了漂移区的有效掺杂浓度,导致Ialin和Iasat增加.根据图2中Iasat和Ialin在整个应力过程中不断减小的结果可知,整个应力过程中,界面态产生机制强于热空穴注入机制,主导器件Ialin和Iasat的热载流子退化.
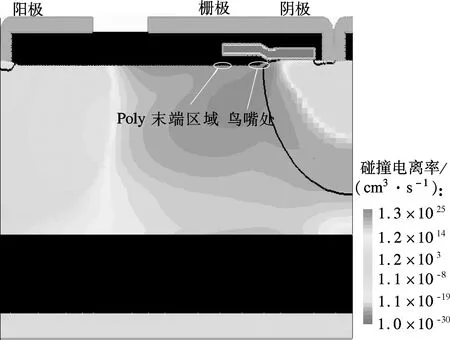
图3常温下LIGBT器件碰撞电离二维分布图

图4 常温下LIGBT器件Si/SiO2界面纵向电场分布曲线
为了分析图2中Ialin比Iasat退化大的现象,本文分别仿真了LIGBT器件Ialin(监测条件为Vgc=5 V,Vac=1 V)和Iasat(监测条件为Vgc=5 V,Vac=7 V)条件下电流路径图,同时仿真并提取了Ialin和Iasat条件下,LIGBT器件鸟嘴区和Poly场板末端区域的电流密度在器件Y方向上的分布.根据图5中的仿真结果可知,在这2个区域内,Ialin几乎在器件表面整体分布,而Iasat分布比较分散,离器件表面更远.由于界面态和载流子注入会使栅氧化层受到损伤,导致器件表面处载流子的迁移率变小,进而使Ialin比Iasat的退化更为严重.
根据前面的分析,器件表面鸟嘴处和Poly场板末端处的碰撞电离产生的大量界面态是使Ialin

(a) Ialin 条件下电流路径

(b) Iasat 条件下电流路径

(c) 鸟嘴处和Poly末端处的电流密度在器件Y方向的分布
图5LIGBT器件Ialin和Iasat条件下电流路径及电流密度分布
和Iasat发生热载流子退化的主要因素,为此利用TCAD仿真工具分别在这2个区域加等量界面态,探究这2个区域的界面态分别对Ialin的影响(因为Ialin受热载流子效应的影响比Iasat更严重,所以选取Ialin作为主要研究对象).分别在这2个区域加等量(5×1011cm-2)界面态,并提取加入界面态前后Ialin的变化曲线(即Vac=1 V时的Ia-Vgc曲线),结果如图6所示.从图中可以看出,与原始的Ialin相比,在鸟嘴处加界面态后Ialin明显降低,而在Poly场板末端处加界面态后的Ialin的变化相对小得多.该实验结果可以用图5(c)中的仿真结果进行解释,在鸟嘴区Ialin的分布靠近器件的表面,而在Poly场板末端区域,Ialin的分布离器件表面较远,由于界面态主要影响器件表面处载流子的迁移率,因此鸟嘴处界面态的产生对器件Ialin的影响更大.

图6 加等量界面态后的Ialin-Vgc与原始仿真曲线
另外,根据图2可知,器件Vth在应力前后没有发生漂移,这说明应力过程中器件的栅氧化层中没有陷阱电荷的产生.从仿真结果来看,沟道区内的碰撞电离率很小,可以忽略,所以可以认为在沟道区没有载流子的注入和界面态的形成,这也与实验中Vth没有退化的现象相吻合.
基于前面的分析可以得出,LIGBT器件在常温下施加Vgc=2 V,Vac=120 V应力时,主导器件Ialin和Iasat的退化机制使得鸟嘴处产生大量界面态,导致Iasat和Ialin存在较大的退化;因为Ialin的分布比Iasat的分布更靠近器件表面,所以界面态或载流子注入对Ialin的影响比对Iasat更明显,从而导致Ialin比Iasat退化更严重;另外,由于沟道区的碰撞电离率很小,可以认为热载流子的注入和界面态的产生没有发生在沟道区,因而使得Vth在应力前后没有发生漂移.
2.2环境温度对LIGBT器件热载流子退化的影响
作为功率输出器件,LIGBT经常工作在高温环境中,为了研究环境温度对器件热载流子退化的影响,在应力为Vgc=2 V,Vac=120 V,应力温度分别为25,75,100,120 ℃的条件下对器件进行退化测试.因为Ialin受热载流子效应的影响比Iasat更严重,所以本文选取Ialin作为研究对象,图7显示了4种温度下Ialin随应力时间的退化曲线.可以看出,与常规的高温会使器件Ialin退化降低不同[10-11],整个应力过程中,LIGBT器件Ialin的退化会随环境温度的升高而增大.
采用TCAD仿真工具,分别仿真并提取了4种温度条件下, 器件内部靠近Si/SiO2界面的碰撞电离率分布,以分析高温使器件热载流子退化变大的原因.根据2.1节的研究可知,器件鸟嘴处的界面态产生是LIGBT器件热载流子退化的主导机制,因此,本文提取并对比了不同环境温度时器件鸟嘴处沿Si/SiO2界面的碰撞电离率的大小,结果如图8所示.根据仿真结果可知,温度越高,LIGBT器件的碰撞电离率越大,这表明温度升高会使更多的热载流子对器件表面造成损伤,产生更多的界面态,从而导致Ialin的退化更严重.

图7 LIGBT器件Ialin随应力时间退化曲线

图8 LIGBT器件鸟嘴处沿Si/SiO2界面的碰撞电离率 仿真分布图
器件沿Si/SiO2界面的碰撞电离率由器件沿Si/SiO2界面的横向电场和表面电流所决定的,因此本文对高温环境中器件沿Si/SiO2界面的横向电场和阳极电流的变化进行了仿真和测试,进一步解释图8中的LIGBT器件表面碰撞电离率会随温度升高而增大的原因.图9对比了不同温度条件下器件表面横向电场分布图,从图中可以看出,4种温度条件下器件表面横向电场基本相同,这表明器件表面横向电场不是碰撞电离增大的主要因素.图10显示了固定Vac为120 V,环境温度分别为25和120 ℃时,器件Iac随Vgc的变化曲线.测试曲线表明,高温会使器件的阈值电压降低,且高温下的电流比常温下的电流大.这是因为温度升高时,半导体的费米能级向禁带中央移动,费米势减小,从而使器件更容易达到反型层产生的条件,阈值电压Vth降低[12].此外,受BJT结构的影响,LIGBT器件的电流也会呈现正温度系数.综上所述,高温下器件阈值的降低与LIGBT器件的正温度系数特性都将会使高温环境中器件的电流比常温环境中的电流大,LIGBT器件的碰撞电离也相应增大,最终导致器件的热载流子效应在高温条件下变得更严重.
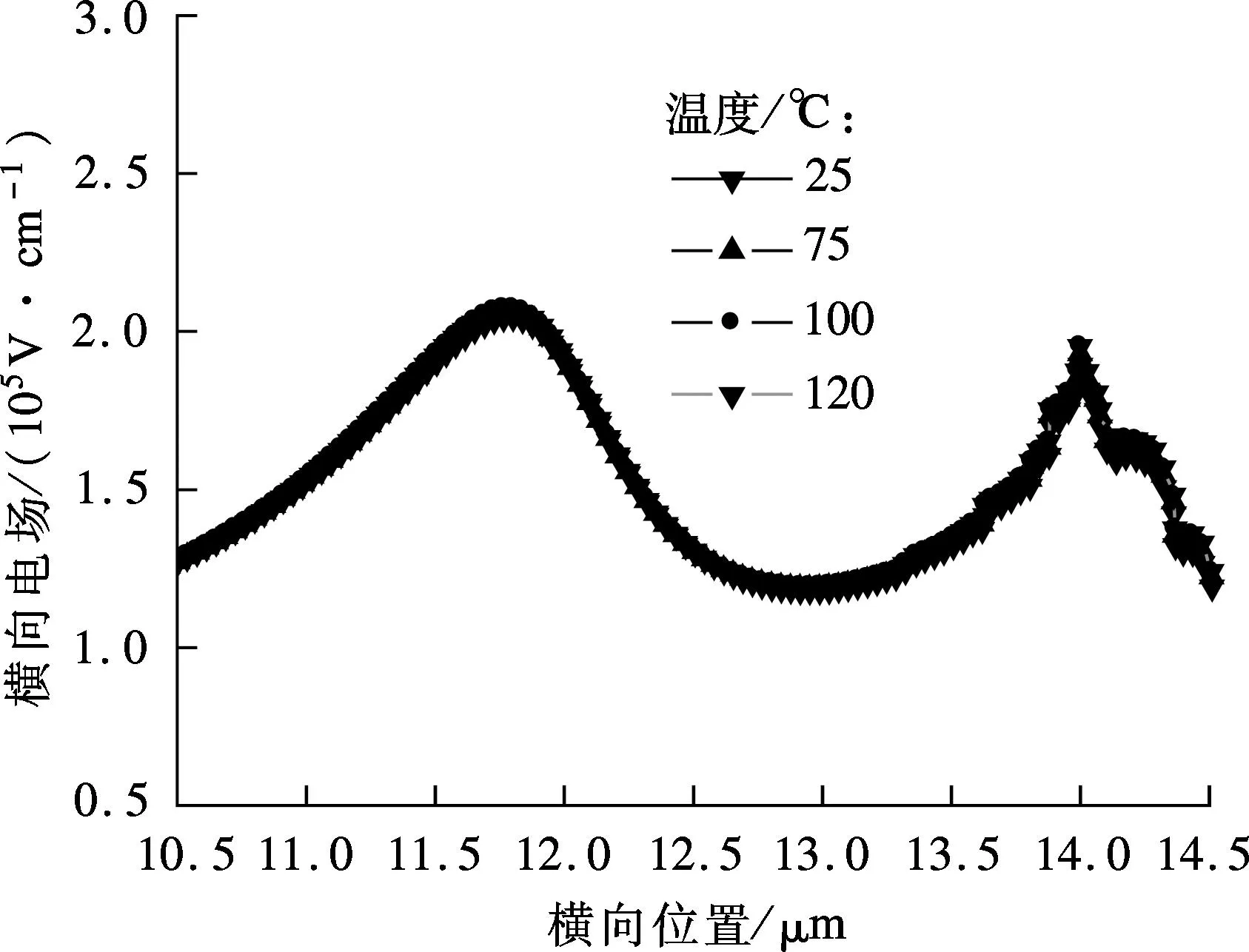
图9 器件沿Si/SiO2界面的横向电场分布

图10 25和120 ℃条件下Iac随Vgc变化曲线
3结语
本文研究了常温时处于最坏栅压应力条件下的LIGBT器件热载流子退化机理以及环境温度对LIGBT器件热载流子效应的影响.研究结果表明,主导LIGBT器件Ialin和Iasat的退化机制是鸟嘴处产生大量界面态,使得Ialin和Iasat存在较大的退化.Ialin的分布比Iasat的分布更靠近器件的表面,导致Ialin的退化比Iasat的退化严重.然而,沟道区的碰撞电离和热载流子损伤很小,使Vth在整个应力过程中基本没有退化.对于工作在高温环境中的LIGBT器件来说,LIGBT器件具有的正温度系数特性以及高温下器件阈值的降低,共同导致了电流的增大,进而使器件的碰撞电离和相应损伤增大,最终增强了器件在高温条件下的热载流子退化效应.本文的研究结果对工作在高温环境中的LIGBT器件实际寿命的评估具有指导意义.
参考文献 (References)
[1]Chen W, Xie G, Zhang B, et al. New lateral IGBT with controlled anode on SOI substrate for PDP scan driver IC[C]//InternationalConferenceonCommunications,CircuitsandSystems. Milpitas, CA,USA, 2009: 628-630.
[2]Qiao M, Jiang L, Wang M, et al. High-voltage thick layer SOI technology for PDP scan driver IC[C]//InternationalSymposiumonPowerSemiconductorDevices&ICs.San Diego, CA, USA,2011: 180-183.
[3]Sumida H, Hirabayashi A, Kobayashi H. A high-voltage lateral IGBT with significantly improved on-state characteristics on SOI for an advanced PDP scan driver IC[C]//IEEEInternationalSOIConference.Williamsburg, VA,USA, 2002: 64-65.
[4]Liu S Y, Huang T T, Sun W F, et al. Reliability concern and design for the lateral insulator gate bipolar transistor based on SOI substrate [J].Solid-StateElectronics, 2013, 85:28-35. DOI:10.1016/j.sse.2013.02.002.
[5]Liu S, Sun W, Zhang C, et al. Model of hot-carrier degradation for lateral IGBT device on SOI substrate [J].ElectronicsLetters, 2013, 49(7): 497-499.
[6]Liu S, Sun W, Huang T, et al. Novel 200 V power devices with large current capability and high reliability by inverted HV-well SOI technology[C]//InternationalSymposiumonPowerSemiconductorDevices&ICs.Kanazawa, USA, 2013: 115-118.
[7]Song Z, Chen Z X, Yong A Z, et al. The failure mechanism worst stress condition for hot carrier injection of NMOS [J].TheElectrochemicalSociety(ECS)Transactions, 2013, 52(1): 947-952.
[8]Chen J F, Chen T H, Ai D R. Two-stage hot-carrier-induced degradation of p-type LDMOS transistors[J].ElectronicsLetters, 2014, 50(23): 1751-1753.
[9]Huang Tingting, Liu Siyang, Sun Weifeng, et al. Novel lateral insulated gate bipolar transistor on SOI substrate for optimizing the hot-carrier degradation [J].JournalofSoutheastUniversity(NaturalScienceEdition), 2014, 30(1):17-21.
[10]Reggiani S, Barone G, Poli S, et al. TCAD simulation of hot-carrier and thermal degradation in STI-LDMOS transistors [J].IEEETransactionsonElectronDevices, 2013, 60(2): 691-698.
[11]Reggiani S, Barone G, Gnani E, et al. Characterization and modeling high-voltage LDMOS transistors[M]//HotCarrierDegradationinSemiconductorDevices. Basel, Switzerland: Springer International Publishing, 2015: 309-339.
[12]Groeseneken G, Colinge J P, Maes H E, et al. Temperature dependence of threshold voltage in thin-film SOI MOSFETs[J].IEEETransactionsonElectronDevices, 1990, 11(8): 329-331.
Hot-carrier degradation mechanism and influence of ambient temperature for power LIGBT
Zhang YiZhang ChunweiLiu SiyangZhou LeileiSun Weifeng
(National ASIC System Engineering Technology Research Center, Southeast University, Nanjing 210096, China)
Abstract:The mechanism of hot-carrier degradation for lateral insulated gate bipolar transistor (LIGBT) and the influence of ambient temperature are investigated. The results indicate that the main degradation mechanism is the generation of a large number of interface states at the beak of LIGBT, which leads to the large decreases of the saturation-region anode current Iasatand the linear-region anode current Ialin. Meanwhile, the distribution of Ialinis much closer to the device surface comparing with that of Iasat, so the degradation of Ialinis more serious than that of Iasat. In the channel region, the impact ionization and the hot carrier damage are tiny; as a result, the threshold voltage Vthremains constant before and after the stress. Moreover, the influence of ambient temperature on the hot carrier degradation of LIGBT is also investigated. LIGBT shows positive temperature coefficient, and the decreased threshold voltage under the high temperature condition induces the increase of the current of LIGBT under the same stress, which leads to the increase of impact ionization. Thus, finally enhanceing the hot-carrier damage of LIGBT.
Key words:lateral insulated gate bipolar transistor(LIGBT); ambient temperature; hot-carrier effect;degradation
doi:10.3969/j.issn.1001-0505.2016.02.005
收稿日期:2015-09-17.
作者简介:张艺(1991—),女,硕士生;孙伟锋(联系人),男,博士,教授,博士生导师,swffrog@seu.edu.cn.
基金项目:国家自然科学基金资助项目(61204083)、江苏省杰出青年基金资助项目(BK20130021)、港澳台科技合作专项资助项目(2014DFH10190)、江苏省“青蓝工程”资助项目、中央高校基本科研业务费专项资金资助项目、江苏省普通高校研究生科研创新计划资助项目(SJLX-0076).
中图分类号:TN386.2
文献标志码:A
文章编号:1001-0505(2016)02-0255-05
引用本文: 张艺,张春伟,刘斯扬,等.功率LIGBT热载流子退化机理及环境温度影响[J].东南大学学报(自然科学版),2016,46(2):255-259. DOI:10.3969/j.issn.1001-0505.2016.02.005.
