量子垒结构对Si衬底GaN基绿光LED光电性能的影响
2016-05-04汤英文熊传兵井晓玉
汤英文, 熊传兵, 井晓玉
(1. 闽南师范大学 物理与信息工程学院, 福建 漳州 363000; 2. 南昌大学 国家硅基LED工程技术研究中心, 江西 南昌 330047)
量子垒结构对Si衬底GaN基绿光LED光电性能的影响
汤英文1*, 熊传兵1, 井晓玉2
(1. 闽南师范大学 物理与信息工程学院, 福建 漳州 363000; 2. 南昌大学 国家硅基LED工程技术研究中心, 江西 南昌 330047)
在Si衬底上外延生长了3种不同量子垒结构的绿光外延片并制作成垂直结构芯片,3种量子垒结构分别为GaN、In0.05Ga0.95N/Al0.1Ga0.9N/In0.05Ga0.95N、In0.05Ga0.95N/GaN/In0.05Ga0.95N,对应的3种芯片样品为A、B、C,研究了3种样品的变温电致发光特性。垒结构的改变虽然对光功率影响很小,但是在光谱性能上会引起显著改变,结果如下:在低温(13 K)大电流下,随着电流密度的增大,样品的EL谱峰值波长蓝移更为显著,程度依次为B>A≈C;在高温(300 K)小电流下,随着电流密度的增大,样品EL谱的峰值波长蓝移程度的大小依次为A>B>C。在同一电流下,随着温度的升高,样品在大部分电流下的EL谱峰值波长出现“S”型波长漂移,在极端电流下又表现出不同的漂移情况。这些现象与局域态、应力、压电场、禁带宽度等因素有关。
垒结构; 绿光LED; 电致发光; 硅衬底; MOCVD
1 引 言
近年来,GaN基半导体器件尤其是InGaN/GaN LED在晶体生长、器件制备等方面取得多项重大技术突破[1-4],已广泛用于各种显示、背光和家用照明等领域。硅衬底具有价格便宜、易获得大尺寸等优势,有利于降低半导体照明的成本;但是Si和GaN有很大的晶格失配(17%)和巨大的热失配(56%),比蓝宝石与GaN的晶格失配(13%~16%)以及SiC与GaN的晶格失配(3.5%)更为严重。Si上GaN薄膜受到的张应力和蓝宝石上GaN所受应力完全相反,所以硅上GaN基外延及器件的制备难度大而充满了挑战[5-6]。采用金属有机化学气相沉积(MOCVD)方法,用InGaN/GaN多量子阱结构作为有源层的GaN基蓝、绿光LED已经实现了商品化生产。在过去的十几年里,蓝光器件的发光效率得到了很大的提高,但绿光器件进展缓慢,而绿光是白光照明、显示不可或缺的部分。InGaN绿光LED的低效与其量子阱In组分过高是分不开的。近年来的研究表明,随着In组分的升高,InGaN材料许多性质也将发生变化,例如材料质量变差和应力发生变化。在量子阱中,InGaN与 GaN之间大的晶格失配在器件的有源层产生明显的双轴应力,尤其是 InGaN/GaN,InGaN/AlGaN 异质结构,垒层应力的大小直接影响LED芯片的各方面的性能。
关于改变蓝宝石GaN基LED量子阱结构与组分对其光电性能影响的报道非常之多[7-9],硅衬底上GaN所受应力与蓝宝石上GaN所受应力不一样,增加了硅衬底GaN基LED量子阱所受应力的复杂性。本文是在Si衬底上外延生长3种不同垒结构的GaN基绿光多量子阱LED外延薄膜,而其他外延结构完全相同。对3种LED芯片变温变电流的电致发光的特性进行了研究,并以HRXRD等测试分析作为辅助,对实验结果进行了解释。
2 实 验
实验中的GaN绿光多量子阱LED薄膜是采用英国Thomas Swan 公司的MOCVD生长系统在硅(111)衬底(2 in)上外延生长的,其芯片尺寸为 1 200 μm×1 200 μm ,生长方法见文献[10]。样品A、B、C的量子阱都包含2 nm的GaN盖层,其量子垒具体结构分别为:9 nm的GaN,3 nm In0.05-Ga0.95N/3 nm Al0.1Ga0.9N/3 nm In0.05Ga0.95N,3 nm In0.05Ga0.95N/3 nm GaN/3 nm In0.05Ga0.95N,如图1所示。

图1 样品A(a)、B(b)、C(c)的绿光量子阱的垒结构。
Fig.1 Quantum barrier structures of sample A(a), B(b), C(c), respectively.
采用HRXRD分别对3种结构外延片的晶格常数、倒易空间等进行测试,得到晶格失配关系即应力关系,晶格失配的大小为样品A>样品B>样品C。对所制作的芯片进行了变温电致发光测试,温度范围为13~320 K,电流范围为0.01~400 mA。HRXRD测试所用的主要测试仪器为英国Bede公司生产的 Bede D1 System衍射仪,衍射仪的靶材料为Cu靶 ,X射线波长为 0.154 056 nm,X射线管工作电压为 40 kV,电流为40 mA。测试环境为室温。变温电致发光测试所用仪器有电源 KEITHLEY 2635、光 谱 仪Compact Array Spectrometer (CAS) 140 CT和变温装置(氦气低温制冷装置)。
3 结果与讨论
3.1 变电流电致发光光谱对比分析
图2为3种样品分别在13 K和300 K时的变电流的电致发光光谱。从图2(a)可以看出,在环境温度为13 K时,大电流下随着电流密度的增加,样品A、B、C的发光波长出现了不同程度的蓝移,蓝移量的大小为:样品B>样品A≈样品C。从图2(b)可以看出,在环境温度为300 K时,样品蓝移量的大小也不同,小电流下的大小关系为样品A>样品B>样品C,而大电流下基本相同。
测试用的芯片来自相对应的外延片,除了上述提到的绿光量子阱的垒结构不同,其余结构完全相同,并且从外延片到芯片也采用了相同的流程和处理工艺。低温(13 K)下的载流子动能小,扩散能力差,主要依靠势能输运。由图1的绿光量子垒结构可知样品A、B、C的能带结构,如图3(a)~(c)所示。从图3中可以看到,能带的势垒大小顺序为样品B>样品A>样品C,所以载流子限制效果的关系为样品B>样品A>样品C。样品B载流子的限制效果最强,在大电流密度下,载流子在量子阱中堆积得最高,即载流子的势能最高,所以蓝移最严重[11-12]。
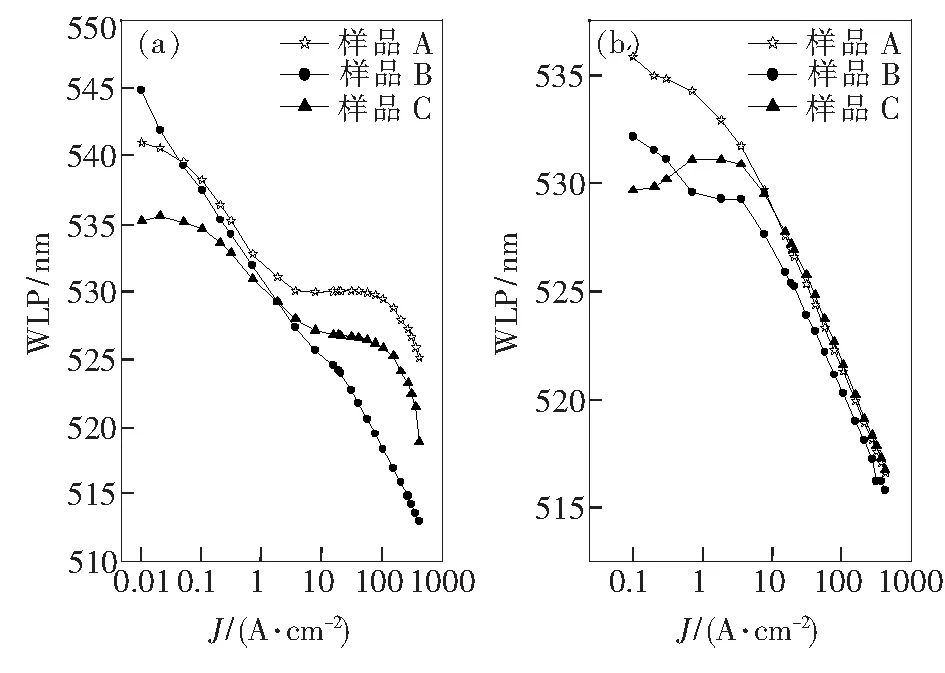
图2 环境温度为13 K(a)和300 K(b)时的变电流的电致发光光谱
Fig.2 Electroluminescence specta with variational forward current densities at 13 K(a) and 300 K(b)
高温(300 K)下的载流子主要靠扩散输运,压电场屏蔽占主导地位。根据HRXRD测试倒易空间图的弛豫度分析得到,量子阱中的应力大小为样品A>样品B>样品C[13]。所以由压电场屏蔽效果导致的波长漂移的大小为样品A>样品B>样品C[14],与实验结果一致。

图3 样品A(a)、B(b)、C(c) 的能带结构图。
Fig.3 Energy band structures of sample A(a), B(b), C(c), respectively.
3.2 变温电致发光光谱对比分析
图4(a)是样品B在100 mA的正向电流下的变温电致发光光谱。在13~320 K的环境温度范围内,样品B的峰值波长呈现S型,简化为图4(b)。其中①代表极低温度下出现的波长变长的红移现象,②代表随着温度升高出现波长变短的蓝移现象,③代表随着温度进一步升高再次出现波长变长的红移现象。

图4 (a)样品B在100 mA的正向电流下的变温电致发光光谱;(b)典型的波长随温度的漂移曲线。
Fig.4 (a) Electroluminescence spectrum of sample B with variational ambient temperature at 100 mA forward current. (b) Typical electroluminescence peak wavelength curve with varying ambient temperature.
经整理发现,在0.1~400 mA之间的电流作用下,3种样品的峰值波长随温度的变化都是典型的波长随温度的漂移曲线,即“S”型波长漂移曲线,如图4所示。出现S型波长漂移曲线的主要原因是:在极低温度下,载流子未进入最低能态就被冻结,升温后载流子扩散进入局域态,所以光谱发生红移;在中间温度范围内,温度的升高会使载流子获得更高能量,当这些能量足够使载流子脱离局域态时,载流子就会进入更高能级,所以此时光谱发生蓝移;温度进一步升高会使禁带宽度减小,此时因温度升高导致的禁带宽度的变化占主导作用,所以峰值波长又发生红移[15-17]。
3.3 极端电流下变温电致发光对比分析
图5为3个样品在0.3 mA和400 mA下的变温电致发光光谱的对比。分析发现,样品在0.3 mA和400 mA下的变温电致发光光谱有一定差异。如图5(a)所示,样品A在0.3 mA的小电流下有图4(b)中所示较低温度范围内的红移现象,即箭头①所示;而在400 mA的大电流下却无①所示现象。其原因是大电流下的局域态发光所占比例很小,故无①所示的红移现象。在0.3 mA和400 mA的电流下,光谱中均有图4(b)中②所示的蓝移现象,但大电流下更明显,即蓝移量更大。在0.3 mA的小电流下,光谱中无图4(b)中③所示的光谱红移。其原因是应力会随着温度升高而减小,造成波长蓝移,与温度升高导致禁带宽度减小造成的③所示的红移抵消。在400 mA的大电流下,光谱中有③所示的红移现象,是因大电流本身能屏蔽压电场,使能带更平,升温造成的禁带宽度减小能够体现出来,进而造成峰值波长再次发生红移。与样品A不同的是,样品B在400 mA的大电流下有图4(b)中①所示的红移现象,如图5(b)所示。这可能是因为样品B势垒过高,低温下载流子输运受阻,堆积严重,升温后载流子堆积减轻,进而引起光谱发生红移。在0.3 mA的小电流下,光谱中无①出现,说明样品B的局域态和样品A相比较少。在0.3 mA和400 mA的电流下,光谱中均有图4(b)中②所示的蓝移,但大电流下更明显,即蓝移量更大,此现象与样品A相同。在0.3 mA的小电流下,光谱中有图4(b)中的③所示的光谱红移现象,而样品A无③现象,说明样品B阱中应力比样品A小,这个结论与HRXRD测试结果相吻合。如图5(c)所示,样品C在0.3 mA和400 mA时的变温发光光谱的变化趋势与样品A相同,差异较大之处是在400 mA时,样品A具有的图4中②所示的蓝移量大于样品C。原因是样品A载流子限制效果较C强,在大电流密度下,样品A载流子在量子阱中堆积更高,载流子势能更高,故蓝移最严重。

图5 样品A(a)、B(b)、C(c)在0.3 mA和400 mA下的变温电致发光峰值波长的变化曲线对比。
Fig.5 Electroluminescence peak wavelength curves with varying ambient temperature at forward current of 0.3 mA and 400 mA of sample A(a), B(b), C(c), respectively.
4 结 论
在Si衬底上外延生长GaN基绿光LED外延薄膜。在其他外延结构、量子阱周期数完全相同的情况下,单一变换绿光量子垒结构,制作成垂直结构的LED芯片,并对其做了变温电致发光特性研究。结果表明:垒结构的不同造成能带结构引起的载流子限制效果和应力大小不同,使得它们的同温度变电流发光光谱和同电流变温发光光谱都有一定的差异。变组分垒结构的绿光LED量子阱的应力以及随电流变化的波长漂移,特别是在大电流情况下,都要小于单组分垒结构的绿光LED量子阱。组分变化导致的势垒变化越平缓的垒结构,其量子阱的应力以及波长漂移也越小。这也是半导体照明及显示对LED芯片的光电性能的基本要求。
[1] CRAWFORD M H. LEDs for solid-state lighting: performance challenges and recent advances [J].IEEEJ.Sel.Top.Quant.Electron., 2009, 15(4):1028-1040.
[2] NAKAMURA S, MUKAI T, SENOH M. Candela-class high-brightness InGaN/AlGaN double-heterostructure blue-light-emitting diodes [J].Appl.Phys.Lett., 1994, 64(13):1687-1689.
[3] NAKAMURA S, SENOH M, NAGAHAMA S I,etal.. InGaN multi-quantum-well structure laser diodes grown on MgAl2O4substrates [J].Appl.Phys.Lett., 1996, 68(15):2105-2107.
[4] TANG H, HAFFOUZ S, BARDWELL J A. Si(111) substrates as highly effective pseudomasks for selective growth of GaN material and devices by ammonia-molecular-beam epitaxy [J].Appl.Phys.Lett., 2006, 88(17):172110-1-3.
[5] DEBNATH R K, MEIJERS R, RICHTER T,etal.. Mechanism of molecular beam epitaxy growth of GaN nanowires on Si (111) [J].Appl.Phys.Lett., 2007, 90(12):123117-1-3.
[6] KROST A, DADGAR A. GaN-based optoelectronics on silicon substrates [J].Mater.Sci.Eng.: B, 2002, 93(1-3):77-84.
[7] 王小丽,王文新,江洋,等. 具有超晶格应力调制结构的绿光InGaN/GaN多量子阱的发光特性 [J]. 发光学报, 2011, 32(11):1152-1158. WANG X L, WANG W X, JIAN G Y,etal.. Luminescent performances of green InGaN/GaN MQW LED employing superlattices strain adjusting structures [J].Chin.J.Lumin., 2011, 32(11):1152-1158. (in Chinese)
[8] CHO Y H, SONG J J, KELLER S,etal.. Influence of Si doping on characteristics of InGaN/GaN multiple quantum wells [J].Appl.Phys.Lett., 1998, 73(8):1128-1130.
[9] GRUDOWSKI P A, EITING C J, PARK J,etal.. Properties of InGaN quantum-well heterostructures grown on sapphire by metalorganic chemical vapor deposition [J].Appl.Phys.Lett., 1997, 71(11):1537-1539.
[10] MO C L, FANG W Q, PU Y,etal.. Growth and characterization of InGaN blue LED structure on Si (111) by MOCVD [J].J.Cryst.Growth, 2005, 285(3):312-317.
[11] WANG T, SAEKI H, BAI J,etal.. Effect of silicon doping on the optical and transport properties of InGaN/GaN multiple-quantum-well structures [J].Appl.Phys.Lett., 2000, 76(13):1737-1739.
[12] WANG T, BAI J, SAKAI S. Influence of InGaN/GaN quantum-well structure on the performance of light-emitting diodes and laser diodes grown on sapphire substrates [J].J.Cryst.Growth, 2001, 224(1-2):5-10.
[13] 邢艳辉,邓军,韩军,等. 引入n型InGaN/GaN超晶格层提高量子阱特性研究 [J]. 物理学报, 2009, 58(1): 590-595. XING Y H, DENG J, HAN J,etal.. Improving the quantum well properties with n-type InGaN/GaN superlattices layer [J].ActaPhys.Sinica, 2009, 58(1):590-595. (in Chinese)
[14] 李弋,刘斌,谢自力,等. 高分辨率X射线衍射研究InGaN/GaN多量子阱结构In组分及厚度 [J]. 功能材料, 2008, 39(8):1259-1260. LI Y, LIU B, XIE Z L,etal.. High-resolution X-ray diffraction studies on the indium content and layer thickness in InGaN/GaN multiquantum wells [J].J.Funct.Mater., 2008, 39(8):1259-1260. (in Chinese)
[15] ELISEEV P G, PERLIN P, LEE J,etal.. “Blue” temperature-induced shift and band-tail emission in InGaN-based light sources [J].Appl.Phys.Lett., 1997, 71(5):569-571.
[16] LI Q, XU S J, CHENG W C,etal.. Thermal redistribution of localized excitons and its effect on the luminescence band in InGaN ternary alloys [J].Appl.Phys.Lett., 2001, 79(12):1810-1812.
Effect of Quantum Barrier Structures on Photoelectric Properties of GaN-based Green LED on Si Substrates
TANG Ying-wen1*, XIONG Chuan-bing1, JING Xiao-yu2
(1.CollegeofPhysicsandInformationEngineering,MinnanNormalUniversity,Zhangzhou363000,China;2.NationalEngineeringTechnologyResearchCenterforLEDonSiSubstrate,NanchangUniversity,Nanchang330047,China)
*CorrespondingAuthor,E-mail:t-y-w2002@sohu.com
Three different quantum barrier structures of GaN-based green LED were grown on Si(111) substrates, and then high power vertical structure LED chips were fabricated. The three kinds of quantum barrier structures were GaN, In0.05Ga0.95N/Al0.1Ga0.9N/In0.05Ga0.95N, In0.05Ga0.95N/GaN/In0.05Ga0.95N, and the corresponding three chip samples were A, B, C. The electroluminescence properties of these three kinds of chips with the same expitaxial structure except the quantum barrier structure were investigated at different forward current densities and ambient temperatures. Although the influence on luminous power is very small with the change of the quantum barrier structures, the change of the spectral properties is significant. Under 13 K, the EL peak wavelength blue shifts when the driving current increases from 0.01 to 400 mA, it is B>A≈C in sequence. While under 300 K, the difference in EL peak wavelength blue shift is A>B>C. At the same forward current densities, when the temperature increases from 13 to 320 K, the EL peak wavelengths of the three kinds of chips are S-shaped at most current, but are different shapes under extreme current. Perhaps, it is due to the fact that the differences in localized states, stress, piezoelectric filed and energy among these three kinds of quantum barrier structures lead to the different EL properties.
quantum barrier structure; green LED; electroluminescence; Si substrate; MOCVD

汤英文(1969-),男,湖南怀化人,博士,教授,2006年于中国科学院上海技术物理研究所获得博士学位,主要从事GaN基宽禁带半导体光电器件的研究。
E-mail: t-y-w2002@sohu.com
2015-11-29;
2015-12-21
国家科技部支撑计划(2011BAB32B01)资助项目
1000-7032(2016)03-0327-05
TN383+.1; TB339
A
10.3788/fgxb20163703.0327
