Si(111)衬底切偏角对GaN基LED外延膜的影响
2015-10-28全知觉张建立江风益
武 芹,全知觉*,王 立,2,刘 文,张建立,江风益
(1.南昌大学国家硅基LED工程技术研究中心,江西南昌 330047;2.南昌大学材料科学与工程学院,江西南昌 330031)
文章编号:1000-7032(2015)04-0466-06
Si(111)衬底切偏角对GaN基LED外延膜的影响
武 芹1,全知觉1*,王 立1,2,刘 文1,张建立1,江风益1
(1.南昌大学国家硅基LED工程技术研究中心,江西南昌 330047;2.南昌大学材料科学与工程学院,江西南昌 330031)
利用金属有机化学气相沉积(MOCVD)方法在具有偏角(0°~0.9°)的Si(111)衬底上生长了GaN薄膜。采用高分辨X射线衍射(HRXRD)对Si衬底的偏角进行了精确的测量,利用HRXRD、原子力显微镜(AFM)以及光致发光(PL)对外延薄膜的晶体质量、量子阱中In组分、表面形貌及光学特性进行了研究。结果表明,Si(111)衬底偏角对量子阱中的In组分、GaN外延膜的表面形貌、晶体质量以及光学性能具有重大影响。为了获得高质量的GaN外延薄膜,衬底偏角必须控制在小于0.5°的范围内。超出该范围,GaN薄膜的晶体质量、表面形貌及光学性能都明显下降。
Si衬底;偏角;GaN;MOCVD
1 引 言
GaN基材料因其优异的性能在光电领域具有广阔的应用前景。与GaN常用的异质外延衬底蓝宝石和SiC相比,Si衬底具有价格低、导电导热性能好、尺寸大、易于光电集成及后续加工等优点[1-4]。然而,Si与GaN之间巨大的晶格失配和热失配严重影响着GaN外延膜质量,如何进一步提高Si衬底GaN外延膜质量仍是一项重要而困难的工作。目前已有许多方法用来提高Si衬底上GaN外延层的质量,例如在GaN外延层与衬底之间插入缓冲层、低温形核层等[5]。偏角衬底被广泛应用在外延生长中,以提高外延层质量。Yamada等[6]报道了GaN衬底偏角会影响GaN表面形貌以及量子阱中In的组分。Ishibashi等[7]报道了在衬底偏角为3.5°的6H-SiC上生长的InGaN/GaN单量子阱,位错密度更低,PL半峰宽更窄。Shen等[8]报道了蓝宝石衬底偏角对GaN外延膜中的位错密度的影响。Bae等[9]报道了蓝宝石衬底偏角不仅影响GaN表面形貌和晶体质量,而且影响LED的光输出功率。然而到目前为止,有关Si(111)衬底偏角对GaN外延层及LED器件结构性能影响的研究还很少[10],比如Si(111)衬底偏角如何影响In组分,而In组分又如何影响GaN外延层及LED器件性能,这些问题还有待深入研究。
本文采用MOCVD方法在不同切偏角(0°~1°)Si衬底上生长了GaN外延薄膜,研究了Si衬底切偏角对GaN外延膜表面形貌、晶体质量、量子阱中In组分及光学特性的影响。
2 实 验
本文研究的GaN薄膜样品是在偏角分别为0.1°、0.2°、0.5°和0.9°的Si衬底上生长的。衬底偏角的精确测量采用了Doucette等[11]提出的测量方法,其中Si衬底的偏角方向为[111]偏向于[110]不同角度。实验采用自主研发的MOCVD进行GaN外延膜的生长,生长过程中分别以TMAl、TMGa、TMIn为Al源、Ga源和In源,NH3为N源,SiH4和CP2Mg分别为n型和p型掺杂剂。把衬底放入MOCVD中先进行高温表面处理,在1 100℃的条件下灼烧10 min,然后生长100 nm的AlN缓冲层,接下来生长2.6 μm厚掺Si的n-GaN、9个周期的GaN/InGaN多量子阱有源层和120 nm厚掺Mg的p-GaN。
采用Panalytical X'pert PRO高分辨X射线双晶衍射仪对GaN晶体质量进行分析,利用Bruker Edge Dimension原子力显微镜对样品的表面形貌进行表征,采用光致发光对样品进行光学特性测试,利用Jordan Valley RADS软件拟合XRD数据分析量子阱中的In含量。
3 结果与讨论
3.1 表面形貌
衬底偏角可以在衬底表面引入原子级别的台阶,大的衬底偏角可以引入较大密度的原子台阶。在化学气相沉积过程中,吸附的原子倾向于在台阶处形核生长,从而影响外延表面形貌[12-13]。图1给出了不同Si(111)衬底偏角上生长的GaN外延片的AFM表面形貌图,扫描范围是10 μm×10 μm。从图中可以看到,当衬底偏角小于0.5°时,表面粗糙度变化不大;当衬底偏角大于0.5°时,表面粗糙度迅速增加。随着偏角变化,台阶形貌也发生了明显的变化。当偏角为0.1°和0.2°时,观察到了螺旋型的原位生长小丘,一般认为这种螺旋小丘是由螺位错引起的[14]。当衬底偏角达到0.5°时,从形貌图中可以看到梯田状的原子层台阶,同时还可以看到原子台阶发生了聚并现象形成的大的台阶。当衬底偏角达到0.9°时,台阶聚并现象更为严重。我们用AFM自带的分析软件对图1(a)、(b)、(c)、(d)分别进行了剖面分析(分析位置如图中横线所示),4组样品对应的剖面分析曲线如图1(e)~(h)所示,其中(g)和(h)中的插图为(c)和(d)中的大台阶流剖面分析曲线。
图1(a)和(b)的剖面分析曲线中只出现了高度为0.2~0.3 nm左右的小台阶,容易判断这些都是GaN外延层的双原子台阶(c/2=0.26 nm)。而图1(c)的剖面分析曲线则出现了一些高度>1 nm的大台阶,显然该样品已经发生了台阶聚并。图1(d)的剖面分析曲线中出现了密度更高的大台阶,且部分台阶高度达到了3~5 nm。不同衬底偏角样品大台阶和小台阶密度见表1。

表1 衬底偏角与台阶密度的关系Table 1 Step density of GaN films as a function of substrate miscut angle

图1 不同偏角Si(111)衬底上生长的GaN外延膜的AFM表面形貌图(a)~(d)和剖面分析曲线(e)~(h)。(a)和(e)0.1°,RMS为0.589 nm;(b)和(f)0.2°,RMS为0.414 nm;(c)和(g)0.5°,RMS为0.525 nm;(d)和(h)0.9°,RMS为1.35 nm。
3.2 晶体质量
为了了解样品的晶体学特性,我们采用HRXRD测量了样品(002)和(102)面的ω摇摆曲线。(002)和(102)面的ω摇摆曲线半高宽可以分别反映出GaN薄膜的螺位错密度和刃位错密度[15-16]。图2给出了样品(002)和(102)面摇摆曲线的半高宽随衬底偏角的变化关系。从图中可以看出,当偏角小于0.5°时,(002)面和(102)面的半高宽变化不大;当偏角大于0.5°时,(002)面和(102)面的半高宽迅速增大,表明样品晶体质量变差。结合图1可知,这可能是当衬底偏角小于0.5°时,能提供更平整有序的台阶,获得稳定的台阶流生长,使结晶质量更好;当衬底偏角大于0.5°时,由于台阶聚并形貌变得粗糙,台阶流生长模式受到了更多的扰动,所以结晶质量变差。
3.3 发光性能
为了研究衬底偏角对GaN外延层光学性质的影响,我们测量了样品的室温PL谱,4个不同偏角样品中心区域的PL发光峰数据列于表2中。可以看出,随着衬底偏角增大,GaN基LED的发光波长逐渐变短,同时半峰宽逐渐增大,尤其是当偏角大于0.5°后显著增大。考虑到4个样品承受的应力状态相似,则引起发光峰波长和半峰宽变化的可能因素应该是In组分和量子阱宽度的差异。也就是说,衬底的偏角有可能引起In掺入效率的变化或者量子阱生长速率的变化。
为了区分这两种可能的效应,我们对样品进行了高分辨率XRD分析。图3是4个样品(002)面XRD ω-2θ扫描图谱,图中GaN(002)面峰左侧的峰为多量子阱的卫星峰,各样品的峰位在表3中列出。从图3中可以看出,随着偏角的增大,不同样品卫星峰之间的间距基本上不变,但卫星峰位置有向GaN主峰逐渐靠近的趋势。
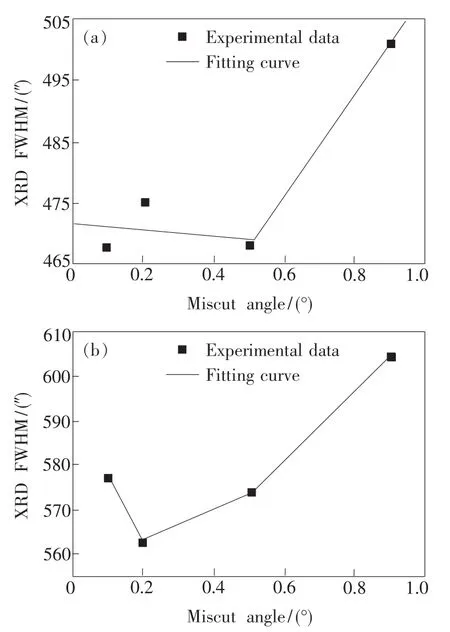
图2 样品XRD(002)(a)和(102)(b)摇摆曲线的半高宽随衬底偏角的变化

表2 不同偏角Si(111)衬底上GaN基LED的峰值波长、半峰宽、In组分和阱宽Table 2 Peak wavelength,FWHM,In content and well thickness of GaN films as a function of substrate miscut angle

图3 不同偏角样品(002)面的XRD ω-2θ扫描图谱的比较
我们用Jordan Valley RADS软件对这4个样品的衍射曲线进行拟合分析,得到了各样品量子阱的阱垒层厚度和平均In组分,列于表2中。从表中数据可知,4个样品的量子阱厚度并没有显著差异,而In组分随着衬底偏角增大逐渐下降。当偏角小于0.5°时,In组分下降趋势不明显;然而当偏角超过0.5°后,In组分迅速下降。图4绘出了In组分随衬底偏角增大而变化的趋势。
Leszczynski等[17]曾报道,在GaN衬底上生长InGaN薄膜时,衬底偏角会影响生长台阶的流动速度,从而影响InGaN中In的组分。在小偏角情况下,台阶的数量较少,其移动速率较快,吸附在台阶表面的In原子还来不及逃离就很快被Ga原子包围;随着衬底偏角的增大,台阶流密度变大,台阶流动速度变慢,使得台阶上吸附的In原子更容易逃离表面。我们的数据同样显示,Si(111)衬底偏角越大,台阶流密度越大,In组分越低,发光波长逐渐蓝移。表3中还显示,样品的PL半峰宽随衬底切偏角增大的趋势,这可能是由于台阶聚并引起的In不均匀分布导致的。由于大偏角衬底上生长的GaN外延层出现台阶聚并现象,而In在不同宽度的台阶面上被吸附的机会不一样,从而导致In组分分布不均匀[18]。

表3 不同偏角样品(002)面XRD ω-2θ扫描图谱的峰位Table 3 Peak position of XRD ω-2θ scans of GaN films grown on Si substrate with miscut angle of 0.1°,0.2°,0.5°and 0.9°

图4 外延片量子阱中的In组分随衬底偏角的变化关系
4 结 论
研究了Si[111]偏[110]方向(0°~0.9°)衬底对MOCVD生长的GaN外延薄膜表面形貌、晶体质量及光学特性的影响。结果表明,Si(111)衬底的切偏角对GaN晶体质量、表面形貌、量子阱中的In组分含量具有重大影响。Si(111)衬底偏角须控制在小于0.5°,GaN外延膜才能获得良好的晶体质量、良好的表面形貌和高的In掺入效率。
[1]Xiong Y J,Zhang M,Xiong C B,et al.Investigation of strain of GaN light-emitting diode films transferred to metal substrate from Si(111)[J].Chin.J.Lumin.(发光学报),2010,31(4):531-537(in Chinese).
[2]Tao X X,Wang L,Liu Y S,et al.Effects of the thickness of p-type GaN on light extraction of GaN based vertical light emitting diodes on silicon substrate[J].Chin.J.Lumin.(发光学报),2011,32(10):1069-1073(in Chinese).
[3]Liu W H,Li Y Q,Fang W Q,et al.The junction temperature characteristic of GaN light emitting diodes on Si substrate[J].Chin.J.Lumin.(发光学报),2006,27(2):211-214(in Chinese).
[4]Xiao Y P,Mo C L,Qiu C,et al.The aging characteristics of GaN-based blue LED on Si substrate[J].Chin.J.Lumin.(发光学报),2010,31(3):364-368(in Chinese).
[5]Nakamura S.GaN growth using GaN buffer layer[J].Jpn.J.Appl.Phys.,1991,30(10A):1705-1707.
[6]Yamada H,Iso K,Saito M,et al.Impact of substrate miscut on the characteristic of m-plane InGaN/GaN light emitting diodes[J].Jpn.J.Appl.Phys.,2007,46(12L):1117-1119.
[7]Ishibashi A,Takeishi H,Uemura N,et al.Metalorganic vapor phase epitaxy growth of a high-quality GaN/InGaN single quantum well structure using a misoriented SiC substrate[J].Jpn.J.Appl.Phys.,1997,36(3S):1961-1965.
[8]Shen X Q,Matsuhata H,Okumura H.Reduction of the threading dislocation density in GaN films grown on vicinal sapphire(0001)substrates[J].Appl.Phys.Lett.,2005,86(2):021912-1-3.
[9]Bae S Y,Lee D S,Kong B H,et al.Electroluminescence enhancement of semipolar GaN light-emitting diodes grown on miscut m-plane sapphire substrates[J].Curr.Appl.Phys.,2011,11(3):954-958.
[10]Wang L,Cui Z Y,Huang F S,et al.Influence of miscut angle of Si(111)substrates on the performance of InGaN LEDs[J].Appl.Phys.Express,2014,7(1):012102-1-3.
[11]Doucette L D,Da Pereira C M,Lad R J.Precise orientation of single crystals by a simple X-ray diffraction rocking curve method[J].Rev.Sci.Instrum.,2005,76(3):036106-1-4.
[12]Kong H S,Glass J T,Davis R F.Chemical vapor deposition and characterization of 6H-SiC thin films on off-axis 6H-SiC substrates[J].J.Appl.Phys.,1988,64(5):2672-2679.
[13]Kimoto T,Nishino H,Yoo W S,et al.Growth mechanism of 6H-SiC in step controlled epitaxy[J].J.Appl.Phys.,1993,73(2):726-732.
[14]Heying B,Tarsa E J,Elsass C R,et al.Dislocation mediated surface morphology of GaN[J].J.Appl.Phys.,1999,85(9):6470-6476.
[15]Heinke H,Kirchner V,Einfeldt S,et al.X-ray diffraction analysis of the defect structure in epitaxial GaN[J].Appl. Phys.Lett.,2000,77(14):2145-2147.
[16]Ning X J,Chien F R,Pirouz P,et al.Growth defects in GaN films on sapphire:The probable origin of threading dislocations[J].J.Mater.Res.,1996,11(3):580-592.
[17]Leszczynski M,Czernecki R,Krukowski S,et al.Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy[J].J.Cryst.Growth,2011,318(1):496-499.
[18]Krs'ko M,Franssen G,Suski T,et al.Correlation between luminescence and compositional striations in InGaN layers grown on miscut GaN substrates[J].Appl.Phys.Lett.,2007,91(21):211904-1-3.

武芹(1988-),女,湖南邵阳人,硕士研究生,2012年于南昌大学获得学士学位,主要从事半导体光电子材料和器件的研究。
E-mail:celerywq@163.com

全知觉(1977-),男,江西临川人,助理研究员,2007年于中国科学院上海技术物理研究所获得博士学位,主要从事半导体光电子材料和器件的研究。
E-mail:quanzhijue@ncu.edu.cn
Influence of Substrate Miscut on Properties of GaN-based LED Films Grown on Si(111)
WU Qin1,QUAN Zhi-jue1*,WANG Li1,2,LIU Wen1,ZHANG Jian-li1,JIANG Feng-yi1
(1.National Engineering Research Center for LED on Si Substrate,Nanchang University,Nanchang 330047,China;2.Material Science and Engineering College,Nanchang University,Nanchang 330031,China)
*Corresponding Author,E-mail:quanzhijue@ncu.edu.cn
GaN-based LED films were grown on Si(111)substrate with different miscut angle from 0°to 0.9°by MOCVD.The miscut angles of Si(111)substrates were precisely measured by high resolution X-ray diffraction(HRXRD).The morphologies of the samples were characterized by atomic force microscopy(AFM).The GaN crystal quality and indium content of MQWs were analyzed by HRXRD.The optical properties of the samples were investigated by photoluminescence(PL).The results reveal that the miscut of Si(111)substrate has significant influence on the crystal quality,surface morphology and optical properties of GaN film.The optimal miscut angle of Si(111)substrate is within 0.5°.Beyond this range,the crystal quality,surface morphology and optical properties of GaN film will deteriorate drastically.
Si substrate;miscut;GaN;MOCVD
O482.31;O484.4
A DOI:10.3788/fgxb20153604.0466
2015-02-05;
2015-03-01
国家自然科学基金(11364034);江西省科技支撑计划(20141BBE50035)资助项目
