离子注入技术与设备常见故障分析
2015-07-18曹健
曹健
(中国电子科技集团公司第十三研究所,河北石家庄050051)
离子注入技术与设备常见故障分析
曹健
(中国电子科技集团公司第十三研究所,河北石家庄050051)
介绍了离子注入技术的特点及其原理,在分析介绍其设备种类的基础上,简要概述了离子注入设备的基本结构,详细分析了影响注入工艺的各种因素,根据多年的设备维护经验,总结归纳了离子注入机的常见故障,并提出了各种故障的处理措施。
离子注入;离子束;束流;聚焦与扫描
离子注入是现代集成电路制造中的一种非常重要的掺杂技术,它以离子加速的方式将掺杂元素注入到半导体晶片内部,改变其导电特性并最终形成所需的器件结构。离子注入工艺有许多优点,已大规模取代了扩散工艺,成为半导体工艺中最常见的掺杂技术。离子注入机的工作过程为:离子源将掺杂元素电离为带正电荷的离子,由吸极把离子从源中提取出来,经过磁分析器分离,把所需的离子与其它离子分离出来,再由加速器将掺杂离子加速到所需能量,最后由聚焦扫描系统把离子注入半导体材料中。离子注入机是半导体工艺中最复杂的设备之一,其设备维修涉及物理、电气、机械、机电一体化、自动控制等多门学科知识。
1 离子注入技术的特点及原理
1.1 离子注入技术的特点
离子注入技术是一种纯净的表面处理技术,它无需在高温环境下进行,故不会改变加工工件的外形和表面光洁度。其主要特点如下:
(1)注入离子的纯度高、能量单一,注入环境清洁、干燥,杂质污染极低。
(2)注入离子的剂量可精确控制,因而掺杂的均匀性高。
(3)离子的注入可在常温下进行,因而对离子掩蔽层的要求不苛刻,二氧化硅、光刻胶等都可以作为掩蔽层。
(4)离子注入的掺杂浓度不受杂质在衬底中的固溶度限制。不会改变化合物半导体材料的组份。
(5)离子注入的横向掺杂效应很小,有利于缩小芯片的面积,降低功耗。
(6)离子注入的缺点是高能离子的轰击会对半导体材料的晶格结构造成损伤。
1.2 离子注入技术原理
离子注入是将离子源产生的离子分离提纯,经加速后高速射向材料表面并注入到材料体内的一种技术。注入离子进入材料表面,与材料中的原子碰撞,将其挤进内部,这些被撞离的原子再与其它原子碰撞,如此持续约数百纳秒内,将在材料中形成一个有数百个间隙原子和空位的区域(如图1所示)。这种级联碰撞会在材料表面形成一个注入元素的浓度峰,其分布为高斯分布。离子注入的深度是离子能量、质量以及基体原子质量的函数,能量愈高,注入愈深。一般情况下,离子越轻活基体原子越轻,注入越深。当离子注入到材料内部,离子便被材料吸收,成为材料的一部分,因而注入层不会脱落或剥离,注入的离子能够与固体原子,或者彼此之间发生一系列物理的和化学的相互作用,入射离子逐渐损失能量,最后停留在材料中,并使材料的表面成分、结构和性能发生变化,进而优化材料表面性能,获得某些新的优异性能。
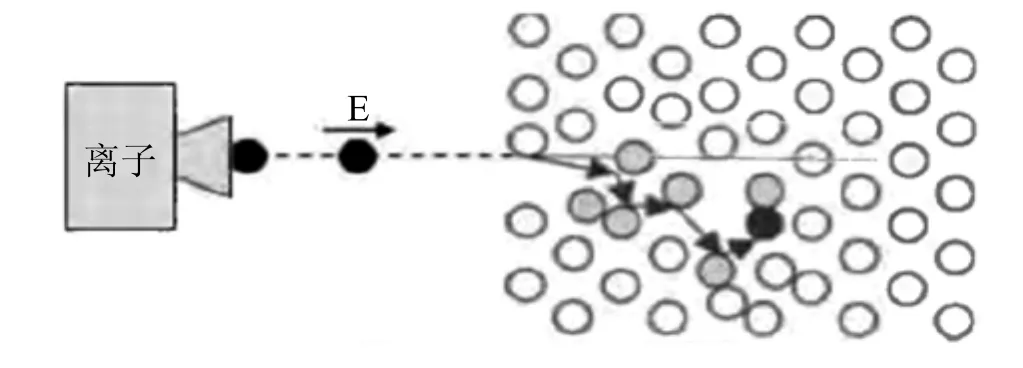
图1 离子注入原理
2 离子注入机分类及设备结构
2.1 离子注入机分类
离子注入设备是半导体制造中重要的工艺设备,按照使用工艺及离子的能量和离子束电流大小可分为高能量、高电流、中电流三种[1]。
(1)高能量注入机的离子束具有较高能量,一般可达到500 keV以上,但其掺杂浓度较低,主要用于材料衬底的深阱掺杂。
(2)高电流注入机能获得较大的离子束电流,其掺杂浓度大,但注入深度较浅,主要用于器件的源漏区掺杂和LDD区掺杂。
(3)中电流注入机应用比较广泛,它的离子能量和束流大小远小于高能量和高电流注入机,被广泛应用于除深井掺杂和源漏掺杂以外几乎所有的离子掺杂工艺。
2.2 离子注入机设备结构
离子注入机的设备结构包括离子源、磁分析器、扫描系统、聚焦加速系统和注入系统,如图2所示。
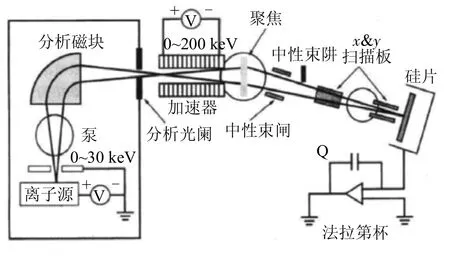
图2 离子注入机结构图
2.2.1 离子源
离子源是离子注入机的关键部件之一,其作用是使掺杂气体电离为离子形成离子束。掺杂气体通过管道进入离子源的电弧反应室,被反应室中灯丝激发的热电子轰击,形成等离子体。这些等离子体在反应室外的负电压电极作用下,其中的正离子便从等离子体中分离出来,离幵电弧反应室,形成具有一定能量的离子束。目前广泛使用的离子源主要有BERNAS和IHC两种[2]。
2.2.2 磁分析器
离子源中产生的离子通常是多种离子,而在实际工艺加工中只需要一种杂质离子。因此,必须采取磁分析器对离子束进行分离,选出所需的单一离子。在磁分析器中,离子束流在与磁场垂直的平面内以恒定速度在真空中运动,离子束中的粒子在洛仑兹力的作用下,作匀速圆周运动。由于不同质量的离子,其匀速圆周运动的半径是完全不同的,因此,磁分析器便将不同质量的离子一一分离开来,只把所需要的杂质挑选出来。通常磁分析器被制成70°至120°的弯曲腔体,内壁两侧装有石墨挡板。在与离子路径垂直的方向上下,各有一个通电磁铁,其作用是调节分析磁场的强度大小。
2.2.3 扫描系统
离子束是一条线状高速离子流,必须通过扫描覆盖整个注入区。常用的扫描方式有固定样品移动离子束和固定离子束移动样品两种。
离子注入机的扫描系统有四种,分别是电子扫描、机械扫描、混合扫描以及平行扫描,目前最常用的是静电扫描系统。静电扫描系统由两组平行的静电偏转板组成,一组进行横向偏转,另一组进行纵向偏转。在平行电极板上施加电场,正离子就会向低电压一侧的电极板偏转,改变电压大小就可以改变离子束的偏转角度。这种扫描的优点是电子和中性离子不会发生偏转,能够从束流中消除。其缺点是离子束不能垂直轰击样片,会导致注入掩膜图形的阴影效应,阻碍离子束的注入。
2.2.4 聚焦与加速系统
聚焦系统:从磁分析器加速出来的离子束由于都是正离子,相互排斥,因此离子束会有一个张角,为了减少束流损失,使离子束能均匀的分布于被注入的样片表面,通常要用电磁透镜加以聚焦。离子束的聚焦器一般由数对同电位极板组成,通过加载一定的电压来调节离子束的聚集效果。
加速器:从离子源吸出的杂质离子,必须通过一个具有强电场作用的加速器进行加速或减速,以获得工艺加工所需的离子能量。在磁分析器之前,离子获得的加速通常称为“前加速”,通过磁分析器后,离子可以再次获另外一段加速或减速,通常称之为“后加速或减速”。离子注入机常用的后加速或减速方式有直流和射频两种,加速器主要由真空室和高压电源组成。
2.2.5 注入系统
离子注入机的内部腔体需要维持在极低的真空状态下,通常其腔体压力小于5×10-7t。这是为了避免离子束从电离产生到最后的扫描注入受到空间其它粒子的干扰。离子注入机的真空系统由干泵、分子泵和冷泵组成。另外,离子源的真空也需要保持在极低压力下,若压力高出要求,则电弧腔和吸极间极易放电,造成离子束不稳定。若离子注入机内部腔体的真空压力过高,将会引起离子和残余气体分子的碰撞,造成离子束电流降低,还会造成电荷交换形成能量污染。
3 影响离子注入工艺的因素和设备常见故障处理
3.1 影响离子注入工艺的因素
影响离子注入工艺均匀性的因素很多,其中最主要的有四种。
3.1.1 注入系统的真空度
注入机系统的真空度对其束流品质有非常大的影响。如果真空度过低,一方面会导致注入机的束流比较小,致使注入的速度降低;另一方面,将导致离子流的聚焦不好,注入的纯度达不到要求。另外,真空度对注入的均匀性也有一定的影响,因为离子束在加速的路径上被一些杂散的气体分子阻挡,导致同一片样品中离子注入深度的均匀性变差。
离子束从离子源到注入靶要经历较长的路径,这对于整个系统的真空度提出了较高的要求。如果真空度不够,则离子束将与系统内残余的气体分子发生级联碰撞,产生许多低能电子和派生离子,导致离子运动方向杂乱。这不仅对于离子束本身是一种污染,同时因为碰撞的随机性,使得离子束的能量统计出现偏差,表现出较高的能散度。
3.1.2 样品表面的洁净度
离子注入对颗粒污染非常敏感,样片表面的颗粒会阻碍离子流的注入。通常注入的束流越大越容易产生更多颗粒,虽然注入后这些颗粒可以清洗掉,但其对注入的遮挡将在样品的注入层中产生一些致命的缺陷。大多数颗粒的产生是由其它工序或者环境因素导致的,另外,实际工艺中各种操作的规范性及正确性也非常关键。不正确的拿取样品、不正确的抽真空步骤以及在系统充气时使用未经过滤的气体等都产生较多颗粒[3]。
3.1.3 聚焦与扫描
从离子源加速管吸出的离子流是发散的,其束流密度很不均匀,必须进行聚焦合轴处理,为随后的扫描提供细小的优质束斑,扫描面内的束流信号才能对称一致,注入层杂质分布才能均匀。
3.1.4 束流大小的选择
离子束入射到绝缘材料晶片上,会在这些材料表面形成电荷积累层,这种现象叫做晶片电荷积累。晶片表面的积累电荷对注入的离子会产生散射作用,影响注入的均匀性。注入的束流越大,晶片的电荷积累越严重,因此,在工艺加工中,应根据需要尽量选择较小的束流。
3.2 注入机常见故障及处理
离子注入机常见故障主要有四类,分别是部件老化、真空问题、电源问题和系统污染。
3.2.1 部件老化
国内注入机大多是引进国外生产线的二手设备,所以部件老化是经常遇到的故障问题。在注入机系统的维修中,要仔细分析判断,对其真空部件、高低电位控制光纤和一些经常动作的运动部件等,要进行定期检查维护,及时更换老化部件,紧固松动的螺钉等。
3.2.2 真空问题
注入机设备系统真空的好坏,是影响注入质量的重要因素。对注入系统真空的维护,通常有以下几项措施:
(1)定期维护保养,要经常定期更换各腔体连接处的密封圈。例如,注入靶室的真空密封圈,经常由于碎片或杂物划伤而导致漏气,要及时更换。
(2)定期维护保养真空泵组。经常检查机械泵的油面是否合适;观察冷泵压缩机压力是否偏低,及时更换吸附桶,冷泵正常温度是否维持在13K以下;定期维护保养分子泵,保证本体真空度。
3.2.3 电源问题
注入机的电源主要有高压电源、吸极电源、灯丝电源、磁分析电源和扫描电源等。进行电源的检修时要注意电源的负载是否正常,先分析定位发生故障的电源模块,然后再逐步排查导致故障的原因,在搞懂各单元电路的工作原理后,再进行直流和稳压、稳流过程分析。
3.2.4 系统污染
导致注入系统污染的原因,主要有以下几种:
(1)离子源污染。措施:检查离子源真空系统是否漏气;检查所用源材料纯度是否满足要求。
(2)质量分析中离子束被污染。措施:检查系统真空是否漏气;检查质量分析器的窄峰是否合适;检查离子能量过滤系统;检查系统是否被金属沾污。
(3)系统部件污染。主要有:离子束撞击电机产生的溅射金属;样品表面光刻胶的碱性元素沾污;法拉第杯的铝;同一注入机注入不同元素的交互污染等。
4 结束语
离子注入机作为半导体工艺中最复杂的设备之一,其维修是一项结合多门学科知识的复杂工作。随着半导体工艺技术的进一步发展,对离子注入技术的精度和均匀性提出了更高的要求,其设备复杂程度也越来越高,维修工作也会越来越复杂、困难,对于我们每一位维修人员,一定要理清思路、顺藤摸瓜,这样,任何问题都将迎刃而解。
[1] 张渊.半导体制造工艺[M].北京:机械工业出版社,2010.
[2] 罗宏洋.状态机在离子注入机中的应用[J].电子工业专用设备,2009,38(9):49-53.
[3] 梁瑞林.半导体器件新工艺[M].北京:科学出版社,2008.
Ion Implantation Technology and Equipment of Common Fault Analysis
CAO Jian
(The 13thResearch Institute,CETC,Shijiazhuang 050051,China)
This paper introduces the characteristics and principle of ion implantation technology,based on the analysis of species on the basis of the equipment are introduced,a brief overview of the basic structure of the ion injection equipment,the various factors influencing the injection process is analyzed in detail,based on years of experience in equipment maintenance,sums up the common faults of the ion implantation machine,and puts forward the treatment measures of various kinds of faults.
Ion implantation;Ion beam;Beam;Focusing and scanning
TN305.3
B
1004-4507(2015)05-0025-05
曹健(1981-)男,工程师,河北人,毕业于天津大学,主要从事于半导体设备的维修和维护工作。
2015-04-13
