环氧树脂和酚醛树脂对芯片框架粘结力的研究
2015-05-18秦苏琼侍二增刘红杰
秦苏琼,侍二增,谭 伟,刘红杰
(连云港华海诚科电子材料有限公司,江苏连云港222047)
环氧树脂和酚醛树脂对芯片框架粘结力的研究
秦苏琼,侍二增,谭 伟,刘红杰
(连云港华海诚科电子材料有限公司,江苏连云港222047)
研究了环氧模塑料配方中不同种类的环氧树脂和酚醛树脂对铜、铜镀银以及铜镀镍钯金3种框架材料粘结力的影响。通过粘结力测试对比,选出对框架粘结力优秀的的树脂,并分析影响框架粘结力的原因。试验结果显示粘结力好的树脂对3种框架的粘结性均有显著提高。
环氧模塑料;框架;粘结力
电子封装的最初定义为保护电路芯片以免受到周围环境的影响。电子封装对于芯片来说是必须的,也是至关重要的。根据封装所用的材料来划分,电子封装形式有金属封装、陶瓷封装、金属一陶瓷封装和塑料封装。塑料封装由于其成本低廉、工艺简单而广泛应用于电子工业。目前绝大部分的封装都采用塑料封装,而其中环氧模塑料又占了塑料封装中的90%以上,环氧模塑料已经成为半导体工业发展的重要支柱之一。环氧模塑料是指由环氧树脂、填充料、催化剂、偶联剂、改性剂、脱模剂、阻燃剂和着色剂等组分组成的粉末,按一定的比例经过前混、挤出、粉碎、磁选、后混合、预成型(打饼)等工艺制成。在注塑成型过程中将半导体芯片包埋在其中,在热压作用下交联固化成热固性塑料,并赋予其一定的结构外形,成为塑料封装的半导体器件。
引线框架作为集成电路的芯片载体,是一种借助于键合材料(金丝、铝丝、铜丝)实现芯片内部电路引出端与外引线的电气连接,形成电气回路的关键结构件,它起到了和外部导线连接的桥梁作用。铜基材料以其良好的导电性、导热性、价格低的优势而大量出现于集成电路用引线框架之行列,应用前景十分广阔,目前已占据引线框架材料用量的80%。但由于铜容易氧化,使润湿性变差,为了保证封装工艺中的装片和键合性能,使芯片和金丝与引线框架形成良好的扩散焊接,引线框架的装片和键合区域(内引线脚上和小岛)一般要进行镀银或者镀镍钯金等表面处理。对框架进行表面处理是因为镀层与引线框架基体和金丝有比其它金属更加好的结合力和焊接性能,保证了很好的装片和键合强度,而且化学性质稳定、耐腐蚀、耐氧化、可靠性好。
1 环氧模塑料与框架材料的粘结力
粘结力是指环氧模塑料与引线框架之间的粘结力的大小。由于SMT回流焊温度在215~260℃,靠近界面的水分先骤热膨胀形成气孔或分层,从而使得塑封料在这个温度下粘结力大幅度下降,导致塑封材料与引线框架以及晶片之间开始分离,因此确保塑封材料密封芯片的效果,必须具有良好的的粘结性能。
2 试验部分
2.1 试验原材料
主要环氧树脂(见表1)。
主要酚醛树脂(见表2)。
框架材料(见表3)。
3.2 试验方法及步骤
试验基础配方(见表4)。
试验步骤:将原材料处理为粉状,按配方比例加入高搅机进行高速混合,混合后加入挤出机挤出,粉碎过筛冷藏备用。

表1 主要环氧树脂原料

表2 主要酚醛树脂原料

表3 框架材料

表4 基础配方
3.3 粘结力测试
将环氧模塑料粉末在40 MPa的压力下压制成饼料,将饼料在高频预热机上预热到约100℃,投入注塑孔内,用tap pull模具传递模塑成型,框架为铜镀银材质。脱模后在175℃的烘箱内后固化6 h。将tab pull样品放入潮箱内,置于60℃,60RH%下放置40 h后取出。进行3次回流焊,随后进行拉力测试,测定塑封料与框架之间的粘接力。见图1所示。

图1 tab pull样品示意图
4 结果与讨论
4.1 环氧模塑料中各成分对铜镀银框架粘结力的研究
本节内容研究模塑料中主要成分环氧树脂和酚醛树脂对铜镀银框架的粘结力的影响。
(1)不同环氧树脂对铜镀银框架粘结力的影响如图2所示。

图2 不同环氧树脂对铜镀银框架粘结力的影响
试验分析了4种不同环氧树脂对铜镀银框架粘结力比较。图2为方差分析结果。其中E1环氧树脂为通用邻甲酚环氧树脂,E2为多芳香基团环氧树脂,E3为双环戊二烯基团环氧树脂,E4为联苯型环氧树脂。
4种环氧树脂对铜镀银框架粘结力大小为E4>E3≈E2>E1。E2中多芳香基团以及E3中双环戊二烯基团由于其交联密度小,具有低吸水性,在60℃,60RH%下40 h后在回流焊中由于吸水产生的应力小,因而粘结力好。而E4联苯型环氧树脂由于其分子量小,其固化后产物的线膨胀系数小,在考核过程中同样产生应力小,表现为对框架的粘结力好。但是由于E4为低分子量树脂,其软化点低,操作性差,因而不建议单独使用,可以配合其它树脂使用。
(2)不同酚醛树脂对铜镀银框架粘结力的影响如图3所示。

图3 不同酚醛树脂对铜镀银框架粘结力的影响
试验考察了4种不同酚醛树脂对铜镀银框架粘结力比较。图3为方差分析结果。其中H1为通用酚醛树脂,H2为多官能团酚醛树脂,H3为多芳香基团酚醛树脂,H4为也多芳香基团酚醛树脂。
4种酚醛树脂对铜镀银框架粘结力大小为H4≈H3>H2≈H1。同样类似环氧树脂,H3和H4由于其交联密度低,吸水率低,经过温度、湿度以及过回流焊后产生的应力小,因而粘结力好。而H2由于其含有多官能团,极性基团多,吸水率大,造成三级考核后粘结力小。
按照铜镀银框架的试验方法测试不同环氧树脂和酚醛树脂对铜框架的粘结力见图4所示。

图4 不同成分对铜框架粘结力的影响
试验结果显示所有成分均在铜框架上具有优异的粘结力。通过铜表面的XPS(X射线光电子能谱)分析(见图5),其中932.4 eV的峰归为金属铜或一价铜;934.6 eV、940.7 eV和943.9 eV的峰为二价铜,即氢氧化铜和氧化亚铜。由于铜表面存在了二价氢氧键,其与模塑料中的羟基、氢键的结合力好。所以说由于裸铜框架表面的化学键决定了模塑料与其具有优异的粘结力。

图5 铜框架表面的XPS
4.2 环氧模塑料中各成分对镍钯金框架粘结力的研究
按照铜镀银框架的试验方法测试不同环氧树脂和酚醛树脂对镍钯金框架的粘结力见图6所示。

图6 不同成分对铜镀镍钯金框架粘结力的影响
通过粘结力数据可以看出催化剂环氧树脂E4对粘结力提高最有效。总体而言,所有环氧模塑料对PPF的粘结力均不好,铜镀镍钯金框架表面示意图见图7,模塑料与框架粘结面的材质为金。由于金表面没有活泼的化学键,因而与环氧模塑料粘结力较差。
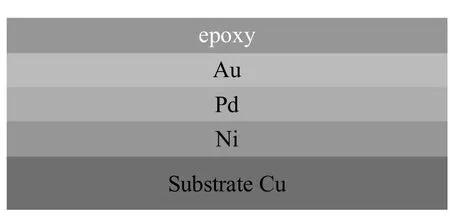
图7 铜镀镍钯金框架结构
5 结 论
本文研究了模塑料对3种框架材料铜、铜镀银、铜镀镍钯金粘结力的影响,分析了不同的环氧树脂和酚醛树脂对粘结力影响的原因。得出主要结论:
(1)不同结构的环氧树脂对粘结力有显著的影响,粘结力减小次序为:联苯型环氧树脂>双环戊二烯基团环氧树脂≈多芳香基团环氧树脂>邻甲酚环氧树脂。
(2)不同的酚醛树脂对粘结力影响明显,粘结力递减顺序为:多芳香基团酚醛树脂>多官能团酚醛树脂>普通酚醛树脂。
(3)对粘结力有显著提高的各成分均适用于铜、铜镀银以及铜镀镍钯金框架。铜框架的粘结力最好,铜镀镍钯金框架粘结力最小。
[1] 孙忠贤.电子化学品[M].化学工业出版社,2000.
[2] 陈平,刘胜平,王德忠.环氧树脂及其应用[M].化学工业出版社,2011.
[3] 邬震泰.半导体器件引线框架材料的现状与发展[J].材料科学与工程,2001,19(3):127-130.
[4] 李银华,刘平,田保红,等.集成电路用铜基引线框架材料的发展与展望[J].材料导报,2007,21(7):24-26.
[5] 李庆生.PPF框架在半导体工业中的应用[J].电子与封装,2010,10(3):36-39.
[6] T.Tubbs and P.Procter.Relationship of Delamination,mold compound formulation and device failure modes [N].Technical Paper,Dexter Electronic Division,The Dexter Corporation,1994(9):1-3.
[7] E.Takano,T.Mino,K.Takahashi,K.Sawada,S-Y. Shimizu,H.Y.Yoo,the oxidation control of copper Leadframe Package for prevention of Popcorn Cracking[C],IEEE 47th ECT Conference,1997:78-83.
[8] Xiuzhen Lu,Li Xu,Huaxiang Lai,Xinyu Du,Studies on microstructure of epoxy molding compound(EMC)-Leadframe interface after environmental aging[C],Electronic Packaging Technology&High Density Packaging,2009:1051-1053.
Research of Adhesion Among Epoxy Resin,Phenolic Resin and Lead Frame
QIN Suqiong,SHI Erzeng,TAN Wei,LIU Hongjie
(Lianyungang HHCK electronic Materials Co.Ltd,Lianyungang 222047 China)
Epoxy resin and phenolic resin are main components of epoxy molding compound.Cu,Cu/Ag,Cu/NiPdAu(PPF)are common lead frames materials on semiconductor packaging.This thesis mainly focuses on the study of the adhesion enhancement between EMC and different lead frames.The influence of resins on Cu/Ag also showed similar influence to Cu and Cu/NiPdAu lead frames.
Epoxy molding compound;Lead frame;Adhesion
TN405
:A
:1004-4507(2015)08-0001-05
秦苏琼(1982-),女,江苏连云港人,工程师,南京大学化学工程硕士,现任职于连云港华海诚科电子材料有限公司研发经理,主要从事于半导体封装以及集成电路组装中电子材料的研究和开发工作。
2015-06-30
