InSb纳米结构材料与器件进展与展望
2014-06-07郝秋来
郝秋来
·综述与评论·
InSb纳米结构材料与器件进展与展望
郝秋来
(华北光电技术研究所,北京100015)
锑化铟(indium antimonide,熔点~525℃)是一种窄禁带半导体。由于其高的电子迁移率、小的有效质量及在极性III-V族材料中有最大的g因子,因而在高速器件、磁阻器件等方面具有潜在的电子学应用价值,而且已被广泛用于磁敏器件、红外探测器等。由于具有较大的波尔半径(60 nm),使得InSb纳米结构成为具有吸引力的进行量子效应研究的半导体。因为这些特性,已有一些关于InSb纳米结构生长的报道。本文描述了近期InSb纳米结构生长的情况。透射电子显微镜等形貌像显示纳米结构为纳米晶体或纳米线,器件制备和性能测试显示其下一步的应用能力。
锑化铟;III-V族化合物;纳米材料;纳米器件;量子束缚;禁带宽度
1 引 言
锑化铟(indium antimonide,InSb熔点~525℃)为闪锌矿结构,在同类的III-V族化合物半导体材料中,有最窄禁带直接带隙(0.18eV@300K),最高的电子迁移率(室温下~78000 cm2V-1s-1)和极小的有效质量(电子有效质量M*e=0.014M0,空穴有效质量M*h=0.014 M0,M0是自由电子质量),被广泛用于红外探测器、磁敏器件和超快电子器件等[1]。
常规的锑化铟晶体制备可以采用的方法比较多样且成熟,如外延或熔态体生长,Czochralski生长的大尺寸体晶已做到近无位错。而纳米结构的锑化铟其生长方式有所不同,目前多采用外延的方法和有机合成的方法。纳米结构的锑化铟由于量子束缚等因素,禁带宽度值随纳米尺寸变化,例如在纳米晶体中发现,其值随纳米尺寸变化(从~1.03 eV/1200 nm到~0.71 eV/1750 nm)。这个禁带宽度的范围使得其与常规的Si等材料禁带宽度可以相提并论。从而使得纳米结构锑化铟除具有原有优势外又具有了新的特质。
近年来,随着纳米技术的不断发展,纳米结构的锑化铟如量子阱、量子点、纳米晶体、纳米线、纳米棒、纳米立方体等分别用不同方法制备成功。同时纳米器件也初步得到开展并取得许多新的特性。
2 纳米结构材料与器件进展
近期对III-V族半导体的纳米结构,特别是对InSb纳米结构研究逐渐活跃起来,这是由于锑化铟具有极佳的潜在优势。纳米结构的锑化铟,通过控制量子结构的形状大小,可以得到所需的禁带大小,从而使得纳米结构锑化铟具有了新的特质。本文将对InSb纳米结构材料及器件的进展介绍如下。
2.1 纳米结构的锑化铟材料生长
纳米结构分为多种形式,一般而言有纳米量子阱、纳米量子线/纳米棒、纳米量子点/纳米晶体等。近期对III-V族半导体的纳米结构,特别是对InSb纳米晶体研究成果逐渐活跃起来,下面分别就纳米量子线/纳米棒、纳米量子点/纳米晶体重地介绍。
2.1.1 纳米晶材料
Maksym Yarema等人采用铟和锑的氨基化合物控制胶体合成InSb纳米晶体,生长的纳米晶结构在多态性方面得以控制[2]。
文中报道了一种新的合成单分散胶体InSb纳米晶的方法,其示意图如图1所示,图1中的TOA是三正辛胺(trioctylamine);TOP是三辛基膦(trioctylphosphine)。采用氮元素强反应组合作前置物,如用氮化铟、氮化锑,可以提供成核动力并且可以形成均匀的胶状InSb纳米晶体、InSb纳米晶体吸收与发射谱在1500~2000 nm近红外区随尺寸的变化显示了半导体行为的量子束缚,而且给出了InSb纳米晶体闪锌矿/纤锌矿多态性和多型性,进而方便地控制设计近、中红外活跃的III-V族半导体的纳米结构。图2是TOP和TOA方法制备的InSb纳米晶体的显微镜像。

图1 InSb纳米晶体和纳米棒合成方法示意图

图2 用TOP和TOA方法制备的InSb纳米晶体低、高的分辨率透射电子显微镜像(TEM)和尺寸分布图
III-V纳米材料缺乏足够的液相合成动力,基本特征是具有强共价键特征的独立的四面体键化合物。大部分已发表的关于GaAs纳米材料生长文章指出其具有低的成晶率且需要高的反应温度或长的生长时间,这都引起III-V纳米晶体(NC)明显的尺寸扩展。另一个困难是难于选择合适的前置物而进一步限制了通过控制成核和生长的实验。在单一前置物下两个元素能够以希望的1∶1比率组成。然而这种方法到目前为止对III-V族纳米晶体成功的例子非常有限。
更进一步,反应动力学要求采用不同的氮原子的前置物,Sb TMS(三甲基硅trimethylsilyl)不稳定特性限制了InSb的合成,所以寻找合成单扩散InSb纳米晶体的主要症结是解决锑的前置物问题。
寻找具有反应能力锑源成为关键,SbCl3是共价,但是不稳定,Sb(TMS)3是具有吸引力的候选者。由于其在金属有机化学气相淀积(metal-organic chemical vapor deposition,MOCVD)中作为前置物,具有化学可操作性。最终通过优化使用氮元素作前置物合成了单扩散胶状InSb纳米晶体。
2.1.2 纳米线材料
最近有些研究者采用不同生长方法,生长出InSb纳米线材料,从形貌图观察,有良好的纳米线结构。
PhilippeCaroff[3]等人采用金属有机气相外延法生长的纳米线结构,通过在InAs纳米线上延续生长InSb纳米线的方法得到InSb纳米线。
图3为InAs(111)B面由400℃到460℃生长InAs/InSb异质结随温度的演变过程。局部放大显示接近InAs和InSb结合部位的典型单个纳米线形貌像如图4所示。
Sebastien R.Plissrd等人[4]采用MOVPE法通过电子束制版光刻等工艺得到清晰纳米线结构样品,如图5所示。

图3 30°倾角扫描电子显微镜成像

图4 30°倾角扫描电子显微镜成像InSb纳米线阵列
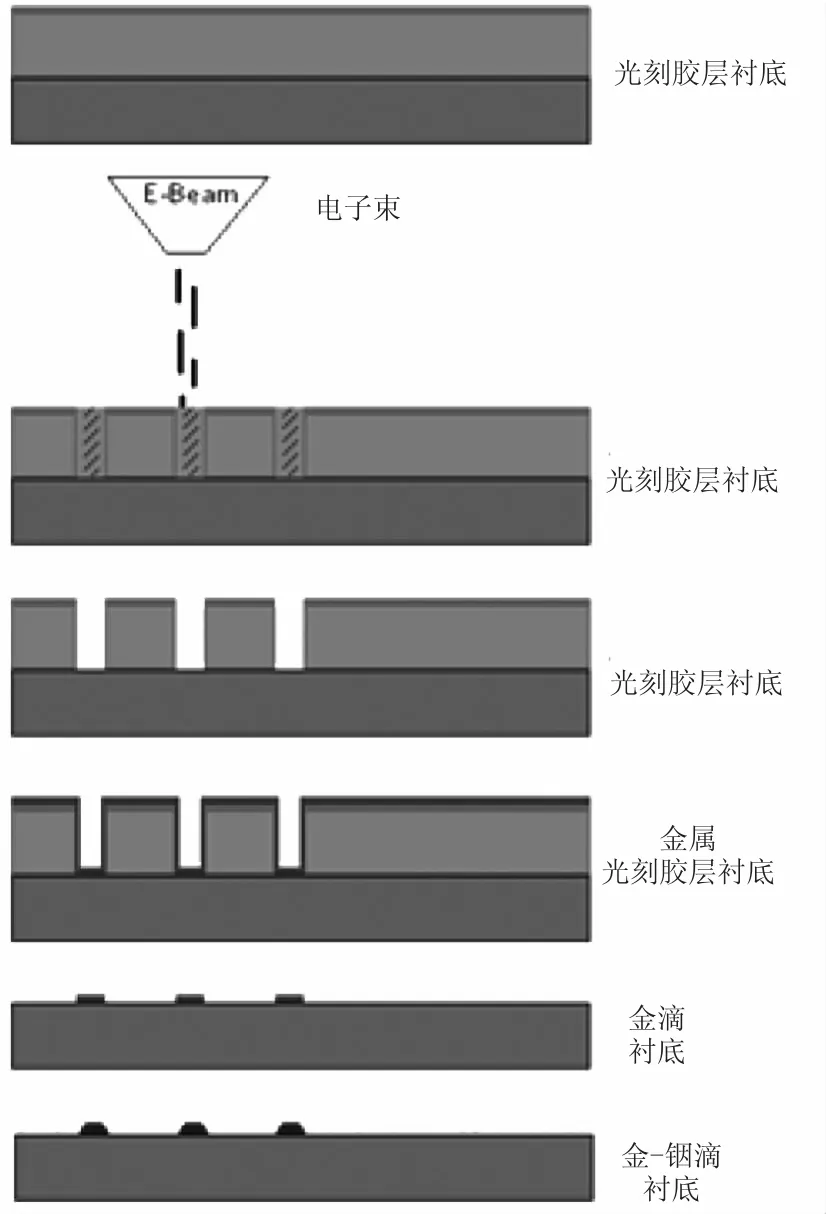
图5 电子束光刻,金淀积和剥离法用来制备25×25金微滴阵列(MOVPE反应器温度为420°C)
图6 为纳米线形貌随V/III比率和间距的变化过程。金催化剂尺寸是50 nm。图6(a)~图6(d)纳米线形貌随V/III比率的变化:(a)44,(b)66,(c)88,和(d)166。针对500 nm固定间距标尺为500 nm。图6(e)~图6(h)为纳米线形貌随间距的变化:(e)400,(f)600,(g)800和(h)1200 nm,对于V/III比率固定44的情况,标尺为500 nm。

图6 30°倾角扫描电子显微镜成像
H.A.Nilsson[5]等人在生长的InAs纳米管上接续生长出InSb纳米管并形成InAs纳米管/InSb纳米管异质结结构,如图7所示。

图7 InAs/InSb纳米管显微像
图7 为生长在InAs(111)B衬底上InAs/InSb异质结纳米管的扫描电子显微像,采用直径40 nm气溶胶金颗粒作为起始籽晶。低处较细的部分是I-nAs纳米管,上面较粗的部分是InSb纳米管,综上所述采用不同的生长方式及生长条件均可得到形貌鲜明的纳米线结构。
2.2 纳米结构的锑化铟器件制备与测试
Sebastien R.Plissrd等人还进行了器件的制备与测试,如图8所示。
图8中,(a)为InSb纳米线与Ti/Au源漏接触扫描电子显微镜像,至于285 nm厚的SiO2衬底上。p-掺杂Si层处在SiO2下面起到整体控制背栅。标尺对应1μm。(b)为当整体控制背栅电压为0,0.5,1和2 V时电流作为源漏电压函数。(c)为通过纳米线的电流受到整体控制背栅电压调制源漏偏置电压为Vsd=10 mV。

图8 InSb纳米线的电学测量
虚线显示在关断区附近的跨导,来自线表接触面的串阻为15 kΩ,在测量设置时被扣除。从有限元计算获得的电容为40μF。
H.A.Nilsson[5]等人进行了其他器件制备与测试,其结果如图9~11所示。测量显示背栅电压阈值VTbg≈0 V,低于此值时纳米线的传导通道关闭,测试同时显示本地指针正栅比背栅有比较高的跨导。

图9 双栅极InSb场效应管电特性
图9 中,(a)为带有整体控制背栅的双栅极InSb场效应管扫描电子显微像。(b)为在T=300K时器件测试的源漏电流Isd与源漏电压Vsd的对应关系,整体控制栅电压Vtg=-3到3 V步进间距0.5 V(输出特性)。(c)为在T=300 K时器件测试的源漏电流Isd与整体控制栅电压Vtg的对应关系,源漏电压Vsd=50 mV和300 mV(转移特性)。

图10 双栅门InSb纳米线电特性
图10 中,(a)带有本地指针正栅的双栅门InSb纳米线扫描电子显微像器件是由63 nm段InSb纳米线与500 nm宽度的Ti/Au金属电极接触,间隔1.3μm。一个单独的140 nm宽的Ti/Au金属门制备在InSb纳米线顶部,之间有一层10 nm厚的HfO2作为栅介电薄层。(b)源漏Isd测试,Vsd=50 mV和T=77 K,对整体控制栅电压Vtg(控门转移特性)背栅电压Vbg为-10到29 V,步进3 V。所有的纳米线通道中的载流子浓度由Vbg控制而Vtg能够用来关断本地导体通道。(c)在Vsd=50 mV和T=77 K时源漏Isd测试,在固定正栅控门电压Vtg=3 V时,作为背栅电压Vbg的对应曲线(背栅转移特性)。
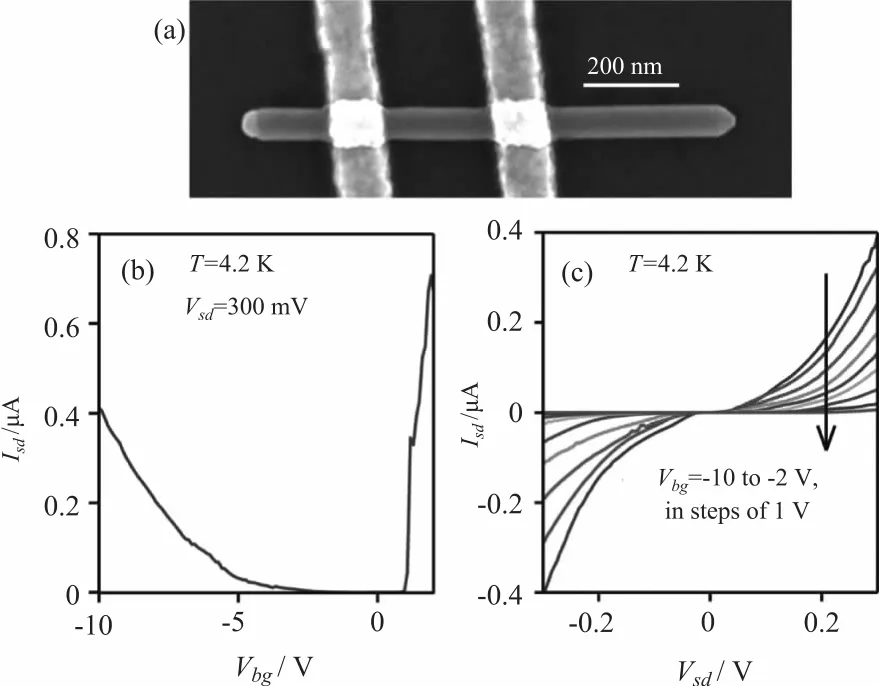
图11 单栅InSb纳米线场效应管电特性
图11 中(a)单栅InSb纳米线场效应三极管扫描电子显微像,两个Ti/Au金属接触电极240 nm在SiO2-覆盖Si衬底上。(b)源漏电流Isd测试,针对器件在源漏偏置电压Vsd=300mV和温度T=4.2 K时对Si背栅电压Vbg的曲线。这里的测试显示器件具有双极特征。(c)源漏电流Isd器件测试T=4.2 K对源漏电压Vsd的关系,背栅电压Vbg为-10到-2V,步长1 V(在p型导通区域)。测试没有清晰显示器件p型导通区的电流饱和行为。
2.3 InSb纳米线气体传感器应用
InSb纳米线场效应三极管可用于异丙醇、丙酮、水蒸气等的气体传感器,如图12所示。

图12 InSb纳米线气体传感器
图12 中,图12(a)为InSb纳米线器件安装在芯片架上,密封在玻璃腔体中照片。图12(b)为背栅InSb纳米线气体传感器示意图。
图13为InSb纳米线气体传感器的电流响应曲线。图13(a)为暴露在水蒸气后电流响应,随后用纯净的氩气净化,图13(b)为暴露在紫外光下同时用氩气净化的电流响应。

图13 电流的响应图
3 锑化铟纳米结构材料与器件展望
在过去的几十年里,集成在电路里的器件尺寸成指数下降。而芯片中器件的数量每两年增加一倍,芯片中每个功能的价格明显下降。半导体制造的这种趋势使得计算能力进一步增强。这也带来了技术进步和科学的发展。更影响着我们日常生活的各个角落。但集成电路这种尺寸的不断下降导致了硅电路三极管制造进入到纳米区间。这就带来了挑战,首先从物理学原理限制上,当尺寸小到一定尺寸时,特别是下降到几纳米,会发生新的物理现象。其次是技术层面,增加制作的复杂性和成本。研究人员将注意力调整到新型3维3栅几何结构FinFet三极管。
FinFet三极管栅长已可小于25 nm,未来预期可以进一步缩小至9 nm,约是人类头发宽度的万分之一。由于在这种导体技术上的突破,未来芯片设计人员可望能够将超级计算机设计成只有指甲般大小。FinFET源自于传统标准的晶体管—场效晶体管(Field-Effect Transistor;FET)的一项创新设计。在传统晶体管结构中,控制电流通过的栅,只能在栅的一侧控制电路的接通与断开,属于平面的架构。在FinFET的架构中,栅类似鱼鳍的叉状3D架构,可于电路的两侧控制电路的接通与断开。这种设计可以大幅改善电路控制并减少漏电流(leakage),也可以大幅缩短晶体管的栅长,如图14所示。

图14 FinFet三极管结构示意图
相似的替代材料的3维三极管方法可以由纳米线三极管实现。非常值得关注的新型材料包括IIIV族化合物、锗、碳纳米管和石墨烯。
由下而上的纳米结构合成制造方法将提供许多先进的特有功效。克服自上而下的依赖光刻技术的局限。同时提供了纳米结构带来的新的物理现象。其中纳米线材料尤为值得研究。纳米线在两维方向上可以在100 nm以下,可以显示出器件所需要的量子束缚效应。
纳米线场效应三极管可以具有环绕栅从而有更好的静电学控制和低的关断电流。而且一维的纳米线由于量子束缚具有弹道电子传输特性使得导通电流增加。纳米线还具有在集成电路各组件间作为连接器使用。
III-V族化合物半导体材料显示了许多吸引人的电学和光学特性,例如高的迁移率、高的热电系数、表面敏感性和在相对大的尺寸具有量子局域效应。这些特性使得III-V族材料在电子学、光电子学,和传感器等领域成为理想的纳米线材料。
而锑化铟是III-V族化合物半导体材料中最值得研究的对象,锑化铟具有成为超快和低静态功耗耗尽型三极管的潜质。由于其低的能带间隙0.17 eV,高的电子迁移率(30000 cm2V-1s-1)等特殊性能,在未来的纳米结构特别是纳米线材料和期间应用上会有越来越多的实质进展。
在纳米结构中,纳米线是目前广受关注的一种结构形式[6-12],一是其本身具有明显的量子束缚效应,同时在某个一维方向上具有与现有器件有机联络的宏观线长,特别是对有载流子引出的器件结构,连接点能够人工操作是目前相当长的一段时期的前提条件。对纳米晶体结构,通过场的控制,有发光等整体特征表现,也是今后重点研究的方向。
[1] Sadao Adachi.Properties of Semiconductor Alloys:Group-IV,III-V and II-VI Semiconductors[M].Hoboken:John Wiley&Sons,2009.
[2] Maksym Yarema,Maksym V Kovalenko.Colloidal Synthesis of InSb Nanocrystals with Controlled Polymorphism U-sing Indium and Antimony Amides[J].Chemistry of Materials,2013,25(9):1788-1792.
[3] Sébastien RomainPlissard,et al.From InSb nanowires to nanocubes:Looking for the sweet spot[J].Nano letters,2012,12:1794-1798.
[4] Philippe Caroff,Maria E Messing,B Mattias Borg,et al. InSb heterostructure nanowires:MOVPE growth under extreme lattice mismatch[J].Nanotechnology,2009,20(49):495606.
[5] Nilsson H A,et al.InSb Nanowire Field-Effect Transistors and Quantum-Dot Devices[J].IEEE Journal of Selected Topics in Quantum Electronics,2011,17(4):907-914.
[6] MotoichiOhtsu,et al.Principles of Nanophotonics[M]. Boca Raton:Taylor&Francis Group,LLC,2008.
[7] Gyu-Chul Yi.Semiconductor Nanostructures for Optoelectronic Devices Processing,Characterization and Applications[M].Heidelberg:Springer-Verlag,2012.
[8] Joyce,Hannah J,et al.III-V semiconductor nanowires for optoelectronic device applications[J].Progress in Quantum Electronics,2011,35(2-3):23-75.
[9] G Hiblot,et al.Compact modeling of the shift between classical and quantum threshold voltages in a III-V nanowire[J].Solid-State Electronics,2014,100:71-78.
[10]Ajit D Kelkar,et al.Nanoscience and Nanoengineering Advances and Applications[M].Boca Raton:Taylor&Francis Group,LLC,2014.
[11]Jesús A del Alamo.Nanometre-scale electronicswith III-V compound semiconductors[J].Nature,2011,479:317-323.
[12]W M Weber,et al.Reconfigurable nanowire electronics-A review[J].Solid-State Electronics,2014.
Progress and prospect of the nano structurematerial and device
HAO Qiu-lai
(North China Research Institute of Electro-optics,Beijing 100015,China)
Indium antimonide(InSb)(melting point~525℃)is a narrow bandgap semiconductor,and it iswell known for its highest bulk electron mobility,smallest effective mass,and largest g factor among binary III-V materials.It therefore has potential electronic applications in high-speed devices andmagnetoresistors,and has been used previously asmagnetic sensors and infrared(IR)detectors.Italso has a large Bohr exciton radius of60 nm,consequentlymaking InSb nanostructure an attractive semiconductor for quantum effect studies.For its interesting properties,some work has been reported on the growth of InSb nanostructure.The recentgrowth of InSb nanostructure is described in this review.Transmission electron microscopy showed the nanostructure to be nanocrystal or nanowires.Device fabrication and characteristics show the application capability of next step.
InSb;III-V group compound;nanomaterials;nanodevice;quantum confine;bandgap
TB383
A
10.3969/j.issn.1001-5078.2014.10.001
1001-5078(2014)10-1069-06
中国国家留学基金委员会资助。
郝秋来(1962-),男,研究员级高级工程师,长期从事光电技术特别是化合物半导体材料与器件研发工作。E-mail:hql519@gmail.com
2014-05-12
