电荷共享效应的RESURF横向功率器件击穿电压模型
2014-02-21郭宇锋姚佳飞
张 珺, 郭宇锋, 黄 示, 姚佳飞, 林 宏, 肖 建
南京邮电大学电子科学与工程学院,南京210003
降低表面场(reduced surface field,RESURF)结构是高压集成电路(high voltage integrated circuit,HVIC)和智能功率集成电路(smart power integrated circuit,SPIC)中的基本结构[1-8],广泛应用于以横向双扩散MOS(lateral double diffusion MOS,LDMOS)为代表的高耐压、低导通电阻横向功率器件[4-15],其基本理论是通过优化外延层浓度和厚度来达到降低表面电场以及提高击穿电压的目的.若外延层足够薄,横向PN结和纵向PN结之间会因相互作用而使耗尽层沿着水平方向延展很长距离,导致表面电场峰值的下降.表面电场的减弱增加了横向结击穿电压,使得器件在纵向结处达到临界电场,器件耐压得到大幅度的提高[2,6-7].
研究RESURF结构的耐压机理为结构优化设计提供了指导,并得到了广泛关注.虽然RESURF模型各不相同,但总的来说可以分为一维模型和二维模型两大类.一般而言,一维模型是将二维问题分解成横向和纵向两个独立的一维问题来分析,如文献[1-2]提出的模型.而电荷共享模型[3]和电荷分配模型[8]则进一步考虑了横向PN结和纵向PN结的相互作用,但只是简单地把共享区电荷分配给纵向结,且假设较为简单,故不能准确描述器件内的场势分布.二维模型则直接求解漂移区内的二维泊松方程,获得二维电场分布,进而求出体内和表面的击穿电压,如文献[12,14]提出的模型.这类模型尽管可以有效分析二维电场和电势分布,但数学表达式复杂,缺乏明晰的物理意义,且难以分析漂移区不全耗尽的情况.
本文考虑到横向结和纵向结耗尽区之间的耦合关系,基于Imam的电荷共享理论[3]重新定义共享区电荷分配关系,提出了共享区电荷沿对角线分配的新方案,并通过求解横向和纵向结的一维泊松方程,得到了一个新的击穿电压解析表达式,然后研究了击穿电压与器件结构参数的关系.解析结果与文献报道[2,9,15-19]的实验结果吻合良好,验证了模型的正确性.本模型一方面继承了一维模型物理概念清晰且数学表达式简单的优点,另一方面也准确地描述了纵向和横向耗尽区的相互耦合作用,因此是一个兼顾准确性和易用性的新模型,具有广阔的应用前景.
1 耐压模型
图1给出了一个典型的体硅RESURF高压二极管结构.在给定的外加反偏电压Vapp下,纵向PsubNepi结和一个横向P+Nepi结都处于反偏状态.P+区与N+区掺杂浓度均设置为1×1020cm-3以形成欧姆接触,因此横向P+Nepi结耗尽区沿漂移区横向扩展(宽度记为Xlat),纵向PsubNepi结耗尽区沿漂移区纵向扩展(宽度记为Xver),二维扩展使耗尽区发生交叠.文献[3]认为交叠部分的耗尽电荷全部贡献于纵向结而对横向结贡献为零,但这种假设缺乏物理依据.为此,本文假设在该共享区内的电荷沿对角线分为两部分,上半部分对横向P+Nepi结产生贡献,下半部分对纵向PsubNepi结产生贡献.下面分漂移区不全耗尽和全耗尽两种情况来分析击穿特性.
以P+Nepi冶金结为坐标原点建立坐标系,令冶金结的方向为y方向,而垂直冶金结的方向为x方向,则对横向结而言,等效掺杂浓度NRESURF可表示为

式中,Xlat表示横向耗尽区宽度,Ld表示漂移区长度,Nepi表示外延层掺杂浓度,Psub为衬底掺杂浓度,Tepi为外延层厚度,Xver为纵向耗尽区宽度.η=Xver(Vapp)/Tepi是纵向耗尽区宽度和外延层厚度之比,表征了横向结和纵向结的耦合程度,同时也表明了由于共享区电荷的耦合作用,横向单边突变P+Nepi结在实际工作中转化成了横向单边线性缓变结P+NRESURF(x),这是本模型与其他一维模型最大的不同之处.由此可得耗尽区内电势分布满足一维泊松方程

下面根据横向击穿发生条件的不同分为3种情况进行讨论.

图1 RESURF器件中的耗尽区共享情况Figure 1 Drift region charge-sharing effect in RESURF device
1.1 横向漂移区未全耗尽情况
当漂移区浓度较高时,在较低的反向偏压下器件就会在P+Nepi结处击穿,此时漂移区不能完全耗尽,其等效掺杂浓度和表面电场分布如图2所示.表面电场在冶金结处取得最高并沿着耗尽区方向不断下落直到在耗尽区边界为零,此时Xlat<Ld且Xver<Tepi,故η<1.将边界条件E(0)=Ec和E(Xlat)=0代入式(1)和(2),则横向结击穿电压VBlat为

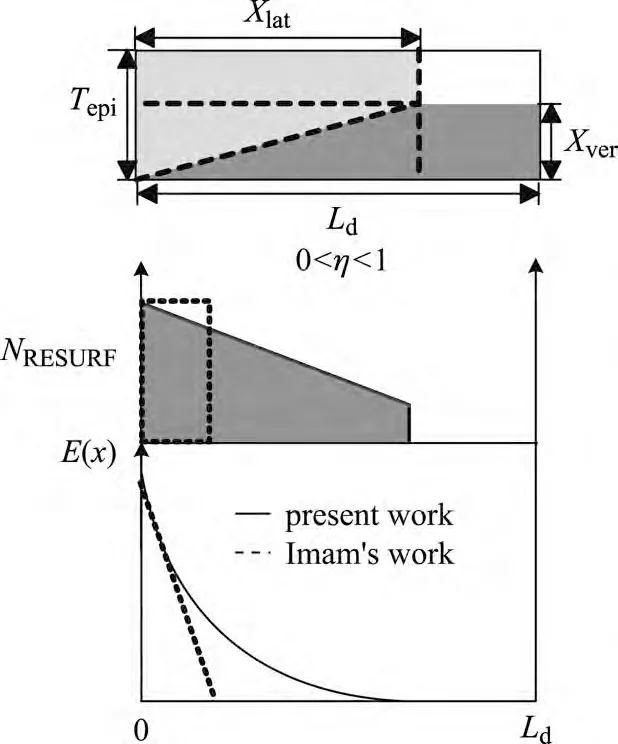
图2 当0<η<1时的等效掺杂浓度和表面电场分布Figure 2 Schematic diagram of the equivalent doping concentration and surface field distribution when 0<η<1
特别地,当η=1时,漂移区恰好从不全耗尽变为全耗尽,对横向结而言x=Ld处的外延层表现为本征态,即此处耗尽区电荷全部分配给纵向结而对横向结并无贡献,只有此时,本模型的结果才与文献[3]的结果一致.
1.2 横向漂移区全耗尽情况下P+N ep i结击穿
漂移区浓度降低到一定程度后,纵向结对横向结耗尽区的二维耦合效应更加明显,η≥1即Xver≥Tepi,漂移区完全耗尽,高掺杂N+区的阻挡Xlat=Ld.根据式(1)可以看出,耗尽区的扩展使得NRESURF(Ld)≤0,即在N+Nepi接触处外延层表现为P型掺杂,可以理解为共享区贡献给纵向结的电荷超出了掺杂浓度,从而导致等效浓度为负值.然而,此时P+Nepi结的电场强度仍然高于N+Nepi结,故横向击穿仍然发生在P+Nepi结,其等效掺杂浓度和表面电场分布如图3所示.可见由于电荷共享效应,靠近N+Nepi结处的纵向耗尽区宽度大于外延层厚度.为满足最高电场峰值出现在P+Nepi结处即E(0)>E(Ld),等效掺杂浓度应满足NRESURF(Ld)>-Nepi,即Tepi≤Xver<2Tepi,故1≤η<2.此时把边界条件E(0)=EC代入式(1)和(2),可以解得横向结击穿电压VBlat为


图3 当1<η<2时的等效掺杂浓度和表面电场分布Figure 3 Schematic diagram of the equivalent doping concentration and surface field distribution when 1<η<2
不难理解此时整个横向结上应由3个PN结构成:P+Nepi结、NepiPepi结、PepiN+结.在外加电压作用下,P+Nepi结和PepiN+结处于反偏状态而NepiPepi结处于正偏状态,因此在漂移区两端出现了两个电场峰值而在漂移区中部出现了一个电场谷值(如图3所示),而Appels和Imam的模型都不能正确解释横向电场分布这一现象[1-3].
1.3 横向漂移区全耗尽情况下N+N ep i结击穿
对于漂移区浓度非常低的器件,击穿时漂移区完全耗尽,且表面峰值电场出现在N+Nepi结处,此时Xlat=Ld且Xver≥2Tepi,故η≥2,其等效掺杂浓度和表面电场分布如图4所示.将边界条件E(Ld)=EC代入式(1)和(2),可以解得击穿电压

特别地,当η=2时,在漂移区中点处的等效漂移区电荷密度为零,而两侧的电荷密度相等,但符号相反.横向电场分布关于漂移区中点完全对称,漂移区两端的峰值电场相等,且均为硅的临界电场EC,此时P+Nepi结和NepiN+同时击穿,器件具有最高的横向击穿电压.

图4 当η>2时的等效电荷和表面电场分布Figure 4 Schematic diagram of the equivalent doping concentration and surface field distribution whenη>2
1.4 纵向结击穿情况
在通常情况下,RESURF器件的纵向击穿发生在纵向结全耗尽情况下(Xver>Tepi)[1-3,8],此时纵向击穿电压可以用穿通PN结的击穿电压表示为[3]

这里考虑到外延层厚度Tepi远远大于N+区的结深xjn,故用Tepi代替了(Tepi-xjn).
事实上,RESURF器件的击穿电压是由横向击穿电压和纵向击穿电压的最小值决定的,因此可得

2 实验与讨论
为了验证解析模型的正确性,根据式(4)~(7)计算出了击穿电压随漂移区浓度和外延层厚度变化的关系,并将解析结果与文献[2]的实验结果进行比较,如图5和6所示,可见解析结果和实验结果吻合良好.

图5 漂移区浓度对击穿电压的影响Figure 5 Dependence of breakdown voltage on doping concentration in drift region
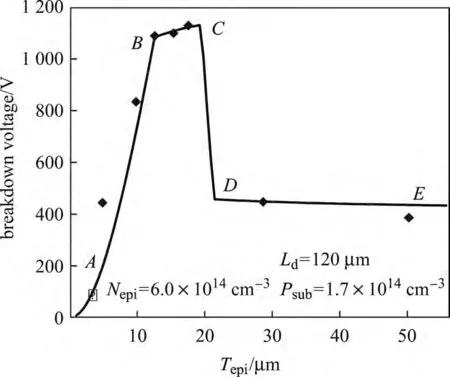
图6 外延层厚度对击穿电压的影响Figure 6 Dependence of breakdown voltage on epitaxial layer thickness
由图5可知,随着漂移区浓度的提高,击穿先后经历了4个阶段.首先,当漂移区浓度很低时,随着浓度的提高击穿电压也随之提高,这种情况下漂移区全耗尽且击穿将发生在横向N+Nepi结上,对应图5中的AB段,此时η>2,击穿电压由式(5)决定;继续提高浓度的同时,η的取值将随着Nepi的增加而降低,这说明随着Nepi的增大,纵向结与横向结之间的耦合作用在不断减小,横向结P+Nepi耗尽区沿漂移区的延伸将不断减小.由于P+Nepi结电场的提高以及N+Nepi结电场的降低,横向击穿电压随着漂移区浓度的提高而迅速提高并高于纵向结击穿电压.击穿将发生在纵向结上,击穿电压由式(6)决定,如图中的BC段所示,击穿电压基本不变,仅随外延层浓度增加略有下降.继续增加Nepi,P+Nepi结电场开始明显高于N+Nepi结电场,横向结击穿电压迅速下降,击穿从体内转至表面P+Nepi结处,此时1<η<2,击穿电压由式(4)决定,对应图中的CD段.当外延层掺杂浓度很高时,击穿发生在P+Nepi结且漂移区仅部分耗尽,此时η<1,击穿电压由式(3)决定,如图中的DE段所示.不难看出,这种情况下的器件耐压很低[1-3,8].特别地,当横向N+Nepi结和P+Nepi结同时击穿时,横向结耐压最高.
图6给出了击穿电压VBRESURF与Tepi关系,与图5类似,随着外延层厚度的增加,耦合因子η从大于2逐渐减小到小于1,器件击穿位置也依次为N+Nepi结、PsubNepi结、P+Nepi结,因此击穿电压的计算公式也依次为式(3)~(6).
综合图5和6可见,漂移区浓度和外延层厚度对击穿电压有着相似的影响规律,都有一个击穿电压最高的平台区.事实上,RESURF效应表明当外延层的掺杂剂量Qepi(漂移区浓度×外延层厚度,Nepi·Tepi)在某一范围变化时,击穿发生在纵向,且击穿电压最高,对器件结构参数的变化不敏感[1-4].为了定量地获得这一范围,根据图5或6可知,在B点横向N+Nepi结和纵向PsubNepi结同时击穿,而在C点横向P+Nepi结和纵向PsubNepi结同时击穿.因此,分别联立式(4)和(6)、式(5)和(6),得到漂移区掺杂剂量上限Qup和下限Qdown的近似表达公式,其单位为cm-2(数学推导详见附录)

式中,β=Tepi/Ld为漂移区几何结构系数,α=VB1/VB2为去耦(即忽略二维耦合效应)后漂移区纵向耐压和横向耐压之比.VB1和VB2的物理意义如图7所示,其中VB1=(ECTepi)/2为不考虑衬底影响的漂移区纵向耐压,而VB2=(qPsubL2d)/(2εs)为不考虑漂移区影响的衬底横向耐压.
图7和8分别给出了衬底浓度和漂移区长度变化时漂移区杂质剂量的理论变化区间,还给出了文献[2,9,15-19]提到的实验数据,可见实验数据都落在区间内,这也意味着利用式(8)和(9)可以准确预测漂移区杂质剂量.从图8中可以看出,文献[1-2]提出的RESURF条件仅给出了判据的上限且不随衬底掺杂浓度和漂移区长度的变化而变化,适用性较差;而文献[3]给出的RESURF判据同时给出了上限和下限,相较于文献[1-2]的RESURF条件具有更好的适用性,但上下限仍不随器件结构参数的变化而改变.本文判据直接由理论模型角度给出,同时考虑到了衬底掺杂浓度和漂移区长度对RESURF判据上下限的影响,数学形式简单明了且具有更好的适用性和工程应用价值.

图7 V B 1和V B 2的物理意义Figure 7 Physical meaning of V B 1 and V B 2

图8 RESURF判据的验证Figur e 8 Verif ication of RESURF criterion
3 结语
本文建立了一个新的横向RESURF器件击穿电压解析模型,假定共享区电荷沿对角线分配给横向结和纵向结,从而将横向结等效为一个单边突变线性缓变结;然后分别求解横向和纵向的一维泊松方程,获得了各种情况下的击穿电压解析表达式,并导出了一个新的RESURF判据.解析结果与文献提供的实验结果的一致性证实了模型的准确性.本文所建立的模型既保留了一维模型表达式简单以及物理概念清晰的优点,也兼具了二维模型可准确描述器件内场势分布以及揭示RESURF机制的特点,具有广泛的应用前景.
[1]APPELSJ,VAESH,VERHOEVENJ.High voltage thin layer devices[J].Electron Devices Meeting,1979,25:238-241.
[2]APPELSJ A,COLLET M G,HART P A H,VAESH M J,VERHOEVEN J F C M.Thin layer high voltage devices[J].Philips Journal of Research,1980,35(1):1-5.
[3]IMAM M,QUDDUS M,ADAMS J,HOSSAIN Z.Effi-cacy of charge sharing in reshaping the surface electric field in high voltage lateral RESURF devices[J].IEEE Transactions Electron Devices,2004,51(1):141-148.
[4]OROUJI A A,MEHRAD M.Breakdown voltage improvement of LDMOSs by charge balancing:an inserted P-layer in trench oxide(IPT-LDMOS)[J].Superlattices and Microstructures,2012,51:412-420.
[5]SHIMAMOTO S,YANAGIDA Y,SHIRAKAwA S,MIYAKOSHI K,OSHIMA T,SAKANO J,WADA S,NOGUCHI J.High-performance p-channel LDMOS transistors and wide-range voltage platform technology using novel p-channel structure[J].IEEE Transactions on Electron Devices,2013,60(1):360-365.
[6]LI Q,WANG W D,LI H O,WEI X M.High voltage silicon power device structure with substrate bias[J].Electronics Letters,2011,47(25):1394-1396.
[7]CHANGY H,CHANGC H.Improving an LDMOST by variation of lateral doping on epitaxial-layer drift region[J].Microelectronics Reliability,2011,51:2059-2063.
[8]LIXiaogang,FENGZhicheng,ZHANGZhengyuan,HU Mingyu.A charge allocating model for the breakdown voltage calculation and optimization of the lateral RESURF devices[J].Journal of Semiconductors,2009,30(3):034005-1.
[9]COLAK S.Effects of drift region parameters on the static properties of power LDMOST[J].IEEE Transactions on electron devices,1981,ED-28(12):1455-1465.
[10]CHUNG S K,HAN S Y,SHIN J C,CHUNG S K,HAN S Y,SHIN J C,CHOI Y I,KIM S B.An analytical model for minimum drift region length of SOI RESURF diodes[J].IEEE Electron Device Letters,1996,17(1):22-24.
[11]CHUNGSK,HANSY.Analytical model for the surface field distribution of SOI RESURF devices[J].IEEE Transactions on Electron Devices,1998,45(6):1374-1376.
[12]SUN Weifeng,SHI Longxing.Analytical models for the surface potential and electrical field distribution of bulk-silicon RESURF devices[J].Solid-State Electronics,2004,48:799-805.
[13]CORTÉSI,TOULONG,MORANCHO F,HUGONNARDBRUYERE E,VILLARD B,TOREN W J.Analysis and optimization of lateral thin-f ilm silicon-on-insulator(SOI)MOSFET transistors[J].Microelectronics Reliability,2012,52:503-508.
[14]HE J,ZHANG X.Quasi-2-D analytical model for the surface field distribution and optimization of RESURF LDMOS transistor[J].Microelectronics Journal,2001,32:655-663.
[15]CHANGY H,LINSW,CHANGC H.Optimization of high voltage LDMOSFETs with complex multipleresistivity drift region and field plate[J].Microelectronics Reliability,2010,50:949-953.
[16]HARDIKAR S,R TADIKONDA R,DAVID W.GREEN D W,KONSTANTINV.VERSHININK V,NARAYANAN E M S.Realizing high-voltage junction isolated LDMOS transistors with variation in lateral doping[J].IEEE Transactions on Electron Devices,2004,51(12):2223-2228.
[17]VESTLING L,OLSSON J,EKLUND K H.Drift region optimization of lateral RESURF devices[J].Solid-State Electronics,2002,46:1177-1184.
[18]MOENSP,van den BOSCH G.Reliability assessment of integrated power transistors:lateral DMOS versus vertical DMOS[J].Microelectronics Reliability,2008,48:1300-1305.
[19]DUAN Baoxing,YANG Yintang,ZHANG Bo.High voltage REBULF LDMOS with N+buried layer[J].Solid-State Electronics,2010,54:685-688.
附录
RESURF判据的数学推导
横向结和纵向结上所承担的外加反偏电压相同,因此当1<η<2时,联立式(4)和(6)可以确定横向结的η值满足

而根据式(6)可知纵向结满足

当横向结和纵向结同时发生击穿时,横向结与纵向结拥有同样的η值,于是联立式(10)和(11)可得利用式(12)并将Qup=NepiTepi代入,即可给出本文RESURF判据的上限为

同样利用横向结和纵向结上具有相同的外加电压,联立式(5)和(6)可以给出在η>2时横向结的η值

由于当横向结和纵向结同时发生击穿时横向结与纵向结拥有同样的η值,且纵向结对应的η值由式(11)决定.因此,联立式(11)和(14)有

利用式(15)并将Qdown=NepiTepi代入,即可确定本文RESURF判据的下限为

式中,εs=1.05×10-10F/m为Si材料介电常数,q=1.602×10-19C为电子电量,这里取Si材料临界电场EC=1.5×105V/cm这一常用的近似值.因此,有近似关系εsEC/q≈1×1012cm-2,并设β=Tepi/Ld为漂移区几何结构系数,α=VB1/VB2为去耦后漂移区纵向耐压和横向耐压之比.其中VB1=(ECTepi)/2为不考虑衬底影响的漂移区纵向耐压,而VB2=(qPsubL2d)/(2εs)为不考虑漂移区影响的衬底横向耐压.将α、β、εsEC/q代入并化简式(13)和(16)可分别近似得到漂移区掺杂剂量上限Qup和下限Qdown,其单位为cm-2

