金属有机化学气相沉积法生长条件对AlN薄膜面内晶粒尺寸的影响*
2013-09-27吴亮亮赵德刚李亮乐伶聪陈平刘宗顺江德生
吴亮亮 赵德刚 李亮 乐伶聪 陈平 刘宗顺 江德生
(中国科学院半导体研究所,集成光电子学国家重点实验室,北京 100083)
(2012年11月16日收到;2012年12月19日收到修改稿)
1 引言
本文利用Williamson-Hall方法[8-10]测量AlN薄膜的面内晶粒尺寸,利用X射线衍射仪(XRD)测试不同氮化时间、缓冲层生长时间、载气流量生长条件下AlN薄膜(0002),(0004),(0006)的ω扫描的半高宽,并分析这些生长条件对AlN薄膜的面内晶粒尺寸的影响.
2 测试所用材料的结构及Williamson-Hall方法
图1是测试所用的材料结构示意图.如图1所示,我们测试所用的AlN薄膜是在C面蓝宝石衬底上利用金属有机化学气相沉淀设备(MOCVD)生长的,Al源和N源分别由三甲基铝(TMA)和NH3提供,载气为H2,反应室保持压强为4000 Pa.先只通入NH3进行氮化,NH3的流量为0.5 L/min,氮化温度为1080°C;再生长一层AlN缓冲层,NH3的流量为0.5 L/min,TMA的流量为120 mL/min;之后再生长一层厚度约为0.7µm的AlN外延层,NH3的流量为5 L/min,TMA的流量为30 mL/min,生长温度为1080°C.

图1 测试所用的材料结构示意图
Williamson-Hall方法测量面内晶粒尺寸的基本原理[11]是:对于三轴衍射(000L)的ω扫描,衍射峰的半高宽β是由位错产生的倾转角βt与面内共格长度 L//产生的加宽βL‖的和.β,βt和βL‖在倒易空间的qy轴上可分别表示为2βsinθ/λ,2βtsinθ/λ和1/L//,其中θ为(000L)面的布拉格角,λ为所用X光的波长,其值为1.5448˚A,面内共格长度L//为两个面内位错间的距离,即认为面内晶粒尺寸是面内位错的间距,所以面内共格长度也被称为面内晶粒尺寸,公式为

对于所有的AlN薄膜我们利用XRD三轴衍射测试其(0002),(0004)和(0006)的ω扫描,代入公式的β是用弧度表示的角度,λ为0.15448 nm.由于βsinθ/λ与sinθ/λ为线性关系,所以以sinθ/λ作为自变量,βsinθ/λ为应变量,将(000L)的三个数值点代入坐标系中,可以得到一条直线,设直线的截距为y0,斜率为K,则可得如下结果:

面内共格长度也即是面内晶粒尺寸,是在假设薄膜由许多小的近柱体的小晶粒组成的条件下引入的.由(1)式可知,(000L)面ω扫描的半高宽有如下结果:

其中C为λ/(2sinθ).由此可知,面内晶粒尺寸越小时,衍射峰半高宽(FWHM)越大,位错密度越大,晶体质量越差.
3 测试结果与讨论
首先测试不同氮化时间条件下AlN薄膜的(000L)面ω扫描,材料的其他生长条件相同.图2为不同氮化时间的Williamson-Hall方法做图.图2中的直线为同一个样品的三个数据点的拟合直线,每条拟合直线上的三个数据点分别代表(0002),(0004),(0006)面ω扫描的数据(包含FWHM和Bragg衍射角θ).其中AlN薄膜的(0002),(0004),(0006)的Bragg衍射角θ分别取18.01°,38.19°,67.96°[11].将图 2 中拟合所得直线的斜率和截距代入(2)式,可以得出面内晶粒尺寸随氮化时间变化的关系,如图3所示.
世行项目的实施,改善了项目区农业基础设施,调整了土地利用结构,提高了土地生产率,减轻了自然灾害,促进了致富奔小康、村容村貌改变和生态文明建设。机耕道达村组,人行便道连院户,极大地方便农民出行;自来水进农户,解决了农村饮水困难;通过沼气建设,项目区农民用上了清洁生活能源,替代煤炭、薪柴和秸秆,保护植被资源,同时,沼渣、沼液作为优质有机肥还田,减少农药、化肥施用量,提高了农产品品质。
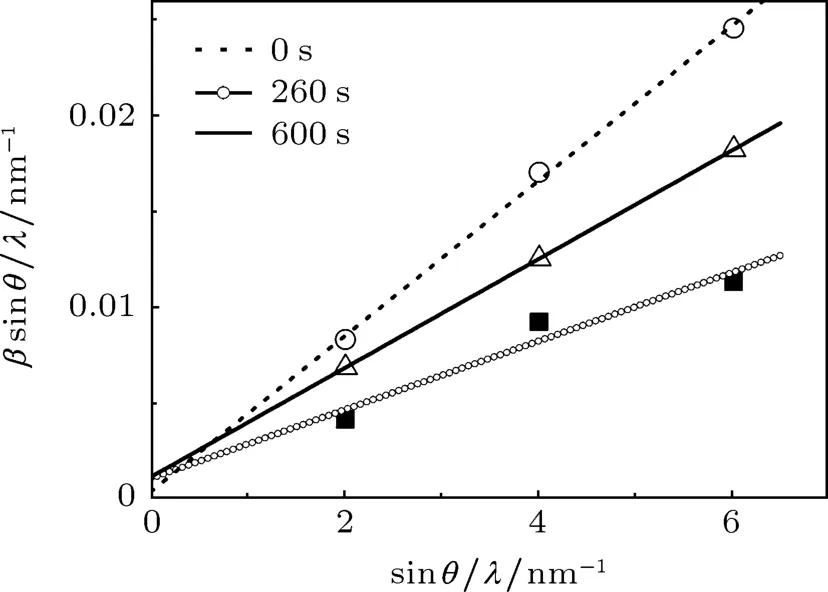
图2 不同氮化时间的Williamson-Hall方法做图
图3 为面内晶粒尺寸随氮化时间变化的关系,由图3可知,随着氮化时间增加,面内晶粒尺寸减小,氮化时间从0增加到260 s时,面内晶粒尺寸减小的幅度很大,即面内晶粒尺寸从948 nm减少到464 nm.当氮化时间从260 s增加到600 s时,面内晶粒尺寸减小的幅度较小,即面内晶粒尺寸从464 nm减少到394 nm.表明氮化过程使得面内晶粒尺寸减小,其原因可以解释为氮化过程使得在蓝宝石衬底表面形成很多的成核区,接下来生长的AlN缓冲层和AlN薄膜层就是在这些成核小岛处不断朝横向和纵向生长,最后合并成平面.此时随着氮化时间的增加,成核小岛的密度也增加,而成核小岛密度增加使得最终形成的晶粒密度增加,从而每个晶粒的大小变小,也即面内晶粒尺寸变小[12].所以随着氮化时间的增加,成核小岛密度增加,面内晶粒尺寸减小.
其次测试不同缓冲层生长时间条件下AlN薄膜的(000L)面ω扫描,所有样品的氮化时间都为260 s,材料的其他生长条件相同.将(0002),(0004),(0006)面ω扫描的数据代入Williamson-Hall做图法中,可得出图4为不同缓冲层生长时间的Williamson-Hall方法做图.将图4中拟合所得直线的斜率和截距代入(2)式,可以得出面内晶粒尺寸随氮化时间变化的关系,如图5所示.

图3 面内晶粒尺寸随氮化时间变化的关系

图4 不同缓冲层生长时间的Williamson-Hall方法做图

图5 面内晶粒尺寸随缓冲层生长时间变化的关系
图5 为面内晶粒尺寸随缓冲层生长时间变化的关系,由图5可知,随着缓冲层生长时间的增加,面内晶粒尺寸基本成线性增加,缓冲层生长时间为100,160和420 s时,面内晶粒尺寸分别为389,464和689 nm.表明增加缓冲层生长时间可以增大面内晶粒尺寸,其原因可以解释为,AlN缓冲层的晶粒是在氮化形成的成核小岛上生长而成的,随着AlN缓冲层生长时间的增加,成核岛不断长大与合并,最终从三维岛状生长过渡为二维平面生长,增加AlN缓冲层生长时间使得岛的合并增加,最终形成的AlN薄膜晶粒尺寸变大,密度降低.所以随着AlN缓冲层生长时间的增加,AlN薄膜晶粒尺寸变大,密度降低,最终AlN薄膜的面内晶粒尺寸变大.

图6 不同载气流量的Williamson-Hall方法做图

图7 面内晶粒尺寸随载气流量变化的关系
最后测试不同载气流量条件下AlN薄膜的(000L)面ω扫描,所用载气为氢气(H2),改变的只是AlN薄膜层生长时的载气流量,氮化层和AlN缓冲层所用载气都为10 L/min,此三个样品都没有AlN缓冲层,氮化时间为300 s,生长材料的其他生长条件相同.将(0002),(0004),(0006)面ω扫描的数据代入Williamson-Hall做图法中,可得出图6为不同载气流量的Williamson-Hall方法做图.将图6中拟合所得直线的斜率和截距代入(2)式,可以得出面内晶粒尺寸随载气流量变化的关系,如图7所示.
图7为面内晶粒尺寸随载气流量变化的关系,由图7可知,随着载气流量的增加,面内晶粒尺寸大幅减小,AlN薄膜层载气流量为6,10和14 L/min时,面内晶粒尺寸分别为5505,535和245 nm,表明减小载气流量可以增大面内晶粒尺寸.可能的解释是载气流量越大,越利于晶粒的纵向生长,从而不利于成核岛的合并,AlN薄膜晶粒尺寸变小,密度变大,使得最终AlN薄膜的面内晶粒尺寸减小.
4 结论
本文应用Williamson-Hall方法测试并分析了不同氮化时间、AlN缓冲层生长时间、载气流量生长条件下AlN薄膜的面内晶粒尺寸的变化.实验结果表明随着氮化时间的增加,成核小岛密度增加,使得面内晶粒尺寸减小;随着AlN缓冲层生长时间的增加,AlN薄膜晶粒尺寸变大,密度降低,最终AlN薄膜的面内晶粒尺寸变大;随着载气流量的增加,越有利于晶粒的纵向生长,使得面内晶粒尺寸减小.要想获得晶体质量较好的AlN薄膜,可以在选择较小的载气流量和较小氮化时间前提下,优化AlN缓冲层生长条件,即增加缓冲层生长时间,甚至可以考虑两步缓冲层生长,以增加AlN成核岛的合并,增加AlN薄膜面内晶粒尺寸.
感谢北京同步辐射装置(BSRF)衍射站对AlN薄膜材料X射线衍射表征的支持和帮助.
[1]Kung P,McClintock R,Vizcaino JL P,Minder K,Bayram C,Razeghi M 2007 Quantum Sensing and Nanophotonic Devices III 6479 J4791
[2]McClintock R,Pau JL,Minder K,Bayram C,Kung P,Razeghi M 2007 Appl.Phys.Lett.90 141112
[3]Pau J L,McClintock R,Minder K,Bayram C,Kung P,Razeghi M,Munoz E,Silversmith D 2007 Appl.Phys.Lett.91 041104
[4]McClintock R,Pau JL,Bayram C,Fain B,Giedraitis P,Razeghi M 2009 Proc.SPIE 7222 72220U
[5]Razeghi M,Bayram C 2009 Proc.SPIE 7366 73661F
[6]Carrano JC,Lambert D JH,Eiting C J,Collins C J,Li T,Wang S,Yang B,Beck A L,Dupuis RD,Campbell JC 2000 Appl.Phys.Lett.76 924
[7]Zhang S,Zhao D G,Liu Z S,Zhu JJ,Zhang SM,Wang Y T,Duan L H,Liu W B,Jiang D S,Yang H 2009 Acta Phys.Sin.58 7952(in Chinese)[张爽,赵德刚,刘宗顺,朱建军,张书明,王玉田,段俐宏,刘文宝,江德生,杨辉2009物理学报58 7952]
[8]Williamson GK,Hall WH 1953 Acta Metall.1 22
[9]Chierchia R,Bottcher T,Heinke H,Einfeldt S,Figge S,Hommel D 2003 J.Appl.Phys.93 8918
[10]Zhang JC,Zhao D G,Wang JF,Wang Y T,Chen J,Liu JP,Yang H 2004 J.Cryst.Growth 268 24
[11]Xu Z J 2007 Measurement and Analysis of Semiconductor(2nd Ed.)(Beijing:Science Press)p164(in Chinese)[许振嘉2007半导体的检测与分析(第二版)(北京:科学出版社)第164页]
[12]Paduano Q S,Weyburne D W,Jasinski J,Liliental-Weber Z 2004 J.Cryst.Growth 261 259
