脉冲激光沉积法制备的ZnO薄膜的低阈值电抽运紫外随机激射*
2013-09-27徐韵李云鹏金璐马向阳杨德仁
徐韵 李云鹏 金璐 马向阳 杨德仁
(浙江大学,硅材料国家重点实验室,杭州 310027)
(2012年12月5日收到;2012年12月18日收到修改稿)
1 引言
随机激射是一种产生于无序增益介质中的发光现象[1].当光在无序增益介质中经过多重散射而获得的光增益超过光损耗时就产生了随机激射.与传统激光相比,随机激光器的制备工艺简单,无需制备精密的谐振腔.随机激射的发光峰线宽很窄,无特定的出射方向,其独特的发光性能在成像[2]、平面显示[3]、生物医药[4]等方面都具有潜在的应用价值.ZnO由于具有较高的光增益系数和折射率,被认为是制备紫外随机激光器的理想材料.自Cao等[5,6]报道了ZnO薄膜和颗粒的光抽运随机激射现象后,基于各种类型的ZnO材料的随机激射引起了人们的广泛研究[7-12].2006年,Leong等[13]利用ZnO-SiO2纳米复合结构首次实现了ZnO纳米颗粒聚集体的电抽运紫外随机激射;2007年,Ma等[14]利用金属绝缘体半导体(MIS)结构实现了ZnO多晶薄膜的电抽运随机激射.随后,人们利用多种器件结构实现了ZnO的电抽运随机激射[15-17].上述工作为ZnO随机激射走向实际应用打下了基础.与传统激光器一样,低阈值电流也是电抽运随机激射所追求的目标之一.显然,在特定的器件结构下,ZnO薄膜随机激射的阈值电流的大小应与薄膜本身的性能有关,而ZnO薄膜的性能则在相当程度上取决于制备方法.制备ZnO薄膜的方法多种多样,其中磁控溅射法和脉冲激光沉积(PLD)法是常用的物理气相沉积法.这两种方法所涉及的物理过程很不相同,形成薄膜的“前驱体粒子”的能量也不一样,因此由它们制备的ZnO薄膜在性能上必然存在差异.这两种薄膜的电抽运随机激射的阈值存在何种差异,到目前为止还未见报道.本文采用MIS结构,分别以溅射法和PLD法制备的ZnO薄膜为半导体发光层制备发光器件.比较这两种器件的电致发光可以发现,以PLD法制备的ZnO薄膜为发光层的器件产生随机激射的阈值电流更低,且在相同电流下的光输出功率更大.本文从随机激射的物理机理出发对此现象进行了解释.
2 实验
用PLD法和直流反应溅射法在〈100〉取向,电阻率0.0015Ω·cm,尺寸为15 mm×15 mm的重掺磷n型单晶硅衬底片上生长ZnO薄膜.用PLD法制备ZnO薄膜时,先将生长室的背景真空抽至5×10-5Pa,然后通入高纯氧气至0.5 Pa的工作气压.将Nd:YAG脉冲激光器的波长为355 nm,脉冲频率为10 Hz,单脉冲能量为100 mJ的激光聚焦在纯度为99.99%的ZnO陶瓷靶上,聚焦面积大约为1 mm2,薄膜沉积在温度为300°C的硅衬底上,沉积时间为90 min,由此获得的薄膜约100 nm厚.用直流反应溅射生长ZnO薄膜时,使用的溅射靶材为纯度99.99%的金属Zn靶.先将生长室的背景真空抽至5×10-3Pa;然后往腔体内通入高纯氩气和氧气,它们的流量分别为30和15 sccm(1 sccm=1 mL/min),在8 Pa的工作气压下进行反应溅射,溅射功率为100 W,衬底硅片的温度也为300°C,生长时间为30 min,沉积的薄膜也是约100 nm厚.为改善薄膜的结晶性,由上述两种方法生长的ZnO薄膜在氧气气氛下再进行2 h的700°C热处理.然后,利用溶胶-凝胶法在ZnO薄膜上旋涂SiO2薄膜.具体步骤如下:配制正硅酸乙酯(TEOS):乙醇(EtOH)=1:10(摩尔比)的前驱体溶液,并加入微量的HCl作为催化剂,搅拌2 h后,作为SiO2的前驱体溶胶.在ZnO薄膜上以3500 r/min的速度旋涂上述SiO2前驱体溶胶薄膜,接着在100°C下烘干20 min,最后在空气中于550°C热处理1 h形成SiO2薄膜.接下来,在SiO2薄膜上溅射约20 nm厚的半透明Au电极作为器件的正面电极,而在硅衬底背面溅射沉积约100 nm厚的Au电极作为背面电极.这里的正面与背面Au电极均呈直径为10 mm 的圆形.通过上述步骤形成的基于ZnO薄膜的MIS结构发光器件的结构如图1所示.
ZnO薄膜的表面形貌和结晶状况分别由Hitachi S-4800型场发射扫描电镜(SEM)和Rigaku D/max 2550-pc型X射线衍射仪 (XRD)(波长为0.15406 nm的Cu Kα辐射)表征.ZnO薄膜的光致发光(PL)和上述发光器件的电致发光(EL)都采用Acton spectraPro 2500i型光谱仪检测.PL的激发光源为波长325 nm的He-Cd连续激光.为获得器件的EL光谱,采用Agilent E3645A直流电源,在器件上施加正向偏压,这时正面Au电极接正电压.采用Newport 1931-C型功率计测量发光器件的光输出功率.经估算,实际测到的光输出功率约为器件总出射功率的2%.
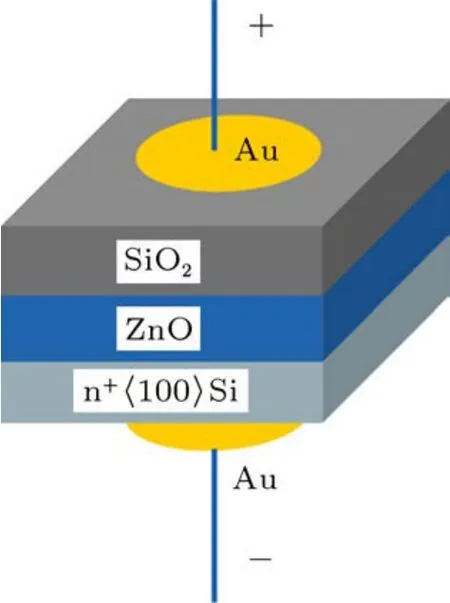
图1 硅衬底上基于ZnO薄膜的MIS器件的结构示意图
3 结果与讨论
以溅射法与PLD法沉积的ZnO薄膜经过700°C热处理2 h后的SEM照片分别如图2(a)和(b)所示.可以看出,两种ZnO薄膜均呈现相当致密的状态,晶粒尺寸相近,均在100—200 nm范围内.相对而言,PLD法生长的ZnO薄膜的晶粒端面更不规则,我们认为这与ZnO靶材在激光照射下熔融产生的“液滴”化有关.总体而言,两种薄膜中的ZnO晶粒都表现为无序聚集的状态,形成典型的无序介质.因两种薄膜中的晶粒大小和晶界数目不存在显著差别,可以推论,在两种薄膜中的光散射强度不应存在明显差异.
图3(a)给出的是两种方法生长的ZnO薄膜的XRD谱.可以看出,两种方法生长的ZnO薄膜具有相同的晶面取向,即XRD谱上均出现较强的对应于(103)晶面和较弱的对应于(002)晶面的两个衍射峰.图3(b)为两种方法生长的ZnO薄膜的室温PL谱.显然,PL谱中的紫外发光峰来自于ZnO的近带边辐射,而PL谱中的可见发光峰一般认为与ZnO中的Znv,Zni,Ov,Oi等点缺陷有关[18].在溅射ZnO薄膜的室温PL谱中,近带边紫外发光峰(380 nm)明显弱于与缺陷相关的可见发光峰(500—750 nm),这说明溅射ZnO薄膜中存在着大量的缺陷,这可能与溅射过程中氧化反应不完全导致的偏离化学计量比有关.在PLD法生长的ZnO薄膜的室温PL谱中,紫外发光峰非常显著而可见发光峰几乎被完全抑制.PLD法生长薄膜的一个优点就是可以很好地保证薄膜的组分与靶材的组分相一致.因此,PLD法生长的ZnO薄膜更接近于理想化学计量比,从而显著减少了Zn和O的点缺陷.总之,从发光的角度来说,经过相同条件的热处理后,PLD法制备的ZnO薄膜具有更好的晶体质量.显然,对ZnO薄膜来说,可见光区的发光受到抑制是有利于其紫外发光的.
以溅射法和PLD法沉积的ZnO薄膜为发光层的MIS器件在不同正向偏压/电流下的室温紫外EL图谱分别如图4(a)和(b)所示.顺便指出,两种器件在可见光区都未表现出电致发光.从图4中可知,当注入电流超过一定值后,EL谱线上出现分立而尖锐的发光峰,这些发光峰的半高宽不超过0.5 nm,相邻两峰之间的间距是不均匀的.随着注入电流的增加,EL谱中尖峰数目和强度也随之增加.EL谱表现出的上述特征表明基于ZnO薄膜的MIS器件在一定的阈值电流之上产生了随机激射.对比图4(a)和(b)可以发现,相比于以溅射法生长的ZnO薄膜作为发光层的器件,以PLD法生长的ZnO薄膜为发光层的器件可在更低的注入电流下实现随机激射.
图5为两种器件实际测得输出光功率随注入电流的变化曲线.从图5中可知,对两者而言,当注入电流超过某一数值(即阈值电流)时,光功率随注入电流的增加而更快速地增大,即曲线的斜率增加.这是由于器件的发光机制由自发辐射转变为随机激射所致.从图5中可以看到,以PLD法制备的ZnO薄膜为发光层的器件产生随机激射的阈值电流约为3 mA,远低于以溅射法制备的ZnO薄膜为发光层的器件的阈值电流(约为15 mA).此外,在相同注入电流下,前者的输出光功率也明显高于后者.上述情况说明以PLD法制备的ZnO薄膜为发光层的器件具有更好的随机激射性能.
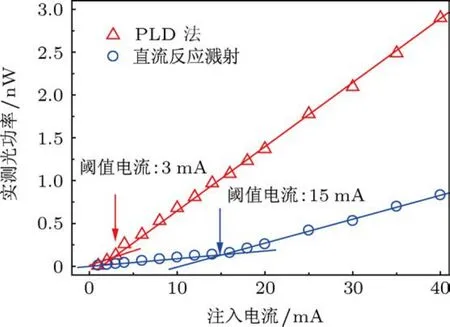
图5 以直流反应溅射法与PLD法制备的ZnO薄膜为发光层的MIS器件实际测得的光功率随注入电流的变化
产生随机激射的先决条件是介质必须具备光增益,而产生光增益的前提条件是受激辐射.我们从能带结构的角度出发,分析基于ZnO薄膜的MIS器件产生受激辐射的物理机理.图6(a)是处于正向偏压下的基于ZnO薄膜的MIS器件的能带结构示意图.在正向偏压下,ZnO能带向下弯曲,因此在SiO2薄膜一侧的附近区域形成电子的积累.由于溶胶-凝胶法制备的SiO2薄膜的热处理温度较低(550°C),因此薄膜中存在大量的缺陷态.靠近SiO2薄膜一侧的ZnO薄膜价带中的一部分电子在电场驱动下进入SiO2薄膜中的缺陷态,而在ZnO价带中产生等量的空穴.因此,在SiO2/ZnO界面附近区域,积累的电子与空穴复合,产生紫外发光.随着正向偏压的增大,导带中积累的电子数目与价带中产生的空穴数目增加.当正向偏压增大到一定程度时,电子的准费米能级(EFn)会进入导带,而空穴的准费米能级(EFp)会接近甚至低于价带顶(如图 6(b)所示),从而满足受激辐射的条件,即EFn-EFp>Eg.由受激辐射导致的光增益因子随注入电流的增加而增大,因此,只要当注入电流足够大时,就可使光在传播过程中获得的光增益大于光损耗,从而产生随机激射.另外需要指出的是,随机激射峰的波长分布范围对应于受激辐射光子的能量范围.考虑到ZnO的激子束缚能较大(约60 meV),并结合图6(b)可知:受激辐射光子的能量覆盖近带边(约为禁带宽度减去激子束缚能)到EFn-EFp(电子和空穴的准费米能级之差).这就不难理解,在短于和长于ZnO禁带宽度对应的波长处均可出现随机激射峰.具体到本文来说,随机激射行为覆盖了约365—395 nm的波长范围.
产生随机激射的另一个条件是光的多重散射.对于ZnO多晶薄膜来说,光在其内部传播过程中必然受到多重散射,它主要来自于ZnO多晶薄膜内的晶界散射.由图2可知,两种方法制备的ZnO薄膜在晶粒尺寸和晶界密度上是相近的,因此可以认为在这两种薄膜内光的多重散射的强度不会有本质上的差异.因此,我们认为在多重散射强度可比拟的情况下,两种器件在随机激射阈值电流和光输出功率上的差异主要是与光获得的净光增益不同有关.如前所述,当光在多重散射过程中获得的光增益大于光损耗(即具有净光增益)时,产生随机激射.对ZnO薄膜来说,缺陷对近带边辐射紫外光的吸收是产生光损耗的一个重要原因.从图3(b)已知,PLD法制备的ZnO薄膜比溅射法制备的ZnO薄膜具有更好的晶体质量,即缺陷数目更小.换句话说,近带边辐射的紫外光在PLD法制备的ZnO薄膜中传播时被缺陷吸收得更少,即遭到的光损耗更小.另一方面,注入到ZnO中的载流子参与缺陷发光的数目更少,即更多地参与了近带边辐射.因此,可以理解以PLD法制备的ZnO薄膜为发光层的器件可以在更低的阈值电流下产生随机激射.进一步地,在相同的注入电流下,由于光损耗更小和更多的载流子参与近带边辐射,以PLD法制备的ZnO薄膜为发光层的器件产生更大的光输出功率.

图6 (a)基于ZnO薄膜的MIS器件在正向偏压下的能带示意图;(b)ZnO薄膜产生受激辐射的原理示意图
4 结论
以反应溅射法和PLD法在硅衬底上制备ZnO薄膜,并以它们为发光层,制备了MIS结构的发光器件.研究表明,以PLD法制备的ZnO薄膜为发光层的器件产生随机激射的阈值电流更低且具有更高的电-光转换效率.XRD显示两种ZnO薄膜具有相似的结晶状态,而从SEM形貌上推论光在这两种ZnO薄膜中的多重散射不会存在显著差异.不过,PL谱分析表明PLD法制备的ZnO薄膜具有更好的晶体质量,即薄膜中的缺陷更少.因此,ZnO近带边辐射的紫外光在该薄膜内的传播过程中遭受的光损耗更小.我们认为,这是以PLD法制备的ZnO薄膜为发光层的器件具有更好电抽运随机激射性能的主要原因.
[1]Wiersma D S 2008 Nat.Phys.4 359
[2]Redding B,Choma M A,Cao H 2012 Nat.Photon.6 355
[3]Gottardo S,Cavalieri S,Yaroschuck O,Wiersma D S 2004 Phys.Rev.Lett.93 3901
[4]Polson RC,Vardeny ZV 2004 Appl.Phys.Lett.85 1289
[5]Cao H,Zhao Y G,Ong H C,Ho ST,Dai JY,Wu JY,Chang R PH 1998 Appl.Phys.Lett.73 3656
[6]Cao H,Zhao Y G,Ho ST,Seelig EW,Wang QH,Chang RPH 1999 Phys.Rev.Lett.82 2278
[7]Chai L,Wang Q Y,Zhang W L,Sun T,Huang JS,Wang K L 2003 Acta Phys.Sin.52 2127(in Chinese)[柴路,王清月,张伟力,孙涛,黄锦圣,王克伦2003物理学报52 2127]
[8]Yu SF,Yuen C,Lau SP,Lee H W 2004 Appl.Phys.Lett.84 3244
[9]Chen L,Lou QH,Wang ZJ,Dong JX,Wei Y R 2006 Acta Phys.Sin.55 920(in Chinese)[陈雷,楼祺洪,王之江,董景星,魏运荣2006物理学报55 920]
[10]Wang CS,Chen Y L,Lin H Y,Chen Y T,Chen Y F 2007 Appl.Phys.Lett.97 191104
[11]Fallert J,Dietz RJB,Sartor J,Schneider D,Klingshirn C,Kalt H 2009 Nat.Photon.3 279
[12]Yang H Y,Yu SF,Li GP,Wu T 2010 Opt.Express18 13647
[13]Leong ESP,Yu SF 2006 Adv.Mater.18 1685
[14]Ma X Y,Chen PL,Li D S,Zhang Y Y,Yang D R 2007 Appl.Phys.Lett.91 251109
[15]Chu S,Olmedo M,Yang Z,Kong JY,Liu JL 2008 Appl.Phys.Lett.93 181106
[16]Long H,Fang G,Huang H,Mo X,Xia W,Dong B,Meng X,Zhao X 2009 Appl.Phys.Lett.95 013509
[17]Zhu H,Shan CX,Zhang JY,Zhang Z Z,Li B H,Zhao D X,Yao B,Shen D Z,Fan X W,Tang Z K,Hou X H,Choy K L 2010 Adv.Mater.22 1877
[18]¨Ozg¨ur¨U,Alivov Ya I,Liu C,Teke A,Reshchikov M A,Do˘gan S,Avrutin V,Cho SJ,Morkoc¸H 2005 J.Appl.Phys.98 041301
