双靶反应磁控共溅射制备Al掺杂ZnO薄膜及其光电性能
2011-12-04李合琴武大伟
刘 丹,李合琴,武大伟,刘 涛
(合肥工业大学材料科学与工程学院,安徽合肥230009)
1 引言
ZnO是一种自激活宽禁带半导体材料,在自然界中储量多,价格低,无毒,且具有较高的化学、机械稳定性及优异的光电学特性。在紫外探测器、发光二极管、透明导电极、太阳能电池、液晶显示器等领域有广泛的应用前景。但纯的ZnO薄膜几乎不导电,通常通过掺杂提高ZnO薄膜导电性,以满足制备不同器件的要求。目前,对ZnO进行掺杂的元素有Al、Sn、Ga、In等,其中Al掺杂能得到与ZnO薄膜结构相同的ZAO薄膜,其电阻率大幅下降,且Al原料易得,价格低,无污染,发展潜力较大。
制备ZnO薄膜的方法主要有:脉冲激光沉积、磁控溅射、金属有机化学气相沉积、超声喷雾热解和溶胶-凝胶法等[1~3]。在诸多的制备方法中,磁控溅射法具有能大面积成膜、沉积率高、基底温度较低且薄膜的附着性好等优点,被研究者广泛采用[4,5]。目前,采用磁控溅射法制备ZAO薄膜,多用Al2O3掺杂的ZnO陶瓷或用掺Al的Zn金属为靶材,若改变Al的掺杂量,必须更换靶材,造成材料的浪费。采用双靶反应磁控共溅射法制备ZAO薄膜,通过调节溅射功率、气压等工艺参数就可以调整Al的掺杂量。
2 实验
采用双靶反应磁控共溅射法在FJL560B1型超高真空磁控与离子束联合溅射设备上制备ZAO薄膜。实验靶材为直径60 mm、厚度5 mm的高纯Zn、Al靶(99.99%),其中Zn靶和Al靶分别用直流和射频电源溅射。基片为单晶Si(100)和载玻片,用丙酮、无水乙醇、去离子水依次超声波清洗15 min,吹干后放入真空室。工作气体为Ar气,反应气体为O2气,气体纯度99.99%。真空室本底真空1.0×10-4Pa,样品制备工艺如表1 所列。1、2、3、4 号样品的基片为 Si(100),5、6、7、8 号样品基片为载玻片,与1、2、3、4 号样品放在同一样品托中在同一工艺条件下制备,用于测量ZAO薄膜在可见光区的透过率。

表1 单晶Si基片上ZAO薄膜的制备工艺参数
采用D/MAX2500VL/PC型X射线衍射仪(Cu-Kα射线源)分析薄膜结构;CSPM4000型原子力显微镜(AFM)观测薄膜表面形貌;FL-4500型荧光分光光度计的激发源为氙(Xe)灯,激发波长为300 nm,测试薄膜荧光光谱;UV-2550紫外可见光分光光度计测试薄膜光透过率;D41-11D/ZM型微控四探针测试仪测量薄膜方块电阻。
3 结果与讨论
3.1 ZAO薄膜的相结构、生长取向和表面形貌
图1为Si基片上制备的未掺杂ZnO薄膜以及Al掺杂的ZnO薄膜的XRD图谱,样品编号为1、2、3、4。由图1知,所有样品在2θ=34°附近出现很强的 (002)衍射峰,当Al靶溅射功率为0 W、10 W、20 W时样品在2θ=72°附近出现很弱的(004)衍射峰,其中(004)峰为ZnO(002)峰的二级衍射峰,当Al靶溅射功率增至30 W时,(004)峰消失。表明Al掺杂对ZnO的晶体结构影响很小,且制备的ZnO薄膜具有高度的C轴择优取向。
表2列出了ZnO和ZAO薄膜(002)衍射峰的XRD参数。由表2可知,对照标准纯ZnO粉末(002)峰衍射角(2θ=34.421°),ZnO薄膜的(002)峰衍射角均左移变小,并且Al掺杂的溅射功率越大,ZAO薄膜(002)峰的衍射角越小。根据布喇格公式,衍射角减小,晶面间距增大(如表2所列)。同时,与未掺杂ZnO薄膜样品相比,ZAO薄膜的衍射峰的半峰宽随Al靶溅射功率的增加略有增大,衍射峰强度也有所下降。这是由于Al3+的原子半径比Zn2+的原子半径小,Al3+替代了Zn2+位置,引起晶格畸变造成的[6,7]。当Al靶溅射功率为20 W时,ZAO薄膜(002)衍射峰强度最强,说明适量的Al掺杂能改善ZAO薄膜的结晶质量[8]。
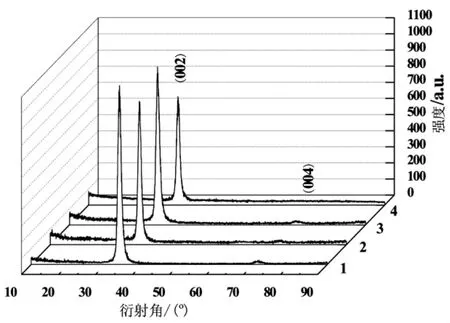
图1 ZnO和ZAO薄膜XRD图

表2 ZnO and ZAO薄膜的XRD参数
图2为1、2、3、4号样品的原子力显微镜(AFM)形貌图,扫描范围为5 μm×5 μm。从图中看出,制备的薄膜均为柱状生长。纯ZnO薄膜晶粒致密均匀,Al靶溅射功为10 W时,ZAO薄膜晶粒生长不完全,晶粒间比较疏松,表面光滑度差,Al靶溅射功率为20 W时,ZAO薄膜晶粒致密均匀,表面平整光滑,当Al靶溅射功率增至30 W时,晶粒的柱状生长显得有些杂乱,并有坑状出现。AFM分析显示,4种薄膜样品的均方根粗糙度 δRMS分别为 5.92 nm、10.89 nm、7.35 nm、8.21 nm。结合 XRD 分析,当 Al靶溅射功率为 20 W 时,制备的ZAO薄膜结晶质量最好。
3.2 ZAO薄膜的电学性能
图3为Al靶溅射功率与薄膜电阻率关系图。当Al溅射功率为0 W,制备的ZnO薄膜的电阻率较大,超出了仪器的测量范围,在这里不做描述。由图3可知,ZAO薄膜的电阻率随Al靶溅射功率的增加先降后增升。当Al靶溅射功率为10 W时,薄膜的电阻率为3.64×10-2#·cm;当溅射功率为20 W时,薄膜电阻率降低到最小值为8.85×10-4#·cm;溅射功率为30 W时,薄膜电阻率又有所升高,为4.36×10-3#·cm。这说明Al成功掺入ZnO薄膜内。薄膜的电阻率与载流子浓度及迁移率有关,载流子主要来源于Al3+对Zn2+置换产生的导电电子和氧空位,载流子的迁移率依赖于各种散射机制(离化杂质散射,晶粒晶界散射,晶格振动散射)和材料温度[9]。一方面,Al靶溅射功率为10 W时,溅射出来的Al离子动能较小,没有足够的能量扩散,使得Al3+对Zn2+置换率较低,载流子的浓度较少,当Al靶溅射功率为20 W时,溅射出来的Al3+离子动能增大,Al3+对Zn2+置换率增大,载流子的浓度增大。但随着Al3+含量的进一步增加,Al3+在薄膜结晶过程中形成的杂质散射中心也增加,离化杂质散射作用增强。另外,由3.1中薄膜表面形貌分析知,溅射功率增大到30 W时,ZAO薄膜的表面粗糙度增大,而表面粗糙度的增加导致薄膜表面积的增加,使薄膜吸附氧的位置增加,薄膜表面的晶粒中吸附的氧能有效的捕获电子,降低了载流子浓度;另外,表面粗糙度的增加也使得载流子移动的有效厚度减小,也增加了表面电阻,导致了ZAO薄膜的电阻率随Al靶溅射功率的增加先降低后增加。

图2 Al靶不同溅射功率下ZnO和ZAO薄膜的AFM形貌图
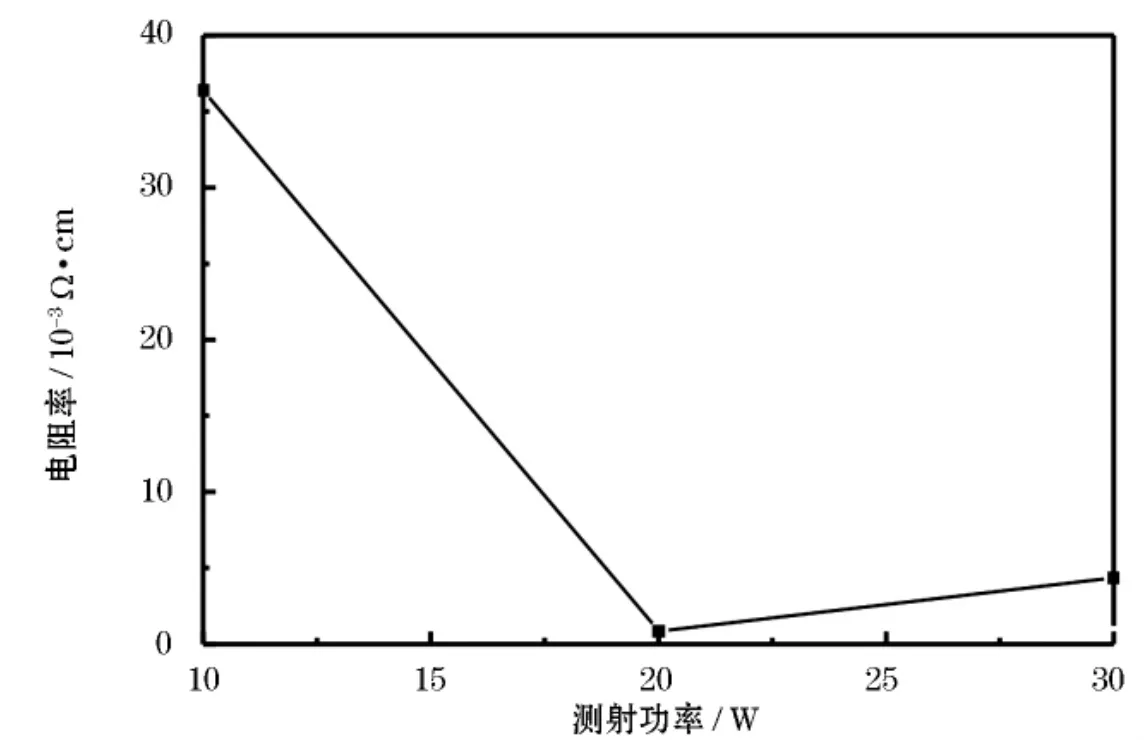
图3 Al靶不同溅射功率下ZAO薄膜电阻率
3.3 ZAO薄膜的光学性能
图4 为1、2、3、4号样品在室温下光致发光(PL)谱。从图中看出,样品发光峰均为单一的紫光发射峰,其峰值分别为404 nm、403 nm、398 nm、396 nm,并且随着Al的掺杂,ZnO薄膜的发光峰位略有蓝移,强度降低。对于ZnO的紫光发射,大多研究者认为由于自由激子的跃迁造成的[10~12]。室温下ZnO的激子束缚能为60 meV,远大于它在室温下的热离化能(26 meV),从理论上讲在室温下可以观察到激子发光。发光峰的强度与晶粒尺度和缺陷状态有关,晶粒尺度减小,激子密度降低,使得紫光发射强度降低。ZAO薄膜发光峰发生蓝移,是由于Al掺杂使薄膜的晶格常数发生了变化,产生的量子效应改变了能带间隙[13]。
图5为5、6、7、8号样品在300~800 nm的透射谱。由图中得知,所有掺杂ZAO样品在可见光部分(400~800 nm)的透过率大于80%。由于ZAO的禁带宽度大于可见光子能量,在可见光照射下不能引起本征激发,所以对可见光是透明的,具有较高的透过率。薄膜的透过率与载流子浓度、薄膜内部缺陷等因素有关,增大载流子浓度则会增加光学吸收,且薄膜电阻率降低,ZAO吸收边向可见光短波方向移动,文中的透射曲线也与该结论较为吻合。但透射率和吸收边的偏移并不十分明显,说明一定程度的Al掺杂对薄膜的透过率影响不大。

图4 ZnO和ZAO薄膜的PL谱

图5 ZnO和ZAO薄膜紫外-可见光透射谱
4 结论
(1)利用双靶反应磁控共溅射法制备的Al掺杂ZAO薄膜,并未引起晶体结构的明显变化且具有高C轴择优取向。
(2)室温PL谱、可见光透射谱及电阻率测量结果显示双靶反应磁控共溅射法制备的ZAO薄膜具有良好的光电性能,在Al溅射功率为20 W时制备的ZAO薄膜结晶质量最好,光电性能最佳。
[1]张贺攀.PLD方法沉积ZnO薄膜及其光电性能研究[D].大连:大连理工大学硕士论文,2009.
[2]吕承瑞,王小平,王丽,等.ZnO半导体薄膜的研究进展[J].材料导报,2008,22卷专辑:216-218.
[3]刘明,魏玮,曲盛薇,等.氧分压对磁控溅射ZnO薄膜生长行为和光学特性的影响[J].无机材料学报,2008,6(23):1096-1100.
[3]封宾,何大伟,富鸣,等.Al掺杂ZnO薄膜的制备及红外光学性能的研究[J].稀有金属材料与工程,2009,2(38):762-766.
[4]KAR J P,KIM S,SHIN B,et al.Influence of sputtering pressure on morphological,menchanical and electrical properties of Aldoped ZnO films[J].Solid-State Electronics,2010,54(2010):1447-1450.
[5]BEN S M,JACQUET,FIOUX P,et al.A ZnO/PET assembly study:Optimization and investigation of the interface region[J].Materials Chemistry and Physics,2009,119(2010):158-168.
[6]陈杰,王军.铝掺杂氧化锌薄膜的光学性能研究[J].功能材料,2010,4(41):693-696.
[7]赵印中,李林,何延春,等.ZnO 薄膜的结构、性能及应用[J].真空与低温,2009,15(1):48-51.
[8]马晓翠,叶家聪,曹培江,等.射频溅射功率对AZO薄膜结构及光电特性和热稳定性的影响[J].发光学报,2010,8(41):235-237.
[9]韦新颖,祁康成,袁红梅,等.直流磁控溅射ZnO:A1薄膜过程中氧气浓度的研究[J].电子器件,2010,2(31):1-4.
[10]李伙全,宁兆远,程珊华,等.射频磁控溅射沉积的ZnO薄膜的光之发光中心与漂移[J].物理学报,2004,3(53):867-870.
[11]孙成伟,刘志文,张庆瑜.退火温度对ZnO薄膜结构和发光特性的影响[J].物理学报,2006,1(55):430-436.
[12]薛华,张国恒,张浩.氧分压对纳米ZnO薄膜光致发光特性的影响[J].半导体技术,2009,2(34):123-126.
[13]史永胜,陈阳阳,宁青菊,等.溅射功率对AZO透明导电薄膜的影响[J].材料导报,2011,3(25):42-44.
