GaAs PHEMT器件高温加速寿命试验及物理分析*
2010-12-21崔晓英
崔晓英,许 燕,黄 云
(工业和信息化部电子第五研究所电子元器件可靠性物理及其应用技术国家级重点实验室, 广州 510610)
GaAs微波器件的退化与金属化稳定性密切相关,实现PHEMT器件功能的金属化主要有栅金属化、欧姆接触金属化和信号传输线金属化,这些金属化本身在电流应力作用下,金属原子发生定向移动,从而在金属上产生裂纹和空洞,以及金属原子堆积的小丘。由于金属原子电迁移的发生使金属化系统电阻增大,改变了器件的直流状态,另外由于金属化不稳定,会导致金属元素向器件体内迁移,发生互扩散,而改变器件内元素的成分比,改变器件的工作状态,造成器件内部不匹配,从而造成瞬态特性也发生退化[1-2]。因此对GaAs PHEMT器件的金属化稳定性进行评价具有非常重要的意义。
本文主要针对GaAs PHEMT器件的特殊评价结构进行高温加速应力试验,研究器件金属化退化的失效机理,并对器件金属化失效单机理进行寿命预计,同时对试验后的样品进行物理分析。
1 试验样品、试验条件及试验系统
试验样品为专门的测试结构,分为两种:(1)A2结构:电镀层(EL)、栅阻挡层(RMG)与栅金属(G2N)间接触孔链,用于评估栅金属间的接触可靠性;(2)A4结构:欧姆接触金属(CO)方块条,用于评估欧姆接触金属耐受电流能力及抗电迁移可靠性。如图1所示。

图1 寿命试验中所用的专门测试结构
由于PHEMT器件的金属化退化与电流应力和温度应力密切相关,因此选择合适的温度应力和电流应力是非常关键的。环境温度应力选择了180 ℃和225 ℃两个温度点。
电流密度应力选择在1 ×106~1 ×107A/cm2之间。根据样品的结构特点选取特定的基板电流应力,结合试验评价结构的面积大小,便可以计算出本次试验评价结构所施加的电流应力:A2结构应力为0.01 A;A4结构应力为0.33 A。
试验系统由高精度、高稳定度的高温箱, 8路电流应力源, 256通道电阻监测系统,高温试验板和互连线等部分组成。测试系统示意图见图2。

图2 测试系统框图
2 试验结果和分析
结构A2 电镀层(EL)、栅阻挡层(RMG)与栅金属(G2N)间接触孔链,用于评估栅金属间的接触可靠性。实际加电流330 mA。试验温度为180 ℃,图3为11只样品的电阻随时间变化的情况。
从图3可以看出, A2结构的电阻在450 h之前随着时间的增加缓慢上升, 450 h之后呈现明显上升趋势,显然温度和电流应力对它的影响很大。在180℃的试验条件下,样品7、10和12发生功能失效。金属电阻达到失效判据(漂移20%)的有9只样品。

图3 A 2结构样品的电阻随时间变化曲线(180 ℃, Sn表示样品号)
结构A4 欧姆接触金属(CO), 用于评估CO耐受电流能力及抗电迁移可靠性,实际加电流 10 mA。图4是12 只样品的电阻随时间变化的情况。试验初始阶段样品电阻出现下降的趋势, 50 h左右后开始稳定,初始阶段电阻的下降很可能是与欧姆接触金属合金工艺的不充分有关。已进行的180 ℃温度下的600 多小时内,结构A4的电阻变化曲线基本平稳,无一样品发生失效。后期曲线的短期内突变情况可能是由于试验中断等突发事件所致。
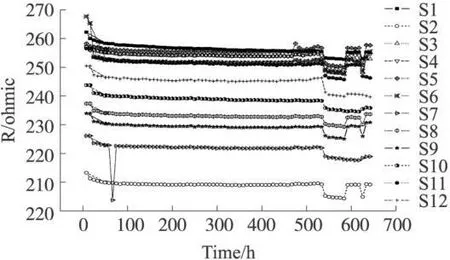
图4 A 4结构样品的电阻随时间变化曲线(180 ℃)
在180 ℃试验600多小时后紧接着将高温箱的温度加到225 ℃,由于样品数量的限制,用180 ℃试验后的剩余样品进行高温225 ℃试验。
结构A2 电镀层(EL)、栅阻挡层(RMG)与栅金属(G2N)间接触孔链。当温度加到225 ℃后, A2样品的阻值变化较大,样品在高温环境下相继失效,图5为A2结构的样品电阻随时间变化的情况。
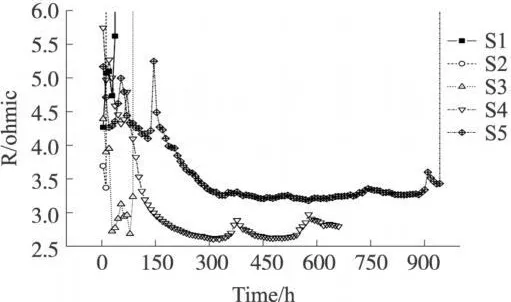
图5 A 2结构样品的电阻随时间变化曲线(225 ℃)
结构A4 欧姆接触金属(CO)。 180 ℃温度下A4无样品发生失效,且电阻变化较小,而225 ℃温度下约 400 h后多数样品的电阻变化加大, 到1 200 h时12只样品中有11只样品电阻变化率超过50 %,如图6所示。可见高温度应力对欧姆接触金属(CO金属)耐受电流能力和抗电迁移能力的影响较大,在高温度应力的影响下,金属的活跃程度更加剧烈,器件的特征电阻也发生很大变化。

图6 A 4结构样品的电阻随时间变化曲线(225 ℃)
3 寿命预计
对225 ℃下A2和A4样品的失效情况进行统计,总试验时间约1 100 h,将样品的失效判据为金属电阻漂移20%的时间设为失效时间,金属电阻的初始电阻为225 ℃试验开始时的初始电阻。对失效分布情况进行统计,绘制出两种结构的寿命分布图,如图7所示。

图7 225 ℃寿命试验下两种结构的寿命分布图
若将试验看成是温度从180 ℃到225 ℃步进的加速寿命试验,同时把试验看作是一个定时截尾试验,那么假定一个截尾时间,然后采用极大似然法即可估算出平均寿命t:

式中t0为截尾时间, t1, t2……tr为截尾时间内失效样品的失效时间, r为截尾数, n是样品数, S(t)是总试验时间。
根据阿伦尼斯模型, 特征寿命的对数是所加温度应力水平倒数的线性函数:

式中Tamb是环境温度, Tsh取20 ℃[3]。 a、b值的常规求法是根据不同温度点下的T和t,由公式(3)利用最小二乘法拟合,然后根据直线的斜率和截距推出a、b的值[4]。但由于试验只有两个温度点下的数据,所以将两个温度点下的T和t代入上式就可以求出a、b的值,当T取85 ℃(358 K)正常水平时,便可求出平均寿命点的估计值:

A2结构样品的寿命值如表1所示。

表1 A 2结构平均寿命预计
4 试验样品失效分析
利用扫描电子显微镜(SEM)和聚焦离子显微镜(FIB)对样品退化形貌进行物理结构分析。栅金属退化主要是靠热激活的,通常能够在加速寿命试验或者高温工作后观察到退化形貌。

图8 A 2结构在试验后的显微形貌和SEM形貌
图8(a)为A2结构第7只样品失效后的内部显微形貌,可以看到其接触孔链表面的金属化层形变,金属化发生了迁移。为了进一步分析,利用FIB对A2结构进行切槽并观察其剖切面,可以看到其剖切面非常平整,由于体内材料分子的约束,未出现空洞,而接触孔链的表面金属未受约束,出现了金属的堆积和空洞。从分析可以看出,电镀层、栅阻挡层与栅金属间接触孔链的耐受电流能力较差,同时也说明了该工艺条件下金的抗电迁移能力较差,如图8(b),(c)所示。
A4 欧姆接触金属(CO金属),已进行的180℃下的600多小时未发生样品失效,且稳定后的样品电阻变化率均小于5 %,电阻变化曲线平稳,可见欧姆接触金属的稳定性较好, 225 ℃下的试验后期多数样品电阻变化明显,到600 h左右,样品陆续发生失效,可见温度应力对欧姆接触金属(CO金属)耐受电流能力和抗电迁移能力的影响较大,高温下的AuGeNi欧姆接触金属更易发生电迁移失效。
图9(a)为A4结构在试验后的显微形貌,可以看到该结构发生了电迁移,利用FIB对A4结构沿X方向进行切割,如图9(b)所示,相邻两条欧姆接触金属的其中一条有明显的电迁移后留下的空洞,而另外一条是没有空洞的。对这两条欧姆接触金属进行对比可以看到,有空洞的的金属条在整个迫切面上金属化都不完整,说明金属不是在表面迁移,而是从表面向体内纵向迁移,因而在金属条上形成了空洞。
利用二次离子质谱对A4结构进行分析。如图10(a)所示为A4结构在试验后某点的失效形貌,我们利用二次离子质谱分析方法将选定区域的金属层向下刻蚀,并通过SEM进行观察,可以看到金属条完整的部分在刻蚀后仍旧非常平整,而金属条有异常的部分在刻蚀后出现了类似于尖峰的凹凸不平的形貌,如图10(b)所示。
在n-GaAs上形成的欧姆接触材料Au,在高于Au-Ge共熔点(363 ℃)的封装和合金过程中会向GaAs中渗透,其具体深度与温度和过程的持续时间有关。当器件工作时,未参加反应的Au可以继续向器件的有源区扩散,容易导致欧姆接触特性的消失和有源层电阻的增加,导致器件失效。图10(b)中的“尖峰”正说明了欧姆接触金属Au向体内扩散形成了一种共融的化合物,这种化合物不同于正常的欧姆接触金属,其抗等离子的刻蚀能力较强,因此留下了类似于尖峰的形貌。
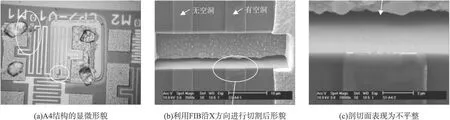
图9 A 4结构在试验后的显微形貌和SEM形貌
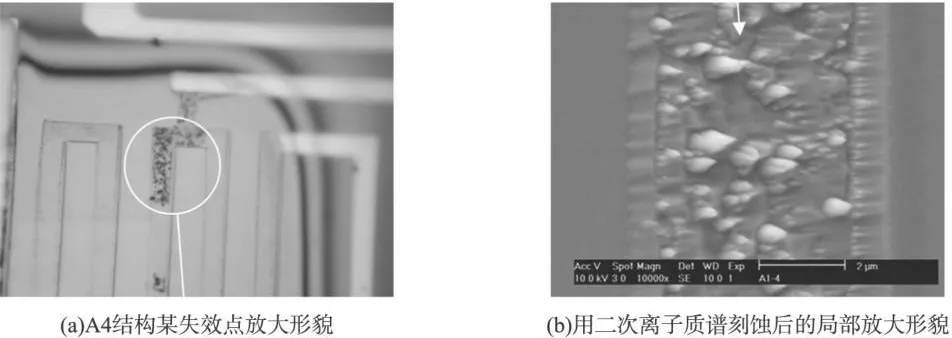
图10 欧姆接触A 4结构用二次离子质谱分析的形貌图
5 结论
GaAs微波器件的退化与电路中的金属化稳定性密切相关,本文针对GaAs PHEMT器件的栅金属接触孔链和欧姆接触金属方块条进行了高温加速应力寿命试验,并对器件金属化失效单机理进行寿命预计,同时对试验后的样品进行了物理分析。试验结果显示:栅金属接触孔链在180 ℃下就发生失效,接触孔链表面的金属化层形变,金属化发生了迁移,说明电镀层、栅阻挡层与栅金属间接触孔链的耐受电流能力较差。
欧姆接触在180 ℃下无样品失效,而225 ℃高温下的AuGeNi欧姆接触金属更易发生电迁移失效,金属向体内扩散,并在金属条上形成空洞。从二次离子质谱分析也可以看到,试验后金属条上的失效点在刻蚀后出现了类似于尖峰的凹凸不平的形貌,说明欧姆接触表面的金属和体内材料形成了一种抗等离子的刻蚀能力较强的化合物。
[ 1] 黄云.GaAs微波单片集成电路的主要失效模式及机理[ J].电子产品可靠性与环境试验, 2002(3):9-15.
[ 2] 朱炜容,黄云,黄美浅,等.GaAs MESFET的热电子应力退化[ J] .可靠性物理与失效分析技术, 2005(6):25-29.
[ 3] 詹郁生,郑学仁.集成电路金属互连焦耳热效应的测试与修正[ J] .华南理工大学学报(自然科学版), 2004, 32(5).
[ 4] 李健,汪金华,陆陪永.温度步进应力加速寿命试验研究[ J].电子产品可靠性与环境试验, 2007, 25(1):51-59.
[ 5] Chou Y C, Lai R, Leung D.Gate Sinking Effect of 0.1 μm InP HEMT MMICSUsing Pt/Ti/Pt/Au[ C] //2006 IEEE:188-191.
[ 6] Chou Y C, Grundbacher R.Physical Identification of Gate Metal Interdiffusionin GaAs PHEMTs[ J] .IEEE Electron Device Letters, 2004, 25(2):64-66.
[ 7] Kuo Chien-I, Hsu Heng-Tung, et al.RF and Logic Performance Improvement of In0.7Ga0.3As/InAs/In0.7Ga0.3As Composite-Channel HEMT Using Gate-Sinking Technology[ J] .IEEE Electron Device Letters, 2008, 29(4):290-293.
[ 8] Magistrali F, Sala D, Turner J, Vanner K.Vanner High Current Temperature Stress Test on Metal Lines and Interconnections for GaAs MMICs[ C] //GaAs ICSymposium.IEEE 2003:261-264.
[ 9] Chou Y C, Luo BW, Leung D, et al.The Effect of Gate Current on the Degradation of GaAs PHEMTMMICs[ C] //2006 JEDEC:111-114.
[ 10] Chu L H, Chang E Y, et al.Effect of Gate Sinking on the Device Performance of the InGaPAlGaAsInGaAs Enhancement-Mode PHEMT[J].IEEE Electron Device Letters, 2007, 28(2):82-85.
[ 11] Ming-Yih Kao, SabyasachiNayak, Rached Hajji, et al.High Performance Dual Recess 0.15 μm pHEMT for Multi-Function MMIC Applications[ J] .2006, IEEE:129-131.
[ 12] Magistrali F, Sala D, Turner J, et al.Vanner High current temperature stress test on metal lines and interconnections for GaAs MMICs[ C] //GaAs IC Symposium.IEEE 2003, 261-264.
