硅外延片几何参数WARP研究
2023-11-16骆红谭卫东魏建宇
骆红,谭卫东,魏建宇
南京国盛电子有限公司,江苏南京,210008
0 引言
随着中国半导体行业的快速发展,硅外延片的需求量大幅增加。而伴随着应用端要求的不断攀升,集成电路芯片呈现向大尺寸、细线宽、高精度发展的趋势[1-2],这对硅外延片的质量提出了更高的要求。在设备设计和测量的过程中,需要进一步加强相关技术研发,同时随着科技发展,所涉及的不同领域也在不断延伸。从整体上来看,需要进一步了解当前设备的具体测试方法,同时还要进一步研究当前整体工作的进度以及成果,根据当前的研究分析,进一步探讨整体的相关情况。几何参数WARP值是硅外延片的重要参数,是影响光刻的关键指标[3],而针对外延片WARP值的相关研究报告相对较少。在研究的过程中,研究的整体框架依然不够全面。本文主要从衬底及不同背封结构、外延厚度、降温速率等多个方面,对硅外延片WARP展开研究分析,进一步提升硅外延片的管控质量。
1 测试方法介绍
在对当前硅外延片几何参数研究的过程中,需要进一步选择正确的测试方法,同时对于当前的测试方法做出介绍。通过正确的测试方法能够得到更加精准的数值。采用ADE9600测试设备对外延片WARP值进行测试分析。在实际测试的过程中,需要根据当前的测试图形来进行分析,同时根据当前的相关曲线来进行研究,进一步判断最高点与最低点之间的距离,同时根据距离的相关公式来进行计算。在实际计算的过程中,需要进一步分析平面图形,同时确立当前中心平面的最高点和最低点,通过测量来进一步得到两者之间的距离。计算方法:被测物中心平面相对于中心平面的焦平面最高点与最低点之间的距离,具体如图1所示[4]。在弯曲图形测试的过程中,通过这样的测试方法能够得到更加精准的数值,从而能够为今后的研究提供一定的数据。
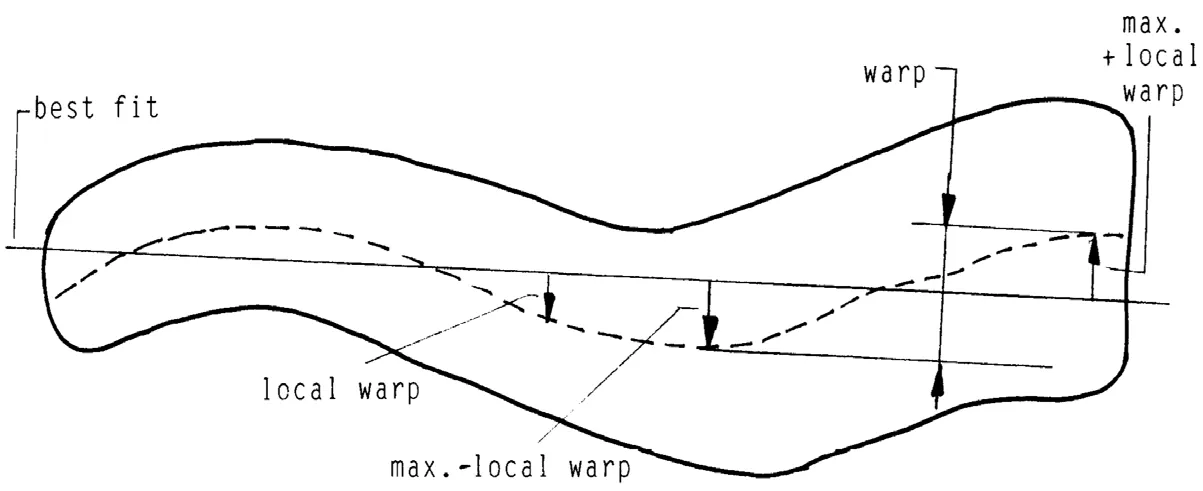
图1 WARP 测试示意图
在生产芯片基材单晶硅片时,很多情况是重掺杂的硅单晶上外延轻掺层。外延之前,通常都会在硅片的背面生长上一层约2000~4000a的低温氧化层(LTO),即二氧化硅层,这层LTO的目的是降低自动掺杂的现象。然而,LTO层会使得外延片后的硅片的翘曲度大幅增加。一般在生长LTO层之前的硅片,表面形状相对平坦,这样的正常硅片在生长完LTO层之后,因为LTO层的应力,会造成硅片变成凹形,而影响到最终硅外延片的翘曲度。例如,对于300mm的大硅片翘曲度超过国际常用标准的25μm,有时甚至超过45μm,呈现向下凹的形状,如同一个盘子。这样的翘曲度会造成在制造芯片时的良率损失。现有技术中,为了降低翘曲度,一般需要通过计算应力,并根据应力大小设计硅片内部的结构,这样的方法不仅效率低,而且过程复杂,大幅度提高了成本。
在实际测试的过程中,需要一套全新的方式和方法,从而进一步降低成本、简化程序,从而能够通过这样的方式提高整体的质量和效率,更加精准地获得相关数据。通过硅外延片几何参数测量的方式能够更加精准地获得数据,与此同时,本研究提供了一种降低调取度的测试方法,同时根据当前的研究进一步获得相关数据,根据硅外延片制备的方法来进行研究,可以将硅片基材研磨为弧形,然后再进行测量,在实际测量的过程进行更加精准的计算。采用ADE9600测试设备对外延片WARP值进行测试分析。
2 研究工作及成果
在研究的过程中,需要进一步了解当前材料的整体情况,同时根据材料的尺寸以及结构来进行分析。通过对材料进行分析获得相关成果。在选择衬底的过程中,可以选取以下三种规格的衬底。衬底一和衬底二经过高温外延后,WARP值相应变差,而衬底三经过高温外延后,WARP值有明显改善。同时根据不同的情况来进行分析,尤其是在不同条件下,需要加工到不同程度,在加工的过程中根据不同的厚度要求来进行设计,同时经过一系列加工手段来进一步获得样本。从整体上来看,其质量有了明显的提升,随着外延厚度的不断增加,其数值均有一定程度的提高。同时通过对不同外延厚度的相关数值变化来进行分析,进一步得出相关结论。
2.1 外延厚度对WARP值的影响分析
选取三种规格的衬底,在相同的生长条件下加工不同厚度的外延片,然后测试对应的WARP值,结果如图2所示。衬底一和衬底二经过高温外延后,WARP值相应变差,而衬底三经过高温外延后,WARP值有明显改善。随着外延厚度的增加,衬底一和衬底三的WARP值均有一定程度的改善趋势;而衬底二的WARP值基本保持在一定的水平程度。在选择三种不同类型衬底的过程中,需要根据当前的不同尺寸来进行分析,同时,根据当前的研究特点来获得厚度的差异性,根据不同外延厚度对应数字的变化来进行汇总,在数据获得的过程中,将相关数据以及不同外延厚度对应的数字变化以图片的形式呈现,同时通过折线图来进一步得出当前不同变化的情况,从而能够得出相关结论,在研究的过程中进一步获得弯曲程度的情况,同时在分析的过程中根据当前不同的条件一一对应,从而能够得出相关结论。
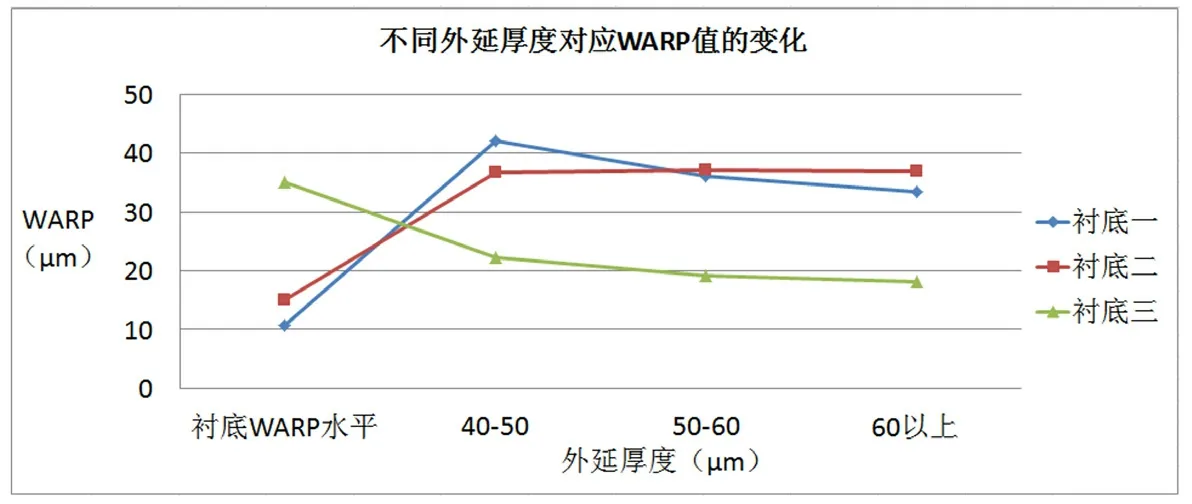
图2 不同外延厚度对应WARP 值的变化
2.2 衬底对外延片WARP值的影响分析
同样选取两种规格的衬底,先安排对衬底片做WARP测试,然后经过外延后,再次监控WARP值。衬底一WARP值越好,经过高温外延后,反而越差;衬底二WARP经过高温后无明显对应性。在实际监测的过程中,根据图片显示来与当前数值进行对应。从整体上来看,在不同数字的影响之下,都会得出不同的结果。在弯曲程度分析的过程中,根据当前的数字来进行研究,从而能够得出相关结论。从整体上来看,衬底对外延片WARP值的影响分析进一步证明了当前理论的正确性。
2.3 降温速率对外延片WARP值的影响分析
在测试的过程中,根据延缓降温速率来进一步分析当前数字的变化情况,同时根据条件一和条件二的差异性来进一步分析当前的情况,在研究的过程中根据当前的降温程度以及不同环境变化来进行探讨,两种条件对应的温度以及功率曲线绘制成图片,同时,在分析的过程中进一步得出当前数字变化的相关因素。
选取衬底三,采用不同的降温速率条件进行外延。条件一是在高温外延结束后,30s内机台功率降至40kW,之后不再通电流,进行降温,温度降至750℃耗时 170s;条件二是在高温外延结束后,420s内机台功率降至40kW,之后功率依旧保持40kW,持续300s,温度降至750℃耗时740s。
在获得相关数字之后,进一步将数字以可视化的图片形式来呈现。通过当前数字的变化,根据不同降温速率条件下的数值变化来进行研究,尤其是条件一和条件二有差异性,使两者所表现出来的结果呈现出明显的差异性,根据当前的速率对外延片数值分析,进一步得出结论。从数值结果分析得出:延缓降温速率对外延片WARP值呈负向作用,但影响程度有限。
3 结语
由于单晶硅、SiO2、多晶硅的热膨胀系数不同,不同背封结构衬底对外延片WARP值的影响也不相同。其中有Poly背封的衬底经过高温外延后,WARP值有一定改善,随着外延厚度的增加,WARP值也逐渐变好。而LTO背封衬底经过高温外延后,WARP值会变差,随着外延厚度的增加,WARP值基本稳定。另外,慢速降温对外延片WARP值呈负向作用,但影响程度有限。在今后研究的过程中,需要进一步对当前领域进行更加深入的研究,同时根据当前我国半导体硅片发展的具体情况,探讨出更加创新的测试方法,从而能够更好地适应时代发展,满足不同行业的需求。
