衬底偏压对反应磁控共溅射 Y∶HfO2薄膜电学性能的影响
2023-10-25张伟奇孙纳纳周大雨
张伟奇,孙纳纳,周大雨
(1.大连理工大学 材料科学与工程学院,辽宁 大连,116024;2.三束材料改性教育部重点实验室(大连理工大学),辽宁 大连,116024)
HfO2薄膜具有高介电常数、高化学稳定性和宽带隙等优点,是替代二氧化硅的理想高k介质材料[1-2]。2011年,Böscke等[3]发现Si掺杂HfO2薄膜具有铁电性能,这为非易失性存储器的广泛应用开辟了新的途径。元素Y、Al、Ca、Zr、Gd、和Se的掺杂也可以诱导HfO2薄膜的铁电性能[4-9]。此外,盖层效应、薄膜厚度及快速退火对薄膜的剩余极化均有影响[10-12]。铁电HfO2薄膜在理想状态下为高阻态,而阳离子/阴离子空位、位错、晶界和薄膜-电极界面作为漏电流通道对电荷的迁移率有影响。漏电流过大会导致器件发热问题加剧,导致薄膜缺陷增加并发生击穿失效,且漏电流过大会导致电滞回线发生明显的形变。因此,低漏电流是获得优良性能铁电薄膜的前提。
HfO2薄膜常见的沉积方法有原子层沉积(ALD)、物理气相沉积(PVD)、化学气相沉积(CVD)和脉冲激光沉积(PLD)[11,13-17]。在ALD沉积过程中薄膜中可能存在的杂质会对铁电性能产生影响,且用于沉积薄膜的前驱体价格昂贵[18]。PLD沉积的薄膜表面有大小不一的颗粒,沉积面积小且均匀性差。CVD方法所用前驱体一般为易燃易爆且有毒的危险物品,原料利用率低,成本也相对高昂。与其他薄膜沉积方法相比,PVD具有沉积速率高、附着力强、沉积温度低及成本低廉等优点。因此,本文采用反应磁控共溅射法沉积Y掺杂氧化铪薄膜。但与ALD相比,PVD沉积的HfO2薄膜粗糙度及漏电流过大,需要采取一定的措施降低HfO2薄膜的漏电流密度。
衬底偏压对磁控溅射所得薄膜的表面粗糙度和密度有影响,而介质薄膜的漏电流密度对晶界和薄膜粗糙度较为敏感。为获得性能优异的微电子器件,有必要将衬底偏压对磁控溅射沉积HfO2薄膜电学性能的影响进行探究。Haque等[19]通过磁控溅射研究了衬底偏压对HfO2薄膜光学性能的影响,发现衬底偏压的应用使得薄膜的密度增大,这主要是由于施加衬底偏压后薄膜表面被高能氩离子轰击造成的,适当的衬底偏压可以有效地降低薄膜的粗糙度。
本研究在磁控溅射Y∶HfO2薄膜时在衬底施加偏置电压,探究衬底偏压大小对薄膜粗糙度和漏电流密度的影响,发现适当的衬底偏压有助于薄膜致密度的提高以及表面粗糙度的降低,且对漏电流密度有较大的影响。研究结果为沉积低漏电流的高介电常数HfO2薄膜提供了一种廉价且高效的方法。
1 实 验
采用改进的工业标准湿法清洗工艺(RCA)对切割成2 cm×2 cm大小的低电阻率(0.001 Ω·cm)重掺杂n型Si(100)进行清洗。采用金属Hf(99.99%)和Y(99.99%)靶反应磁控共溅射沉积了Y掺杂HfO2薄膜,腔室的本底真空气压为5×10-4Pa。为避免SiO2层的生长,溅射HfO2前优先沉积了一层Hf (约2 nm)金属阻挡层。Hf和Y靶分别采用中频和射频电源,功率分别为80 和20 W。样品与金属靶材间距为160 mm,溅射气压为0.6 Pa,Ar/O2流量比为40/40。HfO2的沉积时间为30 min,衬底温度为200 ℃。在溅射过程中,脉冲直流衬底偏压电源的频率和占空比分别为19.7 kHz和30.1%,大小为0~-200 V。沉积完成后在氮气气氛下650 ℃退火40 s。为测试Y∶HfO2薄膜的电学性能,采用金属掩模版直流反应磁控溅射沉积了TiN电极,TiN (115 μΩ·cm)厚度和直径约为160 和110 μm。
采用掠入射X射线衍射(GIXRD,Empyrean)在25°~40°的2θ范围内进行测试,Cu Kα辐射(λ= 0.154 06 nm),分析了HfO2薄膜的晶体结构。掠入射角为0.5°,扫描步长为0.01°,积分时间为0.2 s/步。通过X射线反射率(XRR)检测了薄膜的厚度,并采用RCRefSimW软件对测试数据进行拟合分析。并且采用X射线光电子能谱(XPS,ESCALABTM250)分析了薄膜的组成和化学状态。测试前用3 keV的氩离子清洗薄膜表面,深度测量时Ar+的刻蚀速率为0.05 nm/s。采用铁电测试仪(Multiferroic 100V,Radiant Technologies)测试了极化-电场强度(P-E)和漏电流密度-电场强度(J-E)曲线。
2 结果与讨论
2.1 薄膜物相
首先采用GIXRD分析了Y∶HfO2薄膜的物相,如图1所示,其中的M、T和C分别代表单斜、四方和立方相。从图中可以看出,不同偏压强度下沉积所得薄膜的物相是一致的,即衬底偏压的大小不影响薄膜的物相[19-20]。随着偏压强度增加(0~-150 V),30.36°处的衍射峰强度略有增加,表明薄膜结晶程度增强,并且衍射峰向低角度偏移。当衬底偏压为-200 V时,衍射峰又向高角度偏移。与其他薄膜相比,当偏压为-150 V时,薄膜在35°~36°处的衍射峰发生了变化。立方/四方(c-/t-)晶面(002)在35.2°处的衍射峰由于择优取向而增强,单斜(m-)晶面(-102)在36.1°处的衍射峰减小。需要强调的是36.6°处的峰值对应于TiN电极。
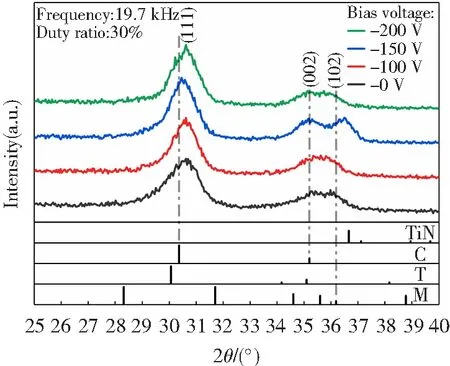
图1 不同衬底偏压强度下Y∶HfO2薄膜的GIXRD谱图
根据布拉格方程,当HfO2薄膜掺杂较大的原子(>Hf)时晶格参数增大,衍射峰的位置向低角度偏移。Y的原子半径大于Hf,衍射峰在无其他因素影响的前提下应向低角度偏移,XPS结果显示不同偏压下薄膜的掺杂含量几乎一致,即掺杂导致的衍射峰偏移可忽略。另外,薄膜应力也会影响衍射峰的位移。压应力的存在会导致薄膜的衍射峰向高角度偏移,这是无衬底偏压所得薄膜在30.36°处衍射峰发生偏移的原因。热应力的产生主要是由于薄膜与基底热膨胀系数的差异,HfO2作为与硅基底兼容性很强的介电薄膜常用作金氧半场效晶体管(MOSFET)的栅极材料,经Y掺杂后的立方HfO2热膨胀系数增加,两者热膨胀系数分别约为 10.4×10-6和2.6×10-6/℃[21-22],热应力计算过程如式(1)所示
(1)
从上式可以看出,不考虑外界其他因素时,立方HfO2与Si基底间会产生一定的压应力;另外,磁控溅射过程中溅射下的粒子仍具有一定的能量(约10 eV),该过程也会引入一定的压应力;当衬底偏压从0增加到-150 V时,磁控溅射薄膜与Si基底产生的应力由于Ar离子的轰击产生应力松弛效应,应力松弛的主要途径似乎是由轰击引起的间隙湮灭和原子重排,使得薄膜应力得到一定的释放[23],应力的减小导致30.36°处的衍射峰向低角度偏移。但随着偏压的继续增大,离子轰击造成的压应力又占主导地位,导致衍射峰向高角度偏移。一些研究表明粗糙度也会影响薄膜的应力。在薄膜生长过程中,内部拉应力是由相邻岛屿的合并产生的。Brian等[24]研究了金刚石薄膜的生长,发现这些应力的解释必须考虑到表面粗糙度的影响。因此,当衬底偏压为-200 V时,衍射角在30.36°处的偏移也可能包含薄膜粗糙度的因素。为验证上述解释,采用反射率测量法(XRR)对Y∶HfO2薄膜的粗糙度和厚度进行了测试和拟合。
薄膜的测试和拟合XRR曲线如图2 (a)所示。随着衬底偏压增加,不同XRR曲线的波峰数减少,表明薄膜厚度降低;薄膜的反射角增大表明薄膜的密度增大。膜厚与粗糙度的拟合结果如图2(b)所示,随着衬底偏压的增强,Y∶HfO2薄膜的厚度由9.80 nm减小到8.63 nm。当偏压为-150 V时,薄膜粗糙度Ra最低,为0.4 nm。

图2 不同衬底偏压下Y∶HfO2薄膜的实验(黑色圆圈)和拟合(红色线条)XRR曲线(a)及厚度和粗糙度(b)
随着偏压的升高,薄膜厚度的减小可能是由于氩离子动能的增加所致。此外,适当的偏压强度可以降低表面粗糙度,提高薄膜的性能,但过高的衬底偏压会导致溅射效应,增加表面缺陷及粗糙度。当衬底偏压为-200 V时,薄膜粗糙度明显增大。进一步测试后发现加载更高衬底偏压后薄膜的粗糙度明显增大,-250和-300 V下的结果分别为1.98和2.37 nm。
为获得Y的掺杂含量以及Hf、Y、O的化学价态,采用XPS对薄膜进行测试,结果如图3所示,测试前用氩离子轰击20 s以清除薄膜表面杂质。对于不同衬底偏压强度的薄膜,Y掺杂的原子百分含量分别为5.71%,5.84%,5.79%和5.81%。由于掺杂含量相似,本文以衬底偏压-150 V下沉积的薄膜为例进行了分析。该掺杂含量的Y∶HfO2薄膜一般为立方相,这与GIXRD的结果一致。Hf4f7/2和Hf4f5/2的双峰位于16.8和18.5 eV处,自旋轨道分裂为1.7 eV[25]。图3(b)为O1s的XPS能谱,在530和531.1 eV处的峰值分别与Hf—O和Y—O键有关,532.2 eV处的O1s峰对应于薄膜内的氧空位(Vo)[26-27]。结果表明:薄膜中存在氧空位,这可能与Hf层、掺杂Y和退火工艺有关。此外,在156.80和158.80 eV处观察到Y3d5/2和Y3d3/2的双重峰,其对应于Y—O键[28]。
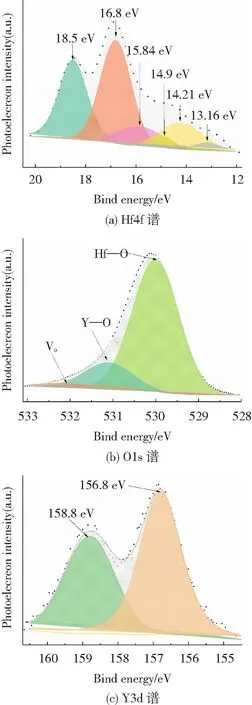
图3 Y∶HfO2薄膜在-150 V衬底偏压下的XPS谱
2.2 薄膜的介电特性及漏电流密度
为了获得薄膜的介电常数,对4种偏压下制备的Y∶HfO2薄膜进行极化与电场强度的测试,结果如图4所示。测试电压和频率分别为1 V和1 kHz,介电常数由式(2)计算得出

图4 不同衬底偏压下Y∶HfO2薄膜的P-E曲线
P=ε0(εr-1)E
(2)
铁电薄膜的极化曲线由理想状态下的电阻、电容及铁电体三部分组成,三者对应的P-E曲线分别为对称的二次曲线、直线及类矩形[29]。但实际溅射所得介电薄膜为非理想状态,即薄膜内部存在各种缺陷且表面不光滑,导致其P-E曲线不是简单的直线状态。从图4中可以看出,由于漏电流过大导致部分薄膜的P-E曲线趋于非线性,其中-150 V偏压下的曲线线性程度最好,更高偏压下沉积的薄膜接近击穿状态。当衬底偏压从0增加到-200 V时,Y∶HfO2薄膜的介电常数分别为24.3、25.9、27.1和29.0,相对的,立方HfO2的理论介电常数约为30.0[30]。
上述薄膜的介电常数与理论值不一致可能是由于在硅与Y∶HfO2之间存在Y∶HfOx层,加载电压后,Y∶HfOx与Y∶HfO2串联导致Y∶HfO2实际加载电压低于总电压。Y∶HfOx层的存在是预沉积的金属Hf氧化所致。金属Hf层在HfO2基忆阻器研究中通常作为除氧层,即通过金属Hf的氧化生成层间HfOx,使其在不同电压下形成导电通路并得到不同的电阻值[31]。此外,在HfO2和硅片之间可能存在SiO2层,但金属Hf层具有强氧化性,可以阻碍SiO2的形成。因此,本文认为非化学计量比的HfOx存在于HfO2与硅基底的界面处,其中Y∶HfO2和Y∶HfOx的结构示意图以及两者串联的电容器理论模型如图5所示。

图5 Y∶HfO2/Y∶HfOx电容器结构及其串联电容器模型
串联电容器的计算公式可以推导为
C=CH·Ch/(CH+Ch)
(3)
式中CH和Ch分别为Y∶HfO2和Y∶HfOx薄膜的电容,电容公式表示为:
CH=εH·S/dH
(4)
Ch=εh·S/dh
(5)
C=ε·S/(dH+dh)
(6)
式中:εH和εh分别为Y∶HfO2、Y∶HfOx的介电常数;dH和dh分别为Y∶HfO2、Y∶HfOx的厚度;S为电容器的面积。由式(3)~(6)可知,串联结构的理论介电常数为
(7)
为简化讨论,Y∶HfOx与重掺杂硅片之间的电阻被忽略。立方HfO2和HfOx的介电常数分别为30.0和12.5[32]。在计算介电常数前需要验证HfOx的存在并得到其厚度。在无偏压加载下沉积薄膜的XPS深度分析结果如图6所示,其刻蚀速率约为0.05 nm/s,每刻蚀30 s后采集一次XPS深度信息,即每1.5 nm采集一次XPS数据。图6中表面处的结果与图3(a)是一致的,随着探测深度增加,在12~15.5 eV处也出现了谱峰,该部分谱图对应于金属Hf和HfOx,这与Vladimir等[31]的研究结果一致,金属Hf对应的Hf4f7/2和Hf4f5/2低能峰位于14.21和15.84 eV处,在13.16和14.90 eV处的峰值对应于HfOx[33]。HfOx的产生主要与退火后金属Hf层的氧化有关。由图6可知,Y∶HfOx薄膜约在2.5 nm处生成,在10 nm处消失,其厚度约为7.5 nm。此外,不同偏压强度沉积的薄膜厚度变化不大且退火工艺相同,本文假设不同偏压下所得薄膜的Y∶HfOx厚度是一致的。

图6 Y∶HfO2薄膜(沉积于0 V)在不同深度(Hf4f)的XPS深度分析示意图及其结果
结合Y∶HfO2和Y∶HfOx薄膜的厚度及介电常数,由式(7)计算得到串联结构的总介电常数理论值分别为22.2、23.4、25.1和27.1,如图7所示。理论值与测试值的曲线变化趋势一致,两者的差值可能是测试过程中的偏差造成的,该结果间接表明非化学计量比的HfOx存在于薄膜内部。

图7 不同衬底偏压下Y∶HfO2薄膜的实验和理论介电常数
不同偏压下所得薄膜的漏电流密度变化如图8所示。当偏压为-100和-200 V时,薄膜质量并不理想,过大的漏电流导致图4中的P-E曲线发生形变。从图8可以看出,当衬底偏压为-150 V时,薄膜漏电流密度减小到最小(8×10-8A/cm2)。进一步测试发现薄膜在-250和-300 V下的P-E曲线接近击穿后的二次曲线状,数据不具备分析意义,故图中未列出。
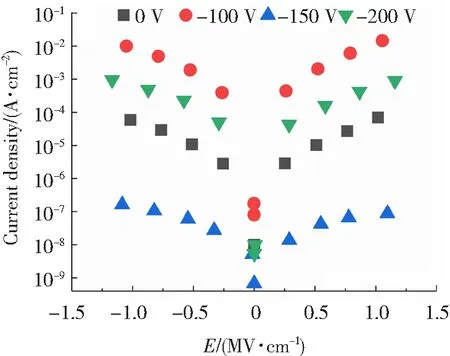
图8 不同衬底偏压下Y∶HfO2薄膜的J-E曲线
ALD法沉积的HfO2薄膜漏电流密度在1 MV/cm的电场强度下约为1×10-8~1×10-5A/cm2,即本文磁控溅射法所得薄膜的漏电流密度仅与原子层级的沉积方法相差约1个数量级[34-35]。
薄膜的漏电流密度受氧空位、晶界和粗糙度的影响[36]。Y∶HfO2薄膜的氧空位是由Y掺杂和退火过程中金属Hf的氧化产生的。但在相同掺杂含量和金属Hf厚度的不同薄膜中,氧空位的含量应该是一致的,说明薄膜漏电流密度的变化与氧空位相关性不大。采用Debye-Scherrer方程[37],根据图1中30.36°处的半高宽(FWHM)计算了晶粒尺寸,结果表明:随着衬底偏压的增大,不同薄膜的晶粒尺寸分别为8.3、9.6、9.7和9.5 nm。衬底偏压的不同导致了Ar+能量的变化,这会影响薄膜晶粒的生长,而晶粒尺寸大更易形成导电通路。粗糙度对半导体/氧化物界面的反转层有较大影响,粗糙度的大小会影响电子能级[38]。综上所述,漏电流密度的变化主要由薄膜粗糙度和晶粒尺寸的变化导致的。
由于Y的掺杂含量较高(5.81%),Y∶HfO2薄膜的P-E曲线不具有迟滞回线的特征。为了获得铁电性质Y∶HfO2,下一步工作需要调整Y的含量来获得优良的铁电薄膜。
3 结 论
通过改变衬底偏压获得了低漏电流和高介电常数的反应磁控共溅射Y∶HfO2薄膜,可获得如下结论:
1)衬底偏压的使用会在薄膜沉积中引入应力,但对薄膜物相几乎没有影响。
2)适当的衬底偏压可以显著降低HfO2薄膜的漏电流密度,而过小或过大的衬底偏压会导致薄膜漏电流增大。
3)当衬底偏置电压为-150 V时薄膜的粗糙度和漏电流密度最低,分别为0.4 nm和8×10-8A/cm2。漏电流密度的变化是由于不同衬底偏压所致,引入的氩离子轰击效应对晶粒大小和薄膜粗糙度有一定的影响。
反应磁控溅射低漏电流HfO2薄膜的实现为其大规模、低成本工业化沉积提供了一种有效的方法,并且为沉积HfO2铁电薄膜提供了一定的基础。
