SGT-MOSFET 电场解析模型的建立*
2023-07-27苏乐王彩琳杨武华梁晓刚张超
苏乐 王彩琳 杨武华 梁晓刚 张超
(西安理工大学电子工程系,西安 710048)
屏蔽栅沟槽金属氧化物半导体场效应晶体管(SGT-MOSFET)在体内引入了纵向接源电极的屏蔽栅极,可以辅助耗尽漂移区,其耐压原理与沟槽MOSFET(VUMOSFET)不同.本文以110 V 左右结构的SGTMOSFET 为研究对象,通过数值仿真、理论分析以及解析建模,研究了不同结构的耐压原理以及结构参数与电场强度分布的相关性;建立了与器件各个结构参数相关的电场解析模型,为器件结构设计提供了理论依据;并引入雪崩载流子对小电流下的电场解析模型进行了修正,使得解析结果和仿真结果吻合较好;通过修正后的电场解析模型提取了最优电场下的场氧厚度,使得相应产品的静、动态特性得到明显改善,从而极大地提升了器件的性能.
1 引言
屏蔽栅沟槽金属氧化物半导体场效应晶体管(SGT-MOSFET)是一种新型的功率MOSFET 器件,其不仅具有传统深沟槽MOSFET 低导通损耗的优点,同时也具有更低的开关损耗[1-5].目前SGT-MOSFET 作为开关器件主要应用于新能源电动车、新型光伏发电、节能家电等领域的核心功率控制部件,其性能与可靠性直接决定了系统的能源转换效率和可靠性[6-9].
对于SGT-MOSFET 性能的提升,一方面可以通过结构改进来实现,如重掺杂n 型区结构、双分离栅结构、不同介电常数场氧层结构、浮空n 柱结构、pn 掺杂多晶硅屏蔽栅结构、多层外延结构、浮空电极结构、窄栅低k介质层结构、p+埋层结构等[10-18].另一方面可以通过参数优化来实现,这就需要建立与器件结构参数相关的电场解析模型.Zhang 等[19,20]在研究横向扩散金属氧化物半导体(LDMOS),SGT-MOSFET 阻断状态下漂移区的电场模型时,通过借鉴RESURF 技术相关理论给出了该类器件的电场优化条件判据,为器件结构设计提供了重要的理论依据.
实际上SGT-MOSFET 不仅由沟槽间漂移区来承受耐压,还包括体区以及沟槽底部漂移区的耐压区,因此有必要建立更加完整的电场解析模型来对器件结构参数进行优化,从而最大限度的提高器件性能.本文以110 V 左右结构的SGTMOSFET 为研究对象,通过数值仿真、理论分析以及解析建模,研究不同结构的耐压原理以及结构参数与电场强度分布的相关性;建立了与结构参数相关的电场解析模型,并通过引入雪崩载流子对其进行了修正;通过修正后的电场解析模型提取了最优电场下的场氧厚度,从而极大地改善了相应产品的性能.
2 仿真模型
2.1 结构模型
110 V SGT-MOSFET 产品的扫描电子显微镜(SEM)照片如图1 所示.通过SEM 照片提取的元胞各区域尺寸及扩展电阻测试(SRP)技术获得的各区域掺杂浓度如表1 所示.仿真中通过面积因子将器件有源区的面积设置为和产品一致的2.57 mm × 3.59 mm (0.09 cm2).

图1 SGT-MOSFE 产品SEM 图Fig.1.The SEM photo of SGT-MOSFE product.

表1 SGT-MOSFE 产品具体结构参数Table 1. The structural parameters of SGT-MOSFET product.
为对比分析建立了如图2 所示的传统沟槽MOSFET (VUMOSFET)、电荷耦合MOSFET(CCMOSFET)、SGT-MOSFET 结构模型,其除了栅电极不同外,其他参数均一致.

图2 两元胞VUMOSFET (a),CCMOSFET (b),SGT-MOSFET (c)结构图Fig.2.The structures of two-cell VUMOSFET (a),CCMOSFET (b),SGT -MOSFET (c).
2.2 栅电荷测试电路模型
栅电荷是指器件栅源电压上升到指定数值时,所需要对栅极输入的总电荷量,是衡量MOSFET器件开关速度快慢的重要指标.图3 所示为栅电荷测试电路及测试波形.在0—t1阶段,电流源Ig对栅源电容充电,栅源电压持续上升,但此时栅源电压仍小于器件阈值电压VTH,器件并未导通;在t1—t2阶段,电流源Ig对栅源电容继续充电,栅源电压持续上升,在t1时刻栅源电压等于VTH,器件导通;在t2—t3阶段,电流源Ig对栅漏电容进行充电,此时栅源电压维持不变,对应的电压值为平台电压VGP;在t3—t4阶段,电流源Ig继续对栅电容进行充电,直到栅源电压上升到指定数值VGS,这一部分电荷称为过充电荷.因此总的栅电荷QG包括栅源电荷QGS、栅漏电荷QGD以及栅源电压从VGP上升至VGS时所需的过冲电荷.
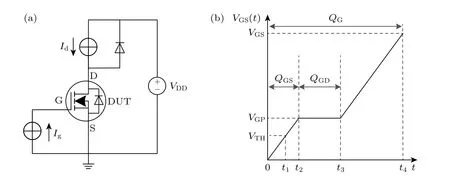
图3 (a)栅电荷测试电路;(b) 栅电荷测试波形Fig.3.(a) Testing circuit of the gate charge;(b) test waveform of the gate charge.
2.3 物理模型
仿真所采用的物理模型包括禁带窄化模型;依赖于掺杂、温度、载流子-载流子散射以及高电场造成的载流子漂移速度饱和的迁移率模型;受沟道表面横向电场散射影响的迁移率退化模型;依赖于掺杂和温度的SRH (Shockley-Read-Hall)体复合模型;在栅氧与硅交界处采用SRH 表面复合模型,俄歇(Auger)复合模型;vanOverstraeten and de Man的雪崩产生模型.
3 仿真结果与分析
仿真VUMOSFET,CCMOSFET,SGT-MOSFET 在50 mA 电流下的击穿曲线以及通过曲线示踪器(B1505 A)测试的SGT-MOSFET 产品的击穿曲线如图4 所示.在相同漂移区掺杂下,CCMOSFET 和SGT-MOSFET 由于体内场板的引入,击穿电压相比于VUMOSFET 分别提升了91%和140%.场氧厚度为0.58 µm 的SGT-MOSFET 击穿电压比场氧厚度为0.28 µm 的CCMOSFET 提升了25%,而在相同的0.58 µm 场氧厚度下两者击穿电压一致,表明CCMOSFET 和SGT-MOSFET 的耐压原理相同.并且SGT-MOSFET 击穿曲线的仿真结果与测试结果相符合.

图4 不同结构击穿曲线对比Fig.4.Comparison of breakdown curves of different structures.
沿图2 中虚线1—3 截取的3 种不同结构MOSFET 的电场强度分布曲线如图5 所示.VUMOSFET在阻断状态下由n 漂移区和p 基区形成的J1结来承担电压,此处会产生一个电场峰值.CCMOSFET,SGT-MOSFET 由于体内场板的引入,在J1结和沟槽底部会产生两个电场峰值,从而会进一步优化器件体内的电场强度分布,提高器件击穿电压.可以看出SGT-MOSFET 的电场强度分布比CCMOSFET更加均匀,因此击穿电压更高.

图5 不同结构电场强度分布图Fig.5.The electric field strength distribution diagram of different structures.
为了分析场氧厚度对器件击穿电压、电场均匀性的影响,沿图2 中虚线1—3 截取了3 种不同结构的电势分布曲线如图6 所示.与CCMOSFET相比,SGT-MOSFET 的场氧更厚,则聚集于SGTMOSFET 沟槽两侧的空穴载流子数目更少,沟槽间的空穴载流子分布更加均匀.因此SGT-MOSFET纵向轴对称线上的电势更高,击穿电压更大,电场分布更加均匀.

图6 不同结构电势分布曲线Fig.6.The potential distribution curves of different structures.
CCMOSFET、SGT-MOSFET 在不同场氧厚度和台面宽度下的击穿电压如图7 所示.在元胞宽度不变的情况下,台面宽度为1.4 µm 时,击穿电压随场氧厚度增大而线性增大;在台面宽度为2.4 µm和3.4 µm 时,随场氧厚度增大击穿电压先增大后减小,并且台面宽度越宽,击穿电压最大时对应的场氧厚度越薄.这是由于在1.4 µm 台面宽度下,器件体内场板可以充分辅助耗尽n 漂移区,场氧厚度的变化对空间电荷区展宽的影响很小,而场氧厚度的增大会进一步优化电场强度分布,从而提高器件击穿电压.在2.4 µm 和3.4 µm 较大的台面宽度下,场氧厚度的增加会进一步削弱体内场板对n漂移区的耗尽,使空间电荷区展宽减小,击穿电压下降.

图7 不同场氧厚度下的击穿电压Fig.7.The breakdown voltage under different field oxygen thicknesses.
4 电场解析模型
4.1 电场解析模型的建立
以上分析可知,场氧厚度和台面宽度对器件击穿电压以及电场强度分布的影响不是独立的,而与电场强度分布有关的结构参数还包括沟槽深度、元胞宽度、漂移区掺杂浓度等.参数越多其对电场强度分布影响的关联性越复杂,因此有必要建立与器件各个结构参数相关的电场解析模型来为器件结构设计提供依据.
如图8 所示为两个元胞的SGT-MOSFET 结构示意图,建立如下坐标系,以硅表面为X轴,以两个元胞沟槽间漂移区的对称轴为Y轴.图中Wn为1/2 台面宽度,Tox为屏蔽栅与漂移区间的场氧层厚度,Ln为沟槽间漂移区的长度,Dp为p 基区的深度,WPSC为空间电荷区在p 基区的展宽,WTSC为空间电荷区在沟槽底部的展宽.将轴对称线上的纵向电场强度划分为p 基区、沟槽间漂移区和沟槽底部三段分布.

图8 SGT-MOSFET 结构示意图Fig.8.The schematic diagram of SGT-MOSFET.
对于沟槽间漂移区电场强度分布,假设阻断状态下沟槽间的漂移区完全耗尽,则有二维泊松方程:
将φ(x,y) 沿x方向泰勒展开并保留前三项为
y轴为沟槽间漂移区的对称轴,对称轴上的横向电场强度为零,则有边界条件
假设x方向的场氧层电场强度均匀分布,则介质交界处电位移矢量的连续性方程为
由于屏蔽栅与源极相接,电势为0,则有边界条件:
假设沟槽间漂移区上承担的电压为V2,则在(0,Dp)和(0,Ln)处有边界条件:
由方程(7)及边界条件(9)和(10)式可得SGTMOSFET 沟槽间漂移区的电场强度分布表达式[21]:
由表达式(11)可知,沟槽间漂移区的电场强度分布与外加漏源电压V2,台面宽度Wn,场氧层厚度Tox,沟槽间漂移区长度Ln,以及漂移区掺杂浓度Nd有关.p 基区和沟槽底部的电场强度分布主要由掺杂浓度决定,为了简化计算,取p 基区为常掺杂,即
将y=Dp和y=Dp+Ln代入电场强度表达式(11)可得:
由(13)—(15)式可得p 基区和沟槽底部的电场强度表达式为
由(16)式和(17)式可得p 基区和沟槽底部的空间电荷区展度分别为
对p 基区和沟槽底部的电场强度积分可得:
将(23)式代入(11)式可得繁杂的沟槽间漂移区的电场强度表达式.重复(13)—(17)式,可得p 基区和沟槽底部的电场强度表达式.最终整个器件的电场强度表达式为
将表2 中具体参数值代入表达式(24),可得SGT-MOSFET 在不同电压下电场强度分布的解析结果如图9 所示,并与仿真结果进行对比.可以看出,50 V 电压下解析结果和仿真结果吻合较好,而在113 V 高电压下,解析模型沟槽底部的电场强度高于仿真结果,这是由于在高电压下器件内部已产生雪崩电流,雪崩产生的电子在正向漏源电压下向漏极移动,使沟槽底部电场强度降低,而解析模型并未考虑到雪崩载流子对电场强度分布的影响.

图9 不同电压下电场解析结果和仿真结果的对比Fig.9.Comparison of electric field analysis results and simulation results under different drain-source voltages.
4.2 电场解析模型的修正
考虑上雪崩产生的载流子对电场强度分布的影响,引入雪崩电流来对电场解析模型进行修正.器件在113 V 电压下的漏极电流为1×10—3A,此时器件空间电荷区的掺杂浓度为有效掺杂浓度,需要考虑上雪崩产生的电子和空穴[22]:
电子和空穴有关电场强度的漂移速度表达式如下[23]:
在空间电荷区中电子电流连续性方程如下:
总电流密度J等于:
电子和空穴有关电场强度的的碰撞电离率为
通过求解以上非线性方程组,最终可得修正后的电场解析表达式为
将V=113 V,J=1×10—3A 代入(34)式,得到修正后的电场强度解析模型如图10 所示,可以看出其与仿真结果符合得较好.

图10 修正后的电场解析模型Fig.10.Revised electric field analytical model.
4.3 参数优化
在1.4 µm 台面宽度下,器件击穿电压随场氧厚度增加而线性增大,说明此时屏蔽栅能够较好的辅助耗尽漂移区.因此建立了1.4 µm 台面宽度下不同场氧厚度的电场解析模型,如图11 所示.随着场氧厚度增大,元胞间漂移区轴对称线上的电场强度分布越加均匀,在0.68 µm 场氧厚度下,J1结和沟槽底部的电场峰值几乎相等,达到最优电场强度分布.

图11 不同场氧厚度下的电场解析模型Fig.11.Analytical model of electric field under different field oxygen thicknesses.
通常通过优值参数来评估器件的性能,其中优值FOM1是评估器件静态特性的指标,由(35)式定义.击穿电压VBR越高,导通电阻Ron越小,则优值FOM1越大,代表器件击穿电压和导通电阻折中越好,器件静态特性越优异.
器件在不同场氧厚度下的Ron、VBR、归一化优值FOM1如图12 所示.通态时屏蔽栅极与源极接零电位,会使电子电流远离靠近屏蔽栅极侧的漂移区.而随着场氧厚度增大,电子电流导通面积增大,因此器件导通电阻降低.在0.68 µm 场氧厚度下优值FOM1最大,表明此时器件的静态特性最佳.

图12 不同场氧厚度下的Ron、VBR、归一化优值FOM1Fig.12.Ron,VBR,and normalized FOM1 under different.
优值FOM2是评估器件开关特性的指标,定义为
其中导通电阻Ron越小,栅电荷Qg越少,则优值FOM2越小,代表器件开关速度越快,功耗越少,器件动态特性越优异.
不同场氧厚度下的栅电荷如图13 所示,测试条件为VDD=80 V,VGS=10 V,Ig=6.5 mA,Id=13 A.随着场氧厚度增大,栅源电容减小,因此栅源电荷降低.虽然不同场氧厚度下器件击穿电压不同,但由于屏蔽栅可以充分辅助耗尽n 漂移区,场氧厚度的变化对空间电荷区展宽影响很小,因此栅漏电荷几乎不变.
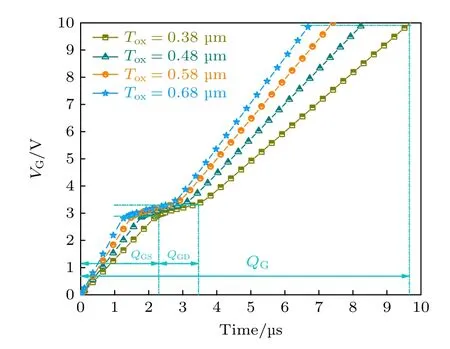
图13 不同场氧厚度下的栅电荷Fig.13.Gate charges under different field oxygen thicknesses.
器件在不同场氧厚度下的Ron、栅电荷Qg、优值FOM2如图14 所示.在0.68 µm 场氧厚度下优值FOM2最小,表明此时器件的动态特性最佳.相对于图1 中场氧厚度为0.58 µm 的SGTMOSFET产品,在优化后的0.68 µm 场氧厚度下FOM1提升了18.9%,FOM2降低了8.5%,因此器件的静动态特性均得到明显改善.
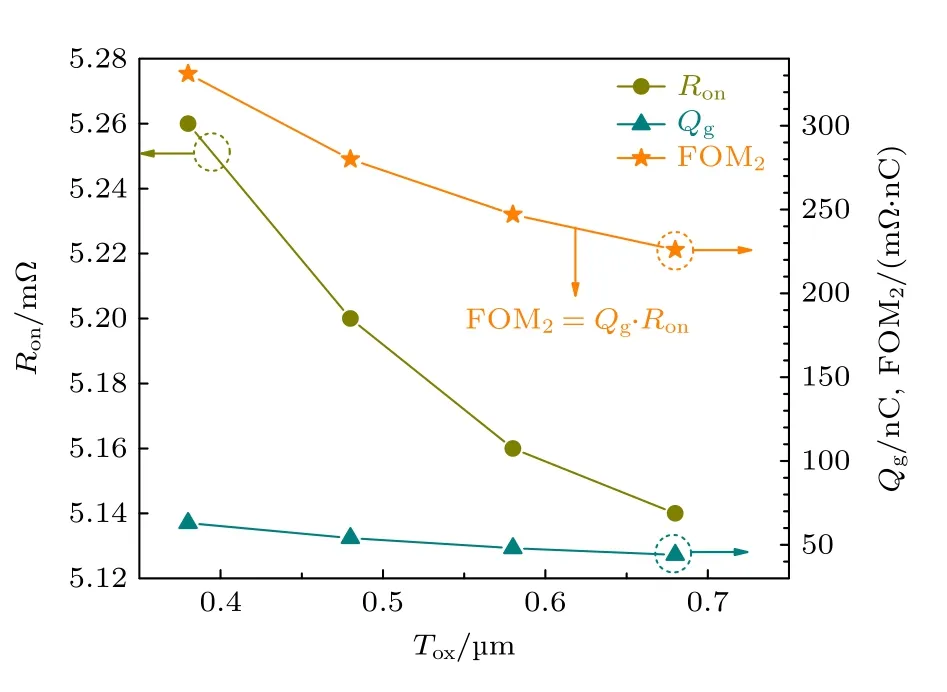
图14 不同场氧厚度下的Ron、Qg、优值FOM2Fig.14.Ron,Qg,and FOM2 under different field oxygen thickness.
5 结论
SGT-MOSFET 场氧厚度和台面宽度对器件击穿电压以及电场强度分布的影响不是相互独立的,参数越多其对电场强度分布影响的关联性越复杂.本文通过建立与器件各个结构参数相关的电场解析模型,为器件结构设计提供了理论依据;并引入雪崩载流子对小电流下的电场解析模型进行了修正,使得解析结果和仿真结果吻合较好;通过修正后的电场解析模型提取了最优电场下的场氧厚度.与原本0.58 µm 场氧厚度的SGTMOSFET 产品相比,在0.68 µm 最优场氧厚度下器件的优值参数FOM1提升了18.9%,FOM2降低了8.5%,使得器件的静、动态特性均得到明显改善,从而极大地提升了相应产品的性能.
